Ультрафиолетовые светодиоды на основе AlGaN с почти нулевым КПД и специально разработанным слоем блокировки электронов p-типа сверхрешетки для высокой эффективности легирования магнием
Аннотация
В этой работе сообщается о светодиоде глубокого ультрафиолетового излучения (DUV LED) на основе AlGaN, практически не имеющем спада эффективности, излучающем с максимальной длиной волны 270 нм. В светодиоде DUV используется специально разработанный слой блокировки электронов p-типа в сверхрешетке (p-EBL). Сверхрешетка p-EBL обеспечивает высокую концентрацию дырок в p-EBL, что, соответственно, увеличивает эффективность инжекции дырок в множественные квантовые ямы (MQW). Повышенная концентрация дырок в области МКЯ может более эффективно рекомбинировать с электронами, способствуя излучательной рекомбинации, что приводит к снижению уровня тока утечки электронов. В результате внешняя квантовая эффективность предлагаемой структуры DUV-светодиодов увеличивается на 100%, а структура DUV-светодиодов практически без провалов эффективности получается экспериментально.
Фон
Ультрафиолетовые лучи в режиме длин волн 200 ~ 280 нм нашли потенциальное применение в системах очистки воды [1, 2]. Учитывая низкое управляющее напряжение постоянного тока и большую совместимость с системой очистки воды, в качестве отличного кандидата были выбраны светодиоды глубокого ультрафиолета (DUV-светодиоды) на основе AlGaN. Стоит отметить, что для обработки воды большого объема требуется система очистки, обеспечивающая источник мощного УФ-излучения. Однако внешняя квантовая эффективность (EQE) для DUV-светодиодов на основе AlGaN с длиной волны излучения короче 280 нм в настоящий момент не выполняется [3]. Главный ограничивающий фактор для плохого EQE частично возникает из-за большой плотности пронизывающих дислокаций (TDD) в квантовых ямах с высоким содержанием алюминия [2, 3]. Внутренняя квантовая эффективность (IQE) быстро уменьшается, когда TDD составляет порядка 10 9 см −2 [3]. Даже если TDD уменьшится до 10 8 см −2 которые могут обеспечить IQE 60 ~ 80%, эффект падения эффективности может привести к тому, что EQE будет ниже 5% для неизолированных светодиодов UVC, когда плотность тока инжекции превышает 80 A / см 2 [4]. Отметим, что эффективность вывода света (LEE) для светодиодных чипов без покрытия UVC составляет ~ 10% согласно расчетам FDTD [5]. Одной из основных интерпретаций падения эффективности светодиодов на основе III-нитрида является перетекание электронов в слой инжекции дырок p-типа [6]. Слой с инжекцией дырок p-типа AlGaN с высоким содержанием алюминия имеет концентрацию свободных дырок даже ниже 1 × 10 17 см −3 [7], что приводит к более серьезному уровню утечки электронов. Mehnke et al. измерили паразитную эмиссию, которая имеет место в слое инжекции дырок p-типа, и паразитная эмиссия хорошо объясняется утечкой электронов [8]. Чтобы уменьшить утечку электронов из множественных квантовых ям (МКЯ), можно увеличить скорость захвата электронов, вставив одиночные игольчатые слои в квантовые барьеры [9]. Слои с пиками имеют состав Al выше, чем квантовый барьер, поэтому электрическое поле, индуцированное поляризацией в слоях пиков, может хорошо снизить скорость дрейфа электронов. Таким образом, улучшенная эффективность захвата возможна только в том случае, если светодиод DUV растет вдоль ориентации [0001]. Другим эффективным методом увеличения скорости захвата электронов является увеличение смещения зоны проводимости между квантовым барьером и квантовой ямой, что может быть реализовано за счет надлежащего увеличения состава Al [10], в то время как архитектура квантового барьера может быть дополнительно развита за счет того, что состав Al градуированный [11]. Как было упомянуто ранее, концентрация свободных дырок для слоя инжекции дырок AlGaN p-типа с высоким содержанием алюминия является низкой, что приводит к плохой способности инжекции дырок в область MQW. Плохая инжекция дырок также рассматривается как причина утечки электронов [12]. Перспективным методом увеличения термоэлектронной эмиссии дырок через слой блокировки электронов p-типа (p-EBL) является возбуждение дырок с помощью резервуара электрического поля [13]. Транспортировка дырок также может быть благоприятной, если слой инжекции дырок на основе p-AlGaN с алюминиевым составом ступенчатой конструкции используется для светодиодов DUV [14]. Композицию Al в ступенчатой обшивке можно дополнительно заменить составом градиента Al для слоя AlGaN, чтобы увеличить концентрацию отверстий [15,16,17]. Помимо создания слоя инжекции дырок, были предложены альтернативные p-EBL для уменьшения эффекта блокировки дырок, например, вставка тонкого слоя AlGaN с более низким содержанием алюминия [18]. Очень важной структурой для кандидата в p-EBL является сверхрешетка p-EBL. Были предприняты огромные усилия по изучению влияния сверхрешетки GaN / AlGaN на синие светодиоды на основе GaN [19,20,21]. Тем не менее, AlGaN p-EBL для синих светодиодов имеет состав AlN ниже 20%, что делает эффект блокировки отверстий для синих светодиодов не таким серьезным, как для светодиодов DUV. Следовательно, улучшение EQE составляет менее 20%, и падение эффективности все еще очевидно, даже если для синих светодиодов используется сверхрешетка p-EBL GaN / AlGaN. В светодиодах DUV используются p-EBL с высоким содержанием алюминия, что создает еще более сложную проблему впрыска дырок [1]. Чтобы решить проблему блокировки дырок, вызванную богатым алюминием p-EBL, для светодиодов DUV также предлагается сверхрешетка p-EBL, например сверхрешетка p-EBL AlInGaN / AlGaN [22] и сверхрешетка p-EBL AlGaN / AlGaN [23]. Однако экспериментальное подтверждение сверхрешеточного p-EBL, которое помогает получить EQE с высоким и почти без спадов КПД, на данном этапе отсутствует для светодиодов DUV. Таким образом, эта работа экспериментально демонстрирует эффективность специально разработанной сверхрешетки p-EBL AlGaN / AlGaN в улучшении EQE и значительном подавлении падения эффективности для светодиодов DUV. Улучшенный EQE хорошо объясняется улучшенной инжекцией дырок в область MQW, в то время как уменьшенный уровень утечки электронов помогает заметно подавить падение эффективности. Подробный механизм будет представлен в этой работе позже.
Методы / экспериментальные
Две архитектуры светодиодов DUV (светодиоды A и B, показанные на рис. 1) в этой работе выращены на шаблоне AlN с помощью системы химического осаждения из газовой фазы (MOCVD). Шаблон AlN толщиной 4 мкм выращивают на сапфировой подложке с ориентацией [0001] с использованием метода гидридной парофазной эпитаксии (HVPE). Выращиваем 20-периодный AlN / Al 0.50 Ga 0.50 N-сверхрешетка на шаблоне AlN, которая служит слоем снятия напряжения для выращиваемого впоследствии эпислоя. N-Al толщиной 2 мкм 0,60 Ga 0,40 Слой N с концентрацией электронов 1 x 10 18 см −3 выращивается для обеспечения электронов. Фотоны DUV генерируются пятипериодным Al 0,45 Ga 0,55 N / Al 0,56 Ga 0,44 N МКЯ, содержащие Al толщиной 3 нм 0,45 Ga 0,55 N квантовых ям и Al толщиной 12 нм 0,56 Ga 0,44 N квантовых барьеров. Затем MQW закрываются p-EBL на основе AlGaN толщиной 10 нм. В нашем эксперименте мы проектируем и выращиваем два типа p-EBL для светодиодов A и B соответственно. Светодиод A имеет значение Al 0,60 Ga 0,40 P-EBL на основе N и светодиод B имеет пятипериодный 1-нм Al 0,45 Ga 0,55 N / 1-нм Al 0,60 Ga 0,40 N-основанный p-EBL. Обратите внимание, наша петля p-EBL в сверхрешетке начинается с Al 0,45 Ga 0,55 Тонкий слой N после выращивания последнего Al 0,56 Ga 0,44 Квантовый барьер N. Таким образом, граница раздела последний квантовый барьер / сверхрешетка p-EBL поляризуется, давая индуцированные отрицательной поляризацией пластовые заряды, что помогает уменьшить накопление электронов на последнем квантовом барьере и дополнительно подавляет утечку электронов. После p-EBL следует 50 нм p-Al 0,40 Ga 0.60 Поставщик дырок N / 50 нм p-GaN. Наконец, слой p-GaN покрыт сильно легированным магнием p + толщиной 10 нм. -GaN слой. Пластины светодиодов DUV подвергаются термическому отжигу на месте при температуре 800 ° C в N 2 окружающей среды в течение 15 минут, чтобы расщепить связи H – Mg. Концентрация дырок тогда приблизительно оценивается как 1 × 10 17 см −3 и 3 × 10 17 см −3 для слоя p-AlGaN с высоким содержанием алюминия и слоя p-GaN соответственно.
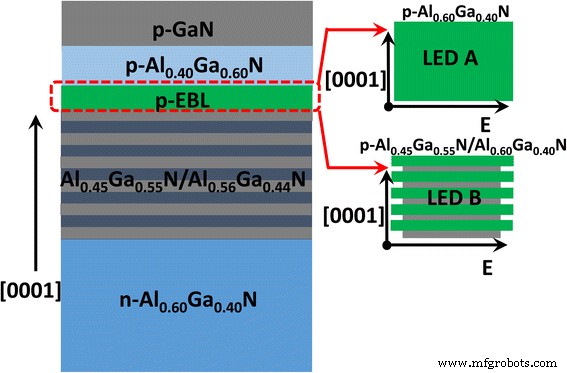
Схематические архитектурные конструкции исследуемых светодиодов. Также представлены схематические диаграммы энергетических зон для двух p-EBL:светодиод A имеет p-Al 0,60 Ga 0,40 EBL на основе N и светодиод B имеют p-Al 0,45 Ga 0,55 N / Al 0,60 Ga 0,40 N сверхрешетка EBL. P-Al 0,45 Ga 0,55 N / Al 0,60 Ga 0,40 N-сверхрешетка EBL специально разработана таким образом, чтобы инициировать образование тонкого p-Al 0,45 Ga 0,55 Слой N так, чтобы поверхность раздела для p-Al 0,45 Ga 0,55 N / Al 0,56 Ga 0,44 N последний квантовый барьер обладает отрицательными поляризационными интерфейсными зарядами. E означает уровень энергии.
Светодиодные пластины DUV превращаются в светодиодные чипы DUV в соответствии со стандартным процессом микротехнологии. Меза получается путем травления с индуктивно связанной плазмой (ICP), размер мезы составляет 650 × 320 мкм 2 . Пакет металла Ti / Al наносится на n-Al 0,60 Ga 0,40 N слой, который затем отжигается в N 2 в течение 1 мин при температуре 900 ° С. Токопроводящий элемент Ni / Au наносится на поверхность мезы, а затем отжигается в O 2 . в течение 5 мин при температуре 550 ° С. Наконец, мы наносим металлы Ti / Al / Ni / Au одновременно на сплав Ti / Al и токопроводящий слой Ni / Au, служащий n-электродом и отражающим p-электродом соответственно. Светодиодные чипы DUV представляют собой перекидные устройства, а фотоны DUV собираются со стороны сапфира с помощью интегрирующей сферы.
Чтобы лучше понять причину улучшенного EQE и подавленного спада эффективности, численные расчеты выполняются с использованием пакета APSYS [13, 18]. Важные физические параметры, которые используются для расчета событий рекомбинации носителей и потерь носителей, включают время рекомбинации Шокли-Рид-Холла (SRH), коэффициент рекомбинации Оже, коэффициент смещения энергетической полосы для интерфейсов AlGaN / AlGaN и уровень поляризации для [0001 ] -ориентированные структуры III-нитрида, которые установлены на 10 нс, 1 × 10 -30 см 6 s −1 , 50:50 и 40% соответственно [13, 18]. LEE установлен на 10% для светодиодных чипов DUV без покрытия с поглощающим слоем p-GaN толщиной 50 нм [5].
Результаты и обсуждения
Экспериментально измеренные спектры электролюминесценции (ЭЛ) при разном уровне плотности тока для светодиодов A и B представлены на рис. 2а. Спектры электролюминесценции собираются в импульсном режиме с рабочим циклом 0,1%, чтобы избежать эффекта саморазогрева. На рис. 2а показано, что максимальная длина волны излучения для обоих светодиодных устройств DUV составляет ~ 270 нм. Пиковая длина волны излучения стабильна в пределах испытанного диапазона тока из-за устранения эффекта самонагревания. Интенсивность электролюминесценции для светодиода B выше, чем для светодиода A. На рис. 2b показана зависимость оптической мощности и EQE от плотности тока инжекции, что показывает, что EQE увеличивается на ~ 90%. Кроме того, уровни падения эффективности составляют ~ 24 и ~ 4% для светодиодов A и B при уровне плотности тока 110 А / см 2 . соответственно [droop =( EQE макс - EQE Дж ) / EQE макс , в котором EQE макс и EQE Дж обозначают максимальный EQE и EQE при плотности тока Дж ]. На рис. 2в представлены численно рассчитанные плотность оптической мощности и EQE в терминах плотности тока инжекции. Результаты численных расчетов и результаты экспериментальных измерений хорошо согласуются друг с другом, так что светодиод B показывает улучшенный EQE и существенно сниженный уровень падения эффективности. Согласие между рис. 2b и 2c хорошо подтверждает физические модели и параметры, которые мы установили для вычислений.
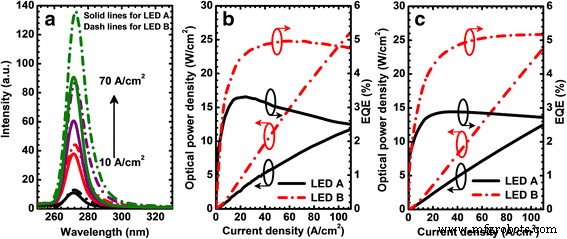
а Измерены спектры ЭЛ при плотности тока 10, 30, 50 и 70 А / см 2 . б Измерял оптическую мощность и эквалайзер. c Расчетная оптическая мощность и EQE для светодиодов A и B соответственно
Два светодиода DUV отличаются друг от друга только p-EBL. Следовательно, необходимо исследовать роль сверхрешетки p-EBL в улучшении оптических характеристик светодиода B. На рис. 3а представлены профили концентрации дырок в области МКЯ для светодиодов A и B при плотности тока 50 А / см 2 . Показано, что уровень концентрации дырок внутри МКЯ для светодиода B выше, чем для светодиода A. Как сообщалось, p-EBL снижает уровень утечки электронов, одновременно препятствуя инжекции дырок [24]. Полезный подход к уменьшению эффекта блокировки дырок состоит в увеличении концентрации дырок в области p-EBL, что затем помогает уменьшить высоту барьера валентной зоны [25]. На рисунке 3b показаны уровни концентрации дырок в p-EBL и p-Al 0,40 . Ga 0.60 N слоев для светодиодов A и B при плотности тока 50 А / см 2 . Средняя концентрация дырок в сверхрешетке p-EBL для светодиода B намного выше, чем для светодиода A, на два порядка. Большая концентрация дырок в сверхрешетке p-EBL хорошо объясняется отличным переносом дырок. Интересно, что если мы дополнительно посмотрим на рис. 3b, мы обнаружим, что концентрация дырок в p-EBL / p-Al 0,40 Ga 0.60 Интерфейс N становится ниже для светодиода A, что также отражает более гладкую эффективность впрыска дырок через сверхрешетку p-EBL для светодиода B.

Профили концентрации дырок, рассчитанные численно a в MQW и b в слоях инжекции дырок p-типа для светодиодов A и B соответственно; c экспериментально измеренные спектры ЭЛ в полулогарифмическом масштабе при плотности тока 10, 30, 50 и 70 А / см 2 для светодиодов А и В соответственно; г численно рассчитанные уровни концентрации электронов в слоях инжекции дырок p-типа для светодиодов A и B. Численно рассчитанные данные собираются при плотности тока 50 А / см 2
Как упоминалось ранее, эффективность светодиодов тесно связана с уровнем утечки электронов. Поэтому мы показываем измеренные спектры электролюминесценции светодиодов A и B в полулогарифмическом масштабе (см. Рис. 3c), чтобы указать подробную информацию о паразитной люминесценции. Пиковая длина волны излучения паразитной люминесценции находится в центре около 425 нм, что может быть связано с глубокими уровнями, связанными с легирующими добавками Mg [26]. Интенсивность паразитной люминесценции для светодиода B выше, чем для светодиода A, и предполагается, что больше носителей рекомбинируют на глубоких уровнях. В нашем эксперименте слои с инжекцией дырок p-типа для обеих архитектур светодиодов DUV не спроектированы, и уровень концентрации дырок в слоях с инжекцией дырок должен быть аналогичным. Таким образом, установлено, что электроны, которые покидают область МКЯ, имеют более высокую концентрацию в слое инжекции дырок для светодиода B, чем для светодиода A. Наши предположения дополнительно подтверждаются рис. 3d, на котором показаны профили концентрации электронов в p- прослойки дырочного типа для светодиодов A и B при плотности тока 50 А / см 2 . Это также означает, что ток утечки электронов был значительно снижен благодаря сверхрешетке p-EBL для светодиода B.
Затем мы представляем рассчитанные профили скорости излучательной рекомбинации для светодиодов A и B на рис. 4, которые получены при уровне плотности тока 50 А / см 2 . Предполагается, что скорость излучательной рекомбинации для светодиода B выше, чем для светодиода A, благодаря предложенной сверхрешетке p-EBL, которая еще больше способствует инжекции дырок в область МКЯ и тем временем подавляет уровень утечки электронов.
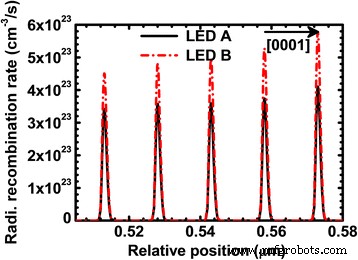
Вычисленные численно профили скорости излучательной рекомбинации для светодиодов A и B. Данные собираются при уровне плотности тока 50 А / см 2
На рисунках 5a и 5b показана энергетическая полоса вблизи p-EBL для обоих светодиодных устройств DUV. Энергетические зоны рассчитаны при плотности тока 50 А / см 2 . . Как сообщалось Zhang et al. [27], индуцированные сильной поляризацией положительные заряды на границе раздела последний квантовый барьер / p-EBL могут значительно притягивать электроны, вызывая высокую локальную концентрацию электронов. Высокая локальная концентрация электронов может уменьшить эффективную высоту барьера зоны проводимости ( Ø e ) для p-EBL, который составляет ~ 295 мэВ для светодиода A. Если в этой работе объемный p-EBL на основе AlGaN заменить на специфическую сверхрешетку p-EBL (т. е. петля сверхрешетки p-EBL начинается с тонкого слоя AlGaN с меньшей шириной запрещенной зоны, чем последний квантовый барьер AlGaN), зона проводимости для последнего квантового барьера названа вверх (см. рис. 5b), и это способствует обеднению электронами последнего квантового барьера, что затем увеличивает Ø e до ~ 391 мэВ и обеспечивает меньший уход электронов за счет термоэлектронной эмиссии [28]. Кроме того, сверхрешетка p-EBL облегчает процесс внутризонного туннелирования для дырок, в результате чего концентрация дырок в p-EBL также становится выше (см. Рис. 3b). Повышенная концентрация дырок в p-EBL для светодиодов. имеет тенденцию уменьшать эффективную высоту барьера валентной зоны ( Ø h ) [25], т.е. значения Ø h составляют ~ 324 мэВ и ~ 281 мэВ для светодиодов A и B соответственно при плотности тока 50 А / см 2 . Еще меньший Ø h для светодиода B, в свою очередь, способствует термоэлектронной эмиссии для отверстий. Стоит отметить, что сверхрешетка p-EBL также может вызывать внутризонное туннелирование для электронов. К счастью, улучшенная концентрация дырок в МКЯ может лучше поглощать электроны за счет излучательной рекомбинации, что также способствует уменьшению утечки электронов [12]. Из-за более предпочтительной инжекции дырок и еще более сильного тока рекомбинации, который создается процессом излучательной рекомбинации, происходящим в области МКЯ, прямое напряжение для светодиода B становится меньше, чем для светодиода A, как показано на рис. 5c.
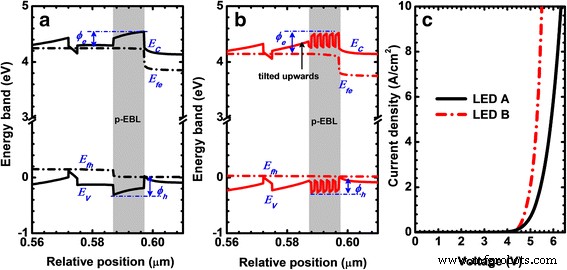
Вычисленные численно профили энергетических зон вблизи a объемный p-EBL на основе AlGaN для светодиодов A, b сверхрешетка p-EBL для светодиода B и c измеренная плотность тока с точки зрения приложенного смещения для светодиодов A и B. Данные для a и b рассчитаны при плотности тока 50 А / см 2 . E C , E V , Ø e , и Ø h обозначают зону проводимости, валентную зону и эффективную высоту барьера для зоны проводимости и валентной зоны соответственно
Выводы
Подводя итог, в этой работе сообщается о специальной сверхрешетке p-EBL для светодиодов DUV, которая может поддерживать как повышенную эффективность инжекции дырок, так и уменьшенную утечку электронов в слой пассивной инжекции дырок p-типа. Таким образом, как численно, так и экспериментально получены улучшенный EQE и заметно подавленное падение эффективности. Мы твердо верим, что предложенная структура светодиодов DUV очень многообещающая для реализации высокоэффективных светодиодов DUV, а физика устройства, раскрытая в этой работе, вводит большее понимание в оптоэлектронное сообщество на основе III-нитридов.
Сокращения
- APSYS:
-
Расширенные физические модели полупроводниковых приборов
- DUV:
-
Светодиоды глубокого ультрафиолета
- EL:
-
Электролюминесценция
- EQE:
-
Внешняя квантовая эффективность
- HVPE:
-
Гидридная парофазная эпитаксия
- ICP:
-
Индуктивно связанная плазма
- IQE:
-
Внутренняя квантовая эффективность
- LEE:
-
Эффективность отвода света
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- MQW:
-
Множественные квантовые ямы
- p-EBL:
-
слой блокировки электронов p-типа
- TDD:
-
плотность проникающих дислокаций
Наноматериалы
- Дизайн эмиссионного слоя для электронных умножителей
- Высокопроводящий слой PEDOT:PSS Transparent Hole Transport Layer с обработкой растворителем для высокоэффективных кремниевых /…
- Зеленый синтез квантовых точек InP / ZnS Core / Shell для применения в светоизлучающих диодах, не содержащих тяжелых м…
- Высокоэффективные солнечные элементы из инвертированного перовскита с квантовыми точками CdSe / слоем перенос…
- Электропроводящий нановолоконный композит TPU с высокой растяжимостью для гибкого датчика деформации
- Перовскитовые светодиоды высокой яркости с высокополярным спиртовым растворителем, использующие PEDOT:PSS как с…
- УФ-обработка низкотемпературных обработанных слоев переноса электронов SnO2 для планарных перовскитных солне…
- О слое распространения тока p-AlGaN / n-AlGaN / p-AlGaN для светодиодов глубокого ультрафиолетового излучения на основе…
- Теоретическая система трибоэлектрических наногенераторов контактного режима для повышения эффективности п…
- Влияние ширины квантовых ям на электролюминесцентные свойства светодиодов AlGaN, излучающих глубокий ультрафи…



