Аналоговое переключение и искусственное синаптическое поведение Ag / SiOx:Ag / TiOx / p ++ - Si Memristor Device
Аннотация
В этом исследовании, вставив буферный слой TiO x между SiO x :Слой Ag и нижний электрод, мы разработали мемристорное устройство с простой структурой Ag / SiO x :Ag / TiO x / p ++ -Si с помощью процесса физического осаждения из паровой фазы, в котором рост и разрыв нити можно эффективно контролировать во время аналогового переключения. Синаптические характеристики мемристорного устройства с широким диапазоном изменения сопротивления для модуляции веса за счет реализации положительных или отрицательных последовательностей импульсов были тщательно исследованы. Одновременно были достигнуты несколько функций обучения и памяти, в том числе потенцирование / депрессия, облегчение парных импульсов (PPF), краткосрочная пластичность (STP) и переход STP-to-LTP (долговременная пластичность), управляемый повторяющимися импульсами. чем репетиционная операция, а также пластичность, зависящая от времени всплеска (STDP). На основе анализа логарифмических ВАХ было обнаружено, что контролируемое выделение / растворение проводящих Ag-нитей в диэлектрических слоях может улучшить характеристики тестируемого мемристорного устройства.
Введение
В 2008 г. теоретическая концепция мемристора [1] стала реальностью, когда Струков и др. опубликовали свои исследования взаимосвязи между магнитным потоком и зарядом в TiO 2 на базе двух компактных оконечных устройств [2], что вызвало интерес исследователей во всем мире. Помимо различных потенциальных приложений, начиная от логических операций и реконфигурируемых радиочастотных систем до приложений энергонезависимой памяти [2, 3, 4], мемристоры также были исследованы для имитации биосинаптических функций из-за их схожей структуры и рабочей динамики. В настоящее время широко признано, что прямая эмуляция синаптических функций в электронном устройстве имеет решающее значение для разработки нейроморфных вычислительных систем, основанных на мозге [5,6,7]. Однако традиционно разработанные электронные синапсы основаны на дополнительных технологиях металл-оксид-полупроводник (CMOS), которые страдают от эффекта узкого места фон Неймана с точки зрения сложного процесса выполнения вычислений, пределов плотности интеграции и рассеивания энергии. Таким образом, использование настраиваемого двухполюсника открыло много многообещающих возможностей для разработки новых структур для электронных синапсов, которые являются результатом уникальных свойств мемристоров с энергонезависимыми характеристиками, наноразмерными размерами, низким энергопотреблением, более быстрым откликом и т. Д. . [8, 9].
В последнее время различные материалы (например, оксиды металлов, такие как ZnO 2 , WO x , SnO x [10, 11], халькогениды, такие как Cu 2 S, Ag 2 S [12, 13] и сегнетоэлектрические материалы, такие как La 2 О 3 , Pb 0,8 Ba 0,2 ZrO 3 [14, 15]) были исследованы для проектирования и изготовления мемристорных устройств. Для многих устройств изменение сопротивления приписывают индуцированной полем миграции кислородных вакансий или ионов металлов (например, Ag + , Cu 2+ , и Al 3+ ) и формирование пути с высокой проводимостью. Токопроводящий путь в мемристорах обычно называют «токопроводящей нитью (CF)», которая впоследствии может быть разорвана во время операции переключения. В общем, в мемристорах наблюдались два типа переключения:резкое (цифровое переключение) и постепенное (аналоговое переключение). Резкое изменение сопротивления соответствует цифровому сигналу (0 или 1), что полезно для хранения информации [16, 17].
В отличие от цифрового переключения, непрерывная перестройка проводимости мемристоров имеет некоторое сходство с биологическим синапсом, который является основной клеточной единицей для функций обучения и памяти в человеческом мозге [18]. В нескольких мемристорных устройствах реализованы аналоговые изменения проводимости, используемые для имитации модуляции веса биологических синапсов [19, 20]. Диффузионный Ag в мемристорах на основе a-Si и оксидов с Pt / a-Si:Ag / Pt и Pt / SiO x N y :Структуры Ag / Pt успешно имитируют Ca 2+ или Na + динамика в биосинапсах [21, 22]. Сходным образом, филаменты ионов кислорода / вакансий в мемристорах на основе оксидов металлов также были предложены для реализации синаптических функций, включая кратковременную потенциацию (STP) и облегчение парных импульсов (PPF) [23, 24]. Однако правила биологического обучения разнообразны, и до сих пор не все синаптические функции были задействованы в моделях мемристоров [16].
Помимо выбора материалов, контроль роста и разрыва филаментов путем вставки дополнительного диэлектрического слоя в структуру «металл / мемристивный слой / металл» дает определенные преимущества для имитации синаптических функций, включая STP и LTP, а также низкое энергопотребление. Недавно, чтобы контролировать скорость образования / разрыва проводящей нити, Wang et al. [25] продемонстрировали поведение аналогового переключения, вставив SiO 2 слой в TaO x на основе мемристора. Ван и др. [26] также реализовали аналоговое переключение и эмулировали функции STP и STDP, вставив слой восстановленного оксида графена в структуру Ag / SrTiO 3 / Мемристор FTO для контроля разрастания Ag-нитей. Более того, сообщалось [27, 28], что на основе знания TiO x материала с высокой диэлектрической проницаемостью (~ 40) и малой шириной запрещенной зоны (~ 3 эВ), характеристики мемристорного устройства с точки зрения долговечности и однородности цикла были значительно улучшены за счет введения TiO 2 тонкий слой с HfO 2 мемристический слой. Кроме того, сообщалось [24], что из-за низкой подвижности ионов и низкой скорости окислительно-восстановительной реакции TiO x Тонкая пленка также может действовать как буферный слой для предотвращения чрезмерного роста проводящей нити, обеспечивая лучшее синаптическое поведение и поддерживая хороший контакт с проводящей нитью во время процессов резистивного переключения.
В этой статье мы сообщаем о новой структуре Ag / SiO x :Ag / TiO x / p ++ -Si мемристорные устройства и их аналоговое переключение. По сравнению с однослойным устройством, о котором сообщалось ранее [22, 29], было обнаружено, что вставка TiO x Слой, как показано в приведенной выше структуре, действительно влияет на коммутационное поведение мемристорного устройства с точки зрения увеличения окна проводимости и поддержания стабильного состояния во время процессов переключения. Кроме того, проводимость мемристорного устройства можно легко настроить как для положительных, так и для отрицательных последовательностей импульсов, соответственно. Наши недавние результаты демонстрируют, что мы успешно получили надежное аналоговое переключение и должным образом имитируемые биосинаптические функции, такие как краткосрочная и долговременная пластичность (STP и LTP), функция облегчения парных импульсов (PPF), пластичность, зависящая от времени всплеска ( STDP), а также переход STP в LTP в Ag / SiO x :Ag / TiO x / p ++ -Си мемристорное устройство.
Методы
- i.
Изготовление устройства:как показано на рис. 1а, мемристор был разработан как Ag / SiO x :Ag / TiO x / p ++ -Si структура. П ++ -Si подложки (15 × 15 мм 2 ) с удельным сопротивлением около 0,01 Ом · см очищались стандартным методом, после чего на них изготавливались устройства. Все следующие процессы проводились при комнатной температуре в системе высокого вакуума. Сначала на p ++ был нанесен слой оксида титана толщиной ~ 10 нм. -Si-подложки с помощью высокочастотного магнетронного распыления с использованием высокочистой керамики TiO 2 цель. Затем SiO x толщиной ~ 95 нм :Слой Ag был нанесен методом совместного высокочастотного распыления с использованием SiO 2 мишень с небольшими кусочками серебра, размещенными на пути магнитного распыления. Во время процесса осаждения скорость потока и давление Ar поддерживались на уровне 50 sccm и 20 mTorr, соответственно, в то время как мощность RF поддерживалась на уровне 80 W. Наконец, на верхнем электроде (TE) слоя Ag толщиной ~ 30 нм был сформирован узор. с помощью фотолитографии и техники отрыва, в которой тонкие металлические слои осаждались с помощью магнетронного распыления постоянного тока. Диаметр отдельного электрода составляет около 150 мкм.
- ii.
Методы характеризации:для анализа микроструктуры SiO x были проведены измерения просвечивающей электронной микроскопии (ПЭМ) и рентгеновской фотоэлектронной спектроскопии (XPS). :Ag и TiO x слоев и химического состояния атомов Ag, соответственно, в которых образец ПЭМ был изготовлен сначала с использованием сфокусированного ионного пучка (FIB, FEI Nova Nano Lab 200), а затем наблюдался в системе ПЭМ FEI Phillips CM10-Supra. Электрические характеристики были выполнены с помощью полупроводникового анализатора (Keithley 2636B), подключенного к зондовой станции. Во время электрических измерений положительное и отрицательное смещения определялись током, протекающим между верхним и нижним электродами. Все электрические измерения проводились при комнатной температуре на воздухе.

Схема Ag / SiO x :Ag / TiO x / p ++ -Si мемристорный прибор и его поперечный ПЭМ-анализ. а Схематическое изображение устройства и аналогия между биологическим синапсом и электронным синапсом. б Поперечное сечение одного мемристорного блока из Ag / SiO x с помощью просвечивающего электронного микроскопа :Ag / TiO x / p ++ -Si структура. SiO x :Ag и TiO x тонкие пленки между Ag TE и p ++ -Si BE электроды. c Элементное отображение поперечного сечения устройства
Результаты и обсуждение
Схема устройства и измерительная конфигурация показаны на рис. 1а. Устройство имеет простую конструкцию, состоящую из SiO x :Ag и TiO x тонкие слои, зажатые между Ag TE и p ++ -Si BE, что подтверждается ПЭМ поперечного сечения мемристорной ячейки и элементным картированием, показанным на рис. 1b и c. Химическое состояние атомов Ag на поверхности SiO x анализируется XPS, как показано в Дополнительном файле 1:Рисунок S1. Спектр Ag3d для Ag деконволюционирован до одиночного дублета с энергией связи 368,0 эВ для Ag3d 5/2 и 374,0 эВ для Ag3d 3/2 , которые точно относятся к металлическому состоянию Ag. Изображение HRTEM в дополнительном файле 1:На рисунке S2 показано поперечное сечение аморфного TiO x слой, в то время как небольшие нанокластеры Ag видны в SiO x :Слой Ag, который, вероятно, вызван диффузией Ag во время процесса подготовки образцов для просвечивающей электронной микроскопии, чтобы минимизировать общую межфазную энергию системы материалов [22]. Кроме того, быстрое преобразование Фурье (БПФ) подтверждает, что нанокластеры Ag, внедренные в SiO x имеют поликристаллическую структуру, например нанокристаллы Ag (111) и Ag (002). В Ag / SiO x :Ag / TiO x / p ++ -Si мемристорное устройство Ag / SiO x :Ag и TiO x / p ++ -Si в качестве пресинаптической мембраны и постсинаптической мембраны, соответственно, как показано на рис. 1a. Синаптический вес изменяется за счет высвобождения Ca 2+ или Na 2+ ионы в промежутке между пре- и постсинаптическими мембранами, который пресинаптическая мембрана называет «щелью», когда принимаются нервные импульсы. Точно так же проводимость Ag / SiO x :Ag / TiO x / p ++ -Si мемристор может быть модулирован искусственно как электронный синапс за счет миграции ионов Ag под импульсами напряжения.
На рисунке 2а показана вольт-амперная кривая Ag / SiO x :Ag / TiO x / p ++ -Si мемристорный прибор в полулогарифмической шкале. При качающемся смещении 0 В → +4,0 В → −4,0 В → 0 В измеренная кривая ВАХ показывает сжатую петлю гистерезиса, которая является отпечатком мемристора. Когда к Ag TE применяется положительное смещение, постепенное увеличение тока до предела допустимого тока (I cc ), и состояние сопротивления устройства изменяется с состояния с высоким сопротивлением (HRS) на состояние с низким сопротивлением (LRS), что называется процессом «SET». Принимая во внимание, что когда к Ag TE применяется отрицательное смещение, происходит уменьшение тока, и состояние сопротивления возвращается в HRS из LRS, что называется процессом «RESET». Это указывает на то, что проводимость устройства может модулироваться соответственно положительным или отрицательным смещением развертки, демонстрируя биполярное резистивное переключение. Интересно, что вместо резкого увеличения или уменьшения тока во время процессов SET и RESET в режиме высокого напряжения ток устройства последовательно увеличивается или уменьшается при повторяющейся развертке напряжения 0 В → +2,1 В или 0 В → −2,1 В, как показано на рис. 2b. Зависимость тока и напряжения от времени (I-V-t) также представлена на вставке к рис. 2b, чтобы более четко показать изменения проводимости. Как и в биосинапсе, очевидная реакция устройства в виде эволюции тока вниз-вверх или вверх-вниз наблюдается после выполнения последовательных положительных (1-5) и отрицательных (6-10) частей кривых I-V соответственно. Непрерывное увеличение (или уменьшение) тока во время развертки положительного (или отрицательного) напряжения указывает на то, что сопротивление устройства может модулироваться в режиме развертки постоянного тока. Также наблюдается, что во время каждой последующей положительной или отрицательной развертки ВАХ выбирается там, где последняя остановлена, показывая типичную функцию аналогового переключения для мемристорного устройства. Долговечность мемристорного устройства может быть оценена путем реализации более широкого биполярного качающегося напряжения при напряжении считывания +0,3 В, как на рис. 2c, что показывает, что устройство может работать стабильно и равномерно между LRS и HRS во время установки / сброса. операция более 10 3 циклов.

ВАХ Ag / SiO x :Ag / TiO x / p ++ -Си мемристорное устройство. а Биполярное переключение b Повышение или понижение за счет повторения развертки напряжения. На вставке показана зависимость напряжения и тока от времени (V-I-t), демонстрирующая состояние проводимости во время потенцирования или депрессии. c Испытание на долговечность при считывании напряжения -0,3 В для 10 3 циклы более широкого диапазона биполярных разверток от 0 до +4,0 В для установки и от 0 до -4,0 В для сброса. г Повторяющиеся свойства модуляции проводимости
Мемристорное устройство также может работать с импульсными сигналами, а не с напряжением качания постоянного тока. На рисунке 2d показан отклик устройства в виде потенцирования или подавления после выполнения повторяющихся потенцирующих (положительное смещение) и подавляющих (отрицательное смещение) импульсов. Амплитуды импульсов потенцирования и подавления равны +1,2 В и -1,2 В соответственно, а длительность и интервалы всех импульсов фиксированы и равны 5 мс. Здесь модуляция проводимости в устройстве наблюдается независимо от положительного или отрицательного импульсного смещения, что похоже на синаптический ответ в форме потенцирования или депрессии под потенцирующим и подавляющим стимулом, соответственно. Очевидно, что реакция устройства может регулироваться от цикла к циклу в зависимости от количества импульсов стимуляции, что указывает на то, что для имитации регулировки веса и запоминания можно использовать стабильное и равномерное потенцирование и депрессию за пределами полярности приложенного смещения. усиление электронного синапса [30].
Для понимания поведения переключения анализируются механизмы проводимости путем подбора ВАХ. Для этого отдельный SiO x :Мемристор на основе тонкой пленки Ag со структурой Ag / SiO x :Ag / p ++ -Si тоже сфабрикован. Как показано на рис. 3a, реакция устройства на квазипостоянную развертку напряжения указывает на типичное поведение порогового переключения, о чем сообщалось ранее [29, 31]. Направления стрелок показывают, что устройство может переключаться между двумя состояниями как энергозависимая память. Однако ВАХ Ag / SiO x :Ag / TiO x / p ++ -Si мемристор показывает, что ситуация сильно отличается от автономного SiO x :Мемристорный прибор на основе Ag. На рис. 3b показано, что устройство демонстрирует биполярное переключение в аспекте LRS и HRS под положительной и отрицательной частью кривой I-V, тогда как рабочие напряжения относительно выше. На рисунке 3c показана ВАХ Ag / SiO x :Ag / TiO x / p ++ -Si мемристорное устройство, которое соответствует Ln (I) по сравнению с Ln (V) данных положительной области для HRS и LRS. Эти результаты подгонки показывают, что поведение переноса заряда в HRS согласуется с классическим механизмом ограниченной проводимости, ограниченным пространственным зарядом (SCLC), который состоит из трех частей:омической области (I / V) и области закона Чайлда (I / V 2 ) и области резкого увеличения тока [32]. В то время как линейное поведение в LRS, где наклон =1, указывает на отличное омическое поведение, как показано на рис. 3c. Различное поведение проводимости в HRS и LHR подтверждается образованием проводящей Ag-филамента в LRS [32]. Рисунок 3d также подтверждает, что резистивное переключение вызвано образованием / разрывом проводящей нити. Можно видеть, что хотя LRS устройства не зависит от размера ячейки устройства, HRS устройства пропорциональна размеру ячейки. Это независимое от размера свойство LRS обычно наблюдается в проводящих запоминающих устройствах на основе нити [33]. Таким образом, можно сделать вывод, что явление резистивного переключения в Ag / SiO x :Ag / TiO x / p ++ -Si мемристор обычно возникает в результате контролируемого образования / разрыва проводящей нити под действием положительного / отрицательного напряжения смещения. Постепенные изменения проводимости могут быть результатом изменения зазора в поперечном сечении между TE и BE под действием электрического поля, как и в других отчетах [34]. Таким образом, общее сопротивление устройства можно описать как R =Rij =V / I в соответствии с эквивалентной схемой, где Rij определяется как сопротивление, связанное с размером бокового зазора CF между TE и BE. Следовательно, если этот зазор можно отрегулировать путем изменения размера CF Ag между TE и BE с использованием подходящего запрограммированного смещения, то проводимость или сопротивление мемристивного устройства можно регулировать постепенно.

Анализ механизма проводимости Ag / SiO x :Ag / p ++ -Si и Ag / SiO x :Ag / TiO x / p ++ -Si устройства. а Линейная ВАХ Ag / SiO x :Ag / p ++ -Si и b Ag / SiO x :Ag / TiO x / p ++ -Si устройство. c Механизмы проводимости соответствуют SCLC в HRS и омической в LRS для Ag / SiO x :Ag / TiO x / p ++ -Si устройство в соответствии с результатами подгонки положительного участка ВАХ в ( b ). г Зависимость проводимости от площади ячейки в LRS или HRS
Соответствующая физическая модель также представлена на рис. 4 для интерпретации механизма переключения в автономном SiO x :Ag и SiO x :Ag / TiO x мемристорные устройства. Поведение наночастиц Ag в SiO x клетки на основе могут быть интерпретированы на основе электрохимических реакций (миграция и накопление ионов Ag и атомов Ag) между биполярными электродами, аналогично тому, как сообщалось ранее [22, 35]. Когда прикладывается напряжение развертки, наночастицы Ag растут дальше, перекрывая зазор между электродами, что приводит к резкому увеличению тока до уровня податливости, и мемристор включается в LRS (как показано на средней панели рис. 4а). После устранения электрического смещения удлиненные нанокластеры Ag, которые раньше сформировали мостик, теперь быстро сжимаются [22], и устройство возвращается в режим HRS (как показано на последней панели рис. 3a) [35], указывая на биполярное пороговое переключение. поведение мемристора, которое может переключаться между двумя состояниями, как в устройствах энергозависимой памяти.
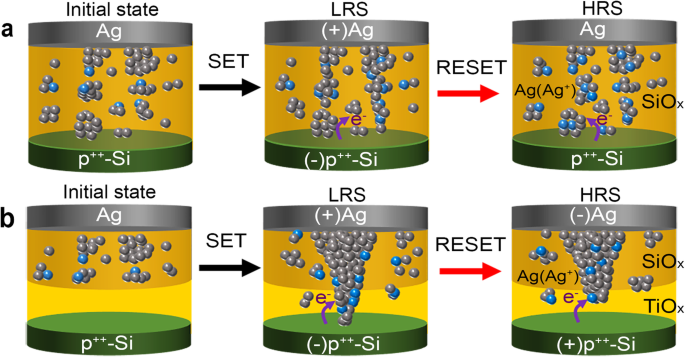
Принципиальная схема физической модели поведения переключения. а Ag / SiO x :Ag / p ++ -Си мемристорное устройство; б Ag / SiO x :Ag / TiO x / p ++ -Si мемристорное устройство
Совершенно иная ситуация в случае SiO x :Ag / TiO x -на основе мемристорного устройства, где SiO x тонкий слой имеет широкую запрещенную зону (~ 9 эВ) и более низкую диэлектрическую проницаемость (~ 3), но TiO x слой имеет малую ширину запрещенной зоны (~ 3 эВ) и высокую диэлектрическую проницаемость (~ 40), что делает электрическое поле на SiO x слой выше, чем у TiO x слой, растворяющий больше атомов Ag в переключающем слое [28]. Это низкая подвижность ионов и низкая скорость окислительно-восстановительной реакции оксида титана, которые контролируют миграцию и накопление атомов Ag и иона Ag через межфазный слой [36]. Эти два факта, как упоминалось выше, могут вызывать образование нити в форме наноконуса от TE к BE [37]. Концентрированная металлическая область в форме эффективного ограничения роста волокна в форме наноконуса от TE до BE может обеспечивать управление состояниями сопротивления во время циклической операции [38]. Когда верхний электрод Ag имеет достаточно положительное смещение через двойные слои, электрического поля на диэлектрических слоях достаточно, чтобы направить ионы Ag из Ag TE в p ++ -Si BE через межфазный слой, что приводит к уменьшению эффективного зазора между электродами (как показано на средней панели рис. 4b). Нити Ag не растворяются, если не применяется отрицательное напряжение, и имеют тенденцию сохранять свою первоначальную форму даже при снятии напряжения смещения. Когда прикладывается отрицательное напряжение, начинается нормальный сброс, и CF Ag частично разрушаются (обычно в самом тонком месте) из-за электрохимического процесса с термической поддержкой [39]. Мемристор выключается и возвращается в режим HRS (последняя панель фиг. 4b), а затем обратимо циклически переключается между двумя состояниями (показанными на фиг. 3b) в качестве энергонезависимого запоминающего устройства. На левой панели рис. 4b показано, что сформированные здесь волокна должны быть толще, чем волокна на средней панели рис. 4а, которые не могут быть растворены и разорваны, пока не будет приложено отрицательное напряжение. Филаментная часть в SiO x слой все еще намного тоньше, чем у части наноконуса в TiO x слой, а форма всей нити чем-то похожа на наноконус. Таким образом, когда применяется отрицательное смещение, нить накала будет быстро разорвана при приложении отрицательного напряжения (рис. 3b), тогда как напряжение будет еще больше увеличиваться, а ток снова увеличивается, что указывает на риск отрицательного SET при высоком смещении. диапазон из-за остаточных атомов Ag, существующих у поверхности BE.
Фактически, полное сопротивление мемристора в HRS просто связано с зазором между концом нити наноконуса и нижним электродом, который можно увеличивать или уменьшать, регулируя электрическое смещение [33]. Эту тенденцию к изменению HRS в мемристорах можно увидеть на рис. 2b, на котором ток может увеличиваться или уменьшаться последовательно при повторяющемся смещении развертки от 0 В до +2,1 В и от 0 В до -2,1 В, соответственно. С другой стороны, постоянного скачка напряжения ниже +2,1 В недостаточно для образования проводящей нити накала между TE и BE. Вместо этого проводящая нить Ag может постепенно накапливать атомы Ag, что приводит к уменьшению эффективного зазора между электродами, как показано в Дополнительном файле 1:Рисунок S3. Следовательно, с помощью подходящего программного смещения может быть реализован переход от типичного порогового переключения к постепенному переключению, а общее сопротивление ячейки памяти может быть настроено путем регулирования эффективного зазора между электродами, как это можно наблюдать в биологическом синапсе.
Подобно биосинапсу, входные стимулы с подходящим программированием импульсов могут изменять состояние проводимости мемристорного устройства для выполнения нескольких нейронных задач. PPF - еще одна важная функция, которая может регулировать проводимость путем временного суммирования входных стимулов и выполнять несколько краткосрочных нейронных задач, включая синаптическую фильтрацию и адаптацию [40, 41]. Функция PPF в биосинапсе работает следующим образом:второй постсинаптический ответ становится выше, чем первый во время двух последовательных спайковых стимулов, оставляя время интервала спайков меньше, чем время восстановления [22]. На рисунке 5a показан отклик устройства, который отслеживается после реализации пары вспомогательных импульсов с амплитудой +2,0 В с фиксированной шириной и интервалом, названной шкалой 0,08 с. Наблюдается заметное увеличение тока в ответ на второй импульс, чем на первый, что указывает на очевидное изменение состояния проводимости после реализации подходящего программирования импульсов. В промежутке между двумя последовательными импульсами наблюдается спад тока, что можно объяснить наличием в приборе нестабильного характера. Спад проводимости может соответствовать диффузии атомов Ag после снятия потенцирующего импульса [42]. Успешная функция PPF может быть выполнена только тогда, когда временной интервал между двумя последовательными импульсами меньше, чем время диффузной релаксации атомов Ag, в результате чего большее количество атомов Ag проталкивается в SiO x :Ag / TiO x слой. Более того, состояние насыщения достигается, когда устройство непрерывно стимулируется рядом стимулирующих импульсов с амплитудой +2,0 В и фиксированной шириной и интервалом, названными шкалой 0,08 с, как показано на рис. 5b. Результаты показывают, что, когда применяются высокочастотные импульсы, которые накачивают больше атомов Ag в SiO x слой до тех пор, пока не образуется проводящий мост между TE и BE, достигая уровня насыщения [22]. Это явление очень похоже на правило обучения Хебба, согласно которому изменения синаптического веса должны иметь насыщенное значение, чтобы избежать чрезмерной возбудимости нейронов с применением неокрашенных пиков последовательности импульсов [43].
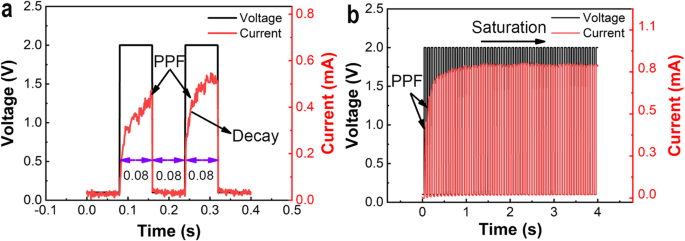
Экспериментальные результаты облегчения парных импульсов (PPF) . а Реализация PPF на Ag / SiO x :Ag / TiO x / p ++ -Si устройство, использующее импульс +2,0 В с длительностью 0,08 с. б Демонстрация движения насыщения синаптического веса с использованием серии импульсов амплитудой +2,0 В с той же шириной и интервалом 0,08 с
Более того, как и в биологическом синапсе, мемристор будет страдать от потери памяти из-за внезапного уменьшения тока после реализации потенцирующего спайка, что можно объяснить наличием STP в мемристоре [44, 45]. В нейробиологии STP и LTP обычно называют кратковременной памятью (STM) и долгосрочной памятью (LTM) [46]. Установлено, что переход от STP к LTP может происходить через повторяющиеся стимулы (т. Е. В процессе репетиции) [46, 47]. Чтобы проверить и сравнить это поведение с тем, что наблюдается в биологических синапсах, в наш Ag / SiO x была применена последовательность импульсов напряжения. :Ag / TiO x / p ++ -Si мемристорные устройства. На рис. 6а показано увеличение тока от исходного состояния 0,05 мА до 1,8 мА после выполнения 15 последовательных импульсов (амплитуда +1,4 В, ширина и интервал 5 мс). Нормализованное затухание тока ((I t -I o ) / Я o × 100%) измеряется при считываемом напряжении +0,3 В сразу после наложения потенцирующих импульсов со временем ( t ), как показано на рис. 6б. Связь между нормализованным затуханием тока и временем хорошо подогнана соотношением, приведенным в формуле. (1) [48]:
$$ {\ Delta I} _t / {\ Delta I} _o \ times 100 \% =\ exp \ left [- {\ left (t / \ tau \ right)} ^ {\ beta} \ right] $$ ( 1)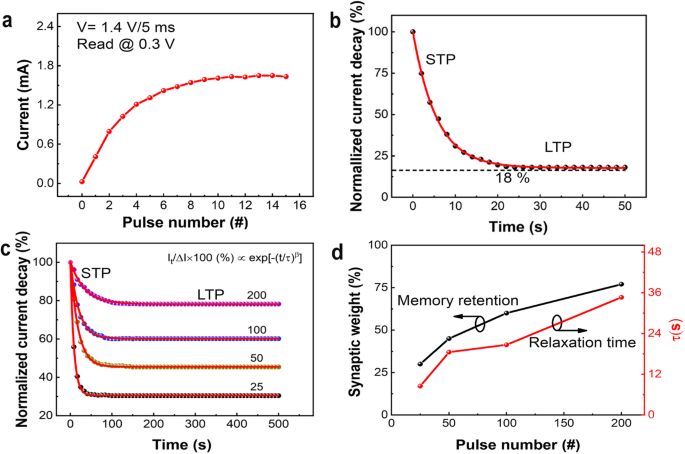
Текущий распад и сохранение памяти в Ag / SiO x :Ag / TiO x / p ++ -Si мемристор. а Увеличение тока после выполнения 15 последовательных потенцирующих идентичных импульсов. б Спад тока отслеживают при считывающем напряжении +0,3 В после стимуляции устройства. c Нормализованное затухание тока в зависимости от времени, показывающее переход от STP к LTP после выполнения последовательности импульсов, равной количеству стимуляции. г Время сохранения памяти и время релаксации ( τ ) для количества импульсов
здесь τ называется временем релаксации, а β называется индексом растяжения (0 < β <1). Обычно это соотношение используется для описания релаксационных процессов в неупорядоченных материалах со случайным распределением энергии. Кривая показывает, что уменьшение синаптического веса похоже на «кривую забывания» человеческой памяти в психологии [49], которая вначале характеризуется быстрым спадом, который можно было бы назвать STP, а затем постепенно достигает стабильного уровня, который можно было бы назвать LTP. в устройстве. Однако очевидное затухание нормированного тока в устройстве наблюдается за очень короткий промежуток времени ( t ), а затем достигает уровня насыщения в состоянии низкой проводимости (до 16% за 50 с). В этой ситуации, без каких-либо других изменений параметров импульса, мы выполнили дальнейший процесс моделирования с повторяющимся числом импульсов. The current is measured at a read voltage of +0.3 V immediately after imposing different numbers of pulses (i.e., 25, 50, 100, and 200) from the same initial state for each set of pulse trains. Figure 6c shows that the normalized current decay with time in each set of measurements is fitted by the relation given in Eq. (1). Figure 6d shows that by an increase of the stimulation number, the relaxation time (τ ) increases, indicating forgetting process fades slowly. Meanwhile, an obvious elevation of the current level is observed, implying a positive change in synaptic weight (conductance), as shown in Fig. 6d by the black line. These results presented in Fig. 6 provide clear evidence of the existence of STP and LTP in our device. A smaller number of stimulations can only induce STP in the device, with a slight rise in conductance at saturation level. Therefore, by increasing the number of repetitive stimulations, the rehearsal process not only rises a conductance level but also is achieved a long-lasting memory retention phenomenon, as shown in Fig. 6d by the red line.
The conventional digital-type memories require the non-volatility to store the information, while in bio-synapse, information processes and accordingly reconfigures the memory status. It can be seen in Fig. 6 that the transition from STP to LTP is realized, and the synaptic weight is adjusted accordingly, while the unimportant ones with small synaptic weight are temporarily stored and then diminished with time. This phenomenon is quite similar to the “multi-store model” presented by Atkinson and Shiffrin [50]. In this model, first input information is analyzed, then stored in different hierarchy levels, according to the importance of “synaptic weight” through the rehearsal process. Therefore, an increase in synaptic weight and resultant prolonged relaxation time (τ ) in our device as a function of stimulation numbers has best verified the rehearsal scheme.
Besides the pulse repetition process, the transition of the STP to the LTP phenomenon is further examined as a function of pulse strength. The device response is monitored after implementation of different pulse amplitudes, i.e., +1.2 V, +1.6 V, +2.0 V, and +2.8 V with similar width and interval scale of 3 ms, as shown in Fig. 7a. The current is monitored with a readout voltage of +0.3 V after imposing each pulse train consisting of 50 pulses. The fitted results with the stretched exponential relaxation model in Fig. 7a shows that the relaxation time is increased as a function of pulse strength (as shown in Fig. 7b red line). Meanwhile, as shown in Fig. 7b, an elevation of the synaptic weight of about 90% is observed at a larger τ of 43 s and +2.8 V amplitude, which is much higher than the synaptic weight of about 25% at a smaller τ of 10 s and +1.2 V amplitude (as shown in Fig. 7b black line), indicating the formation of LTP. Based on these results, it is easy to find that the formation and persistence of LTP in our device are highly dependent on both pulse numbers or pulse amplitude. These results coincide with the facts that the memory states, i.e., STM and LTM, and their stabilities in bio-synapses are related to the input stimulus characteristics.
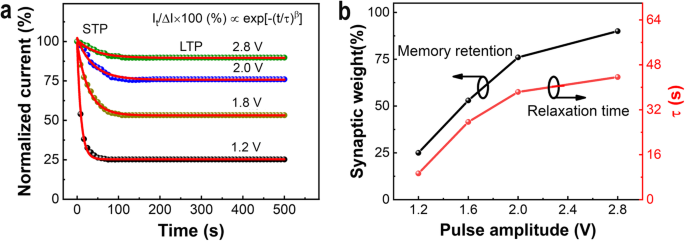
Experimental results of current decay in Ag/SiOx :Ag/TiOx /p ++ -Si memristor device after the stimulation process. а The normalized current decay versus time showing the transformation from STP to LTP; б The memory retention and relaxation time (τ ) as a function of the pulse amplitude
The spike-time-dependent-plasticity (STDP) is another fundamental character for learning and memory function [51] in a biological synapse. It has been reported [52] that in the electronic synapse, the weight can be modulated by a relative timing of pre- and post-synaptic pulses. The Hebbian STDP rule works as follows:if the pre-spike precedes the post-spike (Δt> 0), it could reinforce the connection strength between two neurons. In contrast, if the post-spike heads the pre-spike (Δt <0), it could weaken the connection strength between two neurons. Such kinds of reinforcement and weakening of connection strength between two neurons are also called LTP and LTD, respectively [45]. In the whole process, the order of pre- and post-spikes with respect to time determines the weight change (ΔW) polarity. In order to emulate the STDP rule in our device, a pair of pulses (+1.2 V, 5 ms, and −1.2 V, 5 ms) as pre- and post-spiking signals are implemented, as shown in Fig. 8a. It can be seen that there will emerge a more considerable conductance change (synaptic weight) with the decrease of Δt (in both cases when Δt> 0 and Δt <0). The percentage change in synaptic weight is defined as ΔW =(Gt −G0 )/G0 × 100%. Here, G0 is the conductance measured before stimulation and Gt is the conductance measured after the stimulation using pre- and post-spiking pairs, respectively. A plot is shown in Fig. 8b, that can explain the relationship between ΔW and Δt before and after the simulation process. It can be seen that when the pre-synapse (positive) appears before the post-spike (negative) (Δt> 0), the conductance is enhanced with an increase in ΔW along with the decrease in Δt. On the contrary, when the pre-synapse (positive) appears after the post-spike (negative) (Δt <0), the net conductance of the device is decreased (depressed) in ΔW along with the increase in Δt. These results have demonstrated that our Ag/SiOx :Ag/TiOx /p ++ -Si memristor device has successfully emulated the Hebbian STDP learning rule in the form of an artificial synapse.
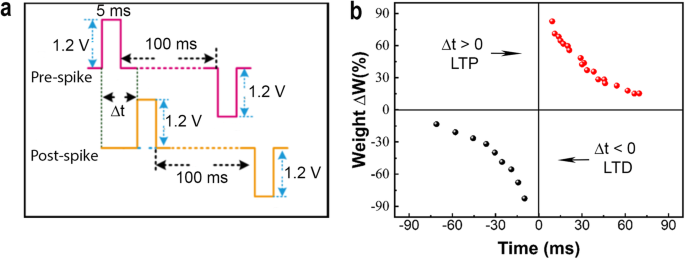
Experimental results for implementation of STDP rule in Ag/SiOx :Ag/TiOx /p ++ -Si memristor device. а The schematic illustration of implementing electrical programming bias comprising the pair of pulses at amplitudes +1.2 V and −1.2 V fixed with the same width of 5 ms. The approaching time difference between stimulus pulses is Δt ms (t =±10n, n =1, 2, …, 10); б The synaptic weight (ΔW) as a function of spike timing (Δt), demonstrating well on the potentiation and depression behaviors in the memristor device
Выводы
In summary, a new kind of memristor device with the simple structure of Ag/SiOx :Ag/TiOx /p ++ -Si has been fabricated by a physical vapor deposition process. The synaptic characteristics of the memristor with a wide range of resistance change for synaptic weight modulation by implementing positive or negative pulse trains have been investigated extensively. Several crucial learning and memory functions have been demonstrated simultaneously in such a single fabricated memristor device, including short-/long-term potentiation and depression (STP/STD, LTP/LTD), PPF and the STP-to-LTP transition as well as STDP, which are adjusted and controlled by repeating pulses more than a rehearsal operation. Furthermore, the analysis of logarithmic I-V characteristics with corresponding physical model indicates that the controlled formation/dissolution of Ag-filaments across the Ag and p ++ -Si electrodes could improve the performance of the new Ag/SiOx :Ag/TiOx /p ++ -Si memristor device with a buffer layer of TiOx between the SiOx :Ag layer and the bottom electrode. This developed device, as an artificial synapse, might bring a potential research prospect in the design and hardware implementation of new-generation biomimetic neural networks and computing systems.
Доступность данных и материалов
Все данные полностью доступны без ограничений.
Сокращения
- BE:
-
Нижний электрод
- HRS:
-
Состояние высокого сопротивления
- I-V:
-
Ток-напряжение
- LRS:
-
Состояние низкого сопротивления
- LTM:
-
Long-term memory
- LTP:
-
Long-term plasticity
- PPF:
-
Paired-pulse-facilitation
- SCLC:
-
Space-charge limited conduction
- STDP:
-
Spike-time-dependent-plasticity
- STM:
-
Short-term memory
- STP:
-
Short-term plasticity
- TE:
-
Верхний электрод
- ТЕМ:
-
Просвечивающая электронная микроскопия
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
Наноматериалы
- Аналоговые и цифровые сигналы
- Типы аналоговых и цифровых датчиков с приложениями
- Двойные функции устройства V / SiOx / AlOy / p ++ Si в качестве селектора и памяти
- Влияние вариаций травления на формирование каналов Ge / Si и производительность устройства
- Влияние двухслойных гетероструктур CeO2 − x / ZnO и ZnO / CeO2 − x и полярности электроформования на коммутационные свой…
- Улучшенный поглотитель ближнего инфракрасного диапазона:двухэтапный структурный черный кремний и его приме…
- Улучшенные чувствительные к видимому свету фотокаталитические свойства нанолистовых композитов Ag / BiPbO2Cl
- Многофункциональное устройство с переключаемыми функциями преобразования поглощения и поляризации в тераг…
- Искусственный интеллект предсказывает поведение квантовых систем
- Преимущества и недостатки искусственного интеллекта



