Исследование азотирования при выравнивании полосы на интерфейсах MoS2 / HfO2
Аннотация
Влияние азотирования на выравнивание полос между многослойным MoS 2 и HfO 2 был исследован методом рентгеновской фотоэлектронной спектроскопии. Смещения валентной зоны (проводимости) MoS 2 / HfO 2 с обработкой азотированием и без него составили 2,09 ± 0,1 (2,41 ± 0,1) и 2,34 ± 0,1 (2,16 ± 0,1) эВ, соответственно. Настраиваемое выравнивание полосы может быть связано с образованием связи Mo-N и изгибом полосы на поверхности для HfO 2 инициируется азотированием. Это исследование инженерии энергетических зон MoS 2 / HfO 2 гетеропереходы также могут быть распространены на другие диэлектрики с высоким k для интеграции с двумерными материалами для разработки и оптимизации их электронных устройств.
Фон
В настоящее время слоистые дихалькогениды переходных металлов (TMDC) вызывают большой интерес из-за их захватывающих свойств для потенциальных приложений в современной электронике и оптоэлектронике [1, 2]. В частности, дисульфид молибдена (MoS 2 ) привлекает значительное внимание как многообещающий материал канала для продолжения масштабирования за пределы технологического узла 7 нм [3, 4]. Конструктивно MoS 2 Кристалл состоит из одной гексагонально расположенной плоскости Мо, зажатой двумя гексагонально расположенными S-плоскостями. Треугольное призматическое расположение образовано ковалентно связанными звеньями S-Mo-S [5, 6]. MoS 2 обладает зависимой от слоя шириной запрещенной зоны, отличающейся от прямой запрещенной зоны (1,8 эВ) для однослойного (SL) MoS 2 к непрямой запрещенной зоне (1,2 эВ) для объемного MoS 2 [7]. В отличие от графена с нулевой шириной запрещенной зоны, модуляция ширины запрещенной зоны в зависимости от толщины послужила стимулом для исследования MoS 2 в оптических и электрических приборах [3, 8]. На основе физики MoS 2 , плотность состояний многослойного MoS 2 втрое больше, чем однослойный MoS 2 , что приводит к высоким токам возбуждения в баллистическом пределе [8]. В этом контексте малоуровневый MoS 2 может дать значительные преимущества для транзисторных приложений, чем SL MoS 2 [3].
С другой стороны, электронные устройства на основе традиционных диэлектриков из диоксида кремния приближаются к физическому пределу из-за своей низкой диэлектрической проницаемости [9]. Чтобы получить тонкую эквивалентную толщину оксида (EOT), критически важно интегрировать диэлектрики с высоким k с MoS 2 . На сегодняшний день многие диэлектрики high-k были исследованы с использованием MoS 2 , в том числе Al 2 О 3 , ZrO 2 , HfO 2 , и h-BN [10,11,12,13,14]. DiStefano et al. получили соответствующие смещения зоны проводимости и валентной зоны 3,3 ± 0,2 и 1,4 ± 0,2 эВ для многослойного MoS 2 выращены методом напыления оксида на аморфный BN [13]. Тао и др. сообщил, что смещение зоны проводимости (CBO) для монослоя MoS 2 / Al 2 О 3 (ZrO 2 ) гетеропереход составил 3,56 эВ (1,22 эВ), а смещение валентной зоны (VBO) составило 3,31 эВ (2,76 эВ) [15]. И CBO 2,09 ± 0,35 эВ и VBO 2,67 ± 0,11 эВ на MoS 2 / HfO 2 о интерфейсе сообщили McDonnell et al. [12]. Среди этих затворных диэлектриков HfO 2 считался одним из наиболее многообещающих кандидатов из-за его высокой диэлектрической проницаемости (k ∼ 20), совместимости с затвором из поли-SiGe, TaN и затвором из поликристаллического кремния [16]. Однако HfO 2 имеет плохую термическую стабильность, большой ток утечки, высокую плотность ловушек для оксидов, плотность ловушек на границе раздела фаз и т. д. [17]. Эти ограничения побудили к обширным исследованиям поисковых методов пассивации, таких как технологии азотирования границ раздела или фторирования [18, 19]. В этой работе мы изучили выравнивание энергетических зон многослойного MoS 2 на HfO 2 диэлектрики с плазменным азотированием и без него, в которых эффект поверхностного азотирования был охарактеризован методом рентгеновской фотоэлектронной спектроскопии (XPS).
Методы
SiO 2 Пластина (280 нм) / Si поочередно очищалась ацетоном и изопропанолом путем ультразвуковой очистки каждые 10 мин с последующей промывкой деионизированной водой и N 2 сухой. Многослойный MoS 2 пленки были нанесены на SiO 2 / Si подложка методом химического осаждения из паровой фазы (CVD) с использованием прекурсоров MoO 3 (0,08 мг, 99%, Alfa Aesar) и порошок S (1 г, 99%) [20, 21]. После процедуры роста MoS 2 фильм будет переведен на HfO 2 / Si методом полиметилметакрилата (ПММА) [22], как показано на рис. 1а. В этом процессе ПММА был впервые нанесен центрифугированием на MoS 2 . / SiO 2 / Si в качестве опорного слоя. Затем образцы погружали в раствор КОН для стравливания SiO 2 . , после чего MoS 2 слой с ПММА всплывет на поверхность раствора. В конце концов, слой ПММА будет растворен в ацетоне после того, как образец будет перенесен на HfO 2 . / Si подложка. HfO 2 пленки были выращены на кремниевой пластине методом атомно-слоистого осаждения (ALD) при температуре 200 ° C с использованием Hf [N (CH 3 ) (С 2 H 5 )] 4 [тетракис (этилметиламидо) гафний, TEMAH] и H 2 Пары O как прекурсоры [23, 24]. Во время процесса оптимизации времени плазменной обработки было обнаружено, что азот будет сильно диффундировать в оксид после 70-секундной обработки азотированием по измерениям SIMS, что серьезно ухудшит качество оксида. Хотя время плазменной обработки составляет 30 с, по результатам ВИМС не наблюдалось явного пика азота на поверхности оксида. Для контрольного образца 50 с N 2 плазменная обработка проводилась на HfO 2 / Si под давлением 3 Па перед MoS 2 перечислить. В плазме результирующая доза азота составляет примерно 8,4 × 10 14 атомов / см 2 оценивается по результатам масс-спектрометрии вторичных ионов (ВИМС). Концентрация азота была рассчитана примерно на 1,5% после азотирования на основе данных XPS. Для измерений XPS были подготовлены четыре образца 1–4 #:1 # многослойный MoS 2 фильм на SiO 2 / Si подложка (многослойный MoS 2 ), HfO толщиной 2 # 2 пленка на подложке Si (объемный HfO 2 ), 3 # перенесено MoS 2 пленка на выращенном HfO 2 Подложка / Si (выращенный MoS 2 / HfO 2 гетеропереход), и 4 # передано MoS 2 фильм на N 2 обработанный плазмой HfO 2 / Si подложка (азотированный MoS 2 / HfO 2 гетеропереход).
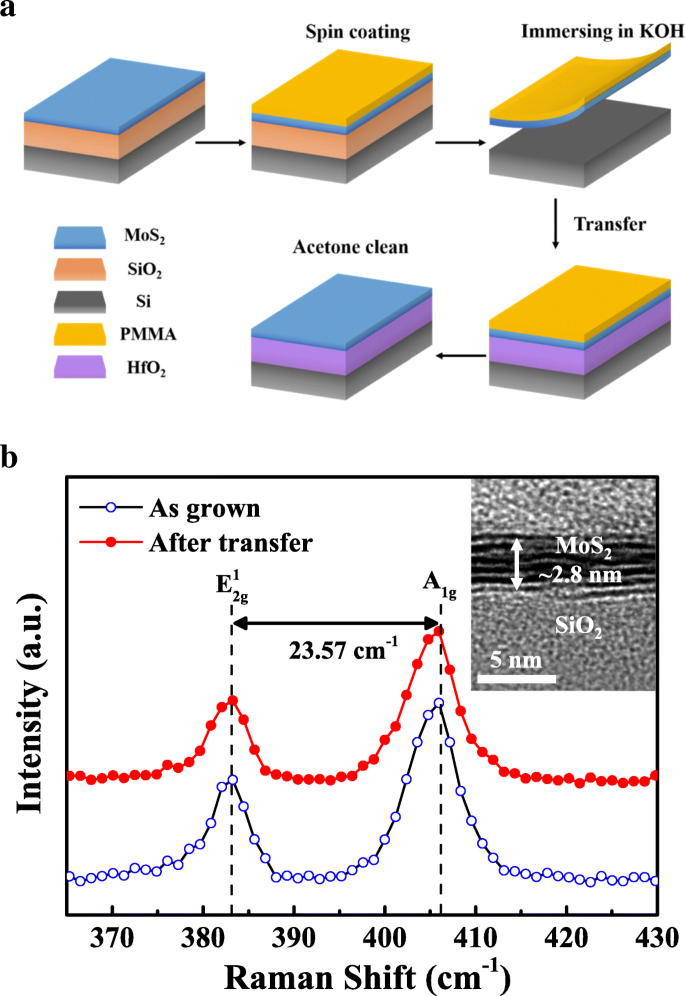
а Технологическая схема метода мокрого переноса с использованием ПММА для MoS 2 / ALD-HfO 2 образование гетеропереходов. б Соответствующие рамановские спектры выращенного и перенесенного MoS 2 фильм. На вставке - изображения сечения выращенного MoS 2 , полученные с помощью просвечивающей электронной микроскопии. на SiO 2 / Si подложка
Результаты и обсуждения
Рамановская спектроскопия inVia RENISHAW была использована для характеристики рамановских спектров многослойного MoS 2 пленка до и после процедуры переноса, как показано на рис. 1b. Два пика комбинационного рассеяния можно увидеть на расстоянии около 382,86 см −1 . и 406,43 см −1 , соответствующие плоскости (\ ({E} _ {2g} ^ 1 \)) и внеплоскостной ( A 1 г ) соответственно [25, 26]. Было обнаружено, что рамановский сдвиг почти отсутствует в \ ({E} _ {2g} ^ 1 \) и A 1 г частоты режимов после процесса передачи, указывающие на минимальную модификацию конструкции. Разность частот ( ∆k ) между \ ({E} _ {2g} ^ 1 \) и A 1 г мода была определена как около 23,57 см −1 , обозначая от четырех до пяти слоев MoS 2 фильм [27]. Как показано на вставке к рис. 1b, толщина MoS 2 Пленка была подтверждена с помощью просвечивающего электронного микроскопа высокого разрешения (HRTEM) примерно на 2,8 нм, что согласуется с вышеупомянутыми спектрами комбинационного рассеяния. Кроме того, мы представили профили глубины SIMS перенесенного MoS 2 пленка на азотированном HfO 2 / Si подложка. Измерение SIMS проводилось на приборе Physical Electronics ADEPT 1010 SIMS с пучком первичных ионов Cs при энергии 1 кэВ, в котором собирались положительные ионы и выполнялась компенсация заряда. В этом измерении SIMS элемент азота был определен количественно, в то время как другие элементы (Mo, Hf и Si) использовались только как маркеры слоя и не определялись количественно. Как показано на рис. 2а, профили глубины перенесенного MoS 2 пленка на азотированном HfO 2 Подложка / Si была определена с помощью SIMS, в котором сигналы основных компонентов, представленных Mo, N, Hf и Si, нанесены на график в зависимости от глубины. Распространение N в HfO 2 наблюдался слой, который мог быть заинтригован инжекцией азота в нижележащий слой во время бомбардировки первичным пучком или плазменной обработки. Также стоит отметить, что профили глубины около поверхностного слоя обычно сложны и бессмысленны из-за поверхностного загрязнения и поверхностных эффектов, например, аномальной интенсивности N-элемента вблизи поверхности [28]. Более высокий сигнал профиля N около HfO 2 / Si можно отнести к тому, что азот имеет тенденцию диффундировать в HfO 2 / Si, что приводит к накоплению N вблизи границы [29]. Хвост Мо в HfO 2 пленка могла быть в основном вызвана бомбардировкой первичным лучом в измерениях SIMS [30]. На рис. 2b показаны соответствующие XPS-спектры N 1s для образцов 3 # и 4 #; пики высокой интенсивности для обоих гетеропереходов:Mo 3p 3/2 в то время как низкоинтенсивный пик при ~ 395,80 эВ был обнаружен для азотированного гетероперехода, что указывает на образование связи Mo-N [31].
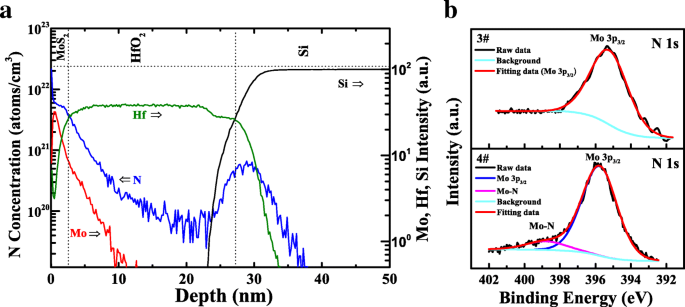
а Профили глубины SIMS перенесенного MoS 2 пленка на азотированном HfO 2 / Si подложка. б XPS-спектры N 1s для MoS 2 / HfO 2 гетеропереходы с обработкой нитридом и без него, соответственно
Для получения выравнивания полос между многослойным MoS 2 и HfO 2 с нитридной обработкой и без нее, измерения XPS с шагом 0,05 эВ были выполнены на системе VG ESCALAB 220i-XL с использованием монохроматического рентгеновского источника Al Kα (hν =1486,6 эВ). Постоянная энергия прохождения была установлена на уровне 20 эВ. Кроме того, для калибровки энергии связи (BE) использовали стандартный C 1s (284,8 эВ) [32]. Чтобы оценить значения VBO для MoS 2 / HfO 2 гетеропереходы, уровни ядра Mo 3d и Hf 4f (КЯ) были выбраны для образца 1–4 # соответственно. На рис. 3а представлена узкая развертка РФЭС спектров Mo 3d и валентной полосы образца № 1 [33]. Таким образом, разница в энергии связи (BED) между Mo 3d 5/2 Максимальный уровень ядра и максимум валентной зоны (VBM) для образца № 1 был рассчитан как 228,49 ± 0,1 эВ. Рисунок 3b иллюстрирует CL Hf 4f 7/2 . и VBM для образца 2 #; соответствующий BED был определен как 14,10 ± 0,1 эВ. На рис. 3в показаны измеренные XPS-спектры ХЛ Mo 3d и Hf 4f для MoS 2 . / HfO 2 гетеропереходы с / без обработки нитридом. Отмечается, что Mo 3d 5/2 CL сдвинулась с 229,45 ± 0,05 эВ для образца 3 # до 229,90 ± 0,05 эВ для образца 4 #. Это можно объяснить тем, что межфазный слой азотирования был введен на MoS 2 / HfO 2 граница раздела после плазменной обработки, что приводит к вышеупомянутому связыванию Mo-N. При наличии связи Mo-N последующий перенос заряда между элементами Mo и N способствовал измеренному Mo 3d 5/2 Сдвиг CL. Кроме того, Hf 4f 7/2 CL 17,40 ± 0,05 эВ для образца 3 # был смещен в сторону более высокой энергии связи 17,60 ± 0,05 эВ для образца 4 #, в то время как O 1s также показал сдвиг на 0,20 эВ в сторону более высокого BED, как показано на фиг. 3d. Эти сдвиги пиков подразумевали изгиб полосы вниз при HfO 2 поверхность, что можно интерпретировать как то, что азотная плазма индуцировала донорные дефекты для HfO 2 [34]. На основе метода Краута [35] VBO ( ∆E V ) значения можно рассчитать по следующему уравнению:
$$ \ Delta {E} _V =\ left ({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S }} _ 2} - {E} _ {\ mathrm {VBM}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \ right) - \ left ({E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} - {E} _ {\ mathrm {VBM}} ^ {{\ mathrm {Hf } \ mathrm {O}} _ 2} \ right) - {\ Delta E} _ {\ mathrm {CL}} $$ (1)где \ ({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \) и \ ( {E} _ {\ mathrm {VBM}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \) - энергии связи Mo 3d 5/2 CL и VBM для MoS 2 , \ ({E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} \) и \ ( {E} _ {\ mathrm {VBM}} ^ {{\ mathrm {HfO}} _ 2} \) - энергии связи Hf 4f 7/2 CL и VBM для ALD-HfO 2 , ∆E CL =\ ({E} _ {\ mathrm {Mo} \ 3 {\ mathrm {d}} _ {5/2}} ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} - {E} _ {\ mathrm {Hf} \ 4 {\ mathrm {f}} _ {7/2}} ^ {{\ mathrm {Hf} \ mathrm {O}} _ 2} \) относится к КРОВАТИ между Mo 3d 5/2 и Hf 4f 7/2 CL для ALD-HfO 2 / MoS 2 гетеропереходы. Следовательно, ∆E V из MoS 2 на ALD-HfO 2 с обработкой азотированием и без обработки были рассчитаны как 2,09 ± 0,1 и 2,34 ± 0,1 эВ, соответственно.

а XPS-спектры Mo 3d CL и валентной полосы для многослойного MoS 2 . б XPS-спектры ХЛ Hf 4f и валентной полосы объемного HfO 2 . XPS-спектры c Mo 3d, Hf 4f и d O 1s CL для переданного MoS 2 пленка на насыпном HfO 2 с / без азотирования
Для оценки влияния N 2 плазменная обработка по смещению зоны проводимости (CBO, ∆E C ) между ALD-HfO 2 и многослойный MoS 2 ширина запрещенной зоны 5.9 ± 0.1 эВ для HfO 2 и 1,4 ± 0,1 эВ для MoS 2 были использованы здесь соответственно [7, 36]. Таким образом, CBO может быть получен с помощью следующего уравнения:
$$ {\ Delta E} _C ={E} _g ^ {{\ mathrm {HfO}} _ 2} - {E} _g ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} - {\ Delta E } _V $$ (2)где \ ({E} _g ^ {{\ mathrm {HfO}} _ 2} \) и \ ({E} _g ^ {\ mathrm {Mo} {\ mathrm {S}} _ 2} \) - запрещенные зоны HfO 2 и MoS 2 , соответственно. Согласно формуле. (2), ∆E C между MoS 2 и ALD-HfO 2 с обработкой азотированием и без обработки были рассчитаны как 2,41 ± 0,1 и 2,16 ± 0,1 эВ, соответственно. Соответствующие зонные диаграммы показаны на рис. 4. Примечательно, что значения как VBO, так и CBO этих двух гетеропереходов обеспечивают отличное удержание электронов и дырок, обеспечивая их пригодность для MoS 2 полевые транзисторы на основе [37]. Более того, у азотированного гетероперехода более высокий CBO по сравнению с гетеропереходом без нитридов, что лучше для n-канальных полевых транзисторов.
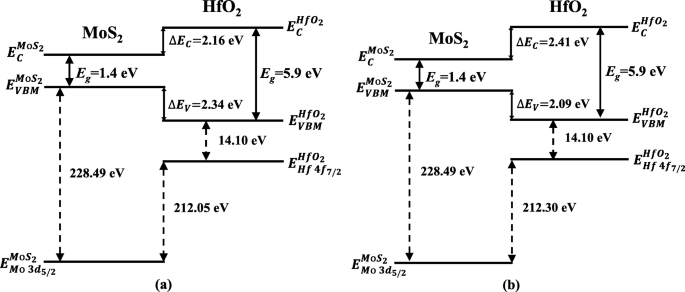
Бэнд-диаграммы MoS 2 / HfO 2 гетеропереход а без азотирования и b с азотированием
Выводы
В заключение, измерения XPS показали, что выравнивание полосы на MoS 2 / HfO 2 интерфейс может быть изменен путем введения азотирования в HfO 2 поверхность перед укладкой MoS 2 фильм. CBO и VBO были определены как 2,16 ± 0,1 и 2,34 ± 0,1 эВ для не азотированного MoS 2 . / HfO 2 гетеропереход, тогда как CBO был изменен до 2,41 ± 0,1 эВ, а VBO был изменен до 2,09 ± 0,1 эВ для азотированного MoS 2 / HfO 2 гетеропереход соответственно. На границе раздела был введен азотирующий межфазный слой, который, как было обнаружено, приводил к образованию связи Mo-N. Кроме того, азотная плазма может вызывать дефекты, подобные донорам, что приводит к изгибу поверхностных зон для HfO 2 . Таким образом, инженерные разработки по выравниванию межфазных полос предоставят многообещающие пути к гибкому проектированию и оптимизации современной электроники.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой рукописи, включены в рукопись.
Сокращения
- ALD:
-
Осаждение атомного слоя
- BE:
-
Связующая энергия
- BED:
-
Разница в энергии связывания
- CBO:
-
Смещение зоны проводимости
- CL:
-
Базовый уровень
- CVD:
-
Химическое осаждение из паровой фазы
- FET:
-
Полевой транзистор
- HfO2:
-
Оксид гафния
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- MoS 2 :
-
Дисульфид молибдена
- PMMA:
-
Поли (метилметакрилат)
- SIMS:
-
Масс-спектрометрия вторичных ионов
- SL:
-
Однослойный
- TEMAH:
-
Тетракис (этилметиламидо) гафний
- TMDC:
-
Дихалькогенид переходного металла
- VBM:
-
Максимальный диапазон валентности
- VBO:
-
Смещение полосы валентности
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
Наноматериалы
- Знакомство с терагерцовым диапазоном
- MoS2 с контролируемой толщиной для электрокаталитического выделения водорода
- Межфазные, электрические характеристики и характеристики совмещения полос стопок HfO2 / Ge с прослойкой SiO2, сфор…
- Температурная кристаллизация нанофлексов MoS2 на графеновых нанолистах для электрокатализа
- Большой боковой фотоэлектрический эффект в гетеропереходе MoS2 / GaAs
- Зависящая от смещения фоточувствительность многослойных фототранзисторов MoS2
- Основные компоненты ленточнопильных станков
- Как выбрать скорость пиления?
- Мощная ленточная пила для резки металла
- Представляем вертикальную ленточную пилораму



