Влияние сетчатой контактной структуры p-типа на эффект экстракции света для глубоких ультрафиолетовых светодиодов Flip-Chip
Аннотация
В этой работе с помощью трехмерного метода конечных разностей во временной области (3D FDTD) систематически исследуются флип-чипы светодиодов глубокого ультрафиолетового излучения (DUV LED) на основе AlGaN с различными сетчатыми контактными структурами. Замечено, что как поперечная электрическая (TE) -, так и поперечная магнитная (TM) -поляризованная эффективность вывода света (LEE) чувствительны к расстоянию и углу наклона ячеистой структуры. Мы также обнаружили, что LEE не будет увеличиваться при использовании большого коэффициента заполнения для сетчатых структур, что происходит из-за конкуренции между поглощением слоя p-GaN, резонансным поглощением плазмонного плазмона металла Al и эффектом рассеяния сетчатыми структурами. . Очень сильный эффект рассеяния, возникающий в контактах гибридных наностержней p-GaN / усеченных наноконусов p-AlGaN, может значительно усилить LEE как для TE-, так и для TM-поляризованного света, например, когда угол наклона составляет 30 °, LEE для TE - и TM-поляризованный свет можно увеличить в ~ 5 раз и ~ 24 раза при длине волны излучения 280 нм соответственно.
Введение
Светодиоды глубокого ультрафиолетового излучения на основе AlGaN (DUV-светодиоды) имеют большой потенциал применения в таких областях, как очистка воды, медицинская фототерапия, обнаружение и фотокатализ [1,2,3]. Однако DUV-светодиоды с высокой внешней квантовой эффективностью (EQE) по-прежнему трудно получить, особенно когда длина волны излучения уменьшается. EQE для светодиодов можно рассчитать как произведение внутренней квантовой эффективности (IQE), обозначенное как η IQE и эффективность вывода света (LEE), обозначенная как η ЛИ , то есть η EQE = η IQE · η ЛИ . В настоящее время EQE для обычных светодиодов DUV с перевернутой структурой составляет менее 10%, что сильно ограничивается низким значением LEE, составляющим 7–9% [4]. На данный момент самый высокий мировой рекорд EQE для светодиодов DUV составляет 20% на длине волны 275 нм, и такой высокий EQE достигается благодаря значительно улучшенному LEE, который возможен за счет интеграции различных передовых технологий LEE, таких как узорчатая сапфировая подложка, прозрачный p-электрод и передовая технология упаковки [5]. Следовательно, улучшение LEE для реализации высокоэффективных светодиодов DUV становится чрезвычайно важным. Хорошо известно, что на LEE существенно влияют полное внутреннее отражение (TIR) и потери Френеля, которые вызваны большим контрастом показателей преломления между AlGaN и воздухом ( n воздух =1 и n AlGaN =2,6) [6]. Кроме того, увеличение содержания Al в квантовых ямах на основе AlGaN приводит к преобладанию поперечно-магнитного (TM) -поляризованного света, который трудно проникнуть в конус выхода до того, как он будет извлечен из светодиодов DUV [7]. Для увеличения LEE, с одной стороны, широко применялись различные технологии, включая шероховатые поверхности [8], узорчатые сапфировые подложки [9], наклонные боковые стенки [10] и поверхностные плазменные поляритоны [11], и, таким образом, рассеяние Центры могут быть созданы, что помогает увеличить вероятность выхода фотонов с сапфировой подложки. Другое препятствие, ограничивающее LEE, возникает из-за поглощающего контактного слоя p-GaN из-за трудности выращивания слоя p-AlGaN с высоким содержанием алюминия с высокой концентрацией дырок [5]. Следовательно, важно уменьшить оптическое поглощение, которое вызывается слоем p-GaN для светодиодов DUV, и предлагаемые методы включают сетчатый контактный электрод p-типа [12, 13], распределенный брэгговский отражатель (DBR) / всенаправленный отражатель. (ODR) [14, 15] и фотонный кристалл [16]. Среди предложенных подходов сетчатый контактный электрод p-типа эффективен и менее затратен. Lobo et al. сообщили о схемах контактов p-типа в микрометровом масштабе и доказали свою эффективность в улучшении вывода света [13]. Однако исследования сетчатого контактного электрода p-типа нанометрового масштаба проводятся редко. Кроме того, в предыдущих отчетах не учитывалось рассеивающее влияние сетчатого контактного электрода p-типа микрометрового масштаба на LEE. Мы считаем, что эффект рассеяния в контактных электродах p-типа нанометрового масштаба может еще больше увеличить LEE.
В этой статье численно исследовано влияние наноразмерной сетчатой контактной структуры и алюминиевого отражателя на LEE для светодиодов DUV. Изучаются различные сетчатые контактные структуры, включая контакт наностержня p-GaN, гибридные контакты наностержня p-GaN / наностержня p-AlGaN и контакты гибридного наностержня p-GaN / усеченного наноконуса p-AlGaN. Используя трехмерное моделирование во временной области (3D FDTD), эта работа исследует зависимость LEE от переменных параметров для предлагаемых структур. Мы обнаружили, что светодиод с оптимизированными контактами из гибридных наностержней p-GaN / p-AlGaN с усеченными наноконусами обеспечивает более чем 5-кратное и 24-кратное усиление LEE для поперечно-электрического (TE) - и TM-поляризованного света, соответственно.
Модель и методы моделирования
Симулятор, используемый в нашей работе, разработан на основе решения Lumerical FDTD, которое может решать зависящие от времени уравнения Максвелла для расчета распределений электромагнитного поля в конечных структурах [17, 18]. На рисунке 1а представлена имитационная модель для обычных светодиодов DUV с перевернутым кристаллом. Слой отражателя из алюминия закреплен на верхней части моделируемой структуры для отражения фотонов обратно в прозрачный сапфир, так что большая часть света может быть извлечена [19]. Обратите внимание, что отражатель из алюминия имеет коэффициент отражения до 92% в УФ-диапазоне спектра [20]. Механизм рассеяния металла описывается модифицированной моделью Друде во время моделирования [21]. Толщина слоя p-GaN, слоя n-AlGaN и сапфира составляет 100 нм, 1,5 мкм и 1 мкм соответственно [12]. Множественные квантовые ямы (МКЯ) внедрены между слоем n-AlGaN и слоем p-AlGaN, общая толщина которых составляет 100 нм. Кроме того, мы установили одиночный диполь в середине области МКЯ и диполь, который представляет собой электронно-дырочную рекомбинацию [22]. Пиковая длина волны излучения спектра для дипольного источника установлена на 280 нм. Дипольный источник поляризован в направлении, параллельном или перпендикулярном X ось для возбуждения TE или TM моды соответственно [23]. Z -ось перпендикулярна плоскости C для светодиодов DUV. Следовательно, TE-поляризованный и TM-поляризованный свет распространяется в основном в плоскостях YZ и XY соответственно. Коэффициенты поглощения на длине волны излучения 280 нм для слоя AlGaN, МКЯ и слоя GaN принимаются равными 10 см −1 . , 1000 см −1 , и 170 000 см −1 , соответственно. Показатели преломления материала для слоя AlGaN, слоя GaN и сапфира приняты равными 2,6, 2,9 и 1,8 соответственно [23, 24]. Поперечный размер рассчитанной структуры установлен равным 8 × 8 мкм 2 . . Предполагается, что граничные условия для четырех боковых границ имеют коэффициент отражения, равный 100%, так что конечные боковые размеры можно считать бесконечными [25]. Условия для верхней и нижней границ устанавливаются так, чтобы иметь идеально согласованный слой (PML), который может полностью поглощать электромагнитную энергию. В наших моделях при проведении моделирования применяется неоднородная сетка, а наименьший размер сетки установлен на 5 нм, что обеспечивает хорошую точность для расчета LEE. Монитор мощности расположен на расстоянии 300 нм от сапфира для сбора энергии, передаваемой через монитор, и регистрации излучения электрического поля в ближней зоне. Электрическое поле ближнего поля преобразуется в электрическое поле дальнего поля путем выполнения преобразования Фурье. LEE вычисляется как отношение полной извлеченной мощности, полученной от монитора мощности, и полной мощности излучения от диполя [26]. Мощность, полученная от монитора мощности, получается путем интегрирования распределения мощности в дальней зоне по поверхности монитора мощности.
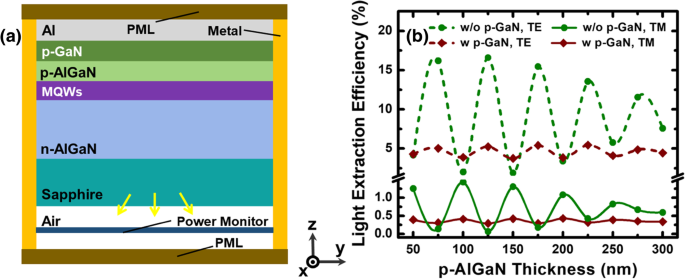
а Схематическая диаграмма вида сбоку трехмерных вычислительных моделей FDTD для стандартной структуры светодиодов DUV с перевернутым кристаллом. б TE- и TM-поляризованные LEE для светодиодов DUV с p-GaN и без p-GaN в зависимости от толщины p-AlGaN
Результаты и обсуждения
Влияние толщины оптической полости на LEE
Как хорошо известно, эффект оптического резонатора может настраивать режим излучения для МКЯ в светодиодах с перевернутым кристаллом, который чувствителен к толщине слоя p-типа, в то время как толщина слоя p-типа оказывает существенное влияние на LEE [27] . Поэтому сначала мы исследуем влияние толщины слоя p-AlGaN на TE-поляризованные и TM-поляризованные LEE для обычных светодиодных структур. Толщина слоя p-AlGaN также представляет собой расстояние между МКЯ и отражателем из алюминия. Как показано на рис. 1b, все кривые LEE показывают периодические колебания с толщиной слоя p-AlGaN и периодом около 50 нм. Колебательное поведение обусловлено эффектом оптического резонатора, который возникает из-за конструктивной интерференции между светом от источника и светом, отраженным алюминиевым зеркалом. Согласно теории интерференции, период можно вычислить как Δ d = λ / 2 n AlGaN =53 нм [21], что хорошо согласуется с результатами моделирования на рис. 1б. Кроме того, пиковые значения LEE для TM-поляризованного света противоположны пикам для TE-поляризованного света. Согласно уравнениям Френеля и матрице Мюллера [28], существуют разные амплитуды отражения и фазовые сдвиги для отражения TE- и TM-поляризованного света от границы раздела между двумя линейными изотропными средами. Более того, можно обнаружить, что, хотя сильное поглощение слоем p-GaN ослабляет эффект оптического резонатора, LEE для светодиода со слоем p-GaN толщиной 100 нм все еще демонстрирует небольшую флуктуацию амплитуды. Более слабый эффект оптического резонатора для светодиода со слоем p-GaN приводит к тому, что как для TE-, так и для TM-поляризованного света минимальный LEE для светодиода со слоем p-GaN больше, чем для светодиода без p-GaN. слой, как показано на рис. 1b. Между тем, можно также наблюдать, что средний LEE для TM-поляризованного света составляет только одну десятую от этого для TE-поляризованного света, и полученные здесь результаты согласуются с результатами в [23]. Кроме того, стоит отметить, что светодиоды без слоя p-GaN показывают самые большие LEE для TE-поляризованного света и TM-поляризованного света - 16% и 1,5% соответственно, в то время как эти цифры составляют всего 5% и 0,5% для Светодиоды со слоем p-GaN соответственно. Следовательно, можно получить трехкратное усиление LEE для светодиодов без слоя p-GaN, что указывает на то, что слой p-GaN может значительно поглощать свет как с TE-, так и с TM-поляризацией. Это связано с тем, что некоторые источники света должны испытывать многократные отражения для выхода, а оптимизированная толщина p-AlGaN также обеспечивает лучший эффект оптического резонатора. Следовательно, уменьшение поглощения p-GaN очень важно для LEE светодиодов DUV и может привести к более чем двукратному увеличению LEE.
Влияние ячеистых контактов p-GaN на LEE
Чтобы уменьшить поглощение слоем p-GaN, p-GaN встраивается в субмикроконтакты для увеличения LEE. На основе обычного перевернутого DUV-светодиода на рис. 1а слой p-GaN предназначен для наностержней, которые встроены в алюминиевый отражатель и образуют субмикроконтактный электрод p-типа (см. Рис. 2а) с квадратной решеткой. (см. рис. 2б). Высота наностержней p-GaN составляет 100 нм. Диаметр наностержней p-GaN составляет 250 нм, что близко к длине волны излучения. Оптимизированная толщина слоя p-AlGaN установлена на 125 нм в соответствии с рис. 1b. Для светодиода DUV с сетчатыми контактами p-GaN расстояние является наиболее важным. С одной стороны, меньшее расстояние должно способствовать более эффективному распространению тока по всей активной области. С другой стороны, меньшее расстояние увеличивает коэффициент заполнения сетчатых контактов p-GaN и, таким образом, увеличивает оптическое поглощение. Следовательно, оптимизированный интервал, обеспечивающий как хорошее распределение тока, так и отличный LEE, очень важен для предлагаемых светодиодов DUV. Затем мы исследуем и покажем влияние расстояния на LEE на рис. 2c. Как и ожидалось, по сравнению с обычными светодиодами DUV, LEE с TE-поляризацией и TM-поляризацией для светодиодов DUV с сетчатыми контактами p-GaN значительно улучшены. LEE для TE-поляризованного света увеличивается с увеличением расстояния до тех пор, пока расстояние не достигнет 125 нм, потому что поглощение p-GaN уменьшается в результате уменьшения коэффициента заполнения p-GaN. И LEE имеют более чем трехкратное улучшение, когда расстояние составляет около 125 нм. Однако после 125 нм LEE для TE-поляризованного света уменьшается с коэффициентом заполнения. Наблюдения, когда расстояние превышает 125 нм, позволяют сделать вывод, что есть еще один фактор, оказывающий важное влияние на LEE. Согласно отчету [29], длина экстинкции фотона может быть выражена как 1 / L вымирание =1 / L рассеяние + 1 / L поглощение , где L рассеяние и L поглощение соответствуют длине рассеяния и длине поглощения соответственно. Поскольку LEE в основном зависит от поглощения материала и структурного рассеяния, можно сделать вывод, что эффект рассеяния, вызванный сетчатыми контактами p-GaN, в основном влияет на LEE, когда расстояние больше 125 нм.

а Схематическая диаграмма вида сбоку перекидного светодиода DUV с сетчатыми контактами p-GaN. б Схематическая диаграмма вид сверху сетчатого распределения контактов p-GaN. c LEE для светодиодов DUV с сетчатыми контактами p-GaN в зависимости от расстояния между наностержнями, когда толщина p-AlGaN составляет 125 нм
Чтобы подтвердить эффект рассеяния сетчатыми контактами p-GaN, установлена модель без поглощающего материала, так что коэффициент поглощения для материала GaN установлен на 0, а отражатель из Al заменен на идеальный электрический проводник (PEC) с почти 100 % отражательной способности, для которой результаты моделирования показаны черным квадратом на рис. 3а. Видно, что LEE увеличивается, а затем уменьшается с увеличением расстояния. А именно, эффект рассеяния субмикроконтакта p-GaN возрастает и затем уменьшается с увеличением пространства. Следовательно, увеличенное расстояние для сетчатых контактов GaN p-типа будет подавлять эффект рассеяния, и это интерпретирует наблюдение на рис. 3а, согласно которому, когда расстояние больше 50 нм, LEE уменьшается с увеличением расстояния.
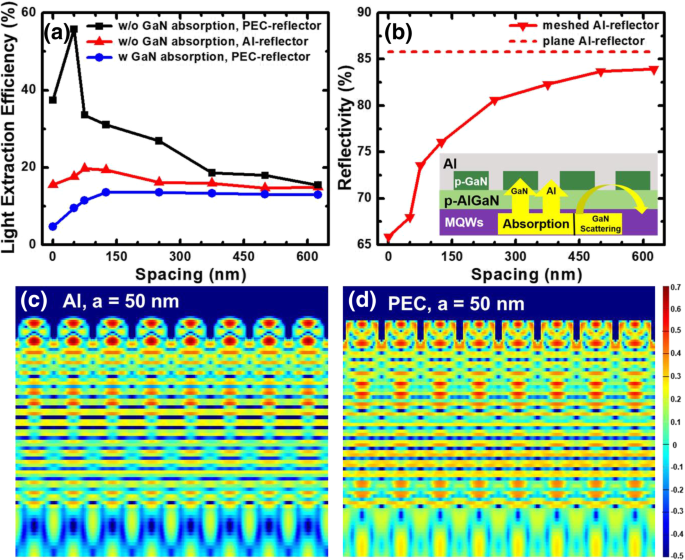
а LEE как функция расстояния между наностержнями для светодиодов DUV с непоглощающими / поглощающими наностержнями p-GaN высотой 100 нм, а отражателями являются Al и PEC соответственно. б Отражательная способность при нормальном падении с сетчатым отражателем из алюминия и плоским отражателем из алюминия как функция расстояния между наностержнями. На вставке показан эффект поглощения слоем p-GaN, поглощения металлическим Al и структурного рассеяния в светодиоде DUV с сетчатыми контактами p-GaN. Распределение электрического поля в поперечном сечении при расстоянии между наностержнями 50 нм с c Al и d Отражатель PEC
Кроме того, когда поглощение GaN установлено на 0 и применяется отражатель из Al, LEE также сначала увеличивается, а затем уменьшается в виде красной треугольной линии, показанной на рис. 3a. Однако максимальный LEE в 20% для структуры с отражателем из алюминия намного меньше, чем в 56% для структуры с отражателем из PEC. На рис. 3б представлена зависимость коэффициента отражения от шага для сетчатого отражателя из алюминия. Отражательная способность сетчатого отражателя из алюминия уменьшается с уменьшением расстояния между ними. Другими словами, металлическая поверхность из алюминия становится шероховатой при уменьшении зазора. Следовательно, уменьшение отражательной способности для шероховатых металлических поверхностей можно объяснить возбуждением поверхностных плазмонов и поверхностным эффектом [30,31,32]. Шероховатая металлическая поверхность должна модулировать фазу падающего света, приводя к поглощенному свету и возбуждению поверхностных волн (поверхностные плазмоны). Поверхностный эффект приводит к улавливанию света в углублениях на поверхности с возможным поглощением. Кроме того, распределение электрического поля в поперечном сечении с использованием плоской волны в качестве источника падения для отражателя из алюминия и отражателя PEC показано на рис. 3в и г соответственно. Можно обнаружить, что для светодиода с отражателем из Al наностержни p-GaN обладают самой сильной локальной напряженностью электрического поля, но такие наблюдения менее очевидны в наностержнях p-GaN для светодиода с отражателем PEC, что подтверждает наличие поглощение поверхностного плазмонного резонанса для сетчатого алюминиевого отражателя. Кроме того, аналогичную тенденцию LEE можно наблюдать, как показывает синяя круглая линия на рис. 3a, когда наша модель учитывает поглощение слоем p-GaN и отражатель PEC. LEE становится больше для светодиода без поглощения GaN и с отражателем PEC (красная треугольная линия), что указывает на то, что поглощение слоем p-GaN более серьезное, чем поглощение металла. Следовательно, для светодиодов DUV с сетчатыми контактами p-GaN существует конкуренция между поглощением слоем p-GaN, поглощением металлическим Al и структурным рассеянием, как показано на вставке к рис. 3b. Когда расстояние слишком мало, на LEE существенно влияет поглощение слоя p-GaN и металла, в то время как рассеяние структуры оказывает основное влияние на LEE, когда расстояние становится большим.
Кроме того, мы дополнительно исследуем влияние высоты наностержня p-GaN на LEE для светодиодов DUV. Зависимость расстояния между LEE при разной высоте наностержней p-GaN:10 нм, 25 нм, 50 нм и 100 нм показана на рис. 4a. LEE увеличивается при уменьшении высоты наностержня со 100 до 25 нм. Очевидно, что увеличение LEE объясняется более слабым поглощением более тонкого слоя p-GaN. Однако рис. 4a также показывает, что LEE похожи, когда высота наностержня составляет 25 нм и 10 нм. Как показано на рис. 4b, отражательная способность металлического Al с наностержнями p-GaN увеличивается быстрее с уменьшением высоты наностержня. Следовательно, можно сделать вывод, что эффект рассеяния на высоте 25 нм сильнее, чем на высоте 10 нм, которая дает аналогичный LEE. Тем не менее, наибольший LEE составляет 15%, когда наностержни p-GaN находятся на высоте 100 нм, а максимальный LEE составляет только 18%, когда наностержни p-GaN находятся на высоте 25 нм; Таким образом, получается небольшая разница. В основном это связано с сильным поглощающим слоем p-GaN, как показано на вставке к рис. 4a. Для слоя p-GaN толщиной 10 нм может быть отражено только 40% света, поэтому отраженный свет в основном исходит от отражателя из алюминия среди наностержней p-GaN. Следовательно, на коэффициент отражения больше влияет расстояние, а не высота наностержней p-GaN. Следовательно, по сравнению с расстоянием между наностержнями, высота наностержня p-GaN меньше влияет на LEE.
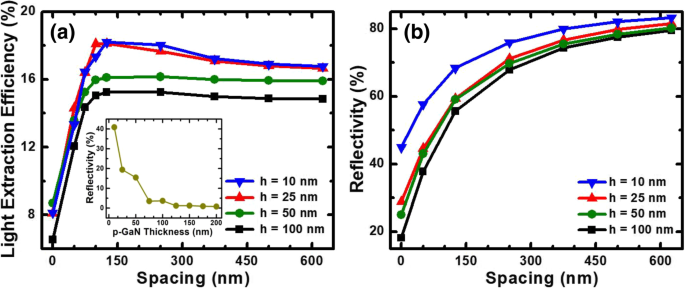
( а) Устанавливаются LEE в зависимости от расстояния между наностержнями для DUV-светодиода с алюминиевым отражателем и высотой наностержней p-GaN 10, 25, 50 и 100 нм. На вставке:коэффициент отражения при нормальном падении для обычного DUV-светодиода как функция толщины слоя p-GaN и b . отражательная способность при нормальном падении как функция расстояния между наностержнями, когда высота наностержней p-GaN составляет 10, 25, 50 и 100 нм
Влияние гибридных ячеистых контактов p-GaN / p-AlGaN на LEE
Кроме того, мы также предлагаем слой гибридных сетчатых контактов p-GaN / p-AlGaN, как показано на рис. 5а. Высота и диаметр наностержня p-GaN установлены равными 100 нм и 250 нм соответственно. Высота наностержня p-AlGaN ( H ) в этом случае является переменной. LEE для различных светодиодов DUV с точки зрения расстояния между наностержнями показаны на рис. 5b, для которого мы установили значения H до 0 нм, 25 нм, 75 нм и 100 нм. Можно обнаружить, что LEE для светодиодов DUV с различными наностержнями с высоким содержанием p-AlGaN больше, чем LEE без наностержней p-AlGaN ( H =0 нм). А на LEE для светодиодов DUV меньше влияет высота наностержня p-AlGaN, если H не 0 нм. На вставке к рис. 5b показан нормальный коэффициент отражения в терминах расстояния между наностержнями для гибридной структуры, и мы можем видеть, что высота наностержня p-AlGaN оказывает незначительное влияние на коэффициент отражения. Следовательно, эффект рассеяния просто усиливается наностержнями p-AlGaN, что, следовательно, приводит к улучшенному LEE. Диаграммы направленности в дальней зоне для светодиодов DUV с наностержнями p-AlGaN высотой 75 и 0 нм при расстоянии между наностержнями 125 нм показаны на рис. 5в и г соответственно. Можно заметить, что напряженность электрического поля светодиодов DUV с наностержнями p-AlGaN высотой 75 нм (см. Рис. 5c) выше, чем напряженность электрического поля с наностержнями p-AlGaN высотой 0 нм (см. Рис. 5d). Распределение электрического поля для светодиодов DUV с наностержнями p-AlGaN высотой 75 нм больше, чем у наностержней p-AlGaN высотой 0 нм, что подтверждает, что наностержни p-AlGaN улучшают эффект рассеяния света. Рисунок 5e демонстрирует, что на TM-поляризованный LEE даже в меньшей степени влияет высота наностержня p-AlGaN.

а Схематическая диаграмма вида сбоку флип-чипа DUV-светодиода с гибридными сетчатыми контактами на основе наностержней p-GaN / p-AlGaN. б LEE для TE-поляризованного света в зависимости от расстояния между наностержнями и высоты наностержней p-AlGaN установлены на 0, 25, 75 и 100 нм. Вставка:Коэффициент отражения при нормальном падении для DUV-светодиода с p-GaN высотой 100 нм и высотой p-AlGaN 0, 25, 75 и 100 нм в зависимости от расстояния между наностержнями. Диаграммы направленности излучения в дальней зоне на расстоянии 125 нм с высотой p-AlGaN c 75 нм и d 0 нм. е LEE для TM-поляризованного света в зависимости от расстояния между наностержнями и высоты наностержней p-AlGaN установлены на 0, 25, 75 и 100 нм.
Наш предыдущий анализ показывает, что ТМ-поляризованный свет все еще страдает от чрезвычайно низкого LEE. В результате должны быть предложены методы рассеяния TM-поляризованного света. Для этой цели мы предлагаем наностержни p-AlGaN с наклонными боковыми стенками, формируя таким образом структуру усеченных наноконусов p-AlGaN, как показано на рис. 6а. Высота усеченных наноконусов p-AlGaN установлена на 75 нм, а угол наклона установлен на α . Заметное усиление LEE для TE- и TM-поляризованного света с уменьшенным α можно увидеть на рис. 6б и в соответственно. Для наклонного угла α =30 °, невозможно установить меньший период, потому что усеченные наноконусы p-AlGaN были плотно упакованы, когда расстояние между наностержнями p-GaN составляет 260 нм. Самый большой TE-поляризованный LEE достигает 26% при расстоянии 375 нм и α установлен на 30 °. Это число в 1,44 раза больше, чем расчет на рис. 5а. Более примечательно, что по сравнению со структурой на рис. 5a, самый большой TM-поляризованный LEE для конструкции на рис. 6a составляет 12%, когда расстояние составляет 260 нм и α установлен на 30 °, и это число увеличивается в 10 раз. По сравнению с обычным светодиодом DUV без сетчатых структур, LEE с TE- и TM-поляризацией могут быть увеличены более чем в 5 и 24 раза за счет использования конструкции, показанной на рис. 6a, соответственно. Эти смоделированные результаты показывают, что усеченный наноконус p-AlGaN с углом наклона 30 ° может значительно улучшить эффект светорассеяния, особенно для TM-поляризованного света.
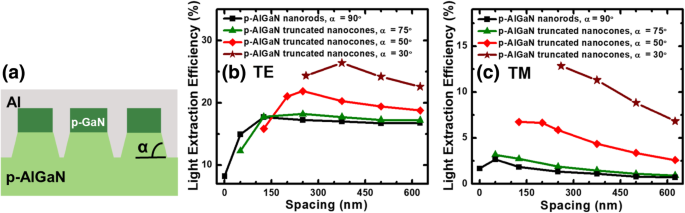
а Схематическая диаграмма вида сбоку для перевернутого DUV-светодиода с гибридными контактами наностержня p-GaN / усеченного наноконуса p-AlGaN. LEE TE-поляризованного света ( b ) и TM-поляризованного света ( c ) в зависимости от расстояния между наностержнями для светодиодов DUV, а структуры имеют p-GaN высотой 100 нм и p-AlGaN высотой 75 нм (углы наклона установлены на 30 °, 50 °, 75 ° , и 90 °)
Выводы
Таким образом, подробно исследовано влияние различных сетчатых контактных структур, включая наностержень p-GaN, гибридный наностержень p-GaN / p-AlGaN и наностержень p-GaN / усеченный наноконус p-AlGaN, на LEE для светодиодов DUV. Доказано, что поглощение слоем p-GaN и поглощение металлическим Al играют основную роль в LEE для структур с меньшим расстоянием между наностержнями, в то время как рассеивающая способность сетчатой структуры вносит доминирующий вклад в LEE для структур с большим расстоянием между наностержнями. Стоит отметить, что, несмотря на очень заметное усиление LEE для TE-поляризованного света, ни наностержень p-GaN, ни гибридный наностержень p-GaN / p-AlGaN не могут значительно способствовать LEE для TM-поляризованного света, что связано с очень слабый эффект рассеяния света в плоскости. Таким образом, мы дополнительно предлагаем и доказываем, что LEE для TM-поляризованного света можно значительно улучшить, комбинируя наностержень p-GaN и усеченный наноконус p-AlGaN, и было обнаружено, что оптимизированный угол наклона составляет 30 °. Таким образом, по сравнению с обычным светодиодом DUV без сетчатой структуры, можно достичь 24-кратного увеличения TM-поляризованного LEE.
Сокращения
- 3D FDTD:
-
Трехмерный метод конечных разностей во временной области
- DBR:
-
Распределенный брэгговский отражатель
- Светодиоды DUV:
-
Светодиоды глубокого ультрафиолета
- EQE:
-
Внешняя квантовая эффективность
- IQE:
-
Внутренняя квантовая эффективность
- LEE:
-
Эффективность отвода света
- MQW:
-
Множественные квантовые ямы
- ODR:
-
Всенаправленный отражатель
- PEC:
-
Идеальный электрический проводник
- PML:
-
Идеально подобранный слой
- TE:
-
Поперечный электрический
- МДП:
-
Полное внутреннее отражение
- TM:
-
Поперечный магнитный
Наноматериалы
- Обоснование использования нейроморфных чипов для вычислений ИИ
- Влияние ультрафиолетового излучения на характеристики 4H-SiC PiN диодов
- Влияние контактной неравновесной плазмы на структурные и магнитные свойства шпинелей Mn Х Fe3 - X О4
- Зеленый синтез квантовых точек InP / ZnS Core / Shell для применения в светоизлучающих диодах, не содержащих тяжелых м…
- Эволюция области контакта при нормальной нагрузке для шероховатых поверхностей:от атомных к макроскопическ…
- Влияние различных связующих на электрохимические характеристики металлооксидного анода для литий-ионных ба…
- Ультрафиолетовые светодиоды на основе AlGaN с почти нулевым КПД и специально разработанным слоем блокировки эл…
- Влияние морфологии и кристаллической структуры на теплопроводность нанотрубок из диоксида титана
- Эффективное поглощение света с использованием решеток двусторонней пирамиды для тонкопленочных кремниевых…
- Проектирование потока света



