Улучшенный поглотитель ближнего инфракрасного диапазона:двухэтапный структурный черный кремний и его применение в устройствах
Аннотация
Кремний широко используется в полупроводниковой промышленности, но имеет плохие характеристики в фотоэлектронных устройствах ближнего инфракрасного диапазона из-за его высокого коэффициента отражения и предельной ширины запрещенной зоны. В этом исследовании двухэтапный процесс, метод глубокого реактивного ионного травления (DRIE) в сочетании с плазменной иммерсионной ионной имплантацией (PIII), используется для изготовления микроструктурированного черного кремния на поверхности C-Si. Эти улучшенные поверхности, легированные элементами серы, обеспечивают более узкую запрещенную зону и увеличение светопоглощения, особенно в ближнем инфракрасном диапазоне (от 800 до 2000 нм). Между тем, максимальное светопоглощение значительно увеличивается до 83%. Фотоэлектронный детектор Si-PIN с микроструктурированным черным кремнием на задней поверхности демонстрирует замечательные характеристики устройства, обеспечивая чувствительность 0,53 А / Вт на длине волны 1060 нм. Этот новый микроструктурированный черный кремний, сочетающий характеристики узкой запрещенной зоны, может иметь потенциальное применение в фотоэлектронном обнаружении в ближней инфракрасной области.
Фон
До сих пор многие материалы из черного кремния с микро- и наноструктурой также можно было изготавливать с использованием DRIE-обработки и ионной имплантации с целью снижения коэффициента отражения света и увеличения поглощения в ближней инфракрасной области [1,2,3,4,5]. Процесс DRIE обычно выполняется в режиме циклических стадий травления-пассивации с фоторезистивной маской, которая может обеспечить микротехнологию кремния для структур с высоким аспектным отношением. Как правило, этот подход использует плазму на основе F, такую как SF 6 для быстрого изотропного травления с последующим переключением на цикл пассивирования боковых стенок с использованием C 4 F 8 [6,7,8]. Во время последующего цикла травления пассивирующая пленка предпочтительно удаляется со дна канавки из-за ионной бомбардировки, предотвращая травление боковых стенок [9]. Наконец, чередование циклов травления и пассивирования может формировать определенные геометрические формы протравленных кремниевых структур, которые в основном зависят от размера маски, потока газа, мощности электрода, времени обработки, продолжительности цикла и так далее. Чтобы увеличить поглощение кремния в ближней инфракрасной области спектра, протравленные кремниевые структуры будут легированы ионной имплантацией после процесса DRIE. При определенных условиях могут быть получены массивы черного кремния, и полученные примеси серы, содержащиеся в решетке кремния, в конечном итоге вызовут значительное поглощение излучения ниже запрещенной зоны [10, 11].
Как один из наиболее важных материалов в полупроводниковой промышленности, черный кремний широко используется в чувствительных фотоэлектронных детекторах, солнечных элементах, биохимических датчиках, устройствах отображения и объектах оптической связи [12,13,14,15,16,17,18, 19,20]. Микро- и наноструктуры черного кремния были предметом интенсивных исследований в последние годы из-за их широкого применения в устройствах. Фотоэлектронный детектор Si-PIN с черным кремнием на передней поверхности был исследован в нашей ранней работе [21]. Эта структура устройства имеет широкий обедненный слой, так что он может уменьшить влияние диффузионного движения носителей и достичь цели повышения чувствительности устройства и скорости отклика. Также следует отметить, что использование черного кремния в качестве светочувствительной поверхности очень трудно для сгенерированных носителей, которые собираются слоем P для вывода фототока через электрод, что приводит к относительно низкому отклику видимого света по сравнению с традиционным детектором Si-PIN. Таким образом, возникает вопрос, мог ли фотоэлектронный детектор Si-PIN с черным кремнием на задней поверхности одновременно выполнять две задачи, то есть повышать чувствительность устройства не только в ближнем инфракрасном, но и в видимом диапазоне?
В этой статье мы сообщаем об увеличении светопоглощения и более узкой запрещенной зоне, характерных для микроструктурированного черного кремния, изготовленного с помощью двухэтапного процесса:DRIE в сочетании с PIII. Было изучено влияние различных процессов травления на коэффициент поглощения света в диапазоне длин волн от 400 до 2000 нм, а также был исследован детектор на основе этого микроструктурированного черного кремния на задней поверхности с акцентом на чувствительность устройства в диапазоне длин волн 400 ~ 1100 нм.
Методы
Как показано на рис. 1а, для исследования оптических свойств микроструктурированного кремния с помощью программного обеспечения FDTD Simulation были выбраны однородные и периодические распределительные цилиндрические массивы. На рисунке 1b представлена зависимость между поглощением и четырьмя различными размерами моделей микроструктурированного кремния после оптимизированного моделирования, в котором четыре модели имеют одинаковый диаметр цилиндра ( D =4 мкм), но другое межосевое расстояние ( T 1 =12 мкм, T 2 =10 мкм, T 3 =8 мкм, T 4 =6 мкм).
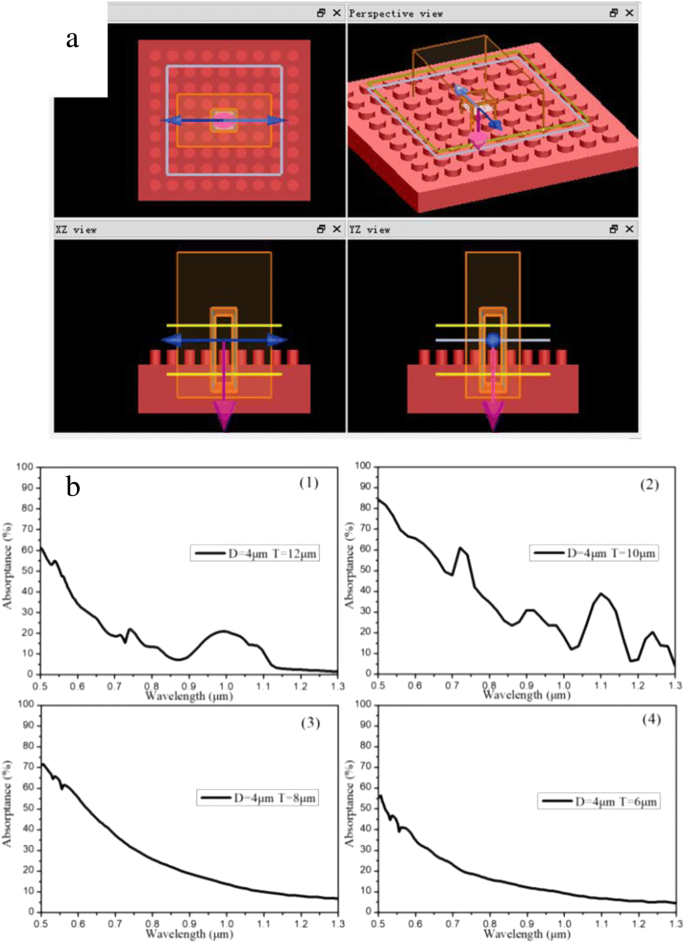
Оптическая имитационная модель ( a ) и результаты моделирования ( b ) микроструктурированного кремния
Как показано на рис. 2, на основе вышеупомянутых оптимизированных результатов моделирования были разработаны три различных фотолитографических маски путем изменения размера маски, названного маской I ( D =4 мкм, T =6 мкм), маска II ( D =4 мкм, T =8 мкм), а маска III ( D =4 мкм, T =10 мкм) соответственно. Затем был нанесен фоторезист NR9-1500PY для нанесения маски из круглых решеток на полируемую поверхность кусочков кремния (15 × 15 см 2 ), вырезанные из кремниевых пластин n-типа толщиной 500 мкм и удельным сопротивлением от 2500 до 3000 Ом · см. Чтобы исследовать влияние процесса травления на светопоглощение микроструктурированного кремния, мы переместили испытательные образцы, полученные из маски III, в технологическую полость (DRIE, ICP-100D) и изменили время цикла, в котором SF 6 использовался как травильный газ и C 4 F 8 в качестве пассивирующего газа - 30, 70 и 100 раз по-разному. После процессов травления с кусочков кремния удаляли остатки фоторезиста в атмосфере кислорода, чтобы поверхность кремния была чистой и гладкой. Чтобы увеличить поглощающую способность микроструктурированного кремния, особенно в ближнем инфракрасном диапазоне, испытательные образцы, полученные из маски III, далее были легированы элементами серы посредством процесса PIII при условии 1,0E + 15 см - 2 доза имплантации и энергия имплантации 800 эВ соответственно.

Принципиальная схема размеров маски
Морфология черного кремния была охарактеризована с помощью автоэмиссионного сканирующего электронного микроскопа (SEM, JSM-7500F). Коэффициент поглощения света получали при комнатной температуре с помощью оптоволоконного спектрометра (NIR2500), снабженного интегрирующей сферой (Idea Optics, IS-20-5). Чувствительность детектора измерялась с использованием измерителя оптической мощности (OPHIR, Vega), оптического прерывателя (Scitec Instruments, Model-300CD) и прибора Keithley2636B в темноте комнаты. Чтобы обеспечить точность измерения, мы провели калибровку перед испытанием, и каждое из этих измерений проводилось на нескольких образцах (обычно от 4 до 6).
Результаты и обсуждение
На рис. 3 представлены типичные СЭМ-изображения выровненных массивов микроструктурированного кремния, которые перпендикулярны поверхности подложки для трех различных размеров маски. Ясно показано, что вид сверху микроструктурированного кремния на самом деле не является стандартными кругами из-за того, что процесс DRIE в основном зависит от размера маски и качества техники фотолитографии. Затем, чтобы исследовать влияние процесса травления на светопоглощение микроструктурированного кремния, мы изменяем время цикла в 30, 70 и 100 раз на испытательных образцах маски III в условиях травления с SF 6 в течение 3 с и пассивируя с помощью C 4 F 8 в течение 2 с, время каждого цикла.
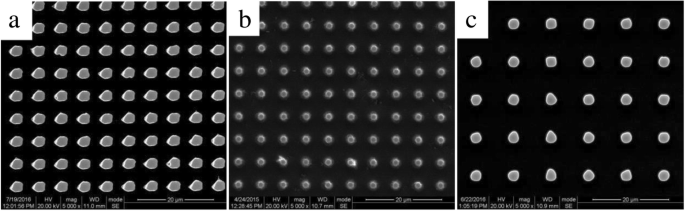
Типичные микроструктурированные кремниевые матрицы производства DRIE для различных размеров масок. а Маска I. б Маска II. c Маска III
В соответствии с различным соотношением скоростей травления фоторезиста и кремния глубину травления можно регулировать параметрами процесса, если фоторезист достаточно толстый, как маска. Из рис. 4 видно, что высота цилиндров увеличивается с увеличением количества циклов, в которых высота от верха до подложки составляет примерно 1,87 мкм, 2,35 мкм и 3,15 мкм соответственно. Хорошо известно, что в процессе DRIE, несмотря на наличие пассивирующих газов для защиты боковой стенки мишени травления, он все же более или менее сопровождается боковым травлением. Это причина того, почему полученные морфологии не являются идеальными цилиндрическими массивами. Очевидно, что морфологию этих массивов микроструктурированного кремния можно хорошо контролировать, варьируя процесс литографии и время цикла травления.
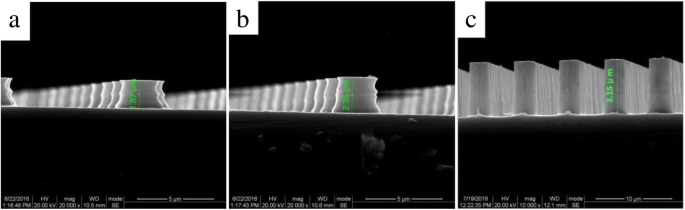
Виды в разрезе образцов маски III, изготовленных для разного времени цикла. ( а ) 30, ( b ) 70 и ( c ) 100
На рис. 5а представлена светопоглощающая способность микроструктурированных цилиндрических массивов в разное время цикла без процесса PIII. Показано, что C-Si с вытравленными кремниевыми массивами, по сравнению с обычным C-Si, может в определенной степени увеличивать коэффициент поглощения света во всем диапазоне длин волн от 400 до 2000 нм. Образец, протравленный в течение 100 циклов, имеет наивысшее поглощение, до 70% в ближнем ИК-диапазоне (от 800 до 2000 нм), а среднее поглощение этого образца достигает 55% в диапазоне длин волн от 400 до 2000 нм. Это связано с многократным отражением и поглощением микроструктурированного кремния (как на рис. 6). В процессе непрерывного отражения падающего света от боковой поверхности цилиндра длина пути поглощения падающего света увеличивается, что приводит к увеличению коэффициента поглощения. Тем не менее, скорость поглощения все еще недостаточно высока, когда длина волны превышает 1000 нм. Следовательно, для дальнейшего улучшения поглощения микроструктурированного кремния, особенно в ближнем инфракрасном диапазоне, те же образцы легируют элементами серы с помощью процесса PIII при условии 1,0E + 15 см - 2 доза имплантации и энергия имплантации 800 эВ соответственно. Как показано на рис. 5b, коэффициент поглощения света, очевидно, увеличивается в диапазоне длин волн от 400 до 2000 нм после ионной имплантации. Здесь коэффициент поглощения света образца, протравленного за 100 циклов, намного выше, чем у C-Si. Максимальное и среднее светопоглощение значительно увеличиваются до 83% и 62% соответственно. Более того, легко заметить (как на рис. 5c), что коэффициент поглощения 100-циклических образцов имеет значительное изменение длины волны от 800 до 2000 нм до и после легирования серными элементами, при котором максимальное и среднее значения увеличиваются на 13%. и 7% соответственно.
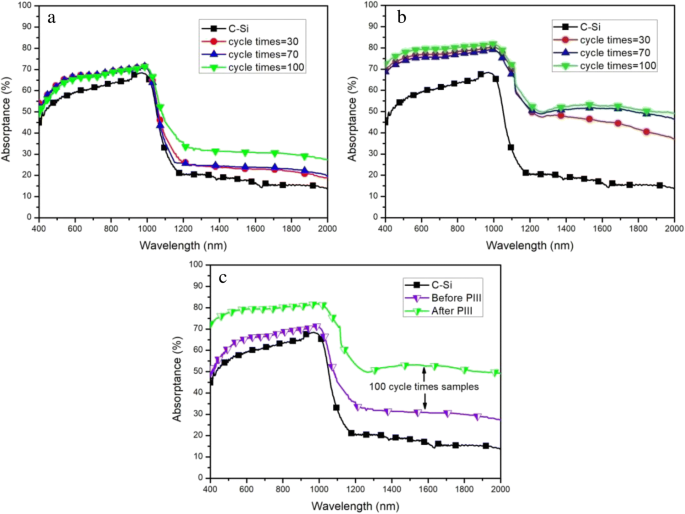
Поглощение C-Si и черного кремния, изготовленных с разным временем цикла до ( a ) и после PIII ( b ) и сравнение образцов за 100 циклов ( c )

Путь прохождения падающего света на поверхности микроструктурированного кремния
Такое высокое поглощение в основном происходит из-за легирования серой микроструктурированных цилиндрических массивов, образующих множество примесных уровней в структуре энергетических зон C-Si. В результате, когда эти индуцированные множественные примесные уровни перекрываются, после уширения образуется новая примесная полоса, что в конечном итоге уменьшает запрещенную зону C-Si. Ширина запрещенной зоны может быть получена из спектра поглощения образца с помощью картографирования Tauc. Были предприняты следующие конкретные шаги:
(i) спектр отражения преобразуется в функцию К-М F ( R ∞ ) с помощью теории Кубелки-Мунка:
$$ F \ left (R \ infty \ right) \ приблизительно \ frac {A ^ 2} {2R} $$ (1)в котором R и A - спектр отражения и спектр поглощения образца соответственно.
(ii) КМ-функция F ( R ∞ ) подставляется в формулу Таука следующим образом:
$$ {\ left (hv \ alpha \ right)} ^ {1 / n} =K \ left (hv- Например \ right) $$ (2) $$ hv =\ frac {1239.7} {\ lambda} $$ (3)в котором значение индекса n связано с типом перехода образца:прямой переход, n =1/2; непрямой переход, n =2. F ( R ∞ ) пропорциональна коэффициенту поглощения α, который можно заменить на F ( R ∞ ) и n =2 подставляется в формулу (2), чтобы получить:
$$ {\ left (hv F \ left (R \ infty \ right) \ right)} ^ {1/2} =K \ left (hv- Eg \ right) $$ (4)(iii) Спектральные данные отражения и поглощения образца подставляются в формулу. (1), и уравнение. (1) подставляется в формулу. (4), с hv по оси абсцисс ( X ось) и ( hvF (R ∞ )) 1/2 как ордината ( Y ось).
(iv) Точка перегиба (точка максимума первой производной) получается путем вычисления первой производной от hv - ( hvF (R ∞ )) 1/2 кривой, и касательная к кривой проведена в этой точке. Значение абсциссы пересечения касательной и X оси - ширина запрещенной зоны образца.
На рисунке 7 показаны окончательные расчетные значения ширины запрещенной зоны C-Si и черного кремния с разным временем цикла. Легко обнаружить, что три нижние запрещенные зоны черного кремния, такие как 1,045 эВ, 1,033 эВ и 1,025 эВ, явно уменьшены, соответственно, по сравнению с шириной запрещенной зоны C-Si 1,12 эВ.
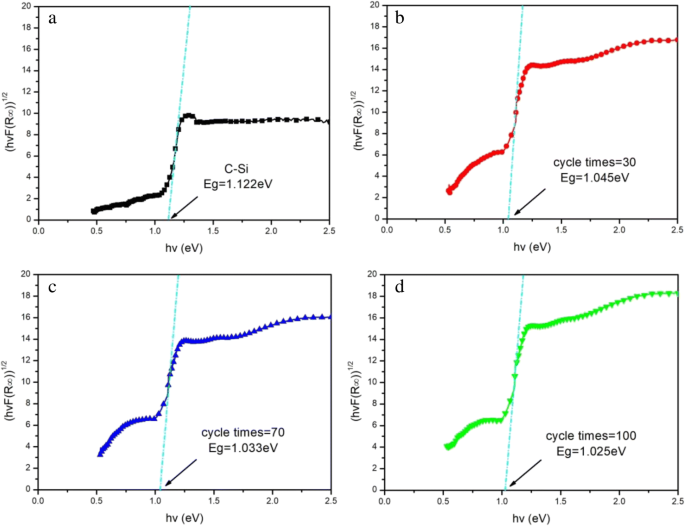
Ширина запрещенной зоны C-Si ( a ) и черный кремний, изготовленные с разным временем цикла:( b ) 30, ( c ) 70, ( d ) 100
На основе указанного выше черного кремния с улучшенными оптическими свойствами был изготовлен детектор Si-PIN с черным кремнием, сформированным на задней поверхности. Во-первых, пластина чистого монокристаллического кремния (n-типа) окисляется с обеих сторон, образуя SiO 2 слои. Во-вторых, слой P создается диффузией бора на светочувствительной области, которая формируется на ранней стадии травления SiO 2 слой на лицевой поверхности пластины с помощью процесса фотолитографии. В-третьих, слой Si 3 N 4 Проницаемая пленка наносится на слой P, а затем задняя поверхность пластины полируется и шлифуется до толщины около 200 мкм. В-четвертых, N + , легированный фтором На шлифованную поверхность наносится слой микроструктурированного черного кремния на поверхности N + слой. Наконец, электродные окна протравливаются с помощью процесса фотолитографии, и металлические электроды наносятся на обе стороны пластины. На рисунке 8 показано реальное изображение устройства (а), темновой ток (б), ВАХ при освещении с длиной волны 1060 нм (в) и сравнение чувствительности двух разных детекторов (г). Настоящим заявляется, что чувствительность устройства 1 (S1336-44BK, коммерческий Si-PIN-детектор) повторно отображается на основе общедоступного веб-сайта компании Hamamatsu Photonics [22], а чувствительность устройства 2 получается на нашем новом изготовлен Si-PIN-детектор с черным кремнием, сформированным на задней поверхности, в котором светочувствительная поверхность представляет собой круг диаметром 2 мм. Хорошо видно, что устройство 2 значительно увеличивает чувствительность, особенно в ближнем инфракрасном диапазоне длин волн, т.е. 0,53 А / Вт на 1060 нм и 0,31 А / Вт на 1100 нм, соответственно.
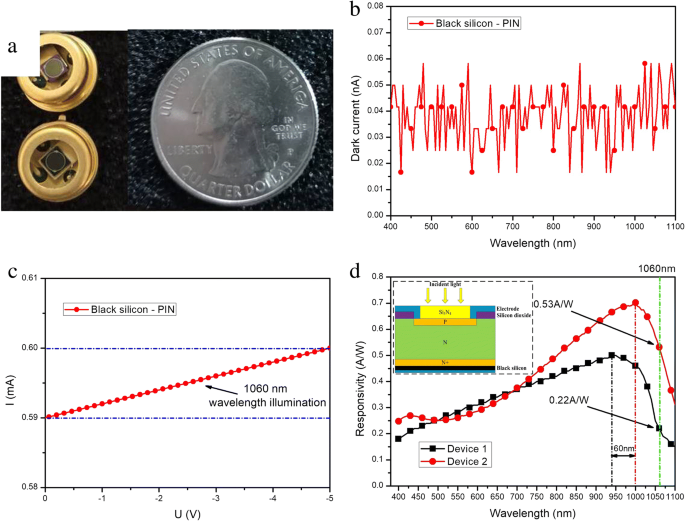
Изображение детектора ( a ), темновой ток ( б ), ВАХ при освещении с длиной волны 1060 нм ( c ) и чувствительности двух разных детекторов ( d ):устройство 1 из исх. [22] и устройство 2 по результатам данной статьи. Вставка d показывает структуру устройства
Из рис. 8b видно, что хотя детектор Si-PIN с черным кремнием, сформированным на задней поверхности (устройство 2), показывает относительно небольшое улучшение чувствительности в видимом спектре, его спектр отклика дает еще более высокую чувствительность на длине волны. диапазон от 680 до 1100 нм с красным смещением пика чувствительности около 60 нм по сравнению с коммерческим Si-PIN-детектором (устройство 1). Основная причина такого различия заключается в том, что устройство этих двух детекторов (устройства 1 и 2) различается. Когда энергия фотонов больше, чем ширина запрещенной зоны C-Si, падающий свет в основном поглощается P-слоем, и поэтому генерируемые носители имеют достаточно энергии для прохождения N-слоя. Большинство сгенерированных носителей можно собрать с помощью N + слой для вывода фототока через электрод. В этом состоянии, независимо от того, выполнена ли задняя поверхность детектора с черным кремнием или без него, будет ограниченное влияние на отклик устройства в видимой длине волны. В отличие от детектора с черным кремнием на передней поверхности [21], устройство 2 демонстрирует лучший отклик в видимой длине волны. Вот почему наблюдается относительно небольшое улучшение отклика в видимом свете согласно измеренной кривой чувствительности. Опять же в устройстве 2, поскольку черный слой кремния установлен на задней поверхности, даже если энергия фотонов меньше ширины запрещенной зоны C-Si, ближний инфракрасный свет может проникать через слой P и поглощаться слоем N, и тогда большое количество сгенерированных несущих может быть собрано N + слой под действием обратного смещения. В результате на выходе будет счетный фототок, и устройство будет значительно увеличивать чувствительность в ближнем инфракрасном диапазоне.
Согласно приведенным выше результатам, наше настоящее исследование могло бы предоставить осуществимую стратегию для ближнего инфракрасного фотоэлектронного поля обнаружения, но есть еще много аспектов, которые следует учитывать. Например, следует изучить более совершенные процессы производства и технологии ионной имплантации микроструктурированного черного кремния, которые могли бы точно контролировать морфологию и ширину запрещенной зоны структурированного кремния. Кроме того, следует разработать некоторые другие новые структуры фотоэлектронного детектора на основе черного кремния, чтобы обеспечить более высокую производительность устройства.
Выводы
Таким образом, микроструктурированные материалы из черного кремния изготавливаются с помощью двухэтапного процесса:глубокого реактивного ионного травления в сочетании с плазменной иммерсионной ионной имплантацией. Микроструктурированные цилиндрические массивы на поверхности кремниевых пластин имеют три различных размера:маска I ( D =4 мкм, T =6 мкм), маска II ( D =4 мкм, T =8 мкм), а маска III ( D =4 мкм, T =10 мкм), высотой 1,87 мкм, 2,35 мкм и 3,15 мкм соответственно. Очевидно увеличенное поглощение света черным кремнием было получено в широком диапазоне длин волн от 400 до 2000 нм, а максимальное и среднее поглощение света достигают 83% и 62% соответственно. Эти усовершенствования широко обсуждаются на основе многократного отражения, увеличения длины пути поглощения и узкой запрещенной зоны. Был изготовлен новый фотоэлектронный детектор Si-PIN с черным кремнием, сформированным на задней поверхности, и было проведено сравнение чувствительности устройства с одним коммерческим устройством, названным S1336-44BK. Сделан вывод, что наш фотоэлектронный детектор Si-PIN с черным кремнием, сформированным на задней поверхности, имеет существенное увеличение чувствительности, особенно в ближнем инфракрасном диапазоне длин волн, повышаясь до 0,53 А / Вт на 1060 нм и 0,31 А / Вт на 1100 нм. соответственно.
Наноматериалы
- Применение металлического молибдена и его сплавов
- Как добиться плавной и эффективной адаптации устройства через мобильное приложение
- Управление устройствами Интернета вещей и его роль в облегчении масштабных развертываний Интернета вещей
- Спин-орбитальное взаимодействие Coin Paradox усиливает магнитооптический эффект и его применение во встроенном о…
- Электронные состояния нанокристалла, легированного кислородом, и видимая эмиссия на черном кремнии, получен…
- Ультратонкий идеальный поглотитель и его применение в качестве плазмонного датчика в видимой области
- Возобновляемый флуоресцентный зонд BHN-Fe3O4 @ SiO2 Гибридная наноструктура для Fe3 + и ее применение в биоимиджинге
- Обзор применения наноструктурированного черного кремния
- Моноклональное антитело к гепараназе, меченное магнитными золотыми наночастицами, и его последующее примене…
- Простой синтез сверхдлинных и тонких медных нанопроволок и его применение в высокоэффективных гибких прозра…



