Морфология, структура и оптические свойства полупроводниковых пленок с наноостровками GeSiSn и напряженными слоями
Аннотация
Получены зависимости толщины критического перехода двумерного роста в трехмерный (2D-3D) от состава для пленок GeSiSn с фиксированным содержанием Ge и содержанием Sn от 0 до 16% при температуре роста 150 ° С. . Построены фазовые диаграммы изменения сверхструктуры при эпитаксиальном росте Sn на Si и на Ge (100). Используя данные фазовой диаграммы, становится возможным идентифицировать покрытие Sn на поверхности Si и контролировать сегрегацию Sn на сверхструктуре, наблюдаемую на картине дифракции быстрых электронов на отражение (ДБЭО). Многослойные структуры с псевдоморфными слоями GeSiSn и массивом островков плотностью до 1,8 × 10 12 см −2 были выращены с учетом подавления сегрегации Sn за счет снижения температуры роста GeSiSn и Si. Двухдоменная (10 × 1) сверхструктура, связанная с присутствием Sn на поверхности, впервые была обнаружена в многослойных периодических структурах при росте Si на слое GeSiSn. Периодические структуры GeSiSn / Si демонстрировали фотолюминесценцию в диапазоне 0,6–0,85 эВ, соответствующем диапазону длин волн 1,45–2 мкм. Расчет зонной диаграммы для структуры с псевдоморфным Ge 0.315 Si 0,65 Sn 0,035 позволяет предположить, что пики фотолюминесценции соответствуют межзонным переходам между X долина в Si или Δ 4 -долина в GeSiSn и подзона тяжелых дырок в слое GeSiSn.
Фон
Эффективные светоизлучающие устройства не были представлены, поскольку Si является полупроводником с непрямой запрещенной зоной, хотя кремниевые фотонные устройства, такие как волноводы [1], фотодетекторы [2] и модуляторы [3], были успешно созданы.
Добавление Sn в матрицу твердого раствора Ge, Si или GeSi является одним из подходов к получению полупроводников с прямой запрещенной зоной на основе материалов IV группы. Включение Sn в решетку Ge уменьшает разницу между минимумами Г и L долины, и GeSn может стать прямым запрещенным материалом. Как было показано, прямолинейность для кубической решетки GeSn возникает при содержании Sn около 9% [4, 5]. Это значение может быть меньше 6% при наличии деформации растяжения, тогда как для пленок с деформацией сжатия переход можно ожидать при содержании Sn более 11% [6]. Уменьшение ширины запрещенной зоны за счет включения Sn позволяет увеличить рабочую длину волны от ближнего до среднего инфракрасного диапазона, что желательно в области оптических межсоединений, в волоконно-оптических системах связи нового поколения, датчиках, обработке сигналов, преобразовании энергии и т. Д. оптические запоминающие устройства [7]. Поэтому в последние годы значительно возрос интерес к классу материалов Ge-Si-Sn.
Большие усилия прилагаются для получения эпитаксиальных пленок GeSn инструментального качества [8, 9]. Одной из серьезных проблем является образование включений (выделений) Sn при росте слоя GeSn [10, 11]. Помимо осаждения, сегрегация Sn наблюдается в процессе роста слоев GeSn, GeSiSn и окисления пленки GeSn [11, 12]. Методы неравновесного роста, такие как молекулярно-лучевая эпитаксия (MBE) и химическое осаждение из газовой фазы (CVD), служат надежными методами подавления осаждения и сегрегации. Для уменьшения эффекта выделения и сегрегации Sn может быть выполнено снижение температуры роста [13] или деформационное включение, или добавление третьего элемента, например Si, который снижает локальное напряжение вокруг атомов Sn.
Данные о морфологии и структуре поверхности или о механизмах образования монокристаллических пленок GeSiSn практически не встречаются в литературе, несмотря на большие перспективы материалов на основе соединений IV группы. Эти данные необходимы для создания наногетероструктур с напряженными и релаксированными слоями GeSiSn. В данной работе впервые демонстрируются данные, связанные с созданием многослойных структур, сверхрешеток не только с псевдоморфными слоями GeSiSn, но и с наноостровками GeSiSn, которые не содержат дислокаций и позволяют изменять ширину запрещенной зоны материала в широких пределах. и покрывают инфракрасный диапазон длин волн, ранее недоступный для GeSi.
Целью данной работы является исследование роста упругонапряженной псевдоморфной пленки GeSiSn, формирование трехмерных наноостровков и получение многослойных периодических структур, содержащих псевдоморфные слои GeSiSn и наноостровки.
В наших предыдущих работах [14,15,16] кинетические диаграммы морфологического состояния пленки GeSiSn были построены для различных несоответствий параметров решетки между GeSiSn и Si в диапазоне содержания Sn от 0 до 8% с использованием дифракции электронов высоких энергий на отражение ( RHEED). В этой статье представлены новые критические зависимости толщины перехода от двумерного к трехмерному росту (2D-3D) от состава пленки GeSiSn с фиксированным содержанием Ge в диапазоне содержания Sn от 0 до 16%. Получены фазовые диаграммы изменения сверхструктуры при росте Sn на Si и Ge (100). Несмотря на то, что в [17,18,19] реконструкции поверхности Sn на Si изучались при различных оловянных покрытиях, наши данные продемонстрировали новые сверхструктуры. Кроме того, фазовая диаграмма изменения сверхструктуры при росте Sn на Ge (100) ранее нигде не была представлена. Оптические свойства многослойных периодических структур, включающих псевдоморфные слои GeSiSn, впервые были исследованы методом фотолюминесценции на образцах с различным содержанием Sn. Расчет зонной диаграммы гетероструктур GeSiSn / Si проводился с использованием подхода теории твердого тела [20].
Экспериментальный
Все образцы с псевдоморфными слоями GeSiSn и с наноостровками GeSiSn были выращены в условиях сверхвысокого вакуума 10 −7 –10 −8 Па на установке молекулярно-лучевой эпитаксии (МЛЭ) «Катунь С.» Камера эпитаксиального выращивания имеет испаритель электронного пучка для Si и эффузионные ячейки Кнудсена для Ge и Sn. Скорость роста слоя GeSiSn варьировалась от 0,015 до 0,05 нм / с. Эпитаксиальный рост проводился на подложках Si (100) в интервале температур 150–450 ° С с содержанием Sn от 0 до 20%. Были получены не только одиночные слои GeSiSn, но и многослойные периодические структуры, содержащие гетеропереходы GeSiSn / Si. Сначала наносился слой GeSiSn, который затем накрывался слоем Si толщиной 10 нм при температуре роста 400–500 ° С. Основным методом контроля изменений морфологии и структуры поверхности и исследования механизмов роста было отражение дифракции высокоэнергетических электронов (ДБЭО). Картина ДБЭ регистрировалась на видеокамеру во время выращивания. Затем был выбран профиль вместе с одним из кристаллографических направлений и созданы изменения интенсивности этого профиля в пространственно-временных координатах. Анализ пространственно-временного распределения интенсивности ДБЭО позволил нам изучить механизмы двумерного роста, изменений надстройки и образования трехмерных островков. Момент перехода от двумерного роста к трехмерному (переход 2D-3D) определялся по временной зависимости интенсивности рисунка ДБЭ вместе с одним из стержней, в направлении которого возникает объемный рефлекс. На основе метода определения перехода 2D-3D построены зависимости критической толщины перехода 2D-3D от содержания GeSiSn при фиксированном содержании Ge. На основе этих зависимостей задавалась толщина псевдоморфного слоя GeSiSn в многослойных структурах и создавались слои с массивом наноостровков GeSiSn. Морфология и структура поверхности анализировались методом сканирующей туннельной микроскопии (СТМ) на сверхвысоковакуумном оборудовании Omicron-Riber. Оптические свойства образцов исследовались методом фотолюминесцентной (ФЛ) спектроскопии с использованием монохроматора ACTON 2300i и охлаждаемого детектора OMA-V на основе матрицы фотодиодов InGaAs с полосой чувствительности от 1,1 до 2,2 мкм. Для возбуждения фотолюминесценции использовалось излучение Nd:YAG-лазера (532 нм).
Результаты и обсуждение
Исследован рост тонкой пленки GeSiSn при температуре 150 ° С в диапазоне содержания Sn от 0 до 16%. Накопление деформации происходит при осаждении слоя GeSiSn из-за несоответствия параметров решетки GeSiSn и Si. Переход от 2D-3D перехода наблюдается при определенной толщине. Процедура определения перехода 2D-3D на примере Ge 0.6 Si 0,28 Sn 0,12 Рост представлен на рис. 1. Имеются начальные картины ДБЭО с поверхности Si до Ge 0.6 Si 0,28 Sn 0,12 осаждение пленки (рис. 1а), окончательная картина ДБЭО (рис. 1в), образованная Ge 0.6 Si 0,28 Sn 0,12 массив островков и смачивающий слой, а также пространственно-временное распределение интенсивности вертикального профиля, указанного стрелкой на рис. 1а, и зависимость интенсивности горизонтального профиля (горизонтальный профиль, указанный на пространственно-временном распределении интенсивности на рис. 1б) на Ge 0.6 Si 0,28 Sn 0,12 толщина пленки (рис. 1б). Момент перехода 2D-3D определялся путем нанесения касательной к зависимости интенсивности от толщины (рис. 1б) в области резкого увеличения интенсивности. Такой подход общепринят [21].
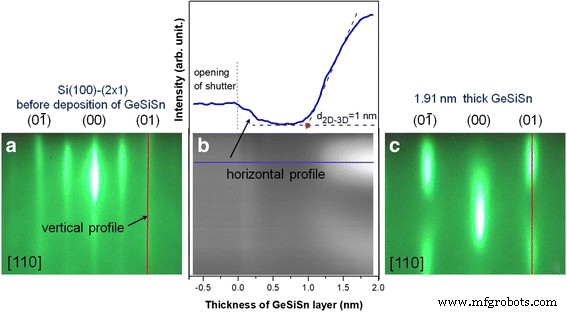
Определение момента перехода 2D-3D при выращивании пленки GeSiSn: a Картина ДБЭО с поверхности Si (100) - (2 × 1) перед Ge 0.6 Si 0,28 Sn 0,12 показан рост, b пространственно-временное распределение интенсивности вертикального профиля в серой шкале и зависимость интенсивности горизонтального профиля от нанесенного Ge 0.6 Si 0,28 Sn 0,12 толщина пленки. Профили обозначены стрелками в ( a ) и ( b ) и c окончательный образец ДБЭО после Ge 0,6 толщиной 1,91 нм Si 0,28 Sn 0,12 осаждение
Зависимости критической толщины перехода 2D-3D от состава для пленок GeSiSn с фиксированным содержанием Ge и содержанием Sn от 0 до 16% построены (рис. 2) с использованием описанной выше методики перехода 2D-3D. Ранее были опубликованы кинетические диаграммы морфологического состояния пленок GeSiSn в интервале температур 150–450 ° С при различном рассогласовании решеток GeSiSn и Si [14]. На основе анализа кинетической диаграммы определена оптимальная температура 150 ° С, при которой критическая толщина перехода 2D-3D достигает максимального значения и сегрегация Sn подавляется. Значение толщины пленки GeSiSn ниже кривой, соответствующей критической толщине 2D-3D перехода от температуры и состава, определяет область существования псевдоморфных пленок. На кривых наблюдается уменьшение критической толщины 2D-3D перехода с увеличением содержания Sn от 0 до 16% (рис. 2). Такое поведение объясняется эффектом деформации. Увеличение содержания Sn от 0 до 16%, например, Ge 0,6 Si 0,28 Sn 0,12 рост, приводит к увеличению несоответствия параметров решетки Ge 0,6 Si 0,28 Sn 0,12 и Si с 2,5 до 5,6% соответственно, что сокращает время и, как следствие, толщину перехода к трехмерным наноостровкам. Совершенно не ясна природа особенности, которая проявляется на кривой с содержанием Ge 30% и наблюдается при содержании Sn от 3 до 10% до конца. Зная величину критической толщины перехода 2D-3D, можно получить псевдоморфные пленки GeSiSn и использовать их в многослойных периодических структурах с гетеропереходом GeSiSn / Si. В наших экспериментах точность определения критической толщины перехода 2D-3D составляет 0,06 нм и определяется в основном неточностью поддержания расхода Si из-за нестабильности работы источника.
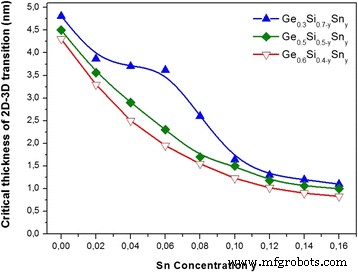
Критические зависимости толщины перехода 2D-3D от состава пленки GeSiSn при нескольких фиксированных значениях содержания Ge, Sn от 0 до 16% и температуре роста 150 ° С
Выбор толщины псевдоморфного слоя на основе полученных ранее кинетических диаграмм [16] и зависимостей критической толщины 2D-3D перехода от состава (рис. 2) позволяет выращивать не только отдельные слои GeSiSn, но и использовать эти слои. в многослойных периодических структурах. В периодической структуре GeSiSn / Si, где слой GeSiSn покрыт слоем Si, проблема возникает из-за сегрегации Sn на поверхности Si. Сегрегация Sn приводит к перестройке поверхности и появлению целого ряда сверхструктур в зависимости от поверхностной концентрации Sn. Исследование реконструкции поверхности при росте Sn на Si (100) и Ge (100) было необходимо для того, чтобы понять, какое покрытие Sn соответствует сверхструктуре, наблюдаемой на изображении ДБЭО. Фазовые диаграммы изменения надстройки построены в интервале температур 100–750 ° С. Подобная диаграмма роста Sn на Si (100) впервые была представлена в [17]. Ueda et al. нанесение Sn при комнатной температуре с последующим отжигом. Они наблюдали сверхструктуру только после отжига пленки. В наших экспериментах Sn наносился при температуре 100 ° С и получался на реконструированной поверхности Si (100– (2 × 1). Повышение температуры до 750 ° С приводило к формированию сверхструктурной серии на поверхности Влияние положения адсорбированных атомов Sn на поверхности Si (100) на энергию связи Sn-Si исследовалось с помощью фотоэлектронной спектроскопии в работе [18]. Увеличение покрытия Sn. Таким образом, все перестройки, происходящие при росте Sn на Si (100), можно объяснить уменьшением энергии поверхностной системы.Переход к трехмерному росту связан с накоплением деформаций из-за рассогласованию параметров решетки Sn и Si на 19% .Поликристаллический вид пленки наблюдался в [17] при толщине 3,2 ML (монослой) Sn. Образование поликристаллической пленки вызвано низкой температурой осаждения пленки Sn. То же самое относится и к Sn рост на поверхности Ge (100). В настоящее время статьи о сверхструктурах Sn на Ge (100) в литературе отсутствуют.

Фазовые диаграммы изменения надстройки при росте: а Sn на Si (100) и b Sn на Ge (100)
Указанные на диаграммах надстройки появляются как при повышении, так и при понижении температуры. Эти фазовые диаграммы помогают определить концентрацию Sn на поверхности при росте Si над слоем GeSiSn. Сверхструктуры, возникающие на поверхности Si в процессе роста периодической структуры, можно наблюдать при температурах, которые отличаются от температур, представленных на фазовых диаграммах. Слой Si наносится на поверхность GeSiSn при температурах 400–500 ° С; однако могут появиться сверхструктуры, характерные для всего диапазона температур, представленного на рис. 3. Создание структуры с гетеропереходами GeSiSn / Si требует предотвращения образования двухдоменной (5 × 1) сверхструктуры, которая связана с сегрегацией Sn и препятствием в формировании многослойной периодической структуры с псевдоморфными слоями (рис. 4а). ). Самый простой способ подавить сегрегацию Sn при росте Si над слоем GeSiSn - это рост Si в два этапа. На первом этапе происходит осаждение слоя Si толщиной 1-2 нм при комнатной температуре. Дальнейший рост Si продолжается при температуре 400–500 ° С. Эта температура определяется содержанием Sn в слое GeSiSn. Основные сверхструктурные серии, возникающие при росте Si на слое GeSiSn в многослойных периодических структурах, состоят из (2 × 1) + (2 × N), c (8 × 4), (4 × 1), (6 × 1) , и (5 × 1). Кроме того, на поверхности Si наблюдается двухдоменная (10 × 1) сверхструктура (рис. 4б). Эта сверхструктура не появлялась в экспериментах при росте Sn на Si и Ge, но можно сказать, что она соответствует минимальному покрытию Sn, так как исчезает при непродолжительном отжиге при температуре 400–500 ° С и температуре (2 × 1) появляется сверхструктура, характерная для поверхности Si.

Наблюдаемые сверхструктуры при росте Si на слое GeSiSn в многослойной периодической структуре в азимутальном [110] направлении: a (5 × 1) и b (10 × 1)
Получены периодические структуры, содержащие псевдоморфные слои или массив наноостровов GeSiSn. С помощью кинетических диаграмм морфологического состояния пленки GeSiSn исследован массив островков GeSiSn в многослойной периодической структуре. СТМ изображения Ge 0.75 Si 0,2 Sn 0,05 Поверхность с массивом наноостровов в первом (рис. 5а) и в пятом периоде (рис. 5б) с размером сканирования 400 нм × 400 нм. Массив островков был получен при температуре роста 250 ° С. Гистограммы распределения количества островов по размерам также показаны на рис. 5. Острова с плотностью 5,18 × 10 11 см −2 и средний размер 8,95 нм представлены на рис. 5в. Осажденный Ge 0,75 Si 0,2 Sn 0,05 Толщина пленки 1,78 нм. Средний размер островков в пятом периоде составляет около 4 нм, а плотность островков достигает 1,8 × 10 12 см −2 при эффективной толщине Ge 0,75 Si 0,2 Sn 0,05 пленки 1,89 нм, что следует из гистограммы на рис. 5г. Увеличение плотности в 3.5 раза и уменьшение размера островков в 2 раза может быть связано с увеличением доли Sn на поверхности Si с увеличением номера периода. Это утверждение подтверждается изменением сверхструктур, наблюдаемым по картине ДБЭО во время роста пленки Si над слоем GeSiSn, от (2 × 1) и (2 × N) к структуре поверхности c (8 × 4). Формирование сверхструктуры c (8 × 4) происходит в процессе роста Sn на Si, начиная с толщины покрытия 0,4 монослоя (МС) при температуре роста 400 ° С. При понижении температуры роста до 100 ° С можно увеличить плотность островков, но качество поверхности будет хуже. Повышение температуры роста до более 250 ° С усиливает сегрегацию Sn. Итак, оптимальный интервал температур роста слоев GeSiSn с массивом островков составляет 150–250 ° С, в котором наблюдаются осцилляции зеркального отражения при росте смачивающего слоя GeSiSn, что соответствует механизму 2D роста.

СТМ изображения Ge 0.75 Si 0,2 Sn 0,05 поверхность с размером сканирования 400 нм × 400 нм: a Ge 0,75 Si 0,2 Sn 0,05 поверхность в первом периоде, б Ge 0,75 Si 0,2 Sn 0,05 поверхность в пятом периоде; гистограммы распределения количества островков по размеру базы для Ge 0,75 Si 0,2 Sn 0,05 фильм: c в первом периоде (Ge 0,75 Si 0,2 Sn 0,05 толщина пленки 1,78 нм) и d в пятом периоде (Ge 0,75 Si 0,2 Sn 0,05 толщина пленки 1,89 нм)
Кристаллическое совершенство многослойной структуры исследовали методом просвечивающей электронной микроскопии (ПЭМ). ПЭМ-изображения многослойной структуры с Ge 0,5 Si 0,45 Sn 0,05 Гетеропереход / Si и период 25 нм показаны на рис. 6. Из данных ПЭМ можно сделать вывод, что наши образцы не содержат пронизывающих дислокаций и являются идеальными кристаллическими с острыми границами раздела. Псевдоморфное состояние пленки GeSiSn в многослойной периодической структуре, кристаллическая решетка и деформации обсуждаются в [14] на основе анализа данных, полученных с помощью ПЭМ. Состав пленки GeSiSn определялся в потоках Si, Ge и Sn. Скорость роста Si, Ge и Sn измерялась кварцевым толщиномером. Состав пленки GeSiSn был идентифицирован методом рентгеновской дифрактометрии. Анализ показал совпадение как заданного, так и измеренного составов.
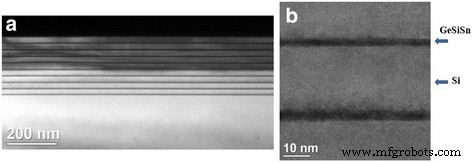
а ПЭМ-изображение многослойной структуры, включая Ge 0,5 Si 0,45 Sn 0,05 гетеропереход с периодом 25 нм. б ПЭМ-изображение высокого разрешения той же структуры
Методом фотолюминесценции исследованы оптические свойства многослойных периодических структур со слоями GeSiSn для структур с различным содержанием Sn. Структуры демонстрировали фотолюминесценцию в диапазоне 0,6–0,8 эВ, что соответствует диапазону длин волн 1,45–2 мкм (рис. 7). Получены спектры фотолюминесценции с максимумами интенсивности при 0,78, 0,69 и 0,65 эВ. Они соответствуют длинам волн 1,59, 1,8 и 1,9 мкм и наблюдаются при 3,5, 4,5 и 6% Sn соответственно. Увеличение содержания Sn в слое GeSiSn приводит как к уменьшению энергии оптических переходов, так и к увеличению интенсивности фотолюминесценции. Увеличение интенсивности может быть вызвано увеличением глубины квантовой ямы для более высокого содержания Sn в слое твердого раствора GeSiSn. Для продвижения в диапазоне длин волн более 2 мкм требуется увеличение содержания Sn в слоях GeSiSn. Для определения оптических переходов, наблюдаемых в спектрах люминесценции, необходимо было рассчитать зонную диаграмму гетероструктуры GeSiSn / Si.

Спектры фотолюминесценции многослойных периодических структур с содержанием 3,5, 4,5 и 6% Sn в псевдоморфных слоях GeSiSn
Зонная диаграмма гетероструктуры GeSiSn / Si рассчитывалась с использованием подхода теории модельного твердого тела [20]. В рамках этой модели оба полупроводника, образующих гетеропереход, необходимо привести к единой «энергетической» шкале, чтобы определить положение зоны в гетеропереходе. Величина валентной запрещенной зоны гетероструктур Ge / Si в гетеропереходе хорошо известна [22] и составляет 0,54 эВ; кроме того, валентная зона Ge лежит выше по энергии, чем валентная зона Si. Ширина запрещенной зоны между Ge и Sn известна из модели, представленной в [23], и составляет 0,69 эВ [24]. Таким образом, значение ширины запрещенной зоны на гетерогранице для Si / Si 1-x-y Ge x Sn y гетероструктуру можно записать как:
$$ {E} _ {v, av} =0,54x + 1,23y $$Поскольку валентная зона полупроводника образована подзонами тяжелых и легких дырок, а также подзоной, отщепленной спин-орбитальным взаимодействием; затем положение валентной зоны ( E v, av ), усредненное по трем подзонам, используется для определения ширины запрещенной зоны и построения зонной диаграммы гетероструктуры. Для определения положения подзоны тяжелых и легких дырок, а также подзоны, разделенной спин-орбитальным взаимодействием, используются следующие выражения:
$$ {\ displaystyle \ begin {array} {l} {E} _ {\ mathrm {HH} \ left (\ mathrm {LH} \ right)} ={E} _ {v, av} + {\ Delta} _0 / 3 \\ {} {E} _ {\ mathrm {SO}} ={E} _ {v, av} -2/3 {\ Delta} _0 \ end {array}}, $$где индексы HH, LH и SO указывают на подзону тяжелых и легких дырок, а также подзону с разделением по спину. Δ 0 значение обозначает энергию спин-орбитального расщепления в полупроводнике. После определения положения подзоны валентной зоны в гетеропереходе положения соответствующих впадин зоны проводимости определяются с использованием выражения:
$$ {E} ^ n ={E} _ {\ mathrm {Ge}} ^ n \ left (1-xy \ right) + {E} _ {\ mathrm {Si}} ^ nx + {E} _ {\ mathrm {Sn}} ^ ny- {b} _ {\ mathrm {Si} \ mathrm {Ge}} ^ nx \ left (1-xy \ right) - {b} _ {\ mathrm {Sn} \ mathrm {Ge }} ^ ny \ left (1-xy \ right) - {b} _ {\ mathrm {Si} \ mathrm {Sn}} ^ n xy, $$где индексы n = Γ , L , и X укажите соответствующие долины \ ({b} _ {\ mathrm {SiGe}} ^ n \), \ ({b} _ {\ mathrm {SnGe}} ^ n \) и \ ({b} _ {\ mathrm {SiSn}} ^ n \) –– параметры «изгиба» с учетом отклонения от линейного закона для ширины запрещенной зоны, \ ({E} _ {\ mathrm {Ge}} ^ n \), \ ({ E} _ {\ mathrm {Si}} ^ n \) и \ ({E} _ {\ mathrm {Sn}} ^ n \) –– запрещенные зоны Ge, Si и Sn в соответствующей долине. Практически все параметры взяты из [24]. Параметры изгиба долин L и Г взяты из [25].
После определения положения всех интересующих нас полос в гетеропереходе учитывались их смещения под действием деформаций. Влияние деформаций на ширину запрещенной зоны учитывалось с помощью констант деформационного потенциала [26]. Поскольку двумерные слои были псевдоморфными, в нашем случае для определения деформаций использовался стандартный подход, описанный, например, в [26]:деформации в плоскости квантовой ямы можно определить как ε xx (yy) = ε ǀǀ =( а GeSiSn - а Si ) / а Si , где a –– постоянная решетки соответствующего материала. В направлении, перпендикулярном плоскости квантовой ямы, величина деформации ε zz =−2 ( С 12 / С 11 ) ε xx можно определить с помощью C 12 и C 11 упругие модули кристаллического соединения. Постоянная решетки твердого раствора определялась из квадратичного соотношения:
$$ {a} _ {\ mathrm {Ge} \ mathrm {SiSn}} ={a} _ {\ mathrm {Ge}} \ left (1-xy \ right) + {a} _ {\ mathrm {Si} } x + {a} _ {\ mathrm {Sn}} y + {b} _ {\ mathrm {Si} \ mathrm {Ge}} ^ {\ hbox {'}} x \ left (1-x \ right) + { b} _ {\ mathrm {Sn} \ mathrm {Ge}} ^ {\ hbox {'}} y \ left (1-y \ right), $$где a Ge , а Si , а Sn –– Параметры решетки Ge, Si и Sn [24], \ ({b} _ {\ mathrm {SiGe}} ^ {\ hbox {'}} \) =- 0,026 Å, \ ({b} _ {\ mathrm {SnGe}} ^ {\ hbox {'}} \) =0,166 Å –– параметры «изгиба» с учетом отклонения от закона Вегарда.
Согласно расчетам зонной диаграммы, пики ФЛ соответствуют межзонным переходам между X-долиной Si или Δ 4 -долина из GeSiSn и зона тяжелых дырок в слое GeSiSn (рис. 8).
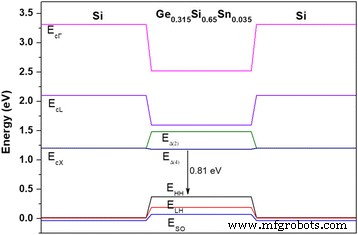
Si / Ge 0,315 Si 0,65 Sn 0,035 / Зонная диаграмма гетерокомпозиции Si
Выводы
Определены критические зависимости толщины перехода 2D-3D от состава слоев GeSiSn с фиксированным содержанием Ge и содержанием Sn, изменяющимся от 0 до 16% при температуре роста 150 ° С. Были построены сверхструктурные фазовые диаграммы для эпитаксиального роста Sn на Si (100) и Ge (100). Многослойные периодические структуры с псевдоморфными слоями и массивом островков GeSiSn плотностью до 1,8 × 10 12 см −2 были получены. Впервые в многослойной периодической структуре при росте Si на слое GeSiSn наблюдалась двухдоменная сверхструктура (10 × 1), которая при небольшом отжиге трансформируется в сверхструктуру (2 × 1). Периодические структуры GeSiSn / Si продемонстрировали фотолюминесценцию в диапазоне 0,6–0,8 эВ, что соответствует диапазону длин волн 1,45–2 мкм. На основе расчетов зонной диаграммы для структуры с псевдоморфным Ge 0,315 Si 0,65 Sn 0,035 пики ФЛ соответствуют межзонным переходам между X-долиной Si или Δ 4 -долина из GeSiSn и зона тяжелых дырок в слое GeSiSn. Дальнейший прогресс в длинноволновой области требует исследования оптических свойств структур с большим содержанием Sn.
Сокращения
- CVD:
-
Химическое осаждение из паровой фазы
- MBE:
-
Молекулярно-лучевая эпитаксия
- ML:
-
Монослой
- PL:
-
Фотолюминесценция
- RHEED:
-
Дифракция электронов высоких энергий на отражение
- STM:
-
Сканирующая туннельная микроскопия
- ТЕМ:
-
Просвечивающая электронная микроскопия
Наноматериалы
- Полупроводниковые наночастицы
- Структура и электронные свойства наноглины каолинита, легированной переходным металлом
- Модуляция свойств электронной и оптической анизотропии ML-GaS вертикальным электрическим полем
- Легкий синтез и оптические свойства малых нанокристаллов и наностержней селена
- Оптические и электрические характеристики кремниевых нанопроволок, полученных методом химического травлен…
- Влияние воды на структуру и диэлектрические свойства микрокристаллической и наноцеллюлозы
- Влияние толщины бислоя на морфологические, оптические и электрические свойства наноламинатов Al2O3 / ZnO
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Оптические и электронные свойства фемтосекундных лазерно-индуцированных гипердопированных серой кремниевы…
- Получение и оптические свойства пленок GeBi с использованием метода молекулярно-лучевой эпитаксии



