Механизм проводимости и повышение выносливости в RRAM на основе HfO2 с лечением нитридом
Аннотация
Технология азотирования с использованием источника азота из комплекса мочевина / аммиак улучшила резистивное переключение в HfO 2 на основе резистивной оперативной памяти (RRAM). В результате азотирования получено высокопроизводительное и надежное устройство, обеспечивающее превосходную выносливость (более 10 9 циклов) и эффект самодостаточности. Таким образом, механизм токопроводимости изменился из-за пассивации дефектов атомами азота в HfO 2 тонкая пленка. В состоянии высокого сопротивления (HRS) он перешел в излучение Шоттки от Пула-Френкеля в HfO 2 на базе RRAM. В состоянии с низким сопротивлением (LRS) механизм проводимости тока был ограничен током пространственного заряда (SCLC) после обработки нитридом, что предполагает, что атомы азота образуют кластеры вакансий Hf – N – Ox (V o + ), которые ограничивают движение электронов через переключающий слой.
Фон
В последнее время резистивная память с произвольным доступом (RRAM), состоящая из изолирующего слоя, зажатого двумя электродами, широко изучалась как многообещающий кандидат для энергонезависимой памяти следующего поколения благодаря своим превосходным свойствам, таким как простая структура, низкое энергопотребление, высокая скорость работы. (<300 пс) и неразрушающее считывание [1–9]. Хотя большинство устройств RRAM по многим характеристикам превосходят энергонезависимую память, высокий рабочий ток RRAM и снижение производительности являются основными проблемами энергонезависимой памяти с точки зрения применения портативных электронных устройств.
Pt / HfO 2 Структура / TiN может обеспечивать токопроводящий путь, который вызывает резистивное переключение [10–19]. Однако дефекты аморфного HfO 2 увеличит количество путей утечки, что приведет к снижению энергопотребления и джоулева нагрева. В данной работе резистивный коммутирующий слой HfO 2 был обработан раствором с источником азота комплекса мочевина / аммиак в качестве нитридной обработки для улучшения его электрических коммутационных свойств.
Методы
Узорчатый TiN / Ti / SiO 2 Подложка / Si была изготовлена с помощью стандартного процесса осаждения и травления, после чего могут быть сформированы сквозные отверстия (вставка на рис. 1а). Затем HfO 2 толщиной 23 нм Тонкая пленка была нанесена в сквозные отверстия на подложке с помощью высокочастотного магнетронного распыления с использованием чистого HfO 2 цель. Мощность распыления была зафиксирована на уровне ВЧ-мощности 150 Вт и проводилась в среде аргона (Ar =30 sccm) с рабочим давлением 4 мТорр при комнатной температуре. HfO 2 / Устройство полуфабриката из TiN помещали в реакционную камеру и погружали в раствор с источником азота из комплекса мочевина / аммиак для обработки нитридом. Во время обработки азотированием раствор нагревали до 160 ° C в камере из нержавеющей стали системы в течение 30 минут. Затем верхний платиновый электрод толщиной 110 нм был нанесен магнетронным распылением на постоянном токе на HfO 2 тонкая пленка для формирования электрических устройств с Pt / HfO 2 / Сэндвич-конструкции из TiN. Наконец, все электрические характеристики были измерены с помощью анализатора параметров полупроводников Agilent B1500. Во время электрических измерений к нижнему электроду (TiN) прикладывались постоянный ток и импульсное качающееся смещение, в то время как верхний электрод (Pt) был заземлен. Кроме того, инфракрасная спектроскопия с преобразованием Фурье (FTIR) была измерена спектрометром Bruker VERTEX 70v в средней инфракрасной области.

а Формирующие кривые тока HfO 2 устройства на базе RRAM. б Сравнение циклов развертки постоянного тока при токе согласования 5 мА между начальной и после обработки азотированием HfO 2 на базе RRAM. c Циклы развертки постоянного тока без соблюдения внешнего тока HfO 2 устройство после азотирования. г Время удерживания HfO 2 устройства на основе RRAM при 85 ° C с податливым током и без него после азотной обработки
Результаты и обсуждение
Процесс гальванопластики требуется для активации всех устройств RRAM с использованием смещения постоянного тока с током согласования 10 мкА, как показано на рис. 1a. После процесса формования электрические вольт-амперные (I-V) свойства HfO 2 RRAM на основе RRAM сравнивали при начальной и после обработки азотированием. В LRS ток был явно снижен по сравнению с током необработанного HfO 2 тонкая пленка, как показано на рис. 1b. Снижение тока можно отнести к дефектам, пассивированным NH 3 молекула в лечебном растворе. Мы обнаружили, что распределение HRS намного более стабильно после обработки азотированием, как показано на вставке к рис. 1b. Состояния сопротивления извлекаются с напряжением считывания 0,1 В в течение 100 циклов развертки с режимом постоянного тока (вставка на рис. 1b). Отношение сопротивления включения / выключения было немного снижено после обработки азотированием. Интересно, что в этих HfO 2 наблюдалось свойство самодостаточности резистивной коммутации. устройства на основе RRAM после обработки, как показано на рис. 1c. После более чем 10 3 циклов развертки наблюдалась повторяемая самозащитная характеристика устройства без серьезных поломок. Время удерживания оценивали при 85 ° C и оставалось стабильным даже после 10 4 s как в HRS, так и в LRS.
Чтобы дополнительно оценить производительность устройства, тесты на выносливость HfO 2 RRAM на основе RRAM были выполнены для начальной и после обработки азотированием, как показано на рис. 2. В необработанном устройстве после 10 6 В циклах развертки соотношение HRS / LRS значительно ухудшается с 100:1 до 5:1, как показано на рис. 2a. Однако после азотирования, даже после более чем 10 9 циклов развертки устройство показало стабильное соотношение HRS / LRS, как показано на рис. 2b. Эти результаты показывают, что процесс азотирования увеличил содержание HfO 2 RRAM на основе RRAM для работы с превосходными функциями переключения и надежностью. Для дальнейшего исследования этих результатов был использован FTIR-анализ для наблюдения за химическими изменениями HfO 2 тонкая пленка, как показано на рис. 3. Острый пик на 1589 и 1311 см −1 появились после обработки азотированием, что соответствует симметричному и асимметричному пику валентных колебаний связи N – O [20]. Кроме того, максимальная интенсивность связей N – H при 1471 см −1 [21] увеличилось из-за процесса нитридизации источником азота из комплекса мочевина / аммиак (вставка на рис. 3). Следовательно, мы можем сделать вывод об образовании азотсодержащих соединений после обработки азотированием.
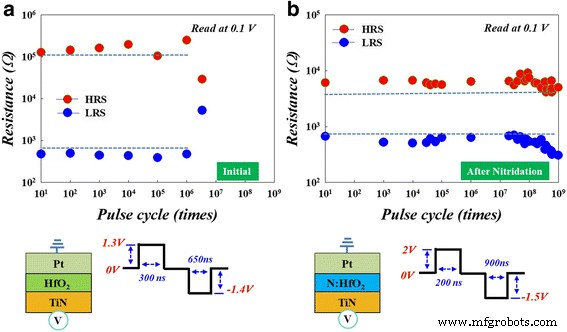
Сравнение времени выдержки в HfO 2 на основе RRAM: a начальная и b после азотирования. На нижних диаграммах показаны соответствующие структуры устройства и режимы импульсов выносливости

Сравнение ИК-Фурье спектров HfO 2 тонкие пленки между начальной и последующей обработкой азотированием
Чтобы прояснить механизм резистивного переключения, мы проанализировали механизм проводимости тока HfO 2 тонкая пленка с обработкой азотированием и без нее, показанная на рис. 4a и d. Для необработанного HfO 2 В тонкой пленке электроны переносились через дефекты, так что в механизме проводимости тока преобладала проводимость Пула-Френкеля в соответствии с линейной зависимостью между ln (I / V) и квадратным корнем из приложенного напряжения (V 1 / 2 ) на HRS, как показано на рис. 4b [22].
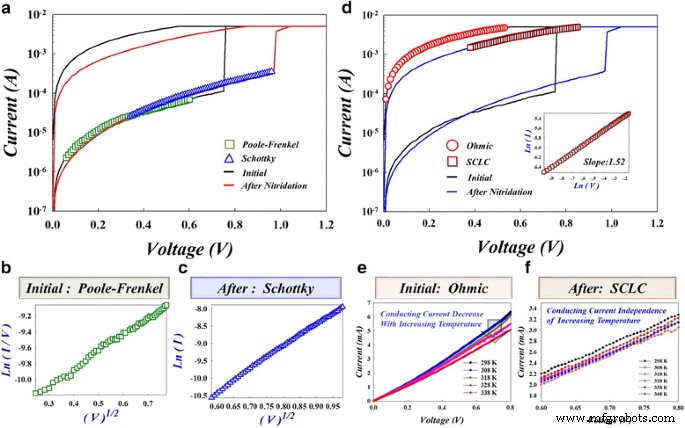
а Анализ механизма проводимости тока HRS по ВАХ в HfO 2 RRAM на основе RRAM между начальной и после обработки азотированием. б Механизм проводимости тока Пула-Френкеля HRS в HfO 2 на базе RRAM. c Механизм проводимости эмиссионного тока Шоттки HRS в HfO 2 на основе RRAM после обработки азотированием. г Анализ механизма токопроводимости LRS, который превращается в SCLC из омической проводимости после обработки нитридом в HfO 2 -на основе RRAM; на вставке показан текущий результат подгонки SCLC. е Механизм омической проводимости LRS в HfO 2 на основе RRAM, что характерно для текущей отрицательной корреляции с температурой. е Механизм SCLC LRS в HfO 2 на основе RRAM, который не зависит от температуры после азотирования
Напротив, HfO 2 RRAM на основе RRAM демонстрирует механизм эмиссии Шоттки в соответствии с линейной зависимостью между ln (I / T 2 ) и квадратный корень из приложенного напряжения (V 1/2 ) HRS, как показано на рис. 4в [23, 24]. Это связано с уменьшением количества дефектов и оборванных связей, так как связи пассивируются атомами азота после обработки азотом. Кроме того, мы также проанализировали механизм проведения тока с обработкой и без обработки в LRS в HfO 2 на базе RRAM. На LRS - транспортный механизм необработанного HfO 2 В RRAM на основе RRAM преобладала омическая проводимость, при которой ток уменьшается с повышением температуры, как показано на рис. 4e. После обработки азотом механизм проводимости тока переходит в ток, ограниченный пространственным зарядом (SCLC), с крутизной 1,52. Кривая ВАХ не зависит от температуры, с линейной зависимостью между ln (I) и квадратом приложенного напряжения V 2 на LRS, как показано на рис. 4f [25].
Мы предложили модель для объяснения характеристик механизма проводимости тока, и она показана на рис. 5. Таким образом, есть два смещающих диполя, связанных с атомами N и O, и атом Hf (т.е. последовательность O – Hf – O заменяется на O – Hf – N – O) после легирования атомов N в HfO 2 тонкая пленка. Поскольку электронная отрицательность азота ниже, чем у кислорода, диполь связи Hf – N ниже, чем связь Hf – O, что создает более низкую область диэлектрической проницаемости. Когда в процессе SET прикладывается положительное смещение, из-за их более низкой диэлектрической проницаемости образуется серия вакансий Hf – N – Ox, которые затем образуют кластеры вакансий (Vo + ). Проводящий путь обычно формируется вместе с кластерами вакансий Hf – N – Ox (Vo + ), когда атомы азота захватывают ионы кислорода вокруг кластеров, как показано на рис. 5б. Наличие этих изолирующих кластеров вакансий Hf – N – Ox (Vo + ) приводит к снижению тока и эффекту самодостаточности, обнаруженному в HfO 2 на основе RRAM.

Схема миграции ионов кислорода через заданный процесс в HfO 2 на основе RRAM для a начальная и b после азотирования образует кластеры вакансий Hf – N – Ox (V o + )
Выводы
Таким образом, в Pt / HfO 2 наблюдалось свойство самодостаточности резистивного переключения. / Устройство TiN RRAM после азотирования. Время выносливости достигло 10 9 . циклов и время удерживания более 10 4 s достигается при 85 ° C. Из-за меньшей электронной отрицательности атома азота по сравнению с атомом кислорода, диполь связи Hf – N меньше, чем диполь связи Hf – O, что создает более низкую диэлектрическую проницаемость. В процессе SET вакансионные кластеры Hf – N – Ox (Vo + ) образуют токопроводящую дорожку. Изолирующие вакансионные кластеры Hf – N – Ox (Vo + ) защитить устройство от серьезной поломки и выполнить свойство самоконтроля.
Сокращения
- FTIR:
-
Инфракрасная спектроскопия с преобразованием Фурье
- HRS:
-
Состояние высокого сопротивления
- LRS:
-
Состояние низкого сопротивления
- RRAM:
-
Резистивная память с произвольным доступом
- SCLC:
-
Ограниченный ток пространственного заряда
Наноматериалы
- Масло и маргарин
- Интервью с экспертом:Спенсер Райт из pencerw.com и nTopology
- Набирая обороты с Markforged:формование и литье колес, напечатанных на 3D-принтере
- Материалы:пена EPP с улучшенными свойствами поверхности и оптимизированным поведением заполнения
- Умный наноматериал и нанокомпозит с продвинутой агрохимической активностью
- Модель удержания TaO / HfO x и TaO / AlO x RRAM с характеристиками самовосстанавливающегося переключателя
- Наночастицы альбумина, содержащие ресвератрол, с длительным кровообращением и улучшенной биосовместимостью…
- Повышение противоопухолевой эффективности и фармакокинетики буфалина с помощью пегилированных липосом
- Токсичность наночастиц CoFe2O4, покрытых ПЭГ, с лечебным эффектом куркумина
- Снижение контактного сопротивления между металлом и n-Ge за счет введения ZnO при обработке аргоновой плазмой



