Анализ инфракрасного отражения эпитаксиальных легированных слоев GaN n-типа, выращенных на сапфире
Аннотация
Инфракрасная (ИК) спектроскопия отражения применяется для исследования многослойного n + , легированного кремнием. / n 0 / n + -Структура GaN, выращенная на буфере GaN с GaN-шаблоном / сапфировой подложкой. Анализ исследуемой структуры методами фототравления, SEM и SIMS показал наличие дополнительного слоя с резкой разницей в уровнях легирования Si и O, расположенного между эпитаксиальным буфером GaN и шаблоном. Моделирование экспериментальных спектров отражения проводилось в широком диапазоне частот. Показано, что моделирование спектра ИК-отражения с использованием метода матрицы переноса 2 × 2 и включение в анализ дополнительного слоя позволяет получить наилучшее соответствие экспериментального спектра, что следует при оценке толщин слоев GaN, находящихся в хорошем состоянии. согласование с данными SEM и SIMS. Спектральная зависимость связанных мод плазмон-LO-фонон для каждого слоя GaN получается из спектральной зависимости диэлектрика легирующей примеси Si, которая объясняется эффектами компенсации акцепторными состояниями.
Фон
В последние годы наблюдается повышенный интерес к III-нитридным материалам, в частности к GaN [1, 2]. Благодаря прорыву в технологиях выращивания эпитаксиальные пленки GaN нашли широкое применение в оптоэлектронных устройствах, таких как синие и ультрафиолетовые светодиоды (светодиоды) [3], лазеры [4] и микроэлектронные устройства, например. ж., мощные и высокочастотные полевые транзисторы [5, 6]. Концентрация и мобильность свободных носителей - ключевые параметры, определяющие производительность устройства в приложениях. Измерение Холла концентрации и подвижности свободных носителей в многослойных структурах устройств на основе GaN - нетривиальная и трудоемкая технологическая задача, требующая присоединения омических контактов к каждому измерительному слою и специальных процедур измерения.
Инфракрасная (ИК) спектроскопия отражения с преобразованием Фурье и спектроскопия комбинационного рассеяния света являются бесконтактными и неразрушающими методами, которые позволяют изучать не только фононные колебания, но и характеризовать свойства носителей [7]. Однако известной проблемой конфокальной микро-рамановской спектроскопии является ухудшение пространственного разрешения по глубине из-за преломления света [8]. Это было показано в исх. [6], при сканировании по глубине многослойной структуры GaN с длиной волны возбуждения 488.0 нм разрешение по глубине составляет всего около 1,8 мкм, а разрешение по горизонтали составляет около 210 нм. ИК-спектроскопия решает эту проблему благодаря высокой чувствительности к толщине слоя из-за интерференционных эффектов и влияния дисперсии показателя преломления в широком спектральном диапазоне.
Спектры ИК-отражения тонких пленок GaN исследовались еще в 1973 г. А.С. Бейкера [9], но пространственная неоднородность и в целом низкое структурное качество таких пленок существенно ограничивали практическое применение полученных результатов. Тем не менее была продемонстрирована возможность определения параметров поглощения оптических фононов и свободных носителей заряда в тонких пленках GaN. Детальные исследования продольного оптического фонона - плазмонно-связанные (LOPC) моды в объемном GaN были выполнены Перлином и др. [10] с использованием рамановской спектроскопии и Shubert et al. [11] с использованием ИК-эллипсометрии. Влияние различных подложек на оптические свойства кубических и вюрцитных пленок GaN также детально исследовано [12,13]. Учитывая отсутствие подложек из природного GaN, было показано, что использование сапфировых подложек для эпитаксиального роста пленки GaN оптимально для использования в устройствах, работающих при высоких температурах. Исследования гексагонального сапфира методом ИК-спектроскопии отражения [14] показали сложный спектр, форма которого сильно зависит от поляризации и угла падения. Это значительно затрудняет измерения и определение спектральных характеристик фононных мод и свойств свободных носителей в тонкой пленке GaN, выращенной на сапфировых подложках.
Таким образом, правильный выбор алгоритма спектрального анализа и вида диэлектрической проницаемости имеет большое значение для анализа спектров ИК-отражения многослойных структур GaN-на-сапфире [15,16,17]. В данной работе показана возможность применения метода ИК-спектроскопии отражения и метода матрицы переноса 2 × 2 для анализа планарных многослойных структур на основе GaN с неоднородной глубиной и профилями легирования, которые на практике могут быть разными типами полупроводниковых III-нитридов. на основе структур устройств с вертикальной конструкцией, таких как светоизлучающие и выпрямительные диоды, диоды Ганна, транзисторы с высокой подвижностью электронов (HEMT) и т. д.
Методы
Экспериментальный
Исследуемые n + / n 0 / n + -GaN-структуры были выращены на шаблонах MOCVD GaN на Al 2 О 3 (0001) подложек при температуре 800 ° C методом плазменной молекулярно-лучевой эпитаксии с использованием N 2 расход 0,5 sccm и мощность ВЧ плазмы 350 Вт (рис. 1). Это приводит к скорости роста ~ 0,27 мл / с -1 . . Сначала на матрице MOCVD GaN выращивали буфер GaN толщиной 0,3 мкм. За слоем GaN, легированным кремнием, толщиной 0,8 мкм следовали нелегированный слой GaN толщиной 1,75 мкм и слой GaN, легированный кремнием толщиной 0,4 мкм (рис. 1). Номинальная концентрация легирования Si в n + -GaN слоев было ∼ 10 19 см −3 .
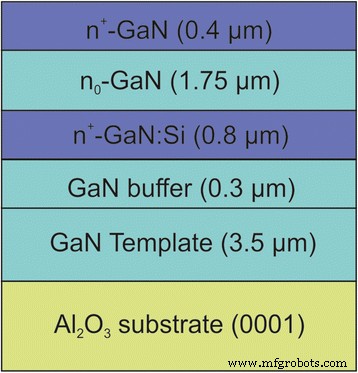
Схема исследуемого n + / n 0 / n + -Структура GaN, выращенная на GaN-шаблоне / (0001) сапфировой подложке
Чтобы исследовать области с различной концентрацией носителей, сколотый край исследуемой структуры исследовали методом фототравления в безэлектролитической конфигурации с использованием K 2 S 2 О 8 Водный раствор –KOH (система травления KSO-D) [18]. Этот метод позволяет выявить области с различной концентрацией носителей и визуализировать относительные различия концентраций носителей путем измерения скорости травления с помощью профилирования поверхности [19, 20]. Поперечное сечение исследуемого образца подвергалось фототравлению в течение 3 мин. После этого образцы были исследованы с помощью сканирующей электронной микроскопии (СЭМ).
Исследования образцов методом масс-спектроскопии вторичных ионов (SIMS) были выполнены на системе CAMECA IMS6F с использованием цезия (Cs + ) первичный пучок с током 400 нА для определения профиля концентрации примесей. Размер растра составлял примерно 50 × 50 мкм 2 , а вторичные ионы собирались из центральной области диаметром 30 мкм. Для H, C, O и Si концентрации были получены из H–, O–, C–, Si– частиц соответственно, а матричный сигнал Ga– был взят за эталон.
Измерения методом инфракрасной спектроскопии отражения в спектральном диапазоне 300–4000 см −1 со спектральным разрешением 1 см −1 были выполнены при комнатной температуре с использованием FTIR-спектрометра Bruker Vertex 70 V, оборудованного источником Globar и детектором дейтерированного триглицинсульфата (DLaTGS) с полиэтиленовым окном. Угол падения 11 °. S -поляризованные спектры измеряли с помощью поляризатора КРС-5. Спектр отражения золотого зеркала использовался в качестве эталона.
Описание модели оптического анализа
Коэффициент отражения системы слои / подложка был рассчитан с использованием метода матрицы переноса 2 × 2 [17, 21], в котором может быть включено произвольное количество слоев и автоматически учитываются интерференционные эффекты внутри пленок. Метод матрицы переноса 2 × 2 для изотропных слоистых систем позволяет независимо вычислять s - и p -поляризованные спектры отражения и пропускания в случае слоистых систем, состоящих из однородных двухосных или одноосных изотропных пластин, ось c которых совпадает с осью z лабораторных координат. В этом случае матрица переноса многоуровневой системы 2 × 2 может быть представлена в следующем виде [21]:
$$ {\ left (\ begin {array} {c} \ hfill {E} _0 ^ {+} \ hfill \\ {} \ hfill {E} _0 ^ {-} \ hfill \ end {array} \ right) } _ {s / p} =\ frac {1} {t_ {0,1} ^ {s / p}} \ left (\ begin {array} {cc} \ hfill 1 \ hfill &\ hfill - {r} _ {1,0} ^ {s / p} \ hfill \\ {} \ hfill {r} _ {1,0} ^ {s / p} \ hfill &\ hfill 1 \ hfill \ end {array} \ right ) {\ displaystyle \ prod_ {l =1} ^ N {T} _ {l / \ left (l + 1 \ right)} ^ {s / p} {\ left (\ begin {array} {c} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {+} \ hfill \\ {} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {-} \ hfill \ end {массив } \ right)} _ {s / p}} ={\ left (\ begin {array} {cc} \ hfill {T} _ {11} \ hfill &\ hfill {T} _ {12} \ hfill \\ {} \ hfill {T} _ {21} \ hfill &\ hfill {T} _ {22} \ hfill \ end {array} \ right)} _ {s / p} {\ left (\ begin {array} { c} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {+} \ hfill \\ {} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {-} \ hfill \ end {array} \ right)} _ {s / p}. $$ (1)Звездочки в верхних индексах амплитуды поля в выходной среде используются в формуле. (1) для учета значений компонентов электрического поля справа от N / N +1 интерфейс.
Передаточная матрица \ (2 \ times 2 \ kern0.24em {T} _ {l, \ left (l + 1 \ right)} ^ {s / p} \) учитывает распространение плоских волн от l -й слой, множественные отражения внутри этого слоя и влияние l / (l + 1) интерфейс. Такую матрицу можно определить как [17]:
$$ {T} _ {l / \ left (l + 1 \ right)} ^ {s / p} =\ frac {1} {t_ {l / \ left (l + 1 \ right)} ^ {s / p}} \ left (\ begin {array} {cc} \ hfill \ exp \ left (i {\ delta} _l ^ {s / p} \ right) \ hfill &\ hfill - {r} _ {l + 1 , l} ^ {s / p} \ exp \ left (i {\ delta} _l ^ {s / p} \ right) \ hfill \\ {} \ hfill {r} _ {l, l + 1} ^ { s / p} \ exp \ left (-i {\ delta} _l ^ {s / p} \ right) \ hfill &\ hfill \ exp \ left (-i {\ delta} _l ^ {s / p} \ right ) \ hfill \ end {array} \ right), $$ (2)где \ ({r} _ {l, l + 1} ^ {s / p} \) и \ ({t} _ {l, l + 1} ^ {s / p} \) обозначают коэффициенты частичного отражения и пропускания для l / (l + 1) интерфейса, \ ({\ delta} _l ^ {s / p} \) - фазовый сдвиг, наложенный на свет после его распространения посредством l- -й слой для s - и p -поляризованный свет.
Фазовый сдвиг на с - и p -поляризованный свет после прохождения через l- -й слой можно определить как [17]:
$$ {\ delta} _l ^ {s / p} =\ frac {2 \ pi {d} _l} {\ lambda} {n} _ {l, s / p} \ cos {\ theta} _ {l, s / p} =\ frac {2 \ pi {d} _l} {\ lambda} {n} _l \ sqrt {1 - {\ left (\ frac {1} {n_ {l, s / p}} \ sin \ theta \ right)} ^ 2}, $$ (3)где n l это the комплексный показатель преломления для l- й слой, d l толщина l- -й слой и θ угол падения.
Коэффициенты частичного отражения и передачи для s - и p -поляризации можно рассчитать с помощью уравнений Френеля. Например, коэффициенты частичного отражения и передачи для s -поляризации имеют следующий вид [21]:
$$ \ begin {array} {l} {r} _ {l, l + 1} ^ s =\ frac {n_ {ls} \ cos {\ theta} _ {ls} - {n} _ {\ left ( l + 1 \ right) s} \ cos {\ theta} _ {\ left (l + 1 \ right) s}} {n_ {ls} \ cos {\ theta} _ {ls} - {n} _ {\ left (l + 1 \ right) s} \ cos {\ theta} _ {\ left (l + 1 \ right) s}} \\ {} {t} _ {l, l + 1} ^ s =\ frac {2 {n} _ {ls} \ cos {\ theta} _ {ls}} {n_ {ls} \ cos {\ theta} _ {ls} + {n} _ {\ left (l + 1 \ right) s} \ cos {\ theta} _ {\ left (l + 1 \ right) s}} \ end {array} $$ (4)Таким образом, комплексные коэффициенты отражения многослойного пакета могут быть получены путем замены коэффициентов частичного отражения и передачи на N + 1 интерфейс (уравнения (4)) в уравнении. (1) и фазовые сдвиги всех N слои (уравнение (3)):
$$ {R} _ {s / p} ={\ left | {r} _ {0, N + 1} ^ {s / p} \ right |} ^ 2 ={\ left | \ frac {T_ {21) }} {T_ {11}} \ right |} ^ 2. $$Модель функции диэлектрической проницаемости инфракрасного излучения
Показатель преломления зависит от комплексной диэлектрической функции ε ( ω ), который можно записать как:
$$ \ varepsilon \ left (\ omega \ right) ={\ varepsilon} ^ {\ mathrm {lat}} \ left (\ omega \ right) + {\ varepsilon} ^ {\ mathrm {fc}} \ left (\ омега \ право). $$ (5)Первый член соответствует вкладу от дисперсии мод решетки, а второй - возбуждению свободных носителей заряда.
Вклад решеточных мод в ИК-отклик ε широта ( ω ) при энергии фонона ℏω можно описать с помощью факторизованной модели с лоренцевым уширением [22]:
$$ {\ varepsilon} ^ {\ mathrm {lat}} \ left (\ omega \ right) ={\ varepsilon} _ {\ infty} {\ displaystyle \ prod_ {k =1} ^ M \ frac {\ omega_ { \ mathrm {LO} k} ^ 2 - {\ omega} ^ 2-i \ omega {\ gamma} _ {\ mathrm {LO} k}} {\ omega _ {\ mathrm {TO} k} ^ 2 - {\ омега} ^ 2-я \ omega {\ gamma} _ {\ mathrm {TO} k}}}, $$ (6)где M - количество инфракрасно-активных полярных фононных мод для s - или p -поляризации на c- ось; ω LOk и ω TOk - частота (см −1 ) из k- th LO и TO фонон; γ LOk и γ TOk их константы затухания (см −1 ). Для GaN параметры ω LOk и ω TOk учитывать E 1 (LO), A 1 (LO) и E 1 (TO) и A 1 (ТО) колебательные моды [23].
Вклад свободных частиц носителя ε fc ( ω ) к диэлектрической функции можно описать с помощью классического приближения Друде [15]:
$$ {\ varepsilon} ^ {\ mathrm {fc}} \ left (\ omega \ right) =- {\ varepsilon} _ {\ infty} \ frac {\ omega_p ^ 2} {\ omega \ left (\ omega + я {\ gamma} _p \ right)}, $$ (7)с
$$ {\ omega} _p ={\ left (\ frac {N {e} ^ 2} {\ varepsilon _ {\ infty} {\ varepsilon} _0 {m} ^ {\ ast}} \ right)} ^ {1 / 2} $$ (8) $$ {\ gamma} _p =\ frac {e} {m ^ {\ ast} \ mu} $$ (9)Экранированные плазменные частоты ω p (Уравнение (8)) зависят от концентрации свободных носителей N , высокочастотная диэлектрическая проницаемость ε ∞ , а эффективная масса м ∗ свободных носителей ( ε 0 - диэлектрическая проницаемость вакуума и e - единичный электрический заряд). Параметр затухания плазмонов γ p зависит от подвижности оптических носителей μ (Уравнение (9)) [24].
Параметры ω LO и режимы LOPC могут быть определены из мнимой части функции потерь энергии - \ (\ mathrm {I} \ mathrm {m} \ left (- \ frac {1} {\ varepsilon \ left (\ omega \ right)} \ справа) \) [7], где ε ( ω ) - комплексная диэлектрическая функция, полученная из уравнения. (5).
Результаты и обсуждение
СЭМ-изображение (рис. 2) показывает фототравленное поперечное сечение n + / n 0 / n + -GaN структура, выращенная на GaN-буфере / GaN-шаблоне / сапфировой подложке, где четко видны шесть отдельных слоев, которые представляют собой пять слоев GaN с разной концентрацией носителей и сапфировую подложку. Следует отметить, что общая толщина исследуемой структуры GaN, измеренная с помощью СЭМ, согласуется с технологической, и наблюдаемые слои GaN согласно рис.1 можно условно отнести к номинальным верхним легированным кремнием n + область (слой 1), нелегированная n 0 область (слой 2), нижний слой, легированный кремнием n + область (слой 3), нелегированный буфер GaN (слой 4) и шаблон GaN.
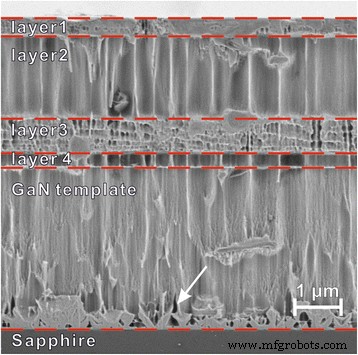
СЭМ-изображение поперечного сечения исследуемого n + / n 0 / n + -GaN структура. Нерегулярный рисунок вертикальных линий образовался во время скола (т.е. перед фототравлением) и характерен для неполированных сколов Al 2 О 3 / Гетероструктуры GaN. Шероховатый пирамидальный слой ( точечные отверстия ) на шаблоне сапфир / GaN, обозначенном стрелкой стрелкой было обнаружено фототравлением
Далее, чтобы получить более полное представление об уровне примесей / легирования исследуемых образцов, были выполнены измерения SIMS. Полученные ВИМС-профили (рис. 3) хорошо коррелируют с номинальной толщиной слоев GaN и общей толщиной исследуемой многослойной структуры. Все исследованные элементы (H, C, O, Si) были выше предела обнаружения (от 3 до 5 × 10 16 ат / см 3 ) метода ВИМС.
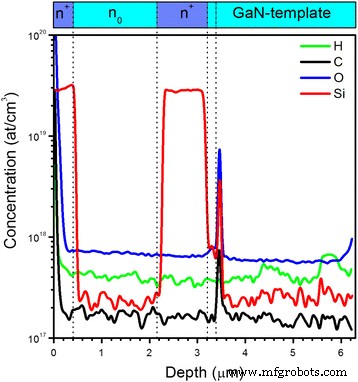
Профили примесных элементов исследуемых n + / n 0 / n + -Структура GaN, измеренная с помощью SIMS с поверхности образца
Профиль преднамеренного легирования Si в целом соответствует номинальному профилю легирования с концентрацией около 2,8 × 10 19 см −3 в легированном верхнем и нижнем n + регионов и около 2,3 × 10 17 см −3 в нелегированном n 0 область. Однако, как видно из данных ВИМС, существует также тонкий (<50 нм) -дельта слой с концентрацией Si 1,1 × 10 19 см −3 между буфером GaN и шаблоном GaN. Следует отметить, что дельта-слой, легированный кремнием, также содержит более высокие концентрации непреднамеренных примесей кислорода и углерода - 2,4 × 10 19 см −3 и 1,4 × 10 18 см −3 , соответственно. Этот дельта-слой связан с интерфейсом гомоэпитаксиального отрастания, который обычно возникает из-за загрязнения шаблона GaN примесями O, Si и C, абсорбированными из атмосферы в технологическом процессе загрузки или в начале отрастания [25, 26].
Как обсуждалось выше, анализ поперечного сечения SEM и анализ SIMS дают структуру слоев GaN, которая отличается от номинальных параметров возбуждением дополнительной области GaN, но с общей толщиной, соответствующей номинальной. Для выяснения влияния обнаруженного выше дополнительного дельта-слоя GaN на ИК-спектр отражения исследуемой структуры было проведено моделирование экспериментального спектра путем построения моделей, состоящих из шести слоев, соответствующих номинальным технологическим параметрам, СЭМ-изображений ( Рис. 1), и семь слоев по ВИМС. Расчетные спектры на основе описанных выше моделей представлены на рис. 4.

Моделирование спектров ИК-отражения при разном количестве слоев. Экспериментальный спектр исследуемых n + / n 0 / n + -Структура GaN показана сплошной линией . а Рестстрахлен регион. б Увеличенные спектры в диапазоне более 750 см −1
Как видно из рис. 4, семислойная модель профиля ВИМС дает наилучшее приближение экспериментального ИК-спектра отражения. Таким образом, дальнейшее моделирование и анализ проводятся с использованием этой модели с измененными параметрами по сравнению с номинальными технологическими (рис. 1), и которая учитывает дополнительный слой между технологическим буферным слоем GaN и шаблоном GaN (рис. 5).
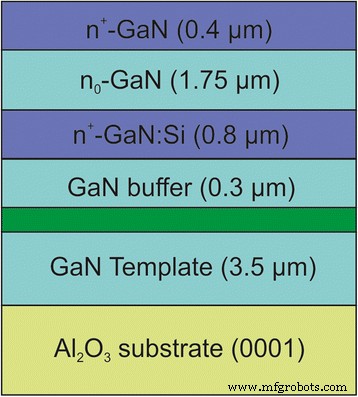
7-слойная модель, используемая для моделирования спектров ИК-отражения исследуемых n + / n 0 / n + -GaN структура. Дополнительный слой ( зеленый ) представляет собой тонкий интерфейсный слой между шаблоном GaN и исследуемыми слоями GaN
На рисунке 6 показаны экспериментальные и подогнанные теоретические s -поляризованные спектры отражения исследуемой структуры при угле падения 11 °. Расчетный спектр основан на описанной выше модели (рис. 5). Дисперсия комплексного показателя преломления для слоев GaN и сапфировой подложки определялась по формуле. (5). Сапфировая подложка считалась полубесконечной, что позволяло не учитывать внутренние отражения внутри подложки и от неполированной тыльной стороны. Сложная структура, наблюдаемая в остальной части спектра, обусловлена комбинацией перекрывающихся GaN и Al 2 О 3 полосы reststrahlen наряду с интерференционными эффектами. Сравнение этих данных с рассчитанными спектрами не только может предоставить информацию о толщине различных слоев образцов, но также может помочь интерпретировать сложную структуру области остаточных лучей с точки зрения вкладов различных материалов.

Экспериментальный ( сплошная линия ) и рассчитанное наилучшее соответствие ( штрихпунктир ) ИК-спектры отражения n + / n 0 / n + -Структура GaN, выращенная на GaN-шаблоне / Al 2 О 3 . а Рестстрахлен регион. б Область помех
Определение толщины слоев из сравнения данных коэффициента отражения с расчетным спектром представляет собой двухэтапный процесс [27]. Во-первых, полосы в прозрачной области над полосами остаточных лучей (ω> 1200 см −1 ) обусловлены интерференционным воздействием на слои многослойной структуры. Таким образом можно оценить общую толщину исследуемой структуры, которая представляет собой сумму всех слоев.
Как только толщина стопки известна, можно определить индивидуальную толщину каждого слоя путем подгонки вычисленных спектров к интерференционным эффектам в остальной области спектра. Толщина слоев варьировалась с учетом ранее определенной общей толщины. При этом ограничении коэффициент отражения выше 1200 см −1 существенно не меняется. Интерференционные эффекты в области остаточных лучей можно отличить от других особенностей, таких как колебательные моды TO и LO, на основании того факта, что интерференционные полосы смещаются по положению при изменении толщины слоя [28].
При аппроксимации экспериментального спектра в области остаточных лучей варьировались следующие параметры модели:параметры затухания γ LO и γ TO для E 1 (LO) и E 1 (ТО) фононные моды; плазменная частота ω p ; параметр затухания плазмонов γ p ; и толщины слоя. Следует отметить, что только E 1 Фононы симметрии активны в ИК-диапазоне с -поляризация [9]. Начальные частоты E 1 (LO) и E 1 (TO) фононы для GaN и сапфировой подложки были взяты из экспериментов по ИК-отражению [29] и комбинационному рассеянию света [6,14]. Типичные значения частоты фононов GaN:ω TO =560 см −1 и ω LO =740 см −1 . Частоты фононов для каждого слоя уточнялись в процессе подгонки. Полученные параметры наилучшего соответствия с планками погрешностей приведены в таблице 1. Следует отметить, что полученные в процессе подгонки толщины слоев хорошо согласуются с данными SEM.
Ссылаясь на рис. 6а, пик отражения при ~ 450 см -1 можно отнести к сапфировой подложке. Особенности, наблюдаемые в диапазоне 500–740 см −1 обусловлены комбинацией перекрывающихся особенностей слоев GaN и полос остаточных стекол сапфира. Для более глубокого анализа были смоделированы ИК-спектры отражения объемного GaN и слоя GaN на сапфире толщиной 6,78 мкм с толщиной GaN, соответствующей общей толщине исследуемой структуры, в области полосы остаточного излучения (рис.7). . Как видно из рис. 7, спектры отражения слоя GaN толщиной 6,78 на сапфире и объемном GaN в диапазоне 500–740 см −1 похожи на экспериментальный спектр. Маленькая деталь на ~ 511 см −1 связана с сапфировой подложкой. Следует отметить, что на ~ 736 см −1 , есть слабый провал, соответствующий A 1 (LO) мода шаблона GaN. Согласно правилам отбора, A 1 (LO) режим запрещен в s -поляризованные ИК-спектры [9]. Возможной причиной регистрации этой запрещенной моды может быть утечка поляризации из-за апертуры отражающей насадки, а также микронеоднородности кристаллической структуры GaN. В частности, это может быть вызвано наклоном c - ось столбчатой вюрцитной структуры GaN от направления, перпендикулярного плоскости роста пленки. Этот режим не учитывался при моделировании из-за его слабого влияния на результирующий спектр. Характеристики в диапазоне 750–1200 см −1 обусловлены перекрытием полос остаточных лучей GaN:Si и сапфира и интерфейсными эффектами. Падение с высоты ~ 775 см −1 связано с интерфейсным эффектом на краю полосы остаточных лучей слоев GaN и сапфира. Широкое падение на ~ 825 см −1 связано с перекрытием высокочастотной ветви моды, связанной плазмон-LO-фонон (LPP + ) из n + слои.
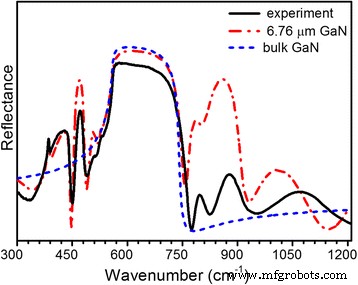
Экспериментальный ( сплошная линия ) ИК-спектры отражения исследуемых n + / n 0 / n + -Структура GaN и рассчитанные спектры отражения слоя GaN толщиной 6,78 мкм на сапфире ( пунктирная линия ) и объемного GaN ( пунктирная линия )
На рисунке 8 показаны вычисленные мнимые части функции потерь энергии для каждого слоя в соответствии с параметрами осциллятора, приведенными в таблице 1 для оценки E 1 -LOPC режимы. Как видно, высокочастотная ветвь режимов LOPC (LPP + ) при концентрациях носителей менее 10 17 см −3 (n 0 слой и шаблон) почти совпадают с E 1 (LO) фононная мода. Увеличение концентрации носителей в диапазоне 2 × 10 17 –3 × 10 18 см −3 (Рис. 5) приводит к значительному высокочастотному сдвигу и уширению ЛПП + ветвь, что свидетельствует об усилении взаимодействия LO-фонона с плазмоном и уменьшении подвижности носителей заряда. Такое поведение LPP + ветвь хорошо согласуется с экспериментальными данными по ИК-отражению пленок GaN, легированных кремнием, выращенных на сапфире З.Ф. Ли и др. [30], а также измерения комбинационного рассеяния света в объемном GaN [10] и эпитаксиальных слоях [31]. Следует отметить, что низкочастотный LPP - ветвь LOPC не может быть надежно определена в нашем случае, так как s -поляризованные ИК-спектры отражения не измерялись в низкочастотном диапазоне ниже 300 см −1 .

Расчетная мнимая часть диэлектрической функции, полученная для каждого проанализированного слоя GaN на основе анализа наилучших данных
Значения концентрации носителей и подвижности, перечисленные в таблице 2, были рассчитаны с использованием формул. (8) и (9) с эффективной массой электрона m * 0,2 м 0 [32]. Видно, что рассчитанный профиль концентрации носителей аналогичен профилю концентрации примеси Si, полученному с помощью SIMS-измерений (рис. 3), но с на порядок меньшими концентрациями носителей по сравнению с концентрацией примеси Si. Такое несовпадение концентраций носителей и легирующих примесей наблюдалось ранее M. Bockowski et al. [33], и было связано с эффектами компенсации акцепторными состояниями (вероятно, вакансиями галлия), энергия образования которых уменьшается с увеличением легирования n-типа [34]. Следует отметить, что концентрация носителей для n + слоев в порядке ~ 10 18 см −3 находится в хорошем согласии с результатами наших рамановских исследований подобных структур GaN, основанных на анализе LOPC-мод [6]. Полученное уменьшение подвижности носителей μ с концентрацией носителей также хорошо согласуется с холловскими экспериментами с GaN [35] и теоретическим моделированием [36].
Значения высокочастотной диэлектрической проницаемости ε ∞ оказались в диапазоне 4,99–5,35 (таблица 1). Увеличение ε ∞ для легированного n + слоев по сравнению с n 0 слои могут быть связаны с красным сдвигом запрещенной зоны α-GaN [37]. Следует отметить, что значения ε ∞ может быть определена с относительно небольшой погрешностью только для пленок с низкой проводимостью. Точность определения ε ∞ убывают с концентрацией носителей, что связано с тем, что ε ∞ Параметр учитывает «высокочастотный» предел, когда диэлектрическая модельная функция экстраполируется на более короткие волновые числа, чем исследованные здесь [11]. Широкий спектральный диапазон 300–4000 см −1 был проанализирован с целью уменьшения ошибки определения ε ∞ и другие параметры, участвующие в моделировании спектров ИК-отражения n + слои.
Выводы
Измерены и детально проанализированы спектры ИК-отражения многослойной структуры, состоящей из слоев GaN, выращенных на сапфировой подложке и легированных различными концентрациями примеси Si. Анализ исследуемой структуры методом СЭМ фототравленного поперечного сечения показал хорошую корреляцию с технологическими параметрами слоев GaN. ВИМС-анализ также выявил наличие тонкого дельта-слоя вблизи границы раздела буфер GaN / GaN-шаблон с более высоким содержанием примесей Si и O, что связано с интерфейсом гомоэпитаксиального отрастания. Моделирование спектра ИК-отражения исследуемой многослойной структуры путем включения в анализ дополнительного слоя позволило получить наилучшее соответствие экспериментальному спектру. Obtained thicknesses of GaN layers are in good agreement with the SEM and SIMS data. Calculated from the spectral dependence of dielectric permittivity LOPC modes for each GaN layer showed high-frequency shift and broadening of LPP + branch with the increase in carrier concentration. Concentration and mobility of charge carrier for each GaN layer were calculated from the plasmon frequency and damping parameter. Obtained carrier concentration profile is similar to those obtained by SIMS, but with values of carrier concentration one order of magnitude less than the concentration of Si doping impurity, which can be attributed to compensation effects by the defect acceptor states. Thus, it is demonstrated that IR reflectance spectroscopy and 2 × 2 transfer matrix method can be successfully used for analysis of epitaxial multilayer GaN structures with non-uniform doping profiles, and allow for the determination of the fundamental electron and phonon parameters of each GaN layer.
Change history
Сокращения
- IR:
-
Infrared
- FTIR:
-
Fourier transform infrared spectroscopy
- SEM:
-
Scanning electron microscopy
- SIMS:
-
Secondary ion mass spectrometry
- LOPC:
-
Longitudinal optical phonon– plasmon coupled
Наноматериалы
- Структура и электронные свойства наноглины каолинита, легированной переходным металлом
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Новые нанокомпозиты полистирола с полианилином, легированным лаурилсерной кислотой
- Температурная зависимость ширины запрещенной зоны в MoSe2, выращенном методом молекулярно-лучевой эпитаксии
- Аморфные кремниевые нанопроволоки, выращенные на пленке оксида кремния путем отжига
- Нацеливание на эндотелиальные клетки с помощью многофункциональных наночастиц GaN / Fe
- Анализ рамановского картирования кремниевых микрокольцевых резонаторов, интегрированных в графен
- Оптимальные слои легирования кремнием квантовых барьеров в последовательности роста, формирующие потенциал…
- Структурный сдвиг GaN в сети Nanowall, наноколонке и компактной пленке, выращенной на Si (111) от MBE
- Понимание механизма роста эпитаксиальных слоев GaN на механически расслоенном графите



