Окно памяти и повышение выносливости FeFET на основе Hf0,5Zr0,5O2 с затравочными слоями ZrO2, характеризуемыми измерениями с помощью быстрых импульсов напряжения
Аннотация
HfO 2 Полевой сегнетоэлектрический транзистор (FeFET) со стеком затвора металл / сегнетоэлектрик / изолятор / полупроводник (MFIS) в настоящее время рассматривается как возможный кандидат для энергонезависимой памяти с высокой плотностью записи и высокой скоростью записи. Хотя удерживающая способность HfO 2 FeFET на основе FeFET со стеком затворов MFIS может удовлетворить требования для практических приложений, его окно памяти (MW) и надежность в отношении долговечности должны быть дополнительно улучшены. В этой работе исследуется преимущество использования ZrO 2 посевные слои по MW, удержанию и выносливости Hf 0,5 Zr 0,5 О 2 FeFET на основе (HZO) со стеками затворов MFIS с использованием измерений быстрых импульсов напряжения. Установлено, что FeFET на основе HZO с ZrO 2 посевной слой показывает большую начальную и 10-летнюю экстраполированную молекулярную массу, а также улучшенные характеристики выносливости по сравнению с FeFET на основе HZO без ZrO 2 семенной слой. Результаты показывают, что использование блока затворов с прямым кристаллическим высоким содержанием k / Si может дополнительно улучшить молекулярную массу и надежность HfO 2 на основе FeFET.
Фон
HfO 2 Тонкие сегнетоэлектрические пленки на основе сегнетоэлектриков рассматриваются как перспективные материалы для затворов для сегнетоэлектрических полевых транзисторов (FeFET) из-за их комплементарной совместимости металл-оксид-полупроводник (CMOS) и масштабируемости. Среди нескольких видов структур стека затворов, которые могут использоваться в FeFET, металл / сегнетоэлектрик / изолятор / полупроводник (MFIS) представляет собой более практичную конфигурацию, поскольку он соответствует современной архитектуре MOS-устройств и хорошо сочетается с современными металлическими затворами с высоким коэффициентом k. (HKMG) процессы. Поэтому были предприняты большие усилия для разработки и изготовления полевых транзисторов FeFET со структурами стека затворов MFIS для приложений во встроенной энергонезависимой памяти, полевых транзисторах с отрицательной емкостью, искусственных нейронах, синапсах и устройствах логики в памяти [1,2,3,4 , 5,6,7,8].
До настоящего времени FeFET-транзисторы с высокой плотностью записи и высокой скоростью записи со структурами стека затворов MFIS были успешно изготовлены с использованием процессов HKMG [9, 10]. Помимо высокой плотности интеграции и высокой скорости записи, большое окно памяти (MW) и высокая надежность в отношении удержания и долговечности также критичны для использования FeFET в приложениях энергонезависимой памяти [11,12,13,14]. Из-за большого смещения полосы к кремнию, высокого коэрцитивного поля и умеренной диэлектрической проницаемости HfO 2 тонкие сегнетоэлектрические пленки на основе HfO 2 FeFET-транзисторы со структурой стека затворов MFIS демонстрируют надежные удерживающие свойства (10-летняя экстраполяция) [15,16,17]. Однако, хотя HfO 2 тонкие пленки на основе демонстрируют умеренную выносливость более 1 × 10 9 циклы переключения [14, 18], HfO 2 полевые транзисторы на основе FeFET со структурой стека затворов MFIS имеют довольно ограниченный срок службы в диапазоне от 1 × 10 4 до 1 × 10 7 циклы переключения [17,19,20,21,22,23]. Теоретически ожидается, что использование изолирующих слоев с высоким k уменьшит электрическое поле в стеке затворов MFIS, что уменьшит изгиб полосы, тем самым улучшив долговечность и MW HfO 2 на основе FeFET [12, 14]. Экспериментально Али и др. подтвердили, что увеличение значения k сверхтонкого слоя изолятора (т.е. использование SiON вместо SiO 2 ) может эффективно улучшить свойства выносливости, а также молекулярную массу HfO 2 на основе FeFET [13]. В нашем предыдущем исследовании [24] мы сообщили, что внедрение кристаллического ZrO 2 Слой high-k в стеках затворов MFIS может улучшить качество кристаллов и подавить образование моноклинной фазы в Hf 0,5 Zr 0,5 О 2 (HZO) тонких пленок, что приводит к большой МВ 2,8 В, характеризуемой методом развертки постоянного напряжения.
В этой работе мы сообщаем о характеристиках MW, удерживания и долговечности FeFET на основе HZO с кристаллическим ZrO 2 и без него. посевные слои с помощью быстрых измерений импульсов положительного и отрицательного напряжения. Более того, преимущество использования кристаллического ZrO 2 Обсуждаются семенные слои по МВ и выносливым свойствам.
Методы
N-канальные FeFET с ZrO 2 и без него Затравочные слои были изготовлены с использованием процесса последнего затвора, как описано в [24]. ZrO 2 Затравочный слой и слой HZO были выращены при температуре роста 300 o . C осаждением атомного слоя (ALD). Схема изготовленных FeFET показана на рис. 1а, ширина канала которого ( W ) и длины ( L ) составляли 80 и 7 мкм соответственно. Между тем, TaN / HZO / TaN и TaN / HZO / ZrO 2 Конденсаторы / TaN были также изготовлены для оценки сегнетоэлектрических свойств тонких пленок HZO. Поляризация – напряжение ( P – V Петли гистерезиса конденсаторов были измерены с помощью испытательной системы сегнетоэлектрика Radiant Technologies RT66A, а характеристики устройства FeFET были измерены с помощью анализатора полупроводниковых приборов Agilent B1500A с блоком генератора импульсов (B1525A) [20]. Две основные последовательности испытаний, используемые для измерения МВ и долговечности, показаны на рис. 1b и c. Для измерений MW и удерживания импульсы программы / стирания (P / E) сначала применялись к затворам FeFET, а операции чтения выполнялись в разные интервалы времени с использованием I D - V G развертка ( V D =0,1 В) для определения В TH . Как правило, V TH определяется как напряжение затвора, соответствующее току стока 10 −7 A ∙ W / L [25], а MW определяется как разница V TH значения между запрограммированным и удаленным состояниями. Для измерения выносливости, МВ измеряли после определенного количества чередующихся импульсов P / E.

а Схема изготовленных FeFET-транзисторов. Дополнительный кристаллический ZrO 2 посевной слой отмечен черными линиями сетки. б , c Последовательности испытаний, используемые для измерения МВ и выносливости
Результаты и обсуждение
На рис. 2а показаны P – V петли гистерезиса TaN / HZO / TaN и TaN / HZO / ZrO 2 Конденсаторы TaN. Примечательно, что TaN / HZO / ZrO 2 Конденсатор / TaN обладает даже лучшими сегнетоэлектрическими свойствами, чем конденсатор TaN / HZO / TaN, что согласуется с опубликованными результатами [26], указывающими на то, что кристаллический ZrO 2 Затравочный слой действительно может улучшить качество кристаллов и подавить образование моноклинной фазы в тонких пленках HZO [24]. На рисунке 2b показан I D - V G кривые FeFET на основе HZO с дополнительным кристаллическим ZrO 2 и без него посевные слои после импульсов P / E. Красные линии символов представляют I D - V G кривые после подачи программного импульса 7 В / 100 нс, в то время как синие линии символов представляют I D - V G кривые после подачи импульса стирания - 7 В / 100 нс. Видно, что I D - V G кривые обоих FeFET показывают характеристики переключения против часовой стрелки, предполагая, что MW существующих FeFET возникают из-за переключения поляризации слоев HZO, а не из-за захвата и инжекции заряда. Тем не менее, FeFET на основе HZO с дополнительным кристаллическим ZrO 2 затравочный слой демонстрирует улучшенную молекулярную массу 1,4 В, что примерно в 1,8 раза больше, чем (0,8 В) FeFET на основе HZO без дополнительного кристаллического ZrO 2 семенной слой. Более того, полученная МВт 1,4 В сравнима с лучшими результатами, о которых сообщалось на сегодняшний день [9, 11, 14, 17, 21,22,23, 27].
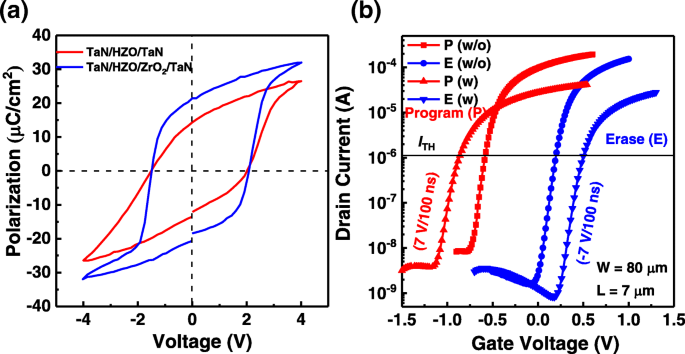
а P – V петли гистерезиса TaN / HZO / TaN и TaN / HZO / ZrO 2 / TaN MFM-структуры, измеренные при 4 В и частоте 5 кГц. б Я D - V G кривые FeFET на основе HZO с (w) и без (без) ZrO 2 затравочные слои после программного импульса (+ 7 В / 100 нс) и импульса стирания (-7 В / 100 нс)
Надежность в отношении удерживания FeFET на основе HZO с дополнительным кристаллическим ZrO 2 и без него посевные слои также оценивались. На рисунке 3 показан V TH характеристики удерживания после применения программного импульса 7 В / 100 нс и импульса стирания -7 В / 100 нс при комнатной температуре. Понятно, что V TH значения приблизительно линейны с логарифмической шкалой времени. Экстраполированная молекулярная масса после 10 лет для FeFET на основе HZO с дополнительным кристаллическим ZrO 2 затравочный слой составляет 0,9 В, больше, чем (0,6 В) для FeFET на основе HZO без дополнительного кристаллического ZrO 2 семенной слой. Поскольку толстая эквивалентная толщина емкости (CET) ZrO 2 (1,5 нм) / SiO 2 Слои изолятора затвора (2,6 нм) приведут к усилению поля деполяризации в стеке затворов [13, 15], дальнейшее улучшение удерживающих свойств можно ожидать, если толщина SiO 2 слой уменьшается.

Удерживающие характеристики FeFET на основе HZO с ZrO 2 и без него семенные слои
На рисунке 4 показана эволюция I D - V G кривые после чередования циклов P / E ± 7 В / 100 нс. Для FeFET без дополнительного кристаллического ZrO 2 слой семян, как значительный сдвиг, так и ухудшение уклона в I D - V G кривые наблюдаются на ранних стадиях цикла P / E, а I D - V G кривые в стертых состояниях демонстрируют большее ухудшение наклона по сравнению с состояниями программы. Для FeFET с дополнительным кристаллическим ZrO 2 семенной слой, хотя I D - V G кривые в стертых состояниях демонстрируют очевидный положительный сдвиг на ранних стадиях цикла P / E, который приписывается эффекту «пробуждения» [13, 28,29,30,31,32], нет очевидного сдвига на I D - V G кривых в состояниях программы наблюдается до 1 × 10 3 циклы. Более того, для FeFET с дополнительным кристаллическим ZrO 2 посевной слой, I D - V G кривые как в стертом состоянии, так и в состоянии программы демонстрируют лишь небольшое ухудшение наклона до 1 × 10 3 циклов.
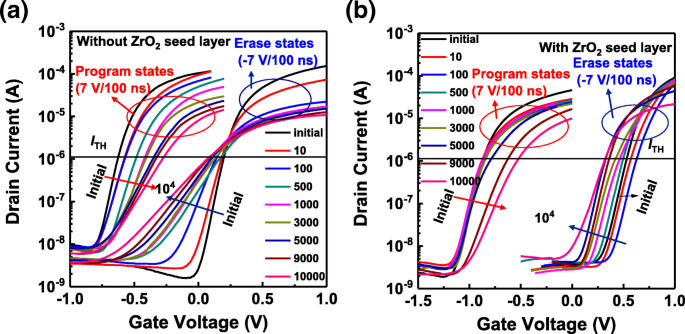
Эволюция I D - V G кривые FeFET на основе HZO a без и b с ZrO 2 семенные слои с циклическим переключением P / E
Согласно предыдущим отчетам [12, 28, 33], параллельный сдвиг в I D - V G кривые объясняются постепенным накоплением захваченных зарядов в стопке затворов, в то время как уменьшение наклона в I D - V G кривые - это результат генерации граничных ловушек. Поскольку захваченные заряды могут быть выведены из ловушки электрическими средствами, но образование межфазных ловушек необратимо, минимизация образования межфазных ловушек чрезвычайно важна для улучшения характеристик выносливости [28]. Ловушки интерфейса, генерируемые циклическим P / E (Δ N это ) можно описать с помощью уравнения. (1) [34, 35]:
$$ \ Delta \ mathrm {SS} =\ frac {\ Delta {N} _ {it} kT \ ln 10} {C_ {FI} {\ varnothing} _F} $$ (1)где ΔSS - изменение подпорогового колебания, k постоянная Больцмана, T абсолютная температура, C FI - полная емкость стека затворов, а ∅ F - потенциал Ферми. Δ N это как функция цикла P / E для FeFET на основе HZO с дополнительным кристаллическим ZrO 2 и без него затравочные слои показаны на рис. 5. Очевидно, что для FeFET без дополнительного кристаллического ZrO 2 посевной слой, Δ N это очевидно возрастает с ранних стадий цикла P / E, и Δ N это в стертых состояниях намного больше, чем в состояниях программы. Однако Δ N это для FeFET с дополнительным кристаллическим ZrO 2 посевной слой почти не меняется до 1 × 10 3 циклов, и он всегда меньше, чем у FeFET без дополнительного кристаллического ZrO 2 семенной слой. Поскольку вставка дополнительного ZrO 2 Затравочный слой уменьшает электрическое поле в стеке затворов, и, таким образом, изгиб полосы слабее, а образование ловушек на границе раздела менее интенсивно [12, 14].
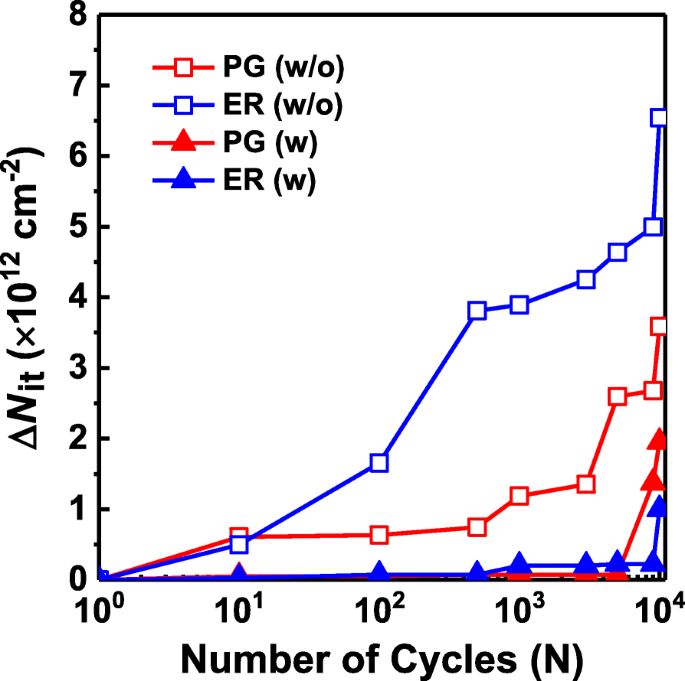
Эволюция ∆ N это с чередованием P / E
На рисунке 6 показано изменение характеристик тока утечки затвора ( I G - V G кривые) FeFET на основе HZO с ZrO 2 и без него семенные слои с чередованием P / E. Для FeFET без дополнительного кристаллического ZrO 2 В затравочном слое ток утечки затвора резко возрастает с ранних стадий цикла P / E. Однако ток утечки затвора для FeFET с дополнительным кристаллическим ZrO 2 посевной слой почти не меняется до 5 × 10 2 циклов, и он всегда меньше, чем у FeFET без дополнительного кристаллического ZrO 2 семенной слой. Сообщается, что увеличение тока утечки затвора может быть связано с сгенерированными интерфейсными ловушками [28]. Снижение тока утечки затвора с помощью циклирования для FeFET с дополнительным кристаллическим ZrO 2 начальный слой будет отнесен к подавлению генерации прерывания интерфейса.
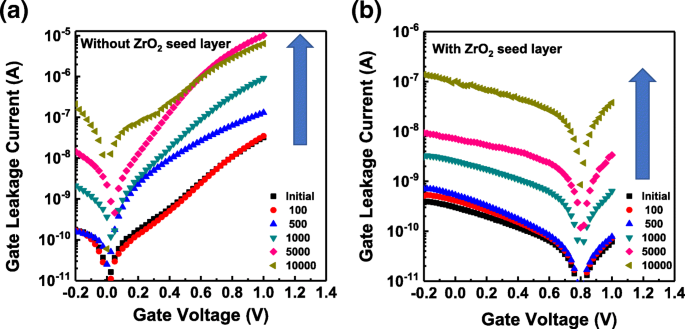
Эволюция характеристик тока утечки затвора ( I G - V G кривые) FeFET на основе HZO a без и b с ZrO 2 семенные слои с циклическим переключением P / E
V TH значения для программ и состояний стирания, извлеченные из I D - V G кривые FeFET на основе HZO с дополнительным кристаллическим ZrO 2 и без него Затравочные слои показаны на рис. 7. FeFET на основе HZO с дополнительным кристаллическим ZrO 2 затравочный слой всегда имеет большую молекулярную массу, чем FeFET на основе HZO без дополнительного кристаллического ZrO 2 семенной слой. Более того, молекулярная масса FeFET на основе HZO без дополнительного кристаллического ZrO 2 затравочный слой, очевидно, уменьшается на ранних стадиях цикла P / E, в то время как MW FeFET на основе HZO с дополнительным кристаллическим ZrO 2 слой семян немного уменьшается до 1 × 10 3 циклы. По мере дальнейшего увеличения числа циклов P / E FeFET на основе HZO с дополнительным кристаллическим ZrO 2 посевной слой также показывает очевидную деградацию наклона I D - V G кривые и MW, из-за улучшенной генерации ловушек на границе раздела. Однако молекулярная масса FeFET на основе HZO с дополнительным кристаллическим ZrO 2 посевной слой все еще больше 0,9 В до 1 × 10 4 циклов, что примерно в 2,3 раза больше, чем (0,4 В) FeFET на основе HZO без дополнительного кристаллического ZrO 2 семенной слой. Как обсуждалось ранее, уменьшение необходимого электрического поля для получения более насыщенных состояний поляризации, вероятно, отвечает за улучшенные характеристики износостойкости.

Эволюция V TH с чередованием P / E
Выводы
МВт, а также надежность в отношении удержания и долговечности FeFET на основе HZO с TaN / HZO / SiO 2 / Si и TaN / HZO / ZrO 2 / SiO 2 Затворные стеки / Si MFIS были охарактеризованы измерениями быстрых импульсов напряжения. Результаты показывают, что FeFET на основе HZO с дополнительным кристаллическим ZrO 2 затравочный слой демонстрирует большое начальное окно памяти 1,4 В и экстраполированное 10-летнее сохранение 0,9 В, что больше, чем начальное окно памяти (0,8 В) FeFET на основе HZO без дополнительного кристаллического ZrO 2 семенной слой. Более того, надежность в отношении долговечности FeFET на основе HZO может быть улучшена путем введения кристаллического ZrO 2 затравочный слой между слоем HZO и SiO 2 / Si подложка. Повышение молекулярной массы и выносливости FeFET на основе HZO с ZrO 2 Затравочные слои в первую очередь связаны с улучшенным кристаллическим качеством слоя HZO и подавлением образования межфазных ловушек из-за уменьшения электрического поля, необходимого для получения более насыщенных состояний поляризации. На основе этой работы ожидается, что использование прямой кристаллической затвора с высоким k / Si приведет к дальнейшему улучшению MW и надежности HfO 2 на основе FeFET, и поэтому требуют дальнейшего изучения и развития.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью.
Сокращения
- CMOS:
-
Комплементарный металл-оксид-полупроводник
- FeFET:
-
Сегнетоэлектрический полевой транзистор
- FeFET:
-
Сегнетоэлектрические полевые транзисторы
- HKMG:
-
Металлические ворота high-k
- HZO:
-
Hf 0,5 Zr 0,5 О 2
- I D :
-
Слить ток
- L:
-
Длина
- MFIS:
-
Металл / сегнетоэлектрик / изолятор / полупроводник
- MW:
-
Окно памяти
- P / E:
-
Программирование / стирание
- P – V :
-
Поляризация – напряжение
- SS :
-
Подпороговое колебание
- V G :
-
Напряжение затвора
- V TH :
-
Пороговое напряжение
- W:
-
Ширина
- Δ N это :
-
Сгенерированные интерфейсные ловушки
Наноматериалы
- ST:8-битные микроконтроллеры с богатым аналогом и DMA в недорогом пакете SO-8
- Умный наноматериал и нанокомпозит с продвинутой агрохимической активностью
- Резистивная память ZrO2 / ZrO2 - x / ZrO2 без соблюдения нормативных требований с управляемым межфазным режимом перек…
- Механизм проводимости и повышение выносливости в RRAM на основе HfO2 с лечением нитридом
- Улучшение частотной модуляции и поглощения ТГц микроболометра со структурой микромоста с помощью антенн спи…
- Морфология, структура и оптические свойства полупроводниковых пленок с наноостровками GeSiSn и напряженными сл…
- Высокопроизводительные прямоугольные полевые транзисторы с U-каналом с затвором и только 2-нм расстоянием ме…
- Безрезисторный источник опорного напряжения в наномасштабе с низким энергопотреблением и высоким PSRR
- Гибкий мемристор на основе Hf0.5Zr0.5O2, осажденный на атомном слое, с краткосрочной / долгосрочной синаптической п…
- Высокое напряжение пробоя и низкое динамическое сопротивление во включенном состоянии AlGaN / GaN HEMT с имплантац…



