Высокое напряжение пробоя и низкое динамическое сопротивление во включенном состоянии AlGaN / GaN HEMT с имплантацией ионов фтора в слой пассивирования SiNx
Аннотация
В этом исследовании мы предложили и экспериментально продемонстрировали высокое напряжение пробоя (BV) и низкое динамическое сопротивление в открытом состоянии ( R ВКЛ, Д ) AlGaN / GaN транзистор с высокой подвижностью электронов (HEMT) путем имплантации ионов фтора в толстый SiN x пассивирующий слой между электродами затвора и стока. Вместо имплантации ионов фтора в тонком барьерном слое AlGaN положение пика и распределение вакансий далеки от канала двумерного электронного газа (2DEG) в случае имплантации ионов фтора в толстом пассивирующем слое, что эффективно подавляет прямой токовая (постоянная) деградация статических и импульсных динамических характеристик. Ионы фтора в пассивирующем слое также расширяют область обеднения и увеличивают среднюю напряженность электрического поля (E-поля) между затвором и стоком, что приводит к увеличению BV. BV предлагаемого HEMT увеличивается до 803 В с 680 В обычного AlGaN / GaN HEMT (Conv. HEMT) с такими же размерными параметрами. Измеренное R ВКЛ, Д предлагаемого HEMT увеличивается только на 23% при высоком напряжении покоя стока 100 В, в то время как R ВКЛ, Д HEMT с имплантацией ионов фтора в тонкий барьерный слой AlGaN увеличивается на 98%.
Фон
В последние десятилетия новые полупроводниковые материалы, такие как GaN, оксиды металлов и 2D-материалы, были широко изучены с целью дальнейшего повышения эффективности преобразования и хранения энергии благодаря их превосходным свойствам материалов и устройств [1,2,3,4, 5,6,7,8]. Среди них AlGaN / GaN-транзисторы с высокой подвижностью электронов (HEMT) на основе GaN являются хорошими кандидатами для приложений с высокой мощностью, высокими частотами и низкими потерями из-за высокого критического поля пробоя и высокой подвижности электронов [9,10,11,12,13 , 14]. Напряжение пробоя (BV) является одной из наиболее важных целей при проектировании, и заявленные значения все еще намного ниже теоретического предела [15, 16]. Следовательно, очень важно еще больше улучшить BV, особенно не за счет увеличения размера устройства. Было предложено несколько методов терминации для улучшения BV, таких как полевая пластина [17,18,19], имплантация ионов фтора [20,21,22] и заглубление на краю затвора [23, 24]. Ионы фтора, имплантированные в тонкий барьерный слой AlGaN (FBL) [22], имеют простой процесс изготовления без создания дополнительной паразитной емкости; однако положение пика профиля фтора и распределения вакансий близко к каналу двумерного электронного газа (2DEG), что неизбежно приведет к значительному ухудшению статических и динамических характеристик.
В этой работе высокое напряжение пробоя и низкое динамическое сопротивление в открытом состоянии ( R ВКЛ, Д ) AlGaN / GaN HEMT с имплантацией ионов фтора в SiN x пассивирующий слой (FPL HEMT) экспериментально исследован. В отличие от имплантации ионов фтора в тонком барьерном слое AlGaN, имплантация ионов фтора в толстом пассивирующем слое может удерживать положение пика распределения фтора и вакансий далеко от канала 2DEG, таким образом эффективно подавляя деградацию статических и динамических характеристик. . Ионы фтора в пассивирующем слое в качестве метода прерывания также используются для оптимизации распределения поверхностного электрического поля (электрического поля), таким образом достигая улучшенного BV. В заключение, FPL HEMT демонстрирует отличные статические и динамические характеристики.
Методы изготовления
На рис. 1 представлена трехмерная схема FPL HEMT, FBL HEMT и Conv. HEMT соответственно. Все устройства имеют длину ворот L . G 2,5 мкм, расстояние затвор-исток L GS 1,5 мкм, и расстояние затвор-сток L GD 10 мкм. Эпитаксиальная гетероструктура AlGaN / GaN, используемая для изготовления FPL HEMT, была выращена на кремниевой подложке 6 дюймов (111) методом химического осаждения из газовой фазы (MOCVD). Эпитаксиальные слои состоят из 2-нм крышки из GaN, 23-нм Al 0,25 Ga 0,75 N-барьер, прослойка AlN толщиной 1 нм, канал GaN 150 нм и буфер GaN 3,5 мкм. Плотность и подвижность 2DEG, измеренные с помощью эффекта Холла, составили 9,5 × 10 12 . см −2 и 1500 см 2 / V s соответственно. Предлагаемый FPL HEMT начался с изоляции мезы, которая была реализована с помощью Cl 2 высокой мощности. / BCl 3 травление на основе индуктивно связанной плазмы (ICP). Затем было выполнено химическое осаждение из паровой фазы (LPCVD) SiN x толщиной 40 нм. слой был нанесен при 780 ° C / 300 мТорр с NH 3 поток 280 sccm и SiH 2 Cl 2 расход 70 см3 / мин, что дает скорость осаждения 3,7 нм / мин. Показатель преломления измеряется эллипсометром как 1,978, а отношение N / Si SiN x составляет 1,31 [25]. Кристалличность LPCVD SiN x является аморфным, что подтверждается микрофотографией просвечивающего электронного микроскопа высокого разрешения (HR-TEM) (см. вставку к рис. 1а). После открытия окон контактов истока и стока SF 6 После плазменного сухого травления омический контакт Ti / Al / Ni / Au (20/150/45/55 нм) был нанесен и отожжен при 890 ° C в течение 30 с в N 2 окружающий. Контактное сопротивление 1 Ом мм и сопротивление листа 400 Ом / квадрат были получены методом линейных линий передачи. Затем металлический электрод затвора формируется путем осаждения и снятия Ni / Au (50 нм / 150 нм). Затем окно имплантации ионов фтора (длина окна =3 мкм) было сформировано фоторезистом AZ5214, и ионы фтора были имплантированы ионным имплантером SEN NV-GSD-HE при энергии 10 кэВ в дозе 1 × 10 12 см −2 . Наконец, образцы были отожжены при 400 ° C в течение 15 мин в N 2 окружающей среды, чтобы завершить процесс изготовления транзисторов [26].
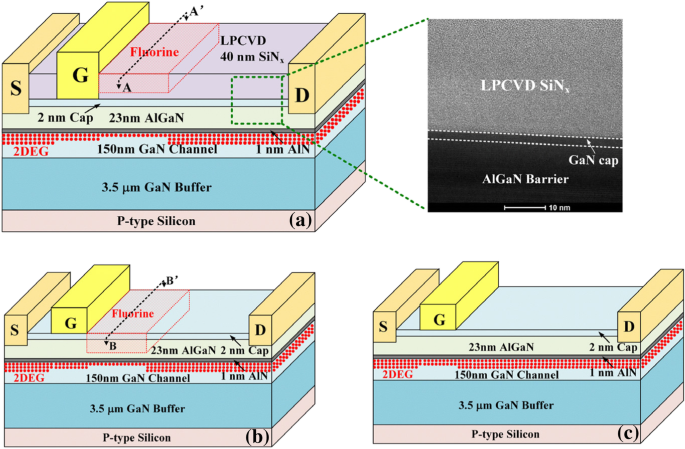
Трехмерная схема а FPL HEMT (вставка:микрофотография HR-TEM LPCVD SiN x ), b FBL HEMT и c Конв. HEMT
Результаты и обсуждение
На рисунке 2 показан профиль концентрации ионов фтора, измеренный методом вторичной ионной масс-спектроскопии (SIMS), и смоделированная концентрация вакансий с помощью TRIM вдоль линий разреза:(a) A-A ' FPL HEMT и (b) B-B ′ FBL HEMT соответственно. При одинаковой энергии и дозе имплантации ионов фтора, измеренное положение пика от поверхности и максимальная концентрация профиля фтора почти одинаковы для двух структур. В случае имплантации ионов фтора в тонкий барьерный слой AlGaN индуцированные фтором вакансии распространяются в область канала 2DEG. Распределение концентрации вакансий прерывистое на каждой границе раздела, потому что энергия связи каждого материала разная [27]. Однако в случае имплантации ионов фтора в толстый SiN x слой пассивирования, распределение вакансий находится в пределах SiN x слой пассивирования и вдали от канала 2DEG. Вакансии, индуцированные ионной имплантацией, будут захватывать канал 2DEG, а 2DEG может быть легко захвачен, если распределение вакансий близко к 2DEG [28]. В заключение, имплантация ионов фтора в толстый SiN x пассивирующий слой может значительно снизить влияние ионной имплантации на канал 2DEG и эффективно подавить деградацию статических и динамических характеристик.

Измеренный профиль SIMS концентрации ионов фтора и смоделированная концентрация вакансий с помощью TRIM вдоль линий разреза. а А-А '. б B-B ′
На рисунке 3 показаны измеренные значения I-V . передаточные характеристики и выходные характеристики постоянного тока (DC). По сравнению с Конв. HEMT, как FPL HEMT, так и FBL HEMT показывают уменьшение I DS и увеличение статического сопротивления в открытом состоянии ( R ВКЛ ), потому что ионы фтора вызывают вспомогательное истощение 2DEG в области дрейфа и, таким образом, уменьшают плотность 2DEG [29]. Кроме того, ионная имплантация также снижает подвижность ДЭГ. Подвижность 2DEG HEMT FPL и FBL, измеренная с помощью эффекта Холла, составляет 228 см 2 / В с и 203 см 2 / V s после ионной имплантации соответственно. Благодаря одинаковой дозе ионов фтора выходные характеристики и R ВКЛ FPL HEMT и FBL HEMT практически одинаковы при низком напряжении стока (например, V DS <3 В). Однако когда V DS > 3 В, коллапс тока стока насыщения происходит в FBL HEMT, потому что профиль вакансии фтора простирается до области канала 2DEG, и 2DEG может быть легко захвачен этими вакансиями глубокого уровня, индуцированными фтором, когда напряжение стока больше критического. напряжение стока (например, В DS > 3 В) [30], тем самым уменьшая ток стока. Распределение вакансий FPL HEMT далеко от канала 2DEG, что эффективно подавляет коллапс тока стока насыщения.

Измерено a I-V передаточные характеристики, и b Выходные характеристики постоянного тока для трех HEMT
На рисунке 4 показаны измеренные значения I-V . характеристики и смоделированные распределения поверхностного электрического поля в состоянии блокировки. BV FPL / FBL / Conv. Напряжение HEMT составляет 803/746/680 В соответственно. BV определяется как напряжение сток-исток при токе стока ( I DS ) 1 мкА / мм при V GS =- 4 В. Ионы фтора между затвором и стоком в качестве метода завершения уменьшают пик E-поля на краю затвора и вызывают новый пик E-поля в конце области ионной имплантации, и, таким образом, FPL HEMT и FBL HEMT обеспечивает более равномерное распределение поверхностного электрического поля и более высокий BV, чем у Conv. HEMT. По сравнению с FPL HEMT, FBL HEMT обладает усиленным эффектом модуляции электрического поля, поскольку профиль иона фтора близок к каналу 2DEG. Однако для FBL HEMT ионная имплантация неизбежно вызовет дополнительные повреждения в барьере AlGaN [31, 32], что приведет к непрерывному пути тока утечки затвора затвор-барьерный слой-2DEG ; следовательно, BV FBL HMET немного меньше, чем у FPL HEMT.

а Измерено отключенное состояние I-V характеристики с напряжением затвора −4 В, поддерживающим плавающую подложку. б Смоделированные распределения поверхностного электрического поля при V DS =150 В
Импульсный I DS - V DS измерения [33] при медленном переключении были выполнены для характеристики поведения динамического сопротивления в открытом состоянии ( R ВКЛ, Д ) изготовленных НЕМТ AlGaN / GaN. На рис. 5а схематически показано приложение напряжения напряжения во время импульсного I DS - V DS измерения. В импульсном I-V во время измерений на электроды затвора и стока GaN HEMTs воздействовали короткими импульсами напряжения перед каждым I-V измерения, чтобы убедиться, что устройства были в выключенном состоянии. Ширина импульса составляет 3 мс, а период - 5 мс. На рис. 5b – d показано сравнение импульсных выходных характеристик устройств под ( V GS0 , V DS0 ) из (0 В, 0 В) и (0 В, 100 В). Видно, что есть малейшее ухудшение (12,3%) динамического сопротивления включению для Conv. HEMT из-за отсутствия процесса имплантации ионов фтора. По сравнению с FBL HEMT, FPL HEMT имеет низкую деградацию динамического сопротивления включению. Благодаря пассивирующему слою распределение вакансий находится далеко от канала 2DEG и находится внутри пассивирующего слоя, что подавляет захват заряда в FPL HEMT. На рисунке 6 показаны значения отношения R ВКЛ, Д / R ВКЛ для трех HEMT под ( V GS0 , V DS0 ) от (0 В, 0 В) и (0 В, 100 В) с шагом 20 В. Для FBL HEMT измеренное значение R ВКЛ, Д уже увеличивается на 98% от статического при ( V GS0 , V DS0 ) значений (0 В, 0 В) и (0 В, 100 В), а R ВКЛ, Д FPL HEMT увеличивается всего на 23% при высоком смещении покоя стока 100 В.
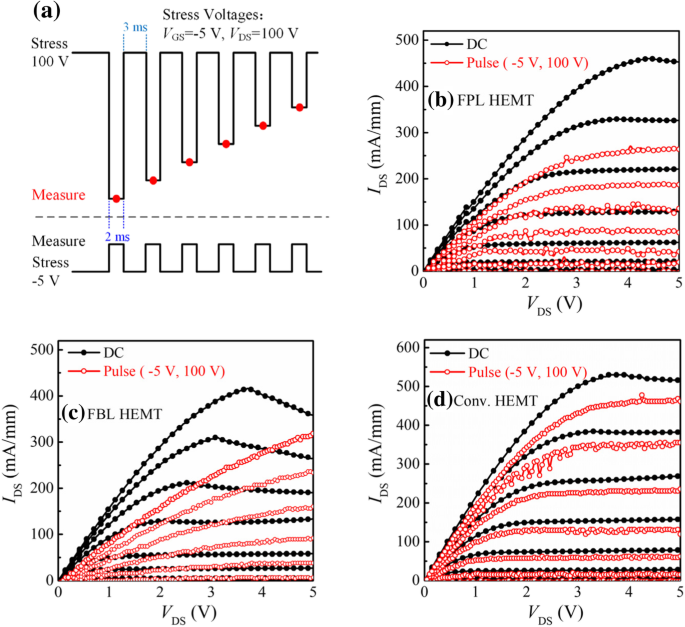
а Схема, изображающая приложение напряжения напряжения во время импульсного I DS - V DS измерения. Импульсный I DS - V DS характеристики изготовленных HEMT AlGaN / GaN с b FPL HEMT, c FBL HEMT и d Конв. HEMT ( V GS =- 4 ~ 0 В; шаг:0,5 В)
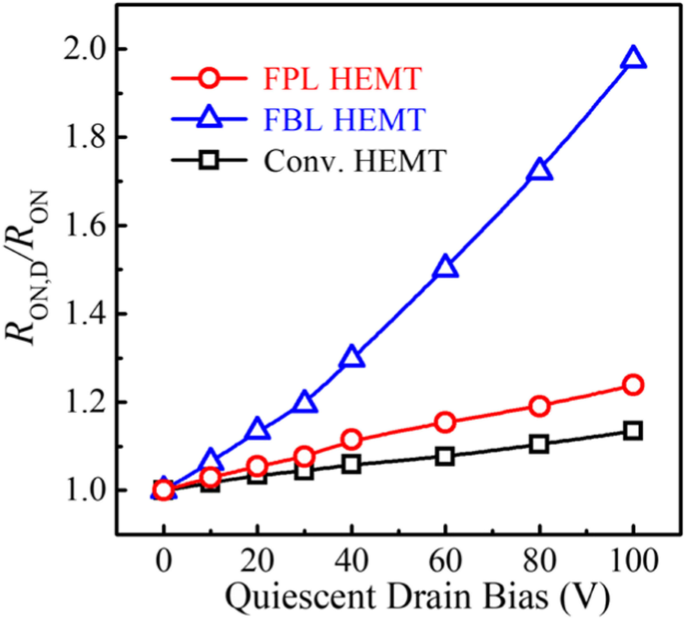
Коэффициент R ВКЛ, Д / R ВКЛ для изготовленных HEMT в различных точках смещения покоящегося дренажа. Ширина и период импульса составляют 3 мс и 5 мс соответственно
Выводы
В заключение мы предложили новый AlGaN / GaN HEMT с высоким напряжением пробоя и низким динамическим сопротивлением в открытом состоянии. Оснащен имплантацией ионов фтора в толстый SiN x слой пассивации. Имплантация ионов фтора в пассивирующий слой может эффективно подавить ухудшение электрических характеристик. Динамическое сопротивление в открытом состоянии всего в 1,23 раза больше, чем статическое сопротивление в открытом состоянии после выключенного состояния V DS напряжение 100 В, а для FBL HEMT - 1,98 раза. Кроме того, ионы фтора в пассивирующем слое также модулируют распределение E-поля и расширяют область обеднения; таким образом, BV предлагаемого HEMT увеличивается до 803 В с 680 В обычного AlGaN / GaN HEMT.
Доступность данных и материалов
Все данные, полученные или проанализированные в ходе этого исследования, включены в эту опубликованную статью.
Сокращения
- 2DEG:
-
Двумерный электронный газ
- HEMT:
-
Транзистор с высокой подвижностью электронов
- ICP:
-
Индуктивно-связанная плазма
- LPCVD:
-
Химическое осаждение из паровой фазы под низким давлением
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- SIMS:
-
Масс-спектроскопия вторичных ионов
- ТЕМ:
-
Просвечивающий электронный микроскоп
Наноматериалы
- Что такое аварийное обслуживание и как с ним бороться
- Влияние состояний поверхности и мольной доли алюминия на поверхностный потенциал и 2DEG в HEMT из AlGaN / GaN
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Совместно модифицированные ТИМы RGO и трехмерных графеновых сетей с высокой производительностью
- Графен / полианилиновый аэрогель со сверхэластичностью и высокой емкостью в качестве высокостойкого к сжати…
- Зависимость толщины от межфазных и электрических свойств в атомарном слое, нанесенном на GaN c-плоскости
- RRAM на основе HfAlOx с атомарным слоем и низким рабочим напряжением для вычислений приложений в памяти
- Боковой транзистор металл-оксид-полупроводник со сверхнизким удельным сопротивлением в открытом состоянии …
- Безрезисторный источник опорного напряжения в наномасштабе с низким энергопотреблением и высоким PSRR
- Материалы и дизайн печатных плат для высокого напряжения



