Исследования оптических свойств множественных квантовых ям InGaN / GaN с различной толщиной верхнего слоя GaN
Аннотация
Три образца МКЯ InGaN / GaN с различной толщиной покровного слоя GaN были выращены методом химического осаждения из газовой фазы (MOCVD) для исследования оптических свойств. Мы обнаружили, что более толстый верхний слой более эффективно предотвращает испарение композиции In в слое квантовой ямы InGaN. Кроме того, квантово-ограниченный эффект Штарка (QCSE) усиливается с увеличением толщины покрывающего слоя GaN. Кроме того, по сравнению с результатами измерения электролюминесценции, мы сосредоточились на различии состояний локализации и дефектов в трех образцах, вызванных разной толщиной крышки, чтобы объяснить аномалии в измерениях фотолюминесценции при комнатной температуре. Мы обнаружили, что слишком тонкий покрывающий слой GaN усугубляет неоднородность состояний локализации в слое квантовой ямы InGaN, а слишком толстый покрывающий слой GaN создает больше дефектов в покрывающем слое GaN.
Введение
Структура с множественными квантовыми ямами (МКЯ) InGaN / GaN широко используется в светодиодах видимого диапазона (СИД) и лазерных диодах (ЛД) в качестве активной области и достигла большого успеха [1,2,3,4]. Повышение качества МКЯ InGaN / GaN технологически важно для реализации высокоэффективных светодиодов и ЛД на основе GaN. В предыдущих исследованиях было обнаружено, что высокотемпературные квантовые барьеры (КБ) из GaN (HT-GaN) полезны для улучшения качества кристалла и силы света квантовых ям InGaN / GaN [5, 6]. Из-за слабой прочности связи In-N температура роста слоя квантовых ям (КЯ) InGaN обычно ниже, чем КД GaN для получения высокого содержания In. Это может вызвать испарение атомов индия из квантовой ямы InGaN во время роста квантовой ямы GaN при более высокой температуре. Доказано, что вставка низкотемпературного покрывающего слоя GaN (LT-GaN cap) между InGaN QW и GaN QB эффективно снижает десорбцию состава In, что может улучшить однородность толщины слоя InGaN QW и распределение состава In [7,8,9]. Однако, когда температура роста покрывающего слоя GaN снижается, миграционная способность адатомов становится слабее, что приводит к ухудшению качества материалов GaN. Более того, сообщается, что количество дефектов увеличивается с увеличением толщины покрывающего слоя GaN, выращенного при низких температурах, что не способствует улучшению однородности распределения атомов индия и интенсивности света квантовых ям InGaN [10]. Многие предыдущие отчеты не фокусировались на влиянии состояний локализации на люминесцентные свойства в активной области с различной толщиной крышки GaN. В этой работе мы используем рентгеновскую дифракцию (XRD), электролюминесценцию (EL) и фотолюминесценцию (PL), чтобы сообщить о влиянии толщины покрывающего слоя GaN, выращенного при низких температурах, на структуру и люминесцентные свойства InGaN / GaN. МКЯ и подробно описывают роль состояний локализации в характеристиках люминесценции с помощью температурно-зависимых экспериментов по ФЛ.
Методы
Три образца МКЯ InGaN / GaN были выращены на сапфировой подложке с плоскостью c методом химического осаждения из газовой фазы (MOCVD). Все образцы содержат одинаковые структуры, состоящие из нелегированного буферного слоя GaN (1,2 мкм), слоя n-GaN, легированного Si (1 мкм), двухпериодной активной области МКЯ InGaN / GaN и легированного магнием p-GaN. слой (40 нм). В процессе выращивания активной области InGaN / GaN условия выращивания квантовых ям InGaN были идентичны друг другу; тонкий покрывающий слой LT-GaN был выращен при той же температуре, что и InGaN QW (710 ° C), чтобы предотвратить испарение индия, а время роста покрывающего слоя LT-GaN составляло 150, 300 и 500 с для образца A, B и C соответственно; а затем температура роста GaN QB была повышена до 810 ° C, чтобы улучшить качество материала GaN QB, и время роста HT-GaN QB было идентичным для этих образцов. Для определения структурных параметров этих трех образцов использовалась дифракция рентгеновских лучей (XRD). Электролюминесценция (EL) и фотолюминесценция (PL) при комнатной температуре были проведены для характеристики оптических свойств активных областей.
Спектры ЭЛ измерялись с помощью спектрометра высокого разрешения Ocean Optics HR2000 при постоянном токе (DC), где выходная мощность измерялась с помощью Si-фотодиода, а энергия спектрального пика ЭЛ и FWHM обнаруживались монохроматором и фотоумножителем. Для измерения PL a λ В качестве источника возбуждения использовался He-Cd-лазер непрерывного действия длиной 325 нм с падающей оптической мощностью 3 мВт и размером пятна 0,5 мм 2 . Температурно-зависимые измерения ФЛ от 30 до 300 К были записаны для анализа влияния состояний локализации на характеристики люминесценции с использованием полупроводникового лазера на основе GaN с длиной волны 405 нм и мощностью излучения 5 мВт в качестве источника возбуждения. Образец охлаждали проточным жидким гелием, а для температурно-зависимых измерений использовали холодильник замкнутого цикла CTI Cryogenics.
Результаты и обсуждения
На рис. 1а показаны дифрактограммы плоскости (0002), полученные при сканировании ω-2θ для этих образцов. Хорошо видны сателлитные пики этих образцов, что свидетельствует о наличии тонкой периодической структуры и резкой границы раздела в этих МКЯ. Мы используем SmartLab Studio II и программу Global Fit (предлагающую расширенный метод подгонки базы с параллельным отпуском для анализа данных, генерируемых дифрактометром SmartLab), чтобы получить средний состав по In, а также толщину QB и QW, как показано в Таблице 1. Это может быть ясно видно, что содержание индия в квантовой яме увеличивается с увеличением толщины покрывающего слоя LT-GaN, что указывает на то, что более толстый покрывающий слой более эффективен для предотвращения испарения композиции индия. На рисунке 1b показано отображение обратного пространства (RSM) образца C. Главный пик GaN и сателлитные пики расположены на одной линии, что свидетельствует о том, что слои квантовых ям с самым высоким содержанием In во всех образцах полностью деформированы. Поэтому следует учитывать влияние пьезоэлектрического поля на световые свойства.
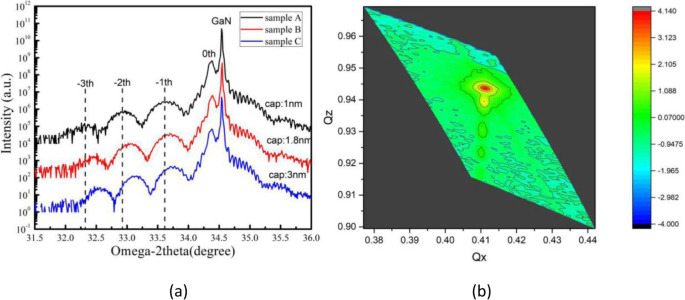
а Кривые сканирования XRD ω-2θ на плане GaN (0002) для образцов A, B и C. b Отображение взаимного пространства образца C
На рис. 2 показаны спектры электролюминесценции образцов A, B и C при токе 5 мА. Длина волны пика составляет 453,6 нм, 456,3 нм и 466,7 нм для образцов A, B и C соответственно. Судя по результатам измерений XRD, по мере увеличения толщины покрывающего слоя LT-GaN увеличенный состав In в квантовых ямах вызывает красное смещение энергии пика электролюминесценции. Мы также обнаружили уменьшение интенсивности ЭЛ с увеличением толщины покровного слоя LT-GaN. Известно, что более толстый барьерный слой GaN (общая толщина покрывающего слоя LT-GaN и HT-GaN QB) увеличивает расстояние дырок от p-GaN до активной области, что приводит к снижению эффективности инжекции дырок, что приводит к к снижению интенсивности ЭЛ [11, 12]. Кроме того, увеличение состава In будет увеличивать пьезоэлектрическое поле в слое квантовой ямы InGaN, так что наклон энергетической полосы усиливается, что приводит к красному смещению пика излучения и снижению световой отдачи, что известно как квантово-ограниченный штарк. эффект (QCSE) [13,14,15]. Чтобы проверить влияние QCSE на EL, пиковая энергия и FWHM EL, изменяющаяся при различной инжекции, показаны на рис. 3. По мере увеличения тока инжекции синий сдвиг энергии пика эмиссии можно отнести к эффекту заполнения полосы и QCSE. компенсируется эффектом электронного экранирования [16,17,18]. Поскольку образец C с наибольшим составом In имеет самую глубокую потенциальную яму и самое сильное пьезоэлектрическое поле, эффект заполнения зоны и эффект экранирования заряда являются наиболее значительными, поэтому величина синего сдвига энергии пика электролюминесценции является наибольшей для образца C (166 мэВ ). Эффект заполнения зоны и эффект экранирования заряда в образце A самый слабый, так что сокращение запрещенной зоны из-за теплового эффекта постепенно преобладает при высоком токе инжекции (50 мА), что приводит к красному смещению пиковой энергии. Для образца A FWHM увеличивается с увеличением тока инжекции, как показано на рис. 3b, указывая на то, что уширение спектра электролюминесценции, вызванное эффектом заполнения полосы, всегда преобладает. Сообщалось, что зарядовая экранировка поляризованного электрического поля в квантовых ямах InGaN будет вызывать сужение спектральной ширины полосы электролюминесценции с увеличением тока инжекции [19]. Следовательно, для образцов B и C эффект заполнения зоны значительный при меньших токах инжекции, и спектр ЭЛ расширяется. По мере дальнейшего увеличения инжекционного тока процесс экранирования носителей поляризованного электрического поля постепенно вступает во владение, поэтому значение FWHM уменьшается. Кроме того, мы также обнаружили, что ток, соответствующий поворотной точке FWHM от нарастания до спада для образцов B и C, составляет примерно 10 мА и 20 мА соответственно, что также означает, что пьезоэлектрическое поле в образце C является самым сильным. P> 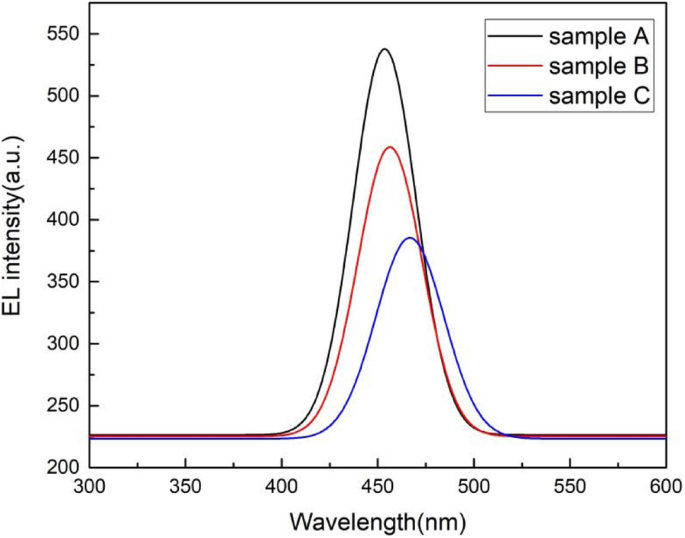
Спектры электролюминесценции образцов A, B и C при токе 5 мА
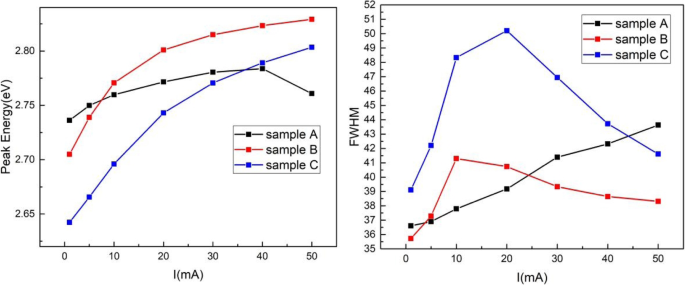
( а ) Пиковая энергия EL и ( b ) Полная ширина EL на полувысоте (FWHM) как функция тока инжекции для образцов A, B и C
На рис. 4а показаны спектры ФЛ при комнатной температуре образцов A, B и C при мощности возбуждения полупроводникового лазера на GaN с длиной волны 5 мВт 405 нм. Длина волны пика составляет 473,1 нм, 472,9 нм и 478,2 нм для образцов A, B и C соответственно. Поскольку интенсивность фотолюминесценции образцов B и C на рис. 4a относительно мала, мы также использовали 325 нм He-Cd-лазер в качестве источника возбуждения для проведения эксперимента по фотолюминесценции. Результаты экспериментов по ФЛ на рис. 4а и б согласуются между собой, что устраняет неопределенность экспериментальных результатов, полученных на рис. 4а. По сравнению с результатами измерения электролюминесценции на рис. 2, мы обнаружили некоторые аномалии на рис. 4а:(1) образец A содержит меньше In в составе, чем образец B, но пиковая длина волны образца A немного длиннее, чем образец B; (2) интенсивности ФЛ образцов B и C подобны друг другу, а сила света образца A намного выше, чем у образцов B и C. Чтобы выяснить соответствующие причины для объяснения этих аномалий, зависимая от температуры PL (TDPL ) была проведена для трех образцов, а зависимость энергии пика ФЛ от температуры показана на рис. 5. Для образца B энергия пика излучения монотонно уменьшается с увеличением температуры. Вообще говоря, увеличение уменьшения ширины запрещенной зоны, вызванное температурой, приведет к красному смещению энергии излучения. Однако в образце A наблюдается заметный синий сдвиг при повышении температуры от 70 K до 190 K. Тепловое перераспределение локализованных экситонов было введено для объяснения аномального синего сдвига излучения в TDPL:при повышении температуры локализованные экситоны термически активируются и термический переход от потенциальных минимумов состояний локализации к состоянию с более высокой энергией [5, 20, 21]. Для образца C пиковая энергия ФЛ практически не изменяется в диапазоне от 50 K до 175 K, что указывает на взаимное смещение эффекта уменьшения ширины запрещенной зоны и эффекта локализации экситонов.
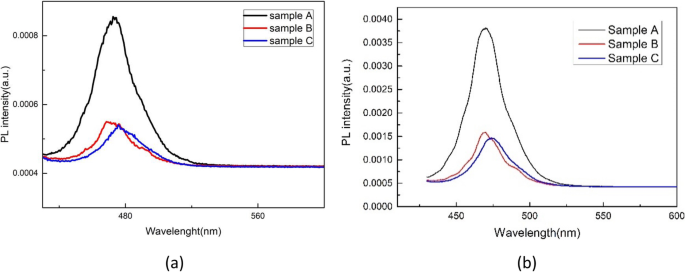
Спектры ФЛ при комнатной температуре для образцов A, B и C с использованием полупроводникового лазера на основе GaN с длиной волны 405 нм ( a ) и 325 нм He-Cd-лазер ( b ). Пиковая длина волны 473,1 нм, 472,9 нм и 478,2 нм, полученная из ( a ) и 470,5 нм, 470,1 нм и 475,2 нм, полученные из ( b ) для образцов A, B и C соответственно
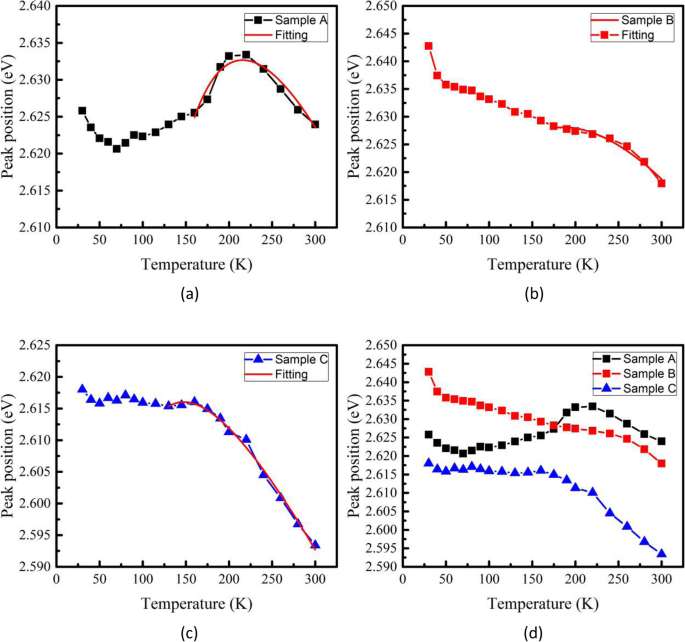
Красные линии в ( a ), ( b ) и ( c ) являются аппроксимирующими кривыми, основанными на формуле. (1) и подгоночный параметр σ составляет 36,96 мэВ, 18,89 мэВ и 23,77 мэВ для образцов A, B и C соответственно. ( д ) Приведены экспериментальные данные по энергии пика ФЛ как функции температуры
Учитывая эффект локализации экситона, модель хвоста зоны может быть изменена до следующего выражения для описания энергии пика излучения, зависящего от температуры [22, 23]:
$$ {E} _0 (T) ={E} _0 (0) \ hbox {-} \ frac {\ alpha {T} ^ 2} {T + \ beta} \ hbox {-} \ frac {\ sigma ^ 2 } {{\ mathrm {k}} _ BT} $$ (1)где E 0 (0) - ширина запрещенной зоны при T =0, α и β параметры Варшини, k B - постоянная Больцмана. Третий член σ является стандартным отклонением локализованного распределения и описывает степень эффекта локализации, т. е. большее значение σ означает более сильную неоднородность состояний локализации. Колебания состава In в InGaN могут быть основной причиной образования хвоста полосы. Состояния в хвостах зон образуются при минимальной локальной потенциальной энергии, подобно квантовым точкам. Рекомбинацию электронно-дырочных пар в этих самообразованных квантовых точках можно рассматривать как локализованную рекомбинацию экситонов [24, 25]. Модель неприменима при низких температурах из-за сильного вырождения и возможного отклонения от квазиравновесия [20]. Подгоночный параметр σ составляет 36,96 мэВ, 18,89 мэВ и 23,77 мэВ для образцов A, B и C соответственно, что означает, что состояния локализации образца A с самым тонким покровным слоем являются наиболее неоднородными. Обычно состояния локализации возникают из-за кластеров с высоким содержанием In с разными размерами и флуктуации толщины квантовой ямы в сплавах InGaN. Поэтому мы разумно полагаем, что более тонкий верхний слой LT-GaN не может эффективно предотвратить испарение индия при повышении температуры до выращенного слоя GaN QB. Процесс случайного испарения состава индия приводит к колебаниям содержания индия и толщины квантовой ямы InGaN. Для образца B покровный слой GaN толщиной 1,8 нм является достаточно толстым, чтобы защитить In от десорбции и сформировать более однородный слой квантовой ямы InGaN. Неоднородные состояния локализации обычно сохраняют более глубокое потенциальное состояние и приводят к красному смещению энергии пика излучения. Вот почему длина волны пика образца A больше, чем у образца B, наблюдаемого на рис. 4. Кроме того, увеличение состава In в слое квантовой ямы InGaN также будет способствовать образованию кластеров In большого размера, что объясняет, почему эффект локализации экситона в образце C с наибольшим содержанием индия немного прочнее, чем в образце B.
На рис. 6 показана интегральная интенсивность ФЛ как функция температуры для образцов A и C, которая хорошо описывается следующим выражением [5, 26]:
$$ I (T) =\ frac {1} {1 + {\ sum} _ {\ mathrm {i}} {C} _i \ exp \ left (- \ frac {E_i} {k_BT} \ right)} $ $ (2)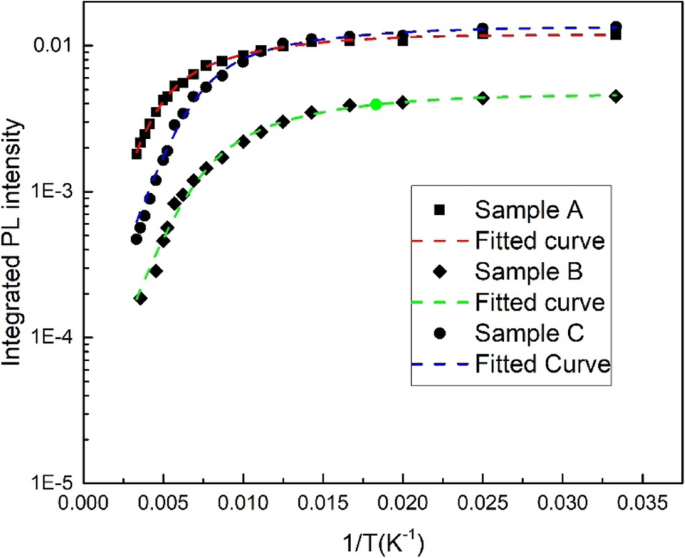
Интегральная интенсивность ФЛ как функция обратной температуры для образцов A, B и C
где C я - постоянная, соответствующая плотности центров безызлучательной рекомбинации, а E я представляет собой энергию активации центров безызлучательной рекомбинации. Подгоночный параметр C я и E я были показаны в таблице 2. Заметно, что напряжение фотоумножителя в решетчатом спектрометре для образца B было установлено ниже, чем для образцов A и C, во время температурно-зависимых измерений ФЛ; следовательно, интегральная интенсивность ФЛ образца B самая низкая, но это не влияет на результаты подгонки.
C 2 для образцов B и C больше, чем для образца A, что указывает на то, что больше дефектов формируется в более толстом покрывающем слое LT-GaN. Было обнаружено, что дефекты в слое LT-крышки увеличиваются с увеличением толщины слоя LT-крышки [6, 10]. Влияние дефектов в покрывающем слое LT-GaN рядом с квантовой ямой на интенсивность ФЛ существенно, поскольку волновые функции электронов и дырок проникают в барьеры. Активная энергия 79,67 мэВ ( E a2 для образца A) связано с испусканием дырок из квантовых ям с последующим захватом на барьерные дефекты и безызлучательной рекомбинацией, что подтверждается отчетами Олайзолы [6]. Мы также сравнили изображения микро-ФЛ образцов A, B и C, как показано на рис. 7. Темные пятна на изображениях микро-ФЛ можно отнести к безызлучательной рекомбинации в активной области InGaN / GaN. По сравнению с образцом A, в образцах B и C, очевидно, можно наблюдать более крупные темные пятна, что указывает на то, что больше дефектов существует в более толстом покрывающем слое LT-GaN. Как правило, термический отжиг реализуется после верхнего слоя LT, чтобы уменьшить кластер индия в слое InGaN и улучшить качество кристалла. Если покрывающий слой слишком толстый, эффект термического отжига будет ослаблен, и образование большего количества преципитатов металлического индия будет препятствовать диффузии адатомов из покрывающего слоя GaN и вносить больше дефектов в закрывающий слой LT. Появление большего количества дефектов и более сильного QCSE в МКЯ InGaN / GaN с более толстым закрывающим слоем LT-GaN является невыгодным для повышения интенсивности люминесценции, так почему же интенсивность ФЛ C сравнима с B? Фактически, состояния локализации также играют важную роль в улучшении световой отдачи. Носители могут быть захвачены в локализованные состояния и излучательно рекомбинировать. Чем сильнее локализованный эффект экситонов, тем больше носителей не будет захвачено дефектами, что, по-видимому, объясняет, что интенсивность ФЛ образцов B и C похожа друг на друга, а сила света образца A намного выше, чем у образцов B и C.
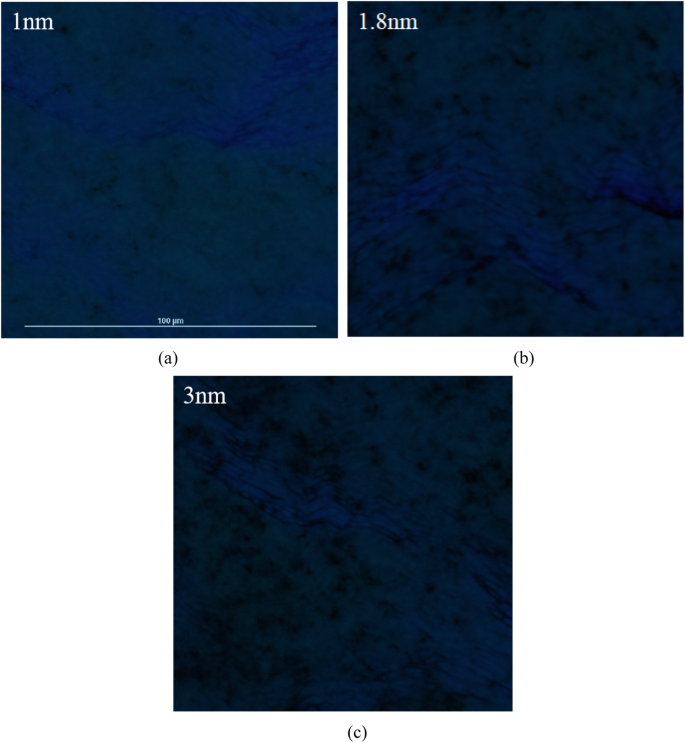
Изображения Micro-PL образцов A, B и C с различной толщиной покровного слоя LT-GaN ( a ) 1 нм, ( b ) 1,8 нм и ( c ) 3,0 нм
Выводы
Таким образом, было исследовано влияние толщины покровного слоя GaN на оптические характеристики. Результаты, полученные в результате измерений XRD, показывают, что более толстый верхний слой более эффективен для защиты композиции In от десорбции. QCSE улучшается, а эффективность инжекции дырок снижается с увеличением толщины покрывающего слоя GaN. Различная степень эффекта локализации экситона, вызванная разной толщиной покровного слоя GaN, объясняет аномалии длины волны и интенсивности пика ФЛ для трех образцов. Слишком тонкий верхний LT-слой усугубит неоднородность состояний локализации в слое квантовой ямы InGaN, а слишком толстый LT-верхний слой вызовет больше дефектов в покровном слое GaN. Следовательно, оптимизация толщины закрывающего слоя LT-GaN является ключевым вопросом для обеспечения однородности и интенсивности излучения активного слоя InGaN.
Доступность данных и материалов
Наборы данных, использованные и / или проанализированные в ходе текущего исследования, доступны у соответствующего автора по разумному запросу.
Сокращения
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- QCSE:
-
Квантово-ограниченный эффект Штарка
- MQW:
-
Множественные квантовые ямы
- QB:
-
Квантовый барьер
- светодиоды:
-
Светодиоды
- LD:
-
Лазерные диоды
- HT:
-
Высокая температура
- LT:
-
Низкая температура
- EL:
-
Электролюминесценция
- TDPL:
-
Фотолюминесценция в зависимости от температуры
- XRD:
-
Рентгеновская дифракция
- FWHM:
-
Полная ширина на половине максимальной
Наноматериалы
- Атомная перестройка множественных квантовых ям на основе GaN в смешанном газе H2 / NH3 для улучшения структурных …
- Многоцветное излучение ультрафиолетовой фотонной квазикристаллической нанопирамиды на основе GaN с полуполя…
- Электрические свойства гибридных композитов на основе многослойных углеродных нанотрубок с графитовыми нан…
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Влияние толщины бислоя на морфологические, оптические и электрические свойства наноламинатов Al2O3 / ZnO
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Оптимальные слои легирования кремнием квантовых барьеров в последовательности роста, формирующие потенциал…
- Исследование солнечного элемента из кристаллического кремния с черным слоем кремния на задней панели
- Морфология, структура и оптические свойства полупроводниковых пленок с наноостровками GeSiSn и напряженными сл…
- Оптические свойства пленок ZnO, легированных алюминием, в инфракрасной области и их применения для поглощения



