Изготовление высококачественных микродисков из GeSn с релаксирующей деформацией путем интеграции методов селективного эпитаксиального роста и селективного влажного травления
Аннотация
GeSn - перспективный материал для изготовления фотонных и наноэлектронных устройств на кристалле. Таким образом, были разработаны методы обработки, посвященные GeSn, включая эпитаксию, отжиг, ионную имплантацию и травление. В данной работе подвешенные, деформационно-релаксированные и высококачественные микродиски GeSn реализованы по новому подходу без какого-либо травления сплава GeSn. Сплав GeSn был выращен на предварительно структурированной подложке Ge (001) методом молекулярно-лучевой эпитаксии при низких температурах. Просвечивающая электронная микроскопия и сканирующая электронная микроскопия были проведены для определения микроструктуры образцов GeSn. Микродиски с различными диаметрами пьедесталов из Ge были изготовлены путем управления временем селективного влажного травления, и результаты микро-комбинационного рассеяния показывают, что микродиски с разными размерами остальных пьедесталов из Ge имеют разную степень релаксации деформации. Сжимающая деформация микродисков почти полностью снимается при подходящих условиях. Технология обработки полупроводников, представленная в этой работе, может быть альтернативным методом для изготовления инновационных микро / наноструктур на основе GeSn и других материалов для ряда приложений Si-совместимой фотоники, 3D-MOSFET и микроэлектромеханических устройств.
Введение
Германий-олово (GeSn), дополнительный металл-оксид-полупроводник (КМОП) -совместимый материал группы IV, в последние годы привлек значительное внимание в связи с его применением в электронике и оптоэлектронике. Добавление большего количества Sn в Ge может улучшить подвижность носителей, а также изменить ширину запрещенной зоны с непрямого перехода на прямой [1, 2]. Теоретические работы [3,4,5] и экспериментальные исследования на основе фотолюминесценции [6,7,8] показывают, что непрямой переход в прямой для релаксированного сплава GeSn происходит при содержании Sn не менее 6,5%. Однако низкая (1%) равновесная растворимость Sn в Ge [9, 10] и большое несоответствие решеток (~ 15%) между Ge и α-Sn создают огромные проблемы для реализации бездефектного сплава GeSn даже с несколько атомных% замещенного Sn. Использование методов неравновесного роста, таких как низкотемпературная молекулярно-лучевая эпитаксия (MBE) [11,12,13,14,15], химическое осаждение из паровой фазы (CVD) [16,17,18,19,20] и остро нуждается твердофазная эпитаксия [21, 22].
В случае сплава GeSn, выращенного на виртуальной подложке Ge с релаксированной деформацией или подложке Ge, ожидается, что наивысшее качество GeSn будет достигнуто в псевдоморфном или полностью деформированном состоянии, что может избежать образования несоответствий и пронизывающих дислокаций. Тем не менее, такой сплав GeSn деформируется при сжатии (~ 0,15% на 1% Sn), и эта деформация, вызванная эпитаксией, сводит на нет эффект легирования Sn с Ge для преобразования запрещенной зоны. В результате для достижения прямой запрещенной зоны требуется гораздо более высокое содержание Sn - 17% для псевдоморфного эпитаксиального слоя GeSn на Ge (001) [23], что приводит к чрезвычайно высоким требованиям к эпитаксии и низкому качеству материала. Поэтому манипулирование деформацией без ущерба для качества кристалла эпислоев GeSn становится очень важной проблемой. Селективное удаление вызывающей напряжения виртуальной подложки Ge или подложки Ge под эпислоями GeSn для образования частично подвешенных микроструктур является многообещающим методом преодоления деформации сжатия в пленках GeSn. Например, были изготовлены подвесные микродиски из GeSn с опорной стойкой в центре [24,25,26,27,28]. Структура может не только ослабить сжимающую деформацию в слое GeSn за счет упругой деформации на свободных поверхностях, но также ограничить оптические модели вблизи края микродиска из-за сильного контраста показателя преломления между GeSn и окружающей средой (воздухом), например шепотом. -gallery-mode [16, 25]. На данный момент описан только один метод изготовления микродисков GeSn с помощью постростовой оптической литографии и травления двумерной пленки GeSn сверху вниз [16, 24, 29, 30]. Однако процесс может подвергаться эффектам теплового рассогласования во время процесса постростового травления, что приведет к ухудшению качества материала микродисков GeSn. Недавно P.Ponath et al. сообщили об избирательном росте площади высококристаллических c BTO с ориентацией по оси [31], которая вдохновила нас на создание микроструктур GeSn. Путем размещения микродисков GeSn непосредственно на последнем этапе на предварительно структурированном SiO 2 / Ge, а затем выборочно протравливает подложку Ge после жертвенного SiO 2 После удаления слоя подвешенные микродиски из GeSn могут быть изготовлены без обычного и сложного процесса постростового травления. Такой метод, если это осуществимо, может избежать вышеупомянутых проблем и, таким образом, получить более качественную микроструктуру GeSn с релаксирующей деформацией. Более того, это также очень многообещающий метод, позволяющий создавать произвольные узоры с высокой точностью и хорошим соотношением сторон, особенно для трехмерной интеграции сложных структур устройств, которые требуют точного контроля толщины слоев.
В данной работе структуры микродисков GeSn были успешно изготовлены новым методом. Это первый опыт изготовления микродисков GeSn, сочетающий селективный эпитаксиальный рост с простым этапом селективного влажного травления. Толщина, концентрация Sn и кристаллическое качество эпислоя GeSn были охарактеризованы с помощью просвечивающей электронной микроскопии высокого разрешения (HRTEM) и масс-спектрометрии вторичных ионов (SIMS). Сканирующая электронная микроскопия (SEM) и микро-рамановская спектроскопия (μ-Raman) были использованы для понимания микроструктуры изготовленных микродисков GeSn. Результаты μ-Рамана при комнатной температуре (RT) показывают, что микродиски с разными размерами оставшихся Ge-пьедесталов имеют разную степень релаксации деформации. Сжимающая деформация микродисков почти полностью снимается при подходящих условиях. Этот метод изготовления микродисков без необходимости травления самого GeSn полезен для получения релаксированных и высококачественных наноструктур GeSn и других материалов.
Методы
Материалы
Пластины Ge были приобретены у компании AXT. Ацетон, изопропиловый спирт, плавиковая кислота, этиловый спирт, перекись водорода, водный раствор аммиака и гидроксид калия были поставлены Sinopharm Chemical Reagent (Китай). Деионизированный H 2 O (18,2 МОм · см) получали из системы ультрафильтрации (Milli-Q, Millipore, Мальборо, Массачусетс).
Подготовка подложки Ge с рисунком
Пластины Ge (001) (n-типа, 0,025–0,031 Ом · см) сначала погружали в ацетон и изопропиловый спирт на 3 мин, а затем химически очищали с использованием разбавленного раствора плавиковой кислоты (HF:H 2 O =1:20) в течение 20 с при КТ. После этого была проведена промывка в деионизированном H 2 . O (DI – H 2 О). Процедура очистки важна, особенно обработка HF для снятия слоя естественного оксида и обеспечения чистой поверхности Ge и плотного контакта со следующим SiO 2 слой. В этом случае профиль отрыва достигается осаждением Si / SiO 2 композитный слой. Затем вафли сушили продувкой N 2 . и быстро загружают в камеру сверхвысокого вакуума (UHV) плазменного химического осаждения из паровой фазы (PECVD) и отжигают при 300 ° C в течение 20 минут до полного удаления газа. Затем 300 нм SiO 2 Слой был нанесен при той же температуре с помощью PECVD с последующим нанесением 50 нм нелегированного поликристаллического Si с помощью магнетронного распыления при комнатной температуре, как показано на рис. 1а. Круглые отверстия в Si / SiO 2 Композитный слой формируется с помощью стандартной техники фотолитографии (рис. 1b) и двухэтапного травления (рис. 1c, d).
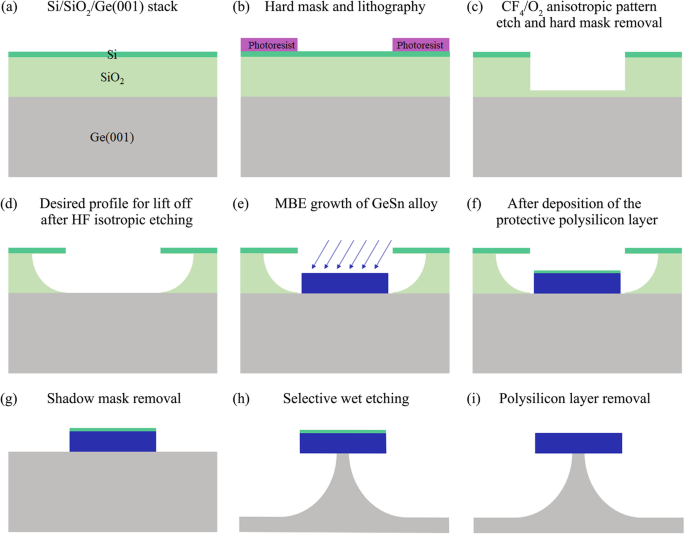
Схема поперечного сечения изготовления подвесных микродисков GeSn
Более подробно, перед нанесением рисунка Si / SiO 2 / Ge, пластина очищалась ацетоном, этиловым спиртом и DI-H 2 O, затем высушили феном с N 2 и предварительно запекли в духовке при 90 ° C. После этого на него наносили центрифугирование фоторезистом AZ5214 с использованием центрифуги для нанесения покрытия при скорости 4000 об / мин в течение 30 с, а затем помещали на плиту для мягкой выпечки при 90 ° C на 2 мин. Затем машина для изготовления пластин (Heidelberg, uPG501) была использована для создания массивов узоров в форме круга на Si / SiO 2 / Ge стеки. Круглые узоры закреплены на расстоянии 5 мкм друг от друга, а диаметр составляет от 3 до 5 мкм. Затем образцы были перенесены на нижний SiO 2 . слой двухступенчатым травлением. Анизотропное сухое травление реактивным ионным травлением газовой смесью CF 4 и O 2 впервые был использован для травления Si / SiO 2 слоев и остановили примерно 20 нм SiO 2 левый. Затем для удаления оставшегося SiO 2 использовали растворение фоторезиста и влажное травление с использованием разбавленной HF при комнатной температуре. слой, чтобы обнажить германий в круглых отверстиях, а также протравить латерально под определенной кромкой поликремния, чтобы создать выступ, который является желаемым профилем для отрыва.
Рост GeSn и изготовление микродисков
Для осаждения тонких пленок GeSn используется система MBE с твердым источником (Riber SSC) с базовым давлением 2 × 10 −10 Использовался Торр [32]. Электронно-лучевой испаритель и пиролитическая эффузионная ячейка BN с использованием твердых источников высокой чистоты оборудованы для испарения Ge и Sn в системе MBE. Для калибровки скорости осаждения использовался кварцевый монитор. Перед загрузкой подложек с рисунком в систему сверхвысокого вакуума подложки были очищены O 2 плазма для удаления любых органических остатков, вызванных сухим травлением. После ополаскивания в ацетоне, изопропиловом спирте и разбавленной HF подложки переносили в камеру MBE для роста GeSn. После термодесорбции при 450 ° C в течение 15 минут подложки охлаждались на месте до 150 ° C для роста слоя сплава GeSn со скоростью роста Ge 0,5 Å с −1 и контролируемый поток Sn в качестве источника легирующей примеси. Эта температура роста достаточно низка, чтобы эффективно сдерживать поверхностную сегрегацию Sn. Чтобы предотвратить окисление, окончательно осаждали закрывающий слой Ge толщиной 10 нм при той же температуре.
После выращивания сплавы GeSn с номинальной концентрацией Sn 4% и 10% будут использоваться для изготовления микродисков. Затем на верхнюю часть образцов при комнатной температуре наносился дополнительный слой поликремния толщиной 30 нм с использованием магнетронного распыления для защиты слоя GeSn от последующего травления. Затем жертвенный SiO 2 Слой был удален разбавленным HF (1:1), что также приводит к удалению перекрывающего слоя поликремния и нанесенной на него пленки GeSn. Как видно на рис. 2, изолированные круглые столбы GeSn были обнаружены после SiO 2 слой был удален. Однако периферия круговой мезы не такая гладкая, что плохо сказывается на эффектах оптического ограничения. Неожиданная ситуация вызвана осаждением GeSn на краю нижнего SiO 2 слой, возникающий из-за недостаточного бокового травления нижнего SiO 2 и осаждение под неправильным углом (30 °). Впоследствии простой этап селективного влажного травления подрезает круглые столы при комнатной температуре, что приводит к образованию подвешенных структур микродисков GeSn. Селективный травитель (APM) состоит из H 2 О 2 (31 мас.%), NH 4 ОН (28 мас.%) И DI-H 2 O с объемным соотношением 2:0,5:80 [30]. Наконец, верхний защитный слой поликремния был удален с помощью КОН. Схема этапов процесса показана на рис. 1e – i.
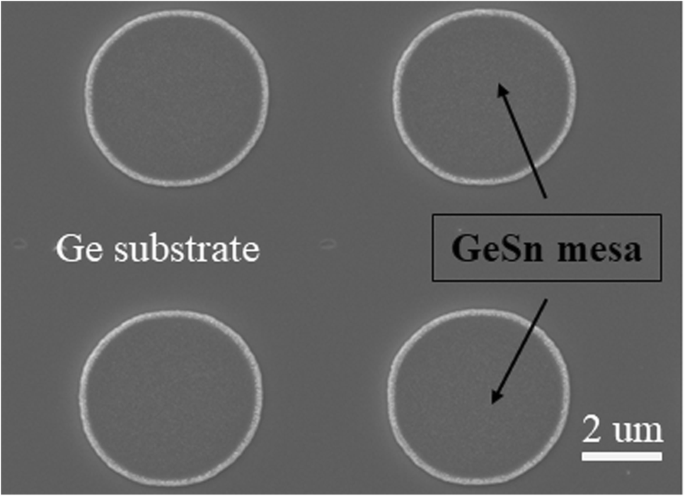
Вид сверху на СЭМ-изображение изолированных круглых столешниц из GeSn диаметром 5 мкм после удаления теневой маски
В нашем методе изготовления микродисков GeSn важное значение имеет окончательное селективное влажное травление из-за разной скорости травления материалов GeSn с разной концентрацией Sn. Селективность травления Ge над Ge 1 − x Sn x также будет меняться в зависимости от концентрации Sn. Чем выше концентрация Sn в GeSn, тем выше покрытие поверхности SnO y будут разработаны [33]. Это снизит скорость влажного травления GeSn и приведет к более высокой селективности травления Ge по сравнению с GeSn. В предыдущем исследовании сообщалось, что H 2 О 2 мокрое травление на основе (H 2 О 2 :NH 4 ОН:H 2 O =2:0,5:80), как и в этой работе, достигается селективность травления Ge по сравнению с Ge 0,928 Sn 0,072 из 9:1 [30].
Результаты и обсуждение
На рис. 3а показана электронная микроскопия поперечного сечения круглой мезы GeSn диаметром 5 мкм без верхнего слоя поликремния. На рис. 3b, c представлены микрофотографии ПЭМ высокого разрешения (ПЭМВР) для областей A и B, соответствующих границе раздела GeSn / Ge и средней области слоя GeSn, соответственно. Толщина пленки слоя GeSn примерно на 250 нм (рис. 3а) меньше толщины теневой маски. Как видно на рис. 3б, дефекты в основном локализуются на границе раздела GeSn / Ge толщиной 30 нм, что приводит к последующему росту монокристалла GeSn. На изображении HRTEM области B видны четкие полосы решетки слоя GeSn, что указывает на то, что сплав является высококристаллическим, а картина быстрого преобразования Фурье (БПФ) области B хорошо соответствует дифракционной картине GeSn, как показано на рис. 3c. Кроме того, чтобы подтвердить концентрацию Sn в сплаве GeSn, было выполнено измерение SIMS, как показано на вставке к рис. 3а. Концентрация Sn составляет 9,8 ± 0,5%, что соответствует номинальному значению около 10%. Кроме того, распределение атомов Sn очень однородно по глубине профиля только что выращенной пленки GeSn.
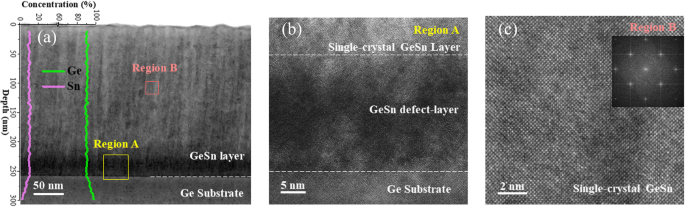
а Поперечное сечение ПЭМ-изображения круглой мезы GeSn диаметром 5 мкм без верхнего слоя поликремния. Врезка:профиль глубины ВИМС слоя GeSn. б ПЭМ-изображение интерфейса GeSn / Ge с высоким разрешением (область A). c ПЭМ-изображение высокого разрешения для средней области слоя GeSn (область B). Вставка:шаблон БПФ области B
Структуру поверхности образцов исследовали методом сканирующей электронной микроскопии. На рис. 4а показано СЭМ-изображение сверху Ge 0,96 диаметром 5 мкм. Sn 0,04 круглые столы после 510 с селективного влажного травления раствором АРМ при КТ. Следует отметить, что травители готовятся непосредственно перед экспериментами, чтобы избежать эффектов старения химикатов. СЭМ-изображение показывает, что не только подложка Ge, но и часть мезы GeSn вытравлены. Невозможность сформировать структуру диска для Ge 0.96 Sn 0,04 сплав обусловлен низкой концентрацией Sn, что приводит к низкой селективности травления Ge по сравнению с GeSn. В отличие от Ge 0.96 Sn 0,04 Образец круглой мезы GeSn диаметром 5 мкм с более высокой концентрацией Sn, равной 9,8%, также был травлен с помощью APM при комнатной температуре. Как показано на рис. 4b, c. в, структуры микродисков успешно сформированы для Ge 0.902 Sn 0,098 сплав после 510 с мокрого травления. Ранее Han et al. [30] сообщили, что они изготовили частично взвешенный Ge 0.928 Sn 0,072 микродиски (размером 5 мкм) с поднутрением около 1,2 мкм с использованием H 2 О 2 на основе мокрого травления с селективностью 7:1. Однако после селективного влажного травления края их диска изгибаются и ломаются из-за сильных капиллярных сил притяжения, возникающих между подвешенной структурой и подложкой по мере удаления травильной жидкости, что приводит к контакту высвобожденной микродисковой структуры с подложкой [ 24]. Но этого явления не наблюдается в наших экспериментах, даже если селективное травление продлится почти до полного удаления нижнего пьедестала из Ge. Это можно объяснить более высокой селективностью травления и более толстым слоем GeSn около 250 нм. Интересно, что на пьедесталах видны неожиданные грани с разной ориентацией, что может быть вызвано зависящей от ориентации скоростью бокового травления во время процесса селективного влажного травления.
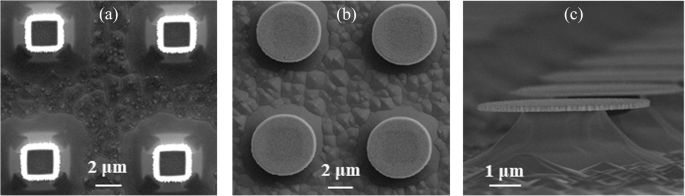
СЭМ-изображения после селективного влажного травления. а Ge диаметром 5 мкм 0,96 Sn 0,04 круглые столы после травления 510 с. б , c Ge диаметром 5 мкм 0,902 Sn 0,098 круглые столовые после травления 510 с
Кроме того, были изготовлены микродиски с пьедесталами из Ge разного диаметра, контролируя время селективного травления. На рис. 5а показан диаметр оставшегося пьедестала из Ge в зависимости от времени травления в APM. Планки погрешностей представляют собой стандартное отклонение данных пяти разных микродисков в одном образце. Подобная тенденция линий указывает на то, что скорость травления Ge примерно равна для Ge 0,902 Sn 0,098 дисков с разным диаметром 3 мкм и 5 мкм, что согласуется со значением скорости травления из [5]. [30]. При этом минимальный диаметр Ge-пьедестала для установки микродиска GeSn составляет около 300 нм. Подвешенные микродиски GeSn будут стянуты сильными притягивающими капиллярными силами, если пьедесталы Ge станут меньше.
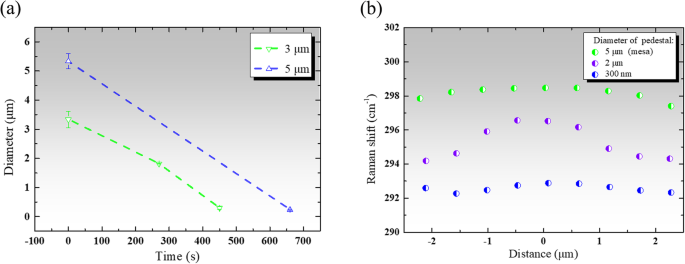
а Диаметр пьедестала Ge как функция времени селективного влажного травления для диаметров Ge 0,902 3 мкм (зеленая пунктирная линия) и 5 мкм (синяя пунктирная линия) Sn 0,098 диски. б Измерения рамановского сдвига с линейным сканированием по диаметру 5 мкм Ge 0.902 Sn 0,098 меза (зеленая точка) и микродиски с Ge-пьедесталом диаметром 2 мкм (фиолетовая точка) и Ge-пьедесталом диаметром 300 нм (синяя точка)
Чтобы исследовать распределение упругой деформации микродисков GeSn, было выполнено μ-Раман при комнатной температуре на дисках диаметром 5 мкм с использованием лазера 633 нм для возбуждения с размером пятна около 600 нм. Мощность лазера составляет всего 1% от максимальной мощности (15 мВт) для минимизации тепловых эффектов [34], а глубина проникновения возбуждающего лазера в пленки GeSn составляет примерно 50 нм [26]. Рамановский сдвиг измерялся путем аппроксимации спектров функциями Лоренца.
На рисунке 5b показано сканирование одномерных рамановских линий для Ge 0.902 . Sn 0,098 микроструктуры. Ясно отмечено (1) для мезы диаметром 5 мкм без подрезки, пик комбинационного рассеяния, связанный с LO-модой Ge-Ge LO, неочевидно смещается в сторону меньших волновых чисел от центра к краю мезы, а большой сдвиг комбинационного рассеяния указывает на то, что в мезе GeSn наблюдается большая деформация сжатия; (2) для микродиска диаметром 5 мкм и пьедестала Ge диаметром 2 мкм пик комбинационного рассеяния, связанный с LO-фононной модой Ge-Ge, явно смещается в сторону меньших волновых чисел от центра к краю диска, обнаруживая градиент деформации из-за закрепления. к сравнительно большому пьедесталу Ge. А микродиск из GeSn 5 мкм с основанием диаметром 2 мкм по-прежнему сохраняет на своей периферии определенную сжимающую деформацию; (3) положения пиков Ge-Ge, измеренные по диаметру 5 мкм Ge 0.902 Sn 0,098 Микродиски с Ge-пьедесталом диаметром 300 нм остаются стабильными и имеют очевидный уменьшенный рамановский сдвиг. Поэтому ожидается, что диски с узкими пьедесталами из Ge (диаметром около 300 нм) будут полностью расслаблены.
На рис. 6 представлен типичный спектр комбинационного рассеяния света Ge 0,902 диаметром 5 мкм. Sn 0,098 микродиск с Ge-пьедесталом диаметром 300 нм. Для дисков спектры комбинационного рассеяния света показывают асимметричный пик на частоте 292,4 см −1 . соответствующий режиму гетеродина Ge-Ge LO. Спектры комбинационного рассеяния, записанные для мезы диаметром 5 мкм и эталонной объемной подложки Ge (001), также нанесены на график для сравнения. Обратите внимание, что после подрезки уберите рамановский сдвиг (- 6,3 см −1 ) пика Ge-Ge можно наблюдать для микродисков с содержанием 9,8% Sn, поскольку на сдвиг частоты комбинационного рассеяния в полупроводниковых сплавах в основном влияют деформация и состав. Предыдущие исследования комбинационного рассеяния света [33, 35,36,37] показали, что рамановский сдвиг LO-фононной моды Ge-Ge в GeSn может быть выражен как функция концентрации Sn x Sn и двухосная деформация в плоскости ε ∥ следуя формуле. (1):

Сравнение рамановских спектров 5 мкм Ge 0.902 Sn 0,098 микродиск с основанием из Ge диаметром 300 нм, 5 мкм Ge 0.902 Sn 0,098 диаметр мезы и объемная подложка Ge в качестве эталона. Врезка:увеличенный вид спектров комбинационного рассеяния света. Пики Ge-Sn также можно наблюдать в районе 260 см −1 , и сдвиг вниз с уменьшением диаметра опор Ge
$$ \ Delta \ omega ={\ omega} _ {\ mathrm {Ge} \ mathrm {Sn}} - {\ omega} _ {\ mathrm {Ge}} =\ mathrm {A} \ cdotp {x} _ { \ mathrm {Sn}} + \ mathrm {B} \ cdotp {\ varepsilon} _ {\ parallel} $$ (1)где ω GeSn и ω Ge - положение пика фононной моды Ge-Ge LO в GeSn и в объемном Ge, соответственно, а A и B - коэффициенты.
Рамановские пики Ge-Ge LO для мезы и дисков показывают сдвиг - 1,4 см −1 и - 7,7 см −1 по сравнению с пиком объемного Ge (300,1 см −1 ). Взяв коэффициенты из предыдущих экспериментальных результатов [37], значение двухосного пятна в плоскости ε ∥ рассчитывается как -1,18% для свежевыращенной мезы GeSn. Для изготовленных микродисков двуосное пятно в плоскости ε ∥ примерно равна 0, что подтверждает практически полную деформационную релаксацию микродисков. Согласно недавнему теоретическому расчету Ge 1- x Sn x электронная зонная структура [38], выращенный Ge 0.902 Sn 0,098 слой является непрямым запрещенным материалом с шириной запрещенной зоны около 0,56 эВ, в то время как полностью релаксированный Ge 0,902 Sn 0,098 Микродиск представляет собой материал с прямой запрещенной зоной с шириной запрещенной зоны 0,50 эВ.
Выводы
В заключение, микродиски из GeSn были успешно изготовлены путем сочетания селективного эпитаксиального роста с процессом селективного влажного травления. HRTEM и SEM были выполнены, чтобы подтвердить, что сплав GeSn является высококристаллическим и что структура микродисков GeSn легко формируется простым селективным влажным травлением. Измерения μ-комбинационного рассеяния показывают, что релаксация деформации микродиска GeSn будет больше с уменьшением диаметра пьедестала из Ge из-за одновременного уменьшения механических ограничений со стороны меньшего пьедестала из Ge. И, наконец, с помощью этого более экономичного метода были получены высококачественные микродиски GeSn с полной релаксацией деформации. Процесс изготовления также является очень многообещающим методом для достижения меньшего размера мезы GeSn до тех пор, пока латеральный квантовый размерный эффект не станет важным, и для получения других наноструктур GeSn, таких как квантовые точки GeSn, наночастицы GeSn и нанопроволоки GeSn для будущих Si-совместимых фотонных и электронных приложения для устройств.
Доступность данных и материалов
Данные, подтверждающие выводы этой работы, доступны у соответствующего автора по обоснованному запросу.
Сокращения
- APM:
-
Смесь перекиси аммиака (влажный травитель)
- БПФ:
-
Быстрое преобразование Фурье
- HRTEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- MBE:
-
Молекулярно-лучевая эпитаксия
- PECVD:
-
Химическое осаждение из паровой фазы с применением плазмы
- RT:
-
Комнатная температура
- SEM:
-
Сканирующая электронная микроскопия
- SIMS:
-
Масс-спектрометрия вторичных ионов
- μ-Раман:
-
Микро-рамановская спектроскопия
Наноматериалы
- Абстрактный класс Java и абстрактные методы
- Оптические и электрические характеристики кремниевых нанопроволок, полученных методом химического травлен…
- Изготовление тонких пленок SrGe2 на подложках Ge (100), (110) и (111)
- Изготовление, характеристика и биологическая активность систем нано-доставки авермектина с различными разм…
- Последние достижения в синтетических методах и применении серебряных наноструктур
- Изготовление и характеристика ZnO Nano-Clips с помощью процесса, опосредованного полиолом
- Производство спиральных нановолокон из CA / TPU и анализ их механизма
- Изготовление и фотокаталитические свойства новых нанокомпозитов SrTiO3 / Bi5O7I
- Понимание механизма роста эпитаксиальных слоев GaN на механически расслоенном графите
- Лазерное травление и лазерная гравировка



