Перераспределение носителей между двумя видами локализованных состояний в квантовых ямах InGaN / GaN, исследованное методом фотолюминесценции
Аннотация
Многоквантовые ямы (МКЯ) InGaN / GaN готовятся в тех же условиях методом химического осаждения из газовой фазы (MOCVD), за исключением толщины покрывающих слоев, дополнительно выращенных на каждом слое ямы InGaN. Интенсивность фотолюминесценции (ФЛ) образца тонкого защитного слоя намного выше, чем у образца более толстого защитного слоя. Интересно, что образец толстого покрывающего слоя имеет два пика фотолюминесценции при высокой мощности возбуждения, а кривые энергия-температура пика ФЛ показывают аномальный переход от обращенной V-образной формы к правильной S-образной с увеличением мощности возбуждения. Между тем, он показывает более низкую термическую стабильность образца толстого покровного слоя при более высокой мощности возбуждения, чем при более низкой мощности возбуждения. Такое нетипичное явление объясняется перераспределением носителей заряда между двумя видами локализованных состояний, которое вызвано неоднородным распределением состава индия в образце толстого покрывающего слоя. Кроме того, люминесценция глубоких локализованных состояний имеет лучшую термическую стабильность, а люминесценция мелких локализованных состояний имеет плохую термическую стабильность. Фактически, такое более сильное неоднородное распределение индия может быть вызвано деградацией последующего эпитаксиального роста области МКЯ InGaN / GaN из-за более длительного времени роста покрывающего слоя из низкотемпературного GaN.
Введение
Структура с множественными квантовыми ямами (МКЯ) InGaN / GaN привлекла большое внимание в связи с ее широким использованием в светодиодах (LED) и лазерных диодах (LD) [1,2,3,4,5,6]. Хотя высокая плотность пронизывающих дислокаций и уменьшение перекрытия волновых функций вызвано спонтанной и пьезоэлектрической поляризацией МКЯ InGaN / GaN, их яркостная эффективность все еще удивительно высока [7,8,9,10]. Одна из основных причин заключается в том, что локализация экситонов в минимумах потенциала из-за флуктуаций содержания индия приводит к образованию состояний типа квантовых точек в квантовых ямах InGaN / GaN [11]. Однако остается неясным, какую роль играют состояния локализации в механизме люминесценции. В нескольких исследованиях сообщалось о влиянии флуктуаций состава InGaN на радиационные и оже-рекомбинации [12,13,14]. Теоретическое моделирование атомистической сильной связи, использованное Джонсом, показало, что локализация увеличивает скорость как излучательной, так и оже-рекомбинации, но скорость оже-рекомбинации увеличивается на порядок выше, чем излучательная [15]. Экспериментально локализация носителей приводит к ослаблению правила k-отбора в процессе оже-рекомбинации и, таким образом, сильно усиливает процесс оже-рекомбинации в полярных квантовых ямах InGaN / GaN при сильном оптическом возбуждении [16]. Хорошо известно, что зависящее от температуры S-образное поведение энергии пика люминесценции является отпечатком локализации носителей заряда. Многие модели, такие как модель ансамбля локализованных состояний (LSE), предлагаются для объяснения локализации носителей и поведения теплового перераспределения, показывая, что изменение энергии пика люминесценции с температурой может зависеть от уникального процесса перераспределения носителей при различных уровнях возбуждения [17, 18,19,20,21]. Как правило, производимые устройства, такие как лазерные диоды, всегда работают с более высокой плотностью инжектируемых носителей [22]. В этом случае спектры фотолюминесценции локализованных состояний могут демонстрировать уникальное поведение на разных уровнях возбуждения, связанное с однородностью локализованных состояний. Поэтому необходимы дальнейшие исследования, чтобы понять влияние колебаний сплава на устройства InGaN.
В данной работе два типичных образца с разной толщиной покрывающих слоев GaN, которые дополнительно выращиваются на каждом слое InGaN, были приготовлены с помощью системы химического осаждения из газовой фазы (MOCVD). Свойства МКЯ подробно охарактеризованы измерениями дифракции рентгеновских лучей с высоким разрешением (HRXRD), температурно-зависимой фотолюминесценции (TDPL) и зависимой от мощности фотолюминесценции (PDPL). Обнаружено, что образец толстого защитного слоя показывает аномальный пик на стороне с более высокой энергией при высокой мощности оптического возбуждения. Это подразумевает сосуществование двух разных типов локализованных состояний. Между тем интенсивность ФЛ спадает быстрее при низких температурах, когда мощность возбуждения увеличивается. Следовательно, мы можем предположить, что фотолюминесценция глубоких локализованных состояний имеет лучшую термическую стабильность, а фотолюминесценция мелких локализованных состояний имеет плохую термическую стабильность.
Методы
Материалы
Исследованы образцы МКЯ InGaN / GaN с различной толщиной покровного слоя, выращенные на сапфировой подложке с c-плоскостью с помощью AIXTRON 3 × 2 в моноблочном реакторе с душевой головкой. Триметилгаллий (TMGa), триметилиндий (TMIn) и аммиак (NH 3 ) были использованы для эпитаксиального роста в качестве прекурсоров источников Ga, In и N соответственно, в которых H 2 и N 2 были газом-носителем роста GaN и InGaN соответственно. МКЯ состоит из двух периодов квантовых ям InGaN / GaN. Во время роста каждого слоя скважины скорость потока TMIn поддерживалась постоянной. Затем был выращен покровный слой GaN при той же температуре, что и слой, то есть 710 ° C. После этого температура была увеличена до 830 ° C и оставалась на несколько секунд, а затем был выращен барьерный слой при 830 ° C. Оба образца A и B выращены в одинаковых условиях, за исключением времени роста покровного слоя GaN, т.е. оно составляет 30 с для образца A и 200 с для образца B. Схематическая диаграмма структуры и параметров роста двух МКЯ InGaN / GaN A и B показаны на рис. 1.
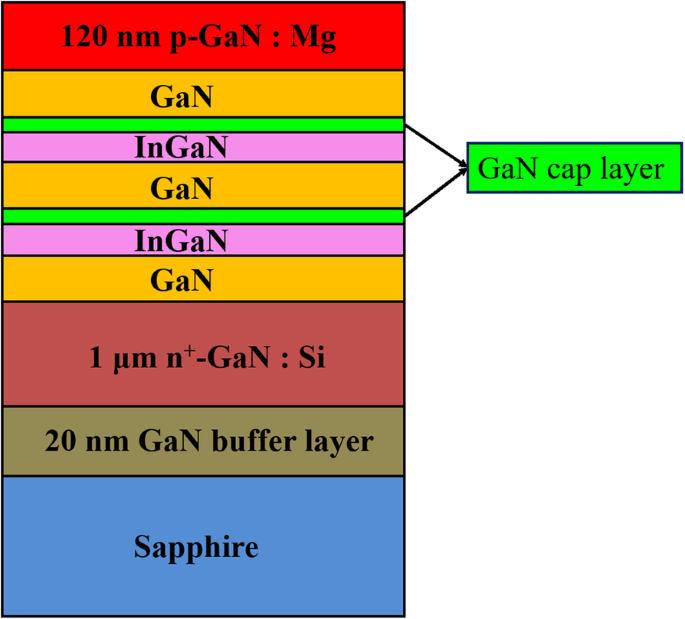
Схематическое изображение поперечного сечения структур эпитаксиального слоя двух МКЯ
Характеристика
Чтобы определить среднее содержание индия, толщину периода и качество материала двух МКЯ InGaN / GaN, измерение дифракции рентгеновских лучей с высоким разрешением (HRXRD) выполняется с помощью Rigaku Ultima IV с излучением Cu-Ka (λ =1,54 Å), которое работает при 40 кВ и 30 мА. Для измерений фотолюминесценции в зависимости от температуры (TDPL) и мощности возбуждения (PDPL) в качестве источника возбуждающего света использовался лазер с длиной волны 405 нм с размером пятна 0,5 мм 2 , мощность возбуждения варьировалась от 0,01 до 50 мВт. Образцы помещали в гелиевый криостат замкнутого цикла, а температуру контролировали от 10 до 300 К.
Результаты и обсуждения
Для исследования структурных свойств двух образцов A и B было выполнено сканирование с симметрией ω-2θ (0002), как показано на рис. 2a. Пик подложки происходит от плоскости GaN (002), а пики-сателлиты - от МКЯ. Сателлитные пики до четвертого порядка отчетливо наблюдаются во всех двух образцах, что свидетельствует о хорошей периодичности слоя. Кроме того, средний состав индия и периодическая толщина могут быть получены путем аппроксимации измеренных кривых, как показано в таблице 1. Можно видеть, что по мере увеличения толщины защитного слоя толщина барьера GaN, а также толщина и состав индия InGaN слои колодца немного увеличиваются. Фактически, поскольку скорость роста защитного слоя составляет всего 0,006 нм / с, а температура роста составляет всего 710 К, изменение толщины барьера относительно невелико. Однако следует отметить, что рост дополнительных покрывающих слоев GaN может влиять не только на толщину барьерного слоя, но также на диффузию, испарение и перераспределение атомов In в слоях ям InGaN, что будет подробно обсуждаться позже. P> 
Сканирование омега-2 тета и картирование обратного пространства обоих образцов выполняются с помощью HRXRD. а Кривые HRXRD Omega-2theta на плоскости GaN (0002) для образцов A и B. b Картирование обратного пространства (RSM) для дифракции GaN (10–15) образца A
Между тем, для изучения деформированного состояния слоев GaN QB и InGaN QW выполняется картирование обратного пространства (RSM) в окрестности плоскости GaN (10–15). Результат образца A показан на рис. 2b (фигура RSM для B аналогична, но не показана здесь). Мы можем наблюдать, что для образца A сателлитные пики МКЯ и пика GaN хорошо совпадают на одной и той же вертикальной линии, что указывает на то, что МКЯ обоих образцов полностью деформированы без какой-либо релаксации [23].
На рис. 3 показаны измерения PDPL для двух образцов при 10 К. Интересно обнаружить, что два образца демонстрируют совершенно разное поведение. Для образца A есть небольшой пик, расположенный на стороне с более низкой энергией (пик A 1 ) доминирующего пика A 2 . Подтверждено, что пик A 1 фононная реплика, удаленная на 92 мэВ от основного пика A 2 . Фононная копия B 2 также присутствует в образце B и называется пиком B 1 . С другой стороны, на рис. 3б можно увидеть, что есть только один доминирующий пик люминесценции B 2 при мощности возбуждения менее 5 мВт. Однако, когда мощность возбуждения превышает 10 мВт, другой пик B 3 аномально появляется при более высокой энергетической стороне B 2 , и пик B 3 постепенно становится доминирующим пиком излучения вместо пика B 2 при дальнейшем увеличении мощности возбуждения. Здесь мы можем предположить, что большинство оптических возбужденных носителей сначала попали в ловушку в электронных состояниях первого типа (например, локализованные состояния, созданные локальными кластерами, богатыми In), а затем излучательно рекомбинируют, создавая пик люминесценции A 2 и B 2 . [24].
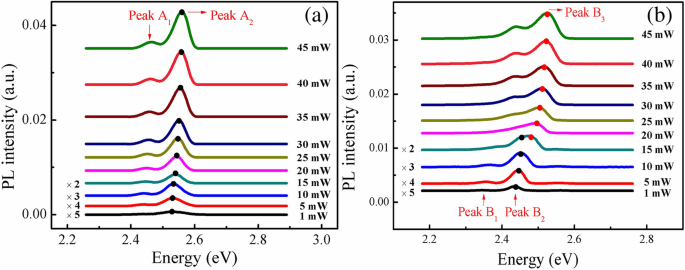
Спектры ФЛ образцов A ( a ) и B ( b ) при различных мощностях возбуждения, измеренных при температурах 10 К
Чтобы изучить поведение аномального пика B 3 Кроме того, для образца B мы выполнили измерения TDPL при различных мощностях возбуждения, показанных на фиг. 4, на которых фиг. 4a и b представляют собой спектры ФЛ, полученные при мощности возбуждения 5 мВт и 40 мВт, соответственно. Обратите внимание, что явление двух пиков в спектрах излучения на рис. 4b было ясно видно при температурах ниже 200 К и становилось размытым к 300 К. Обобщая поведение спектров излучения, можно видеть, что переход от пика излучения с низкой энергией к пику излучения Высокоэнергетический пик излучения возникает в узком диапазоне мощности возбуждения и имеет «переключающий» характер. За пределами узкой переходной области одиночный низкоэнергетический ( B 2 ) или высокой энергии ( B 3 ) пик излучения доминирует при низкой и высокой мощности возбуждения соответственно.
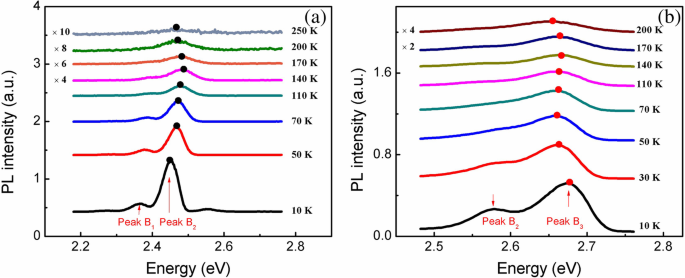
Спектры ФЛ образца B в диапазоне температур 10–300 K, измеренные при мощности возбуждения 5 мВт ( a ) и 40 мВт ( b )
Кроме того, при более внимательном рассмотрении изменения энергии доминирующего пика излучения в зависимости от температуры обоих образцов мы можем найти кое-что уникальное. Как показано на рис. 5a, когда мощность возбуждения увеличивается с 5 до 40 мВт для образца A, изменение пиковой энергии PL с повышением температуры (называемая ниже кривой ET) показывает кривые «перевернутой V-образной формы», которые отличаются от обычных S-образная форма. Перевернутая V-образная форма почти не меняется с увеличением мощности возбуждения, за исключением общего синего сдвига пиковой энергии. Обращенная V-образная температурная зависимость объясняется совместным действием эффекта заполнения носителями на центрах люминесценции и эффекта сжатия запрещенной зоны, сопровождаемого повышением температуры [25, 26]. С другой стороны, как показано на рис. 5b, кривые E-T для образца B при мощности возбуждения ниже 5 мВт показывают обратную V-образную форму. Эта ситуация аналогична образцу A. Однако, когда мощность возбуждения постепенно увеличивается до 40 мВт, первое красное смещение появляется в более низком диапазоне температур, и кривые E-T имеют правильную S-образную форму. По-видимому, это явление противоречит ожиданиям, что при достаточно большой мощности возбуждения эффект локализации полностью исчезнет, а температурное поведение пиковой энергии будет точно соответствовать закону Варшни [27].

Энергия пика излучения ФЛ как функция температуры для образцов A ( a ) и B ( b ) при разных мощностях возбуждения. Сплошные линии - теоретические кривые подгонки с использованием модели LSE. Точки - данные эксперимента
Таким образом, для количественного объяснения наблюдаемой аномальной зависимости возбужденной оптической мощности люминесценции локализованных состояний была использована модель люминесценции LSE для аппроксимации E-T кривых, предложенная Q. Li et al. Эта модель может использоваться во всех температурных диапазонах, и она может соответствовать не только S-образным кривым E-T, но также V-образной или перевернутой V-образной форме. Кроме того, было также доказано, что модель LSE может быть сведена к модели «полосового хвоста» Елисеева и др. При высоких температурах [24, 25]. В этой модели пиковая энергия как функция температуры может быть описана как [18,19,20,21]:
$$ E (T) =\ left ({E} _0- \ frac {\ alpha {T} ^ 2} {\ theta + T} \ right) - {xk} _BT $$ (1)где θ - температура Дебая конкретного материала и a - параметр Варшни, k B - постоянная Больцмана, а x можно численно решить с помощью следующего трансцендентного уравнения [18,19,20,21]:
$$ {xe} ^ x =\ left [{\ left (\ frac {\ sigma} {k_BT} \ right)} ^ 2-x \ right] \ left (\ frac {\ tau_r} {\ tau_ {tr} } \ right) {e} ^ {\ left ({E} _0- {E} _a / {k} _BT \ right)} $$ (2)где σ - стандартное отклонение распределения локализованных состояний. Другими словами, это означает ширину распределения плотности состояний гауссова типа. τ r и τ tr представляют собой излучательную рекомбинацию и время ускользания локализованного носителя, и, следовательно, τ r / τ tr подразумевает долю носителей, которая рекомбинирует безызлучательно. E 0 - центральная энергия локализованных центров, а E а дает «маркировочный» уровень, ниже которого все локализованные состояния заняты носителями при 0 К, что аналогично квазиуровню Ферми в распределении Ферми-Дирака. Очевидно, что E 0 и E а вместе связаны с происхождением локализованных центров люминесценции [17].
Полученные параметры подгонки обоих образцов показаны в таблице 2. Для образца A центральная энергия E 0 и E а изменяется на 19 мэВ и 18 мэВ с 5 до 40 мВт соответственно. Замечено, что E 0 - E а и σ практически без изменений. Это потому, что по мере увеличения возбужденной мощности будет возбуждено все больше и больше носителей. Во-первых, сильное пьезоэлектрическое поле ям InGaN будет экранировано фотогенерированными носителями, что приведет к увеличению центральной энергии E 0 . Во-вторых, все больше и больше носителей будут занимать более высокие электронные состояния в соответствии с эффектом заполнения, что приведет к увеличению квазиуровня Ферми локализованных носителей E а . Следовательно, E 0 - E а представляет собой совместное действие эффекта поляризационного экранирования и эффекта заполнения носителями, и, таким образом, наблюдается общий сдвиг в голубой цвет в положении пика для образца A. В отличие от образца A, для образца B от 5 до 40 мВт наблюдается большее увеличение E 0 и E а , 73 мэВ и 57 мэВ соответственно. E 0 - E а увеличиваются на 16 мэВ, τ r / τ tr изменяется на несколько порядков, а σ немного уменьшается. Такие изменения настолько велики, что приходится предполагать, что происхождение центров люминесценции различно при разных мощностях возбуждения 5 мВт и 40 мВт.
Поэтому предполагается, что для образца B существует два типа состояний локализации, которые распределяются на двух разных энергетических глубинах в слоях ямы из-за неоднородного распределения состава индия, т. Е. С более высоким составом индия (состояния глубокой локализации) и более низким состав индия (состояния мелкой локализации). Кроме того, чтобы объяснить описанное выше явление в образце B, схематические диаграммы, показывающие возможный механизм перераспределения носителей между двумя типами локализованных состояний, показаны на рис. 6. При 10 К, при более низкой мощности возбуждения, такой как 5 мВт, показано на рис. 6а большая часть возбужденных оптических носителей сначала захватывается электронными состояниями первого типа (глубокими локализованными состояниями), и, таким образом, преобладает пик с более низкой энергией, тогда как при 40 мВт, показанном на рис. 6б, все больше и больше фотогенерируется. носители будут занимать более высокий энергетический уровень, а затем мелкие локализованные состояния с более высокой плотностью энергетических состояний также будут заполнены, и, таким образом, более высокий пик энергии будет постепенно доминировать с увеличением возбуждаемой мощности. Следовательно, E 0 и E а сильно увеличиваются, и τ r / τ tr возрастают на несколько порядков, что означает возможность выхода носителей из локализованных состояний. При повышении температуры до 30 К при 5 мВт, как показано на рис. 6c, фотогенерированные носители с определенным количеством тепловой энергии в основном используются для заполнения более глубоких локализованных состояний, что приводит к первому синему сдвигу E-T кривых; однако на рис. 6d, когда речь идет о 40 мВт, исходя из предположения, что мелкие локализованные состояния обладают большей емкостью, чем глубокие локализованные состояния, большинство фотогенерированных носителей остается в мелких локализованных состояниях, и они смогут передавать в глубокие локализованные состояния, которые обладают сильной способностью связывать носители. Следовательно, кривые E-T имеют красное смещение. Другими словами, появление аномальных изменений кривых ET связано с множеством видов состояний локализации из-за неоднородного распределения индия в слоях ям InGaN образца B. И такие колебания состава, как предполагается, в основном связаны со случайными флуктуациями сплава на поверхности. атомный масштаб [28].

Принципиальные схемы, показывающие возможный механизм аномального изменения зависимости энергии пика ФЛ от температуры при различных мощностях возбуждения. Распределение несущих при более низкой T (10 K) показано на ( a ) и ( b ) для P =5 мВт и 40 мВт соответственно. Распределение несущих при более высоком T (30 K) показано в ( c ) и ( d ) для P =5 и 40 мВт соответственно
Кроме того, появление пика излучения высокой энергии при высокой мощности возбуждения образца B также приводит к аномальному изменению интегральной интенсивности ФЛ. На рис. 7 представлены кривые зависимости интегральной интенсивности от температуры для образцов A и B, измеренные при мощности возбуждения 5 мВт и 20 мВт соответственно. Во-первых, обратите внимание, что термическое тушение образца B, очевидно, происходит быстрее, чем у образца A. Как правило, в тепловом тушении люминесценции МКЯ InGaN преобладают процессы безызлучательной рекомбинации, которые можно описать уравнением Аррениуса. Следовательно, быстрая термическая закалка подразумевает плохую термическую стабильность образца B. Кроме того, при достаточно высокой мощности возбуждения влияние центров безызлучательной рекомбинации при относительно низких температурах не будет столь значительным, поскольку центры безызлучательной рекомбинации легко насыщаются. избыточными носителями [27]. Это может прекрасно объяснить более медленное изменение интегральной интенсивности ФЛ в зависимости от кривых 1 / T с увеличением мощности возбуждения образца A. Однако для образца B весьма интересно то, что нормализованная интегральная интенсивность при мощности возбуждения 5 мВт даже выше. чем ниже 20 мВт, когда температура ниже 125 K, и наоборот, при температурах выше 125 K. Как упоминалось ранее, предполагается, что только один пик излучения с более низкой энергией, который возникает из глубоких локализованных состояний, является доминирующим. при 5 мВт, в то время как другой, более высокий, возникший из мелких локализованных состояний, становится доминирующим при 20 мВт. Таким образом, можно сделать вывод, что глубокие локализованные центры люминесценции обладают большей эффективностью люминесценции, чем мелкие центры люминесценции. Это хорошо согласуется с предыдущим результатом исследования локализованных состояний [28]. Таким образом, можно до некоторой степени доказать, что существует два типа локализованных состояний, возбуждаемых при 20 мВт для образца B.
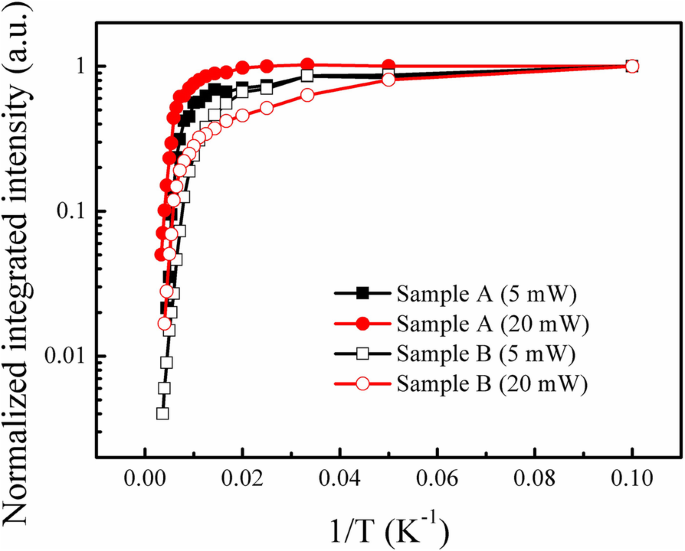
Интегральная интенсивность, извлеченная из спектров ФЛ обоих образцов в диапазоне температур 10–300 К, измеренная при мощности возбуждения 5 мВт и 20 мВт
На основе всех этих анализов мы демонстрируем, что пик B 3 происходит из состояний локализации с более низким потенциалом, связанных с неоднородным распределением состава индия в образце B. Это хорошо согласуется с экспериментальными результатами пика более высокой энергии излучения B 3 и снижение IQE образца B при низких температурах при более высокой мощности возбуждения. Фактически, в процессе роста квантовых ям, учитывая эффекты затягивания, атомы индия склонны накапливаться в верхней части слоя квантовой ямы InGaN и образовывать дополнительный слой, известный как плавающий слой индия [29]. Рост более толстого покрывающего слоя GaN при низкой температуре губительно для испарения этих плавающих атомов индия. Следовательно, атомы In могут встраиваться в покровный и барьерный слой GaN после роста квантовой ямы [30]. Естественно, такое поведение приведет к увеличению толщины слоя скважины, и, таким образом, QCSE улучшится. Более высокая деформация и более сильное пьезоэлектрическое поле в активной квантовой яме вызовут более локализованную релаксацию и, следовательно, более глубокие локализованные потенциалы и более высокие барьеры. Между тем, в последующий рост барьерного слоя GaN вводится больше дислокаций и дефектов. Как правило, вблизи дислокаций возникает большое растягивающее напряжение, и атомы индия могут иметь тенденцию накапливаться возле дислокаций и неравномерно распределяться. [31, 32] Следовательно, при росте слоя ямы InGaN появляется больше областей, богатых и бедных индием, что связано с увеличением плотности дислокаций. Это означает, что масштаб флуктуаций индия будет увеличиваться с увеличением толщины покровного слоя. В наших экспериментах это показывает, что в образец B с более толстым верхним слоем вводятся два различных типа состояний локализации, и пик ФЛ с более высокой энергией излучения активируется при более высокой мощности возбуждения. С другой стороны, фотогенерированные носители, оставшиеся в глубоких локализованных состояниях, могут экранировать дефекты и, таким образом, иметь лучшую термическую стабильность, в то время как фотогенерированные носители, оставшиеся в мелких локализованных состояниях, будут захвачены связанной с дефектами безызлучательной рекомбинацией, как только они смогут преодолеть относительно меньшая высота барьера.
Выводы
Таким образом, образцы с множественными квантовыми ямами (MQW) InGaN / GaN с различной толщиной покрывающих слоев GaN, дополнительно выращенных на слоях ям InGaN, получают с помощью системы химического осаждения из газовой фазы (MOCVD). Их структурные и оптические свойства исследуются и анализируются с помощью измерений HRXRD, TDPL и PDPL. Результаты PDPL показывают, что дополнительный пик с высокой энергией излучения возбуждается при более высокой мощности возбуждения только для образца B, который выращен с толстыми верхними слоями. Между тем, результаты TDPL, измеренные при различных мощностях возбуждения для образца B, показывают, что E-T-кривые доминирующего пика PL меняются с обращенной V-образной формы на правильную S-форму при увеличении мощности возбуждения. Кроме того, была обнаружена более низкая термическая стабильность образца B при высокой мощности возбуждения. Эти аномальные явления означают, что существует два типа локализованных состояний образца B, которые вызваны относительно неоднородным распределением индия. Эти выводы дают нам дальнейшее понимание механизма фотолюминесценции зеленых квантовых ям InGaN / GaN и эффекта неоднородности при высоком уровне возбуждения, что может помочь нам в производстве лазерных диодов InGaN / GaN.
Сокращения
- HRXRD:
-
Дифракция рентгеновских лучей высокого разрешения
- LD:
-
Лазерные диоды
- светодиоды:
-
Светодиоды
- LSE:
-
Локализованный государственный ансамбль
- MOCVD:
-
Система химического осаждения металлоорганических соединений из паровой фазы
- MQW:
-
Мультиквантовые ямы
- NH 3 :
-
Аммиак
- PDPL:
-
Энергозависимая фотолюминесценция
- RSM:
-
Отображение взаимного пространства
- TDPL:
-
Фотолюминесценция в зависимости от температуры
- TMGa:
-
Триметилгаллий
- TMIn:
-
Триметилиндий
Наноматериалы
- Атомная перестройка множественных квантовых ям на основе GaN в смешанном газе H2 / NH3 для улучшения структурных …
- Дизайн эмиссионного слоя для электронных умножителей
- Многоцветное излучение ультрафиолетовой фотонной квазикристаллической нанопирамиды на основе GaN с полуполя…
- Обнаружение пространственно локализованного экситона в самоорганизованных сверхрешетках из квантовых точе…
- Квантовые точки висмута в отожженных квантовых ямах GaAsBi / AlAs
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Оптимальные слои легирования кремнием квантовых барьеров в последовательности роста, формирующие потенциал…
- Исследование солнечного элемента из кристаллического кремния с черным слоем кремния на задней панели
- Межзонная фотопроводимость метаморфных квантовых точек InAs / InGaAs в окне 1,3–1,55 мкм



