Сравнительный анализ дефектов в слоях GaN с имплантированным Mg и легированным Mg на отдельно стоящих подложках GaN
Аннотация
Неэффективное легирование р-типа, индуцированное магнием, остается основным препятствием при разработке электронных устройств на основе GaN для твердотельных осветительных приборов и источников питания. В данной работе представлен сравнительный структурный анализ дефектов в слоях GaN на отдельно стоящих подложках GaN, где введение Mg осуществляется двумя способами:ионной имплантацией и эпитаксиальным легированием. Сканирующая просвечивающая электронная микроскопия выявила наличие пирамидальных и линейных дефектов только в образце, имплантированном Mg, тогда как образец, легированный Mg, не показал наличия этих дефектов, что предполагает, что природа дефектов зависит от метода внедрения. По данным масс-спектрометрии вторичных ионов, наблюдается прямое соответствие между концентрацией Mg и расположением и типом этих дефектов. Наши исследования показывают, что эти пирамидальные и линейные дефекты представляют собой частицы, богатые Mg, и их образование может привести к снижению плотности свободных дырок, что по-прежнему является серьезной проблемой для материалов и устройств на основе p-GaN. Поскольку отдельно стоящие подложки из GaN предлагают платформу для реализации вертикальных устройств на основе pn-переходов, сравнительное структурное исследование дефектов, возникающих из-за различных процессов включения Mg в слои GaN на таких подложках, вероятно, даст больше информации для понимания механизмов самокомпенсации Mg, а затем оптимизация процесса легирования магнием и / или имплантации для развития технологии устройств на основе GaN.
Введение
За последние три десятилетия GaN стал одним из наиболее изученных полупроводниковых соединений во всем мире. В основном это связано с его огромным потенциалом не только в области твердотельного освещения, но и в работе с мощными, высокочастотными и высокотемпературными устройствами [1,2,3,4,5,6,7,8]. Для успешного использования устройств на основе GaN и родственных гетероструктур в таких приложениях и операциях ключевым требованием является контролируемое легирование n-типа и p-типа. В этом аспекте обеспечение и контроль легирования n-типа в эпитаксиальных слоях или монокристаллах GaN в настоящее время в значительной степени оптимизированы по сравнению с его аналогом p-типа, который по-прежнему является узким местом как для академических кругов, так и для промышленности. К настоящему времени Mg оказался наиболее эффективной легирующей добавкой p-типа, несмотря на его высокую энергию активации, которая требует больших концентраций Mg (около 10 19 см −3 или более) для достижения разумных концентраций свободных дырок, близких к 10 18 см −3 . Любое увеличение атомных концентраций Mg сверх 10 19 см −3 приводят к уменьшению концентрации свободных дырок [9,10,11]. Это явление в основном объясняется созданием N вакансий [12,13,14], точечных дефектов, связанных с Mg [10, 15], или заряженных и / или нейтральных комплексов, связанных с вакансиями Mg, которые понижают уровень Ферми и насыщают свободные дырки. концентрации [16, 17]. На основании измерений фотолюминесценции, дающих пик при 2,9 эВ, комплекс глубоких донорных дефектов Mg-V N также считается одной из основных причин механизма самокомпенсации. [17,18,19]. Следовательно, несмотря на ряд значительных исследовательских попыток понять включение Mg в GaN, эта проблема все еще остается неясной, и необходимо провести дальнейший анализ.
Большинство более ранних отчетов об анализе дефектов с использованием микроскопических исследований в атомном масштабе основано на слоях GaN, легированных магнием, выращенных на сапфире с использованием химического осаждения из газовой фазы (MOCVD) или молекулярно-лучевой эпитаксии (MBE). Насколько нам известно, имеется лишь несколько отчетов об анализе дефектов в отдельно стоящих подложках GaN, легированных магнием, и нет отчета об анализе дефектов на основе просвечивающей электронной микроскопии в отдельно стоящих подложках GaN, в которые Mg вводится посредством ионной имплантации. В настоящее время хорошо известно, что отдельно стоящие подложки из GaN имеют ряд преимуществ перед слоями GaN, выращенными методом MOCVD / MBE на чужих подложках, благодаря пониженному уровню плотности дислокаций и их применению в эффективных вертикальных устройствах. Достижение достаточной активности легирующих добавок p-типа в таких подложках посредством ионной имплантации необходимо изучить для коммерциализации и разработки твердотельных осветительных приборов и устройств большой мощности на основе GaN. Сохраняя все эти вопросы в качестве первоочередной задачи, мы провели подробный структурный анализ дефектов, содержащих Mg, в отдельно стоящих слоях GaN, где включение Mg достигается легированием, а также ионной имплантацией.
Экспериментальные методы
В нашем исследовании используются отдельно стоящие подложки n-GaN, выращенные методом гидридной парофазной эпитаксии. После этого на этих подложках методом MOCVD выращиваются эпитаксиальные слои. Включение Mg осуществляется двумя способами:ионной имплантацией и эпитаксиальным легированием. В первом случае Mg имплантируется в нелегированный эпитаксиальный слой GaN толщиной 4 мкм без нанесения какого-либо защитного слоя на нелегированные слои GaN, тогда как во втором случае GaN, легированный Mg толщиной 1 мкм, эпитаксиально выращивается на 4 мкм. -толстые нелегированные слои GaN непрерывно. Для достоверного сравнения уровень включения Mg остается таким же, как 4 × 10 19 . см −3 в обоих случаях. Имплантация Mg проводится при 500 ° C с последующим отжигом при 1350 ° C для активации допантов. Энергии имплантации приняты равными 15, 30, 55, 95 и 180 кэВ с соответствующими дозировками 3,0 × 10 13 . , 5,5 × 10 15 , 1,1 × 10 14 , 1,9 × 10 14 , и 8 × 10 14 см −2 , чтобы получить коробчатый профиль глубиной 200 нм. Измерения Холла проводятся для оценки электрических свойств образцов GaN, легированных и имплантированных магнием. Для образца GaN, легированного магнием, концентрация и подвижность дырок составили 3,4 × 10 17 . см −3 и 9,5 см 2 /Против. С другой стороны, электрические свойства имплантированного Mg образца не могли быть оценены должным образом из-за его очень резистивной природы. Распределение Mg в зависимости от глубины исследуется с помощью масс-спектрометрии вторичных ионов (SIMS), в то время как анализ с помощью сканирующей просвечивающей электронной микроскопии (STEM) используется для структурных исследований дефектов, вызванных Mg. Для этого на JEOL JEM-ARM200F, работающем при 200 и 80 кВ, были выполнены STEM и электронная энергодисперсионная рентгеновская спектроскопия. Для этих исследований образцы ПЭМ были приготовлены путем измельчения сфокусированным ионным пучком с использованием пучков Ga с последующим измельчением низкоэнергетическими ионами Ar с охлаждением жидким азотом.
Результаты и обсуждение
Анализ дефектов в слое GaN с имплантированным Mg
На рисунке 1 (а) показано изображение в светлом поле (BF) -STEM имплантированного Mg GaN, тогда как (b) показан соответствующий профиль SIMS. Стрелка, показанная на рис. 1 (a), представляет положительное направление [0001], и изображения просматриваются вдоль оси зоны [11 \ (\ overline {2} \) 0]. Видно, что дефекты распределены неравномерно в зависимости от глубины, фактически наблюдается прямая корреляция между концентрациями Mg и дефектами. Большинство дефектов накапливаются на расстоянии около 150 нм от поверхности, где концентрация Mg превышает 10 19 . см −3 как видно из измерений SIMS. Для лучшего понимания дефектов и их визуализации из-за имплантации Mg в GaN, визуализация выполняется вне зоны оси путем наклона образца на 10 ° вокруг оси c от оси [11 \ (\ overline {2} \) 0]. . Это условие ослабляет дифракционный контраст из-за идеального кристалла и увеличивает контраст дефектов, что позволяет лучше визуализировать дефекты по сравнению с окружающей средой. BF-STEM-изображение образца GaN, имплантированного Mg, полученное в условиях вне зоны оси, показано на рис. 1 (c), где видны некоторые линейные дефекты на глубине около 200 нм от поверхности. Соответствующий профиль Mg SIMS представлен на (d) в линейном масштабе, где наблюдается прямое соответствие между существованием этих линейных дефектов и концентрацией Mg. Было обнаружено, что эти дефекты расположены в узкой области, где концентрация Mg составляет около 10 19 см −3 диапазон.
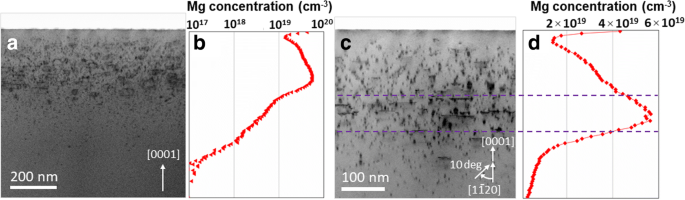
а Изображение поперечного сечения образца GaN, имплантированного Mg, в светлом поле, полученное вдоль оси [11 \ (\ overline {2} \) 0] и b . соответствующий глубинный профиль Mg, полученный с помощью SIMS. Для лучшей визуализации дефектов и их связи с концентрацией Mg визуализация выполняется в условиях вне зоны оси, как показано на c . Профиль Mg, соответствующий c показано в d в линейном масштабе, где линейные дефекты наблюдаются в узкой области с наибольшей концентрацией Mg
Кроме того, визуализация BF-STEM с большим увеличением выполняется в условиях вне зоны оси, как показано на рис. 2 (a), где (b) показывает выбранную область (a) при большем увеличении. Как показано на (b), наблюдаются четыре типа структур, обозначенных как A, B, C и D. Дефекты, помеченные как «A», имеют пирамидальную форму, тогда как «B» проявляются как линейные дефекты.

а Изображение поперечного сечения образца GaN, имплантированного Mg, в светлом поле, полученное в состоянии вне зоны для усиления контрастов дефектов. Увеличенный вид отмеченной области в ( a ) представлена в ( b ), где наблюдаются четыре различных типа дефектов, обозначенных как A, B, C и D. ПЭМ-изображение с высоким разрешением пирамидальных доменов, обозначенных буквой A на ( b ) показан в ( c ) со схематическим изображением внизу справа. Искаженная решетка на пирамидальной области представлена сжатием ( c ), как показано в ( d ). ПЭМ-изображение с высоким разрешением одного типичного дефекта типа C или D представлено в ( e ) со сжатым изображением в ( f ), показывая контраст поля деформации вокруг дефекта
Структурные наблюдения этих дефектов важны с точки зрения понимания механизмов компенсации Mg, и следующие разделы рукописи в основном посвящены структурному анализу дефектов типа «A» и «B». Структуры, обозначенные буквой «A», представляют собой пирамидальные дефекты с положительным направлением [0001], направленным к их головке, их основание на плоскости [0001] с шестью стенками на плоскостях [11 \ (\ overline {2} \) 3], наклоненных, как показано ПЭМ-изображение с высоким разрешением одного из таких дефектов на рис. 2 (с). Схематическое изображение такого пирамидального домена также показано на рис. 2 (c). Рисунок 2 (c) сжат перпендикулярно направлению [0001], как показано на (d), где решетка кажется искаженной в пирамидальной области по сравнению с окружающей матрицей GaN, что указывает на смещение между подрешетками Ga и N внутри и снаружи этих пирамидальных доменов. . Это согласуется с выводами Vennegues et al. [20], где наблюдаются пирамидальные домены аналогичного типа. Подобные дефекты пирамидальной формы ранее наблюдались в пленках GaN, легированных Mg, и их существование обычно объясняют модификацией атомной структуры GaN из-за введения Mg [19,20,21,22,23,24]. Liliental-Weber et al. [25, 26] предположили, что такие пирамидальные дефекты происходят из богатых Mg кластеров, присутствующих вблизи вершины этих пирамид. Структура GaN в фазе вюрцита обычно описывается гексагональной упаковкой N-плоскостей с половиной узлов тетраэдров N-подрешетки, заполненными атомами Ga. Vennegues et al. [27] на основе своих исследований предположили, что введение более высокого уровня Mg в GaN приводит к замещению Ga на Mg с образованием Mg 3 N 2 , соединение Mg-N, как сообщается, имеет структуру антибиксбиита. Структура Antibixbyte Mg 3 N 2 соответствует заполнению N узлов тетраэдров подрешетки Mg, занимающим три из каждых четырех узлов. Согласно модели, предложенной Vennegues et al. [27] пирамидальный домен можно рассматривать как два кристалла GaN противоположной полярности, разделенных монослоем Mg 3 N 2 . Это дополнительно подтверждается исследованиями Hansen et al. [28], где эти пирамидальные домены были предложены как Mg 3 N 2 включения. Vennegues et al. [27] и Leroux et al. [23] также сообщили, что образование таких пирамидальных доменов, имеющих нанометровый размер, также требует включения Mg от низкого до среднего 10 19 см −3 диапазон. Это согласуется с нашими выводами, согласно которым дефекты пирамидальной формы наблюдаются на уровне ниже 10 19 см −3 Концентрации Mg, как видно из корреляции между изображением STEM (рис. 1 (c)) и соответствующим профилем SIMS (рис. 1 (d)). Следовательно, дефекты пирамидальной формы, обозначенные как структуры «A» на рис. 2 (b) нашего исследования, считаются богатыми Mg пирамидными доменами, и их образование может быть напрямую связано с механизмом компенсации Mg в слоях p-GaN. Другие типы дефектов, показанные на рис. 2 (b), представляют собой дефекты типа «C» и «D», которые по существу представляют собой аналогичные структуры с различными размерами. Контраст, который кажется удлиненным в направлении [0001], если смотреть с оси [11 \ (\ overline {2} \) 0], вероятно, возник из-за деформации. Для дальнейшего пояснения этого ПЭМ-изображение с высоким разрешением одного такого подобного дефекта представлено на рис. 2 (e), где (f) показано то же изображение, сжатое перпендикулярно направлению [0001]. Искаженная решетка вдоль направления [0001] предполагает различную постоянную решетки из-за разного поля деформации вдоль этого направления. Поскольку размер Mg меньше по сравнению с Ga, ожидается, что его включение в узлы Ga вызовет деформацию в решетке, которая может привести к такому контрасту вокруг этих дефектов.
Другой тип дефектов, обозначенных буквой «B» на рис. 2 (b), кажется линейными дефектами, перпендикулярными направлению [0001], если смотреть с оси [11 \ (\ overline {2} \) 0]. Важно отметить, что дефекты такого типа, по-видимому, накапливаются в узкой области с более высокими концентрациями Mg (как видно из соответствия между изображением BF-STEM и профилем Mg SIMS, показанным на рис. 1 (c) и (d)), которые предполагает, что их образование связано с чрезмерным включением Mg. Другое наблюдение - наличие пирамидальных доменов на краях этих линейных дефектов, которые указывают на то, что накопление этих доменов может привести к их образованию. Однако не следует исключать, что это могло быть просто случайное перекрытие пирамидальных и линейчатых дефектов, и в этом направлении необходимы дальнейшие исследования. Изображение BF-STEM, показывающее эти типы дефектов, представлено на рис. 3 (а). Для лучшего понимания этих дефектов образец наклоняют примерно на 10 ° вокруг оси, перпендикулярной направлению [0001], и полученное изображение BF-STEM показано на рис. 3 (b). Этот наклон образца сильно возбуждает дифракционные пятна в направлении 1–100, что приводит к усилению контраста от поля деформации в направлении, окружающем дефект. Судя по контрасту поля деформации, дефект, который выглядел как линия (см. Рис. 2 (a) и (b)), на самом деле состоит из пары линий, разделенных несколькими нм, глубже в направлении [0001].

а Поперечное сечение светлого поля STEM-изображение объемного образца GaN, имплантированного Mg, для анализа дефектов типа B, которые выглядят как усеченные пирамиды или трапециевидные формы. б представляет изображение, полученное путем наклона образца на 10 ° вокруг оси, перпендикулярной c - ось, на которой наблюдается различный контраст по краям этих дефектов
Возможно присутствие Mg в этих дефектах, поскольку они появляются в более узкой области, где концентрация Mg превышает 10 19 . см −3 как видно из соответствия между STEM-изображением (рис. 1 (c)) и профилем Mg SIMS (рис. 1 (d)). Чтобы подтвердить это мнение о том, что эти типы дефектов содержат Mg, мы провели измерения с помощью сканирующей просвечивающей электронной микроскопии и энергодисперсионной спектроскопии (STEM-EDS) с диаметром зонда EDS менее 0,2 нм в двух разных областях:«вдали от дефекта» и «В дефекте» обозначены точками 1 и 2 соответственно, как показано на рис. 4 (а). Сравнительные спектры EDS из точек 1 и 2 в диапазоне энергий от 1,19 кэВ до 1,35 кэВ, где ожидается пик Mg, показаны на рис. 4 (b) со вставкой, показывающей полные спектры EDS. Присутствие Mg отчетливо видно на дефекте (точка 2). Чтобы еще раз обосновать это, мы выполнили картирование STEM-EDS на аналогичном образце GaN, имплантированном Mg. Рисунок 4 (c) представляет STEM-изображение образца GaN, имплантированного Mg, со стрелками, направленными вниз, показывающими эти линейные дефекты, а соответствующая EDS-карта Mg показана на рисунке 4 (d). В этих дефектах хорошо видно присутствие Mg. Следовательно, эти дефекты содержат Mg и их образование при концентрациях Mg выше 10 19 см −3 вероятно, это еще одна причина компенсации магния.

а Изображение поперечного сечения образца GaN с имплантированным Mg методом STEM, показывающее отдельный дефект типа «B». Точки 1 и 2 представляют области, где выполняются измерения EDS, и результирующие спектры EDS показаны на b . . Спектры ЭДС в диапазоне энергий 1,19–1,40 кэВ приведены на б . на вставке показаны полные спектры EDS с пиками Ga и N. c и d представить изображение STEM и соответствующую карту Mg аналогичного имплантированного Mg объемного образца, показывающую присутствие Mg в этих типах дефектов
Анализ дефектов в слое GaN, легированного магнием
Затем мы провели структурные исследования на образце GaN, в котором слой GaN, легированный магнием, толщиной 1 мкм эпитаксиально выращен на нелегированном эпитаксиальном слое GaN толщиной 4 мкм. Стоит еще раз упомянуть, что уровень Mg остается неизменным, то есть 4 × 10 19 см −3 для содержательного сравнения двух подходов к введению Mg:эпитаксиально легированного и ионной имплантации. На рисунке 5 (a) показано BF-STEM изображение GaN, легированного магнием, эпитаксиально выращенного на отдельно стоящих подложках GaN, при просмотре вдоль [11 \ (\ overline {2} \) 0], тогда как (b) показывает профиль Mg как функцию глубины GaN. получено с помощью SIMS. Обратите внимание, что концентрация Mg остается почти постоянной и составляет около 4 × 10 19 . см −3 в поле зрения на рис. 5 (а) (до 700 нм), в отличие от более раннего случая имплантированного магнием GaN, где концентрация Mg оказалась функцией глубины GaN (см. рис. 1 (а) - (г)). )).
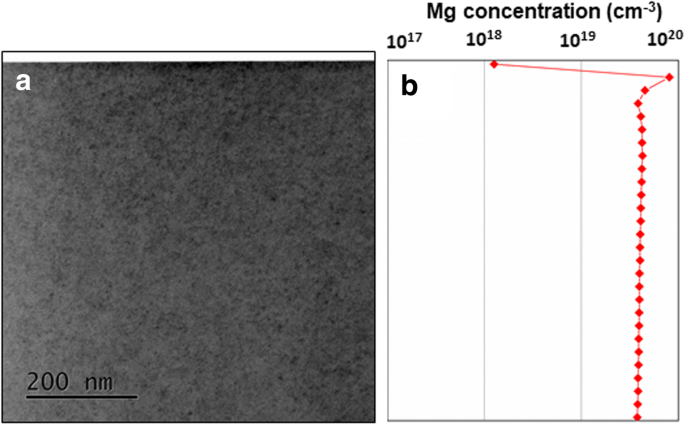
а Поперечное сечение светлого поля STEM-изображение объемного образца GaN, легированного магнием, полученное вдоль оси [112 ̅0] и b соответствующий глубинный профиль Mg, полученный с помощью SIMS. Обнаружено, что точечные дефекты равномерно распределены по образцу
Для проведения анализа дефектов в образце GaN, легированного магнием, получение изображений методом STEM в внезонной оси путем наклона образца на 10 ° вокруг c -ось от оси [11 \ (\ overline {2} \) 0] осуществляется. На рисунках 6 (a) и (b) представлены изображения BF-STEM и DF-STEM, на которых наблюдаются точечные дефекты размером около 5 нм, равномерно распределенные по образцу. Обратите внимание, что профиль Mg в этом случае также кажется однородным, как это видно из профиля SIMS (см. Рис. 5 (b)). Равномерное распределение Mg и этих дефектов в образце GaN предполагает прямую корреляцию между этими дефектами и внедрением Mg. Эти точечные дефекты размером около 5 нм, вероятно, являются выделениями Mg (и, возможно, вызванными им дефектами упаковки). Из-за их небольшого размера осаждение Mg само по себе не может быть напрямую подтверждено измерениями EDS (пики Ga и Mg расположены довольно близко друг к другу, что чрезвычайно затрудняет картирование небольшой разницы концентраций).
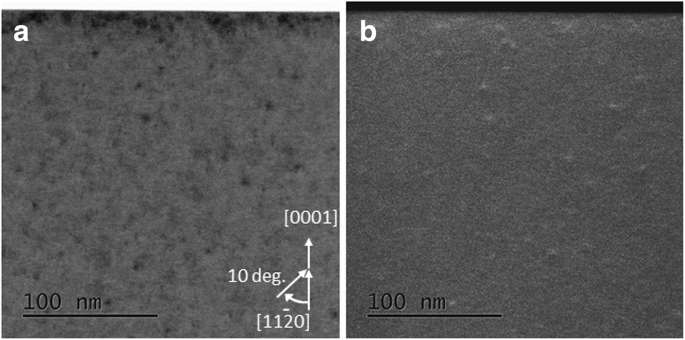
Поперечное сечение а STEM-BF и b STEM-ADF-изображения объемного образца GaN, легированного магнием, полученные в условиях вне зоны действия оси для усиления контрастов дефектов
Это наблюдение полностью отличается от более раннего случая имплантированного Mg образца, где обнаружено, что дефекты накапливаются на расстоянии 200 нм от поверхности, где концентрация Mg была максимальной. Кроме того, в отличие от образца, имплантированного Mg, мы не наблюдали каких-либо пирамидальных и двухлинейных дефектов (обозначенных как A и B на рис. 2 (b)) в образце GaN, легированном Mg. Интересно, что пирамидальные и линейные дефекты также наблюдаются в образцах GaN, где Mg вводится другими методами, кроме ионной имплантации. Например, Хромов и др. В [29] сообщается о наличии пирамидальных дефектов в образцах GaN, легированных Mg, выращенных методом MOCVD. Однако они наблюдали такие дефекты только в образце более легированного GaN, где концентрация Mg составляла около ~ 5 × 10 19 . см −3 . Однако в образцах с Mg ~ 2 × 10 18 см −3 эти пирамидальные домены не наблюдались. Vennegues et al. [27] также наблюдали такие пирамидальные домены в образцах GaN, легированных Mg, выращенных методом MOCVD, с концентрацией Mg в среднем 10 19 см −3 диапазон. В образце с концентрацией Mg ниже 10 19 таких дефектов не наблюдалось. см −3 . В нашей работе аналогичный уровень Mg ~ 4 × 10 19 см −3 вводится посредством ионной имплантации и эпитаксиального легирования для анализа наличия этих дефектов. Эти дефекты наблюдаются только в образце, имплантированном Mg, но не в образце, легированном Mg, что предполагает, что распределение Mg также следует учитывать для объяснения их существования. Из измерений SIMS обнаружено, что Mg неравномерно распределен в имплантированном Mg образце (рис. 1 (b) и (d)), тогда как образец, легированный Mg, показал равномерное распределение Mg (рис. 5 (b)). Более того, в образце, имплантированном Mg, эти дефекты были обнаружены только в узком окне с более высокой концентрацией Mg по сравнению с окружающей матрицей. Следовательно, образование этих дефектов связано с уровнем включенного Mg и распределением Mg, и они, вероятно, будут образовываться в областях, где Mg находится в диапазоне 10 19 см −3 . Представляется, что неоднородный профиль Mg в образце, имплантированном Mg, приводит к неравномерному распределению дефектов. Однако не следует отрицать такие возможности, как неравномерно распределенные дефекты, вызывающие неоднородное распределение Mg, или зависимость профиля имплантации Mg от наличия таких дефектов; поэтому необходимы дальнейшие исследования в этом направлении. Наш сравнительный анализ дефектов в GaN с включением Mg показывает, что природа и тип дефектов зависят от метода внедрения.
Выводы
Подводя итог, можно сказать, что структурные исследования дефектов в имплантированных Mg и легированных Mg эпислоях на отдельно стоящих подложках GaN на основе сканирующей просвечивающей электронной микроскопии показали, что природа дефектов сильно зависит от способа внедрения Mg. Имплантированный Mg GaN показал наличие пирамидальных доменов, указывающих в направлении [0001], и двухлинейных дефектов с элементами, разделенными на несколько нанометров глубже в направлении [0001]. Пирамидальные домены считаются Mg 3 N 2 структур на основе, тогда как линейчатые дефекты, как обнаружено с помощью энергодисперсионной спектроскопии, также содержат Mg. Было обнаружено, что эти линейные дефекты расположены на глубине около 200 нм от поверхности в узкой области с концентрацией Mg около 10 19 . см −3 которые предполагают, что их образование связано с уровнем имплантированной концентрации Mg. Ожидается, что образование этих дефектов в GaN при имплантации Mg будет вносить значительный вклад в механизмы самокомпенсации Mg, ведущие к неэффективному легированию p-типа. Напротив, образец GaN, легированный магнием, показал только наличие точечных дефектов, которые, как было обнаружено, равномерно распределены по всему образцу. Настоящее исследование, в котором подчеркивается зависимость метода включения Mg и его концентрации от природы и типа дефектов, может оказаться полезным для выбора соответствующего количества Mg, которое необходимо включить для достижения высокой проводимости p-типа в материалах на основе GaN для эффективной работы устройства.
Сокращения
- ADF:
-
Кольцевое темное поле
- BF:
-
Яркое поле
- EDS:
-
Энергодисперсионная спектроскопия
- MBE:
-
Молекулярно-лучевая эпитаксия
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- SIMS:
-
Масс-спектрометрия вторичных ионов
- STEM:
-
Сканирующая просвечивающая электронная микроскопия
Наноматериалы
- Примеры схем и списков соединений
- Текущий метод и анализ сетки
- 5G и GaN:переход от LDMOS к GaN
- 5G и GaN:будущие инновации
- Анализ организации актина и фокальной адгезии в клетках U2OS на полимерных наноструктурах
- Анализ инфракрасного отражения эпитаксиальных легированных слоев GaN n-типа, выращенных на сапфире
- Электроформование на изоляционные основы путем контроля смачиваемости и влажности поверхности
- Изготовление тонких пленок SrGe2 на подложках Ge (100), (110) и (111)
- Исследование углеродных нановолокон и активного углерода как симметричного суперконденсатора в водном элек…
- Морфология, структура и оптические свойства полупроводниковых пленок с наноостровками GeSiSn и напряженными сл…



