Исследование энергетической полосы на гетеропереходах дисульфида молибдена и ZrO2
Аннотация
Выравнивание энергетических зон в многослойном MoS 2 / ZrO 2 интерфейс и эффекты CHF 3 плазменная обработка на смещении полосы была исследована с помощью рентгеновской фотоэлектронной спектроскопии. Смещение валентной зоны (VBO) и смещение зоны проводимости (CBO) для MoS 2 / ZrO 2 образец составляет около 1,87 эВ и 2,49 эВ соответственно. В то время как VBO был увеличен примерно на 0,75 эВ для образца с CHF 3 плазменная обработка, которая объясняется сдвигом уровня ядра Zr 3d вверх. Результаты расчетов показали, что атомы F имеют сильное взаимодействие с атомами Zr, а энергетический сдвиг валентной зоны для d-орбитали атомов Zr составляет около 0,76 эВ, что согласуется с экспериментальным результатом. Это интересное открытие способствует применению ZrO 2 как материалы ворот в MoS 2 на основе электронных устройств и предоставляет многообещающий способ регулировки выравнивания полосы.
Введение
В последние десятилетия SiO 2 / Материалы на основе Si играли доминирующую роль в производстве электронных устройств, таких как интегральные логические схемы, энергонезависимая память и т. Д. Однако по мере того, как размер устройств непрерывно уменьшался от микрометров до менее 10 нм, традиционные полупроводники с трудом удовлетворяли требованиям повышенной удельной емкости, низкого тока утечки затвора и высокой подвижности носителей. Поэтому поиск новых полупроводников в качестве каналов для устройств и оксидов с высоким κ в качестве изоляторов становится ажиотажным. С момента открытия графена успешное изготовление двумерных (2D) материалов, особенно полупроводников с подходящей шириной запрещенной зоны, предоставило многообещающий способ преодолеть этот недостаток.
Среди 2D-материалов дисульфид молибдена (MoS 2 ) с настраиваемыми свойствами, основанными как на количестве слоев, так и на выборе материалов подложки, привлекает все большее внимание не только из-за его хорошей химической стабильности и механической гибкости, но и превосходных оптических и электрических свойств [1, 2]. Ширина запрещенной зоны монослоя MoS 2 составляет около 1,80 эВ, в то время как для объема 1,20 эВ. Перспективные характеристики электронных и оптоэлектронных устройств из MoS 2 слои, такие как полевые транзисторы [3,4,5], датчики [6] и фотодетекторы [7], доказывают, что они могут быть потенциальной заменой Si в традиционной электронике и органических полупроводников в носимых и гибких системах [8, 9,10,11]. Хотя однослойный MoS 2 Полевые транзисторы (FET) на основе полевых транзисторов показали отличные характеристики с высоким коэффициентом включения / выключения тока около 10 8 и низкое подпороговое колебание ~ 77 мВ / декада [3], его широкое применение было затруднено из-за синтеза высококачественного однослойного MoS с большой площадью 2 и стабильность устройств [12,13,14]. Многослойный MoS 2 может быть более привлекательным из-за высокой плотности состояний, которая способствует высокому току возбуждения в баллистическом пределе [15]. Кроме того, подвижность носителя многослойного MoS 2 может быть дополнительно значительно улучшен оксидами с высоким κ из-за эффектов диэлектрического экранирования [16, 17]. Поэтому важно и важно исследовать многослойный MoS 2 / гетеропереходы оксидов с высоким κ.
В электронных устройствах с гетеропереходом свойства переноса электронов точно контролируются профилями энергетических зон на границе раздела между полупроводником и оксидом изолятора с точки зрения смещения валентной зоны (VBO) и смещения зоны проводимости (CBO). VBO и CBO должны быть как можно больше, чтобы работать в качестве барьера, чтобы уменьшить ток утечки, образованный инжекцией дырок и электронов, особенно CBO играет ключевую роль в выборе подходящих оксидов с высоким k для затвора. клемма и должна быть не менее 1 эВ, чтобы избежать утечки тока [18,19,20]. Между тем, интерфейсные заряды, расположенные в полупроводнике / оксидах, оказывают важное влияние на конструкцию зон и должны быть оптимизированы с помощью технологии пассивации, такой как SiH 4 пассивация, и CHF 3 лечение. В этой статье мы исследовали выравнивание полос многослойного MoS 2 / ZrO 2 системы, так как характер интерфейса имеет прямое отношение к характеристикам устройств, и влияние CHF 3 плазменная обработка на смещении полосы на MoS 2 / ZrO 2 был исследован интерфейс.
Методы и эксперименты
В экспериментах многослойный MoS 2 пленки выращивались на SiO 2 / Si подложки с помощью систем химического осаждения из паровой фазы (CVD) с MoO 3 и порошок серы в качестве источников Мо и предшественников серы соответственно. Во время процесса роста в качестве газа-носителя использовался газ Ar, а температура роста составляла 800 ° C в течение 5 минут. Затем MoS 2 / ZrO 2 образцы были приготовлены путем переноса многослойного MoS большой площади 2 пленка на ZrO 2 / Si подложки с использованием метода полиметилметакрилата (ПММА). ZrO 2 оксид (15 нм) был нанесен на Si при 200 ° C с использованием системы осаждения атомных слоев (BENEQ TFS-200) с прекурсором тетракис диметиламидо циркония (TDMAZr) в качестве источника циркония и водой (H 2 O) в качестве источника кислорода. Чтобы исследовать эффекты CHF 3 лечение по выравниванию полосы в MoS 2 / ZrO 2 интерфейсов, для одного образца ZrO 2 Подложка / Si была обработана CHF 3 плазма с ВЧ мощностью около 20 Вт и расходом около 26 sccm. Между тем, время плазменной обработки составляет около 60 с, а давление поддерживается на уровне 1 Па во время процесса. Следовательно, полученная доза F составляет примерно 2,0 × 10 14 . атомов / см 2 оценивается с помощью измерений масс-спектрометрии вторичных ионов (ВИМС). В процессе оптимизации времени плазменной обработки CHF 3 плазма серьезно ухудшила качество материала из-за введения фтора, диффундированного в ZrO 2 в основном, когда время было установлено на 70 с. В то время как при времени плазменной обработки 50 с, менее 60 с, результаты ВИМС не показали явного пика F на поверхности оксида. В другом примере нет CHF 3 проведена плазменная обработка. Рамановские характеристики образцов снимали в системе RENISHAW при комнатной температуре. Рентгеновская фотоэлектронная спектроскопия (XPS) была измерена с использованием системы VG ESCALAB 220i-XL. Энергия фотонов монохроматизированного рентгеновского источника Al Kα составляет около 1486,6 эВ. Во время измерений энергия прохода была установлена на уровне 20 эВ для получения спектров РФЭС. Кроме того, пик C 1 с (284,8 эВ) использовался для корректировки энергии связи на уровне ядра, чтобы устранить эффект дифференциальной зарядки поверхности образца.
Результаты и обсуждения
Рамановские спектры выращенного и перенесенного многослойного MoS 2 были охарактеризованы при комнатной температуре, как показано на рис. 1. Два основных режима комбинационного рассеяния, обозначенные как A 1 г и \ ({\ mathrm {E}} _ {2g} ^ 1 \) наблюдались в спектре. В частности, мода \ ({E} _ {2g} ^ 1 \) возникает в результате противоположного движения плоских атомов S по отношению к центральному атому Мо в области более низких частот, тогда как A 1 г относительно внеплоскостных колебаний атомов S в более высокочастотной области [21]. Было замечено, что \ ({\ mathrm {E}} _ {2g} ^ 1 \) и A 1 г режимы MoS 2 претерпевают красный сдвиг и синий сдвиг, соответственно, от монослоя к массивным образцам, что связано с различной межслойной восстанавливающей силой Ван-дер-Ваальса и влиянием структурных изменений, вызванных упаковкой [21]. Следовательно, разность частот (Δk) между A 1 г и режимы \ ({\ mathrm {E}} _ {2g} ^ 1 \) часто используются для оценки количества слоев или толщины MoS 2 фильм. Здесь Δk выращенного MoS 2 пленка около 25,32 см −1 , что указывает на то, что пленка состоит более чем из шести слоев. Кроме того, результат поперечной просвечивающей электронной микроскопии (ПЭМ), показанный на вставке к рис. 1, продемонстрировал количество слоев выращенного MoS 2 составляла около 8, что соответствовало толщине около 4,5 нм. Более того, положение пика комбинационного рассеяния и полная ширина на полувысоте (FWHM) MoS 2 практически одинаковы до и после переноса, что указывает на то, что процесс переноса незначительно влияет на качество материала.
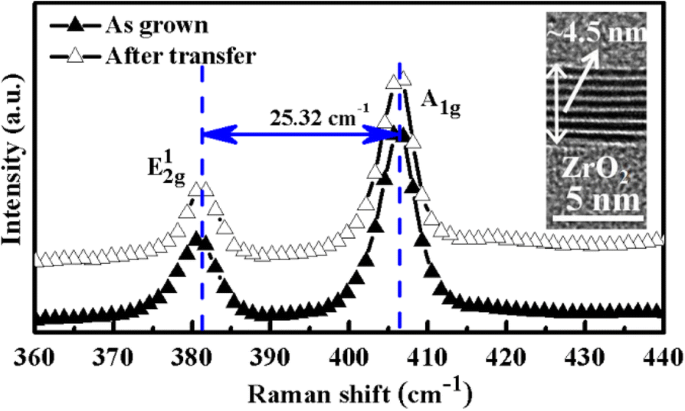
Рамановская спектроскопия ультратонкого MoS 2 фильм до и после передачи. На вставке - изображение MoS 2 , полученное с помощью просвечивающей электронной микроскопии (ПЭМ). на ZrO 2 / Si подложка, на которой показаны слои MoS 2
Доказано, что XPS является эффективным способом определения смещения полосы на границе гетероперехода [22, 23]. В MoS 2 / ZrO 2 гетеропереход, значение VBO было получено из изменения спектров валентной зоны ZrO 2 между оксидом без покрытия и MoS 2 материал [24]. На рис. 2а, б показаны спектры основного уровня и полосы валентности чистого ZrO 2 . и многослойный-MoS 2 / ZrO 2 , соответственно. Пересечение между базовой линией и наклоном передней кромки дает максимум валентной зоны (VBM) образца, где уровень Ферми принимается за опорный уровень. Результаты показали, что VBM ZrO 2 и многослойный-MoS 2 / ZrO 2 системы составляют около 1,88 эВ и 0,06 эВ соответственно. Кроме того, спектр Zr 3d на уровне ядра чистого ZrO 2 демонстрирует хорошо разделенные дублетные пики, обозначаемые как Zr 3d 5/2 и 3d 3/2 со значениями энергии 182,05 эВ и 184,45 эВ соответственно, тогда как соответствующие значения для MoS 2 / ZrO 2 образец составляют 182,10 эВ и 184,50 эВ соответственно. Изменение Zr 3d на уровне ядра 5/2 или 3d 3/2 ~ 0,05 эВ находится в диапазоне погрешности измерения и обработки данных. По сравнению с чистым ZrO 2 образец, многослойный MoS 2 оказали небольшое влияние на спектр Zr 3d, как показано на рис. 2b. Тогда разница в энергии между Zr 3d 5/2 и VBM составляет 180,17 эВ и 182,04 эВ для чистого ZrO 2 образец и MoS 2 / ZrO 2 образец соответственно. Следовательно, значение VBO для многослойного MoS 2 / ZrO 2 граница раздела составляет около 1,87 ± 0,05 эВ, в основном из-за разницы VBM между чистым ZrO 2 и MoS 2 / ZrO 2 . Аналогично для многослойного MoS 2 / ZrO 2 образец с CHF 3 плазменная обработка перед MoS 2 передачи, VBM составляет около 0,02 эВ, как показано на рис. 2c, почти идентично образцу без CHF 3 лечение. Однако спектр Zr 3d смещается в сторону более высоких энергий примерно на 0,75 эВ, Zr 3d 5/2 ~ 182,85 эВ, а 3d 3/2 ~ 185,25 эВ, что указывает на увеличение значения VBO примерно на 0,75 ± 0,04 эВ после плазменного травления. Затем значение CBO ∆E C можно получить по формуле
$$ \ Delta {\ mathrm {E}} _ {\ mathrm {C}} ={E} _ {G, ZrO2} - {E} _ {G, MoS2} - \ Delta {E} _V. $$ (1)где E G , ZrO 2 и E G , MoS 2 ширина запрещенной зоны ZrO 2 и MoS 2 соответственно, и ∆E V соответствует значению VBO. Обычно энергия запрещенной зоны оксидного изолятора может быть получена из энергетического спектра потерь O 1 s [25]. На рис. 3а показан энергетический спектр потерь O 1 с ZrO 2 . , а E G , ZrO 2 составляет около 5,56 эВ, вычисленное из разницы энергий путем экстраполяции базовой линии линейного края (535,95 эВ), аппроксимирующей энергию внутреннего уровня связей Zr-O (530,39 эВ). Ширина запрещенной зоны MoS 2 в этой работе составляет около 1,2 эВ. Следовательно, значение CBO для образца без CHF 3 обработка составляет около 2,49 эВ и 1,74 эВ для образца с CHF 3 лечение. Затем схематические структуры ленточной инженерии для образцов без и с CHF 3 плазменная обработка проиллюстрирована на рис. 3b. Очевидно, многослойный MoS 2 / ZrO 2 система имеет выравнивание типа I, которое облегчает удержание электронов и дырок в MoS 2 . Между тем, большой ∆E C и ∆E V для MoS 2 / ZrO 2 интерфейс подразумевает, что ZrO 2 может быть хорошим диэлектриком затвора для n- или p-канального многослойного MoS 2 применение полевых транзисторов для подавления тока утечки затвора. Кроме того, образец с плазменной обработкой имеет более высокое значение VBO ∆E V (нижний CBO ∆E C ) по сравнению с образцом без плазменной обработки, что лучше при применении полевых транзисторов с p-каналом.
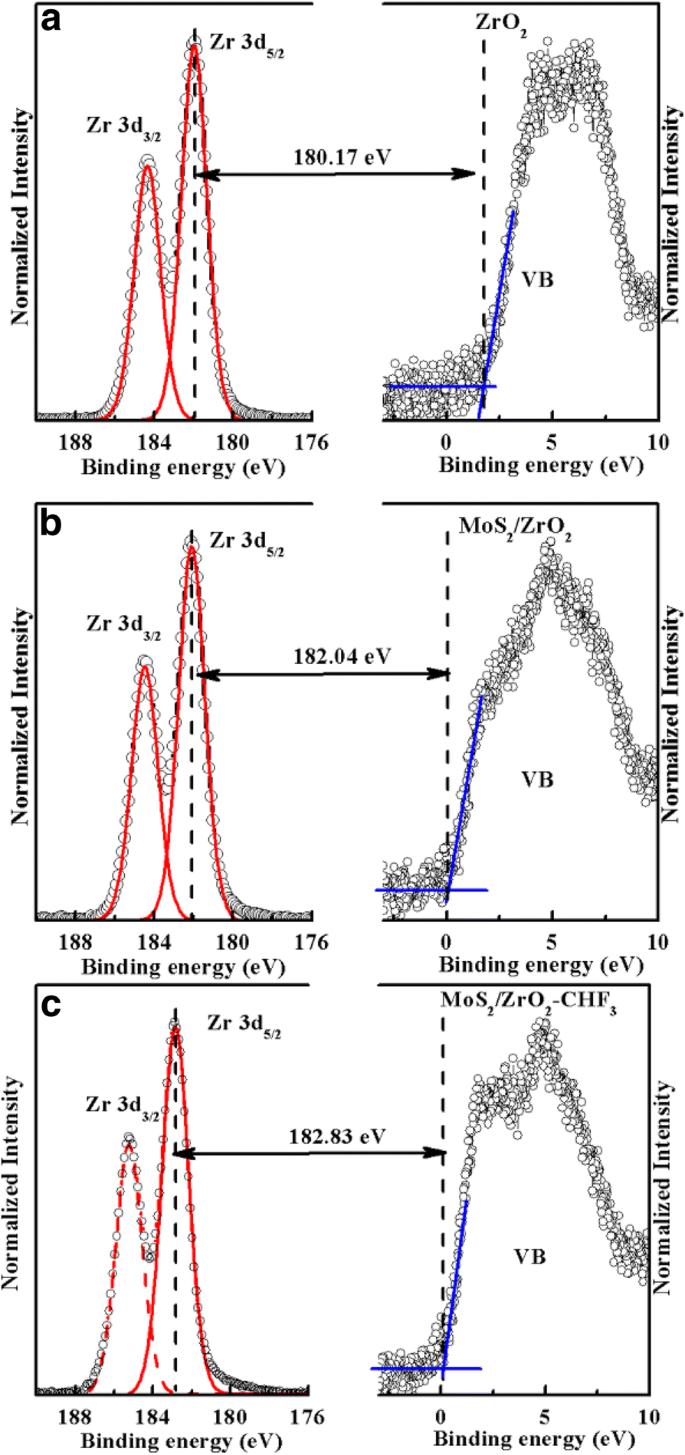
Спектры Zr 3d на уровне ядра и валентной зоны для a голый ZrO 2 оксид, b многослойный-MoS 2 / ZrO 2 образец и c 3 швейцарских франков многослойный MoS с плазменной обработкой 2 / ZrO 2 образец

а Спектры потерь энергии фотоэлектронами O 1 с для ZrO 2 окись. б Схематическая структура выравнивания энергетической зоны в MoS 2 / ZrO 2 интерфейс без (вверху) и с (внизу) CHF 3 плазменная обработка. c Профили глубины ВИМС (Si, Zr и F) для образца с CHF 3 плазменная обработка
Изменение выравнивания полосы на многослойном MoS 2 / ZrO 2 считается, что он тесно связан с богатым фтор межфазным слоем, индуцированным CHF 3 плазменная обработка. На рис. 3c показан результат ВИМС для обработанного плазмой образца для элементов Zr, F и Si с явным пиком ионов F на границе раздела. Между тем, некоторое количество ионов F диффундировало в нижележащий ZrO 2 слой из-за его небольшого размера. В MoS 2 / ZrO 2 интерфейс с CHF 3 При плазменной обработке увеличение VBO (уменьшение CBO) в основном объясняется сдвигом вверх остовных уровней Zr 3d, показанных на рис. 2c, что указывает на то, что ионы F имеют сильное взаимодействие с атомами Zr. Тогда эффекты CHF 3 обработка электронных свойств ZrO 2 оксиды были исследованы с использованием Material Studio в сочетании с Cambridge Sequential Total Energy Package (CASTEP) на основе теории функционала плотности (DFT) [26]. Обобщенное градиентное приближение для обменного и корреляционного потенциала, предложенное Пердью-Берк-Эрнцерхофом (PBE) [27], было использовано для обработки ион-электронных взаимодействий вместе с проектором увеличенного волнового потенциала (PAW) [28]. Энергия отсечки плоской волны выбрана равной 750 эВ, и k-сетка Монкхорста – Пака размером 1 × 1 × 1 используется для выборки зоны Бриллюэна при оптимизации структуры и вычислении полной энергии [29]. Все атомы были расслаблены до их положений равновесия до тех пор, пока общие изменения энергии во время оптимизации, наконец, не сойдутся до менее чем 10 −6 эВ / атом, сила и напряжение на каждом атоме были сведены к 0,003 эВ / нм и 0,05 ГПа, соответственно, а смещение было сведено к 1 × 10 −4 нм. На рис. 4a, b показаны полная и парциальная плотность состояний (DOS) для MoS 2 . / ZrO 2 образцов, где ноль эВ соответствует уровню Ферми. Очевидно, ионы F имеют сильное взаимодействие с атомами Zr, в результате чего часть d-орбитали от атомов Zr, которая проецируется в валентную зону, перемещается вниз примерно на 0,76 эВ от -0,06 до -0,82 эВ ниже уровня Ферми, что согласуется с увеличение смещения балансовой ленты ∆E V ~ 0,75 эВ. Атомы F имеют тенденцию притягивать электроны из-за большой электроотрицательности (4,0) и становятся частично отрицательно заряженными, а затем образуют диполи с атомами Zr, в конечном итоге способствуя изменению смещения зоны. Следовательно, изменение полосы на MoS 2 / ZrO 2 интерфейс, представленный CHF 3 плазменная обработка представляет собой многообещающий способ регулировки выравнивания полос на гетеропереходах, что упрощает разработку связанных устройств.

Расчетная полная плотность состояний (TDOS) и парциальная плотность состояний (PDOS) для образцов без CHF 3 лечение ( а ) и с CHF 3 лечение ( b )
Выводы
В этой статье мы исследовали инженерию энергетических зон в многослойном MoS 2 / ZrO 2 интерфейс и исследовали эффекты CHF 3 лечение с помощью рентгеновской фотоэлектронной спектроскопии. Результаты показали, что выравнивание типа I было сформировано в MoS 2 / ZrO 2 граница гетероперехода с CBO и VBO около 2,49 эВ и 1,87 эВ соответственно. В то время как CHF 3 плазменная обработка увеличивает VBO примерно на 0,75 ± 0,04 эВ в основном из-за сдвига вверх энергии сердцевинных уровней Zr 3d, что согласуется с результатами расчетов. Эта работа доказывает большие возможности применения ZrO 2 с высоким содержанием κ. оксид в многослойном MoS 2 на основе устройств и предоставляет возможный способ изменить выравнивание энергетической полосы интерфейса.
Сокращения
- 2D:
-
Двумерный
- CASTEP:
-
Cambridge Sequential Total Energy Package
- CBO:
-
Смещение зоны проводимости
- CVD:
-
Химическое осаждение из паровой фазы
- DFT:
-
Функциональная теория плотности
- DOS:
-
Плотность состояний
- полевые транзисторы:
-
Полевые транзисторы
- FWHM:
-
Полная ширина на половине максимальной
- MoS 2 :
-
Дисульфид молибдена
- PAW:
-
Проектор дополненной волны
- PBE:
-
Пердев-Бурк-Эрнцерхоф
- PMMA:
-
Полиметилметакрилат
- SIMS:
-
Масс-спектрометрия вторичных ионов
- TDMAZr:
-
Тетракис диметиламидо цирконий
- ТЕМ:
-
Просвечивающая электронная микроскопия
- TMD:
-
Дихалькогениды переходных металлов
- VBO:
-
Смещение полосы валентности
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- ZrO 2 :
-
Диоксид циркония
Наноматериалы
- Использование молибдена в сталелитейной промышленности
- Использование молибдена в химической промышленности
- Какие типы и способы применения молибденового стержня?
- Применение молибдена и молибденовых сплавов
- Влияние состояния на эффективность и надежность двигателя
- Использование углов для улучшения будущего электроники
- Ультратонкий идеальный поглотитель и его применение в качестве плазмонного датчика в видимой области
- Переход на зеленый:плюсы и минусы ветровой энергии
- Защита OT в секторе энергетики и коммунальных услуг
- История ленточнопильного станка и его новаторские идеи



