Теоретический анализ однофотонных лавинных фотодиодов InGaAs / InAlAs
Аннотация
Сообщается о теоретическом анализе и двумерном моделировании лавинных фотодиодов (APD) InGaAs / InAlAs и однофотонных APD (SPAD). Исследованы распределение электрического поля и туннельный эффект InGaAs / InAlAs APD и SPAD. Когда SPAD InGaAs / InAlAs работают в режиме Гейгера, электрическое поле линейно увеличивается в слое поглощения и отклоняется вниз от его линейных соотношений в слое умножения. Учитывая пороговое электрическое поле туннелирования в умножающем слое, толщина умножающего слоя должна быть больше 300 нм. Более того, SPAD могут работать при большом напряжении смещения, чтобы избежать туннелирования в поглощающем слое с высокими концентрациями легирования в заряженном слое.
Фон
В 0,53 Ga 0,47 Как / В 0,52 Al 0,48 As (далее именуемые InGaAs / InAlAs) и InGaAs / InP лавинные фотодиоды (APD) являются наиболее важными фотодетекторами для обнаружения коротковолнового инфракрасного излучения. В последние годы исследования квантового распределения ключей быстро прогрессировали, и теперь ЛФД InGaAs / InAlAs и InGaAs / InP могут реализовывать подсчет и синхронизацию однофотонных фотонов как однофотонные ЛФД (SPAD) [1]. По сравнению с другими однофотонными детекторами в диапазоне длин волн SWIR, такими как фотоэлектронные умножители, однофотонные лавинные диоды InGaAs обладают отличительными преимуществами:высокая производительность, высокая надежность, низкое смещение, малый размер, хорошее временное разрешение и простота эксплуатации [ 2, 3]. Таким образом, ЛФД InGaAs / InAlAs и InGaAs / InP привлекают большое внимание [4, 5]. По сравнению с ЛФД, работающими в линейном режиме, ЛФД работали в режиме Гейгера, поскольку в них подавалось обратное смещение, превышающее напряжение пробоя [6]. SPAD обеспечивают высокий коэффициент усиления в слое умножения, и одиночный фотон может запускать макроскопический импульс тока, что дает возможность точно определять приход одиночного фотона к детектору [7]. Таким образом, SPAD могут обнаруживать одиночный фотон на длине волны 1550 нм [8]. Между тем, длину волны поглощения можно регулировать материалами поглощающего слоя [9].
По сравнению с SPAD на основе InAlAs, теоретические и имитационные исследования SPAD на основе InP являются более обширными [2, 10, 11, 12]. Однако APD на основе InAlAs все чаще используются вместо APD на основе InP, поскольку они могут улучшить производительность как APD, так и SPAD [13]. Отношение коэффициента ионизации электрона (α) к дырке (β) в InAlAs больше, чем в InP, что приводит к низкому коэффициенту избыточного шума и высокому произведению коэффициента усиления на полосу пропускания в ЛФД на основе InAlAs [14]. Большая ширина запрещенной зоны InAlAs может улучшить характеристики пробоя и уменьшить темновую скорость счета (DCR) в SPAD [15]. ЛФД на основе InAlAs обладают высокой подвижностью электронов, что приводит к более быстрому отклику, чем у ЛФД на основе InP [16]. Кроме того, коэффициент ионизации ЛФД InAlAs менее чувствителен к температурным изменениям ЛФД на основе InP [17]. Следовательно, ЛФД InGaAs / InAlAs могут обеспечить высокую производительность с точки зрения характеристик пробоя, DCR, избыточного шума, полосы пропускания усиления, времени отклика и температурных характеристик.
Исследования ЛФД InGaAs / InAlAs в основном сосредоточены на повышении эффективности регистрации одиночных фотонов (SPDE) и уменьшении DCR в SPAD. Karve et al. продемонстрировали первые SAPD на основе InGaAs / InAlAs, которые имеют СПДЭ 16% при 130 К [18]. Наката и др. улучшены температурные характеристики SPAD, что позволяет достичь SPDE 10% при 213 K [19]. Zhao et al. разработан самозатухающий и самовосстанавливающийся SPAD InGaAs / InAlAs с SPDE 11,5% при 160 K; одновременно наблюдался DCR 3,3 M Гц [20]. Meng et al. разработали мезаструктуру InGaAs / InAlAs SPAD, которая достигает SPDE 21% при 260 K [21]. Затем они нанесли толстый слой поглощения и умножения в аналогичной структуре, который улучшает SPDE до 26% при 210 K и снижает DCR до 1 × 10 8 Гц [22]. Однако в этих исследованиях DCR InGaAs / InAlAs SPAD слишком высоки по сравнению с InGaAs / InP SPAD (в последних InP SPAD DCR обычно <10 4 Гц) [23]. Высокие значения DCR в SPAD InGaAs / InAlAs объясняются туннельными токами, которые вызваны сильным полем при перенапряжении смещения [21, 22, 24]. Таким образом, уменьшение механизмов, связанных с туннелированием, важно для SPAD InGaAs / InAlAs, и эти механизмы связаны с распределением электрического поля в SAPD. Из литературы [1. 9], пороговое электрическое поле туннелирования составляет 2,0 × 10 5 В / см в поглощающем слое (InGaAs) и 6,8 × 10 5 В / см в умножающем слое (InAlAs). Таким образом, подходящее распределение электрического поля важно для InAlAs SPAD, которое определяется толщиной слоя заряда и слоя умножения. Рассматривая слой заряда InAlAs APD, Kleinow et al. изучили влияние концентрации легирования в этом слое и обнаружили, что концентрация легирования более важна для работы ЛФД InGaAs / InAlAs [25, 26]. Chen et al. изучили влияние слоев заряда и умножения на пробивное и пробивное напряжение с помощью теоретического анализа и моделирования [27]. Эти исследования были сосредоточены на характеристиках InAlAs APD в линейной модели. Однако производительность InAlAs SPAD еще не полностью изучена в режиме Гейгера.
В этой статье теоретический анализ и моделирование используются для изучения эффекта туннелирования и распределения электрического поля в SPAD InGaAs / InAlAs. С учетом туннельного порогового электрического поля в режиме Гейгера критерии проектирования SPAD оптимизированы, чтобы избежать туннельного эффекта.
Методы
Численное моделирование выполняется для ЛФД SAGCM InGaAs / InAlAs с передней подсветкой с использованием TCAD [28]. Физические модели, используемые для моделирования, представлены следующим образом. Модель ударной ионизации Сельберхерра имитирует размножение лавины в InAlAs. Распределение электрического поля и диффузионный ток описываются дрейфово-диффузионной моделью, которая включает уравнения Пуассона и неразрывность носителей. Для туннельного тока используются модели межполосного туннелирования и туннелирования с использованием ловушек. В моделировании используются другие базовые модели, включая статистику носителей Ферми – Дирака, оже-рекомбинацию, зависимость от концентрации носителей, рекомбинацию Шокли – Рида – Холла, низкую подвижность поля, насыщение по скоростям, ударную ионизацию и метод трассировки лучей. Схематическое сечение эпитаксиальной структуры ЛФД с передней подсветкой для моделирования показано на рис. 1.
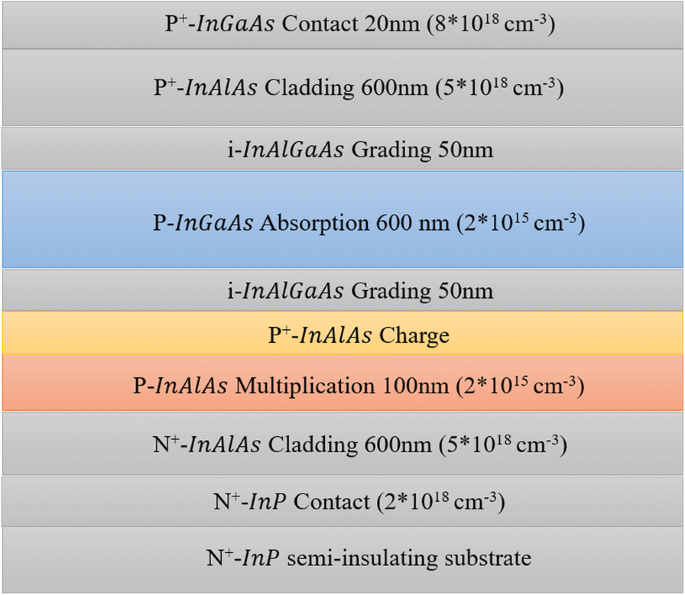
Схематический разрез ЛФД SAGCM с передней подсветкой. Представлено схематическое поперечное сечение освещенного сверху ЛФД SAGCM InGaAs / InAlAs. Он включает структуру, материалы, легирование и толщину. Снизу вверх слои последовательно именуются как подложка, контактный слой, слой оболочки, слой умножения, слой заряда, слой выравнивания, слой поглощения, слой выравнивания, слой оболочки и контактный слой
Снизу вверх слои последовательно называются подложкой, контактным слоем, слоем оболочки, слоем умножения, слоем заряда, слоем выравнивания, слоем поглощения, слоем выравнивания, слоем оболочки и контактным слоем. Фотогенерированные носители, индуцированные в поглощающем слое, дрейфуют в умножающий слой, где вызывают лавинный пробой. Электрическое поле в поглощении регулируется с помощью управления слоем заряда и поддерживает высокое поле только в слое умножения. Между зарядовым и поглощающим слоями выравнивающий слой InAlGaAs предотвращает скопление электронов на гетеропереходе InGaAs-InAlAs. Структура устройства в нашем моделировании аналогична экспериментальной структуре в ссылке. [21].
Распределение электрического поля в SAGCM APD может быть решено с помощью уравнения Пуассона, модели обедненного слоя PN и уравнения граничных условий [29]. Уравнение Пуассона имеет вид
$$ \ frac {d \ xi} {d x} =\ frac {\ rho} {\ varepsilon} =\ frac {q \ ast N} {\ varepsilon}. $$ (1)Уравнение граничных условий задается как
$$ Vbias + Vbi =- {\ int} _0 ^ w \ xi \ left (x, \ mathrm {w} \ right) dx. $$ (2)В этих уравнениях ρ равен легирующему иону q × N в слое истощения ε диэлектрическая проницаемость материала, V предвзятость напряжение смещения на APD, V би - встроенный потенциал, а w - толщина обедненного слоя. Математическая взаимосвязь между распределением электрического поля и напряжением смещения, когда граница обедненного слоя достигает контактного слоя в устройстве, может быть получена с помощью формул. (1) и (2).
Туннельные токи складываются из межзонного туннелирования и туннелирования с помощью ловушек. Межзонный туннельный ток зависит от поля в материале и становится доминирующим компонентом темнового тока в сильных полях [24, 30]. Скорость генерации межполосного туннеля задается как [31].
$$ {G} _ {\ mathrm {btb}} ={\ left (\ frac {2 {m} ^ {\ ast}} {E_g} \ right)} ^ {1/2} \ frac {q ^ 2E } {{\ left (2 \ pi \ right)} ^ 3 \ mathrm {\ hslash}} \ exp \ left (\ frac {- \ pi} {4q \ mathrm {\ hslash} E} {\ left (2 { m} ^ {\ ast} \ ast {E} _g ^ 3 \ right)} ^ {\ raisebox {1ex} {$ 1 $} \! \ left / \! \ raisebox {-1ex} {$ 2 $} \ right. } \ right) $$ (3)В приведенном выше уравнении E г - ширина запрещенной зоны InGaAs (0,75 эВ) или InAlAs (1,46 эВ), m * (равно 0,04 м e в InGaAs и 0,07 м e в InAlAs) - эффективная приведенная масса, а E - максимальное электрическое поле. G btb зависит от электрического поля E и запрещенная зона E г , w туннель считается эффективной толщиной для процесса туннелирования, а A Предполагается, что это площадь устройства. Таким образом, туннельный ток межполосного туннеля задается как [13].
$$ {I} _ {\ mathrm {tunnel}} / A ={G} _ {\ mathrm {btb}} \ ast q \ ast {w} _ {\ mathrm {tunnel}} $$ (4)Расчетные результаты I туннель / А ( w туннель =1 мкм) представлены на рис. 2. I туннель становится значимым при 2,0 × 10 5 В / см InGaAs и 6,9 × 10 5 В / см InAlAs соответственно. Мы обнаружили, что эти рассчитанные значения хорошо соответствуют пороговому электрическому полю туннелирования (2,0 × 10 5 В / см, InGaAs) и (6,8 × 10 5 В / см, InAlAs) в справочниках. Туннельный ток может существенно повлиять на характеристики SPAD в сильном поле. Таким образом, поле должно быть настроено ниже порогового значения туннелирования как в InGaAs, так и в InAlAs SPAD. В таблице 1 показаны параметры, использованные при моделировании.
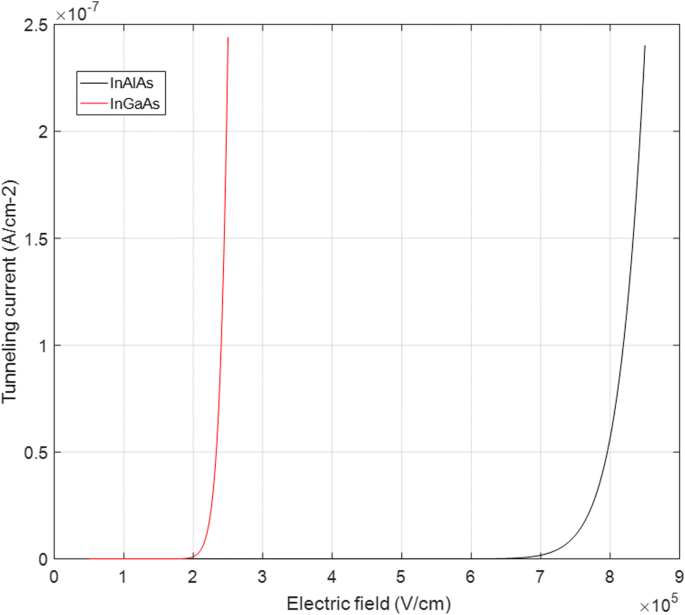
Отношения между Я туннель / А и электрическое поле в InGaAs и InAlAs. Представляет рассчитанные результаты I туннель / А . Я туннель становится значимым при 2,0 × 10 5 В / см InGaAs и 6,9 × 10 5 В / см InAlAs, соответственно
Результаты и обсуждение
В этом разделе теоретический анализ и выводы были изучены путем моделирования. Во-первых, распределение электрического поля в режиме Гейгера было изучено в разделе A. Затем, с учетом туннельного порогового электрического поля в режиме Гейгера, критерии проектирования SPAD оптимизируются, чтобы избежать эффекта туннелирования в разделе B. Структура в справочнике [22] была использована для тестирования имитационной модели. В этом моделировании мы использовали тот же механизм моделирования, что и в справочнике [28], и кривая "вольт-амперная характеристика" вместе с кривой зависимости коэффициента усиления от напряжения была представлена на рис. 3. Можно обнаружить, что коэффициент усиления постепенно увеличивается после прохождения напряжения и внезапное повышение напряжения пробоя.
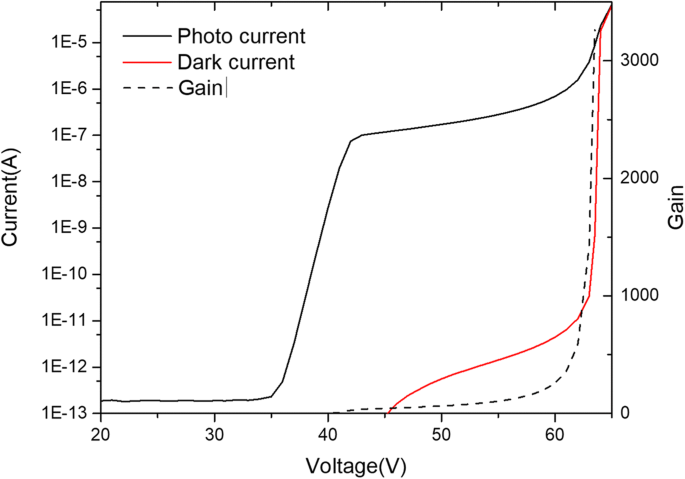
Вольт-амперная кривая вместе с коэффициентом усиления от напряжения InGaAs / InAlAs APD. Представляет кривую i-v вместе с кривой зависимости усиления от напряжения для некоторой типичной структуры устройства, как показано на рисунке
Распределение электрического поля в режиме Гейгера
Мы обнаружили, что на производительность устройства большое влияние оказывает распределение электрического поля. Для поддержания высокого усиления и небольшого темнового тока важен надлежащий контроль электрического поля в слоях умножения и поглощения. Из исх. [32], подходящее распределение поля в InGaAs / InAlAs APD должно соответствовать этим правилам. Гарантия V pt (сквозное напряжение)
На рисунках 4 и 5 представлены смоделированные полевольтные характеристики в слое умножения и поглощения в режиме Гейгера соответственно. APD, работающие в режиме Гейгера, поскольку SPAD применяются с обратным смещением, которое превышает напряжение пробоя на 1 ~ 6 В при моделировании. Толщина слоя заряда ( Вт заряд ) составляет 50 нм, а толщина умножающего слоя ( W умножение ) составляют 100, 200 и 300 нм соответственно.
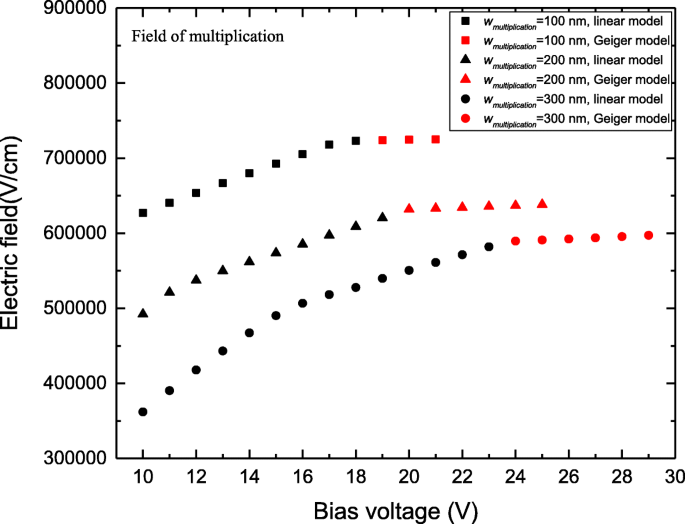
Моделирование приводит к умножению электрического поля в режиме Гейгера. Значения W умножение составляет 100 нм (черный квадрат), 200 нм (черный треугольник), 300 нм (черный кружок). На рис. 3 представлены смоделированные полевольтные характеристики в слоях умножения в режиме Гейгера. Толщина зарядового слоя составляет 50 нм, а толщина слоя умножения составляет 100, 200 и 300 нм соответственно
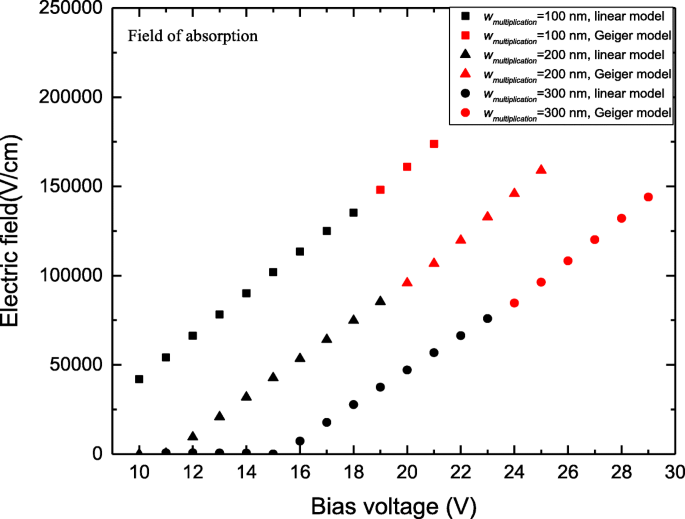
Моделирование приводит к поглощению электрического поля в режиме Гейгера. Значения W умножение составляет 100 нм (черный квадрат), 200 нм (черный треугольник), 300 нм (черный кружок). На рис. 4 представлены результаты моделирования полевольтных характеристик в абсорбционных слоях в режиме Гейгера. Толщина зарядового слоя составляет 50 нм, а толщина слоя умножения составляет 100, 200 и 300 нм соответственно.
Когда InGaAs / InAlAs SPAD работают в соответствии с линейной моделью (APD), электрическое поле в поглощающем слое и слое умножения линейно увеличивается с увеличением напряжения смещения. Однако, когда напряжение смещения превышает напряжение пробоя в режиме Гейгера, электрическое поле в поглощающем слое, как и прежде, линейно увеличивается, тогда как нарастание лавинного электрического поля в умножающем слое замедляется. По сравнению с InGaAs / InAlAs APD, работающими в линейном режиме, InGaAs / InAlAs SPAD обеспечивают высокий коэффициент усиления в слое умножения с более высоким лавинным полем, а одиночный фотон может инициировать макроскопический импульс тока. При этом поле поглощения в моде Гейгера больше, чем в линейной модели. Туннельный ток становится доминирующим компонентом темнового тока в сильном поле, и одиночный фотон может вызвать макроскопический импульс тока с лавинным усилением, которое намного больше, чем в линейном режиме.
Рассмотрение дизайна SPAD
Мы знаем, что SAPD работают в насыщенном режиме. Для поддержания высокого усиления и небольшого темнового тока важен контроль электрического поля в слоях умножения и поглощения. Если поле поглощения меньше, чем поле порога туннелирования, оно может поддерживать высокое лавинное электрическое поле в слое умножения и избегать туннельного тока. Следовательно, концентрация и толщина каждого слоя должны быть правильно рассчитаны для SPAD.
Рисунок 2 показывает, что SPAD имеют вероятность большого туннельного эффекта из-за высокого поля в слоях умножения и поглощения, которые превышают пороговое электрическое поле туннелирования. Таким образом, электрические поля должны быть настроены ниже порогового значения туннелирования как для поглощения InGaAs, так и для умножения InAlAs. Теоретический анализ показывает, что лавинное электрическое поле умножения уменьшается за счет произведения N заряд и w заряд [28]. Таким образом, зарядовый слой может управлять полем поглощения; однако лавинное электрическое поле слоя умножения определяется как w умножение . На рис. 6 представлены смоделированные полевольтные характеристики для различной толщины умножения (100–500 нм) при лавинном пробое устройства. Фоновое легирование в умножающем и поглощающем слое составляет 2 × 10 15 см −3 , которая является собственной концентрацией молекулярно-лучевой эпитаксии (МБЭ). Результаты моделирования показывают, что лавинное электрическое поле в слое умножения уменьшается с увеличением толщины слоя умножения. Таким образом, толстый слой умножения может избежать вероятности туннельного эффекта из-за низкого лавинного электрического поля при умножении.

Электрическое поле в слое умножения с разными W умножение . На рис. 5 представлены смоделированные полевольтные характеристики для различной толщины умножения (100–500 нм) при лавинном пробое устройства
Чтобы избежать лавинного электрического поля при умножении, превышающего пороговое значение туннелирования в режиме Гейгера, толщина умножения должна быть> 300 нм, что дает лавинное электрическое поле менее 6 × 10 5 В / см и даже превышает напряжение пробоя на рис. 4. Таким образом, толстый слой умножения может избежать туннельного эффекта в SPAD, который находится в режиме Гейгера. Это причина низкого DCR в SPAD с толстым умножением.
Как упоминалось в разделе А, электрическое поле в поглощающем слое линейно возрастает в режиме Гейгера. Увеличение напряжения смещения существенно влияет на электрическое поле в поглощающем слое, что индуцирует поле с большой вероятностью, превышающей 2,0 × 10 5 В / см. На рисунке 7 представлено смоделированное распределение электрического поля для различных концентраций легирования в зарядовом слое ( w заряд =50 нм). Мы обнаружили, что более высокие концентрации легирования имеют низкое электрическое поле в поглощающем слое и даже превышают напряжение пробоя 5 В в режиме Гейгера; однако при более низких концентрациях легирования быстро достигается туннельное пороговое электрическое поле. Следовательно, меньшие концентрации легирования в зарядовом слое вызывают более раннее возникновение туннельных эффектов. Чтобы получить достаточное рабочее напряжение смещения в режиме Гейгера, N заряд SPAD больше, чем N заряд APD. По сравнению с нижним N заряд SPAD, тем выше N заряд SPAD могут работать при большом напряжении смещения, чтобы избежать эффекта туннелирования и добиться высокого усиления в слое умножения.
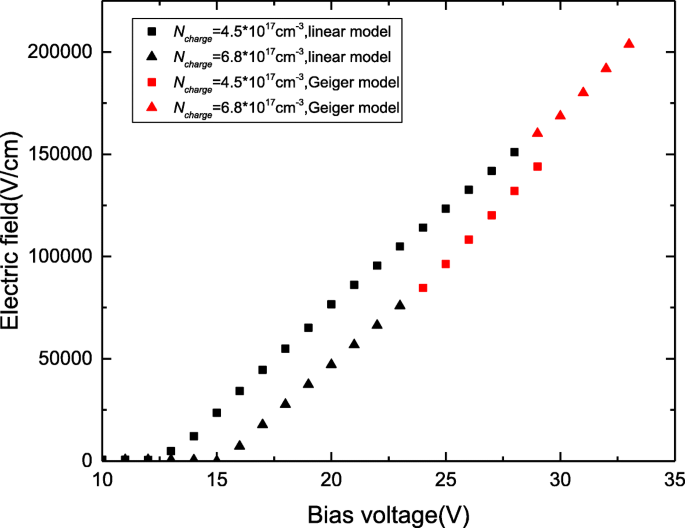
Поле в поглощающем слое с разными N заряд . Значения N заряд составляет 4,5 * 10 17 см - 3 (черный квадрат), 6,8 * 10 17 см −3 (черный треугольник). На рисунке 6 представлено распределение поглощения электрического поля для различных концентраций легирования в зарядовом слое ( W заряд =50 нм)
Выводы
Мы изучаем распределение электрического поля и туннельный эффект InGaAs / InAlAs APD и SPAD с помощью теоретического анализа и моделирования. Когда InGaAs / InAlAs SPAD работают в режиме Гейгера, электрическое поле в поглощающем слое увеличивается линейно и отклоняется вниз от своих линейных соотношений. Учитывая пороговое электрическое поле туннелирования в умножающем слое, толщина умножающего слоя должна быть больше 300 нм. Более того, SPAD могут работать при большом напряжении смещения, чтобы избежать туннелирования в поглощающем слое с высокими концентрациями легирования в заряженном слое.
Сокращения
- 2D:
-
Двумерный
- APD:
-
Лавинный фотодиод
- DCR:
-
Скорость темнового счета
- SAGCMAPD:
-
Отдельные лавинные фотодиоды с поглощением, градуировкой, зарядом и умножением
- SPAD:
-
Однофотонный лавинный фотодиод
- SPDE:
-
Эффективность регистрации одиночных фотонов
Наноматериалы
- Параметры анализа
- Анализ организации актина и фокальной адгезии в клетках U2OS на полимерных наноструктурах
- Анализ инфракрасного отражения эпитаксиальных легированных слоев GaN n-типа, выращенных на сапфире
- Яркий однофотонный источник на 1,3 мкм на основе двухслойной квантовой точки InAs в Micropillar
- Теоретическое исследование двухосно-деформированных германиевых нанопроволок
- Анализ рамановского картирования кремниевых микрокольцевых резонаторов, интегрированных в графен
- Производство спиральных нановолокон из CA / TPU и анализ их механизма
- Межзонная фотопроводимость метаморфных квантовых точек InAs / InGaAs в окне 1,3–1,55 мкм
- Теоретические исследования InGaAs / InAlAs SAGCM лавинные фотодиоды
- Теоретическое моделирование радиационного отклика сверхрешетки Si, Ge и Si / Ge на низкоэнергетическое облучение…



