Зависимость толщины от межфазных и электрических свойств в атомарном слое, нанесенном на GaN c-плоскости
Аннотация
Исследованы межфазные и электрические свойства атомного слоя, осажденного AlN на n-GaN с различной толщиной AlN. По емкости – напряжению ( C - V ) по характеристикам образец с AlN толщиной 7,4 нм показал наибольшую плотность границы раздела и оксидных ловушек. Когда толщина AlN составляла 0,7 нм, спектры рентгеновской фотоэлектронной спектроскопии (XPS) показали доминирующий пик, связанный со связями Al – O, наряду с отсутствием четкого пика AlN. Было обнаружено, что количество оставшихся атомов кислорода у поверхности GaN уменьшается для более толстого AlN. Однако многие атомы кислорода присутствовали в слое AlN, создавая связанные с кислородом дефекты, которые в конечном итоге увеличивали плотность состояний интерфейса. Неоднородность барьера с моделью термоэлектронной эмиссии (TE) была подходящей для объяснения прямого тока смещения для образца с AlN толщиной 7,4 нм, что не подходило для образца с толщиной AlN 0,7 нм. Обратные токи утечки для обоих образцов с толщиной AlN 0,7 и 7,4 нм были лучше объяснены с использованием излучения Фаулера-Нордхейма (FN), а не излучения Пула-Френкеля.
Фон
Из-за большой ширины запрещенной зоны, высокой скорости насыщения электронов и высокого поля пробоя материалы III-нитрида представляют большой интерес не только для оптоэлектронных устройств, таких как синие светоизлучающие диоды (LED), лазерные диоды (LD) и УФ-детекторы, но и для УФ-детекторов. электронные устройства, такие как транзисторы с высокой подвижностью электронов (HEMT) и силовые устройства [1,2,3,4]. Для реализации высокопроизводительных устройств на основе GaN требуется интерфейс металл / GaN с минимальной плотностью состояний интерфейса, который может действовать как ловушки электронов или ограничивать модуляцию высоты барьера в соответствии с работой выхода металла путем закрепления уровня Ферми [5, 6]. Для других методов усовершенствования устройств на основе GaN, некоторые методы, такие как зарастание коалесценции наноколонок GaN, неполярные m -плоскостной GaN, наноимпринт-шаблон GaN и полуполярные граневые наностержни GaN [7,8,9,10,11]. Среди полупроводников на основе соединений III-нитрида нитрид алюминия (AlN) может применяться в УФ-детекторах, коротковолновых излучателях и детекторах благодаря большой ширине запрещенной зоны (∼ 6,2 эВ), высокой теплопроводности, высокому электрическому сопротивлению, а также низкому расширению. при высоких температурах [12, 13]. Кроме того, AlN может быть осажден в процессе, совместимом с дополнительным металл-оксид-полупроводник (CMOS), путем осаждения атомных слоев (ALD) (~ 300 ° C), что является большим преимуществом. Поликристаллические и аморфные пленки AlN, выращенные методом ALD, могут быть использованы в качестве диэлектрического слоя для устройств микроэлектроники [14]. Несмотря на прогресс в технологиях выращивания AlN, выращенный методом ALD AlN все еще демонстрирует нестехиометрические свойства, поскольку он содержит большое количество примесей, связанных с кислородом [15]. Количество атомов кислорода в AlN может сильно влиять на электрические и оптические свойства AlN [16].
Высокий- k диэлектрические оксиды, такие как Al 2 О 3 и HfO 2 были использованы в качестве пассивирующего слоя в транзисторах с высокой подвижностью электронов (HEMT) AlGaN / GaN [17, 18]. Но образование связей Ga – O в Al 2 О 3 Интерфейс / (Al) GaN, как известно, создает высокую плотность глубоких (и медленных) интерфейсных состояний [19]. В качестве альтернативного пассивирующего материала с низкими интерфейсными состояниями AlN рассматривался для устройств на основе GaN из-за его меньшего несоответствия кристаллической решетки GaN [20, 21]. Кроме того, в GaN сообщалось о модуляции электрических свойств, таких как высота барьера в контактах металл / полупроводник (МС), путем введения очень тонкого оксидного слоя [22, 23]. Увеличение высоты барьера в Pt / HfO 2 / GaN диоды металл-диэлектрик-полупроводник (МДП) с HfO 2 толщиной 5 нм сообщалось [22]. Установлено, что введение слоя MgO толщиной 3 нм на границу раздела Fe / GaN снижает эффективную высоту барьера до 0,4 эВ [23]. Однако до сих пор существует ограниченное количество работ, в которых сообщается о технических свойствах контактов с AlN, выращенным методом ALD, на GaN. В этой работе мы наносили слои AlN на n-GaN методом ALD с различной толщиной и исследовали свойства интерфейса AlN / n-GaN.
Методы
Материалы и изготовление устройств
Гидридная парофазная эпитаксия (HVPE) - выращенная, нелегированная, c -плоскость (0001) насыпной GaN (толщина 300 мкм, концентрация носителей 5 × 10 14 см −3 , плотность продвигаемых дислокаций 1,5 × 10 7 см −2 ), приобретенный у Lumilog. После разрезания пластины на мелкие кусочки некоторые из них были загружены в камеру ALD после процесса очистки в HCl:H 2 Раствор O (1:1). Затем температура была увеличена до 350 ° C для нанесения слоя AlN. Тонкие пленки AlN были нанесены с помощью термической системы ALD (производитель:CN-1 в Корее; модель:Atomic Classic) с использованием триметилалюминия (ТМА) и NH 3 в качестве предшественников. Были приготовлены три слоя AlN различной толщины (0,7, 1,5 и 7,4 нм), варьируя количество циклов ALD. Толщину пленки AlN измеряли с помощью многоволновых эллипсометров FS-1 (производитель:Film Sense в США; модель:FS-1). Для исследования электрических характеристик пленок были изготовлены МДП-диоды с платиновым электродом Шоттки (диаметр 500 мкм, толщина 50 нм) и задним контактом из алюминия (толщина 100 нм). Для справки также были изготовлены диоды Шоттки Pt / n-GaN (то есть без слоя AlN).
Характеристика
Температурно-зависимый ток – напряжение ( I - V - Т ) измерения проводились с помощью анализатора параметров полупроводников HP 4155B после помещения образцов на горячий патрон, соединенный с регулятором температуры, и емкость – напряжение ( C - V ) измерения проводились с помощью измерителя HP 4284A LCR. Измерения рентгеновской фотоэлектронной спектроскопии (XPS) проводились с использованием монохроматического Al Κα Источник рентгеновского излучения для наблюдения за механизмом образования на границе раздела AlN / GaN.
Результаты и обсуждение
На рис. 1a – c показаны изображения поперечного сечения, полученные с помощью сканирующей просвечивающей электронной микроскопии (STEM), вокруг слоя AlN. Расчетные толщины слоев AlN были аналогичны значениям, полученным на эллипсометре. Типичная полулогарифмическая плотность тока – напряжение ( Дж - V ) кривые показаны на рис. 2а. По сравнению с образцом без AlN (то есть эталонным образцом) значения тока увеличились для образца с толщиной AlN 0,7 нм и уменьшились для образцов с толщиной AlN 1,5 и 7,4 нм. Используя модель термоэлектронной эмиссии (TE) [24], был проанализирован перенос тока прямого смещения диода Шоттки, чтобы получить как высоту барьера, так и коэффициент идеальности. Рассчитанные высоты барьера составили 0,77 (± 0,03), 0,61 (± 0,01), 0,83 (± 0,05) и 1,00 (± 0,08) эВ для образцов с 0-, 0,7-, 1,5- и 7,4-нм. толщиной AlN соответственно. Коэффициенты идеальности составили 1,63 (± 0,18), 4,19 (± 0,16), 1,83 (± 0,33) и 1,57 (± 0,03) для образцов толщиной 0, 0,7, 1,5 и 7,4 нм. AlN соответственно. При толщине AlN 0,7 нм высота барьера уменьшалась, а коэффициент идеальности увеличивался. Для более толстых слоев AlN коэффициент идеальности был аналогичным, но высота барьера увеличивалась по сравнению с эталонным образцом. На рис. 2в видно, что с увеличением толщины AlN высота барьера сначала уменьшалась, а затем увеличивалась из-за туннельного сопротивления, вызванного толстым слоем AlN. Это указывает на то, что около 0,7 нм является поворотной точкой для высоты барьера с точки зрения толщины AlN.
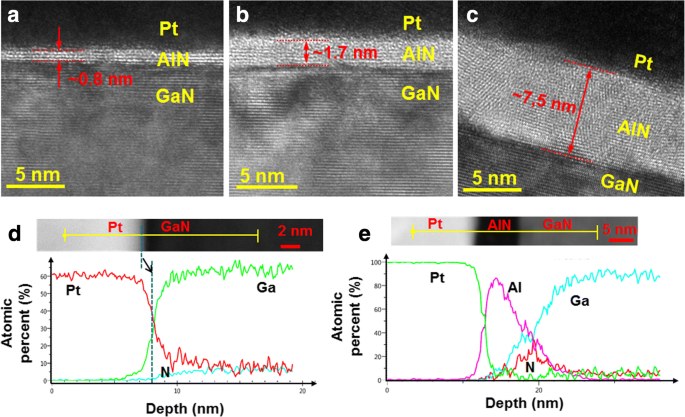
Изображения поперечного сечения с помощью сканирующей просвечивающей электронной микроскопии (STEM) с a 0,7-, б 1.5- и c AlN толщиной 7,4 нм. г , e Профили атомного процента в зависимости от глубины, полученные при сканировании линий энергодисперсионной рентгеновской спектроскопии (EDS) для образцов с толщиной AlN 0 и 7,4 нм соответственно

а Типичный полулогарифмический ток – напряжение ( I - V ) характеристики. б Графики зависимости высоты барьера от коэффициента идеальности. c Высота барьеров и факторы идеальности в зависимости от толщины AlN
На рисунке 3 показан C - V кривые, измеренные на различных частотах. При толщинах AlN 0 и 0,7 нм инверсия значений емкости наблюдалась ниже 10 кГц. Вместо инверсии обычно наблюдается глубокое обеднение для материалов с широкой запрещенной зоной, таких как GaN, из-за низкой скорости генерации неосновных носителей заряда (дырок) [25, 26]. Как показано на рис. 3в, г, для более толстых слоев AlN такая инверсия не наблюдалась. Здесь следует отметить, что в переходе Au / GaN инверсии на низких частотах не наблюдалось. Используя нестационарную спектроскопию глубоких уровней (DLTS), Auret et al. наблюдались дефекты, индуцированные электронным пучком в переходах Шоттки Pt / n-GaN [27]. Здесь мы провели измерения энергодисперсионной рентгеновской спектроскопии (EDS), и профили глубины для образцов с толщиной AlN 0 и 7,4 нм показаны на рис. 1d, e, соответственно. На рис. 1г хорошо видно, что атомы Pt диффундируют в слой GaN, тогда как диффузия атомов Pt в слой GaN эффективно подавляется за счет слоя AlN. Следовательно, можно было бы предположить, что вызванные осаждением Pt дефекты вблизи поверхности GaN создавали инверсионную емкость на низких частотах, и образование этих дефектов подавлялось относительно толстым слоем AlN (> 1,5 нм).> 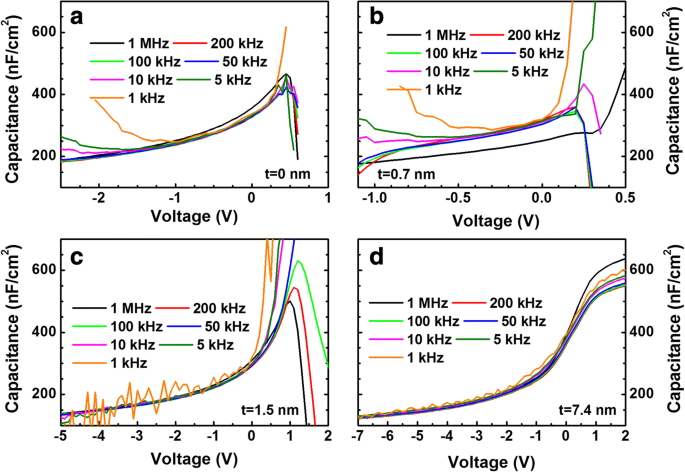
Емкость – напряжение ( C - V ) данные, измеренные на различных частотах для образцов с a 0-, b 0,7-, c 1.5- и d AlN толщиной 7,4 нм
За исключением образца с толщиной AlN 7,4, все другие образцы показали аномальный пик в C - V кривая с увеличением напряжения смещения, связанная с распределением глубоких ловушек в промежутке, последовательным сопротивлением и интерфейсными состояниями [28, 29]. Частотная дисперсия в области накопления связана с образованием неоднородного слоя на границе раздела. Емкость такого слоя действует последовательно с емкостью оксида, вызывая дисперсию накопления [30]. Дисперсия обеднения обусловлена наличием состояний интерфейса, реагирующих на приложенную частоту. Если постоянные времени состояний интерфейса сравнимы с частотой слабого сигнала, состояния интерфейса вносят вклад в общую емкость, так что пороговая емкость увеличивается с уменьшением частоты [31].
На рисунке 4 показаны зависимости проводимости от напряжения ( G / ω - V ) кривые, измеренные на различных частотах. При достаточно высоких прямых и обратных смещениях активированные дефекты могут более эффективно взаимодействовать с соседними состояниями границы раздела на низких частотах и, следовательно, увеличивать проводимость. Примерно в диапазоне - 1 и 0 В все образцы показали рост проводимости с увеличением частоты. Это поведение стало более заметным для образца с толщиной AlN 7,4 нм. Увеличение проводимости с увеличением частоты было связано с центрами рекомбинации, способствующими рекомбинационному току в области обеднения, и состояниями интерфейса, обеспечивающими ток заряда и разряда, или процессом прыжковой проводимости, происходящим на высокой частоте [32]. Таким образом, результаты показывают, что состояния интерфейса с различными постоянными времени присутствуют для всех образцов, и наличие таких дефектов является наиболее значимым для образца с AlN толщиной 7,4 нм.
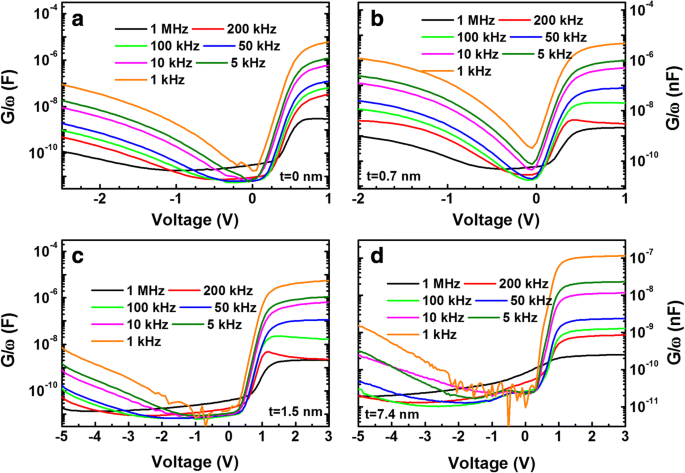
Проводимость – напряжение ( G / ω - V ) данные, измеренные на различных частотах для образцов с a 0-, b 0,7-, c 1.5- и d AlN толщиной 7,4 нм
Как показано на рис. 5a, оценка плотности состояний интерфейса ( D это ) был получен путем применения метода Термана к экспериментальному C – V кривые, измеренные на частоте 1 МГц [33]. Полученные D это по сравнению с E C - E t (расположение состояния интерфейса) представлено на рис. 5б. Здесь мы не анализировали C – V кривая для образца с AlN толщиной 0,7 нм, потому что образец был негерметичным и точная оксидная емкость ( C OX ) не был определен хорошо. Образец с AlN толщиной 7,4 нм показал самую высокую плотность состояний интерфейса, особенно для E C - E t > 0,4 эВ. Кроме того, средняя граница раздела и плотность ловушек оксидов ( Q T ) вдоль запрещенной зоны GaN ( E g ) были рассчитаны путем анализа C - V графики гистерезиса с использованием плоского сдвига напряжения (Δ V FB ) через уравнение Q T =( C OX Δ V FB ) / qE g [34]. Небольшой сдвиг напряжения в плоской полосе и небольшое окно гистерезиса указывают на низкую плотность ловушек. На вставке к рис. 4b показан C - V графики гистерезиса. Плотность захваченного заряда составила 4,2 × 10 9 . , 9,3 × 10 9 , и 3,6 × 10 11 см −2 эВ −1 для образцов с толщиной AlN 0, 1.5 и 7.4 нм соответственно. Гистерезис может возникать из-за пограничных ловушек AlN / GaN и пограничных (или объемных) ловушек в слое AlN. Как и в методе Термана, слой AlN толщиной 7,4 нм показал самую высокую границу раздела и плотность оксидных ловушек. Таким образом, в этом примере можно предположить, что граничные ловушки в слое AlN, а также межфазные ловушки внесли значительный вклад в сдвиг C - V участки.
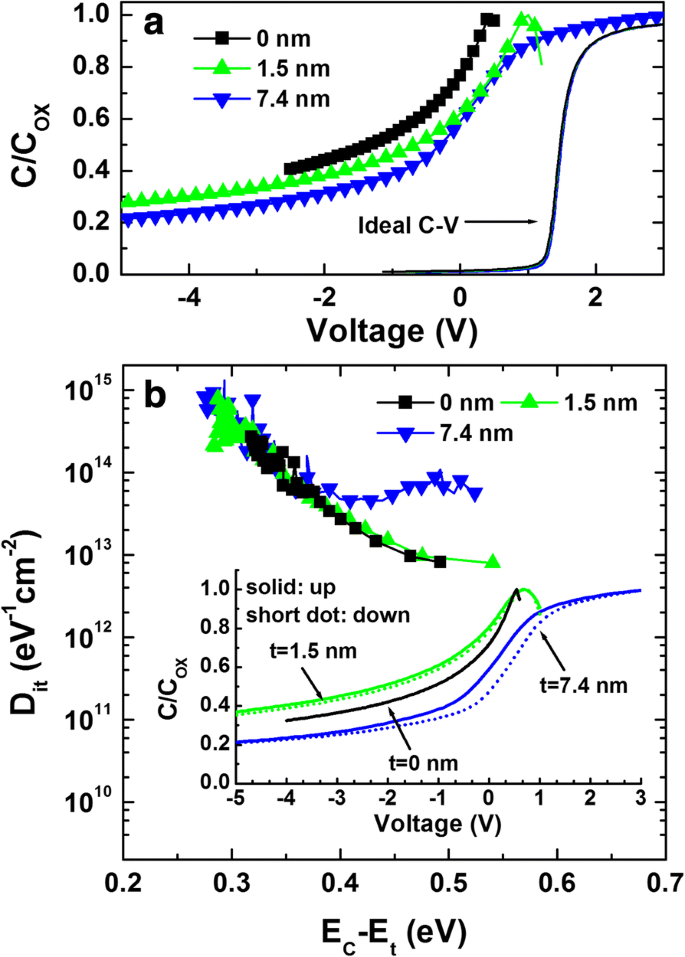
а Сравнение экспериментальной емкости-напряжения ( C - V ) данные, измеренные на частоте 1 МГц и идеальном C– V данные и b плотность состояний интерфейса ( D это ) распределения, определенные методом Термана для образцов со слоем AlN толщиной 0, 1,5 и 7,4 нм. Вставка в b показывает C - V графики гистерезиса, измеренные на частоте 1 МГц
Химический состав на границе AlN / GaN был исследован с помощью РФЭС-измерений для двух образцов с толщиной AlN 0,7 и 7,4 нм. Здесь обработка травлением распылением проводилась на образце с AlN толщиной 7,4 нм, поскольку толщина AlN была слишком большой для получения точной информации вблизи границы раздела AlN / InP. В качестве эталона также сканировали поверхность чистого GaN. На рис. 6а показаны профили глубины XPS для каждого элемента, полученные из образца с AlN толщиной 7,4 нм. Отчетливо видна диффузия атомов Ga в слой AlN. Было обнаружено, что через слой AlN присутствует довольно большое количество атомов кислорода. Однако атомы O и Al не наблюдались вблизи границы AlN / GaN. Более высокое количество кислорода у поверхности AlN по сравнению с границей раздела AlN / GaN указывает на то, что значительная его часть возникла в результате атмосферного окисления, а не самого процесса осаждения методом ALD. Затем мы выбрали узкие сканированные XPS-спектры на одной глубине травления (толщина оставшегося AlN составляла около 1,5–2,0 нм) и сравнили их с данными для других образцов. На рисунке 6b показан Ga 2 p 3/2 спектры на уровне ядра. Пики при ~ 1118,0 эВ и ~ 1119,2 эВ как для чистого GaN, так и для образца с AlN толщиной 0,7 нм связаны с GaN и Ga 2 О 3 соответственно [35, 36]. Пик при ~ 1117,4 эВ для образца с AlN толщиной 7,4 нм обусловлен связью Ga с AlN [37]. Однако мы не можем исключить возможность того, что это может быть Ga 2 Пик O (~ 1117,3 эВ) [38].

а Профили глубины XPS для каждого элемента, полученные из образца с AlN толщиной 7,4 нм. XPS-спектры на уровне ядра b Ga 3 p 3/2, c O 1 с , и d Al 2 p для образцов с толщиной AlN 0, 1,5 и 7,4 нм
Как показано на рис. 6в, пики при ~ 530,2 и ~ 531,9 эВ относятся к хемосорбированным O и Ga 2 О 3 соответственно [39]. Кроме того, пик при ~ 532,8 эВ связан с Al – OH [40]. Однако для образца с толщиной AlN 7,4 нм на выбранной глубине не наблюдалось своеобразного пика. Точно так же не наблюдалось пика на более глубоких глубинах травления (не показано). Когда толщина AlN мала (0,7 нм), хемосорбированные атомы кислорода удалялись, но атомы Al были связаны с ОН. При увеличении толщины AlN очень мало атомов кислорода присутствовало вблизи области поверхности GaN, что указывает на эффект очистки. Однако большое количество атомов кислорода присутствовало в заросшей области AlN, что обеспечивало заряд оксида. O 1 с В спектрах остовного уровня на глубинах травления, где количество атомов Ga незначительно (около 0 ~ 3 нм от поверхности AlN на рис. 6а), обнаружен доминирующий пик при ~ 531,8 эВ, связанный с Al 2. О 3 [41]. Это означает, что некоторая часть слоя AlN состоит из Al 2 . О 3 . Как показано на рис. 6d, пик, связанный с AlN, плохо наблюдается для образца с толщиной AlN 0,7 нм. Скорее, наблюдаются два пика при ~ 74,1 и ~ 75,6 эВ, связанные с AlO x и Al – OH соответственно [42]. Эти связанные со связью Al – O пики, такие как AlO x и Al – OH могут действовать как дефекты. Пик при ~ 73,6 эВ для образца с AlN толщиной 7,4 нм связан с AlN [43].
Свойства переноса тока для образцов с толщиной 0,7 и 7,4 нм были исследованы с использованием зависимости тока от температуры ( I - V - Т ) измерения. Как показано на рис. 7, как прямой, так и обратный ток смещения увеличиваются в одинаковой степени для образца толщиной 0,7 нм. Однако для образца с толщиной AlN 7,4 нм обратные токи утечки больше зависели от температуры, чем прямые токи. При обратном смещении более высокая температура могла вызвать тепловую эмиссию дырок с глубоких уровней в валентную зону AlN и, таким образом, привела к дополнительному притоку электронов [44]. Согласно модели неоднородного барьера [24], эффективная высота барьера, зависящая от температуры ( φ B ) связана со средней высотой барьера с нулевым смещением (\ ({\ overline {\ varphi}} _ B \)) и стандартным отклонением ( σ 0 ) как \ ({\ varphi} _B ={\ overline {\ varphi}} _ B-q {\ sigma_0} ^ 2/2 kT \). σ 0 Были получены значения 0,147 и 0,204 В для образцов с толщиной AlN 0,7 и 7,4 нм соответственно. Используя эти значения, модифицированные графики Ричардсона ln ( I 0 / Т 2 ) - q 2 σ 0 2 / 2 к 2 Т 2 по сравнению с 1 / kT были получены, показанные на рис. 8а. Перехваты по ординате дали константы Ричардсона A ** как 397,3 и 27,1 А · см −2 К −2 для образцов с толщиной AlN 0,7 и 7,4 нм соответственно. Значение для образца с AlN толщиной 7,4 нм аналогично теоретическому значению 26,4 А · см −2 . К −2 для n-GaN, что указывает на то, что неоднородность барьера с TE-моделью может объяснить перенос тока. Однако для образца с толщиной AlN 0,7 нм это значение слишком велико по сравнению с теоретическим значением, указывая на то, что модель TE даже с учетом неоднородности барьера не может объяснить перенос тока. На рисунке 8b показаны значения nkT . как функция от kT . Прямая с наклоном 1,15 хорошо согласуется с экспериментальными данными для образца с AlN толщиной 7,4 нм с использованием модели TE. Однако для образца с толщиной AlN 0,7 нм наклон оказался равным 5,11. Такое большое отклонение от единицы может возникать из-за состояний интерфейса, слоя изолятора и туннельного тока.
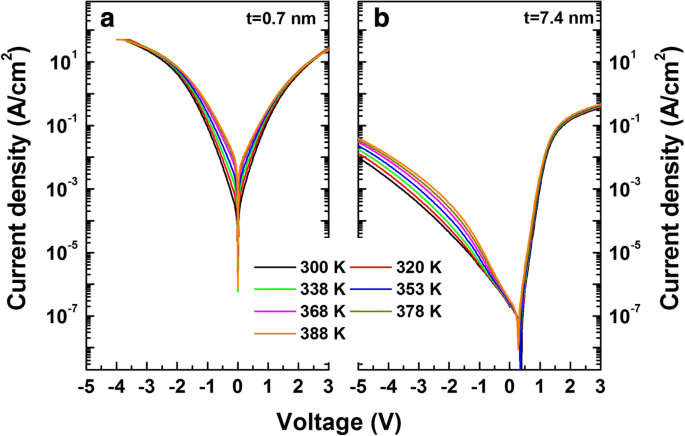
Температурно-зависимая плотность тока – напряжение ( Дж - V ) характеристики для образцов с a 0,7- и b AlN толщиной 7,4 нм
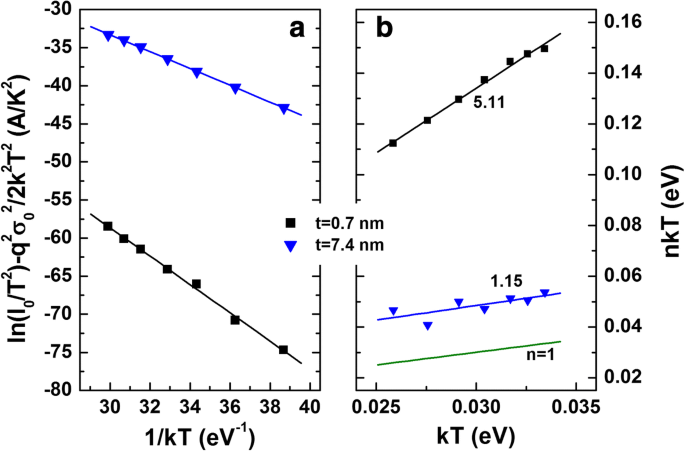
а Измененные графики Ричардсона и b nkT по сравнению с kT графики с линейной аппроксимацией экспериментальных данных. В б , линия с наклоном 1 ( n =1) также был включен в качестве справки
Плотность обратного тока утечки анализировалась с использованием туннельной модели Фаулера – Нордхейма (FN), приведенной в [45].
$$ J =\ alpha {E} ^ 2 \ exp \ left (- \ beta / E \ right) $$ (1)где α =1,54 × 10 −6 / м ∗ Φ B и β =6,83 × 10 −7 ( м ∗ ) 1/2 (Φ B ) 3/2 ; м * ( м * =0,30 для AlN [46]) - эффективная масса электрона в изоляторе, а Φ B - высота туннельного барьера. На рис. 9а, б видно, что эмиссия FN наблюдалась для образцов с толщиной AlN 0,7 и 7,4 нм, когда напряжения смещения превышали –0,9 В и –3 В соответственно. Более высокое напряжение для образца с AlN толщиной 7,4 нм связано с тем, что для более толстого AlN требуется более высокое туннельное напряжение. По наклону, показанному на рис. 9, были определены высоты туннельного барьера для каждой температуры, которые представлены на вставке на рис. 9b. При комнатной температуре высота барьера для образцов с толщиной AlN 0,7 и 7,4 нм составила около 1,67 и 0,78 эВ соответственно. Эти значения ниже, чем сообщаемый сдвиг зоны проводимости 2,58 эВ на границе AlN / GaN [47]. Плохое качество поверхности раздела вблизи границы AlN / GaN может дать такие более низкие значения. Более низкая высота барьера для образца с толщиной AlN 7,4 нм также может быть связана с высокой границей раздела и плотностью захвата оксидов вблизи границы раздела AlN / GaN и связанными с кислородом дефектами в слое AlN. В результате туннелирование с помощью ловушек происходит легче и увеличивается обратный ток утечки.
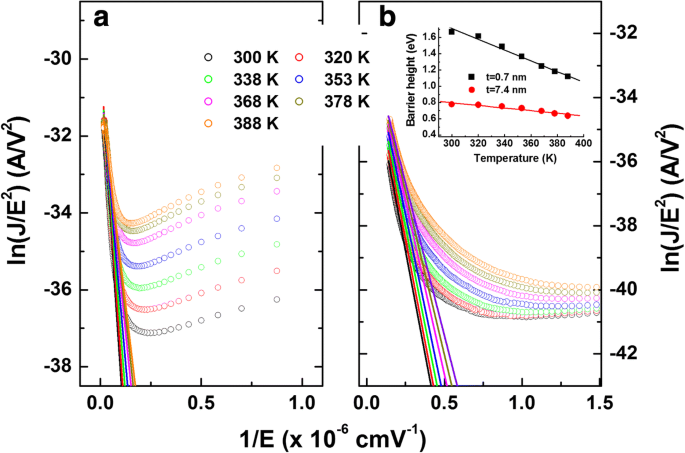
Графики туннелирования Фаулера – Нордхейма (FN) ln ( J / E 2 ) против 1 / E с линейной аппроксимацией экспериментальных данных для образцов с a 0,7- и b AlN толщиной 7,4 нм. Вставка в b представляет рассчитанную высоту барьера как функцию температуры
Модель эмиссии Пула – Френкеля (PF) также была применена к обратному току утечки, приведенному в [48].
$$ \ ln \ left (J / E \ right) =m (T) {E} ^ {1/2} + b (T) \ Big) $$ (2)с
$$ m (T) =\ frac {q} {kT} \ sqrt {\ frac {q} {{\ pi \ varepsilon} _0 {\ varepsilon} _ {\ mathrm {AlN}}}}, b (T) =- \ frac {q {\ varphi} _t} {kT} + \ ln C $$ (3)где ϕ t - высота барьера эмиссии электронов из состояний ловушки, ε AlN относительная диэлектрическая проницаемость изолятора затвора на высокой частоте ( ε AlN 4.77 [49]), ε 0 - диэлектрическая проницаемость свободного пространства, а C является константой. Правильность подгонки выбросов ПФ была подтверждена проверкой температурной зависимости линейного коэффициента m ( Т ), полученные из линейной аппроксимации графиков PF ln ( J / E ) как функция от E 1/2 [50], что показано на рис. 10. От м ( Т ) значения, полученные в результате линейной аппроксимации этих графиков (вставка на рис. 10a), ε AlN для образцов с толщиной AlN 0,7 и 7,4 нм оказалось равным 64,9 и 959,0 соответственно. Полученные значения слишком высоки по сравнению с теоретическим значением 4,77, что указывает на то, что излучение PF не может правильно объяснить перенос тока для обоих образцов. Следовательно, туннелирование FN является более подходящим транспортным механизмом при обратном токе утечки.
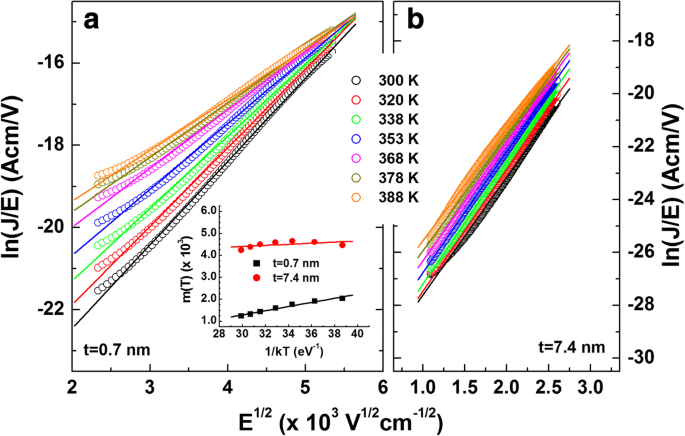
Графики выбросов Пула – Френкеля (PF) для ln ( Дж / E ) против E 1/2 / с линейной аппроксимацией экспериментальных данных для образца с a 0,7- и b AlN толщиной 7,4 нм. Вставка в a представляет расчетные м ( Т ) значения в зависимости от температуры
Хотя уравнение. (1) не содержит температурной зависимости, полученные высоты барьеров уменьшались с увеличением температуры. Наклоны были получены как –6,67 мэВ / К и –1,62 мэВ / К для образцов с толщиной AlN 0,7 и 7,4 нм соответственно. В структуре SiO2 / 4H-SiC сообщалось, что туннелирование FN имеет температурную зависимость с крутизной - 7,6 мэВ / К [51]. Выброшенные электроны из Pt электрода следовали распределению Ферми – Дирака [52], и, таким образом, обратный ток утечки при туннелировании также мог увеличиваться с температурой. В этом случае повышение температуры будет больше для более тонкого слоя AlN.
Между тем, сообщалось, что механизмы переноса тока в сильном электрическом поле нельзя объяснить только туннелированием FN [53, 54]. Даже с учетом изменений зарядов в оксиде и уровне Ферми подложки, а также распределения электронов по энергиям на SiO 2 / SiC с температурой, обратный ток утечки в SiO 2 / 4H-SiC не получил удовлетворительного объяснения [53]. Было высказано предположение, что термоактивированная PF-эмиссия захваченных электронов из межфазных электронных ловушек вносит значительный вклад в увеличение тока утечки [54]. Следовательно, уменьшение таких дефектов в AlN во время процесса ALD имеет решающее значение для производительности устройств на основе AlN / GaN, особенно во время высокотемпературной работы.
Как видно из графика зависимости высоты барьера от толщины AlN на рис. 2c, Li et al. наблюдали аналогичное поведение в контактах металл / n-Ge с Y 2 О 3 слои [55]. Они объяснили уменьшение высоты барьера подавлением нестабильного GeO x рост и пассивация оборванных связей на поверхности Ge. Карпов и др. вставлен Si 3 N 4 в контакты Ni / n-GaN и обнаружили, что высота барьера уменьшилась с 0,78 до 0,27–0,30 эВ с Si 3 N 4 слой. Результаты были объяснены образованием диполя на Si 3 N 4 / GaN-интерфейс [56]. Кроме того, Zheng et al. исследовали контактное сопротивление по сравнению с Al 2 О 3 толщины в структуре Al / n-SiC и обнаружили, что интерфейсный диполь начал формироваться при толщине 1,98 нм [57]. Выше этой толщины контактное сопротивление сначала уменьшалось из-за дипольного эффекта, а затем увеличивалось из-за увеличения туннельного сопротивления. Согласно данным РФЭС на рис. 6, образование слоя AlN неясно для образца с толщиной AlN 0,7 нм. Следовательно, уменьшение высоты барьера с AlN толщиной 0,7 нм более вероятно из-за эффекта пассивации, а не образования межфазного диполя.
Процесс сухого травления, такой как травление с индуктивно связанной плазмой (ICP), широко используется в устройствах на основе GaN из-за химической стабильности GaN [58], хотя было продемонстрировано влажное химическое травление с ультрафиолетовым излучением [59]. Однако процесс сухого травления может вызвать повреждение поверхности GaN, увеличивая ток утечки и ухудшая характеристики выпрямления. Было обнаружено, что обработка после травления с использованием термического отжига и раствора КОН после реактивного ионного травления (RIE) эффективно устраняет поверхностные повреждения GaN [60]. Принимая во внимание полученные на данный момент результаты, мы предполагаем, что осаждение AlN (более 1 нм) может быть применено для уменьшения повреждения на протравленной поверхности GaN, что, как ожидается, улучшит качество интерфейса и характеристики выпрямления.
Выводы
Мы исследовали межфазные и электрические свойства атомного слоя, нанесенного AlN на n-GaN с различной толщиной AlN. По емкости – напряжению ( C - V ) по характеристикам образец с AlN толщиной 7,4 нм показал максимальную границу раздела и плотность оксидных ловушек. Согласно измерениям рентгеновской фотоэлектронной спектроскопии (XPS), образец с толщиной AlN 0,7 нм показал доминирующий пик, связанный со связями Al – O, без четкого пика, связанного с AlN. Остаточных атомов кислорода вблизи поверхности GaN оказалось очень мало для образца с толщиной AlN 7,4 нм. С другой стороны, было обнаружено, что через слой AlN присутствует много атомов кислорода, которые обеспечивают связанные с кислородом дефекты в слое AlN. Анализ обратного тока утечки показал, что эмиссия Фаулера-Нордхейма (FN), а не Пула-Френкеля (PF) была более подходящей для объяснения переноса тока для образцов с AlN толщиной 0,7 и 7,4 нм.
Сокращения
- ALD:
-
Осаждение атомного слоя
- AlN:
-
Нитрид алюминия
- C - V :
-
Емкость – напряжение
- FN:
-
Фаулер – Нордхейм
- J - V :
-
Плотность тока – напряжение
- PF:
-
Пул – Френкель
- TE:
-
Термоэмиссия
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
Наноматериалы
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Межфазные, электрические характеристики и характеристики совмещения полос стопок HfO2 / Ge с прослойкой SiO2, сфор…
- Оптические и электрические характеристики кремниевых нанопроволок, полученных методом химического травлен…
- Иерархические антибактериальные полиамидные 6-ZnO нановолокна, полученные путем осаждения атомных слоев и гид…
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Фотокаталитические свойства порошков TiO2 с покрытием Co3O4, полученных методом плазменного осаждения атомного …
- Влияние толщины бислоя на морфологические, оптические и электрические свойства наноламинатов Al2O3 / ZnO
- Настройка морфологии поверхности и свойств пленок ZnO путем создания межфазного слоя
- Настройка уровня Ферми пленок ZnO посредством суперциклического осаждения атомного слоя
- Зависимость токсичности наночастиц от их физических и химических свойств



