Двухосный датчик деформации с одной решеткой из MoS2
Аннотация
В этой статье мы сообщаем о новом типе MoS 2 решетчатый датчик для плоских двухосных тензорезисторов с пределом точности ~ 1. MoS 2 Решетка численно моделируется с различными двухосными деформациями до 5%. Наши расчеты из первых принципов показывают, что чувствительность к деформации MoS 2 спектр отражения можно рассматривать как дополнительный датчик деформации, интегрированный в решетчатую структуру, позволяющий отображать двухосные деформации в плоскости. Наши экспериментальные исследования на прототипе MoS 2 -решеточный датчик дополнительно подтверждает, что компонент деформации, перпендикулярный периоду решетки, может вызывать сдвиги пиков интенсивности в дифракционных картинах первого порядка решетки. Эта работа открывает новый путь к измерению двухосной деформации в плоскости в устройстве с одной решеткой. Наш новый подход применим к другим материалам, которые обладают предсказуемой отражательной способностью при двухосной деформации и способностью образовывать двумерный монокристаллический слой.
Введение
Технология гибкой электроники привлекла широкое внимание академических и промышленных кругов, но разработка и применение гибких устройств микромасштаба и наномасштаба является сложной задачей из-за трудностей в динамическом смещении и мониторинге деформации [1,2,3,4,5]. Большинство традиционных методов обнаружения деформации, основанных на тензодатчиках сопротивления, требуют миниатюрной матрицы датчиков [4, 6, 7], которую сложно изготовить для гибких электронных приложений. Основанные на оптике методы двумерного (2D) обнаружения деформации, такие как спекл-интерферометрия, превосходят методы, основанные на пьезорезистивности, из-за их более высокой точности [8]. Однако их стратегия измерения корреляции изображений подвергается сомнению из-за требований сложной технологии обработки изображений [8,9,10]. Отражательная решетка может обеспечить высокое разрешение для измерения деформации, но ей не хватает возможности обнаруживать 2D деформацию в одном устройстве [11].
За последние годы 2D-материалы стали предметом огромных исследований. После введения графема [12, 13] семейство 2D-материалов было расширено многими новыми элементами, такими как двойной атомный тонкий черный фосфор [14], трехатомные тонкие дихалькогениды переходных металлов [15], четырехатомные тонкие группы-III. монохалькогениды металлов [16] и другие неслойные 2D-материалы [17]. У этих материалов было обнаружено много интересных свойств, что делает их предметом внимания материаловедения [18,19,20,21,22,23,24].
Дихалькогениды переходных металлов демонстрируют выдающиеся оптические и механические свойства [25,26,27]. Например, MoS 2 может выдерживать до 19,5% [26] двухосной деформации, сопровождающейся модуляцией его отражательной способности [28], и WSe 2 может показать заметный диполь кривизны Берри, а также нелинейный эффект Холла с помощью инженерии деформации [29]. Включение деформационной чувствительности спектра отражения материала в функцию устройства с отражающей решеткой может быть эффективным способом расширить измерения деформации до двухосного обнаружения в одном устройстве. Однако нет сообщений об использовании отражающих решеток в сочетании с модуляцией отражательной способности материала, вызванной деформацией, для 2D-датчиков деформации.
Здесь мы предлагаем новый тип метода измерения двухосной деформации в плоскости, включающий чувствительность к деформации MoS 2 коэффициент отражения в датчике с отражающей решеткой. Расчеты из первых принципов показывают, что двухосная деформация может сместить пик распределения интенсивности на дифрактограммах MoS 2 решетчатое устройство, поскольку коэффициент отражения MoS 2 чувствителен к деформации, вызванной деформацией. Этот нелинейный сдвиг пика хорошо демонстрируется добавлением члена второго порядка к линейному уравнению одноосной деформации, из которого можно извлечь компонент деформации, перпендикулярный направлению периода решетки, с пределом точности ~ 1 ‰. Наши экспериментальные исследования на прототипе MoS 2 -решетки подтверждают, что деформация, перпендикулярная периоду решетки, может вызвать сдвиг пика интенсивности дифракционной картины первого порядка. Наше исследование показывает возможность одноразовых плоских двухосных тензодатчиков с одним решетчатым датчиком.
Методы
Теоретические расчеты для MoS 2 Flake
MoS 2 все оптические отклики на деформацию изучаются с помощью расчетов из первых принципов, выполненных с помощью пакета моделирования Vienna Ab-initio (VASP) [30]. Для всех расчетов использовались потенциалы дополненной волны (PAW) полностью электронного проектора [31]. Геометрическая релаксация и статические расчеты проводились с использованием метода обобщенного градиентного приближения (GGA) Пердью-Берк-Эрнцерхофа (PBE) [32]. Спин-орбитальная связь (SOC) [33] также была включена в статические расчеты. Для определения оптических свойств энергии квазичастиц были впервые получены методом ГВ, выведенным из теории функций Грина [34]. Волновая функция, полученная из статических расчетов, и энергия квазичастиц из расчетов GW использовались для выполнения расчетов по уравнению Бете – Солпитера (BSE) [35] для предсказания диэлектрической проницаемости.
Модель объемного кристалла использовалась для представления MoS 2 хлопья (что различия в оптических свойствах между стопками, превышающими пять слоев, незначительны [36]). В расчетах оптимизации ограничение по энергии было установлено на 400 эВ, и набор k-точек Монкхорста – Пака, равный 15 * 15 * 4, использовался для выборки зоны Бриллюэна. Параметры решетки сначала были оптимизированы в качестве эталона для более поздних расчетов напряженного MoS 2 хлопья. Оптимизированные параметры решетки были a = b =3,18 Å и c =13,87 Å. Геометрия была ослаблена до тех пор, пока энергия не приблизилась к 10 –5 эВ. Используя метод из предыдущей литературы [37], ограничение по энергии 300 эВ и k В оптических расчетах использовался набор точек 6 × 6 × 2. Статическая энергия приблизилась к 10 –6 эВ во всех расчетах. Моделирование дифракционных картин проводилось на основе теоремы Гельмгольца – Кирхгофа [38]. Более подробная информация представлена в Дополнительном файле 1.
Подготовка MoS 2 Образец для измерения спектра
MoS 2 тонкая пленка была механически отслоена от коммерческого MoS 2 монокристалл (SPI Supplies) и переносится на подложку из полидиметилсилоксана (PDMS) с помощью ленты. После переноса на пластину и основу был нанесен еще один слой PDMS для улучшения адгезии.
Подготовка MoS 2 Решетка на гибком основании
MoS 2 тонкая пленка была механически отслоена от коммерческого MoS 2 монокристалл (SPI Supplies) и переносится на подложку из полидиметилсилоксана (PDMS) с помощью ленты. Для изготовления решетчатого устройства MoS 2 Из чешуек сначала была сформирована решетчатая структура с помощью электронно-лучевой литографии (EBL). Затем узорчатый образец травили кислородной плазмой мощностью 20 Вт. В итоге мы получили MoS 2 решетки на основе смыва ПММА.
MoS 2 Измерения устройства
В качестве возбуждающего лазера используется суперконтинуумный источник белого света (NKT Photonics SuperK Compact), который проходит через одну апертуру и попадает на чешуйчатый образец или решетчатый образец под определенным углом относительно плоскости образца, как показано на рис. 1. На рис. При измерении коэффициента отражения отраженный лазер собирается через оптоволокно, подключенное к спектрометру. Спектры отражения при различных деформациях рассчитываются по данным, измеренным спектрометром. Для тестирования MoS 2 На решетке отраженный лазер проецируется на белую доску и выглядит как длинное эллиптическое световое пятно. Фотографии светового пятна используются для анализа распределения интенсивности.
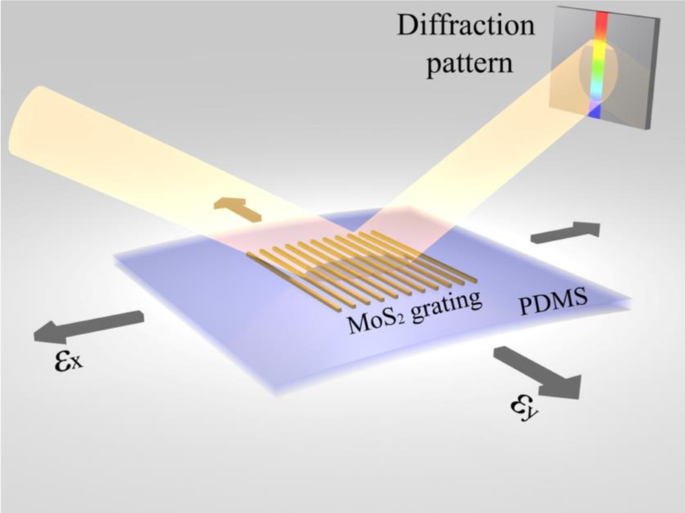
Схематическое изображение MoS 2 решетчатый датчик на гибкой подложке из ПДМС для двухосных тензодатчиков
Результаты и обсуждение
В обычном датчике с отражательной решеткой периодическая структура из параллельных полос решетки может дифрактировать свет, и дифракция используется для измерения деформации, которая идет вдоль направления периода решетки, путем отслеживания сдвига местоположения дифракционных картин [11]. Из-за периодической ориентации структуры функция измерения деформации отражательной решетки ограничена одноосным датчиком деформации в плоскости (параллельно периодическому направлению). Чтобы расширить функцию отражательной решетки для использования в плоских двухосных тензодатчиках, мы предлагаем, чтобы внутренние оптические свойства материала решетки, такие как чувствительность к деформации отражательной способности материала, можно было рассматривать как дополнительный датчик деформации для обнаружения в -плоские компоненты деформации, перпендикулярные периодическому направлению.
MoS 2 имеет слоистую структуру:слой атомов Mo, зажатый между двумя слоями атомов S. Взаимодействие между слоями представляет собой слабую силу Ван-дер-Ваальса. Здесь мы разрабатываем MoS 2 датчик на основе отражательной решетки (рис. 1) и исследование дифракционных картин устройства при различных двухосных деформациях в плоскости с помощью расчетов из первых принципов. Диапазон длин волн падающего пучка в нашем расчете составляет от 400 до 850 нм. Дифракционную решетку можно описать как:
$$ d \ left (\ mathrm {sin} {\ theta} _ {i} - \ mathrm {sin} {\ theta} _ {m} \ right) =n \ lambda $$ (1)где \ (d \) - расстояние между двумя соседними полосами решетки, \ ({\ theta} _ {i} \) - угол между падающим лучом и нормалью к решетке, \ ({\ theta} _ {m } \) - угол между дифракционным лучом и нормалью, когда дифракционный луч имеет максимумы, n - порядок дифракции, а \ (\ lambda \) - длина волны пучка [11]. Из уравнения. (1) мы видим, что падающие пучки с разными \ (\ lambda \) должны иметь разные \ ({\ theta} _ {m} \). Следовательно, пучок с непрерывной длиной волны вызывает непрерывную серию дифракционных пятен, соответствующих разным \ ({\ theta} _ {m} \), образуя эллиптическую дифракционную картину первого порядка.
На рис. 2а показано смоделированное изображение дифракционной картины решетчатого датчика в оригинальной конструкции без приложения деформации. На рис. 2b показана эволюция положения пика интенсивности и положения диаграммы смоделированной дифракционной картины первого порядка устройства при различных двухосных деформациях. Край дифракционной картины первого порядка, соответствующий падающему лучу с длиной волны 850 нм, помечен как «LW». Когда мы применяем одноосную деформацию растяжения в плоскости вдоль направления периода решетки (\ ({\ varepsilon} _ {x} \)), эта деформация может вызвать увеличение расстояния d между каждой полосой. В результате \ ({\ theta} _ {m} \) уменьшается, потому что \ (d \ mathrm {sin} {\ theta} _ {m} \) постоянно для любого заданного \ (\ lambda \) и фиксированного \ ({\ theta} _ {i} \). Поэтому, когда мы постепенно увеличиваем деформацию \ ({\ varepsilon} _ {x} \) от 0 до 4,3%, положение каждой точки на дифракционной картине первого порядка перемещается ближе к центру дифракционного пятна нулевого порядка. пропорционально соответствующей длине волны луча, что согласуется с функцией обычного датчика с отражающей решеткой [11].

а Смоделированное изображение дифракционной картины. Никакой деформации не применялось. Интенсивность представлена цветами. Существует асимметричное поведение между дифракционным пятном первого порядка по обе стороны от луча нулевого порядка, потому что экран в нашем моделировании настроен параллельно решетке, а не перпендикулярно направлению отражения. б Моделирование эволюции дифракционного пятна первого порядка при различных двухосных деформациях. Частный дифференциал интенсивности представлен цветами. Горизонтальная координата и вертикальная координата обозначают положение относительно центра дифракционного пятна нулевого порядка. Пик отмечен пунктирной линией. Слева направо \ ({\ varepsilon} _ {x} \) было установлено как 0%, 0,9%, 2,6% и 4,3% соответственно. Сверху вниз \ ({\ varepsilon} _ {y} \) составлял 0%, 1%, 3% и 5% соответственно
Падающий луч с большей длиной волны \ (\ lambda \) имеет большее изменение \ ({\ theta} _ {m} \), поэтому край LW имеет наиболее очевидный сдвиг местоположения. Однако, когда одновременно применяется деформация растяжения в плоскости, перпендикулярная направлению периода решетки (\ ({\ varepsilon} _ {y} \)), наблюдается сдвиг пика интенсивности в пределах дифракционной картины первого порядка, как показано пунктирная линия на рис. 2б. Когда деформация \ ({\ varepsilon} _ {y} \) увеличивается от 0 до 5%, пик интенсивности смещается дальше от центра пятна дифракции нулевого порядка. Мы связываем этот пиковый сдвиг распределения интенсивности с модуляцией MoS 2 , вызванной деформацией. отражательная способность. В предыдущей литературе сообщалось, что спектр отражения MoS 2 может настраиваться внешней деформацией [28], а коэффициент отражения равен отношению интенсивностей дифрагированного пучка к падающему пучку отражательной решетки. Следовательно, интенсивность лучей с разными длинами волн, дифрагированных на MoS 2 Решетка может модулироваться деформациями в плоскости. Между тем, смещения края LW не происходит, потому что деформация \ ({\ varepsilon} _ {y} \) не влияет на период решетки.
На рис. 3а показано линейное поведение сдвигов пиков MoS 2 . спектры отражения при одноосной деформации растяжения вдоль вектора решетки \ ({\ varvec {b}} \) MoS 2 применены. Эта одноосная деформация растяжения вызывает красное смещение положения пика в MoS 2 отражательная способность. Однако существует нелинейная модуляция сдвига положения пика отражательной способности, когда мы применяем двухосную деформацию растяжения в плоскости. Связь между положением пика в спектрах отражения и двухосной деформацией растяжения в плоскости может быть описана уравнением второго порядка:
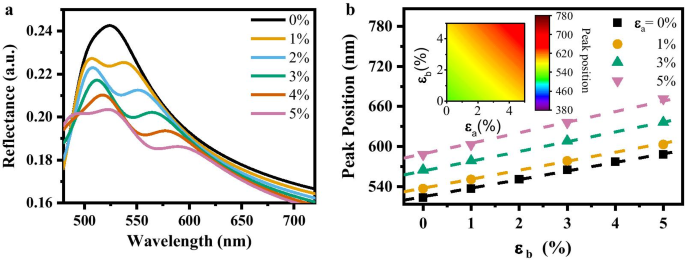
а Спектры отражения MoS 2 чешуйки как функция длины волны при различных одноосных деформациях. б Положения пиков в спектрах отражения MoS 2 отслаиваться при различных двухосных деформациях. Пунктирные линии представляют собой аппроксимирующие кривые. Вставка:отображение положения пиков из уравнения подгонки
$$ \ mathrm {Пиковая позиция} =l \ left ({\ varepsilon} _ {a} + {\ varepsilon} _ {b} \ right) + m {\ varepsilon} _ {a} {\ varepsilon} _ {b } + n $$ (2)где l , м , и n - три константы, а ε а и ε б компоненты деформации вдоль двух векторов решетки MoS 2 . Первый член описывает линейное поведение сдвига положения пика при одноосной деформации растяжения вдоль вектора решетки \ ({\ varvec {a}} \) или \ ({\ varvec {b}} \). Второй член описывает поведение более высокого порядка в ситуации двухосной деформации растяжения. Третий член - это положение пика отражения ненапряженного MoS 2 . Поскольку MoS 2 векторы решетки \ ({\ varvec {a}} \) и \ ({\ varvec {b}} \) симметрично эквивалентны, деформации растяжения в двух направлениях имеют одинаковый фактор вклада. Результаты аппроксимации показывают, что наибольшая разница между аппроксимирующей кривой и положениями пиков, рассчитанными на основе первого принципа, составляет 1,76 нм, что указывает на то, что предел точности тензодатчика ~ 1 может быть получен, когда положение пика отражательной способности используется для вычисления деформация с формулой. (2). На рис. 3b показано отображение положения пика отражения при различных двухосных деформациях растяжения в плоскости, полученное с помощью подобранного уравнения. (2) (см. Подробные графики отражательной способности в дополнительном файле 1).
В нашем моделировании вектор решетки \ ({\ varvec {a}} \) перпендикулярен направлению периода моделируемой решетки. Следовательно, деформация \ ({\ varepsilon} _ {y} \) равна \ ({\ varepsilon} _ {a} \), а деформация \ ({\ varepsilon} _ {x} \) равна \ (\ sqrt {3} / 2 \ times {\ varepsilon} _ {b} \). Наши расчеты показывают, что в MoS 2 На основе решетчатого датчика деформация в плоскости \ ({\ varepsilon} _ {x} \) может быть измерена с помощью сдвига положения края LW дифракционной картины первого порядка. Основываясь на сдвиге пика интенсивности на дифракционной картине первого порядка, мы можем использовать уравнение второго порядка. (2) вычесть вклад деформации в плоскости \ ({\ varepsilon} _ {x} \) из сдвига пика. Затем мы можем количественно рассчитать деформацию в плоскости \ ({\ varepsilon} _ {y} \).
Для дальнейшего экспериментального изучения чувствительности к деформации MoS 2 отражения, мы механически отслоили MoS 2 хлопья (толщиной несколько десятков нанометров; подробности см. в дополнительном файле 1) и прикрепили чешуйку к гибкой подложке из полидиметилсилоксана (ПДМС) методом сухого переноса (показано на вставке на рис. 4а). На этот изготовленный MoS 2 была приложена одноосная деформация растяжения в плоскости. устройство путем фиксации двух сторон подложки на двух этапах трансляции и растяжения подложки. Мы оценили деформацию одноосного растяжения в плоскости, вычислив ε \ (=\ delta L / L \), где \ (L \) - длина подложки между двумя зажимами, а \ (\ delta L \) - изменение длины. Когда деформация изменяется от 0 до 4%, наблюдается красное смещение положения пика в MoS 2 спектр отражения, и величина этого сдвига хорошо согласуется с нашими теоретическими расчетами, как показано на рис. 4а. На рис. 4b, c показано оптическое изображение датчика на основе отражательной решетки на основе MoS2 с периодом 2 мкм на гибкой подложке PDMS, изготовленной методом электронно-лучевой литографии (подробности в разделе «Методы»). При растяжении подложки PDMS на MoS 2 действует деформация растяжения в плоскости, перпендикулярная направлению периода. решетчатое устройство (рис. 4г). Наблюдая за распределением интенсивности на дифракционной картине первого порядка, мы заметили, что пик интенсивности смещается дальше от центра пятна нулевого порядка по сравнению со случаем без деформации, когда мы вводим 4% -ную деформацию растяжения в плоскости перпендикулярно к направление периода (рис. 4д). Сдвиг местоположения дифракционной картины не достигается, поскольку деформация растяжения перпендикулярна направлению периода, а расстояние d между каждой полосой меняется мало.
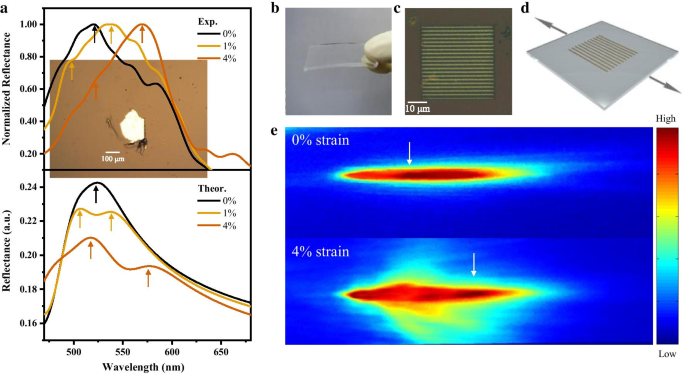
а Экспериментальные результаты спектров отражения с одноосными деформациями (вверху) и рассчитанный из первых принципов спектр отражения с одноосными деформациями (внизу). Стрелки указывают места пиков отражательной способности. Врезка, оптическое изображение MoS 2 чешуйки, используемые для тестирования спектра отражения. б - c Оптические изображения изготовленного MoS 2 решетка на ПДМС. г Принципиальная схема MoS 2 решетка на основе натяжных ступеней трансляции. е Изображение дифракционного пятна первого порядка недеформированной (вверху) и деформированной (внизу) решетки. Белые стрелки указывают пик интенсивности
Заключение
Таким образом, мы демонстрируем новую технику измерения двухосной деформации в плоскости с использованием MoS 2 датчик на основе отражательной решетки. Мы проверяем концепцию путем численного моделирования решетки с различными двухосными деформациями до 5%. В этом новом методе решетчатая структура для обнаружения компонента деформации вдоль направления периода (\ ({\ varepsilon} _ {x} \)) сочетается с чувствительностью к деформации MoS 2 коэффициент отражения, который действует как дополнительный датчик для получения составляющей деформации в плоскости, перпендикулярной направлению периода (\ ({\ varepsilon} _ {y} \)). Компонент \ ({\ varepsilon} _ {y} \) вычисляется с помощью уравнения аппроксимации второго порядка и сдвига пика интенсивности в пределах дифракционных картин первого порядка. Теоретические результаты хорошо подтверждаются нашими экспериментами. Наша работа открывает путь для разработки датчиков с гибкой решеткой и предлагает новый подход к реализации одноразовых плоских двухосных тензодатчиков с одним датчиком на решетке. Наш подход также применим к другим материалам, которые обладают предсказуемой отражательной способностью при двухосной деформации и способностью образовывать двумерные монокристаллические слои.
Доступность данных и материалов
Наборы данных, использованные и проанализированные в ходе текущего исследования, доступны у соответствующего автора по разумному запросу.
Сокращения
- 2D:
-
Двумерный
- VASP:
-
Венский пакет имитационного моделирования для начинающих
- PAW:
-
Полностью электронный проектор дополненной волны
- PBE:
-
Пердью – Берк – Эрнцерхоф
- GGA:
-
Обобщенное приближение градиента
- SOC:
-
Спин-орбитальная связь
- BSE:
-
Уравнение Бете – Солпитера
- PDMS:
-
Полидиметилсилоксан
- EBL:
-
Электронно-лучевая литография
Наноматериалы
- Использование RFID-тегов для мониторинга домашней безопасности
- Библиотека Python датчика температуры TMP006 с использованием Raspberry pi,
- Датчик температуры Python и Raspberry Pi
- Потоковая передача данных датчика с пластины PPDAQC Pi с использованием InitialState
- Датчик движения с использованием Raspberry Pi
- Использование импульсного радиолокационного датчика A111 с Raspberry Pi
- MoS2 с контролируемой толщиной для электрокаталитического выделения водорода
- Температурная кристаллизация нанофлексов MoS2 на графеновых нанолистах для электрокатализа
- Большой боковой фотоэлектрический эффект в гетеропереходе MoS2 / GaAs
- Зависящая от смещения фоточувствительность многослойных фототранзисторов MoS2



