Новый TFET SiGe Channel в форме плавника без допинга с улучшенной производительностью
Аннотация
В данной статье предлагается и исследуется безлегирующий плавниковый канал TFET из SiGe (DF-TFET). Чтобы сформировать высокоэффективный туннельный переход без допинга в линии, индуцируются ребристый канал SiGe и перекрытие затвор / исток. С помощью этих методов можно получить DF-TFET с высоким током в открытом состоянии, коэффициентом переключения 12 порядков и без очевидного амбиполярного эффекта. Высокий κ Диэлектрик затвора пакета материалов индуцируется для улучшения утечки в закрытом состоянии, характеристик интерфейса и надежности DF-TFET. Более того, используя безлегирующий канал и структуру ребер, можно решить проблемы процесса легирования и образования асимметричного перекрытия затвора. В результате структура DF-TFET может иметь хорошую производственную применимость и значительно уменьшить занимаемую площадь. В данной работе изучается физический механизм устройства и влияние параметров на производительность. Наконец, ток в открытом состоянии ( I ВКЛ ) 58,8 мкА / мкм, минимальный подпороговый размах 2,8 мВ / дек (SS min ), среднее подпороговое колебание (SS avg ) 18,2 мВ / дек. Благодаря улучшенным емкостным характеристикам можно получить частоту среза 5,04 ГГц и произведение коэффициента усиления на полосу пропускания 1,29 ГГц. Благодаря улучшенной производительности и надежности DF-TFET может быть очень привлекательным кандидатом для приложений со сверхнизким энергопотреблением.
Введение
С уменьшением масштабов MOSFET скорость переключения, высокочастотные характеристики, плотность, стоимость и функциональность интегральных схем (ИС) значительно улучшаются [1]. Но с непрерывным прогрессом снижения напряжения неприемлемо высокое энергопотребление становится серьезной проблемой для современных ИС [1, 2]. Воспользуйтесь преимуществом механизма межполосного туннелирования, туннельным полевым транзистором (TFET) с крутой SS и низким энергопотреблением - это новое решение этой проблемы, которое привлекло большое внимание [3,4,5,6,7,8,9 ]. Но применение обычных кремниевых транзисторов TFET ограничено значительно низким током в открытом состоянии ( I ВКЛ ), низкий коэффициент переключения, сильный амбиполярный эффект и большой средний подпороговый размах (SS) [1, 7]. Для повышения производительности TFET в последние годы были предложены приложения новых структур и новых материалов для TFET. Например, в последние годы предлагаются TFET со слоем с повышенной скоростью туннелирования [5, 10, 11]. С помощью этого уровня эффективная длина пути туннелирования уменьшается и приводит к очевидному увеличению скорости туннелирования. Более того, TFET с улучшенной структурой затвора изучаются многими исследовательскими группами [12,13,14,15,16,17,18,19,20]. Концепция туннелирования линий введена в L-TFET [17,18,19]. В результате SS avg 42,8 мВ / декада и I ВКЛ из 10 −6 A / мкм может быть достигнуто с помощью L-TFET. Для дальнейшего улучшения характеристик TFET сообщается об улучшенном TG-TFET с Т-образным перекрытием и двойным источником [20, 21]. В результате I ВКЛ TG-TFET достигает 81 мкА / мкм. Для дальнейшего улучшения характеристик устройства требуются высокие требования к профилю легирования туннельного перехода. Инженерам-литейщикам необходимо создать сверхкрутой крутой переход толщиной всего в несколько нанометров, а этого очень трудно добиться. Чтобы избежать этой трудности, исследовательские группы сообщают о применении безлегирующего TFET (DL-TFET) на тонкой собственной полупроводниковой пленке с использованием концепции зарядовой плазмы [22, 23]. В DL-TFET сложность изготовления может быть значительно уменьшена за счет удаления сверхкрутого крутого перехода. Можно избежать ухудшения характеристик, вызванного случайными колебаниями примеси. Более того, изготовление DL-TFET не требует больших тепловых затрат на создание истока и стока, что открывает возможность реализации TFET на других подложках, таких как монокристаллический кремний на стекле. В результате SS DL-TFET был значительно улучшен. Однако из-за низкой эффективности точечного туннельного перехода ток DL-TFET недостаточно высок, что трудно удовлетворить постоянно растущим требованиям современных схемотехнических приложений.
В этой статье предлагается и исследуется новый безлегирующий плавниковый канал TFET из SiGe-канала (DF-TFET). Для повышения производительности и надежности устройства в DF-TFET применен переходной туннельный переход и материал SiGe. Между тем, работа выхода металла затвора оптимизирована для дальнейшего повышения скорости туннелирования. Кроме того, канал без легирования снизил сложность производственного процесса, в то время как конструкция ребер делает возможным изготовление асимметричного затвора / заднего затвора. В результате ток в открытом состоянии ( I ВКЛ ) 58,8 мкА / мкм, ток утечки в закрытом состоянии ( I ВЫКЛ ) около 10 −11 мкА / мкм, среднее подпороговое колебание (SS avg ) 18,2 мВ / дек и минимальное подпороговое колебание (SS min ) 2,8 мВ / дек может быть достигнуто с помощью DF-TFET. При относительно небольшой емкости затвора ( C gg ) и емкость затвора для стока ( C gd ), можно получить хорошие аналоговые / радиочастотные характеристики. Наконец, частота среза ( f T ) достигло 5,04 ГГц, а произведение усиления полосы пропускания (GBW) достигло 1,29 ГГц.
Структура этого документа выглядит следующим образом:В разделе «Структура устройства и метод моделирования» показаны методы моделирования TCAD в этой работе. Представлены структура и параметры DF-TFET. Показаны различия и преимущества DF-TFET по сравнению с DL-TFET и TG-TFET. Механизм, характеристики и аналоговые / радиочастотные характеристики DF-TFET обсуждаются в разделе «Результаты и обсуждение». В этом разделе проводится сравнение производительности DF-TFET, DL-TFET и TG-TFET. Кроме того, в этом разделе изучается влияние параметров устройства на производительность и типичные радиочастотные параметры DF-TFET. Чтобы лучше понять потенциал DF-TFET в приложениях со сверхмалым энергопотреблением, было проведено сравнение электрических характеристик различных TFET и DF-TFET при низком напряжении смещения.
Структура устройства и метод моделирования
Предлагаемая структура DF-TFET проиллюстрирована на рис. 1а. Для улучшения характеристик устройства линейный туннельный переход применяется к безлегирующему ребристому каналу из SiGe по концепции зарядовой плазмы [24, 25]. Известно, что толщина диэлектрика затвора может существенно влиять на туннельный ток. Это потому, что в результате приближения ВКБ [26], как показано в формуле. (1) вероятность туннелирования зависит от эффективной длины экранирования ( λ ), эффективная масса носителя ( м * ), запрещенная зона ( E g ) и эффективное окно энергии экранирования (Δ Φ ).
$$ T _ {{{\ text {WKB}}}} \ приблизительно \ exp \ left ({- \ frac {{4 \ lambda \ sqrt {2m ^ {*}} \ sqrt {E _ {{\ text {g}) }} ^ {3}}}} {{3q \ hbar (E _ {{\ text {g}}} + \ Delta \ Phi)}}} \ right) $$ (1)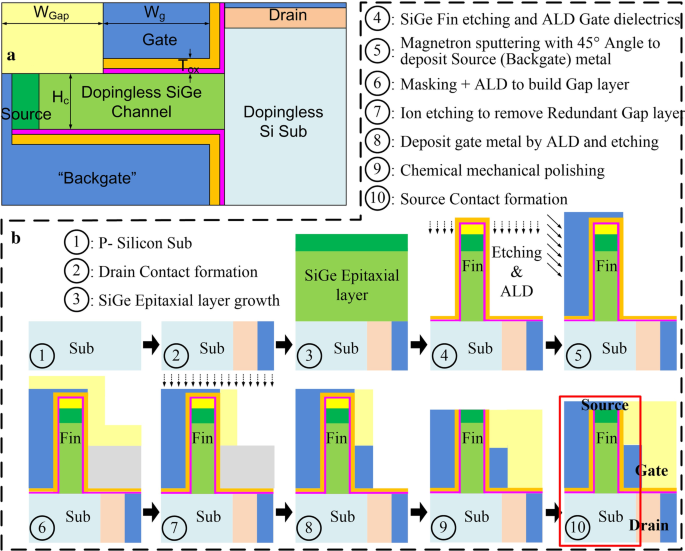
а Структура и b технологический процесс изготовления DF-TFET
Уменьшение толщины диэлектрика затвора или использование высокого κ диэлектрик уменьшит λ и увеличиваем Δ Φ , что приведет к экспоненциальному увеличению вероятности туннелирования. Таким образом, используя высокий κ диэлектрики и уменьшение толщины диэлектрика может значительно увеличить ток в открытом состоянии TFET. Но небольшая толщина диэлектрика и проблемы с качеством интерфейса из-за высокого κ диэлектрики вызовут серьезные проблемы с надежностью. Таким образом, пакетный диэлектрик затвора из 0,5 нм Al 2 О 3 и 2,0 нм HfO 2 установлен, чтобы гарантировать хорошее качество интерфейса [27,28,29], что может значительно снизить ток утечки и повысить надежность диэлектрика затвора. Электрод истока расположен в верхней части ребристой конструкции. В то же время, он также находится рядом с одной стороной плавника и работает как «задний ход» для применения нулевого смещения. Используя электроды затвора и истока с различными выходными функциями металла, можно сформировать линейный туннельный переход в канале SiGe в форме ребра без легирования с помощью концепции зарядовой плазмы. Направление межполосного туннелирования (BTBT) перпендикулярно поверхности канала / затвора. Это может помочь увеличить I ВКЛ за счет улучшения эффективной площади туннельного перехода.
Высокий коэффициент переключения ( I ВКЛ / Я ВЫКЛ ) может быть получено из-за большого тока в открытом состоянии ( I ВКЛ ) и небольшой ток в закрытом состоянии ( I ВЫКЛ ), обеспечиваемый линейным туннельным переходом. Кроме того, применение ребристой структуры в DF-TFET может значительно уменьшить занимаемую площадь по сравнению с туннельным TFET для более строгих линий [30, 31]. На рисунке 1b показан доступный технологический процесс для формирования структуры DF-TFET. В таблице 1 показаны основные параметры процесса DF-TFET. Наконец, без труда создать крутой и однородный резкий p – n-переход, можно добиться хорошей производительности и надежности устройства.
Чтобы лучше понять различия и преимущества DF-TFET, DL-TFET и TG-TFET, на рис. 2 показана структура этих трех устройств. При линейном туннельном переходе ожидается, что L-TFET и TG-TFET получат высокий ток в открытом состоянии. Но экспериментальные результаты показывают, что реальная производительность L-TFET не так высока, как ожидалось [18, 19]. Одна из наиболее важных причин - сложность образования крутого и однородного резкого p – n перехода с идеальными характеристиками интерфейса. Основываясь на структуре L-TFET, TG-TFET значительно улучшает I ВКЛ . Но TG-TFET все еще сталкивается с трудностями при образовании идеального крутого p – n перехода. Таким образом, для получения желаемых хороших характеристик должен быть получен крутой и однородный резкий p – n-переход, который имеет толщину всего несколько нанометров, но его очень трудно реализовать в процессе производства. Используя бездопинговый канал, DL-TFET может избежать этой проблемы и улучшить качество интерфейса вблизи туннельного перехода. Однако по сравнению с транзисторами TFET с туннелированием по линии [16,17,18,19,20,21] с резкими переходами p – n, результат моделирования показывает, что I ВКЛ DL-TFET относительно невысокая [22, 23]. Для дальнейшего улучшения в данной работе предлагается и изучается DF-TFET.
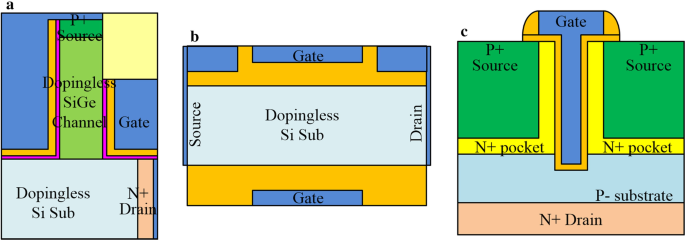
Структура а DF-TFET, b DL-TFET, c ТГ-ТФЭТ
Моделирование DF-TFET выполняется в инструментах Silvaco Atlas TCAD. В этом моделировании вводится нелокальная модель BTBT, чтобы учесть пространственные вариации энергетической зоны, что может помочь повысить точность процесса туннелирования BTBT. Модель мобильности Ломбарди считается точной для определения мобильности канала. Модель сужения запрещенной зоны учитывается для соответствия областям сильнолегированного омического контакта, а также в данной статье учитывается модель рекомбинации Шокли – Рида – Холла.
Результаты и обсуждение
Механизм и сравнение DF-TFET, DL-TFET и TG-TFET
На рисунке 3a показано сравнение характеристик передачи DF-TFET, DL-TFET и TG-TFET. Благодаря использованию туннельного перехода в ребристом канале SiGe, DF-TFET обеспечивает ток в открытом состоянии ( I ВКЛ ) 58,8 мкА / мкм и обеспечивает большой коэффициент переключения, превышающий 12 порядков, при котором не возникает очевидного амбиполярного эффекта. Кроме того, минимальное подпороговое колебание (SS min ) 2,8 мВ / дек и среднего подпорогового размаха (SS avg ) 18,2 мВ / дек. В результате DF-TFET имеет очевидные улучшения в I ВКЛ по сравнению с DL-TFET и подпороговым качанием по сравнению с TG-TFET. Я ВКЛ DF-TFET более чем на порядок больше, чем DL-TFET при V DS = V GS =1 В. На рисунке 3b показано состояние энергетической зоны DF-TFET и показано формирование туннельного окна в ребристом канале. Красная пунктирная линия на вставке к рис. 3b показывает положение, в котором получена кривая энергетической полосы.
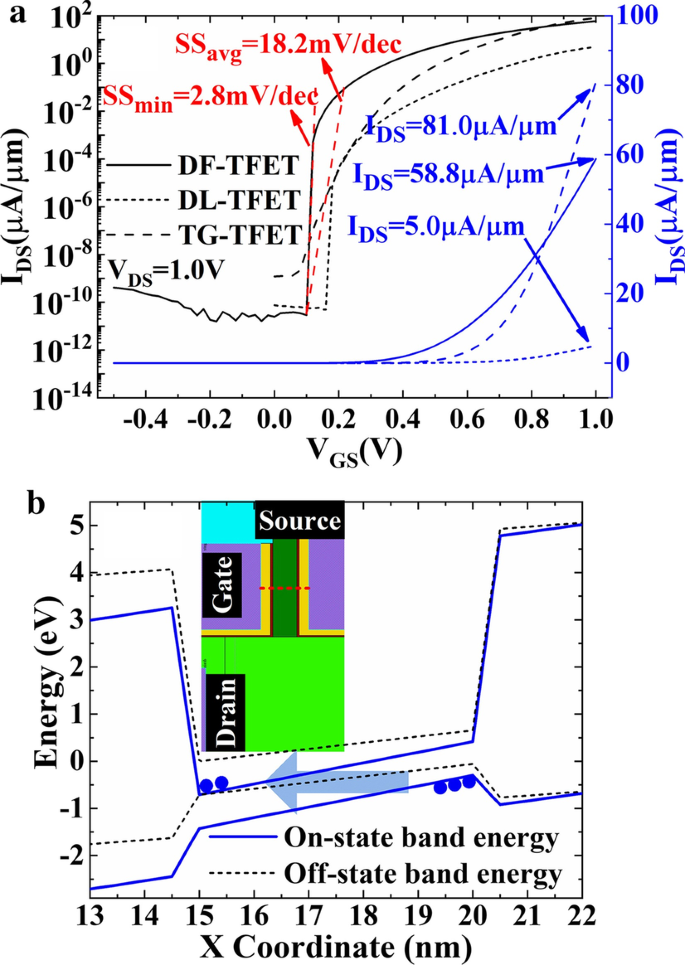
а Передаточные характеристики DF-TFET, DL-TFET и TG-TFET. б Состояние энергетического диапазона DF-TFET в различных рабочих условиях (на вставке показано положение линии разреза)
Распределение важной физической величины в процессе туннелирования DF-TFET показано на рисунке 4, который включает в себя распределение (а) потенциала, (б) скорости туннелирования (в) полной плотности тока и (г) скорости рекомбинации в состояние работы в исправном состоянии. На рис. 4а можно наблюдать четкий градиент потенциала, перпендикулярный границе раздела затвор / канал. Таким образом, в ребристом канале создается огромная разность потенциалов, которая модулирует концентрацию электронов и дырок по обеим сторонам ребристого канала. В то же время в канале в форме ребра может образоваться крутой изгиб энергетической полосы. В результате может быть сформирован линейный туннельный переход, параллельный интерфейсу затвор / канал. На рисунке 4b показана скорость электронного туннелирования в канале ребристой структуры. Пиковое значение скорости электронного туннелирования равномерно распределено вблизи границы раздела затвор / канал и параллельно поверхности. Это доказывает, что линейный туннельный переход параллелен интерфейсу затвор / канал. На рисунке 4c показан текущий путь в DF-TFET. Электроны валентной зоны со стороны затвора / канала туннелируют в зону проводимости около стороны затвора / канала. Под действием напряжения затвора и напряжения стока электроны движутся по каналу оребрения к электроду стока. Таким образом, в DF-TFET формируется путь туннельного тока. На рис. 4d показано распределение скорости рекомбинации в DF-TFET; это может более наглядно проиллюстрировать расположение туннельного перехода. Пурпурная полоса в канале ребра SiGe может обозначать расположение туннельного перехода.
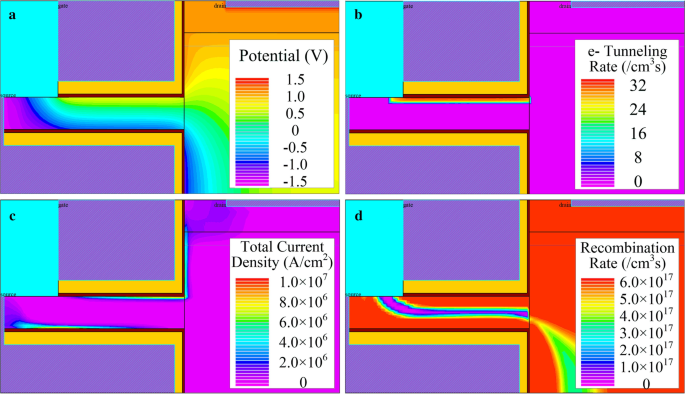
Распространение a потенциал, b e скорость туннелирования, c плотность тока и d скорость рекомбинации DF-TFET
Характеристики постоянного тока с различными параметрами и аналоговыми / радиочастотными характеристиками
На рис. 5а, б показаны входные и выходные характеристики DF-TFET при различных смещениях. Увеличение V DS мало влияет на характеристики подпорогового колебания, но I ВКЛ будет иметь линейный рост, а V DS увеличивается с 0,2 до 1,2 В (при V GS =1,0 В). На рисунке 5c показана частота среза ( f T ) и произведение коэффициента усиления на ширину полосы пропускания (GBW), рассчитанное по формулам. (2) и (3). Результат показывает, что может быть получена частота среза 5,04 ГГц и произведение коэффициента усиления 1,29 ГГц.
$$ f _ {{\ text {T}}} =\ frac {{g _ {\ text {m}}}}} {{2 \ pi C _ {{{\ text {gs}}}} \ sqrt {1 + 2C _ {{{\ text {gd}}}} / C _ {{{\ text {gs}}}}}}} \ приблизительно \ frac {{g _ {{\ text {m}}}}}} {{2 \ pi \ left ({C _ {{{\ text {gs}}}} + C _ {{{\ text {gd}}}}} \ right)}} =\ frac {{g _ {{\ text {m} }}}} {{2 \ pi C _ {{{\ text {gg}}}}}} $$ (2) $$ {\ text {GBW}} =g _ {{\ text {m}}} / 2 \ pi 10C _ {{{\ text {gd}}}} $$ (3)
а Ввод, b вывод и c радиочастотные характеристики DF-TFET
На рисунке 6а показано влияние работы выхода затвора ( φ Ворота ) и работа выхода слива ( φ Слив ) по передаточным характеристикам DF-TFET. С увеличением работы выхода кривая передаточной характеристики смещается в положительную сторону. Поскольку работа выхода изменяется от 3,7 до 4,2 эВ, V th линейно увеличивается от 0 до 0,5 В, в то время как I ВКЛ линейно уменьшается с 93,4 до 18,6 мкА / мкм. Это позволяет регулировать V th применять к различным требованиям приложения. На рисунке 6b показано влияние соотношения состава X . из Si 1− X Ge X . Увеличение состава германия приводит к уменьшению ширины запрещенной зоны и увеличению окна туннелирования, как показано на вставке к рис. 6б. Наконец, результат I ВКЛ кривая увеличения и передачи смещается в отрицательном направлении. Однако когда X > 0,7, как кривая передаточной характеристики, так и I ВКЛ мало изменится с увеличением X . Это связано с тем, что структура энергетической полосы канала становится нечувствительной к X когда X > 0,7, как показано на вставке к рис. 6б. На рис. 6c, d показано влияние длины ворот ( W g ) и толщины канала ( H c ) по передаточным характеристикам. На вставке к рис. 6в показаны размеры канала устройства при различных значениях W g . Из рис. 6d нетрудно заметить, что DF-TFET страдает I ВКЛ уменьшаются, когда H c становится и слишком маленьким, и слишком большим. Таким образом, правильный H c улучшит производительность устройства.

Передаточные характеристики с разными а работа выхода ворот ( φ Ворота ) и работа выхода слива ( φ Слив ), b Соотношение состава SiGe, c длина ворот ( W g ) и d толщина канала ( H c )
Чтобы понять потенциал DF-TFET в приложениях со сверхнизким энергопотреблением, в таблице 2 показано сравнение производительности различных TFET с DF-TFET. По сравнению с TFET с традиционным сильно легированным p – n туннельным переходом [6, 20, 32,33,34,35], DF-TFET имеет очевидные преимущества по SS и коэффициенту переключения. Это связано с характеристиками DF-TFET за счет электростатического легирования. По сравнению с другими бездопинговыми TFET [22, 23, 36, 37], DF-TFET имеет очевидные преимущества на I ON . Это происходит из-за улучшенной скорости туннелирования за счет использования линейного туннельного перехода и материала SiGe. Комбинируя преимущества туннельного перехода p – n и туннельного перехода без легирования, DF-TFET может обеспечить высокий рабочий ток и низкое статическое энергопотребление в приложениях со сверхнизким энергопотреблением.
Заключение
В этой работе предлагается новый DF-TFET, а электрические характеристики анализируются методом моделирования. Обсуждаются и изучаются структурные характеристики, физический механизм, производительность с различными параметрами и аналоговые / радиочастотные характеристики DF-TFET. Преимущества канала с ребристой структурой без легирования, диэлектрика затвора пакета, материала канала SiGe и высокоэффективного туннельного перехода линии, могут быть получены хорошие характеристики переключения и аналоговые / ВЧ характеристики. Более того, избегая образования резкого p – n перехода в процессе производства, можно добиться равномерного легирования с высокой консистенцией и высокой устойчивостью к колебаниям процесса. Результат моделирования показывает, что I ВКЛ 58,8 мкА / мкм, коэффициент переключения 12 порядков, нет явного амбиполярного эффекта, SS мин 2,8 мВ / дек и f T 5,04 ГГц может быть достигнута с помощью DF-TFET. Благодаря большому рабочему току, высокому коэффициенту переключения, крутой SS, хорошей надежности, стабильному производственному процессу и хорошей технологичности, его можно ожидать в качестве одного из многообещающих кандидатов для будущих маломощных ИС и чувствительных датчиков.
Доступность данных и материалов
Неприменимо (Эта рукопись представляет собой чисто теоретическое исследование аналоговых / радиочастотных характеристик TFET. Данные моделирования приведены в этой рукописи и не подлежат описанию здесь).
Сокращения
- DF-TFET:
-
SiGe-канал без допинга в форме ребра TFET
- ИС:
-
Интегральные схемы
- TGTFET:
-
Т-образный затвор с двойным истоком TFET
- DL-TFET:
-
Бездопинговый TFET
- I ВКЛ :
-
Ток в открытом состоянии
- I ВЫКЛ :
-
Ток в выключенном состоянии
- SS min :
-
Минимальное подпороговое колебание
- SS avg :
-
Среднее подпороговое колебание
- C gg :
-
Емкость затвора
- C gd :
-
Емкость затвор-сток
- f T :
-
Частота среза
- GBW:
-
Продукт увеличения пропускной способности
- λ :
-
Эффективная длина просеивания
- m * :
-
Эффективная масса носителя
- E g :
-
Ширина запрещенной зоны
- Δ Φ :
-
Окно эффективного экранирования энергии
- W g :
-
Длина ворот
- W Разрыв :
-
Длина зазора
- T бык :
-
Толщина оксида затвора штабеля
- H c :
-
Толщина канала
- φ Ворота / φ Слив :
-
Функция работы затвора и слива
- V DS :
-
Сток к источнику напряжения
- V GS :
-
Напряжение затвор-источник
Наноматериалы
- Новый подход обеспечивает улучшенную стабильность PUF
- Повышение производительности с помощью автоматической сварки
- Блог:медицинские носимые устройства с отличными характеристиками
- Новый фотокатализатор на гетеропереходе Bi4Ti3O12 / Ag3PO4 с улучшенными фотокаталитическими характеристиками
- Повышенная производительность нового анодного катализатора PdAu / VGCNF для электроокисления в глицериновом топ…
- Механизм проводимости и повышение выносливости в RRAM на основе HfO2 с лечением нитридом
- Изготовление иерархических гетероструктур ZnO @ NiO Core – оболочка для улучшения фотокаталитических характерист…
- Канальные плазмонные нанопроволочные лазеры с полостями с V-образной канавкой
- Влияние вариаций травления на формирование каналов Ge / Si и производительность устройства
- 6 способов улучшить Protocase Designer в версии 4.6



