Инфракрасный фотоэлектрический детектор на основе гетероперехода p-GeTe / n-Si
Аннотация
GeTe - важный полупроводниковый материал с узкой запрещенной зоной, который нашел применение в области накопителя с фазовым переходом, а также в устройствах спинтроники. Однако он не изучался для применения в области инфракрасных фотоэлектрических детекторов, работающих при комнатной температуре. Здесь нанопленки GeTe были выращены методом магнетронного распыления и охарактеризованы для исследования его физических, электрических и оптических свойств. Высокопроизводительный инфракрасный фотоэлектрический детектор на основе гетероперехода GeTe / Si с обнаружительной способностью 8 × 10 11 Джонса было продемонстрировано облучение светом 850 нм при комнатной температуре.
Фон
Инфракрасные детекторы проявили большой интерес в связи с их многочисленными потенциальными применениями в области ночного видения, безопасности, дистанционного зондирования, инспекции пищевых продуктов, биологии и других областях [1,2,3]. Как правило, фотоэлектрические инфракрасные детекторы используют эффекты неосновных носителей, что приводит к короткому времени отклика, что идеально для приложений визуализации и считывания. Инфракрасный детектор на основе HgCdTe хорошо зарекомендовал себя [4, 5]. Однако несоответствие решеток HgCdTe и Si не позволяет интегрировать блоки обнаружения и обработки данных, что приводит к дорогостоящей системе и препятствует миниатюризации технологии.
Было проведено много исследований по разработке различных гетерогенных структур на основе двумерных материалов, выращенных на различных подложках [6,7,8,9]. Результирующая неоднородная структура зависит от взаимодействия Ван-дер-Ваальса [10], и нет необходимости в согласовании решеток различных материалов.
В последние годы материал GeTe привлекает к себе большое внимание [11,12,13,14,15]. Он считается серьезным претендентом на технологию памяти следующего поколения, поскольку материал демонстрирует различные физические, электрические и оптические свойства, когда он находится в аморфной и кристаллической фазах [16,17,18,19,20,21]. GeTe можно также превратить в разбавленный магнитный полупроводник, который является важным материалом для устройств спинтроники [15, 22, 23]. Если уникальные возможности хранения и вычислений GeTe могут быть объединены для разработки новых устройств, это приведет к значительному прогрессу в вычислительной технологии.
Кроме того, возможность разработки фотоэлектрических детекторов на основе двумерных гетеропереходов GeTe и Si приведет к революционным технологиям благодаря их совместимости с кремниевой схемой и процессами спинтронных устройств на основе GeTe. Это будет способствовать бесшовному и быстрому подключению фотоэлектрических детекторов в области вычислений в будущем. Важно отметить, что технология подходит для миниатюризации при невысокой стоимости.
В данной работе нанопленки GeTe p-типа были получены методами магнетронного распыления и отжига. Исследованы физические, электронные и оптические свойства нанопленок. Наконец, был изготовлен фотоэлектрический детектор на основе гетероперехода p-GeTe / n-Si и охарактеризованы его характеристики.
Методы
Устройство было изготовлено с использованием следующих процессов. Сначала подложка из монокристаллического кремния (Si) n-типа была очищена методом химической ванны с использованием смешанного раствора, содержащего H 2 От O до H 2 О 2 кому:NH 3 ∙ H 2 O (3:1:1) при 80 ° C в течение 30 мин и сушили в токе воздуха. Затем пленка GeTe была нанесена магнетронным распылением непосредственно на очищенную подложку при давлении 5 Па в течение 120 с при начальном вакууме 6,0 × 10 −4 Па. Затем пленку завернули в медную фольгу и отожгли в вакуумной печи при 360 ° C в течение 10 мин. Метод отжига был основан на предварительных экспериментах и температурах фазового перехода материала, о которых ранее сообщалось в литературе [18, 24, 25, 26]. Наконец, пара алюминиевых (Al) электродов напылялась на пленку GeTe и подложку Si с использованием метода физического осаждения из паровой фазы (PVD) (при давлении 7,0 × 10 −5 Па) через теневую маску. Толщина алюминиевых электродов составляла приблизительно 100 нм, как было измерено кварцевым генератором во время осаждения. Эффективная площадь устройства составляла 1,5 мм 2 . . На рис. 1а и б показаны процессы магнетронного распыления и отжига в печи соответственно. На рис. 1c и d показаны соответственно осажденные и отожженные пленки GeTe.
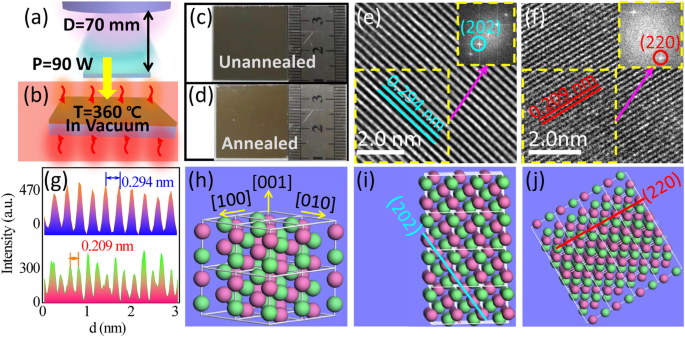
а Магнетронное напыление пленки GeTe на подложку Si. б Последующий отжиг пленки GeTe. c Оптические изображения депонированных и d отожженные пленки GeTe на кварцевой подложке. е - е ПЭМ-изображения и картины БПФ (вставка) отожженной пленки GeTe. г Линейные профили полос решетки кристаллических плоскостей (202) и (220), как показано на верхней и нижней панелях, соответственно. ч - j Принципиальные схемы кристаллических структур
Результаты и обсуждение
Изображения отожженной пленки GeTe, полученные с помощью просвечивающей электронной микроскопии высокого разрешения (ПЭМВР), показаны на рис. 1e и f. На вставках показаны шаблоны быстрого преобразования Фурье (БПФ) пленки GeTe. На изображениях указаны индексы кристаллических плоскостей. Согласно этим результатам отожженная пленка GeTe показала хорошую кристалличность. На рис. 1g показаны линейные профили полос решетки, показанные на рис. 1e и f. Профили верхней и нижней линий на рис. 1g соответствуют кристаллическим плоскостям (202) и (220) пленки GeTe, расстояние между решетками которой составляет 0,294 и 0,209 нм соответственно. Принципиальная схема структуры решетки GeTe представлена на рис. 1h. На рисунках 1i и j показаны модели кристаллов GeTe в плоскости кристаллов, как показано на рисунках 1e и f соответственно.
Рамановская спектроскопия была проведена для исследования структуры пленок GeTe до и после отжига с использованием рамановского микроскопа Renishaw inVia, оснащенного ионно-аргоновым лазером, работающим на длине волны возбуждения 514 нм. На рис. 2а и б показаны нормированные спектры комбинационного рассеяния для пленок GeTe после осаждения и после отжига соответственно. Результаты хорошо согласуются с литературой [27, 28]. Было три отличительных полосы между 100 и 300 см −1 . как показано на рис. 2а. Эти полосы располагались на 124,8, 161,8 и 223,5 см −1 . , а именно полосы B, C и D соответственно. После отжига произошло значительное уменьшение полосы D, а также появление полосы A, расположенной на 108,1 см −1 . как показано на рис. 2b. Полосы B, C и D также были сдвинуты в красную область на 1,1, 5,3 и 21,9 см −1 . , соответственно. Это объясняется структурной трансформацией пленки GeTe, приводящей к снижению степени беспорядка (например, отношения межмолекулярных и внутримолекулярных взаимодействий) [27].

а - б Нормированные рамановские спектры пленок GeTe до и после отжига соответственно. c Спектры поглощения пленок GeTe в УФ-видимой-ближней ИК-области до и после отжига. (Врезка) График α 2 в зависимости от энергии фотона ( hν ) двух пленок GeTe. г Оптические изображения отожженной пленки GeTe для измерений в АСМ. е АСМ-изображение и профили линий (вставка) для измерения толщины отожженной пленки GeTe. е Спектры XRD пленок GeTe до и после отжига. г - я XPS-спектры ядер Ge 2p, Ge 3d и Te 3d отожженной пленки GeTe
Для исследования оптических свойств пленок GeTe до и после отжига была проведена абсорбционная спектроскопия UV-Vis-NIR с использованием спектрометра Horiba iHR 320. На рис. 2с показаны спектры поглощения в УФ-видимой-ближней ИК-области, полученные для обеих пленок. После отжига наблюдается пик поглощения при 600 нм. Коэффициент поглощения отожженной пленки GeTe был значительно больше, чем у неотожженной пленки. Кроме того, наблюдалась тенденция к снижению коэффициента поглощения для увеличения длины волны в инфракрасном диапазоне. Энергия запрещенной зоны ( E г ) пленок можно определить по формулам [29, 30]:
$$ {\ alpha} ^ 2 \ left (h \ nu \ right) =C \ left (h \ nu - {E} _g \ right) $$ (1)где hν - энергия падающего фотона, α - коэффициент оптического поглощения, связанный с hν , и C является константой. Прямая оптическая запрещенная зона пленок GeTe может быть оценена по кривой α 2 от энергии фотона ( hv ), как показано на вставке к рис. 2с. Он может сильно варьироваться в зависимости от условий эксперимента и теоретических моделей [31]. В этой работе оценочная E г пленок GeTe до и после отжига составляла 0,85 и 0,70 эВ соответственно. Это хорошо согласуется с предыдущими работами других авторов, в которых сообщалось об оптической ширине запрещенной зоны ~ 0,85 эВ для аморфной пленки GeTe и ~ 0,73–0,95 эВ для кристаллической пленки [32]. Уменьшение на E г сообщалось после отжига из-за дальнего упорядочения решетки.
Атомно-силовая микроскопия (АСМ) была проведена для определения толщины пленок с помощью АСМ (SPA-400). Маска из фоторезиста использовалась для подготовки образца к АСМ-измерениям. На рис. 2г показано оптическое изображение подготовленного образца для АСМ с явной границей между пленкой GeTe и подложкой. На рис. 2д видно, что на подложках Si после отжига толщина пленки составляет 33 ± 1,5 нм. Отжиг мало влияет на среднеквадратичную шероховатость поверхности тонких пленок GeTe; среднеквадратичная шероховатость поверхности снизилась с 2,1 нм (как осажденный GeTe) до 1,4 нм (отожженный GeTe).
Влияние отжига на структуру нанопленок GeTe было дополнительно исследовано с помощью дифракции рентгеновских лучей (XRD). На рис. 2е показаны рентгеновские дифракционные спектры нанопленок GeTe после осаждения (синий цвет) и после отжига (красный цвет). После отжига появились два сильных дифракционных пика при 29.9 ° и 43.2 °, соответствующие плоскостям решетки (202) и (220) соответственно. Кроме того, в спектре также появлялись два слабых дифракционных пика при 26,0 ° и 53,5 °, которые соответствовали плоскостям решетки (021) и (042) соответственно. В сочетании с приведенными выше результатами ПЭМ становится очевидным, что нанопленка GeTe преимущественно упорядочивается по плоскостям решетки (220) и (202) во время процесса отжига. По сравнению с пленками GeTe после осаждения, в отожженном GeTe наблюдается резкое изменение кристаллической фазы; Разница в связанных со структурой оптических свойствах (спектрах поглощения) показана на рис. 2f и c.
Элементный состав и химические связи на поверхности отожженных нанопленок GeTe исследованы методом рентгеновской фотоэлектронной спектроскопии (XPS) с использованием излучения AlKα с энергией 1486,6 эВ. XPS-спектры пиков основных уровней Ge 2p, Ge 3d и Te 3d отожженной пленки GeTe показаны на рис. 2g, h и i, соответственно. Уровень ядра Ge 2p состоял в основном из Ge 2p 3/2 (1220,1 эВ) и Ge 2p 1/2 (1251,1 эВ) дублетные пики. Внутренний уровень Ge 3d был деконволюционирован на два компонента, а именно Ge-Te и Ge-O с энергией связи 30,0 и 32,8 эВ соответственно. Базовый уровень Te 3d состоял из компонентов Ge-Te, Te-O и Te-Te. Те-О (Te 4+ ) с пиком при 576,5 эВ (Te 3d 5/2 ) и 587,0 эВ (Te 3d 3/2 ) на рис. 2i были связаны с TeO 2 [33, 34]. На внутренних уровнях как Ge 3d, так и Te 3d отожженной нанопленки GeTe присутствуют компоненты, связанные с кислородом, как показано на рис. 2h и i, соответственно. Однако кислородный компонент отсутствовал на уровне ядра Ge 2p, который находился на большей глубине проникновения, как показано на рис. 2g. Кроме того, GeO 2 и ТеО 2 отсутствовали в характеристиках XRD и TEM, следовательно, это свидетельствует о том, что окисление атомов Ge и Te в основном локализовалось на поверхности пленки кислородом воздуха во время процессов переноса и отжига [34], а слой оксида был очень тонким. Кроме того, отожженные пленки GeTe были исследованы с помощью измерения Холла, которое показало проводимость p-типа.
Был изготовлен прототип фотогальванического детектора на основе гетероперехода p-GeTe / n-Si для исследования возможности использования этого материала в области оптоэлектроники. Процессы изготовления устройства показаны на рис. 3а. На рис. 3б изображена структура фотоприемника. Толщина пленки GeTe и алюминиевых электродов составляла 33 и 100 нм соответственно. На рисунках 3c и d показано время отклика устройства. Время нарастания ( t R ) определяется как время, необходимое для увеличения тока с 10 до 90% от пика, а время затухания ( t D ) - время, необходимое для уменьшения тока с 90 до 10%. Как показано, время нарастания и спада были симметричными с временем отклика (τ) 134 мс (например, (t R + t D ) / 2).
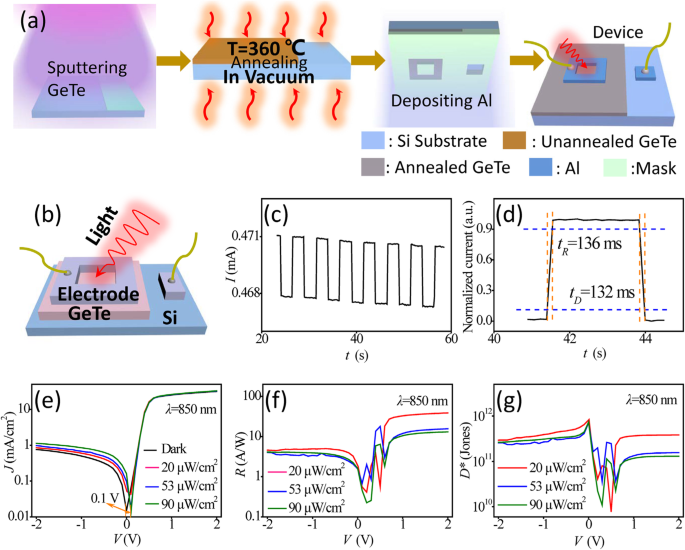
а Принципиальные схемы, иллюстрирующие процесс изготовления фотоэлектрического детектора на основе гетероперехода p-GeTe / n-Si и b структура устройства. c - г Временной фотоотклик аппарата. е Графики журнала ( J ) -V характеристики фотоэлектрического детектора в темноте (черная линия) и различной плотности излучения (цветные линии). е Графики R (отзывчивость) - V и g Д * (обнаруживаемость) - V характеристики фотоэлектрического детектора
Фотоответ устройства оценивался по J - V измерения с использованием источника Keithley 2400 при световом освещении. Журнал J по сравнению с V характеристики устройства, облученного λ =Свет 850 нм при различной плотности 20, 53 и 90 мкВт / см −2 и в темноте, выполненных при комнатной температуре, показаны на рис. 3e. Из рис. 3д видно, что напряжение, соответствующее минимальному значению Дж opt (т.е. плотность фототока) отклоняется на 0,1 В от напряжения, соответствующего минимальному значению Дж Д (то есть плотность темнового тока) в направлении положительного смещения, и что фотогенное напряжение генерировалось в условиях освещения. Таким образом, гетеропереход p-GeTe / n-Si продемонстрировал свое потенциальное применение в инфракрасном обнаружении.
Два важных показателя качества фотодетектора, такие как чувствительность ( R ) и обнаруживаемость ( D * ), определялись по следующим уравнениям [35, 36]:
$$ R =\ frac {I_p} {AP_ {opt}} $$ (2) $$ {D} ^ {\ ast} =\ frac {R \ sqrt {A}} {\ sqrt {2q \ left | { I} _d \ right |}} $$ (3)где I p - фототок, равный абсолютному значению тока при облучении за вычетом тока в темноте, A эффективная площадь устройства, P opt - падающая оптическая мощность, I d - темновой ток, а q - удельный заряд (1,6 × 10 −19 В).
Значения R и D * были 6–15 A / W и 1–8 × 10 11 Джонс (1 Джонс =1 см Гц 1/2 W -1 ), как показано на рис. 3f и g соответственно. Устройство было протестировано при комнатной температуре, без упаковки и без оптимизации. В таблице 1 перечислены чувствительность и обнаруживающая способность некоторых инфракрасных фотоприемников на основе гетероперехода халькогенид / Si; видно, что GeTe / Si показывает относительно более высокие характеристики при комнатной температуре, что может быть связано с большим коэффициентом поглощения и прямой запрещенной зоной GeTe.
Выводы
Кристаллические нанопленки GeTe были получены магнетронным распылением и обработкой после отжига. Изучены физические, электронные и оптические свойства нанопленок до и после отжига. После отжига при 360 ° C в нанопленке обнаружен дальний порядок и ширина запрещенной зоны 0,70 эВ. Фотогальванический детектор на основе гетероперехода p-GeTe / n-Si был изготовлен и продемонстрировал фотоотклик при облучении 850 нм с высоким значением R 6–15 A / W и D * из 1–8 × 10 11 Джонс со временем отклика 134 мс. Таким образом, в данной работе было продемонстрировано использование гетероперехода p-GeTe / n-Si для инфракрасного обнаружения. Он имеет огромный потенциал для интеграции с другими областями, такими как вычисления и хранение данных.
Доступность данных и материалов
Выводы, сделанные в этой рукописи, основаны на данных (основной текст и рисунки), представленных и показанных в этой статье.
Сокращения
- PVD:
-
Физическое осаждение из паровой фазы
- ТЕМ:
-
Просвечивающий электронный микроскоп
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- БПФ:
-
Быстрое преобразование Фурье
- AFM:
-
Атомно-силовой микроскоп
- XRD:
-
Рентгеновский дифрактометр
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
Наноматериалы



