Теоретическое и экспериментальное исследование диода Шоттки из AlGaN / GaN на подложке Si с двойным гетеропереходом
Аннотация
Диод с барьером Шоттки (SBD) AlGaN / GaN с двойным гетеропереходом теоретически и экспериментально исследован на GaN / AlGaN / GaN / Si-sub. Двумерный дырочный газ (2DHG) и электронный газ (2DEG) образуются на границе раздела GaN-вершина / AlGaN и AlGaN / GaN соответственно. В выключенном состоянии 2DEH и 2DHG частично истощаются, а затем полностью исчезают. Остаются фиксированные положительный и отрицательный поляризационные заряды, образующие поляризационный переход. Таким образом, получается плоское электрическое поле в области дрейфа и высокое напряжение пробоя (BV). Кроме того, анод утоплен для уменьшения напряжения включения ( В ВКЛ ). Процесс травления ICP с низким уровнем повреждений приводит к улучшенным контактам Шоттки, а также к низкому току утечки и низкому напряжению V . ВКЛ получается. Изготовленный SBD показывает BV 1109 В с расстоянием между анодом и катодом ( L AC ) 11 мкм. Изготовленные SBD достигают низкого V ВКЛ 0,68 В с хорошей однородностью, высокий коэффициент включения / выключения ∼ 10 10 при комнатной температуре низкое удельное сопротивление в открытом состоянии ( R ВКЛ, СП ) 1,17 мОм см 2 , и высокая добротность Балиги (FOM) 1051 МВт / см 2 .
Введение
Боковой диод на основе гетероструктуры AlGaN / GaN является привлекательным устройством из-за высокой подвижности электронов двумерного электронного газа (2DEG), высокой скорости насыщения электронов и высокого электрического поля пробоя [1,2,3]. Были предприняты значительные усилия для достижения низкого напряжения включения ( В ВКЛ ), низкий ток обратной утечки и высокое напряжение пробоя (BV) для GaN-диодов, используемых в преобразователях и инверторах для источников питания и коррекции коэффициента мощности [4,5,6,7,8,9,10,11,12] . Были предложены различные подходы к решению неравномерного распределения электрического поля. Одна из них - технология field-plate (FP) [5, 13]. Полностью утопленный анодный SBD с пластиной двойного поля обеспечивает высокое напряжение пробоя 1,9 кВ при 25 мкм L AC [5] . Он также может значительно снизить напряжение включения при сохранении высокого напряжения пробоя. Кроме того, традиционная концепция REduced SURface Field (RESURF), обычно используемая в кремниевой технологии, была продемонстрирована в GaN HEMT [14]. Кроме того, предлагается поляризационный переход (PJ), состоящий из двумерного дырочного газа (2DHG) над 2DEG, для улучшения взаимосвязи между удельным сопротивлением в открытом состоянии ( R ВКЛ, СП ) и BV [15,16,17,18]. Устройства на основе GaN, основанные на концепции PJ, были продемонстрированы на подложках из сапфира и SiC, в то время как высокая стоимость и малый диаметр GaN на подложках SiC противоречат массовому коммерческому применению. GaN-на-Si большого диаметра считается перспективным выбором из-за невысокой стоимости [19,20,21,22]. Таким образом, характеристики PJ-диода на кремниевой подложке заслуживают изучения.
В данной работе мы предложили и экспериментально продемонстрировали диод Шоттки на основе GaN / AlGaN / GaN-на-Si с двойным гетеропереходом (DJ). Эффект поляризационного перехода подтвержден моделированием и экспериментами. Достигается плоское электрическое поле (E-field) между анодным и катодным электродами. Процесс ICP для травления канавки Шоттки оптимизирован для достижения низкого обратного тока утечки и низкого V ВКЛ с отличной однородностью травления. Процесс омического контакта также оптимизирован для достижения низкого контактного сопротивления (для 2DEG) на основе индивидуализированного эпитаксиального слоя (с верхней частью из GaN 45 нм). Следовательно, напряжение пробоя 1109 В достигается для SBD с 11 мкм L AC а добротность Балиги составляет 1051 МВт / см 2 . Температурная зависимость и динамический R ВКЛ, СП производительность также исследуется.
Метод и эксперимент
Эпитаксиальный слой был выращен методом химического осаждения из газовой фазы на 6-дюймовом кремнии p-типа, состоящем из буферного слоя GaN толщиной 3,5 мкм, канального слоя GaN толщиной 150 нм, прослойки AlN толщиной 1 нм, Al толщиной 45 нм. 0,25 Ga 0,75 Барьерный слой N и верхний слой GaN толщиной 45 нм снизу вверх. Верхний слой GaN включает слой p-GaN толщиной 35 нм и нелегированный слой GaN толщиной 10 нм. Для заданной толщины AlGaN 45 нм плотность 2DHG увеличивается с увеличением толщины вершины GaN [22]. Толстый верхний слой GaN жизненно важен для 2DHG с высокой плотностью, в то время как он противоречит низкому омическому контактному сопротивлению (для 2DEG). Схематические изображения предлагаемого диода с барьером Шоттки с двойным гетеропереходом (DJ SBD) показаны на рис. 1а. Изготовление SBD началось с изоляции мезы с помощью Cl 2 / BCl 3 травление на основе индуктивно связанной плазмы (ICP) на глубину 300 нм. Затем омическая канавка и канавка анода Шоттки были сформированы с помощью процесса травления ICP с низким уровнем повреждений. Глубина омической канавки и канавки анода Шоттки составляла 50 нм и 90 нм соответственно, что было подтверждено с помощью атомно-силовой микроскопии (АСМ). Раствор гидроксида тетраметиламмония (TMAH) при 85 ° C в течение 15 минут вводили для удаления остатков после травления и модификации боковой стенки канавки после завершения процесса травления [23]. Затем отжиг при 400 ° С в течение 10 мин в N 2 эмбиент был проведен. Омический катод впоследствии был сформирован испаренным электронным пучком Ti / Al / Ni / Au (20/140/55/45 нм), отожженным при 870 ° C в течение 35 с в N 2 окружающей среды, с контактным сопротивлением ( R C ) 0,49 Ом · мм. Наконец, металл анода и межсоединения были осаждены Ni / Au для завершения производственного процесса. В устройствах были представлены различные L AC от 7 до 11 мкм. На Рисунке 1b показано ПЭМ-изображение поперечного сечения анода после ИСП и осаждения металла с высоким разрешением, при этом четко прослеживается структура слоев.
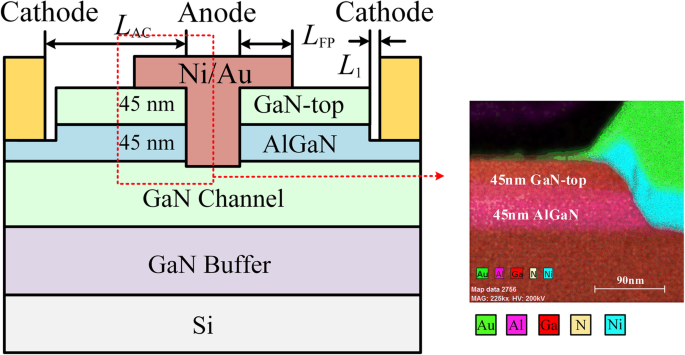
а Поперечное сечение предлагаемого SBD AlGaN / GaN с двойным гетеропереходом и основной процесс изготовления. L AC длина от анода до катода. L FP и L 1 равны 1 мкм и 2 мкм соответственно. б ВР-ТЕМ изображение анода после ИСП и осаждения металла
2DEG индуцируется положительными поляризационными зарядами вдоль границы раздела AlGaN / GaN. Верхняя граница раздела GaN / AlGaN имеет отрицательные поляризационные заряды и, следовательно, генерирует 2DHG на верхней границе раздела [15]. Зазор между дрейфовой областью и катодом ( L 1 ) используется для сокращения пути тока в отверстии, как показано на рис. 2. Мы исследовали только влияние L 1 от 2 до 3 мкм по прямой и обратной блокирующим характеристикам за счет ограничения оригинальной компоновочной конструкции. V ВКЛ и R ВКЛ, СП нет изменений, потому что L 1 не влияет на контакт Шоттки и путь электронного тока. Кроме того, BV немного уменьшается с увеличением L 1 из-за укороченной области дрейфа. Механизм работы DJ SBD при прямом смещении почти такой же, как и у обычных SBD, а это означает, что 2DHG практически не влияет на путь электронного тока от катода к аноду. С увеличением напряжения обратного смещения 2DEG и 2DHG полностью разряжены. Остаются фиксированные положительный и отрицательный поляризационные заряды, образующие поляризационный переход. В результате получается равномерное распределение электрического поля между катодом и анодом (рис. 3).
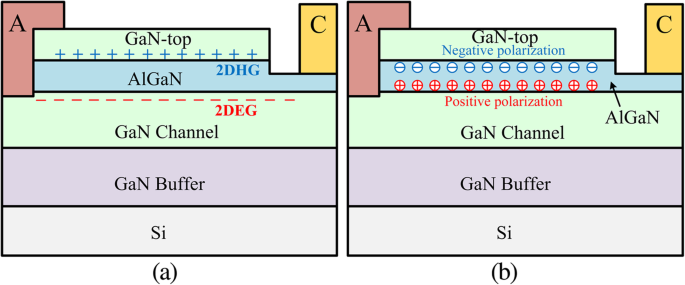
Анализ механизма работы DJ SBD a нулевое смещение и b обратное смещение

Распределение электрического поля вдоль гетерограницы канала AlGaN / GaN методом TCAD-моделирования. Доля Al определяется как 0,25. Чистая плотность акцепторов (глубокий уровень) в буферном слое установлена равной 1,5 × 10 16 . см −3 а уровень энергии на 0,45 эВ ниже минимума зоны проводимости. Плотность акцепторов на интерфейсе AlGaN / GaN установлена равной 6 × 10 12 . см −3 а уровень энергии на 0,23 эВ ниже минимума зоны проводимости
Как показано на рис. 3, характеристика пробоя и механизм поляризационного перехода были подтверждены 2-D Sentaurus TCAD от Synopsys. При моделировании мы учли несколько важных физических явлений, включая сужение запрещенной зоны, поляризацию, подвижность электронов и дырок, ударную ионизацию и рекомбинацию SRH.
Измерение эффекта Холла было принято для определения значений плотности и подвижности 2DHG или 2DEG [22]. Измерения проводились методом Ван-дер-Пау при комнатной температуре. Для измерения 2DHG согласно Ref. В [17] образцы для измерений Холла были изготовлены с омическими контактами Ni / Au. Плотность и подвижность 2DHG составляли 9 × 10 12 . см −2 и 15 см 2 / V s соответственно. ДЭГ измеряли на образцах с углубленной вершиной из GaN и частично из AlGaN, изготовленных с омическими контактами Ti / Al / Ni / Au (для 2DEG). Плотность и подвижность 2DEG составляли 8,5 × 10 12 см −2 и 970 см 2 / V s соответственно. Измерения Холла показали, что подвижность дырок все еще намного ниже, чем объемная подвижность на 100 см 2 . /Против. Ухудшение подвижности было приписано диффузии Mg из p-GaN в нелегированный GaN во время роста MOCVD.
Результаты и обсуждение
Измеренные I-V прямые характеристики SBD с различными L AC изображены на рис. 4а и б. Напряжение включения ( В ВКЛ ) составляет 0,68 В с небольшим отклонением 0,02 В. Фактор идеальности и высота барьера SBD рассчитываются как 1,44 ± 0,15 и 0,76 ± 0,04 эВ, соответственно. На рисунке 4a показано, что высокая плотность прямого тока 183 мА / мм и 144 мА / мм (при прямом смещении 2,5 В) и сопротивление в открытом состоянии 0,642 и 1,17 мОм см 2 достигаются при L AC =7 и 11 мкм соответственно. Кроме того, отличный коэффициент тока включения / выключения ∼ 10 10 получается, как показано на рис. 4b. Наклон подпорога (SS) составляет 63,0 мВ / дек, что близко к идеальному SS (59,6 мВ / дек).
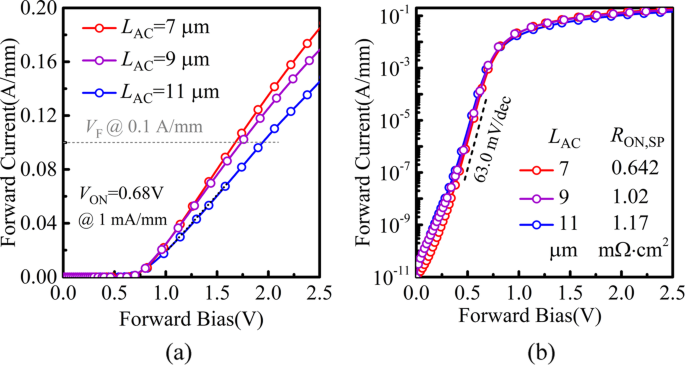
Измеренное прямое смещение I-V характеристики DJ SBD в a линейный и b полулогарифмический масштаб с разными L AC
На рисунке 5a показаны измеренные значения обратного блокирования I-V . характеристики SBD с различными L AC при 300 К. Напряжение пробоя устройств с разной L AC составляет 803 В, 940 В и 1109 В соответственно при токе утечки 1 мА / мм. При моделировании плотности 2DEG и 2DHG предполагаются одинаковыми. Однако экспериментальные результаты показывают, что плотности 2DHG (9 × 10 12 см −2 ) немного выше, чем у 2DEG (8,5 × 10 12 см −2 ). Разница между фиксированными зарядами положительной и отрицательной поляризации в выключенном состоянии влияет на баланс зарядов и, таким образом, ухудшает напряжение пробоя. Влияние L AC на BV и R ВКЛ, СП показан на рис. 5б. Почти линейная связь между BV и L AC , что подразумевает относительное плоское поперечное E-поле в дрейфовой области. Благодаря эффекту поляризационного перехода устройство демонстрирует высокую добротность Балиги (FOM =BV 2 / R ВКЛ, СП ) 1051 МВт / см 2 (@ L AC =11 мкм).
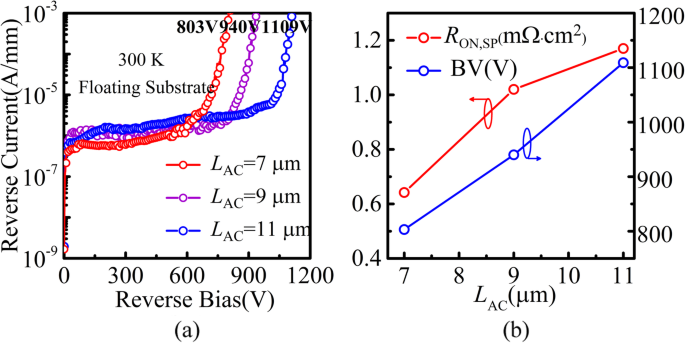
а Измеренная обратная блокировка I-V характеристики DJ SBD с разными L AC ( б ) R ВКЛ, СП и BV как функции от L AC
Процесс травления жизненно важен для качественного интерфейса Шоттки и омического контакта. На рис. 6а показана морфология поверхности углубления после травления ICP (@ 5 ° C) и раствора TMAH. Скорость травления составляет примерно 4,9 нм / мин, и окончательный выбранный рецепт - с Cl 2 4 sccm, мощность ICP 50 Вт и мощность RF 15 Вт. Среднеквадратичная шероховатость составляет 0,244 нм с площадью сканирования 2 × 2 мкм 2 .
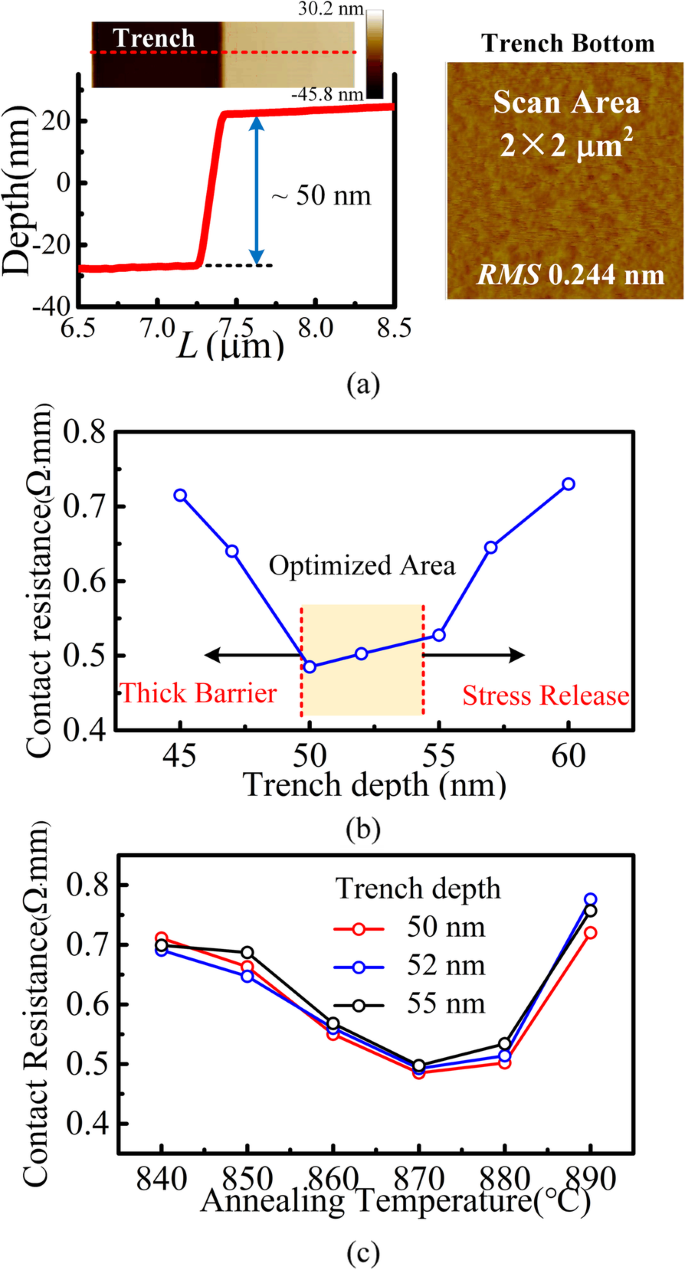
а АСМ морфология траншеи после травления ICP. б Влияние глубины травления на сопротивление омического контакта при испытании TLM. c Контактное сопротивление в зависимости от температуры отжига при глубине канавки от 50 до 55 нм. Время отжига 35 с
Поскольку индивидуальный эпитаксиальный слой включает верхний слой GaN 45 нм и слой AlGaN 45 нм, процесс омического контакта (для 2DEG) отличается от традиционных SBD. Без углубления как верхних слоев GaN, так и барьерных слоев AlGaN трудно достичь низкого контактного сопротивления путем отжига из-за потенциального барьера между омическим металлом и 2DEG. Однако, если барьер чрезмерно углублен, снятие напряжения приводит к снижению концентрации 2DEG. Для уменьшения омического контактного сопротивления используются дополнительные процессы. Поверхности образцов обрабатываются раствором HCl для удаления слоя естественного оксида перед нанесением. Кроме того, применяется плазменная обработка поверхности (мощность ICP 50 Вт BCl 3 10 sccm 3 min) для введения поверхностных донорных состояний [24]. На рис. 6б показана зависимость контактного сопротивления от глубины траншеи. Оптимизированная глубина получается от 50 до 55 нм. Высокотемпературный быстрый термический отжиг (RTA) для контакта Ti / Al / Ni / Au исследуется на рис. 6c. Температура отжига составляет от 840 до 890 ° C, а 870 ° C дает самое низкое контактное сопротивление. Отжиг при высокой температуре, то есть 870 ° C, способствует образованию TiN на границе раздела Ti / нитрид. Однако более высокая температура (например, 890 ° C) увеличивает взаимную диффузию Au и Al, что неблагоприятно для образования хороших омических контактов.
На рис. 7a – c показаны статистические графики статических характеристик, включая V ВКЛ , V F , и BV. Данные извлекаются из 72 SBD с L AC 7, 9 и 11 мкм, изготовленные в 3 отдельных технологических циклах. Устройства показывают стабильные характеристики прямого включения и V ВКЛ не зависит от L AC , потому что V ВКЛ в основном определяется контактом Шоттки. Процесс травления ICP с низким уровнем повреждений, точно контролируемая глубина канавки и высококачественный интерфейс Шоттки способствуют превосходной однородности V ВКЛ и V F . Кроме того, с увеличением L AC (от 7 до 11 мкм) наблюдается монотонный рост (∼ 100 В / мкм) BV в предлагаемых структурах. На рисунке 7d показана статистика гистограммы V ВКЛ для 72 устройств, а среднее значение составляет 0,68 В с небольшим стандартным отклонением 0,02 В.

Статистические графики a напряжение включения, b прямое напряжение и c напряжение пробоя, извлеченное из 72 SBD с L AC 7, 9 и 11 мкм, изготовленные в 3 отдельных технологических циклах. г Распространение V ВКЛ на 72 устройства
Температурная зависимость обратной и прямой характеристик оценена на рис. 8. Как показано на рис. 8а, увеличение температуры окружающей среды с 300 до 475 К приводит к увеличению R ВКЛ, СП в 1,94 раза.
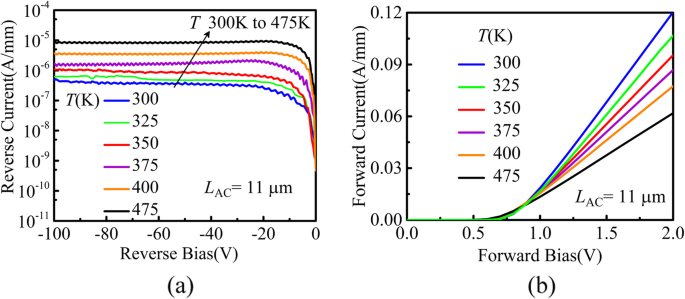
а Обратный ток утечки и b прямые характеристики для DJ SBD при разных температурах
Динамические характеристики DJ SBD измеряются анализатором силовых устройств Agilent B1505A. Точки смещения покоя анодного импульса устанавливаются равными -10 В, -20 В, -30 В, -40 В, -70 В и -100 В, с шириной анодного импульса и периодом 0,5 мс / 500 мс. На рисунке 9b показан динамический R ВКЛ, СП как функция напряжения напряжения. Динамический R ВКЛ, СП даже при 100 В резервное напряжение напряжения всего в 1,18 раза больше напряжения без обратного напряжения, что сравнимо с показателем Ref. [8]. Ограниченное увеличение динамического R ВКЛ, СП способствует снижению состояния интерфейса. Деградация динамического R ВКЛ, СП требуется доработка.
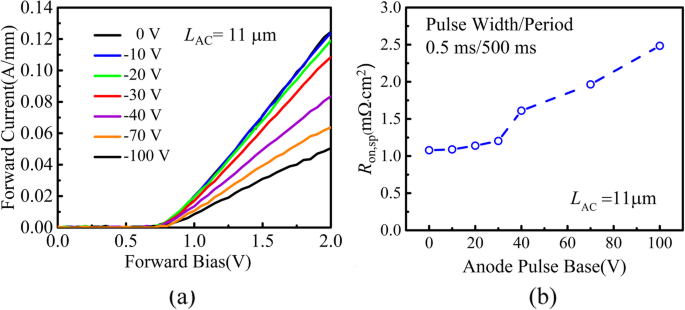
а I-V характеристики при импульсном измерении. б Извлечено R ВКЛ, СП в сравнении с базой анодного импульса с шириной / периодом импульса =0,5 мс / 500 мс
На рисунке 10 представлен сравнительный график зависимости BV от R . ВКЛ, СП для силового диода из GaN на подложках Si / SiC / сапфир [8, 10, 22, 25, 26, 27, 28, 29, 30, 31]. Предлагаемое устройство с L AC 11 мкм демонстрирует BV 1109 В с соответствующим R ВКЛ, СП 1,17 мОм см 2 , что приводит к высокому FOM Балиги 1051 МВт / см 2 . Это значение является лучшим результатом среди боковых силовых диодов на основе GaN на кремниевой подложке.
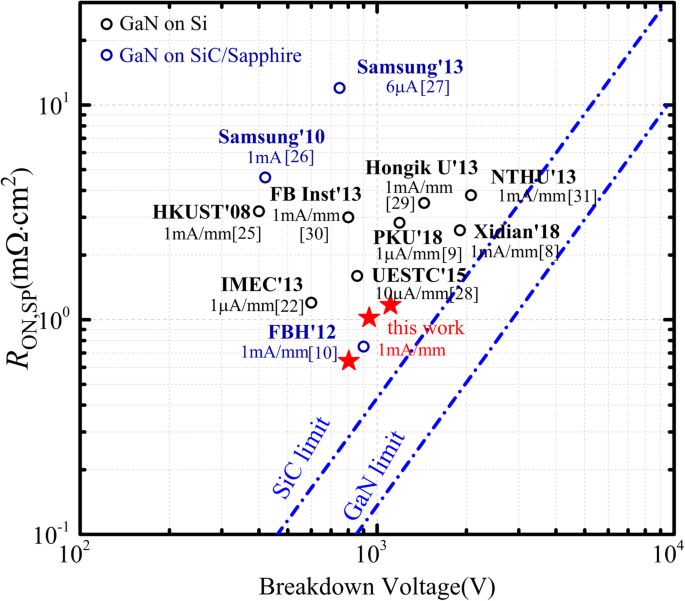
Контрольный график BV по сравнению с R ВКЛ, СП силового диода из GaN на подложках SiC / сапфир / Si. Также приводится обратная утечка, используемая для определения пробоя
Заключение
Изготовлен SBD GaN / AlGaN / GaN-на-Si с двойным гетеропереходом с высокой добротностью. Процесс травления ICP с низким уровнем повреждений приводит к оптимизированным омическим контактам и контактам Шоттки для предлагаемого устройства. Следовательно, низкий V ВКЛ 0,68 В с хорошей однородностью и низким R ВКЛ, СП 1,17 мОм см 2 получаются в устройстве с L AC 11 мкм. Высокий FOM Балиги 1051 МВт / см 2 достигается за счет эффекта поляризационного перехода. Высокая производительность в сочетании с недорогой технологией GaN-on-Si открывает большой потенциал для применения в энергетике будущего.
Доступность данных и материалов
Все данные, полученные или проанализированные в ходе этого исследования, включены в эту статью.
Сокращения
- SBD:
-
Диод с барьером Шоттки
- 2DEG / 2DHG:
-
Двумерный электронный / дырочный газ
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- ICP:
-
Индуктивно-связанная плазма
- ТЕМ:
-
Просвечивающий электронный микроскоп
- AFM:
-
Атомно-силовой микроскоп
- BV:
-
Напряжение пробоя
- R ВКЛ, СП :
-
Удельное сопротивление при включении
- V ВКЛ :
-
Напряжение включения
- FOM:
-
Достоинства
Наноматериалы
- Влияние состояний поверхности и мольной доли алюминия на поверхностный потенциал и 2DEG в HEMT из AlGaN / GaN
- Экспериментальные исследования стабильности и естественной конвекции наножидкости TiO2-вода в корпусах с раз…
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Совместно модифицированные ТИМы RGO и трехмерных графеновых сетей с высокой производительностью
- Экспериментальное исследование характеристик потока и теплопередачи наножидкостей TiO2-вода в трубке со спир…
- Графен / полианилиновый аэрогель со сверхэластичностью и высокой емкостью в качестве высокостойкого к сжати…
- Экспериментальное исследование этосом, инкапсулированных 5-фторурацилом, в сочетании с фракционным лазером …
- Обзор полупроводникового диода Шоттки со сверхширокой запрещенной зоной на основе Ga2O3 для применения в силов…
- Экспериментальные и теоретические исследования контакта Mo / Au Шоттки на механически отслоившейся тонкой пле…
- Преимущества и недостатки больших и малых углов спирали



