Улучшение распространения тока за счет локальной модуляции типа легирования в слое n-AlGaN для светодиодов глубокого ультрафиолетового излучения на основе AlGaN
Аннотация
В этом отчете мы локально модулируем тип легирования в n -AlGaN, предлагая n-AlGaN / p-AlGaN / n-AlGaN (NPN-AlGaN) -структурированный слой распределения тока для светодиодов глубокого ультрафиолетового излучения на основе AlGaN (DUV-светодиоды). После вставки тонкого слоя p-AlGaN в слой поставщика электронов n-AlGaN, барьер зоны проводимости может быть создан в n слой поставщика электронов, который обеспечивает модуляцию поперечного распределения тока в слое поставщика дырок p-типа для светодиодов DUV. Кроме того, согласно нашим исследованиям, концентрация легирования Mg, толщина, состав AlN для слоя вставки p-AlGaN и число переходов NPN-AlGaN оказывают большое влияние на эффект растекания тока. Правильно спроектированный слой распределения тока NPN-AlGaN может улучшить выходную оптическую мощность, внешнюю квантовую эффективность (EQE) и эффективность подключения к розетке (WPE) для светодиодов DUV.
Введение
Благодаря различным приложениям, таким как дезинфекция, очистка воды, лечение и оптическая запись высокой плотности [1,2,3,4,5,6,7,8], были вложены интенсивные усилия в разработку высокоэффективного AlGaN- на основе светодиодов глубокого ультрафиолета (DUV LEDs). На текущем этапе был достигнут значительный прогресс в улучшении кристаллического качества пленок AlGaN с высоким содержанием алюминия, например, выращивание пленок AlN на сапфировых подложках с наноразмерным рисунком с помощью квазиван-дер-ваальсовой эпитаксии с помощью графена может значительно снизить напряжение и уменьшить плотность дислокаций [9], что указывает на внутреннюю квантовую эффективность (IQE) 80% [10]. Стоит отметить, что такой IQE измеряется с помощью метода низкотемпературной фотолюминесценции, который не требует инжекции носителей. Однако светодиоды DUV работают от электрического смещения, которое связано с протеканием тока и переносом носителей [11,12,13]. Другим очень важным аспектом, касающимся протекания тока, является эффект скопления тока, который легко имеет место, когда устройство смещено на очень высоком уровне тока [14]. DUV-светодиоды имеют очень низкую эффективность легирования Mg в слое p-AlGaN с высоким содержанием AlN [15, 16], что приводит к низкой электропроводности. Кроме того, светодиоды DUV используют структуру flip-chip, которая имеет схему бокового ввода тока. Следовательно, по сравнению с УФ-светодиодами, синими и зелеными светодиодами на основе InGaN / GaN, DUV-светодиоды на основе AlGaN более подвержены действующему эффекту краудинга [17]. Возникновение эффекта сгущения тока либо на p-контактном электроде, либо на краю мезы приводит к неравномерной интенсивности электролюминесценции в множественных квантовых ямах (МКЯ) и повышению температуры перехода [18]. В результате действительно важно способствовать боковому распространению тока для светодиодов DUV. Для этой цели предложенный электрод p-типа с узкими полосками позволяет равномерно распределить ток, увеличивая, таким образом, эффективность розетки (WPE) на 60% [19]. Более того, слой распределения тока ITO / ZGO (ZnGaO) может лучше распределять ток и улучшать внешнюю квантовую эффективность (EQE), но повышенное межфазное сопротивление на интерфейсах ZGO / p-GaN делает WPE менее улучшенным для светодиодов DUV [20] .
Поэтому на данном этапе внимание исследователей уделяется стороне p, чтобы облегчить распространение тока для светодиодов DUV. В этой работе, в отличие от других подходов, мы предлагаем и доказываем, что улучшенное распределение тока в слое поставщика дырок p-типа для светодиодов DUV может быть достигнуто путем разработки слоя поставщика электронов n-AlGaN. Энергетический барьер создается в зоне проводимости путем модуляции типа легирования в слое поставщика электронов, т.е. предлагается и параметрически исследована структура n-AlGaN / p-AlGaN / n-AlGaN (NPN-AlGaN). Наши результаты показывают, что поперечное распределение отверстий можно гомогенизировать с помощью перехода NPN-AlGaN, что, таким образом, увеличивает выходную оптическую мощность, внешнюю квантовую эффективность и эффективность настенной розетки для светодиодов DUV. Еще одним преимуществом нашей конструкции является то, что с точки зрения эпитаксиального роста, наличие текущего слоя распределения в слое поставщика электронов n-типа дает эпи-гроверам больше свободы в оптимизации условий роста.
Методы исследования и физические модели
Структуры светодиодов NPN-AlGaN DUV схематически изображены на рис. 1а. В каждом исследованном светодиоде DUV имеется n-Al толщиной 4 мкм 0,60 Ga 0,40 N / p-Al x Ga 1− x N / n-Al 0,60 Ga 0,40 N-слой и концентрация легирования Si в n-Al 0,60 Ga 0,40 N область 5 × 10 18 см −3 . Затем пять пар Al 0,45 Ga 0,55 N / Al 0,56 Ga 0,44 Разработаны N активных слоев с множественными квантовыми ямами (МКЯ), для которых толщины квантовых ям и квантовых барьеров составляют 3 нм и 12 нм соответственно. МКЯ закрыты слоем p-Al, легированным магнием 0,60 толщиной 18 нм. Ga 0,40 Слой N, служащий p-EBL, после чего слой p-Al, легированный магнием, толщиной 50 нм 0,40 Ga 0.60 Далее следуют слой N и слой p-GaN, легированный магнием, толщиной 50 нм. Концентрация дырок для слоев p-EBL и поставщиков дырок установлена равной 3 × 10 17 . см −3 . Мы проектируем геометрию устройства с прямоугольной столешницей размером 350 × 350 мкм 2 . На рисунке 1b показаны схематические профили зоны проводимости, когда два перехода NPN-AlGaN (т.е. структура NPNPN-AlGaN) используются в структуре светодиода DUV, и мы можем видеть энергетические барьеры, существующие в обедненном p-Al х Ga 1− x N регионов. Энергетические барьеры могут регулировать горизонтальное распределение тока в слое поставщика отверстий p-типа. Обратите внимание:чтобы гарантировать прохождение тока через обратносмещенное соединение n-AlGaN / p-AlGaN, очень важно, чтобы слой вставки p-AGaN был полностью истощен, чтобы переход NPN-AlGaN находился в режиме сквозного пробоя. [21]. Подробный анализ и обсуждения будут представлены позже. Наш эталонный светодиод DUV идентичен светодиодам NPN-AlGaN DUV, за исключением того, что n-Al, легированный кремнием, толщиной 4 мкм 0,60 Ga 0,40 Слой N используется в качестве слоя поставщика электронов.
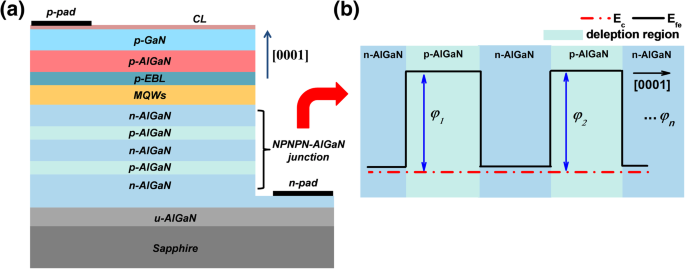
а Схематические структуры для светодиода NPN-AlGaN. б Схематический профиль зоны проводимости для структуры NPNPN-AlGaN, имеющей два перехода NPN-AlGaN; мы определяем высоту барьера для каждого перехода NPN-AlGaN как φ 1 , φ 2 , и φ n , и n - номер перехода NPN-AlGaN
Чтобы лучше понять физический механизм улучшенного эффекта распределения тока, который обеспечивается переходом NPN-AlGaN, эквивалентная схема для светодиода DUV со схемой боковой подачи тока показана на рис. 2a. Мы можем видеть, что ток течет от слоя поставщика дырок p-типа в область n-AlGaN как в вертикальном, так и в боковом направлениях. Если электрическое сопротивление слоя поставщика электронов n-AlGaN меньше, чем у слоя распределения тока (CL), ток имеет тенденцию концентрироваться в области под омическим контактом p-типа, т. Е. I 1 > Я 2 > Я 3 >…> Я n [14]. Включение переходов NPN-AlGaN в структуру DUV-светодиода может подавить эффект деструктивного тока скопления. Затем мы дополнительно упрощаем пути прохождения тока для светодиода NPN-AlGaN DUV на рис. 2b, так что общий ток можно разделить на вертикальную часть ( I 1 ) и горизонтальная часть ( I 2 ) из точки A в точку B . Следовательно, общее напряжение между двумя точками делится между слоем растекания тока, слоем p-GaN, слоем p-AlGaN, МКЯ, переходами NPN-AlGaN и слоем n-AlGaN. На основе текущих путей I 1 и я 2 , Уравнения. 1 и 2 получены, соответственно, и путем решения двух предыдущих формул Eq. Затем выводится 3:
$$ {I} _1 {R} _ {\ mathrm {CL} - \ mathrm {V}} + {I} _1 {R} _X + {I} _1 \ bullet N \ bullet {R} _ {npn} + { I} _1 \ left ({R} _ {n- \ mathrm {V}} + {R} _ {nL} \ right) ={U} _ {\ mathrm {AB}}, $$ (1) $$ {I} _2 \ left ({R} _ {\ mathrm {CL} - \ mathrm {L}} + {R} _ {\ mathrm {CL} - \ mathrm {V}} \ right) + {I} _2 {R} _X + {I} _2 \ bullet N \ bullet {R} _ {npn} + {I} _2 {R} _ {n- \ mathrm {V}} ={U} _ {\ mathrm {AB}} , $$ (2) $$ \ frac {I_1} {I_2} =1 + \ frac {R _ {\ mathrm {CL} - \ mathrm {L}} - {R} _ {n- \ mathrm {L}} } {R _ {\ mathrm {CL} - \ mathrm {V}} + {R} _X + {R} _n + N \ bullet {R} _ {npn}} $$ (3)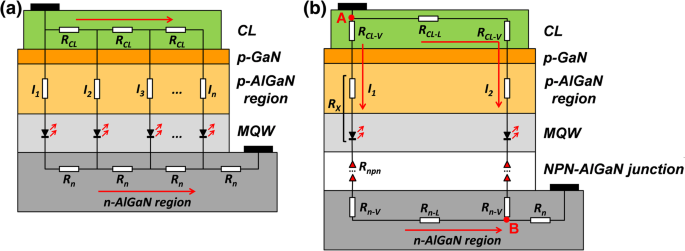
а Светодиоды DUV с эквивалентной схемой бокового ввода тока ( I 1 > Я 2 > Я 3 > ……> Я n ). б Упрощенная эквивалентная схема и пути тока со светодиодной подсветкой DUV со структурой NPN-AlGaN I 1 и я 2 выставлены
где R CL-V и R CL-L - вертикальное и горизонтальное сопротивления текущего растекающегося слоя соответственно; R n - V и R n - L обозначают вертикальное и горизонтальное сопротивления для слоя n-AlGaN соответственно; R n является суммой R n - V и R n - L (т. е. R n = R n - V + R n - L ) для текущего пути I 1 ; Суммирование сопротивления для области инжекции дырок p-типа и области МКЯ представлено как R x ; R npn - межфазное сопротивление, индуцированное высотой барьера в каждом переходе NPN-AlGaN; N означает общее количество переходов NPN-AlGaN и полное падение напряжения между точками A и B описывается U AB . Следует отметить, что токораспределительный слой толщиной 200 нм намного тоньше слоя поставщика электронов n-AlGaN толщиной 4 мкм для всех исследованных устройств. Следовательно, получается КЛ, электрическое сопротивление которой намного больше, чем у слоя n-AlGaN, т. Е. R CL-L - R n - L ≫ 0. Очевидно, что отношение I 1 / Я 2 можно уменьшить, сделав N × R npn увеличение значения . Следовательно, эффект распространения тока в слое поставщика дырок p-типа может быть улучшен за счет использования перехода NPN-AlGaN в слое поставщика электронов n-типа для светодиодных структур DUV. С одной стороны, N × R npn значение можно увеличить, увеличив N . С другой стороны, значение R npn зависит от компонента AlN, толщины и концентрации легирования Mg для слоя вставки p-AlGaN. Поэтому подробный анализ будет проведен в последующих обсуждениях.
Симулятор Crosslight APSYS используется для исследования физики устройства, а модели, которые мы используем, надежны в соответствии с нашими предыдущими публикациями о синих светодиодах на основе нитридов UVA и DUV [22,23,24]. В наших физических моделях коэффициент смещения энергетических зон для гетероперехода AlGaN / AlGaN установлен равным 50:50 [25]. Коэффициент оже-рекомбинации, время рекомбинации Шокли-Рида-Холла (SRH) и эффективность вывода света установлены равными 1.0 × 10 −30 см 6 / с [26], 10 нс [27] и ~ 8% [28] для светодиодов DUV соответственно. Вызванные поляризацией интерфейсные заряды на границе раздела решеток с рассогласованием решетки учитываются, принимая уровень поляризации равным 40% [29].
Результаты и обсуждения
Влияние структуры NPN-AlGaN на эффект распространения тока для светодиодов DUV
Светодиод A (то есть эталонный светодиод DUV без перехода NPN-AlGaN) и светодиод B (то есть светодиод DUV с переходом NPN-AlGaN) были сначала исследованы, чтобы исследовать влияние структуры NPN-AlGaN на гомогенизацию тока для слой поставщика отверстий p-типа. Каждый переход NPN-AlGaN имеет p-Al 0,60 толщиной 20 нм. Ga 0,40 Слой внедрения N, для которого концентрация легирования Mg составляет 1 × 10 18 см −3 . На рисунке 3а показан профиль энергетической зоны при плотности тока 170 А / см 2 . для светодиода B. В переходах NPN-AlGaN образуются два энергетических барьера в зоне проводимости, и образование энергетического барьера хорошо приписывается эффекту истощения введенного p-Al 0,60 Ga 0,40 N слой. Созданные барьеры в светодиоде B вызывают межфазное сопротивление R npn в области соединения NPN-AlGaN, что помогает уменьшить I 1 / Я 2 как указано в формуле. 3, так что больше отверстий будет проходить по текущему пути I 2 . Затем мы рассчитываем и показываем концентрацию горизонтальных дырок в последней квантовой яме (LQW) для светодиодов A и B, когда плотность тока составляет 170 А / см 2 , как показано на рис. 3b. Мы можем ясно видеть, что светодиод B имеет лучшее поперечное распространение тока по сравнению со светодиодом A. Таким образом, мы доказываем, что NPN-AlGaN в слое поставщика электронов n-типа облегчает эффект распространения тока в слое поставщика дырок p-типа для Светодиоды DUV.

а Профиль энергетической зоны для светодиода B, в котором мы определяем зону проводимости, квазиуровни Ферми для электронов и дырок, а также валентную зону как E c , E fe , E fh , и E v , соответственно. б Концентрация горизонтальных отверстий в LQW для светодиодов A и B при плотности тока 170 А / см 2
Помимо отображения концентрации боковых дырок, мы также демонстрируем уровни концентрации дырок в МКЯ для светодиодов A и B на рис. 4a. Мы можем видеть, что из-за улучшенного эффекта растекания тока концентрация дырок в МКЯ увеличена для светодиода B по сравнению с таковым для светодиода A. Повышенный уровень концентрации дырок в МКЯ больше способствует излучательной рекомбинации для светодиода B (см. Рис. 4b).
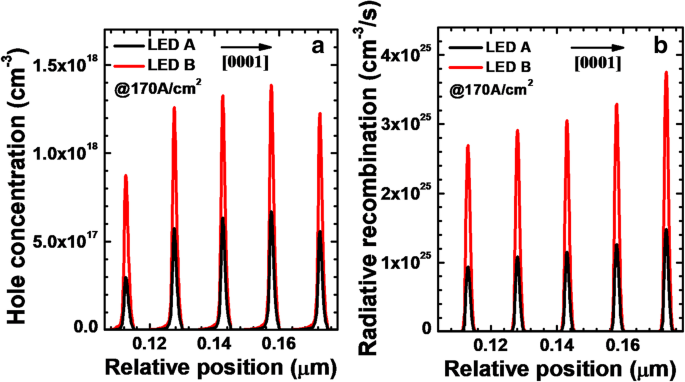
а Уровни концентрации в лунках и b профили излучательной рекомбинации в МКЯ для светодиодов A и B соответственно. Мы собираем данные на расстоянии 120 мкм от правого края мезы при плотности тока 170 А / см 2 .
Влияние перехода NPN-AlGaN также оправдано расчетными оптическими и электрическими характеристиками для светодиодов A и B, как показано на рис. 5. На рис. 5a представлены EQE и плотность оптической мощности как функция инжектируемого тока для обоих светодиодов. A и B. Мы можем видеть, что у светодиода B как EQE, так и плотность оптической мощности выше, чем у светодиода A, благодаря улучшенному эффекту распределения тока и эффективности инжекции дырок, обеспечиваемым переходом NPN-AlGaN. Например, увеличение плотности оптической мощности для светодиода B составляет ~ 1,67% при плотности тока 170 А / см 2 . согласно рис. 5а. Исследования на рис. 5b показывают, что прямое напряжение для светодиода B с переходом NPN-AlGaN имеет небольшое увеличение по сравнению с таковым для светодиода A. Мы связываем это явление с энергетическими барьерами в областях истощения, которые вызваны NPN-AlGaN. переходы. К счастью, более высокое прямое напряжение светодиода B не оказывает отрицательного влияния на эффективность подключения к розетке (WPE), а WPE для светодиода B превышает таковое для светодиода A, когда плотность тока инжекции превышает ~ 56 A / см 2 как показано на рис. 5с. Мы считаем, что как улучшенный EQE, так и WPE могут быть реализованы после того, как соединение NPN-AlGaN будет оптимизировано, что будет полностью исследовано следующим образом.
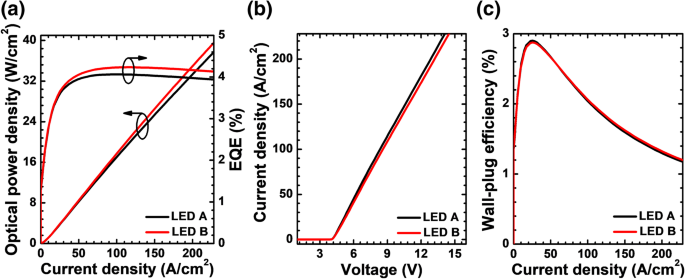
а EQE и плотность оптической мощности с точки зрения инжекционного тока, b вольт-амперная характеристика, и в WPE как функция тока инжекции для светодиодов A и B
Влияние состава AlN для слоя p-AlGaN на текущий эффект распространения
В этом разделе исследуется влияние состава AlN для перехода NPN-AlGaN на оптические и электрические свойства светодиодов DUV. Чтобы наглядно проиллюстрировать этот механизм, мы используем пять светодиодов DUV, то есть светодиоды C i ( я =1, 2, 3, 4 и 5) с разными NPN-Al x Ga 1− x N-переходы, для которых составы AlN для p-Al x Ga 1− x N вводимых слоев составляют 0,60, 0,63, 0,66, 0,69 и 0,72 соответственно. Концентрация легирования и толщина для p-Al x Ga 1− x N слой 1,8 × 10 18 см −3 и 20 нм соответственно. Для всех исследованных устройств используются два перехода NPN-AlGaN, т.е. переход NPNPN-AlGaN. Затем мы вычисляем высоту барьера зоны проводимости для каждого NPN-Al x Ga 1− x N переход для светодиодов C i ( я =1, 2, 3, 4 и 5), как показано в таблице 1. Отчетливо видно, что значение высоты барьера проводимости увеличивается с увеличением состава AlN для p-Al x Ga 1− x N вставной слой увеличивается. Высокая высота барьера проводимости может привести к значению R npn увеличение и уменьшение отношения I 1 / Я 2 одновременно запускается, как указано в формуле. 3. Чтобы доказать эту точку зрения, латеральные распределения дырок в последней квантовой яме для всех исследованных устройств при плотности тока 170 А / см 2 рассчитаны и представлены на рис. 6а. Для светодиода C1 распределение отверстий можно модулировать после NPN-Al 0,60 Ga 0,40 Принята структура N, и очевидно, что эффект распространения тока получает дальнейшее улучшение, когда компонент AlN в слое вставки p-AlGaN увеличивается до 0,63 для наших структур.
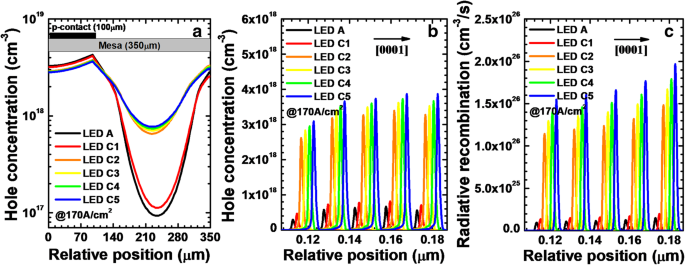
а Концентрация горизонтальных стволов в LQW, b уровни концентрации дырок и c Профили излучательной рекомбинации в МКЯ для светодиодов A и D i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2 . Мы намеренно сдвигаем кривые для b и c на 2 нм для облегчения идентификации
Мы демонстрируем моделируемые уровни концентрации дырок и профили излучательной рекомбинации в МКЯ для светодиодов A и C i ( я =1, 2, 3, 4 и 5) на рис. 6b и c при плотности тока 170 А / см 2 , соответственно. Уровни концентрации дырок и профили излучательной рекомбинации собираются на расстоянии 120 мкм от правого края мезы. Мы смещаем в пространстве уровни концентрации дырок и профили излучательной рекомбинации на рис. 6b и c для исследованных светодиодов DUV на 2 нм для облегчения идентификации соответственно. Самая низкая концентрация дырок в МКЯ четко наблюдается для светодиода A, и, таким образом, самая низкая излучательная рекомбинация также показана на рис. 6c. Концентрация дырок и излучательная рекомбинация в МКЯ увеличиваются из-за перехода NPN-AlGaN, и они могут быть еще больше увеличены с увеличением состава AlN в слое вставки p-AlGaN.
Далее рассчитываются плотность оптической мощности и EQE как функция плотности тока инжекции, которые показаны для исследуемых светодиодов на рис. 7a. Как показано на рисунке, EQE и плотность оптической мощности увеличиваются после перехода на соединение NPN-AlGaN. Более того, EQE и плотность оптической мощности могут быть дополнительно улучшены по мере увеличения состава AlN для слоя вставки p-AlGaN. Мы вносим это в более однородное распределение боковых отверстий в МКЯ, как показано на рис. 6а. Вольт-амперные характеристики светодиодов A и C i ( я =1, 2, 3, 4 и 5) представлены на рис. 7б. Прямое напряжение для светодиода C1 немного увеличивается по сравнению со светодиодом A, а светодиод C5 показывает наибольшее прямое напряжение. На вставке показано прямое напряжение для всех исследованных светодиодов при плотности тока 170 А / см 2 . . Примечательно, что прямое напряжение уменьшается для светодиодов C2, C3 и C4 по сравнению со светодиодом A. Хотя переход NPN-AlGaN увеличивает вертикальное сопротивление для светодиодов DUV, более равномерная концентрация носителей в горизонтальном направлении улучшает горизонтальную проводимость, что приводит к снижению прямого напряжения. Это указывает на то, что усиленный эффект распределения тока может помочь снизить прямое рабочее напряжение для светодиодов DUV, если слой распределения тока спроектирован должным образом [30]. Однако наша конструкция модулирует путь тока, создавая барьеры, и, следовательно, слишком большая высота барьера может принести в жертву электропроводность [21], например, светодиод C5.
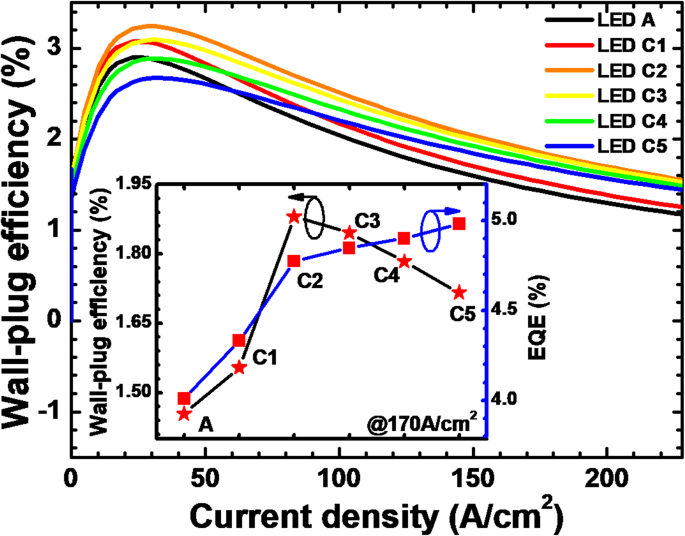
а EQE и плотность оптической мощности с точки зрения тока инжекции и b вольт-амперные характеристики светодиодов A и C i ( я =1, 2, 3, 4 и 5). На вставке:прямые напряжения для светодиодов A и C i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2
WPE как функция плотности тока инжекции для всех исследованных устройств показан на рис. 8. По сравнению со светодиодом A, WPE светодиода C1 увеличивается после перехода NPN-AlGaN. WPE для светодиодов C i ( я =2, 3, 4 и 5) могут быть дополнительно улучшены, когда состав AlN слоя p-AlGaN увеличивается для перехода NPN-AlGaN. Однако светодиод C2 показывает самый высокий WPE из-за самого низкого прямого рабочего напряжения, несмотря на относительно низкую плотность оптической мощности среди светодиодов C i ( я =2, 3, 4 и 5). Кроме того, мы показываем WPE и EQE при плотности тока инжекции 170 А / см 2 . для всех исследованных устройств на вставке. Хорошо известно, что эффект вытеснения тока серьезен при высокой плотности тока инжекции. Переход NPN-AlGaN для светодиода C5 лучше всего подходит для гомогенизации тока. Однако WPE не является удовлетворительным, если прямое рабочее напряжение значительно увеличивается. Следовательно, необходимо полностью оптимизировать значение компонента AlN слоя вставки p-AlGaN для соединения NPN-AlGaN, прежде чем можно будет получить улучшение как для EQE, так и для WPE.
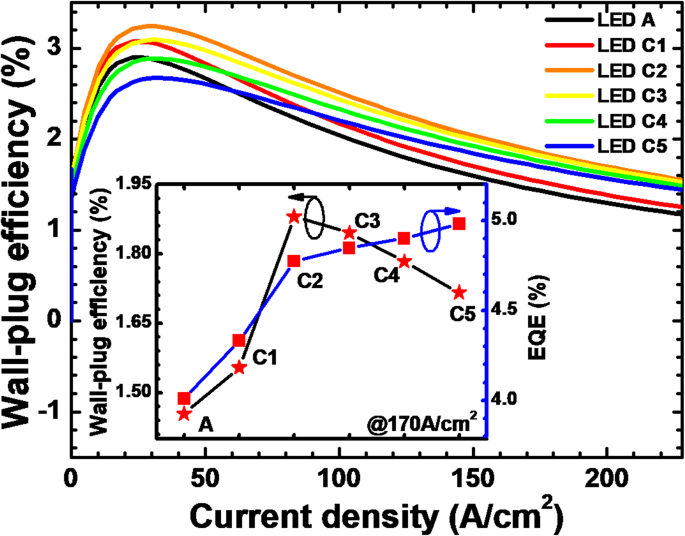
Взаимосвязь между WPE и током инжекции для светодиодов A и C i ( я =1, 2, 3, 4 и 5). На вставке:EQE и WPE для исследованных светодиодов, структурированных слоем p-AlGaN с различными компонентами AlN при плотности тока 170 А / см 2 .
Влияние концентрации легирования магнием для слоя p-AlGaN на эффект распространения тока
Шириной обедненной области для перехода NPN-AlGaN можно управлять, изменяя концентрацию легирования Mg для слоя вставки p-AlGaN, и высота барьера зоны проводимости также будет изменяться соответствующим образом. Таким образом, значение R npn может быть увеличен, когда область истощения соединения NPN-AlGaN станет широкой, а значение I 1 / Я 2 будет уменьшено, то есть эффект распространения тока для светодиодов DUV может быть улучшен. Для лучшего понимания этого момента были разработаны и исследованы пять светодиодов DUV с различными концентрациями легирования Mg для вставочного слоя p-AlGaN в переходе NPN-AlGaN. Мы установили концентрацию легирования Mg для слоя p-AlGaN равной 3 × 10 17 . , 7,5 × 10 17 , 1,7 × 10 18 , 2 × 10 18 , и 3 × 10 18 см −3 для светодиодов D i ( я =1, 2, 3, 4 и 5) соответственно. Толщина и состав AlN для вставочного слоя p-AlGaN составляют 20 нм и 0,61 соответственно. Мы используем два перехода NPN-AlGaN. Как показано в таблице 2, высота барьера зоны проводимости увеличивается по мере увеличения концентрации легирования Mg для слоя p-AlGaN. Затем мы вычисляем и показываем концентрацию боковых дырок в последней квантовой яме при плотности тока 170 А / см 2 . на рис. 9a, и очевидно, что по сравнению с распределением боковых отверстий для светодиода A, распределение боковых отверстий становится более равномерным, когда переход NPN-AlGaN вводится для светодиодов DUV. Более того, еще более гомогенизированное распределение дырок может быть получено после увеличения концентрации легирования Mg для слоя p-AlGaN в переходе NPN-AlGaN.
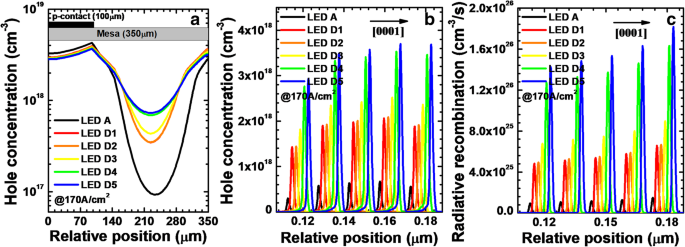
а Концентрация горизонтальных стволов в LQW, b уровни концентрации дырок и c Профили излучательной рекомбинации в МКЯ для светодиодов A и D i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2 . Мы намеренно сдвигаем кривые для b и c на 2 нм для облегчения идентификации
Затем рассчитанные уровни концентрации дырок и профили излучательной рекомбинации в МКЯ демонстрируются для всех исследованных светодиодов на рис. 9б и в при плотности тока 170 А / см 2 . соответственно, а место, где собираются данные, находится на расстоянии 120 мкм от правого края мезы. Как и ожидалось, светодиоды D i ( я =1, 2, 3, 4 и 5) имеют более высокие уровни концентрации дырок и профили излучательной рекомбинации в МКЯ по сравнению со светодиодом A, в то время как концентрация дырок и излучательная рекомбинация увеличиваются с увеличением концентрации легирования Mg в слое p-AlGaN. для светодиодов с переходами NPN-AlGaN. Мы вносим рост концентрации дырок в МКЯ для светодиодов D i ( я =1, 2, 3, 4 и 5) к усиленному эффекту распространения тока.
Из-за уменьшения эффекта скапливания тока и увеличения концентрации дырок в MQW светодиоды D i ( я =1, 2, 3, 4 и 5) соответственно показывают усиленный EQE и плотность оптической мощности (см. Рис. 10a). Вольт-амперные характеристики светодиодов A и D i ( я =1, 2, 3, 4 и 5) показаны на рис. 10б. По всей видимости, прямые рабочие напряжения для светодиодов D i ( я =1, 2, 3, 4 и 5) возрастают с увеличением концентрации легирования Mg для слоя вставки p-AlGaN. Среди них светодиод D5 показывает самое большое напряжение включения, и это связано с паразитным диодом, вызванным очень высокой концентрацией легирования Mg в слое p-AlGaN. На вставке на рис. 10b также видно, что светодиод D5 показывает самое большое прямое рабочее напряжение среди всех исследованных светодиодов, когда плотность тока инжекции составляет 170 А / см 2 .
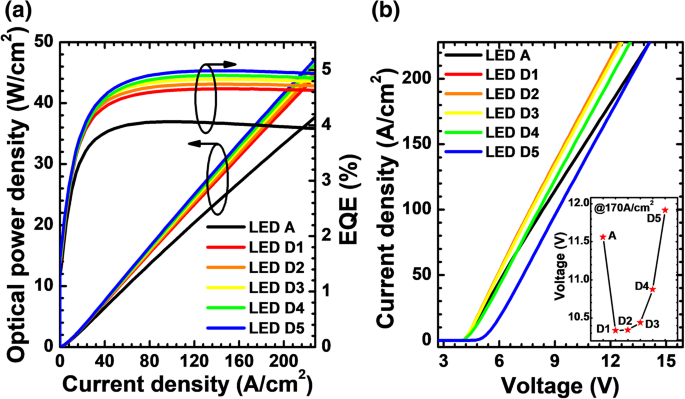
а EQE и плотность оптической мощности с точки зрения тока инжекции и b вольт-амперные характеристики светодиодов A и D i ( я =1, 2, 3, 4 и 5). На вставке:прямые напряжения для светодиодов A и D i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2
Для более полного анализа мы вычисляем WPE как функцию плотности тока инжекции для всех исследованных светодиодов, как показано на рис. 11. WPE для светодиодов D i ( я =1, 2, 3 и 4) выше, чем для светодиода A. WPE для светодиода D5 превышает WPE для светодиода A только тогда, когда плотность инжектируемого тока больше 43 А / см 2 . Нижний WPE для светодиода D5 при плотности тока менее 43 А / см 2 происходит из-за дополнительного потребления прямого напряжения на переходе NPN-AlGaN, как упоминалось ранее. Из рисунка-вставки видно, что EQE показывает восходящую тенденцию с увеличением концентрации легирования Mg для слоя p-AlGaN. Однако WPE уменьшается с дальнейшим увеличением концентрации легирования Mg для слоя p-AlGaN. Следовательно, мы заключаем, что эффект растекания тока и прямое напряжение очень чувствительны к уровню легирования Mg вставляемого слоя p-AlGaN.
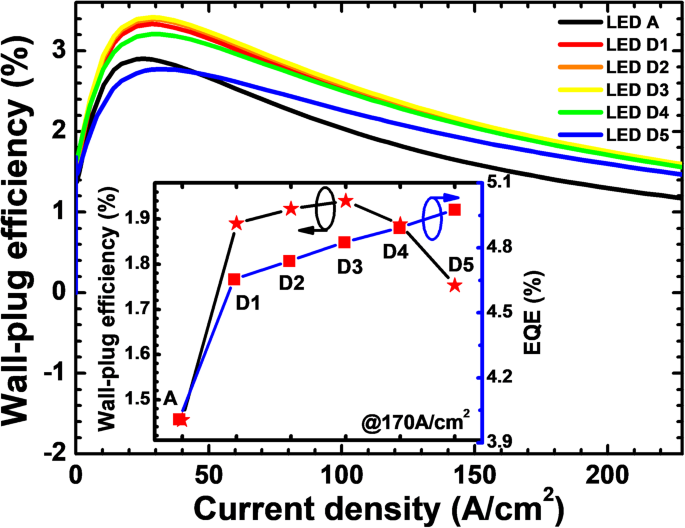
Взаимосвязь между WPE и током инжекции для светодиодов A и D i ( я =1, 2, 3, 4 и 5). На вставке:EQE и WPE для исследованных светодиодов, структурированных слоем p-AlGaN с различной концентрацией легирования при плотности тока 170 А / см 2 .
Влияние толщины слоя p-AlGaN на текущий эффект растекания
В этом разделе исследуется влияние толщины вставочного слоя p-AlGaN в переходе NPN-AlGaN на характеристики светодиода. Прежде всего, два перехода NPN-AlGaN (т.е. переход NPNPN-AlGaN) применяются для всех исследованных светодиодов DUV, из которых состав AlN и концентрация легирования для слоя p-AlGaN в переходе NPN-AlGaN составляют 0,61 и 1,5 × 10 18 см −3 , соответственно. Затем мы установили разную толщину 18, 20, 24, 28 и 32 нм для слоя p-AlGaN в светодиодах T i ( я =1, 2, 3, 4 и 5) соответственно. Расчетные высоты барьера зоны проводимости для каждого перехода NPN-AlGaN представлены в таблице 3. Можно видеть, что высота барьера зоны проводимости увеличивается, когда слой p-AlGaN в переходе NPN-AlGaN становится толстым, что позволяет уменьшить <я> Я 1 / Я 2 и, соответственно, улучшенное распространение тока.
Рассчитаем и покажем концентрацию горизонтальных дырок в LQW для светодиодов A и T i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2 на рис. 12а. Ясно, что распределение дырок становится более однородным, когда переход NPN-AlGaN вводится в структуру светодиода DUV, и оно становится более однородным, если толщина слоя p-AlGaN в переходе NPN-AlGaN становится больше. Уменьшение эффекта затягивания тока приписывается более высокой высоте барьера зоны проводимости в обедненной области, вызванной утолщением слоя p-AlGaN в переходе NPN-AlGaN. На рисунках 12b и c показаны уровни концентрации дырок и профили излучательной рекомбинации, соответственно, для светодиодов A и T i ( я =1, 2, 3, 4 и 5) при плотности тока инжекции 170 А / см 2 . Уровни концентрации дырок и профили излучательной рекомбинации собираются на расстоянии 120 мкм от правого края мезы. Мы можем видеть, что по сравнению со светодиодом A в MQW, светодиоды T i ( я =1, 2, 3, 4 и 5) показывают более высокие уровни концентрации дырок и, следовательно, более высокие профили излучательной рекомбинации. После увеличения толщины слоя p-AlGaN можно получить дальнейшую повышенную концентрацию дырок и излучательную рекомбинацию в МКЯ.
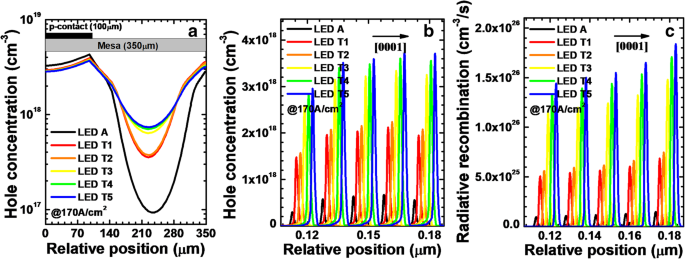
а Концентрация горизонтальных стволов в LQW, b уровни концентрации дырок и c Профили излучательной рекомбинации в МКЯ для светодиодов A и T i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2 . Мы намеренно сдвигаем кривые для b и c на 2 нм для облегчения идентификации
Наблюдаемая плотность оптической мощности и EQE для всех исследованных светодиодов на рис. 13a хорошо согласуются с результатами, показанными на рис. 12c, так что увеличение толщины слоя p-AlGaN в переходе NPN-AlGaN может улучшить плотность оптической мощности и EQE. Кроме того, рассчитываем и показываем вольт-амперные характеристики для светодиодов A и T i ( я =1, 2, 3, 4 и 5) на рис. 13б. Он показывает, что прямые рабочие напряжения для светодиодов T i ( я =1, 2, 3 и 4) демонстрируют значительное уменьшение по сравнению с таковым для светодиода A при плотности тока инжекции более 102 А / см 2 , что связано с значительно улучшенным эффектом распространения тока после принятия NPN-Al 0,61 Ga 0,39 N-переход, как упоминалось ранее. Однако слишком толстый слой p-AlGaN может вызвать увеличение напряжения включения из-за паразитного диода N-AlGaN / P-AlGaN, например, светодиод T5 имеет самое высокое прямое рабочее напряжение среди всех исследованных светодиодов, когда ток плотность 170 А / см 2 , что также показано на вставке рис. 13b.
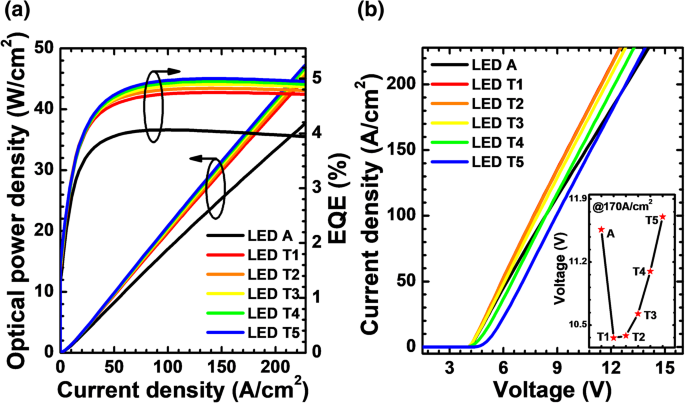
а EQE и плотность оптической мощности с точки зрения тока инжекции и b вольт-амперные характеристики светодиодов А и Т i ( я =1, 2, 3, 4 и 5). На вставке:прямые напряжения для светодиодов A и T i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2
С этой целью особенно важно дополнительно обсудить влияние более высокого прямого рабочего напряжения на характеристики светодиодов DUV. Поэтому мы вычисляем WPE для всех исследуемых устройств и показываем результаты на рис. 14. Мы видим, что WPE для всех светодиодов с переходом NPN-AlGaN демонстрирует явное улучшение по сравнению с таковым для светодиода A. Представленные WPE на вставке На рисунке также показано, что светодиод DUV со структурой NPN-AlGaN может экономить больше электроэнергии, чем светодиод A. Стоит упомянуть, что толщину слоя p-AlGaN невозможно улучшить вслепую, так что только при правильной установке толщины затем можно получить полностью развернутый WPE.
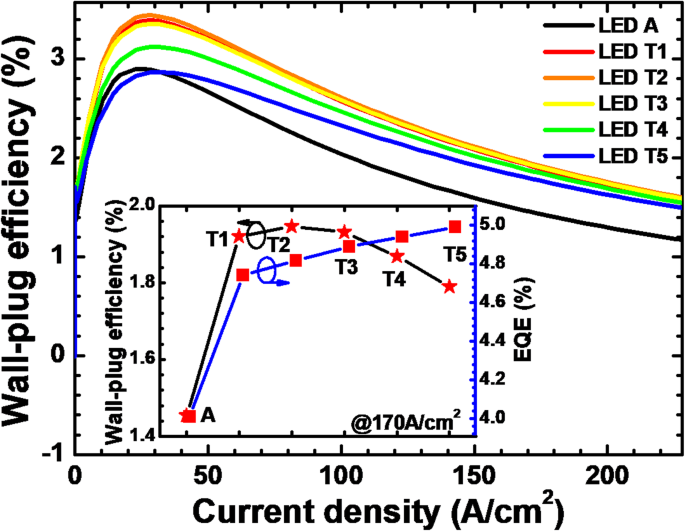
Взаимосвязь между WPE и током инжекции для светодиодов A и T i ( я =1, 2, 3, 4 и 5). На вставке:EQE и WPE для исследованных светодиодов, структурированных слоем p-AlGaN различной толщины при плотности тока 170 А / см 2 .
Влияние номера соединения NPN-AlGaN на текущий эффект распространения
Наконец, мы исследуем влияние числа переходов NPN-AlGaN на эффект распространения тока. P-Al 0,61 Ga 0,39 Слой N используется в переходе NPN-AlGaN для предлагаемых в этом разделе светодиодов DUV, для которых концентрация легирования Mg и толщина составляют 1,5 × 10 18 см −3 и 20 нм соответственно. Светодиоды N i ( я =1, 2, 3, 4 и 5) имеют 1, 2, 3, 4 и 5 переходов NPN-AlGaN соответственно. Как показано в Таблице 4, высота барьера проводимости всех переходов NPN-AlGaN почти одинакова для светодиодов N i ( я =1, 2, 3, 4 и 5). Однако общая высота барьера проводимости для NPN-Al 0,61 Ga 0,39 Количество N переходов в каждом исследованном светодиоде DUV обязательно увеличивается при увеличении количества NPN-Al 0,61 Ga 0,39 Используются N-переходы. Таким образом, значение N × R npn может быть усилен, что помогает лучше распределить ток по горизонтали, т. е. увеличенное значение I 2 в формуле. 3 - предпочтение. Эффект усиленного растекания тока можно наблюдать на рис. 15а. Концентрация дырок в LQW может стать более однородной, если число переходов NPN-AlGaN станет больше.
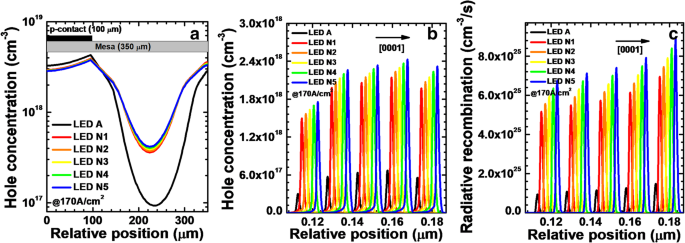
а Концентрация горизонтальных стволов в LQW, b концентрация дырок и c Профили излучательной рекомбинации в МКЯ для светодиодов A и N i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2 . Мы намеренно сдвигаем кривые для b и c на 2 нм для облегчения идентификации
Затем уровни концентрации дырок и профили излучательной рекомбинации в МКЯ для светодиодов N i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2 представлены на рис. 15б и в соответственно. Мы собираем уровни концентрации дырок и профили излучательной рекомбинации на расстоянии 120 мкм от правого края мезы. Концентрация дырок и излучательная рекомбинация улучшаются при использовании NPN-Al 0,61 Ga 0,39 N-переход, и дальнейшее улучшение может быть достигнуто, если будет включено больше переходов NPN-AlGaN. Благодаря повышенной концентрации дырок в MQW, плотность оптической мощности и EQE для светодиодов DUV с переходом NPN-AlGaN также показывает значительное улучшение. Вольт-амперные характеристики для всех исследованных устройств показаны на рис. 16б, который показывает, что прямые рабочие напряжения для светодиодов N i ( я =1, 2, 3, 4 и 5) ниже, чем у светодиода A, и это указывает на то, что эффект распределения тока может помочь снизить прямое напряжение, если концентрация легирования Mg, толщина и состав AlN для p- Слой AlGaN соответствующим образом наносится на переход NPN-AlGaN. Напряжение включения для всех светодиодов с переходом NPN-AlGaN почти такое же, как и для светодиода A, что демонстрирует незначительное влияние обратно смещенного паразитного перехода N-AlGaN / P-AlGaN, если концентрация легирования Mg в p- Слой AlGaN настроен правильно, т. Е. Слой p-AlGaN должен быть полностью истощен, прежде чем устройство будет смещено.
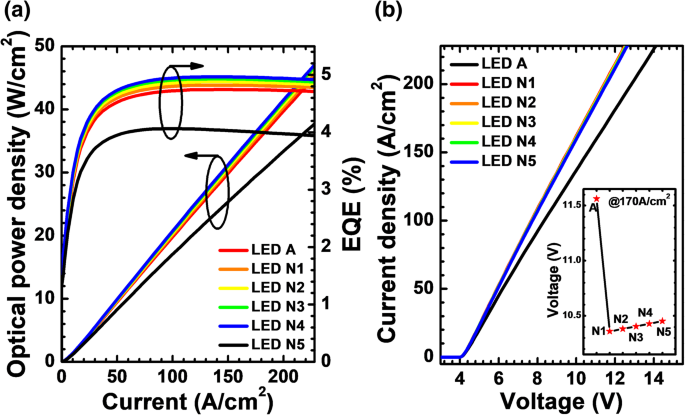
а EQE и плотность оптической мощности с точки зрения тока инжекции и b вольт-амперные характеристики светодиодов A и N i ( я =1, 2, 3, 4 и 5). На вставке:прямые напряжения для светодиодов A и N i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2
И последнее, но не менее важное:WPE были также продемонстрированы для светодиодов N i ( я =1, 2, 3, 4 и 5) на рис. 17. WPE всех светодиодов DUV с NPN-Al 0,61 Ga 0,39 N-переход был продвинут из-за пониженного прямого рабочего напряжения. На вставке мы показываем EQE и WPE для светодиодов A и N i ( я =1, 2, 3, 4 и 5) при плотности тока 170 А / см 2 . Хотя EQE и WPE для светодиодов N i ( я =1, 2, 3, 4 и 5) увеличиваются с увеличением числа переходов NPN-AlGaN, ясно видно, что величина увеличения постепенно уменьшается, что указывает на то, что число переходов NPN-AlGaN также должно установить правильное число, и мы твердо уверены, что устройство будет потреблять больше электроэнергии, если в светодиодах DUV используется слишком много переходов NPN-AlGaN.
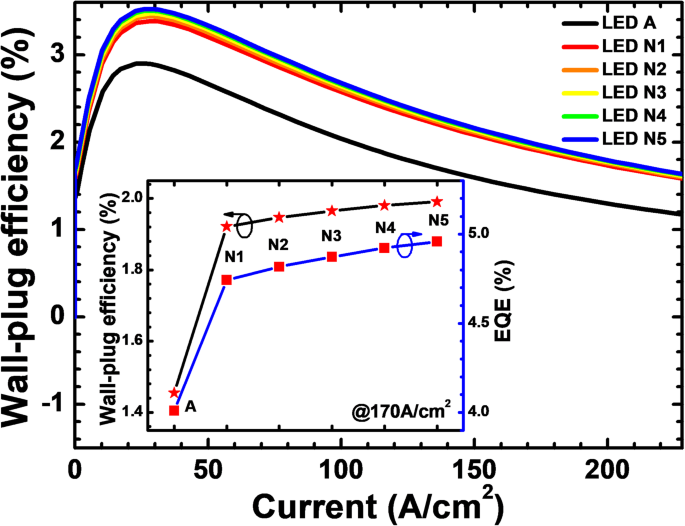
Связь между WPE и током инжекции для светодиодов A и N i ( я =1, 2, 3, 4 и 5). На вставке:EQE и WPE для исследуемых светодиодов, структурированных с различным числом NPN-AlGaN при плотности тока 170 А / см 2
Выводы
В заключение мы предложили встроить переход NPN-AlGaN в слой поставщика электронов n-типа для светодиодов DUV. После всесторонних и систематических обсуждений мы обнаружили, что переход NPN-AlGaN может уменьшить текущий эффект скопления в слое поставщика дырок p-типа и улучшить инжекцию дырок для светодиодов DUV. Переход NPN-AlGaN может настраивать проводимость для слоя поставщика электронов n-типа так, чтобы можно было управлять путём тока в слое поставщика дырок p-типа. Для дальнейших исследований мы исследовали влияние различных параметров переходов NPN-AlGaN на эффект распространения тока, EQE и WPE. Мы обнаружили, что ток может быть дополнительно гомогенизирован, если состав AlN, концентрация легирования Mg, толщина слоя вставки p-AlGaN и число переходов NPN-AlGaN увеличены должным образом. Хотя EQE можно продвинуть с помощью предлагаемых переходов NPN-AlGaN, WPE не всегда монотонно улучшается, что возникает из-за дополнительного падения напряжения на барьерах в переходах NPN-AlGaN. Следовательно, при разработке слоев распределения тока NPN-AlGaN для светодиодов DUV необходимо уделять больше внимания. Тем не менее, мы твердо уверены, что наши результаты предоставили альтернативную стратегию проектирования для снижения текущего эффекта скопления светодиодов DUV. Между тем, мы также ввели дополнительную физику устройств и, следовательно, очень полезны для сообщества.
Доступность данных и материалов
Данные и анализ в текущей работе доступны у соответствующих авторов по разумному запросу.
Сокращения
- APSYS:
-
Расширенные физические модели полупроводниковых приборов
- CL:
-
Текущий слой распространения
- Светодиоды DUV:
-
Светодиоды глубокого ультрафиолета
- EQE:
-
Внешняя квантовая эффективность
- ITO:
-
Оксид индия и олова
- LQW:
-
Последняя квантовая яма
- MQW:
-
Множественные квантовые ямы
- NPN-AlGaN:
-
н-AlGaN / p-AlGaN / n-AlGaN
- IQE:
-
Внутренняя квантовая эффективность
- SRH:
-
Шокли-Рид-Холл
- WPE:
-
Эффективность розетки
- ZGO:
-
Галлат цинка
Наноматериалы
- 4 основных типа приводов с прорезями для крепежа
- Обоснование использования нейроморфных чипов для вычислений ИИ
- Дизайн эмиссионного слоя для электронных умножителей
- Зеленый синтез квантовых точек InP / ZnS Core / Shell для применения в светоизлучающих диодах, не содержащих тяжелых м…
- Оптимальный предшественник титана для изготовления компактного слоя TiO2 для перовскитных солнечных элементо…
- Ультрафиолетовые светодиоды на основе AlGaN с почти нулевым КПД и специально разработанным слоем блокировки эл…
- Перовскитовые светодиоды высокой яркости с высокополярным спиртовым растворителем, использующие PEDOT:PSS как с…
- О слое распространения тока p-AlGaN / n-AlGaN / p-AlGaN для светодиодов глубокого ультрафиолетового излучения на основе…
- Влияние ширины квантовых ям на электролюминесцентные свойства светодиодов AlGaN, излучающих глубокий ультрафи…
- Интеграция экологически чистых перовскитов для высокоэффективных белых светоизлучающих диодов



