Высокопроизводительные двумерные полевые транзисторы InSe с новым зажатым омическим контактом для узлов размером менее 10 нм:теоретическое исследование
Аннотация
Двумерный (2D) полевой транзистор (FET) на основе InSe показал замечательную подвижность несущих и высокое отношение включения-выключения в экспериментальных отчетах. Теоретические исследования также показали, что высокие характеристики могут быть хорошо сохранены на узлах менее 10 нм в баллистическом пределе. Однако как экспериментальный опыт, так и теоретические расчеты показали, что достижение высококачественного омического сопротивления стало основным ограничивающим фактором для высокопроизводительных двумерных полевых транзисторов. В этой работе мы предложили новый многослойный омический контакт с индием для полевого транзистора InSe и всесторонне оценили его характеристики с точки зрения материала и устройства на основе методов ab initio. Свойства материала показывают, что все фундаментальные проблемы омического контакта, включая туннельный барьер, барьер Шоттки и эффективное легирование, хорошо решаются введением многослойной структуры, и было достигнуто превосходное сопротивление контакта. На уровне производительности устройства были исследованы устройства с длиной затвора 7, 5 и 3 нм. Все показатели устройств с зажатым контактом намного превышают требования Международной дорожной карты технологий для полупроводников (ITRS) и демонстрируют очевидное преимущество по сравнению с традиционными структурами. Максимальный прирост тока с 69,4%, 50% и 49% достигается для устройств с длиной затвора 7, 5 и 3 нм соответственно. При этом достигается максимальное снижение внутренней задержки на 20,4%, 16,7% и 18,9%. Кроме того, представлен тест продукта задержки энергии (EDP) по сравнению с другими 2D полевыми транзисторами. Все полевые транзисторы InSe с зажатым омическим контактом превосходят MoS 2 Полевые транзисторы, а также требования ITRS 2024. Наилучший результат приближается к верхнему пределу идеального полевого транзистора BP, что означает превосходное преобладание многослойных структур для полевых транзисторов InSe в следующем поколении технологии комплементарных металл-оксидных полупроводников (КМОП).
Введение
Двумерные (2D) полупроводники вызвали большой интерес в электронных устройствах из-за их привлекательных приложений для следующего поколения технологии комплементарных металл-оксидных полупроводников (CMOS) [1, 2]. Их ультратонкая толщина и хорошие диэлектрические свойства могут обеспечить превосходное управление электростатическим затвором для подавления хорошо известных эффектов короткого канала [3]. Кроме того, поскольку несколько слоев 2D-материалов обычно имеют гладкую поверхность с отсутствием болтающихся связей, превосходная подвижность носителей 2D-материалов может быть хорошо сохранена в сверхтонких телах по сравнению с обычными полупроводниками [4]. За исключением бесщелевого графена, большинство синтезированных 2D-полупроводников, таких как дихалькогениды переходных металлов (TMD), черный фосфор (BP) и селенид индия (InSe), обладают ненулевой запрещенной зоной и, как было продемонстрировано, подходят для полевых транзисторов (FET). ). Полевые транзисторы на базе TMD показали высокое отношение включения / выключения, достигающее 10 8 и низкий ток утечки в устройствах с коротким каналом, благодаря большой эффективной массе [5]. Полевые транзисторы на основе БП обладают выдающимися токовыми и коммутационными характеристиками [6] благодаря высокой подвижности ~ 1000 см 2 / V s и анизотропное транспортное свойство [7]. Недавно было продемонстрировано, что InSe демонстрирует превосходную мобильность ~ 2000 см 2 . / В с при комнатной температуре [8, 9], а полевой транзистор на основе InSe показал высокое отношение включения / выключения 10 8 [10]. Расчеты из первых принципов также показали, что полевой транзистор InSe можно хорошо масштабировать до менее 10 нм в баллистическом пределе [11, 12]. Однако из-за пренебрежения контактным сопротивлением и гипотезы о сильном легировании приближение к теоретическому пределу все еще является сложной задачей в реальных приложениях. Фактически, поскольку надежный метод легирования и способ высококачественного омического контакта все еще отсутствуют, полевые транзисторы на основе 2D материалов, включая InSe, обычно являются полевыми транзисторами с барьером Шоттки (SB) [13,14,15,16]. SB в активных областях дает большое контактное сопротивление, а низкий уровень легирования еще больше ухудшает плотность тока. Достижение низкого контактного сопротивления с достаточно легированными активными областями стало основным ограничивающим фактором для полевых транзисторов на основе 2D материалов (2D FET) для достижения высоких характеристик [17,18,19].
Стремясь решить вышеупомянутые проблемы, мы предложили новый омический контакт типа «сэндвич» для полевого транзистора из InSe. Индий был выбран в качестве электродного металла, поскольку недавние экспериментальные и теоретические исследования показывают, что индий может быть многообещающим кандидатом для InSe FET для достижения хороших характеристик [20,21,22]. Мы теоретически оценили качество омического контакта и производительность устройств с длиной затвора 7, 5 и 3 нм в соответствии с Международной технологической дорожной картой для полупроводников 2013 (ITRS) [23]. Следует отметить, что хотя ITRS был заменен Международной дорожной картой для устройств и систем (IRDS) [24], ITRS2013 демонстрирует четкую тенденцию масштабирования для транзисторов и все еще используется в недавних исследованиях [25, 26]. Рукопись построена следующим образом:сначала исследуются электрические свойства многожильных и обычных (верхних) контактов. Во-вторых, показатели производительности устройства, такие как ток в открытом состоянии и внутренняя задержка, оцениваются и сравниваются с требованиями ITRS. Наконец, представлен тест продукта задержки мощности по сравнению с собственной задержкой для сравнения с другими устройствами на основе 2D-материалов.
Методы
Все атомные структуры были оптимизированы с помощью VASP [27]; Во всех расчетах использовалось снижение энергии на 335 эВ. Элементарная ячейка InSe была релаксирована с критерием напряжения 0,01 эВ / Å в рамках MetaGGA of SCAN [28]. Параметры решетки металлического индия получены из справочника по химии и физике [29]. Как показано на рис. 1, постоянная решетки InSe составляет 4,029 Å, что очень хорошо согласуется с экспериментальными данными [30, 31].

Вид сверху элементарной ячейки для InSe ( a ) и индий ( b ) соответственно
Исходная структура индия на InSe была построена с использованием элементарных ячеек 4 × 1 × 1 и 5 × 2 × 1 с поверхностью InSe и индия (001) соответственно. Средняя абсолютная деформация составила 1,32%, что достаточно для сохранения внутренних свойств материала. Как показано на рис. 2a, b, многослойная структура была построена из слоев индия / InSe / индия, при этом индий на нижней и верхней сторонах имеет зеркальную симметрию с центром InSe. Обе гибридные структуры релаксировали с помощью функционала Ван-дер-Ваальса (vdW) optb88 с критерием силы на каждый атом ниже 0,02 эВ / Å [32, 33]. Площадь конечного контакта составляет 16,19 Å × 6,41 Å. Затем сопротивление омического контакта оценивалось с помощью двухзондового прибора, как показано на рис. 2а, б. Избавившись от ненужного сопротивления полупроводника вне контактных областей, InSe в катоде был сильно легирован 1 × 10 14 э / см 2 как для верхних, так и для зажатых контактов.
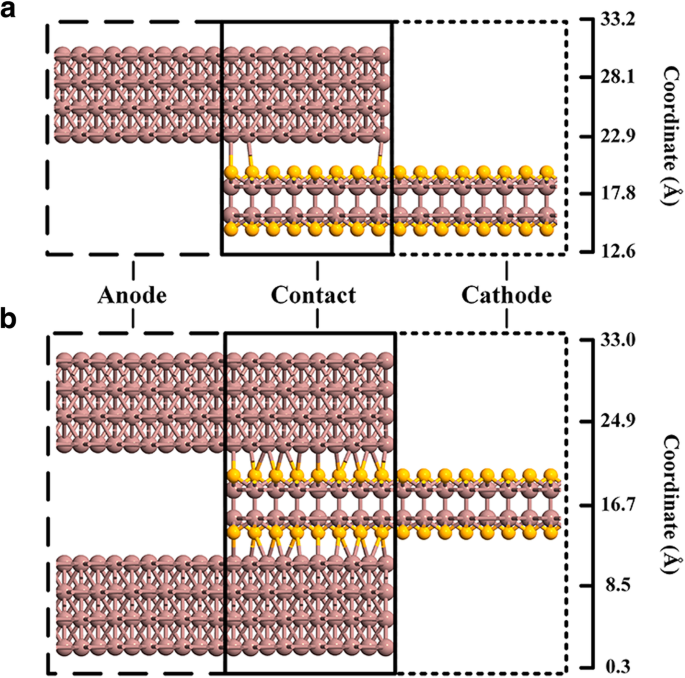
Атомарные структуры контакта и связанное с ним двухзондовое устройство, используемое для оценки контактного сопротивления. а , b предназначены для верхних и зажатых контактов соответственно . Координаты обозначают расположение атомов во внешней плоскости
Что касается оценки характеристик устройства, то геометрия полевого транзистора InSe с зажатыми и верхними омическими контактами показана на рис. 3a, b соответственно. Все имена устройств и узлов соответствуют требованиям ITRS и IRDS соответственно. Параметры устройства перечислены в таблице 1. Для подавления внутриполосного туннелирования применялось перекрытие (UL) 1 нм при длине затвора 3 нм. В отличие от моделирования омического контакта, ни одна из частей устройств не была преднамеренно легирована. Устройства были построены путем объединения истока, стока и канала в транспортном направлении. Канал и два его интерфейса с активными областями были дополнительно релаксированы с фиксированными истоком и стоком. Все моделирование основывалось на теории неравновесной функции Грина (NEGF) и проводилось QuantumATK с полностью самосогласованными расчетами [34,35,36], которые обычно использовались для проектирования и исследования транзисторов в узлах размером менее 10 нм [17] , 37,38,39]. Использовался базис с двойной дзета-поляризацией с механическим отсечением по Ридбергу 90. Отобрана сетка из k-точек пакета Monkhorst с плотностью 8 / Å −1 × 11 / Å -1 × 180 / Å -1 . Параллельный решатель сопряженных градиентов выбран в качестве решателя Пуассона для повышения эффективности. Затем ток всех устройств можно получить, решив формулу Ландауэра-Бюттикера [40]:
$$ I \ left ({V} _ {\ mathrm {Bias}} \ right) =\ frac {2e} {h} \ int T \ left (E, {V} _L, {V} _R \ right) \ left [{f} _ {\ mathrm {R}} \ left (E, {V} _R \ right) - {f} _L \ left (E, {V} _L \ right) \ right] dE $$ <рисунок>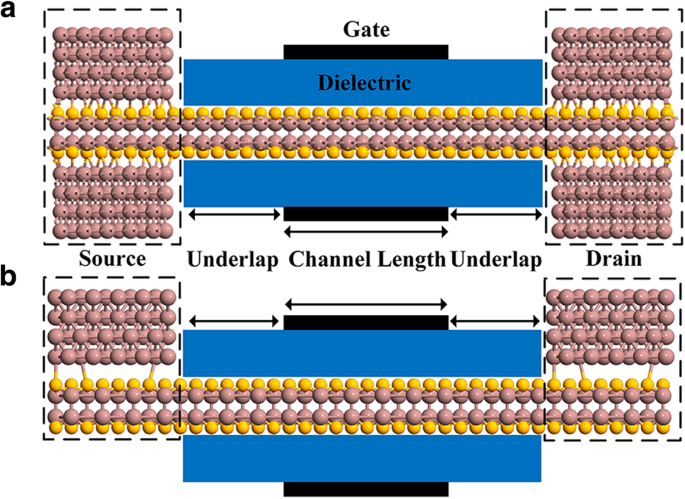
Геометрия полевых транзисторов InSe с зажатыми ( a ) и верхний ( b ) контакты
Где, V Смещение это смещение и может быть достигнуто с помощью: V Смещение = V R - V L , Т ( E , V L , V R ) - коэффициент передачи несущих, f R ( E , V R ) и f L ( E , V L ) являются функцией распределения Ферми-Дирака для катода (стока) и анода (истока) соответственно.
Результаты и обсуждение
В общем, есть три ключевых фактора, коррелирующих с качеством омического контакта в 2D-материалах [18], то есть туннельный барьер и расстояние, которое определяется зазором vdW, перекрытие орбиталей между электродом и полупроводником, а также высота SB. Во-первых, туннельный барьер и расстояние описывались эффективным потенциалом, показанным на рис. 4а. По сравнению с верхним контактом, введение многослойного контакта не только обеспечивает дополнительный транспортный путь на нижней стороне, но также приводит к уменьшению туннельного барьера с 5,48 до 2,38 эВ, что приводит к снижению на 56,6%. Между тем, межфазное расстояние также немного уменьшается на 0,66 Å, что означает уменьшение ширины туннельного барьера. Во-вторых, перекрытие орбит можно оценить по распределению валентных зарядов на рис. 4b. Можно заметить, что многослойный контакт содержит больше валентных электронов в межфазной области по сравнению с верхним контактом, что указывает на более сильное перекрытие орбиталей между индием и InSe. Эта функция также помогает ввести эффект легирования в InSe, а количество избыточных электронов может быть рассчитано с использованием населенности Малликена. Мы извлекли общее количество электронов в InSe сэндвич-структур и структур с верхним контактом, соответственно. Затем уровень легирования может быть получен путем деления числа электронов на площадь области контакта, так как суммарный заряд изолированного InSe всегда должен быть равен нулю. Как показано на правой панели рис. 4b, многослойный контакт дает очень высокий уровень легирования 1,6 × 10 13 . э / см 2 , что почти в 2,8 раза выше, чем у верхнего контакта. Такой высокий уровень приблизил гипотезу при моделировании 2D туннельного полевого транзистора, который обычно требует гораздо более высокого уровня легирования, чем полевой транзистор металл-оксид-полупроводник. В-третьих, плотность состояний (DOS) InSe в первичных, сэндвичевых структурах и структурах с верхним контактом показана на рис. 4c. Перекрытие орбиталей между индием и InSe в межфазной области металлизировало запрещенную зону InSe, а зажатая между ними приводит к более высокому уровню. Эта особенность значительно увеличивает инжекцию носителей через туннельный барьер vdW в межфазной области, поскольку металлизированные состояния в запрещенной зоне предлагают дополнительные туннельные каналы. Кроме того, уровни Ферми расположены выше минимума зоны проводимости, что приводит к энергетическому вырождению ~ 0,07 и 0,27 эВ для верхнего и зажатого контактов соответственно. Таким образом, SB между индием и InSe полностью исключается. В-четвертых, сопротивление омического контакта было рассчитано на основе кривой тока смещения, полученной для двухзондовых устройств, и все результаты показаны на рис. 4d. Мы можем заметить, что оба контакта омические из-за линейной эволюции. На теоретическом уровне, т.е. без учета шероховатости поверхности, межфазных загрязнений и т. Д., Многослойная структура приводит к очень низкому значению контакта 0,032 ± 0,002 Ом мм, что снижает более чем наполовину сопротивление верхнего контакта. Основываясь на приведенных выше обсуждениях, интересно отметить, что удвоение площади контакта всегда приводит к более чем двукратному улучшению омического контакта. Поскольку недавно было экспериментально подтверждено, что верхний контакт с индием эффективен для повышения производительности устройств на основе InSe [21, 22], многослойная структура может быть привлекательным решением для омических контактов для полевых транзисторов из InSe.

а Эффективный потенциал перпендикулярно направлению транспортировки. Координата соответствует расположению атомов и определена на рис. 1. Темные области соответствуют зазору vdW. б Распределение электронов, усредненное по плоскости, нормальное к направлению переноса. Правая панель - уровень допинга. Координата соответствует расположению атомов и определена на рис. 1. c ДОС ИНСЕ. Зеленый цвет соответствует первозданному InSe. г Зависящее от тока смещение двух датчиков. Все красные и синие цвета соответствуют верхним и зажатым контактам соответственно
Затем была оценена производительность устройства, и передаточные характеристики полевого транзистора InSe в узлах 2019, 2021 и 2024 годов были показаны на рис. 5. Можно заметить, что подпороговые колебания (SS) всех узлов ниже 100 мВ / дек. , а SS в узле 2019 демонстрирует почти идеальные характеристики переключения 61,8 и 64,4 мВ / дек для устройств с верхним и промежуточным контактом, соответственно, что указывает на выдающийся электростатический контроль в полевых транзисторах InSe. Кроме того, устройства с зажатыми контактами приводят к очевидному улучшению I DS по сравнению с лучшими с максимальным приростом 69,4%, 50% и 49%, достигаемым в узлах 2019, 2021 и 2024 годов соответственно. Кроме того, я ON был извлечен в соответствии с требованием высокой производительности (HP) в ITRS. Как показано на рис. 5d, я ON всех систем намного превышает требования к HP. По сравнению с устройствами, с которыми чаще всего осуществляется контакт, многослойные системы по-прежнему демонстрируют повышение на 38,2%, 27,3% и 20,5% для узлов 2019, 2021 и 2024 годов соответственно.
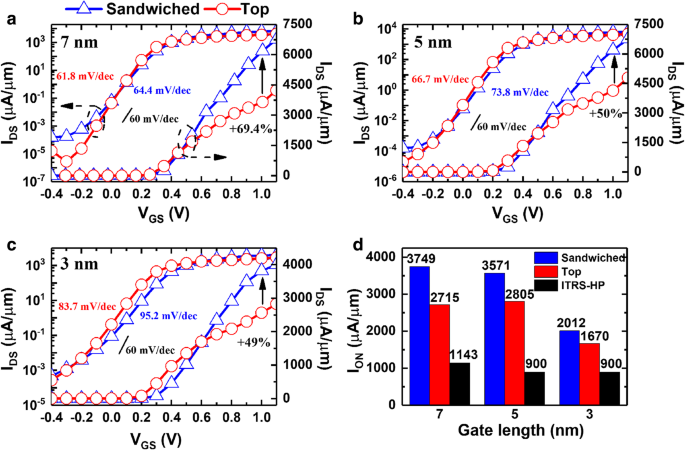
Передаточные характеристики полевых транзисторов InSe в узле. а 2019, б 2021 и c 2024 узла соответственно. г Сравнения I ON в соответствии с требованиями HP ITRS
Другой важный показатель полевого транзистора - внутренняя задержка (τ), которая обозначает верхний предел скорости переключения в логической схеме. Τ было получено с помощью τ =(Q ВКЛ - Q ВЫКЛ ) / Я ВКЛ , где Q ON и Q OFF - заряды во включенном и выключенном состояниях соответственно. Включенное и выключенное состояния ограничены в | V DS | =0,68, 0,64 и 0,64 В для узлов 2019, 2021 и 2024 соответственно. Собственная задержка как функция отношения включения-выключения показана на рис. 6. Несмотря на немонотонную эволюцию при большой задержке, которая возникает из-за туннелирования при низких напряжениях затвора [41], все задержки ниже 0,15 пс и значительно ниже, чем требование ITRS 0,44-0,46 пс. Кроме того, устройства с зажатым контактом приводят к снижению более чем на 30% в областях I ON / I ВЫКЛ ≤ 10 7 , 10 6 , 10 5 для узлов 2019, 2021 и 2024 соответственно. В соответствии с требованиями HP, показанными на рис. 6d, устройства с зажатым контактом могут по-прежнему обеспечивать скорость переключения с 20,4%, 16,7% и 18,9% для узлов 2019, 2021 и 2024 соответственно.
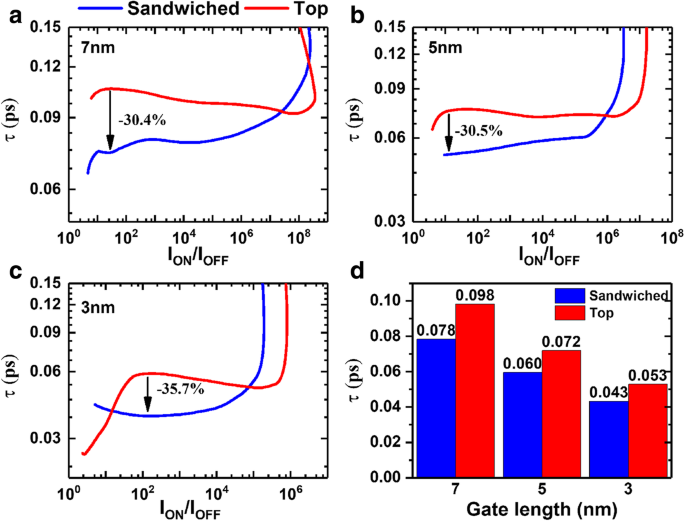
Внутренняя задержка как функция отношения включения-выключения в узле. а 2019, б 2021 и c 2024 узла соответственно. г Сравнение внутренней задержки согласно требованиям HP ITRS
Чтобы более интуитивно оценить производительность устройства, извлекается произведение задержки мощности (PDP) по сравнению с внутренней задержкой. PDP соответствует потребляемой мощности в одном событии переключения и определяется как PDP =(Q ON - Q ВЫКЛ ) V DS со всеми параметрами, вытекающими из требований HP ITRS. Результаты и сравнение с другими двумерными полевыми транзисторами показаны на рис. 7. Во-первых, все двухмерные полевые транзисторы были выбраны на основании правила, согласно которому они были предварительно проверены как транзисторы в экспериментальных отчетах, что является шагом вперед в развитии технологии КМОП. Во-вторых, кроме InSe и MoS 2 [42], все остальные устройства моделировались с сильным легированием в активных областях и пренебрежением омическим контактным сопротивлением [43, 44], поэтому результаты соответствуют верхнему пределу производительности. Как можно видеть, все продукты с задержкой энергии (EDP) ниже требований ITRS 2024, что указывает на привлекательное будущее 2D-полевых транзисторов. Максимум EDP принадлежит MoS 2 Полевой транзистор на 9,9 нм, а лучший - от BP FET. Что касается полевых транзисторов InSe, устройства с промежуточным контактом всегда работают лучше, чем устройства с верхним контактом на всех узлах. Самый высокий EDP для устройств с зажатым контактом имеет длину затвора 7 нм (узел 2019) и превышает все MoS 2 Полевые транзисторы. Самый низкий из них находится на длине затвора 3 нм (2024 узла) и даже приближается к верхнему пределу полевого транзистора BP в направлении кресла, что хорошо известно своими выдающимися транспортными свойствами. Соответственно, EDP полевого транзистора InSe означает, что устройства с зажатым контактом демонстрируют достаточную конкурентоспособность среди 2D полевых транзисторов.
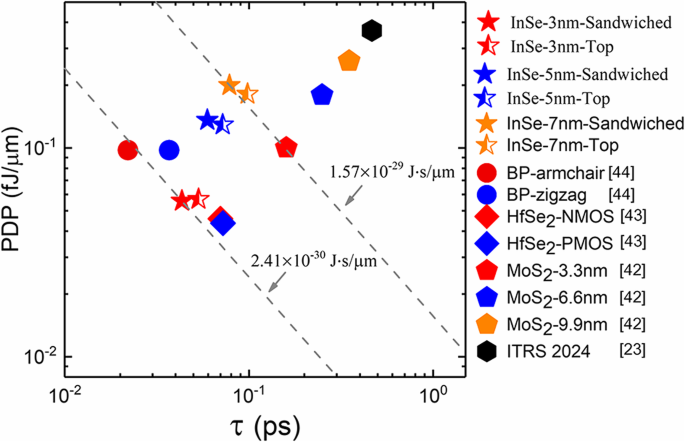
Продукт задержки мощности по сравнению с внутренней задержкой, состоящей из InSe и других 2D полевых транзисторов. Рекомендации, выделенные серым пунктиром, соответствуют конкретным EDP
Выводы
В этой работе для полевого транзистора InSe был предложен новый омический контакт с индием, состоящий из двух слоев. Омический контакт между слоями не только удваивает площадь контакта, но и более чем в два раза повышает качество контакта, что приводит к превосходному сопротивлению контакта. На уровне характеристик устройства с длиной затвора 7, 5 и 3 нм полевые транзисторы InSe с зажатым омическим контактом обеспечивают универсальное повышение производительности по сравнению с обычными устройствами с верхним контактом. Согласно требованиям HP от ITRS, ток в открытом состоянии и внутренняя задержка улучшаются на 38,2 ~ 20,5% и 20,4 ~ 16,7% соответственно. Сравнение EDP с другими 2D-полевыми транзисторами также показывает, что полевые транзисторы InSe с зажатым омическим контактом имеют преимущества перед другими 2D-полевыми транзисторами. Наше исследование предлагает новый путь к созданию высокопроизводительных полевых транзисторов InSe.
Доступность данных и материалов
Наборы данных, использованные и / или проанализированные в ходе текущего исследования, доступны у соответствующего автора по разумному запросу.
Сокращения
- 2D:
-
Двумерный
- CMOS:
-
Дополнительный металл-оксидный полупроводник
- TMD:
-
Дихалькогениды переходных металлов
- БП:
-
Черный фосфор
- InSe:
-
Селенид индия
- FET:
-
Полевые транзисторы
- SB:
-
Барьер Шоттки
- 2D FET:
-
Полевой транзистор на основе 2D материалов
- ITRS:
-
Дорожная карта международных технологий для полупроводников
- vdW:
-
ван дер Ваальс
- UL:
-
Подложка
- NEGF:
-
Неравновесная функция Грина
- DOS:
-
Плотность состояний
- SS:
-
Подпороговое колебание
- HP:
-
Высокая производительность
- τ:
-
Внутренняя задержка
- PDP:
-
Устройство задержки мощности
- EDP:
-
Продукт задержки энергии
Наноматериалы
- Воздушные прокладки для 10-нм чипов
- Nexam поставляет Diab улучшающий свойства Nexamite для высокоэффективной пены ПЭТ
- Волокна из активированного угля с иерархической наноструктурой, полученные из отработанных хлопчатобумажны…
- Многослойные полевые транзисторы SnSe Nanoflake с низкоомными Au-омическими контактами
- Исследование новой червеобразной мицеллярной системы, усиленной наночастицами
- Эволюция области контакта при нормальной нагрузке для шероховатых поверхностей:от атомных к макроскопическ…
- Атомное осаждение нанопленок оксида индия для тонкопленочных транзисторов
- Двумерные мезопористые микрочипы VO2 для высокопроизводительного суперконденсатора
- Сегнетоэлектрические полевые транзисторы на основе одностенных углеродных нанотрубок с преобладанием микр…
- Новая кластерная микроструктура наноконусов с антиотражающими и супергидрофобными свойствами для фотоэлек…



