Подавление чрезмерного роста волокон в памяти произвольного доступа с проводящим мостом с помощью двухуровневой структуры Ta2O5 / TaOx
Аннотация
Двухслойная структура получила широкое распространение для повышения надежности оперативной памяти с произвольным доступом (CBRAM) с проводящим мостом. В этой работе мы предложили удобное и экономичное решение для достижения Ta 2 О 5 / TaO x двухслойная структура с использованием процесса низкотемпературного отжига. Добавление TaO x слой действовал как внешнее сопротивление, подавляющее ток переполнения во время программирования набора, таким образом достигая самоподдерживающегося переключения. В результате распределения состояний с высоким сопротивлением и состояний с низким сопротивлением улучшаются за счет подавления явления перегрузки. Кроме того, LRS-удержание CBRAM, очевидно, улучшается за счет восстановления дефектов в переключающей пленке. Эта работа обеспечивает простой и экономичный метод повышения надежности CBRAM.
Введение
Память с резистивной коммутацией с проводящим мостом (CBRAM) является революционной технологией и считается энергонезависимой памятью (NVM) следующего поколения из-за ее высокой масштабируемости, простой структуры, простоты трехмерной интеграции и высокой скорости работы [1,2, 3]. Для практического применения проблемы надежности, включая сохранение данных и долговечность, препятствуют окончательному внедрению этих запоминающих устройств на рынок памяти. Структурная инженерия - самый популярный подход к повышению надежности CBRAM [4,5,6,7]. Zhao et al. ограниченная инжекция катионов для повышения производительности CBRAM за счет нанопористого графенового слоя [8]. Несмотря на то, что надежность устройства значительно повысилась, оно затрудняет управление материалами и не может использоваться в стандартном процессе CMOS. Чтобы решить эту проблему, Gong et al. предложил КМОП-совместимый и самовыравнивающийся метод формирования межфазного слоя CuSiN в медном электроде для улучшения удержания состояния низкого сопротивления (LRS) [9]. Cao et al. предложили барьерный слой TiN для повышения надежности устройств CBRAM за счет устранения явления чрезмерного роста нанонити и отрицательного поведения SET [10]. Вышеупомянутые методы использовали двухуровневую структуру для эффективной оптимизации надежности CBRAM. Однако они несут затраты на сложный процесс или скорость программирования.
В этой работе мы предлагаем КМОП-совместимый метод формирования двухслойного устройства с помощью простого процесса низкотемпературного отжига. Двухслойное устройство Та 2 О 5 / TaO x Структура образовалась самопроизвольно, что показывает лучшие характеристики надежности по сравнению с неотожженным устройством. Повышенная надежность отожженного устройства может быть объяснена концентрацией волокон, образующихся вдоль границы зерен во время программирования. Кроме того, для устройства для двухслойного отжига из-за наличия TaO x , поведение самосоответствия достигается за счет того, что TaO x слой служит резистором последовательно с Ta 2 О 5 -резистивный слой. Этот результат обеспечивает простой CMOS-совместимый метод формирования двухуровневого устройства и повышения надежности CBRAM.
Методы
Заглушка W диаметром 1 мкм после ХМП служит нижним электродом (ВЭ). После нанесения слоя Ta толщиной 5 нм магнетронным распылением на постоянном токе Ta 2 О 5 образовался в результате процесса термического окисления при температуре ниже 350 ° C в плазме O 2 в течение 300 с путем плазменного химического осаждения из паровой фазы (PECVD). Затем на верхний медный электрод (TE) 40 нм напыляется и формируется узор с помощью литографии. Ячейки памяти формируются в процессе травления газовой смесью SF 6 и C 3 F 8 используя TE в качестве жесткой маски. После этого BE извлекается алюминиевой подушечкой. Наконец, устройство оснащено КМОП-совместимым процессом низкотемпературного отжига при температуре 400 ° C в течение 30 мин. Размер устройства определяется площадью нижнего электрода, которая составляет 1 мкм 2 . . Для справки также подготовлено устройство без процесса отжига. Электрические измерения постоянного тока выполняются с помощью анализатора параметров полупроводников Keithley 4200-SCS. Для всех измерений напряжение подается на Cu TE с заземленным W BE.
Результаты и обсуждение
Для более глубокого понимания процесса отжига, состава и состояния химической связи в Ta 2 О 5 пленки до и после процесса отжига анализируются с помощью рентгеновской фотоэлектронной спектроскопии (XPS). Скорость травления образца 0,5 нм / точка. На рис. 1а пики Ta 2 О 5 4f дублет с пиковой энергией связи 26,70 эВ (Ta 2 О 5 4f 7/2 ) и 28,60 эВ (Ta 2 О 5 4f 5/2 ) с разделением пиков 1,9 эВ наблюдаются на поверхности [11,12,13]. Этот случай демонстрирует существование Ta 2 О 5 слой.

XPS показывает глубину Ta до ( a ) и после ( d ) отжиг. б , e Профиль глубины O до и после отжига соответственно. c, f Профиль атомной концентрации O и Ta с глубиной до и после отжига соответственно
С увеличением глубины пики Ta 2 О 5 4f дублет исчезает, и пики при 22,33 эВ, 23,96 эВ соответствуют Ta 4f 7/2 , Ta 4f 5/2 появляться. Рисунок 1b подтверждает отсутствие сигнала O на той же глубине, где Ta 4f 7/2 и Ta 4f 5/2 существует. Другими словами, на поверхности Ta 2 находится металлический Ta. О 5 для неотожженного устройства. Глубины Та 2 О 5 и Ta, проанализированные по фиг. 1c, составляют 4 нм и 2,5 нм соответственно. Кроме того, имеется пик концентрации атомов O на глубине 7 нм, указывающий на наличие поглощенного кислорода. На рисунках 1d и e показаны глубинные профили XPS-спектров от Ta 2 О 5 пленки после отжига. Пики дублета Ta 4f и Ta 2 О 5 4f дублеты существуют вместе на определенной глубине. Интенсивность Ta 5+ Степень окисления постепенно ослабевает с увеличением глубины. В сочетании с круговым сигналом кислорода по глубине пленки мы подтверждаем, что TaO x существует на поверхности Ta 2 О 5 [11, 14]. Рассчитанная по рис. 1е, толщина Ta 2 О 5 составляет 4 нм и TaO x составляет 3,5 нм. Следовательно, TaO x образуется в результате превращения адсорбированного кислорода в кислород решетки в процессе отжига. Перераспределение кислорода достигнет точки насыщения после процесса отжига. Толщина TaOx, а также напряжение формования не увеличиваются даже при увеличении времени отжига, что доказывает большой запас этого процесса отжига.
На рисунках 2a и b показаны характеристики резистивного переключения Cu / Ta 2 . О 5 / W до и после отжига в режиме свипирования на постоянном токе. Начальные сопротивления ( R начальный ) обоих устройств находятся в высокоомном состоянии (HRS) со значениями ~ 10 9 Ом и 10 10 Ω соответственно. Чем выше R начальный отожженного устройства происходит из-за более толстой оксидной пленки, образующейся при термическом процессе. Примечательно, что это устройство не требует процесса формования, что вполне ожидаемо в практическом применении. Для неотожженного устройства он резко переключается на LRS, когда приложенное напряжение достигает критического значения во время развертки положительного напряжения. В процессе схватывания произошел некоторый сверхнизкий LRS. Ток сброса в таком случае намного выше, чем предварительно установленный ток согласования, что указывает на явление перерегулирования, произошедшее в этом устройстве. На рис. 3b показаны нестабильные LRS и HRS в течение 200 циклов для неотожженного устройства. Большой разброс от цикла к циклу приводит к тому, что окно памяти уменьшается до 20. На рис. 2b показано поведение при переключении отожженных устройств. Ток, протекающий через ячейку, постепенно увеличивается и достигает тока податливости. Никакой очевидной точки переключения не наблюдается, что позволяет избежать явления перерегулирования в неотожженных устройствах. Окно памяти до 10 4 было достигнуто во время циклов переключения благодаря равномерному распределению HRS и LRS.

Типичные ВАХ устройств Cu / TaOx / W перед отжигом ( a ) и после отжига ( б ) с 200 циклами
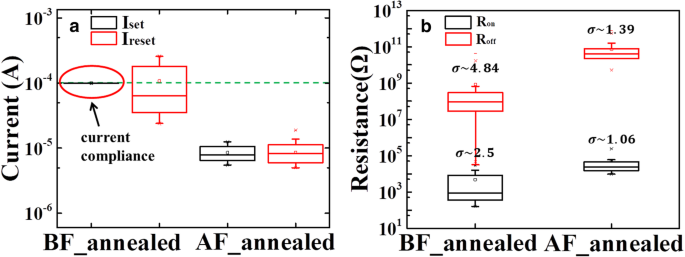
а Установить и СБРОСИТЬ текущие распределения до и после отжига соответственно. б Распределение сопротивления HRS и LRS до / после отжига
Подавление явления перегрузки в отожженном устройстве также может быть подтверждено улучшенным распределением тока сброса ( I СБРОС ) и Установить ток ( I Установить ) в отожженном устройстве, как показано на рис. 3а. Я Установить неотожженного устройства застревает в I CC но я СБРОС широко распространяется. Напротив, для отожженного устройства I СБРОС похож на I Установить . Однородность между устройствами оценивается путем анализа R на и R выкл в 20 различных устройствах в режиме постоянного тока. Как показано на рис. 3 (b), R на извлечено под V читать 0,1 В для неотожженного устройства распределяется от 10 2 Ом до 10 5 Ω, а R на отожженного устройства распределяется с 10 4 Ом до 10 5 Ω. Относительно более высокий R на отожженного устройства в результате последовательного сопротивления TaO x слой. Кроме того, значительно улучшилось распределение HRS в отожженном устройстве. Как показано на рис. 3b, стандартное отклонение (SD) R выкл уменьшен с 4,84 до 1,39.
Результаты цикла при свипировании по постоянному току показаны на рис. 4a и b. Для неотожженного устройства соотношение HRS / LRS составляет около 10 5 сначала, потом постепенно убывает и, наконец, прилипает к LRS. Обратите внимание, что во время езды на велосипеде можно было наблюдать несколько мягких ошибок в виде HRS (красные точки) и LRS (синие точки), которые время от времени бегают вперед и назад. Для отожженного устройства соотношение HRS / LRS остается стабильным (~ 10 4 ) без какой-либо деградации. Во время импульсных измерений оптимальные условия программирования импульсов:3 В / 100 нс для работы с уставкой, - 2 В / 200 нс для операции СБРОС и 0,1 В / 50 нс для операции чтения. Время обнаружения для операций Set / RESET / Read составляет 15 нс / 12 нс / 25 нс соответственно. Как видно из рис. 4c, долговечность неотожженного устройства обычно составляет менее 5 × 10 4 . циклы переключения. Однако из рис. 4d удивительно, что отожженное устройство все еще работает без сбоев после более чем 10 6 циклы переключения. Основываясь на нашем предыдущем исследовании [15], отказ выносливости в CBRAM связан с нестабильной операцией сброса RESET в результате нарастания нити накала в противоэлектрод. С одной стороны, заросшая нить накала требует больше энергии для разрыва и, как правило, вызывает неполный сброс и снижение HRS. С другой стороны, чрезмерное проникновение нити накала в противоэлектрод приводит к остаточным ионам Cu в противоэлектроде, которые могут служить резервуаром для ионов металлов и создавать неожиданный отрицательный SET. Для отожженного устройства чрезмерный рост нити хорошо подавляется введением TaO x слой и приводит к более стабильной операции сброса. В результате окно памяти поддерживается в хорошем состоянии, а характеристика цикла значительно улучшается.

Результаты езды на велосипеде a устройства без отжига до 300 циклов постоянного тока и b устройства с отжигом до 400 циклов постоянного тока. c, d Долговечные характеристики в режиме переменного тока при оптимизированной конфигурации работы:установить 3 В / 100 нс; СБРОС - 2 В / 200 нс. До 10 6 после отжига на устройстве получено циклов
Учет удерживающих характеристик играет решающую роль для практического применения CBRAM [16]. Характеристики удерживания измеряются при температуре ниже 150 ° C с использованием вакуумной печи. Сопротивление каждой ячейки проверяется после охлаждения до комнатной температуры через каждые декады. На рис. 5а и б показана зависимость R HRS / R LRS от времени обжига устройства без отжига и с отжигом соответственно. Для неотожженных устройств (рис. 5а) по мере увеличения времени устройства выходили из строя постепенно в течение 10 4 с. Однако для отожженного устройства (рис. 5b) среди записанных 20 устройств сопротивление LRS и HRS не ухудшается по мере увеличения времени обжига. Другими словами, удерживание устройств значительно улучшается за счет процесса отжига. Срок службы отожженного устройства при 85 ° C может быть определен как 10 лет по графику Аррениуса, что хорошо согласуется с CBRAM [17, 18]. Достижение лучших характеристик удерживания для отожженного устройства связано с тем, что в процессе отжига восстанавливаются некоторые дефекты в переключающей пленке, которые замедляют диффузию частиц Cu.
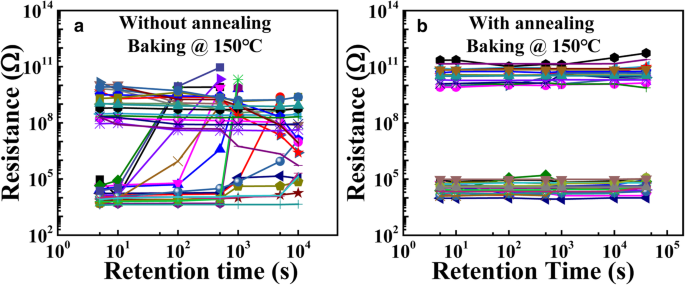
Удерживающие характеристики HRS / LRS для a неотожженное устройство и b отожженное устройство при 150 ° C
На основе приведенных выше результатов физическая модель поведения переключения отожженных и неотожженных устройств проиллюстрирована на рис. 6a – d. Рост филамента в CBRAM связан с переносом ионов Cu в решетке электролита [19]. Явление выброса, которое произошло в неотожженном устройстве, вызывает разрастание нити накала в противоэлектроде. Во время операции сброса остаточные ионы Cu, накопленные в противоэлектроде, будут дрейфовать в туннельный зазор между концом нити накала и противоэлектродом, в результате чего останется Cu + в конце операции сброса и серьезного изменения HRS. Поскольку коэффициент диффузии Cu в TaO x (4,9 × 10 - 20 см 2 / с) намного меньше, чем в Ta (1.0 × 10 - 6 см 2 / с), Cu диффундирует в TaO x намного сложнее под действием электрического поля во время работы Set в образце Cu / Ta 2 О 5 / TaO x / W [20, 21]. Следовательно, перегрузка и чрезмерное разрастание нити может быть хорошо подавлено, а операция RESET станет более стабильной.
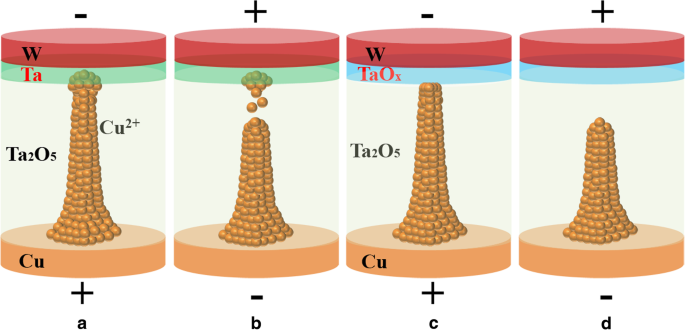
Физическое моделирование переключения отожженных и неотожженных устройств. а Установите и b Процесс RESET для неотожженного устройства со структурой Cu / Ta 2 О 5 / Ta / W. c Установить и d Процесс RESET для отожженного устройства со структурой Cu / Ta 2 О 5 / TaO x / Вт. Разрастание волокна подавляется TaO x слой, образованный в процессе отжига
Выводы
В этом письме мы исследовали характеристики переключения TaO x устройство на базе CBRAM. А Та 2 О 5 / TaO x Двухслойный пакет был сформирован после обработки после термического отжига. ТаО x слой может действовать как внешнее сопротивление, подавляющее ток перелива во время работы установки. Распределение HRS и LRS значительно улучшено за счет подавления явления перегрузки. Кроме того, сохранение данных CBRAM улучшается за счет восстановления дефектов переключающей пленки во время термического отжига. Эта работа обеспечивает наиболее удобное и экономичное решение для достижения двухуровневой структуры и повышения надежности CBRAM.
Сокращения
- CBRAM:
-
Оперативная память с проводящим мостом
- HRS:
-
Состояния с высоким сопротивлением
- LRS:
-
Состояния с низким сопротивлением
- NVM:
-
Энергонезависимая память
- PECVD:
-
Химическое осаждение из паровой фазы с применением плазмы
- TE:
-
Верхний электрод
Наноматериалы
- Дебют ПЛИС оборонного уровня с ранним доступом
- Нанографема, гибкая прозрачная память на основе кремния
- Раскрытие атомной и электронной структуры углеродных нановолокон с набором чашек
- Структура и электронные свойства наноглины каолинита, легированной переходным металлом
- Подготовка и фотокаталитические характеристики фотокатализаторов LiNb3O8 с полой структурой
- Коллективное исследование моделирования и имитации резистивной оперативной памяти
- Электронная структура и ВАХ нанолент InSe
- Электронная структура, зависящая от спина и долины в силицене при периодических потенциалах
- Исследование изменчивости контактной резистивной оперативной памяти с помощью стохастической модели вакан…
- Рекомендации по выбору устройств удаленного доступа для обеспечения безопасности



