Исследование ZrO2 прямой струйной печати и центрифугирования для тонкопленочных транзисторов IGZO с напылением
Аннотация
В этой работе используется малый ток утечки ZrO 2 был изготовлен для напыления тонкопленочного транзистора из индия-галлия-цинка (IGZO) с использованием технологии прямой струйной печати. ZrO 2 для центрифугирования и прямой струйной печати были подготовлены для исследования процесса формирования пленки и электрических характеристик для различных процессов. Однородный ZrO 2 пленки наблюдались через изображения ПЭМ высокого разрешения. Химическая структура ZrO 2 Пленки исследовались методом РФЭС. ZrO 2 для струйной печати слой на IGZO показал превосходные характеристики по мобильности и току в выключенном состоянии, но большое V th сдвиг при положительном смещении стресса. В результате устройство TFT на основе струйно-напечатанного ZrO 2 продемонстрировал подвижность при насыщении 12,4 см 2 / Против, я на / I выкл соотношение 10 6 , напряжение включения 0 В и 1,4 В В th сдвиг после 1-часового штамма PBS. Пленки более высокой плотности с меньшим количеством кислородных вакансий были ответственны за низкий ток в закрытом состоянии для напечатанного ZrO 2 устройство. Механизм ухудшения характеристик при тесте PBS можно приписать области, богатой In, сформированной в заднем канале, которая легко поглощает H 2 О и кислород. Поглощенный H 2 О и кислород захватывают электроны под действием положительного напряжения смещения, выступая в качестве акцепторов в устройстве TFT. Эта работа демонстрирует процесс формирования оксидных пленок с прямой струйной печатью и центрифугированием и раскрывает потенциал оксидного диэлектрика с прямой струйной печатью в высокопроизводительных оксидных тонкопленочных транзисторах.
Фон
Диэлектрики на основе оксидов металлов в последнее время стали перспективной альтернативой SiO 2 . и SiN x в тонкопленочных транзисторах (TFT) из-за их превосходных свойств, включая высокую емкость, малое количество дефектов и большую ширину запрещенной зоны, что приводит к высокой подвижности и низкому току отключения [1,2,3]. По этим причинам оксидные диэлектрики, изготовленные с помощью вакуумного процесса, широко изучаются в дисплеях, массивах датчиков и схемах управления [4]. Между тем, процесс растворения также привлек заметное внимание из-за преимущества низкой стоимости для крупномасштабного производства, включая нанесение покрытий методом центрифугирования, струйную печать, нанесение покрытия распылением и нанесение щелевых покрытий [5, 6]. Среди них прямая струйная печать является наиболее многообещающим методом, позволяющим получать узорчатые пленки без фотолитографии. Однако устройства TFT, изготовленные методом струйной печати, демонстрируют худшие электрические характеристики по сравнению с устройствами, полученными с вакуумной обработкой. Металлооксидные пленки для прямой струйной печати сталкиваются с серьезными проблемами:(1) неконтролируемым растеканием прекурсора оксида на подложке из-за разницы поверхностной энергии жидкости и подложки и (2) совместимостью напечатанных оксидных диэлектриков с полупроводником [7 ].
Процесс формирования пленки диэлектрической пленки, обработанной раствором, оказывает значительное влияние на электрические свойства. Метод центрифугирования широко используется в тонкопленочных транзисторах с обработкой на твердый раствор. Плотность тока утечки оксидного диэлектрика с центрифугированием обычно ниже 10 −6 А / см 2 при 1 МВ / см, а электрическое поле пробоя более 2 МВ / см. Подвижность насыщения TFT на основе оксидного диэлектрика с покрытием составляет около 10 см 2 /Против. Однако для оксидного диэлектрика с печатным рисунком плотность тока утечки примерно на два порядка выше, чем для оксидной пленки с покрытием (> 10 - 4 А / см 2 при 1 МВ / см) и подвижность при насыщении ниже 5 см 2 /Против. В нескольких отчетах сравнивались диэлектрические пленки, напечатанные на струйной печати, с пленками с центрифугированием, особенно в отношении процесса формирования пленки. Плотность, шероховатость поверхности и однородность диэлектрических пленок являются наиболее важными факторами, связанными с электрическими характеристиками TFT [8]. Более того, граница раздела между изолятором затвора и полупроводником также играет ключевую роль для процесса решения TFT [9]. Всестороннее исследование оксидных диэлектриков для струйной печати имеет большое значение для лучшего понимания этой многообещающей технологии.
В этой статье мы подготовили высококачественный ZrO 2 пленки с благоприятным внешним видом поверхности и превосходными электрическими характеристиками как методом нанесения покрытия, так и методом печати, а также исследовали электрический эффект, применяемый в TFT с напылением из оксида индия, галлия, цинка (IGZO) [10, 11]. Сравнивается процесс формирования пленки методом центрифугирования и прямой печати. В методе центробежной печати преобладает центробежная сила, приводящая к равномерному, но дисперсному распределению молекул, в то время как процесс струйной печати зависит от динамики жидкости. Согласно тесту XPS и IV, ZrO 2 для струйной печати пленка (двойные слои) имела меньше кислородных вакансий по сравнению с пленкой с центрифугированием. Увеличение напечатанных слоев ZrO 2 пленки могут заполнять отверстия и вакансии, созданные нестационарным потоком прекурсора, растекающегося по подложке, что способствует уменьшению дефектов и превосходной однородности. ZrO 2 для прямой струйной печати пленка для напыления IGZO имеет более низкую плотность тока утечки, более высокую подвижность, большее соотношение включения / выключения и большее V th сдвиг под действием положительного напряжения смещения, чем у ZrO 2 с центрифугированием -TFT. Область низкого содержания, образованная в заднем канале ZrO 2 , нанесенного струйной печатью. TFT отвечает за худшую стабильность, поскольку молекулы воды и кислород в воздухе могут легко поглощаться под действием положительного напряжения смещения, поглощая электроны из слоя IGZO. Он показывает, что метод прямой струйной печати позволяет изготавливать оксидный диэлектрик с высокой плотностью, но дефект на границе раздела следует хорошо контролировать, чтобы избежать электрической нестабильности.
Методы
Материалы
ZrO 2 раствор был синтезирован растворением 0,6 М ZrOCl 2 · 8H 2 O в 10 мл смеси растворителей 2-метоксиэтанола (2MOE) и этиленгликоля в соотношении 2:3 для достижения определенного поверхностного натяжения предшественника. Раствор перемешивали со скоростью 500 об / мин при комнатной температуре в течение 2 ч с последующим старением не менее 1 дня. Для процесса УФ-обработки озоном использовалась УФ-лампа мощностью 100 Вт с длиной волны 250 нм для облучения подложки из оксида индия и олова (ITO), очищенной изопропиловым спиртом и деионизированной водой. Впоследствии ZrO 2 пленки были сформированы методом центрифугирования или прямой струйной печати. Процесс нанесения покрытия проводился со скоростью 5000 об / мин в течение 45 с, при этом температура капельного пространства и сопла составляла 30 мкм и 30 ° C для процесса печати. ZrO 2 Пленки отжигались при 350 ° C в атмосферных условиях в течение 1 ч. Затем IGZO толщиной 10 нм был выращен методом импульсного распыления постоянного тока при давлении 1 мторр (кислород:аргон =5%) и нанесен теневой маской. IGZO отжигали при 300 ° C в течение 1 ч для уменьшения дефекта пленки. Ширина и длина канала составляли 550 мкм и 450 мкм; таким образом, отношение ширины к длине было 1,22. Наконец, алюминиевые электроды истока / стока толщиной 150 нм были нанесены напылением постоянным током при комнатной температуре.
Инструменты
Для исследования химической структуры оксидных полупроводников были выполнены измерения рентгеновской фотоэлектронной спектроскопии (XPS), выполненные на ESCALAB250Xi (Thermo-Fisher Scientific, Уолтем, Массачусетс, США) при базовом давлении 7,5 × 10 -5 mTorr. Изображения поперечного сечения просвечивающей электронной микроскопии (ПЭМ) были измерены с помощью JEM-2100F (JEOL, Акишима, Токио, Япония), а результаты сканирования картирования электронной дифференциальной системы (EDS) были проанализированы Bruker (Адлерсхоф, Берлин, Германия) для исследуйте распределение элементов. В темноте и на воздухе при комнатной температуре вольт-фарадные кривые измеряли с помощью прецизионного измерителя LCR Agilent 4284A (HP, США). Для измерения передаточных характеристик IGZO TFT и кривых плотности тока утечки мы использовали прецизионный анализатор параметров полупроводников Agilent 4156C. Передаточные характеристики измерялись изменением напряжения затвора от -5 до 5 В при напряжении стока 5 В. Мы рассчитали подвижность полевого эффекта, используя измеренную передаточную кривую и следующее уравнение:
$$ {I} _ {\ mathrm {DS}} =\ frac {W \ mu {C} _ {\ mathrm {i}}} {2L} {\ left ({V} _ {\ mathrm {GS}} - {V} _ {\ mathrm {th}} \ right)} ^ 2 $$ (1)где я DS , C i , μ, W, L, V GS , и V th - ток стока, емкость диэлектрика затвора на единицу площади, подвижность при насыщении, ширина канала, длина канала, напряжение затвора и пороговое напряжение, соответственно. Диэлектрическая проницаемость рассчитывается по следующему уравнению:
$$ {\ varepsilon} _ {\ mathrm {r}} =\ frac {C \ cdotp d} {\ varepsilon_0 \ cdotp S} $$ (2)где ε r , C , d , ε 0 , и S - относительная диэлектрическая проницаемость, емкость диэлектрика затвора, толщина диэлектрика затвора, диэлектрическая проницаемость вакуума и площадь электрода соответственно.
Результат и обсуждение
Процесс формирования пленки методом прямой струйной печати по сравнению с методом центробежной печати представлен на рис. 1. В процессе нанесения покрытия центробежной силой капли равномерно распределяются по всей подложке [12]. Как следствие, после процесса отжига ZrO 2 молекулы хорошо распределяются по субстрату. Между тем, большинство ZrO 2 во время нанесения покрытия молекулы выбрасываются наружу, внутри пленки возникают вакансии. Плотность пленок, полученных методом центрифугирования, не имеет отношения к параметрам покрытия для определенных прекурсоров [13]. В процессе струйной печати принтер движется в определенном направлении, оставляя капли на подложке. Капли сливаются вместе в балансе процесса растекания и сжатия, на который влияют сила тяжести, поверхностное натяжение и вязкоупругость прекурсора. Процесс формирования пленки при струйной печати можно хорошо контролировать, оптимизируя параметры обработки пространства капель, скорости струи, состава чернил и температуры подложки [14]. Самый важный фактор - это пространство для капель, установленное принтером, и процесс последующей обработки носителя. Дополнительный файл 1:На рисунке S1 показаны изображения краевого угла смачивания предшественника печати на подложке ITO с различными периодами УФ-обработки и поляризационным микроскопом отожженного ZrO 2 фильмы. ZrO 2 Пленка, напечатанная на подложке ITO с 40-секундным облучением озоном, имеет лучшую морфологию. Кроме того, метод многослойной печати эффективен в уменьшении дырок в пленке за счет заполнения вакансий дополнительными каплями, напечатанными непосредственно на верхней части первого слоя, что приводит к более однородной пленке с более высокой плотностью и меньшим количеством дефектов [15]. Толщина однослойной и двухслойной пленки при печати составляет 45 нм и 60 нм соответственно (дополнительный файл 1:Рисунок S2). Толщина пленки не пропорциональна напечатанным слоям, что объясняет, что метод множественной печати - это не просто процесс накопления толщины [16]. В целом качество прямой печати ZrO 2 пленки можно хорошо контролировать параметрами обработки. В нашем эксперименте мы готовим однослойный (DP1) и двухслойный (DP2) ZrO 2 с центрифугированием (SC), прямой струйной печатью. пленки и устройства IGZO-TFT на основе этих пленок для исследования различий в морфологии пленок и электрических свойств при различных процессах формирования пленки.
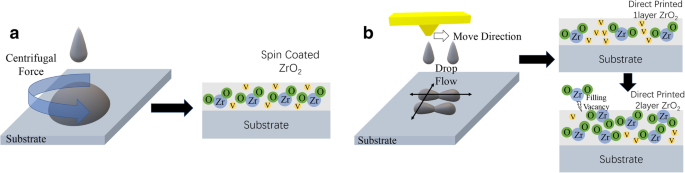
Процесс формирования пленки а нанесение покрытия методом центрифугирования и b метод прямой струйной печати
На рис. 2a – c показан спектр O1s ZrO 2 . фильм подготовлен разными методами. Мы приспособили пик кислорода 1s к суперпозиции трех составляющих пика. Пики с центром при 529,8 ± 0,2 эВ, 531,7 ± 0,2 эВ и 532,1 ± 0,1 эВ могут быть отнесены к разновидностям связи металл-кислород ( V М-О ), кислородные вакансии ( V O ) и слабосвязанные виды ( V M-OR ) соответственно [17, 18]. V М-О разновидности DP2-ZrO 2 пленки составляет 81,57%, что намного выше, чем у SC-ZrO 2 и DP1-ZrO 2 . V O разновидностей также самый низкий для DP2-ZrO 2 фильм. Это согласуется с идеями, упомянутыми выше:(1) в процессе прямой струйной печати можно получить ZrO 2 пленка с более высокой плотностью и меньшим количеством кислородных вакансий, и (2) повторный процесс печати может заполнить отверстия и ловушки и уменьшить количество вакансий внутри пленки. Измерение AFM было выполнено для исследования морфологии поверхности напечатанного ZrO 2 пленка по сравнению с пленкой ZrO 2 , нанесенной методом центрифугирования показано в Дополнительном файле 1:Рисунок S3. ZrO 2 с центрифужным покрытием показывает самую гладкую поверхность с шероховатостью поверхности 0,29 нм, и прямая печать 1-слойный и 2-слойный ZrO 2 пленки имеют размер 1,05 нм и 0,67 нм соответственно. ZrO 2 с прямой печатью Пленка имеет более шероховатую поверхность из-за неконтролируемого потока жидкости в процессе образования пленки [19]. Значительное уменьшение шероховатости поверхности от печати еще одного слоя для ZrO 2 с прямой печатью пленка может быть отнесена к жидкости, напечатанной на подложке, которая заполняет отверстия исходного слоя для образования более однородной пленки. Результаты XPS и AFM показывают, что метод струйной печати имеет потенциал для получения более качественных диэлектрических пленок с меньшим количеством дефектов по сравнению с методом центрифугирования, а также с приблизительной шероховатостью поверхности, которая подходит для изготовления TFT.

O1s спектр a СК, б DP1-слой и c DP2-слой ZrO 2 фильм
Для исследования электрических свойств SC-ZrO 2 были выполнены измерения емкости-напряжения и вольт-амперного состава. и DP-ZrO 2 пленка с использованием Al / ZrO 2 Конденсатор ITO (металл-изолятор-металл) на стеклянной подложке. Мы исключаем влияние толщины пленок, так как они имеют приблизительную толщину (60 нм, 45 нм и 60 нм соответственно). Как показано на рис. 3, DP1-ZrO 2 пленка практически не проявляет каких-либо изолирующих свойств, вызванных большим количеством вакансий в пленке, которые служат проходом для тока утечки. DP2-ZrO 2 пленка демонстрирует лучшие изолирующие свойства, что согласуется с результатом спектра O 1s, упомянутым выше. В результате плотность тока утечки DP2-ZrO 2 пленка 2,4 × 10 −5 А / см 2 при 1 МВ / см и напряжении пробоя более 2,5 МВ / см. В нашем эксперименте большее количество напечатанных слоев имеет одинаковую шероховатость поверхности и показывает небольшое улучшение плотности тока утечки по сравнению с напечатанным двухслойным ZrO 2 фильм. Напротив, печать слишком большого количества слоев может легко подтолкнуть тройную линию (линия разной фазы:газ, жидкость, твердое тело) наружу, вызывая неравномерное распределение исходных чернил. На рисунке 4 показана зависимость емкости от напряжения ZrO 2 с центрифугированием и прямой печатью. фильмы. Относительная диэлектрическая проницаемость для этих трех образцов рассчитана равной 19,2, 20,1 и 18,8, что близко к контрольному значению (18). Для ZrO 2 как с центрифугированием, так и для струйной печати Для пленок плотность емкости увеличивается с увеличением напряжения гистерезиса в обоих трех образцах, и она самая маленькая в SC-ZrO 2 образец и наибольший в DP1-ZrO 2 фильм. Гистерезис связан с однородностью и дефектностью диэлектрической пленки. Это подтверждает, что однородность покрытия ZrO 2 Лучше всего использовать пленку, а многослойность может улучшить однородность пленок для прямой струйной печати [20, 21].
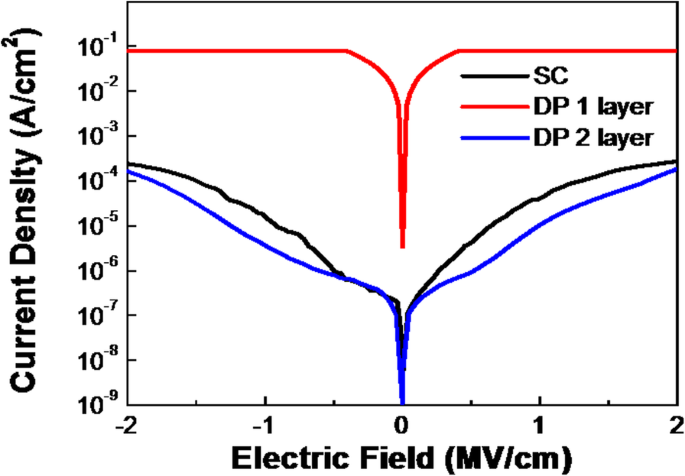
Плотность тока утечки SC, DP1-слоя и DP2-слоя ZrO 2 фильм
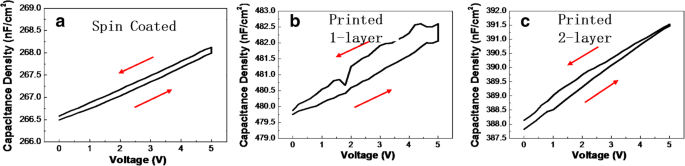
Плотность емкости а СК, б DP1-слой и ( c ) DP2-слой ZrO 2 фильм
Для дальнейшего изучения эффекта ZrO 2 слой, изготовленный различными способами, на характеристики TFT и стабильность смещения затвора, отрицательное напряжение смещения затвора (NBS) и положительное напряжение смещения затвора (PBS), результаты IGZO-TFT с обоими SC-ZrO 2 и DP2-ZrO 2 представлены на рис. 5. Кривые передаточных характеристик при NBS и PBS измеряли при приложении положительного (+ 5 В) или отрицательного (-5 В) смещения в течение 1 часа. DP2-ZrO 2 IGZO TFT показывает лучшую производительность в статическом состоянии с подвижностью насыщения ( μ сб ) 12,5 см 2 / В · с, I на / Я выкл радио 10 6 , и V th от 0 В. SC-ZrO 2 IGZO TFT демонстрирует приблизительную, но меньшую подвижность 10,2 см 2 / V · s, хуже I на / Я выкл радио 2 × 10 5 , и более высокий ток в закрытом состоянии ( I выкл ), в основном из-за увеличения утечки канала из-за большего количества кислородных вакансий ( V O ) в диэлектрической пленке. V th сдвиг IGZO TFT с обоими SC-ZrO 2 и DP2-ZrO 2 по измерениям NBS пренебрежимо мала. Отрицательный V th сдвиг оксидных TFT под действием NBS обычно вызывается захватом дырок или инжекцией заряда, поскольку вакансии ионизированного кислорода могут мигрировать к границе раздела полупроводник / изолятор под действием поля отрицательного смещения затвора. Результаты NBS показывают, что либо SC-ZrO 2 или DP2-ZrO 2 пленка имеет благоприятный контакт с ИГЗО [22, 23]. Однако, в отличие от SC-ZrO 2 IGZO TFT со знаком V th сдвиг 0,4 В после нанесения PBS в течение 1 ч, DP2-ZrO 2 IGZO TFT показывает серьезное снижение производительности и большой V th сдвиг 1,2 В при тесте PBS. Результаты ZrO 2 -IGZO TFT при тесте PBS сведены в Таблицу 1. Поскольку V th сдвиг оксидных TFT при тесте PBS обычно вызван диффузией поглощенных молекул воды или кислорода, мы можем предположить, что обратный канал DP2-ZrO 2 IGZO TFT более чувствителен к атмосферным условиям при тестировании PBS [24, 25].
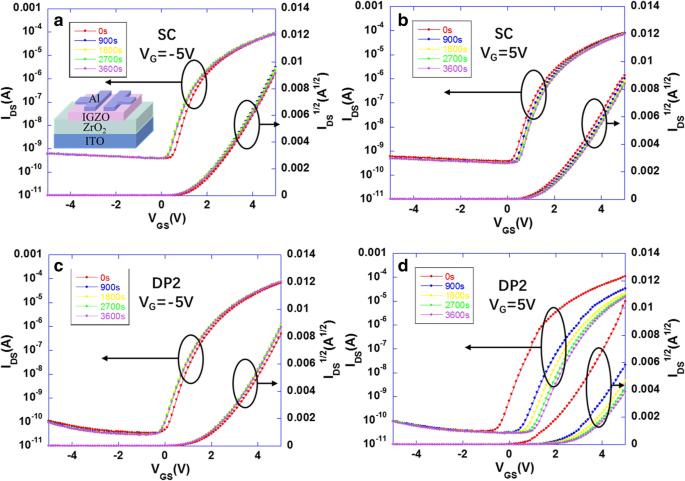
а NBS и b Результаты PBS SC-ZrO 2 IGZO TFT. c NBS и d Результаты PBS DP2-ZrO 2 IGZO TFT
Чтобы исследовать вырождение и V th сдвиг при тесте PBS для ZrO 2 -IGZO TFT, изображения поперечной просвечивающей электронной микроскопии (TEM) и линейное сканирование EDS были измерены для анализа распределения элементов. Из изображений поперечного сечения ПЭМ, показанных на фиг. 6 a и b , структура Al / IGZO / ZrO 2 исследовано в данной статье. Из изображений просвечивающего электронного микроскопа высокого разрешения области канала для обоих SC-ZrO 2 IGZO TFT и DP2-ZrO 2 IGZO TFT, очевидно, может наблюдаться слой IGZO толщиной около 8 нм, что может быть подтверждено распределением элемента In (Ga, Zn) в результатах строчной развертки EDS. Между тем, как для SC-ZrO 2 IGZO TFT и DP2-ZrO 2 IGZO TFT, ZrO 2 слой имеет аморфную структуру, которая способствует низкой плотности тока утечки. Очевидно, что из результата строчной развертки элемент Al диффундирует в слой IGZO, что может быть вызвано ударами во время процесса распыления Al. Кроме того, соотношение элементов Zr и O составляет приблизительно 1:2, что демонстрирует, что чистый ZrO 2 образовалась после отжига. Равномерное распределение элементов In, Ga, Zn и Zr также получается в слое IGZO для SC-ZrO 2 IGZO TFT, указывающий на однородную структуру ZrO 2 пленка IGZO была создана в процессе напыления и после отжига [19]. Но для DP2-ZrO2 IGZO TFT, In, Ga, Zn, O и Zr имеют неравномерное распределение. На рис. 6 (b) мы можем видеть, что элемент Zr вместе с элементом O сосредоточен на границе раздела диэлектрика и активного слоя. И это полностью совпало с анализом процесса формирования пленки многослойной печати. Во время процесса множественной печати прекурсор, напечатанный последним на подложке, частично заполняет вакансии, и большая часть капель накапливается наверху [26]. Более того, сегрегация элементов In и Zn в обратном канале слоя IGZO наблюдается в слое IGZO напечатанного ZrO 2 -TFT. Поскольку в нашем эксперименте доля элемента Zn минимальна, электрические характеристики IGZO TFT определяются элементами In и Ga. Об образовании богатой In области на границе раздела Al / IGZO можно заключить следующим образом:во время процесса отжига слоя IGZO, который направлен на устранение дефектного состояния IGZO, происходило перераспределение каждого элемента. Атомы O были «оторваны» от элементов In и Zn, поскольку они имеют более низкую энергию диссоциации кислородной связи, чем элемент Zr, отталкивая их от границы раздела диэлектрик / полупроводник. Элементарное вещество элементов In и Zn нестабильно, поэтому они рекомбинируют с кислородом, поглощенным в тыльном канале, что может быть подтверждено сканированием EDS [27,28,29]. Область, богатая In с поглощенными молекулами воды и кислородом, является причиной большого V th сдвиг по тесту PBS.
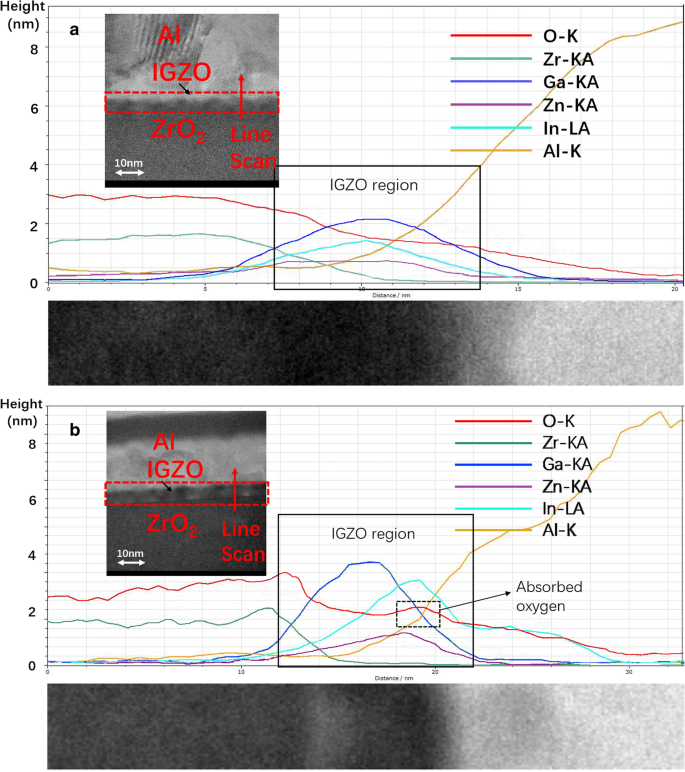
а ПЭМ-изображение и строковое сканирование EDS SC-ZrO 2 IGZO TFT. б ПЭМ-изображение и строковое сканирование EDS DP2-ZrO 2 IGZO TFT
Чтобы концептуально изобразить механизм вырожденной производительности и V th сдвиг под действием положительного напряжения смещения для IGZO TFT, схематические диаграммы полос TFT для ZrO 2 с центрифугированием и ZrO 2 для струйной печати показаны на рис. 7. DP2-ZrO 2 TFT может накапливать больше носителей, чем SC-ZrO 2 TFT в статическом состоянии из-за лучших изоляционных свойств, но при положительном напряжении смещения большинство носителей истощаются акцепторными молекулами, такими как вода и кислород в атмосфере. Обычно водород, кислород и H 2 Молекулы O будут включаться в тонкую пленку IGZO из-за диффузии в обратном канале. После этого водород вступает в реакцию с кислородом и генерирует связи гидроксида кислорода и потребляет электроны, что приводит к ухудшению характеристик при положительном напряжении смещения. Между тем, адсорбированный O 2 и H 2 Молекулы O действуют как акцепторная ловушка, которая может захватывать электроны из зоны проводимости, что приводит к положительному V th сдвиг после PBS [30]. Выродившаяся производительность и V th shift нестабильны, и он может восстановиться через несколько часов в окружающей атмосфере. Из-за разной энергии диссоциации кислородных связей оксида Zr (756 кДж / моль), оксида Ga (364 кДж / моль), оксида In (336 кДж / моль) и оксида цинка (240 кДж / моль) [31 ], Атомы O с большей вероятностью объединяются с элементом Zr из-за больших энергий диссоциации кислородных связей. Элементы In и Zn отодвинуты от ZrO 2 / IGZO интерфейс к обратному каналу поглощает кислород из окружающей среды. Для IGZO TFT с использованием прямой струйной печати ZrO 2 в качестве изолятора затвора, большое количество водорода, кислорода и H 2 Молекулы O «потребляют» электроны при приложении положительного напряжения смещения, что приводит к ухудшению характеристик устройства. Методы, включающие введение пассивирующего слоя в верхней части электрода истока / стока для структуры нижнего затвора, использование структуры верхнего затвора и введение слоя модификации границы раздела между диэлектрическим и полупроводниковым слоями, являются эффективными способами улучшения PBS для TFT-устройства, обработанного на основе раствора. что интересно и будет выполнено в наших дальнейших исследованиях.

Диаграммы полос SC-ZrO 2 TFT и DP2-ZrO 2 TFT при положительном напряжении смещения
Заключение
В заключение, мы изготовили высококачественный ZrO 2 для прямой струйной печати. изолятор затвора с использованием метода многослойной печати без дополнительной технологии нанесения рисунка, который подходит для процесса изготовления крупноформатной печати. Процесс формирования пленки демонстрирует, что ZrO 2 Пленка, изготовленная методом прямой струйной печати, приобретает более плотную структуру по сравнению с процессом нанесения покрытия центрифугированием, но однородность хуже из-за неконтролируемого потока текучей среды исходных чернил. Результаты XPS показывают напечатанный двухслойный ZrO 2 пленка имеет самый высокий процент видов M-O-M ( V М-О ) и низшие кислородные вакансии ( V O ), что отражается в низкой плотности тока утечки. Кривая емкости-напряжения DP2-ZrO 2 пленка показывает небольшой гистерезис, аналогичный SC-ZrO 2 . В результате DP2-ZrO 2 пленка имеет относительно низкую плотность тока утечки 2,4 × 10 −5 А / см 2 при 1 МВ / см и напряжении пробоя более 2 МВ / см; Устройство TFT на базе DP2-ZrO 2 продемонстрировал подвижность при насыщении 12,4 см 2 / Против, Я на / Я выкл соотношение 10 6 , напряжение включения 0 В и 1,2 В В th сдвиг через 1 ч теста PBS. Сегрегация элемента In в обратном канале слоя IGZO, наблюдаемая на ПЭМ-изображении и сканировании EDS, может быть причиной большего V th сдвиг во время теста PBS из-за адсорбированного O 2 и H 2 Молекулы O, которые действуют как акцепторные ловушки, которые могут захватывать электроны из зоны проводимости. В этой статье представлены преимущества технологии прямой струйной печати и исследуются диэлектрические свойства оксидного изолятора, обработанного на растворе, используемого в устройстве оксидного тонкопленочного транзистора. Он демонстрирует, что DP2-ZrO 2 имеет более плотную структуру с меньшим количеством кислородных вакансий, но плохую стабильность в PBS из-за диффузии элементов. Технология прямой струйной печати является многообещающей для применения в массовом производстве из-за ее низкой стоимости и высокой производительности после повышения ее стабильности.
Сокращения
- 2MOE:
-
Метоксиэтанол (растворитель)
- AFM:
-
Атомно-силовой микроскоп
- Al:
-
Алюминий
- DP1 / 2:
-
Прямая печать 1/2 слоя
- EDS:
-
Электронная дифференциальная система
- H 2 О:
-
Молекула воды
- IGZO:
-
Оксид индия, галлия, цинка (оксид-полупроводник)
- ITO:
-
Оксид индия и олова (электрод)
- O 1s:
-
Атомная орбиталь оксида 1
- O 2 :
-
Молекула кислорода
- PBS / NBS:
-
Положительное / отрицательное напряжение смещения (тестовый режим)
- SC:
-
Покрытие отжимом
- SiN x :
-
Нитрид кремния (диэлектрик)
- SiO 2 :
-
Диоксид кремния (диэлектрик)
- ТЕМ:
-
Просвечивающий электронный микроскоп
- TFT:
-
Тонкопленочный транзистор
- UV:
-
Ультрафиолет
- V М-О :
-
Процент связи оксида металла
- V M-OR :
-
Процент связи металл-органика
- V O :
-
Доля оксидной вакансионной связи
- V th :
-
Пороговое напряжение
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- ZrO 2 :
-
Цирконий (оксидный диэлектрик)
- ZrOCl 2 · 8H 2 О:
-
Октагидрат оксихлорида циркония (материал)
Наноматериалы
- ПРОЦЕСС ПРОИЗВОДСТВА ПЛАСТИКОВОЙ УПАКОВОЧНОЙ ПЛЕНКИ ДЛЯ РАЗНЫХ ТИПОВ МАТЕРИАЛОВ
- Разработка процесса нанесения покрытия погружением и оптимизация производительности для электрохромных ус…
- Обеспечение полного покрытия стабильной перовскитной пленки с помощью модифицированного процесса антираст…
- Аморфные кремниевые нанопроволоки, выращенные на пленке оксида кремния путем отжига
- Прямое выращивание перьевидных структур ZnO с помощью простой техники решения для фото-детектирующего прилож…
- Нанопетали из мезопористого оксида никеля (NiO) для сверхчувствительного определения уровня глюкозы
- Атомное осаждение нанопленок оксида индия для тонкопленочных транзисторов
- Получение и термоэлектрические характеристики ITO / PtRh:PtRh тонкопленочной термопары
- Нанокристаллический пленочный анод Fe2O3, полученный методом импульсного лазерного осаждения для литий-ионных…
- Сенсорная пленка для аэрокосмической отрасли



