Изменение оптических свойств квантовых точек InAs с GaAsSb с помощью прослоек InAlAs
Аннотация
В данной работе мы исследуем оптические свойства квантовых точек (КТ) InAs, покрытых композитом In 0,15 Al 0,85 As / GaAs 0,85 Сб 0,15 Снижающие деформацию слои (SRLs) с помощью рентгеновской дифракции высокого разрешения (HRXRD) и фотолюминесцентной (PL) спектроскопии при 77 K. Thin In 0,15 Al 0,85 Как слои толщиной t =20 Å, 40 Å и 60 Å были вставлены между квантовыми точками и GaAs толщиной 60 Å 0,85 Сб 0,15 слой. Эмиссия типа II, наблюдаемая для GaAs 0.85 Сб 0,15 Квантовые точки InAs были подавлены вставкой In 0.15 Al 0,85 Как прослойка. Кроме того, длина волны излучения была сдвинута на синий цвет на t =20 Å и красное смещение на t ≥ 40 Å в результате повышенного удерживающего потенциала и повышенной деформации соответственно. Разделение энергии основного и возбужденного состояний увеличивается до 106 мэВ за t =60 Å по сравнению с 64 мэВ для квантовых точек, закрытых только ТЛК GaAsSb. Кроме того, использование In 0.15 Al 0,85 Поскольку слои значительно сужаются, спектральная ширина линии КТ от 52 до 35 мэВ для образцов с толщиной In 0,15 толщиной 40 и 60 A. Al 0,85 Как прослойки.
Фон
В последние десятилетия самоорганизованные квантовые точки (КТ), синтезированные с использованием техники Странского – Крастанова, привлекают большое внимание. Их оптические и электронные свойства интенсивно исследуются в связи с их потенциальным применением в оптоэлектронных устройствах [1]. Широко исследуемая система квантовых точек InAs / GaAs использовалась в ряде оптоэлектронных устройств в качестве активного материала. Во время роста этих наноструктур происходит значительное изменение размера и формы квантовых точек во время процесса покрытия. Этот процесс довольно сложен и включает перемешивание, сегрегацию или усиленную деформацией диффузию [2]. Использование закрывающего слоя из чистого GaAs ограничивает эмиссию квантовых точек до менее 1300 нм. Чтобы решить эту проблему, использовались слои, снижающие деформацию, сделанные из (Ga, In) (As, Sb, N) [2,3,4,5,6,7]. В частности, особое внимание уделяется тройному GaAsSb, поскольку его результирующее выравнивание полосы может быть адаптировано к типу I или типу II путем изменения содержания Sb [8, 9] и его способности расширять длину волны излучения за пределы C-диапазона. [10]. Однако разница в энергии между основным и возбужденным состояниями ограничивается 60–75 мэВ, когда GaAsSb используется в качестве понижающего деформацию слоя (SRL) [11]. Это энергетическое разделение не препятствует термическому уходу носителей из КТ. Для приложений, требующих большого времени жизни носителей, установка тонкого барьера между квантовыми точками InAs и GaAsSb будет полезна, так как это увеличит расстояние между квантовыми точками и квантовой ямой (КЯ) GaAsSb. Например, использовались прослойки GaAs, что привело к увеличению энергоэффективности солнечных элементов в 23% [12]. Использование слоев InAlAs может представлять интерес для разработки типа излучательной рекомбинации. Для перехода типа II введение InAlAs увеличит время жизни носителей [13] и энергетическое разделение между основным и первым возбужденным состояниями [14,15,16]. Более того, введение слоя InAlAs между квантовыми точками InAs и GaAsSb, как ожидается, уменьшит сегрегацию In и подавит перемешивание атомов In и Ga между квантовыми точками InAs и ТКЛ GaAsSb и еще больше снизит деформацию квантовых точек [17]. Композитные ТКЛ InAlAs / InGaAs используются для закрытия квантовых точек InAs, что приводит к длинноволновому излучению и благоприятному разделению энергии между основным и возбужденным состояниями до 104 мэВ [16, 18].
В этой статье мы сообщаем о первом исследовании эффекта использования In 0,15 Al 0,85 В качестве прослойки на оптические свойства InAs / GaAs 0.85 Сб 0,15 КТ с помощью спектроскопии фотолюминесценции (ФЛ). В частности, были подробно изучены изменение длины волны излучения, тип оптического излучения, ширина спектральной линии и энергетическое разделение между основным и первым возбужденным состояниями.
Методы
Образцы, исследованные в настоящем исследовании, были выращены на подложках из GaAs (001) четверти 2 ″ p-типа, готовых к эпитаксии, в системе молекулярно-лучевой эпитаксии Veeco Gen20A. Клапанные крекеры использовались для создания As 2 и Sb 2 димеры. После роста буферного слоя GaAs при 590 ° C температура подложки была снижена до ~ 485 ° C для роста квантовых точек InAs номинальной толщиной 2,5 миллисекунды. После небольшой паузы под As 2 флюс, композит В 0,15 Al 0,85 ТКЛ As / GaAsSb наносился сразу после выращивания GaAs толщиной 5 нм при той же температуре, после чего температура роста была увеличена до 570 ° C для выращивания барьерного слоя GaAs толщиной 38 нм. Толщина GaAsSb была зафиксирована на уровне 60 Å, в то время как толщина In 0,15 Al 0,85 As варьировали от 20 до 60 Å. ТКЛ GaAsSb толщиной 60 Å был реализован с использованием As 2 / Sb 2 коэффициент потока, дающий содержание Sb 15%, как определено измерениями дифракции рентгеновских лучей на эталонном образце. Для всех слоев использовалась фиксированная скорость роста Ga 0,5 мл / с. Были выращены четыре образца, обозначенные как A, B, C и D, для которых In 0,15 Al 0,85 По толщине t был установлен на 0 Å, 20 Å, 40 Å и 60 Å соответственно. На основе процедуры, использованной Krijn [19], и с использованием параметров в [20], относительное положение зоны проводимости и валентной зоны было оценено, и схематическое изображение выращенных структур с соответствующими зонными диаграммами показано на рис. 1.
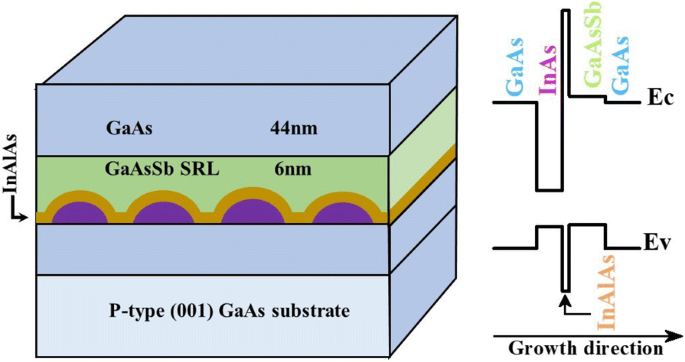
Схема выращенных структур и соответствующая зонная диаграмма квантовых точек InAs, покрытых композитом In 0,15 Al 0,85 Как /GaAs0.85 Сб 0,15 . В 0,15 Al 0,85 По толщине t =0 Å, 20 Å, 40 Å и 60 Å для образцов A, B, C и D соответственно
Кристаллическое качество образцов было охарактеризовано с помощью дифракции рентгеновских лучей высокого разрешения (HRXRD) с использованием рентгеновского дифрактометра Panalytical. Оптические свойства выращенных образцов оценивались с помощью спектроскопии ФЛ при 77 К с использованием модуля ФЛ, подключенного к инфракрасному прибору с преобразованием Фурье Vertex 80 (Bruker Optics GmbH), и с помощью термоэлектрического охлаждаемого InGaAs-детектора с высоким коэффициентом усиления [21]. Образцы возбуждали непрерывным источником твердотельного лазера с длиной волны 532 нм.
Результаты и обсуждение
Кристаллическое качество выращенных образцов было охарактеризовано с помощью HRXRD с использованием сканирования кривой качания путем записи дифракционной картины от атомных плоскостей 004. На рис. 2а показаны полученные дифрактограммы для образцов A, B, C и D, соответствующие толщине InAlAs 0, 20, 40 и 60 Å соответственно. Наблюдаются четкие сателлитные пики, возникающие в результате InAs / InAlAs / GaAsSb, что свидетельствует о хорошем кристаллическом качестве выращенных образцов. Смоделированные рентгеновские кривые качания показаны на рис. 2а вместе с экспериментальными данными. Полученное среднее содержание Sb в эталонном образце А составляет 13%, а толщина GaAsSb составляет 66 Å. Эти значения использовались в образцах B, C и D для определения содержания In и толщины прослойки InAlAs. Моделирование показало, что среднее содержание In составляет 13,5%, а толщина прослойки InAlAs составляет 22, 44 и 65 Å в образцах B, C и D соответственно, что близко к номинальной толщине.> 
а Высокое разрешение ω / 2 θ сканирование образцов A, B, C и D. b Спектр ФЛ образца А, полученный при 77 К и возбуждении 100 мВт. c Энергозависимая ФЛ образца А при 77 К. d Соответствующий пик энергии для первых двух оптических переходов в зависимости от P ex 1/3 при 77 тыс.
Оптические свойства эталонного образца A были сначала исследованы при 77 K с использованием метода зависимой от мощности ФЛ. На рис. 2б показан спектр ФЛ при мощности возбуждения 100 мВт. Спектр ФЛ можно описать тремя гауссовыми пиками с центрами при 1004 мэВ, 1068 мэВ и 1113 мэВ, которые можно идентифицировать как основной и возбужденный оптические переходы. Полная ширина на полувысоте (FWHM) основного и первого возбужденных состояний составляет 52 и 58 мэВ соответственно. Чтобы понять происхождение наблюдаемых первых двух оптических переходов, мощность возбуждения варьировалась от 1 до 100 мВт, и были получены соответствующие спектры ФЛ, как показано на рис. 2c. Для каждой мощности возбуждения энергия первых двух пиков была извлечена с помощью аппроксимации множественной гауссовой функцией и нанесена на график как функция кубического корня из мощности возбуждения, как показано на рис. 2d. Энергия основного перехода уменьшается с уменьшением мощности возбуждения в соответствии с переходом типа II, что указывает на то, что излучение является результатом рекомбинации электронов, находящихся в основном электронном состоянии в КТ (E0 QD ) и дырки, расположенные в КЯ GaAsSb (H0 QW ). Для выравнивания зон InAs / GaAsSb типа II локализация электронов и дырок в КТ и ТКЛ GaAsSb соответственно вызывает эффект изгиба зон, возникающий из-за электрического поля, которое преимущественно направлено вдоль направления роста [22]. Ожидается, что энергия перехода типа II будет увеличиваться пропорционально корню третьей степени из мощности возбуждения, как продемонстрировали Джин и др. [22]. Точно так же энергия первого перехода возбужденного состояния уменьшается с уменьшением мощности возбуждения, и этот переход, скорее всего, является результатом рекомбинации электронов в первом возбужденном электронном состоянии в КТ (E1 QD ) и дырки внутри квантовой ямы GaAsSb (H0 QW ), поскольку плотность состояний в КЯ GaAsSb намного больше плотности состояний в КТ. Первые два оптических перехода показаны на рис. 3а. Отметим также, что энергетическое разделение между основным и первым возбужденным состоянием ΔE остается почти постоянным на уровне 64 мэВ при уменьшении мощности возбуждения, и это свидетельствует о том, что электрическое поле, возникающее в результате накопления заряда, перпендикулярно направлению роста [22], т.е. дырки в GaAsSb локализованы над квантовыми точками. В образце A ожидается излучение типа II, так как содержание Sb в GaAsSb, составляющее 13%, близко к составу, в котором происходит переход от типа I к типу II [23, 24]. Для рассматриваемого содержания Sb должен существовать небольшой сдвиг валентной зоны между квантовыми точками и квантовой ямой GaAsSb, способствующий локализации дырок в квантовой яме GaAsSb и, следовательно, эмиссии типа II [25, 26].
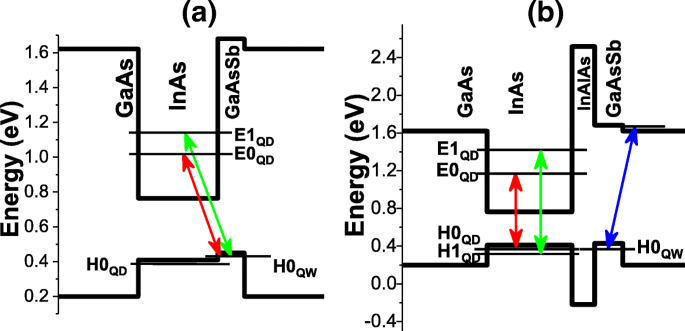
Профили полос образца A ( a ) и образцы B, C и D ( b ) с соответствующими каналами рекомбинации
На рис. 4а показано излучение ФЛ, соответствующее образцам с различным In 0,15 Al 0,85 По толщине с мощностью возбуждения от 1 до 100 мВт. Для всех образцов, содержащих In 0,15 , можно выделить три основных пика. Al 0,85 Как прослойка. Мы отмечаем изменение положений энергетических пиков различных каналов излучения по отношению к эталонному образцу A. При мощности возбуждения 100 мВт были извлечены энергия основного перехода, FWHM, и энергетическое разделение ΔE и сравнивались с образцом A. Извлеченные значения представлены на рис. 4b.

а Энергозависимая ФН InAs / In 0,15 Al 0,85 КТ As / GaAsSb при 77 К. b Соответствующая пиковая энергия, FWHM и ΔE в зависимости от толщины InAlAs и c изменение пиковой энергии каналов оптических переходов в зависимости от кубического корня из мощности возбуждения для образцов B, C и D
Переход в основное состояние образца A происходит при 1004 мэВ с FWHM 52 мэВ и энергетическим разделением ΔE 64 мэВ. Вставка 20 Å In 0,15 Al 0,85 As (образец B) вызывает синий сдвиг перехода в основное состояние на 52 мэВ. Синее смещение согласуется с тем, что наблюдалось, когда композит InAlAs / InGaAs использовался для КТ, выращенных почти при той же температуре роста [27]. Синий сдвиг энергии перехода в основное состояние квантовых точек InAs в образце B является результатом повышенного потенциала удержания [15]. По мере увеличения барьера для электронов и дырок разделение энергетических уровней электронов и дырок должно увеличиваться, что приводит к наблюдаемому синему смещению излучения. Хорошо известно, что покрытие InAs GaAs приводит к уменьшению высоты КТ в результате сегрегации In и перемешивания In-Ga [28]. Введение Sb в закрывающий слой GaAs снижает разложение КТ, подавляя вызванное деформацией перемешивание In-Ga [29]. Ожидается, что введение промежуточного слоя InAlAs дополнительно подавит сегрегацию In и перемешивание In-Ga в результате бездействия адатомов Al. Фактически, Jun et al. [17] с помощью STEM показали, что использование комбинированного слоя InAlAs / InGaAs в качестве закрывающего слоя сильно подавляет сегрегацию In и перемешивание In – Ga вдоль направления роста во время процесса перекрытия квантовых точек InAs, что приводит к увеличению высота наноструктур и более высокая концентрация индия в квантовых точках InAs после покрытия. Учитывая низкую температуру роста квантовых точек, то есть 485 ° C, ожидается, что сегрегация индия и межфазное перемешивание между квантовыми точками и прослойкой InAlAs будут незначительными в результате бездействия адатомов алюминия.
Значения FWHM и ΔE уменьшаются и увеличиваются до 39 мэВ и 92 мэВ соответственно. Дальнейшее увеличение толщины In 0,15 Al 0,85 Что касается 40 Å и 60 Å (образцы C и D соответственно), это вызывает красное смещение длины волны излучения. Это красное смещение, вероятно, вызвано изменением деформации в квантовых точках InAs, поскольку общая толщина ТКЛ композита InAlAs / GaAsSb увеличивается с увеличением толщины InAlAs [30]. Это может изменить структурные размеры квантовых точек и, следовательно, изменить энергетические уровни электронов и дырок. Похоже, что для образцов C и D (40 Å и 60 Å соответственно) эффект деформации преобладает над эффектом удерживающего потенциала. Самая низкая ширина на полувысоте 35 мэВ и максимальное разделение по энергии ΔE 35 и 106 мэВ были получены соответственно для образца D. Большое значение ΔE вызвано использованием более толстого слоя InAlAs и, возможно, увеличенной высоты квантовых точек [31, 32]. Энергетическое разделение сравнимо с разделением, полученным при использовании ТКЛ InAlAs / InGaAs (104 мэВ) [16, 33]. Уменьшение FWHM можно понять с точки зрения уменьшения перемешивания между In 0,15 Al 0,85 Как и КТ и, следовательно, сохранение распределения КТ. Извлеченные параметры приведены в таблице 1.
Интенсивность ФЛ образцов B и C была увеличена по сравнению с образцом A; однако для образца D наблюдалось сильное снижение интенсивности ФЛ, т.е. уменьшение в 5 раз по сравнению с образцом C. Уменьшение интенсивности ФЛ является результатом уменьшения инжекции носителей заряда из слоя GaAsSb в квантовые точки. Фактически, во время освещения многочисленные носители фотогенерируются, и вставка In 0,15 Al 0,85 Поскольку прослойка создает барьер для носителей и может ограничивать их инжекцию в КТ. Носители могут переходить к квантовым точкам в процессе туннелирования, а интенсивность ФЛ выше для образцов с более тонким In 0,15 Al 0,85 Как преграды [34]. Образец D показал самую низкую интенсивность ФЛ при туннелировании через 60 Å In 0,15 Al 0,85 As значительно уменьшается, о чем свидетельствует усиленное излучение ФЛ квантовой ямы GaAsSb, как показано на рис. 4а. Уменьшение туннельного процесса делает благоприятным и усиливает излучательную рекомбинацию электронов и дырок в квантовой яме GaAsSb.
Основное наблюдение на основе зависимой от мощности ФЛ при 77 К для образцов B, C и D, показанной на рис. 4a, - это фиксированные энергетические положения первых двух пиков с увеличением мощности возбуждения, в отличие от того, что наблюдалось в образце A. Это является характеристикой излучения типа I, когда и электроны, и дырки локализованы внутри квантовых точек. Первые два пика излучения возникают в результате рекомбинации электронов и дырок в основном и первом возбужденных состояниях в КТ (E0 QD -H0 QD и E1 QD -H1 QD ). Мы полагаем, что третий пик возникает из-за излучения типа II в результате рекомбинации электронов внутри GaAs и дырок, локализованных в квантовой яме GaAsSb. Действительно, энергия, соответствующая этому переходу, увеличивается с увеличением мощности возбуждения, как показано на фиг. 4a и фиг. 4c, характерных для перехода типа II. Более того, мы видим, что его интенсивность увеличивается с увеличением In 0,15 Al 0,85 По толщине слоя. Это согласуется с уменьшением интенсивности ФЛ основного перехода по мере увеличения толщины In 0,15 Al 0,85 As-слой уменьшает туннелирование носителей из GaAsSb в квантовые точки и способствует излучению типа II, полученному в результате рекомбинации электронов и дырок, находящихся в GaAs и GaAsSb, соответственно. Схема каналов рекомбинации для образцов B, C и D изображена на рис. 3b. Подавление излучения типа II можно понять следующим образом. Вставка 20-Å In 0,15 Al 0,85 По мере увеличения слоя разделение носителей между квантовыми точками и квантовой ямой GaAsSb, в результате чего перекрытие волновых функций электронов и дырок уменьшается. Более того, тот факт, что содержание Sb в содержании GaAsSb близко к кроссоверу I-II типа, In 0,15 Al 0,85 Поскольку прослойка принесет ограниченный уровень в QW (H0 QW ) ниже первого квантованного уровня в квантовых точках (H0 QD ), как показано на рис. 3b, и, следовательно, дырки, захваченные в квантовой яме, могут туннелировать через слой InAlAs, делая менее вероятным излучение типа II. Для более толстого In 0,15 Al 0,85 В случае прослойки (40 Å и 60 Å) туннелирование еще больше уменьшается, но перекрытие волновых функций электронов и дырок существенно уменьшается, что способствует рекомбинации электронов в GaAs с дырками в GaAsSb [13]. Оптический переход квантовых точек InAs / GaAsSb может быть адаптирован к типу применения, требующему короткого или длительного срока службы. В нашем исследовании мы рассмотрели содержание Sb в GaAsSb 13%, что близко к переходу типа I в тип II. Введение промежуточного слоя InAlAs подавляло излучение типа II и увеличивало энергетическое разделение между основным и первым возбужденным состоянием, что желательно для приложений, требующих короткого срока службы носителей. Настоящее исследование также может быть адаптировано для приложений, требующих длительного срока службы носителя. Фактически, ожидается, что комбинация использования более высокого содержания Sb в слое GaAsSb и вставки промежуточного слоя InAlAs сохранит излучение типа II для тонких прослоек InAlAs при значительном увеличении срока службы носителей. В то же время увеличенное разделение энергии между основным и первым возбужденным состояниями уменьшит тепловую утечку носителей.
Заключение
КТ InAs, покрытые композитным In 0,15 Al 0,85 As / GaAs 0,85 Сб 0,15 SRL с переменным In 0,15 Al 0,85 По толщине были увеличены и охарактеризованы. Наш анализ показывает, что вставка In 0,15 Al 0,85 Слой As подавляет наблюдаемое излучение типа II, полученное из InAs / GaAs 0.85 Сб 0,15 КТ. Кроме того, длина волны излучения смещена в синюю область на t =20 Å и красное смещение на t ≥ 40 Å в результате повышенного удерживающего потенциала и повышенной деформации соответственно. Большое энергетическое разделение ΔE 106 мэВ было получено для образца с In 0,15 толщиной 60 ÅA. Al 0,85 Как прослойка. Кроме того, введение In 0.15 Al 0,85 Поскольку промежуточный слой значительно снижает FWHM с 52 мэВ до минимума 35 мэВ.
Сокращения
- FWHM:
-
Полная ширина на половине максимальной
- HRXRD:
-
Дифракция рентгеновских лучей высокого разрешения
- PL:
-
Фотолюминесценция
- QD:
-
Квантовые точки
- QW:
-
Квантовая яма
- SRL:
-
Деформационные слои
Наноматериалы
- Атомная перестройка множественных квантовых ям на основе GaN в смешанном газе H2 / NH3 для улучшения структурных …
- N, N-диметилформамид, регулирующий флуоресценцию квантовых точек MXene для чувствительного определения Fe3 +
- Обнаружение пространственно локализованного экситона в самоорганизованных сверхрешетках из квантовых точе…
- Влияние толщины бислоя на морфологические, оптические и электрические свойства наноламинатов Al2O3 / ZnO
- Зеленый синтез квантовых точек InP / ZnS Core / Shell для применения в светоизлучающих диодах, не содержащих тяжелых м…
- Синтез водорастворимых квантовых точек сульфида сурьмы и их фотоэлектрические свойства
- Простой одностадийный сонохимический синтез и фотокаталитические свойства композитов на квантовых точках г…
- Устранение бимодального размера в квантовых точках InAs / GaAs для изготовления лазеров на квантовых точках 1,3 мк…
- Межзонная фотопроводимость метаморфных квантовых точек InAs / InGaAs в окне 1,3–1,55 мкм
- Материал и оптические свойства флуоресцентных углеродных квантовых точек, полученных из лимонного сока поср…



