Прямой рост монокристаллических нанопроволок GaN на диоксиде кремния, покрытом оксидом индия и олова
Аннотация
В данной работе мы продемонстрировали прямой рост нанопроволок GaN на подложке из плавленого кварца, покрытой оксидом индия и олова (ITO). Нанопроволоки были выращены без катализатора с использованием плазменной молекулярно-лучевой эпитаксии (PA-MBE). Систематически исследуется влияние условий роста на морфологию и качество нанопроволок. Структурные характеристики показывают, что нанопроволоки растут в направлении (0001) непосредственно поверх слоя ITO, перпендикулярного плоскости подложки. Оптические характеристики нанопроволок показывают, что желтая люминесценция отсутствует в фотолюминесцентном отклике нанопроволоки, что объясняется низким количеством дефектов. Измерение методом проводящей атомно-силовой микроскопии (C-AFM) нанопроволок GaN, легированных n-атомом, показывает хорошую проводимость отдельных нанопроволок, что подтверждает потенциал использования этой платформы для новых устройств. Используя относительно низкотемпературный процесс выращивания, мы смогли успешно вырастить высококачественный монокристаллический материал GaN без деградации нижележащего слоя ITO.
Введение
Коммерчески доступные устройства на основе III-нитрида в основном полагаются на сапфир в качестве ростовой подложки, поскольку они могут приспособиться к росту GaN с приемлемым качеством материала. Однако проблема изготовления сапфировой подложки большого диаметра при сохранении приемлемого качества поверхности подложки остается препятствием для увеличения производства [1, 2]. Жизнеспособной альтернативой сапфиру в качестве ростовой подложки из III-нитрида было бы использование подложки на основе диоксида кремния, поскольку они экономически менее дороги и широко используются в промышленности и потребительских приложениях. Однако, поскольку подложки на основе диоксида кремния по своей природе непроводящие, для обеспечения электропроводности необходимо использовать непрозрачный проводящий слой [3, 4]. Следовательно, метод обеспечения одновременной проводимости и прозрачности поверх кремнеземной подложки становится очень важным. Ранее мы использовали тонкую прослойку Ti в качестве места зарождения нанопроволоки для обеспечения одновременной прозрачности и проводимости [5]. Однако, поскольку требуется тонкий слой Ti, электропроводность образца становится ограниченной.
Другой возможный метод получения прозрачной и проводящей подложки заключается в использовании оксида индия и олова (ITO) в качестве места зарождения GaN, поскольку он прозрачен и электропроводен и может быть нанесен на большую площадь поверхности. Технология ITO уже сформировалась и широко используется в различных отраслях промышленности для изготовления прозрачных электродов. Однако нынешняя традиционная технология, используемая для производства GaN, несовместима с ITO. Высокая температура, необходимая для разрушения прекурсоров, используемых при выращивании методом химического осаждения из газовой фазы (MOCVD), приводит к разрушению слоя ITO. Таким образом, требуется низкотемпературный метод выращивания GaN, позволяющий получать высококачественный материал. Были предприняты предыдущие попытки выращивания GaN на ITO при низкой температуре с использованием распыления и плазменного химического осаждения из газовой фазы (PECVD) [6–12]. Однако методы низкотемпературного выращивания обычно приводят к поликристаллическому материалу и большому количеству дефектов.
В этой работе мы пытаемся обойти эту проблему путем прямого роста кристаллических нанопроволок GaN на плавленом кварце, покрытом ITO, с использованием плазменной молекулярно-лучевой эпитаксии (PA-MBE). В PA-MBE активные частицы азота поступают в систему за счет разрыва связи между чистым N 2 газ с использованием ВЧ мощности. Таким образом, температура роста может быть значительно ниже по сравнению с другими методами эпитаксиального роста GaN, предотвращая деградацию слоя ITO. Используя нанопроволоки GaN, можно выращивать высококачественный GaN поверх поликристаллического слоя ITO. Из-за релаксации деформации и фильтрации пронизывающих дислокаций, приписываемых высокому отношению поверхности к объему нанопроволок [13, 14], нанопроволоки GaN обычно демонстрируют монокристалличность и не пронизывают дислокации, несмотря на отсутствие согласования решеток между нанопроволокой и нижележащей нанопроволокой. слой зародышеобразования [15].
Мы исследовали морфологию нанопроволок и их связь с нижележащим слоем ITO, оптические характеристики нанопроволок и возможность использования этой платформы для приложений устройств. Структурные характеристики с помощью электронной микроскопии показывают, что нанопроволоки растут непосредственно на слое ITO перпендикулярно плоскости подложки в направлении c-плоскости (0001). Измерение фотолюминесценции дает хорошее значение внутренней квантовой эффективности (IQE), в то время как желтая люминесценция, связанная с дефектом, отсутствует в спектре излучения. Наконец, проводящая атомно-силовая микроскопия (C-AFM) на нанопроволоках GaN, легированных n, подтверждает, что нанопроволоки являются проводящими, что подчеркивает возможность изготовления новых устройств с использованием нанопроволок GaN на платформе ITO. Благодаря нашей работе мы открыли потенциал выращивания нанопроволок III-нитрида поверх ITO для устройств, где требуются прозрачность и проводимость подложки.
Методы
Осаждение тонкой пленки ITO
Тонкая пленка ITO, использованная в этом эксперименте, была нанесена методом высокочастотного магнетронного распыления. Осаждение производилось при температуре окружающей среды с использованием аргоновой плазмы при ВЧ-мощности 60 Вт, давлении в камере 2,5 мТорр и скорости потока газа 25 стандартных кубических сантиметров в минуту (sccm). Перед нанесением образцы очищают стандартным растворителем с использованием ацетона и изопропилового спирта. Тонкая пленка ITO толщиной примерно 100 нм была нанесена непосредственно на чистый диоксид кремния.
Рост нанопроволоки III-нитридов
Образцы нанопроволоки GaN выращивают с использованием реактора молекулярно-лучевой эпитаксии (PA-MBE) Veeco Gen 930. Перед выращиванием методом MBE подложка из диоксида кремния, покрытая ITO, была отожжена в печи для быстрого термического отжига (RTA) при 650 ° C в атмосфере Ar в течение 5 минут для улучшения кристалличности слоя ITO. Перед загрузкой в камеру образцы очищаются стандартным методом очистки растворителем. Образцы подвергаются последующей термической очистке при 200 ° C и 650 ° C внутри загрузочного шлюза MBE и камеры подготовки для удаления влаги и других загрязняющих веществ, соответственно.
Во время роста нанопроволоки мы использовали значение эквивалентного давления пучка Ga (BEP), равное 1 × 10 −7 . Торр согласно показаниям ионного манометра BFM. Все температуры подложки измеряются с помощью термопары. Чтобы способствовать росту нанопроволоки, начальный затравочный слой наносился при 500 ° C. После нанесения начального затравочного слоя температура подложки была повышена до 700 ° C для роста нанопроволоки.
Структурные, оптические и электрические характеристики
Морфология поверхности слоя ITO исследовалась с помощью системы атомно-силовой микроскопии (АСМ) Agilent 5500 SPM. Электрические характеристики образца измерялись с помощью проводящего АСМ (C-AFM) в контактном режиме. Для улучшения электрического контакта между нанопроволокой и наконечником C-AFM поверх нанопроволок был нанесен слой Ni / Au толщиной 5/5 нм с использованием испарения электронным пучком с последующим быстрым термическим отжигом при 600 ° C в атмосферной окружающей среде. Измерение C-AFM проводилось с помощью наконечника AFM, покрытого Pt / Ir, и приложения смещения к слою ITO образца. Поскольку в нашей конфигурации C-AFM смещение применяется к подложке, положительный ток указывает на ток, текущий от образца к наконечнику AFM.
Структурное качество нанопроволок GaN, выращенных поверх ITO, было исследовано с помощью просвечивающей электронной микроскопии (ПЭМ). Образец ПЭМ поперечного сечения был приготовлен с использованием СЭМ с двухлучевым фокусированным ионным пучком (FIB) FEI Helios Nanolab 400s. СЭМ-визуализацию проводили с использованием СЭМ-системы FEI Nova Nano и Zeiss Merlin. Характеристики просвечивающей электронной микроскопии высокого разрешения (HRTEM) и высокого разрешения кольцевого темнопольного микроскопа STEM (HAADF-STEM) с высоким разрешением были выполнены с использованием просвечивающего электронного микроскопа Titan 80-300 ST (FEI Company). Карта элементного состава была получена с помощью спектроскопии потерь энергии электронов (EELS).
Для исследования полярности нанопроволок мы использовали травление на основе КОН. Сообщалось, что влажное химическое травление с использованием КОН показывает предпочтительное травление N-грани GaN. Следовательно, полярность может быть определена путем сравнения морфологии нанопроволок до и после травления КОН. Мы погрузили нанопроволоку GaN на образцы ITO в 40% раствор КОН на 1 час при комнатной температуре и сравнили морфологию до и после химического погружения, чтобы определить полярность роста нанопроволоки.
Мы исследовали оптические свойства нанопроволок GaN, выращенных непосредственно поверх ITO, с помощью установки для измерения температурной и зависимой от мощности фотолюминесценции (ФЛ). Образец загружали в криостат с гелиевым охлаждением и возбуждали лазером с длиной волны 266 нм (Teem photonics SNU-20F-10x). Температура варьировалась от 10 до 290 К. Сначала мы исследовали зависимый от мощности отклик фотолюминесценции, проведенный при 10 К. Измерение пропускания проводилось с использованием спектрофотометра UV-Vis-NIR (Shimadzu UV-3600).
Измерение дифракции рентгеновских лучей (XRD) проводили с использованием порошковой XRD-системы Bruker D2 Phaser.
Результаты и обсуждение
Поскольку высокотемпературный рост нанопроволок GaN может привести к деградации нижележащего слоя ITO, мы сначала исследовали влияние термического отжига на чистый ITO, нанесенный поверх кремнеземной подложки. Эксперимент проводился внутри буферной камеры МБЭ при типичном давлении 10 −8 Давление торра для имитации фактических условий роста. После отжига электропроводность чистого ITO измеряется с помощью четырехточечного зонда, а шероховатость поверхности исследуется с помощью атомно-силовой микроскопии (АСМ). Из эксперимента по отжигу, показанного на рис. 1а, мы обнаружили, что значение поверхностного сопротивления тонкой пленки ITO остается ниже 10 \ (\ Omega / \ square \). Однако при более высокой температуре отжига тонкая пленка ITO становится более шероховатой с большим размером зерна, как показано на рис. 1b – d.

Влияние температуры отжига на электрические и физические характеристики осажденной тонкой пленки ITO. а Сопротивление листа, измеренное четырехточечным зондом после отжига при различных температурах. Топография поверхности тонкой пленки ITO с помощью АСМ, полученная после отжига образца при b 500 ° C, c 600 ° C и d 700 ° С
Процесс роста нанопроволоки показан на рис. 2
.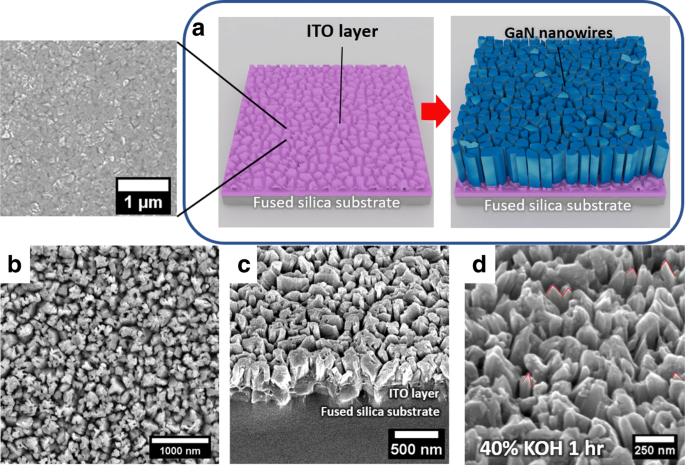
а Схема, иллюстрирующая рост нанопроволок GaN на шероховатой поверхности ITO. На вставке показан вид сверху шероховатой поверхности ITO после термического отжига на сканирующем электронном микроскопе. б Вид сверху нанопроволок GaN, выращенных на ITO. c Увеличенный вид нанопроволок GaN, выращенных на ITO. г Вид сверху на нанопроволоки GaN после 1 часа травления КОН, обнажая острие протравленной нанопроволоки GaN
а. Как показано в результате АСМ, отжиг слоя ITO при повышенной температуре приведет к шероховатой поверхности ITO с большим размером зерна. Во время роста методом МПЭ соседние нанопроволоки GaN, которые растут на поверхности отдельного зерна, имеют тенденцию сливаться и образовывать более крупную нанопроволоку, состоящую из кластера нанопроволок. Следовательно, морфология нижележащего ITO будет напрямую влиять на морфологию нанопроволок, выращенных поверх него. Вид сверху микрофотографии, полученной с помощью сканирующего электронного микроскопа (СЭМ), показан на рис. 2b. По статистике плотность нанопроволоки при виде сверху составляет 9,3 × 10 9 . см −2 с коэффициентом заполнения 73%. Поперечное сечение образца показано на рис. 2в. Нанопроволоки растут перпендикулярно плоскости подложки с некоторым наклоном непосредственно поверх слоя ITO.
СЭМ-изображение образца нанопроволоки после 1 ч погружения в 40% раствор КОН показано на рис. 2г. Видно, что после химической обработки кончики нанопроволок частично стравливаются, что свидетельствует о N-полярности. Этот результат согласуется с ранее опубликованными результатами, согласно которым спонтанно выращенные нанопроволоки III-нитрида обычно являются N-полярными [16–19].
На рис. 3а показана широкоугольная кольцевая сканирующая электронная микроскопия в темном поле (HAADF-STEM) нанопроволок. Нанопроволоки растут непосредственно поверх слоя ITO. Чтобы изучить элементный состав границы раздела между нанопроводами и слоем ITO, мы выполнили линейное сканирование элементарного картирования для Ga, In, N и O с использованием EELS в области, ограниченной красной рамкой. Профиль строчной развертки показан на рис. 3б. Профиль линии указывает на четкую границу между нанопроводами GaN и ITO. ПЭМ-изображение с высоким разрешением одиночной нанопроволоки на рис. 3c показывает структуру решетки нанопроволоки, подтверждая монокристалличность материала. ПЭМ высокого разрешения на границе между нанопроволокой GaN и слоем ITO на рис. 3d показывает то, что выглядит как промежуточный слой (IL), состоящий из смеси поликристаллического и аморфного слоя толщиной около 4 нм между основанием нанопроволоки и ITO. . Предполагается, что этот тонкий слой является переходным слоем GaN, сформированным между поликристаллическим слоем ITO и кристаллическим слоем GaN. Ранее сообщалось о подобном слое, в котором нанопровода GaN выращивают непосредственно поверх слоя аморфного плавленого кварца [15].

ПЭМ и элементное картирование нанопроволок GaN, выращенных на слое ITO. а Изображение HAADF нанопроволок GaN, выращенных непосредственно поверх слоя ITO. Красный прямоугольник указывает, где было выполнено сканирование линии EELS. б Профиль линейной развертки EELS границы раздела между основанием нанопроволоки GaN и слоем ITO. Сопоставление элементов для Ga, In, N и O показано на графике. c ПЭМ высокого разрешения нанопроволоки GaN, демонстрирующая монокристалличность. Красная стрелка указывает направление роста. Межплоскостное расстояние соответствует c-плоскости GaN. г ПЭМ-изображение с высоким разрешением границы раздела между нанопроволокой GaN и слоем ITO. Частично аморфный промежуточный слой (IL) можно увидеть между нанопроволокой GaN и слоем ITO, ограниченный пунктирными красными линиями
Результат температурно-зависимой фотолюминесценции показан на рис. 4а. Измерения показывают, что желтая люминесценция, обычно связанная с дефектами в материалах GaN, примерно на три величины ниже, чем эмиссия края полосы GaN, что подчеркивает высококачественный рост материала GaN. Температурно-зависимая фотолюминесценция показана на рис. 4б. Результат показывает красное смещение при повышении температуры, обычно связанное с уменьшением ширины запрещенной зоны Варшни. Интенсивность пикового излучения уменьшается с увеличением температуры из-за активации центров безызлучательной рекомбинации. Подгонка Аррениуса выполняется по изменению интегральной интенсивности ФЛ по температуре, как показано на рис. 4c. Подгонка дает энергию активации 195 мэВ. Используя соотношение интегральной интенсивности при 290 К и 10 К, мы оцениваем внутреннюю квантовую эффективность нанопроволок примерно в 67%.

а Энергозависимое измерение нанопроволок GaN, выращенных на оксиде индия и олова, выполнено при 10 К. b Температурная зависимость nt ФЛ нанопроволок GaN, выращенных на слое ITO. c Расчетная энергия активации основана на измерении фотолюминесценции в зависимости от температуры. г Прозрачность подложки из плавленого кварца, отожженного слоя ITO на плавленом кварце и нанопроволок GaN, выращенных на слое ITO; е Профили XRD для плавленого кварца без покрытия, тонкой пленки ITO после осаждения, тонкой пленки ITO после отжига и нанопроволок GaN, выращенных на ITO
На рисунке 4d показано изменение коэффициента пропускания для отожженных ITO, плавленого кварца и нанопроволоки GaN на ITO / диоксиде кремния. Пропускание образца снижается после выращивания нанопроволоки GaN. Поскольку нанопроволоки GaN не поглощают в видимом диапазоне длин волн, пониженный коэффициент пропускания можно объяснить рассеянием света, вызванным самими нанопроволоками.
На рисунке 4e показаны результаты рентгеновской дифракции для подложки из диоксида кремния без покрытия, подложки из диоксида кремния с осажденным ITO, отожженных с помощью RTP нанопроволок ITO / диоксид кремния и GaN, выращенных на ITO / диоксиде кремния. В слое ITO после нанесения не наблюдается пика XRD, что указывает на почти аморфный слой. После отжига RTP можно наблюдать пики ITO (211), ITO (222), ITO (400), ITO (440) и ITO (622), что указывает на то, что отжиг улучшает кристалличность слоя ITO, что согласуется с предыдущими отчетами. [20]. Наиболее доминирующими пиками являются пик ITO (222) и пик ITO (400). Измеренный пик GaN (0002) в области 2 θ Сканирование показывает, что эта плоскость параллельна плоскостям ITO, что показывает, что нанопроволоки GaN растут на поликристаллическом слое ITO.
Чтобы проверить, будут ли нанопроволоки GaN на платформе ITO пригодными для использования в устройствах, мы вырастили нанопроволоки GaN с n-легированными нанопроводами GaN с использованием кремния в качестве легирующей примеси и измерили ВАХ отдельных нанопроволок с помощью C-AFM. С помощью этого метода мы получили статистические данные I-V из выборки. Результат измерения показан на рис. 5.

а C-AFM отображение топологии нанопроволок. б Соответствующий ток наконечника при подаче на образец напряжения -8В. c ВАХ одиночной нанопроволоки со смещением напряжения образца от -10 В до 10 В, демонстрирующая различную ВАХ между начальной и второй разверткой. г Распределение ВАХ по ряду нанопроволок после первоначальной развертки насквозь
Отображение тока на рис. 5b показывает, что нанопроволоки на рис. 5а изначально непроводящие, и только несколько точек показывают протекание тока. Чтобы лучше исследовать, почему нанопроволоки непроводящие, мы выполнили I-V характеристику отдельных нанопроволок. Диапазон развертки напряжения образца составляет от –10 до 10 В, с результирующим током на игле от –10 до 10 нА, что ограничено спецификацией системы AFM. Результат показан на рис. 5c. Для первой развертки мы обнаружили, что нанопроволоки демонстрируют очень высокое напряжение включения, что указывает на поведение контакта Шоттки между слоем n-GaN и ITO. Однако после повторения измерения мы обнаруживаем, что напряжение включения на кривой I-V было значительно снижено, что связано с уменьшением высоты барьера Шоттки. Мы наблюдали эту тенденцию к уменьшению напряжения включения после начальной развертки напряжения пробоя через несколько нанопроволок в области сканирования АСМ, показанной на рис. 5d, подтверждая, что это относится ко всем нанопроволокам, выращенным на ITO. Точный механизм снижения напряжения включения требует дальнейшего изучения. Предыдущие отчеты показали, что приложение высокого напряжения к материалу могло вызвать токопроводящие дорожки из-за электрического пробоя [21, 22] или изменить структуру самой нанопроволоки GaN [23], что привело к повышению напряжения включения.
Выводы
В заключение, мы выполнили рост нанопроволок GaN поверх тонкой пленки ITO, нанесенной на подложку из плавленого кварца. Физические характеристики с помощью электронной микроскопии показывают, что нанопроволоки растут перпендикулярно плоскости подложки, сохраняя при этом высокое качество кристаллов. С помощью фотолюминесценции было обнаружено сильное излучение на краю полосы GaN, в то время как желтая люминесценция, обычно связанная с дефектами, отсутствует. Нанопроволоки имеют предпочтительную N-полярность, на что указывает преимущественное травление кристаллической плоскости в растворе КОН. Измерения C-AFM на нанопроволоках с n-легированием показывают хорошую проводимость, что подчеркивает возможность применения платформы для устройств.
Сокращения
- AFM:
-
Атомно-силовая микроскопия
- BEP:
-
Эквивалентное давление пучка
- C-AFM:
-
Проводящая атомно-силовая микроскопия
- EELS:
-
Спектроскопия потерь энергии электронов
- FIB:
-
Сфокусированный ионный пучок
- IQE:
-
Внутренняя квантовая эффективность
- HAADF:
-
Круговое темное поле под большим углом
- HRTEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- ITO:
-
Оксид индия и олова
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- PA-MBE:
-
Плазменная молекулярно-лучевая эпитаксия
- PECVD:
-
Химическое осаждение из паровой фазы с применением плазмы
- PL:
-
Фотолюминесценция
- RF:
-
Радиочастота
- RTA:
-
Быстрый термический отжиг
- sccm:
-
Стандартный кубический сантиметр в минуту
- SEM:
-
Сканирующая электронная микроскопия
- STEM:
-
Сканирующая просвечивающая электронная микроскопия
- ТЕМ:
-
Просвечивающая электронная микроскопия
- XRD:
-
Рентгеновская дифракция
Наноматериалы
- Материаловеды учат нанопроволоки "танцевать"
- Обнаружение магнетизма ядра одиночного атома
- Нанокристаллы олова для будущей батареи
- О полупроводниковых наночастицах
- Самокатализирующийся рост вертикальных нанопроволок GaSb на стержнях InAs путем осаждения из паровой фазы метал…
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- К цепочкам с одним атомом и расслоенным теллуром
- Прямое выращивание перьевидных структур ZnO с помощью простой техники решения для фото-детектирующего прилож…
- Контроль роста высокоднородных нанопроволок селенида индия (In2Se3) с помощью процесса быстрого термического о…
- Оптимальные слои легирования кремнием квантовых барьеров в последовательности роста, формирующие потенциал…



