Биполярные эффекты в фотоэдс метаморфных квантовых точечных гетероструктур InAs / InGaAs / GaAs:характеристика и конструктивные решения для светочувствительных устройств
Аннотация
Исследовано биполярное влияние подложки GaAs и близлежащих слоев на фотоэдс вертикальных метаморфных InAs / InGaAs по сравнению с псевдоморфными (обычными) структурами квантовых точек (КТ) InAs / GaAs. И метаморфические, и псевдоморфные структуры были выращены методом молекулярно-лучевой эпитаксии с использованием нижних контактов либо на выращенных n + -буферы или подложка GaAs. Особенности, связанные с квантовыми точками, смачивающими слоями и буферами, были идентифицированы в фотоэлектрических спектрах обеих структур, контактирующих с буфером, тогда как спектры контактировавших с подложкой образцов показали дополнительное начало, приписываемое дефектным центрам EL2. Образцы, контактировавшие с подложкой, демонстрировали биполярное фотоэдс; Предполагалось, что это происходит в результате конкуренции между компонентами, относящимися к квантовым точкам и их слоями оболочки, с дефектами, связанными с подложкой, и самым глубоким выращенным слоем. В спектрах структур, контактирующих с буфером, прямых субстратных эффектов не обнаружено. Однако заметное негативное влияние n + -GaAs буферный слой по сигналу фотоэдс и фотопроводимости наблюдался в структуре InAs / InGaAs. Анализируя полученные результаты и выполненные расчеты, мы смогли дать представление о конструкции метаморфных структур с квантовыми точками, которые могут быть полезны для разработки новых эффективных фотонных устройств.
Фон
В последние два десятилетия композитные материалы, содержащие полупроводниковые наноструктуры, нашли широкое применение в фотонных приложениях благодаря светочувствительности, простоте и низкой стоимости изготовления, возможности перестройки спектра и высокоэффективному излучению с коротким сроком службы [1,2,3,4,5 ]. In (Ga) As гетероструктуры с квантовыми точками (КТ) представляют собой важный класс чувствительных к инфракрасному излучению наноструктур, которые широко используются в различных фотонных устройствах, таких как лазеры [2, 6], однофотонные источники [7, 8], фотоприемники [9,10,11,12,13] и солнечные элементы [14,15,16]. Многочисленные исследования посвящены улучшению фотоэлектрических свойств таких светочувствительных устройств. Например, диапазон фоточувствительности может быть расширен за счет возбуждения через промежуточную запрещенную зону [17, 18] или генерации множественных экситонов [19, 20], так что эффективность преобразования мощности солнечных элементов на основе квантовых точек может теоретически превысить пределы одиночных запрещенные солнечные элементы [21]. Такие методы, как уравновешивание деформации [22] и метод управления несоответствием [23], а также термический отжиг [24] используются для уменьшения деформаций в этих структурах, работая в рабочем диапазоне [25], а также для увеличения фотоотклика за счет подавление деформационных дефектов [26], которые могут действовать как центры рекомбинации.
Эффективный метод снижения деформации основан на выращивании метаморфного буфера (МБ) InGaAs вместо обычного GaAs. В результате структуры квантовых точек InAs / InGaAs вызвали большой интерес в последнее десятилетие [27,28,29]. При выращивании квантовых точек на МБ InGaAs можно наблюдать существенные различия в процессе формирования и оптических свойствах квантовых точек по сравнению с обычными квантовыми точками в матрице GaAs [25, 30, 31, 32, 33]. Например, ограничивающий слой InGaAs уменьшает рассогласование решеток между квантовыми точками и буфером и, следовательно, деформации в квантовых точках. В результате ширина запрещенной зоны InAs уменьшается и наблюдается значительное увеличение длины волны излучения [34]. Применение МБ в качестве ограничивающего материала позволяет сместить его величину в телекоммуникационное окно на 1,3 и 1,55 мкм [28, 29, 35, 36].
Кроме того, были обнадеживающие попытки применить фотоэлектрические свойства метаморфных структур квантовых точек InAs для создания таких светочувствительных устройств, как метаморфные инфракрасные фотодетекторы [11,12,13] и солнечные элементы [37,38,39]. Некоторые исследования были выполнены для разработки конструкции [25, 31,32,33], а другие - для улучшения фотоэлектрических свойств [39, 40]. Продолжаются исследования по снижению деформаций в гетероструктурах [34, 41], так как это приводит к существенному улучшению плотности фототока и спектрального отклика солнечных элементов [39, 40], а также фотоэмиссионной эффективности таких структур [ 29, 32, 42].
Создание светочувствительных устройств требует глубокого изучения фотоэлектрических свойств. Исследования фотоэдс (PV) или фотопроводимости (PC) являются идеальным инструментом для определения фотоотклика как функции световой энергии, переходов между уровнями, транспорта носителей и рабочего диапазона устройства [10, 43, 44]. Однако, несмотря на то, что некоторые исследования фотоэлектрических свойств структур с метаморфными квантовыми точками InAs были выполнены в последние годы [37,38,39, 43], все аспекты механизма фотоотклика все еще остаются неясными, как и влияние MB по свойствам наноструктур. В частности, подробно не исследовалось влияние подложки GaAs и связанных с ней интерфейсов на фотоэлектрические спектры структур InAs / InGaAs / GaAs с квантовыми точками. Хотя прилагаются значительные усилия, чтобы избежать влияния подложки, на фотоотклик влияет как подложка, так и близлежащие слои, выращенные методом молекулярно-лучевой эпитаксии (MBE). Таким образом, хотя применяемая геометрия контактов должна сохранять нижние слои и подложку электрически неактивными, заметное их отрицательное влияние на PV и фототок было обнаружено нами в предыдущем исследовании [43]. Совсем недавно мы сравнили фотоэлектрические свойства метаморфического InAs / In 0.15 Ga 0,85 Как и структура квантовых точек стандартной InAs / GaAs, и обнаружено, что фототок метаморфического InAs / In 0,15 Ga 0,85 Поскольку на гетероструктуры не влияют уровни, связанные с дефектами в окрестности КТ [45]. Кроме того, был сделан вывод, что эффективные фотонные устройства на 1,3 мкм могут быть разработаны с наноструктурами, аналогичными активному материалу.
В данной работе мы продолжаем исследование фотоэлектрических свойств гетероструктур с КТ InAs, внедренными либо в метаморфический In 0.15 Ga 0,85 Как или обычные буферы GaAs, сосредотачиваясь на влиянии подложки GaAs и близлежащих слоев MBE. Чтобы четко понять роль подложки и буферных слоев, мы рассмотрели структуры с нижними контактами на (i) In 0,15 Ga 0,85 В качестве буферного слоя или (ii) нижней подложки GaAs (см. Рис. 1). Таким образом, в зависимости от выбора нижнего контакта, ток протекал через (i) только квантовые точки и буферные слои и (ii) всю структуру, включая подложки и их границы раздела со слоями MBE. Анализ результатов и расчеты позволили нам понять, как лучше всего проектировать световые сенсоры на метаморфических структурах с квантовыми точками.
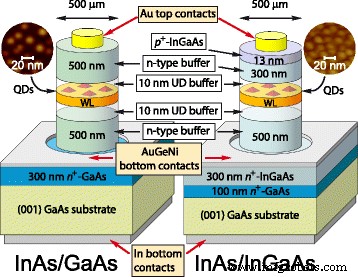
(Цветной онлайн) схемы метаморфических InAs / In 0.15 Ga 0,85 As / si -GaAs (справа) и InAs / GaAs / si -GaAs (слева) исследованы образцы квантовых точек; Показаны изображения АСМ незащищенных структур
Методы
Конструкции были подготовлены MBE на полуизолирующем (001) ( si ) Подложки GaAs. Подложки были n -тип, со значениями 3 × 10 7 см −3 остаточная концентрация носителей, толщина 500 мкм и удельное сопротивление 2 × 10 7 Ом × см. Метаморфические структуры квантовых точек InAs / InGaAs состоят из (i) 100-нм n + -Буферный слой GaAs, выращенный при 600 ° C, (ii) толщиной 300 нм n + -В 0,15 Ga 0,85 Как МБ с n =5 × 10 18 см −3 выращены при 490 ° C, (iii) толщиной 500 нм n -В 0,15 Ga 0,85 Как МБ с n =3 × 10 16 см −3 выращенные при 490 ° C, (iv) 3,0 монослоя (МС) самоорганизующихся квантовых точек InAs, внедренных в 20-нм нелегированный In 0,15 Ga 0,85 Как слой, выращенный при 460 ° C, (v) 300 нм n -В 0,15 Ga 0,85 В качестве верхнего защитного слоя с n =3 × 10 16 см −3 выращены при 490 ° C, и (vi) 13 нм p + -допированный In 0,15 Ga 0,85 Как крышка с p =2 × 10 18 см −3 выращены при 490 ° C (рис. 1). Скорость роста составляла 1.0 ML / s, за исключением КТ, которые были выращены со скоростью роста 0.15 ML / s. Нелегированные слои необходимы для отделения квантовых точек от n -допированных областей и, следовательно, для уменьшения влияния центров безызлучательной рекомбинации, тем самым максимизируя эффективность излучения света КТ [30, 46]. Стандартные структуры квантовых точек InAs / GaAs состоят из (i) 300 нм n + -GaAs буферный слой с n =5 × 10 18 см −3 выращены при 600 ° C, (ii) толщиной 500 нм n -GaAs MB с n =3 × 10 16 см −3 выращенные при 600 ° C, (iii) 3,0 МС КТ InAs, внедренные в нелегированный слой GaAs толщиной 20 нм, выращенные при 460 ° C, и (iv) 500 нм n -GaAs верхний защитный слой с n =3 × 10 16 см −3 выращены при 600 ° C. Скорость роста составляла 1,0 мл / с, за исключением квантовых точек, которые были выращены со скоростью роста 0,15 мл / с.
Изображения с атомно-силовой микроскопии (АСМ) незащищенных структур показаны на рис. 1. Анализ данных АСМ для подобных структур показал, что наиболее частые значения размеров КТ составляют 20 нм (диаметр) и 4,9 нм (высота) для метаморфических структур. КТ и 21 нм (диаметр) и 5,0 нм (высота) для стандартных КТ [30, 31, 45].
Для фотоэлектрических измерений круглые столы толщиной 500 мкм были вытравлены на структурах до нижнего буфера n + слои; Выпрямляющие верхние контакты Au диаметром 400 мкм и толщиной 70 нм затем испарялись на вершине мезы. Для получения омических контактов снизу n + -InGaAs и n + -GaAs буферные слои соответственно Au 0.83 Ge 0,12 Ni 0,05 Сплав напыляли при 400 ° C в течение 1 мин в атмосфере азота. Толстые индиевые омические контакты были сделаны на дне подложек в других частях тех же образцов, чтобы проводить измерения также с током, протекающим через буфер GaAs и si -GaAs субстрат. Омичность контактов подтверждена I - V измерения, соприкасаясь с куском подложки; вольт-амперные характеристики оказались линейными (данные не показаны).
Следуя подходу, предложенному в [5]. [47] и использованный в других работах [48, 49] тонкий p + -InGaAs слой между контактом Au и n -InGaAs слой был использован для увеличения высоты барьера Шоттки, поскольку структура, полученная простым осаждением металла на n -InGaAs показал относительно низкую высоту барьера Шоттки. Следовательно, нанесение тонкого p + -Слой InGaAs увеличивает высоту барьера Шоттки, чтобы он был аналогичен высоте контакта Au-GaAs, сохраняя сходство профиля барьера как для метаморфической структуры, так и для структур InAs / GaAs.
Для проектирования конструкции и контактов, а также для понимания профиля энергии для обеих структур, состоящих из In 0,15 Ga 0,85 МБ As или GaAs, квантовые точки In (Ga) As, нелегированный покровный слой и контакты Au / AuGeNi расчеты проводились с использованием программы Tibercad [50]. Профили полос моделировались в дрейфово-диффузионном приближении с учетом условий деформации, плотности ловушек, связанных с дефектами в области интерфейса InGaAs / GaAs, обедненных слоев вблизи контактов и соответствующей высоты барьера Шоттки. При расчете профилей полос метаморфических квантовых точек учитывались размеры из данных АСМ и учитывались эффекты деформации, следуя подходу, уже проверенному в работах [1,2]. [42, 51]. Расчет квантовых уровней квантовых точек выходит за рамки данной статьи, и моделирование квантовых точек проводилось ранее в [4]. [45]. Однако в этой работе мы рассчитываем профили полос всей гетероструктуры, включая подложку.
Вертикальный фототок и спектры PV были измерены в диапазоне от 0,6 до 1,8 эВ с использованием геометрии возбуждения при нормальном падении при комнатной температуре (RT) (300 K) и той же интенсивности источника света (1,5 мВт / см 2 ). Фототок измерялся с помощью усилителя тока и метода постоянного тока [10, 43,44,45] при смещении 1 В. Ток измерялся как падение сигнала напряжения на последовательной нагрузке с сопротивлением 100 кОм (см. Вставку на рис. 5). Фотолюминесценция (ФЛ), возбужденная на длине волны 532 нм, измерялась при 300 К. Некоторая информация, касающаяся структур и методов, более подробно описана в [4]. [45].
Результаты и обсуждение
А. Фотоэлектрическая характеристика
Спектры PV как InAs / In 0,15 Ga 0,85 Образцы As и InAs / GaAs представлены на рис. 2. При контакте только со слоями МЛЭ толщиной n -InGaAs или n -GaAs буферы, особенности спектров описаны в [45]. Спектральный порог InAs / In 0,15 Ga 0,85 As при 0,88 эВ связано с поглощением в основном состоянии в ансамбле КТ, что соответствует появлению полосы КТ в спектре ФЛ при RT, измеренном ранее [45] (рис. 2а). Спектр излучения метаморфных КТ показывает широкую полосу при 0,94 эВ, которая находится в телекоммуникационном диапазоне на 1,3 мкм (0,95 эВ), в то время как ФЛ КТ демонстрирует хорошую эффективность, как было отмечено в более ранних работах [30, 45, 46, 52]. Широкая полоса спектра PV с максимумом 1,24 эВ и краем 1,11 эВ связана с генерацией носителей в In 0,15 Ga 0,85 Как MB, так и смачивающий слой (WL), в том числе через неглубокие уровни. Следует добавить, что в 0.15 Ga 0,85 Так как ширина запрещенной зоны, рассчитанная для слоя, выращенного методом МБЭ, составляет 1,225 эВ [53], а ФЛ WL наблюдается при 1,2 эВ [45]. Кроме того, наблюдается значительное резкое падение выше 1,36 эВ, что, вероятно, связано с косвенным влиянием буферного слоя из высоколегированного GaAs, расположенного вне межконтактной области, о котором упоминалось в [4]. [43]. Буферный слой заполнен многочисленными мелкими уровнями и зонными неоднородностями, возникающими из-за дефектов роста МПЭ и центров легирования, которые вызывают красное смещение межзонного поглощения GaAs [33, 46, 54, 55]. Для обычной наноструктуры InAs / GaAs с буферным контактом начало при 1,05 эВ спектра ФВ на рис. 2б происходит из основного состояния КТ, что подтверждается спектром ФЛ, в то время как резкий скачок при 1,3 эВ может быть связан с переходы в WL [56]. Особенность после 1,39 эВ, очевидно, связана с поглощением в верхнем буферном слое легированного GaAs. Механизм этого эффекта будет подробно рассмотрен ниже.

(Цветной онлайн) ФЭ-спектры при комнатной температуре a метаморфический InAs / In 0.15 Ga 0,85 As и b Структуры InAs / GaAs с квантовыми точками; ФВ был измерен только в контакте со слоями МЛЭ [45] (черные кривые) и через полуизолирующие si -GaAs субстрат (синий). Спектры PV, измеренные через si -GaAs подложки инвертируются знаком напряжения ниже 1,68 и 1,44 эВ соответственно для a и b . На вставках приведены низкоэнергетические части кривых; полосы ФЛ КТ, измеренные до [45] для обеих структур, представлены для энергетического позиционирования основного состояния КТ (красный цвет)
Как уже упоминалось выше, резкое падение сигнала PV выше 1,36 эВ в InAs / In 0,15 Ga 0,85 Поскольку структура связана с n + -GaAs нижний слой, закрывающий основу. Чтобы устранить влияние слоев под нижним контактом AuGeNi на фотоотклик, мы исследовали фотоэлектрические свойства структур с использованием индиевого контакта на задней стороне подложки. В отличие от предыдущей геометрии контакта Au и AuGeNi, которая допускает униполярный ФВ, биполярный сигнал наблюдался для структур, контактировавших с верхней частью образца и обратной стороной подложки (рис. 2). Необходимо отметить, что знак PV меняется вдоль оси энергии фотонов, и на рис.2 спектры обоих образцов инвертированы знаком напряжения ниже 1,68 и 1,44 эВ для InAs / In 0,15 Ga 0,85 Структуры КТ As и InAs / GaAs соответственно. Здесь PV считается положительным, когда, как в случае контакта со слоями MBE, положительный потенциал прикладывается к верхнему контакту Au, а отрицательный - к нижнему контакту.
Все упомянутые выше оптические переходы вносят вклад в ФЭ-сигнал структур в геометрии контакта подложка-верх. Однако при измерении PV через подложку начало сигнала для метаморфических и обычных структур происходит при примерно 0,72 эВ. Начало при 0,72 эВ приписывают переходу от дефектного центра EL2, расположенного в si -GaAs-подложка и связанные с ней границы раздела около 0,75 эВ ниже зоны проводимости GaAs [57] с учетом возможности перехода через мелкие уровни дефектов [46, 54, 55]. Аспекты, связанные с их расположением, а также с началом красного смещения ПК EL2, подробно обсуждались в других работах [10, 45]. Поскольку в спектрах образцов, контактировавших с буферами InGaAs или GaAs (рис.2), сигнала под полосами, связанными с квантовыми точками, не наблюдалось (рис.2), можно сделать вывод, что подложка и связанные с ней границы раздела не имеют существенного влияния на свойства гетероструктур, выращенных методом MBE. .
Чтобы понять, как выглядит ФВ-сигнал в наших образцах, следует взглянуть на рис. 3, где показаны рассчитанные профили полос вдоль направления роста. Подробное объяснение происхождения ФВ между контактами Au и AuGeNi дано в предыдущей работе [45]. Таким образом, возбужденные светом электроны (дырки) дрейфуют преимущественно к подложке (поверхности), создавая положительный потенциал на контакте Au и отрицательный на контакте AuGeNi.

(Цветной онлайн) рассчитанный профиль полосы в метаморфическом InAs / In 0.15 Ga 0,85 Структуры As (вверху) и псевдоморфные InAs / GaAs (вниз) для объяснения механизма PV. Изгиб полосы более глубоких слоев под контактом AuGeNi показан серым цветом. Наблюдаемые оптические переходы в спектрах PV обозначены вертикальными стрелками; жирными стрелками показаны направления дрейфа оптически возбужденных носителей заряда под действием внутреннего поля (создание ФВ); E F - энергия Ферми. Расчеты проводились с использованием программы Tibercad [50]
Объяснение биполярного ФВ структур с электрически активным si -GaAs подложки, можно рассмотреть их рассчитанные зонные структуры на рис. 3. Как и раньше, носители, генерируемые в верхних слоях, а также в квантовых точках и WL, могут давать «+» наверху и «-» на подложке. Уровень Ферми в полуизолирующей подложке расположен намного ниже, чем в n -дегированные слои МЛЭ. Следовательно, изгиб ленты около n + Интерфейс -GaAs / подложка противоположен таковому в остальной структуре, выращенной методом МБЭ (см. Рис. 3). Следовательно, возбуждение в n + -GaAs-слой и подложка (выше 1,36 эВ) дают сигнал PV, противоположный сигналу от QD, WL и буферов. То же самое относится к возбуждению от дефектов EL2 (выше 0,72 эВ) подложки GaAs и особенно EL2-подобных дефектов в n + -GaAs / GaAs напряженная область [46, 57]. Вклад субстрата и н + -GaAs к общему сигналу фотоэлектрического элемента существенно сильнее, чем сигнал верхних слоев МЛЭ, а отрицательный сигнал фотоэлектрического излучения обычно наблюдается при более низких энергиях возбуждения, в то время как влияние слоев и наноструктур InGaAs проявляется в виде впадин на соответствующих спектральных кривых на рис. 2. Это ясно видно при сравнении спектральных полос квантовых точек, WL и буфера на кривых PV структур, контактировавших с буферами MBE, с впадинами в спектрах образцов, контактировавших с верхней частью подложки. Однако для более высоких энергий возбуждение поглощается ближе к поверхности образца, не достигая более глубоких слоев МПЭ и подложки, которая является основным источником отрицательного сигнала. Следовательно, сигнал PV становится положительным при больших энергиях. Итак, наличие электрически активных си -подложка приводит к конкуренции между спектральными компонентами, связанными с верхними слоями, выращенными методом МПЭ, и дефектами, связанными с подложкой, и n + -Поглощение GaAs.
В остальном подобная характерная особенность выше 1,35 эВ наблюдалась с помощью поверхностной фотоэлектрической спектроскопии в недавнем подробном исследовании p -допированные квантовые точки InAs / GaAs и InAs / InGaAs точечные структуры на основе si -GaAs подложки [58]. Резкое падение амплитуды ФВ объясняется, в отличие от нашего случая, разными носителями заряда, генерируемыми ниже и выше 1,35 эВ. Однако, учитывая резкое различие в упомянутых и настоящих структурах, а также специфику применяемых методов, мы придерживаемся нашей интерпретации собственных результатов.
Основываясь на концепции изгиба полосы под контактом AuGeNi, можно объяснить резкое падение сигнала ФВ в метаморфической структуре InAs / InGaAs с буферным контактом выше 1,36 эВ, наблюдаемое на рис. 2а. Эта спектральная особенность обусловлена влиянием подложки и самого глубокого МПЭ n + -GaAs слой. Действительно, генерируемые там электроны движутся под действием собственного поля к контакту AuGeNi, вызывая там дополнительное электрическое поле, при этом барьер из-за изгиба зон на гетеропереходе InGaAs / GaAs, очевидно, слишком мал, чтобы быть существенным препятствием для носителей заряда. Это выравнивает изгиб полосы в верхних слоях, которые непосредственно вносят вклад в PV, и, следовательно, уменьшает запас носителей, фотовозбужденных выше n + -Слой GaAs и, как следствие, общий сигнал PV.
Небольшая особенность около 1,39 эВ наблюдается на рис. 2b в спектре псевдоморфного образца, контактировавшего с буферами МБЭ, хотя следует ожидать резкого падения сигнала, как в метаморфической структуре, выше 1,36 эВ, с учетом аналогичного изгиба полосы. рядом с n + -GaAs / интерфейс подложки. Такая особенность не является атрибутом только субстрата и n + -дегированный GaAs; такие переходы обнаружены в структурах квантовых точек In (Ga) As / GaAs на основе p -дегированный [58] и нелегированный GaAs [10, 55]. Эти переходы, очевидно, происходят и в верхних слоях GaAs нашей псевдоморфной структуры, компенсируя в основном негативное влияние слоев, прилегающих к подложке, на сигнал ФЭ. В результате на черной кривой для образца InAs / GaAs на рис. 2б можно наблюдать лишь незначительное влияние слоя, прилегающего к подложке, а не спад кривой метаморфического образца, происходящего от более глубоких слоев GaAs, несмотря на аналогичную биполярность. Эффект наблюдается при непосредственном участии субстрата в формировании ПВ.
Причина небольшой особенности после 1,39 эВ в спектре образца InAs / GaAs, контактировавшего с буферами МБЭ, может отличаться от описанной выше для метаморфного образца InAs / InGaAs. По нашему мнению, это происходит из-за небольшого спада сигнала, вызванного краем поглощения верхнего GaAs-буфера толщиной 500 нм, выращенного методом МЛЭ, затеняющего КТ и ЛС, которые вносят более эффективный вклад в ФВ при этих энергиях фотонов. Действительно, электроны и дырки, генерируемые в КТ и СЛ, разносятся в разные стороны и избегают рекомбинации, в отличие от объемной генерации, где рекомбинация гораздо более вероятна. Это основная причина эффективного обнаружения фотоносителей даже из одного слоя КТ и ЛП. Фотоны более высоких энергий поглощаются от зоны к зоне в приповерхностных n -GaAs буферный слой и электроны уходят в объем образца вдали от дырок, что приводит к резкому увеличению PV выше 1,4 эВ. Правильность предложенной причины особенности 1,36 эВ в структуре InAs / GaAs с буферным контактом, а не предполагаемой для метаморфической структуры, подтверждается исследованиями солнечных элементов на основе структур InAs / GaAs с нижними контактами на n + -GaAs подложки [18, 24, 59], т.е. с монотонным изгибом полосы по всему образцу от контакта к контакту. Их спектры PV демонстрируют ту же особенность без барьера, связанного с границей раздела слоя MBE с подложкой. Кроме того, в спектрах ФК структур InGaAs / GaAs с боковой геометрией контакта и без собственного поля наблюдался узкий провал в том же спектральном диапазоне [10, 55].
Спектры ФК структур, полученные при смещении 1 В, направленном подобно собственному полю в верхних слоях структур («-» наверху и «+» на нижнем контакте), представлены на рис. 4. Спектры ПК для структуры, контактирующие со слоями MBE, очень похожи на структуры PV на рис. 2. Компоненты из буферов QD, WL, InGaAs или GaAs, а также n + -GaAs-слой наблюдаются при тех же энергиях. Что касается конструкций с нижним контактом на s i -GaAs, спектры ПК имеют пороги около 0,72 эВ, связанные с поглощением в центре дефекта EL2.
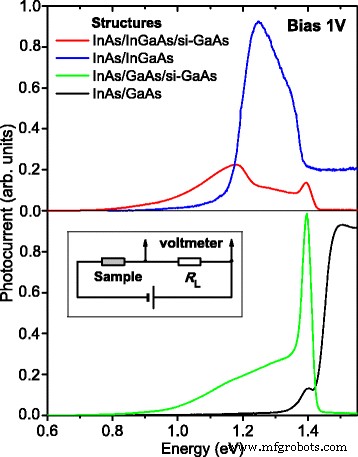
(Цветной онлайн) Спектры фототока метаморфического InAs / In 0.15 при комнатной температуре Ga 0,85 As / si -GaAs и обычный InAs / GaAs / si -GaAs QD-структуры. На вставке:электрическая схема подключения образца для измерений на ПК
Особенности спектров ПК для структур, контактировавших со слоями МЛЭ, представленные на рис. 4, в основном соответствуют таковым в спектрах ФВ на рис. 2, рассмотренным выше. Что касается конструкций с нижним контактом на s i -GaAs подложка с центральным компонентом EL2, существует конкуренция между сигналом от поглощения в слоях MBE и от связанных с EL2 уровней, как обсуждалось выше. Однако форма кривых позволяет сделать вывод, что в слоях выше n возбужденных носителей заряда нет. + -GaAs участвуют в ПК; это особенно актуально для спектра метаморфической структуры КТ. Очевидно, электроны не достигают дна из-за высокого потенциального барьера (см. Рис. 3), создаваемого si -подложка. Подложка имеет слишком высокое сопротивление, и основное падение приложенного напряжения происходит на ней, следовательно, снижения барьера не происходит.
Итак, можно отметить, что на PV и фототок отрицательно влияет n , связанный с подложкой. + -GaAs слой:поглощение выше 1,36 эВ вызывает резкое снижение сигнала. Основная причина барьера под контактом AuGeNi - это si -GaAs-подложка с довольно низким расположением уровня Ферми, приводящим к изгибу зон, противоположному таковому в вершине структуры. Это единственный эффект подложки, наблюдаемый в ФВ при такой геометрии контакта, и он проявляется даже при довольно толстом (400 нм) промежуточном слое между нижним контактом и подложкой.
Б. Решения для проектирования промежуточных слоев субстрата и гетероструктуры
С практической точки зрения можно сделать вывод, что такая конструкция структуры InAs / InGaAs с si -Подложка GaAs бесполезна в разработке вертикальных светочувствительных устройств, особенно вместе с относительно тонким n + -дегированный буфер, даже если конфигурация контактов исключает протекание тока через подложку. Область пространственного заряда, сформированная в n + Область границы раздела -GaAs / подложка заставляет возбужденные здесь носители заряда двигаться противоположно тем, которые возбуждены в метаморфической структуре, как на рис. 3 и 5a, таким образом генерируя противоположный PV-сигнал и уменьшая общую квантовую эффективность образца.
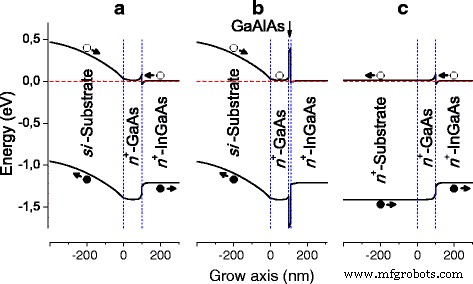
(Цветной онлайн) рассчитанные профили полос около In 0,15 Ga 0,85 Интерфейсы As / GaAs метаморфической структуры, выращенной на si -подложка с n + -GaAs слой толщиной a 100 нм (настоящий образец), b 100 нм и Ga 0,3 толщиной 10 нм Al 0,7 В качестве барьерного слоя и c структура похожа на настоящее, но выросла на n + -подложка легирована аналогично слою n толщиной 100 нм + -GaAs слой выше. Расчеты проводились с использованием программы Tibercad [50]
Следовательно, для устройств, основанных на поглощении света, следует рассмотреть другую конструкцию конструкции. Мы считаем, что такое улучшение необходимо предложить, потому что многие исследовательские группы считают, что si -GaAs субстрат как основа для нового p - нет -типа как инфракрасные фотодетекторы QD [11,12,13], так и солнечные элементы [15].
Простое утолщение n + -GaAs-буфер под метаморфической структурой кажется не очень хорошей идеей. Хотя такой буфер может поглощать больше квантов возбуждения выше 1,37 эВ и затенять границу раздела и подложку внизу, его толщина должна быть очень большой, потому что 800 нм материала InGaAs с более узкой запрещенной зоной выше недостаточно для полного подавления отрицательных биполярных эффектов. Более того, даже очень толстый n + -GaAs-буфер не может исключить отрицательное влияние EL2-подобных центров, которые расположены в основном в подложке и вблизи их границы раздела со слоем МБЭ. Тем не менее, поскольку носители заряда имеют ограниченную длину свободного пробега, утолщение n + -Слой GaAs может ослабить индуцированное отрицательное поле на контакте AuGeNi выше.
Лучшее улучшение может быть обеспечено путем выращивания тонкого барьерного слоя для электронов, выходящих из подложки, как показано на рис. 5b. Для расчетов использовался нелегированный Ga 0,3 толщиной 10 нм. Al 0,7 В качестве барьерного слоя был выбран. Такой барьер мог бы сильно удерживать электроны, возбужденные в подложке, в пределах n + -GaAs слой. Подобные высокоомные слои, выращенные из материалов с широкой запрещенной зоной, такие как InAlAs, GaAlAs и AlAs, использовались в лазерных структурах, чтобы избежать утечки носителей заряда из активной области оптоэлектронного устройства [60]. Однако в случае GaAs-In 0,15 Ga 0,85 В качестве базового устройства Ga 0.3 Al 0,7 Наилучшим образом соответствует из-за широкой запрещенной зоны и небольшого рассогласования решеток между эпитаксиальным слоем. Уменьшая индуцированное носителями поле на контакте AuGeNi, это может подавить негативное влияние области подложки на фотоотклик, особенно в сочетании с увеличением n + -Толщина слоя InGaAs.
Тем не менее, более оптимальная конструкция вертикальных структур, по-видимому, заключается в использовании монотонного градиента легирования, включая n + подложка из GaAs, как это предлагается в [14, 39, 40]. Эта конструкция наиболее эффективна и в то же время проста. Если подложка легирована аналогично покрытию n + -слой или более тяжелый, это вызывает изгиб ленты, показанный на рис. 5c. Кроме того, существенное преимущество такой подложки может проявиться в конструкции солнечных элементов. Подложка с низким сопротивлением позволяет использовать конфигурацию с контактом «-» на дне образца [24, 38,39,40, 59], не затеняя структуру МБЭ от солнечного света.
Выводы
Мы показали, что фотоэлектрическая характеризация свидетельствует о критическом влиянии глубоких уровней на фотоэлектрические свойства вертикальных метаморфических InAs / In 0.15 Ga 0,85 As и псевдоморфные (обычные) структуры квантовых точек InAs / GaAs в случае электрически активных si -GaAs субстрат. Обе наноструктуры демонстрируют биполярный ФВ, вызванный конкуренцией компонентов, происходящих из профилей полос с противоположным наклоном вблизи подложки GaAs и нижней части МПЭ n + -Слой GaAs с одной стороны и остальная часть структуры, выращенной методом МЛЭ, с другой стороны. Альтернативная конфигурация контактов, позволяющая избежать протекания тока через нижние слои, демонстрирует униполярную ФВ. Последняя конфигурация вместе с толстыми буферами на подложке сильно подавляет влияние фотоактивных глубоких уровней, исходящих от границ раздела с si -GaAs-подложка на фотоэлектрические свойства наноструктур. Однако заметное отрицательное косвенное влияние подложки на сигнал фотоэдс и фототока от структуры InAs / InGaAs наблюдается, когда возбуждение поглощается в подложке и вблизи подложки n + -GaAs слой MBE. Анализируя полученные результаты и выполненные расчеты, мы смогли дать представление о конструкции метаморфных структур с квантовыми точками, которые могут быть полезны для разработки новых эффективных фотонных устройств.
Сокращения
- AFM:
-
Атомно-силовая микроскопия
- МБ:
-
Метаморфический буфер
- MBE:
-
Молекулярно-лучевая эпитаксия
- ML:
-
Монослой
- ПК:
-
Фотопроводимость
- PL:
-
Фотолюминесценция
- PV:
-
Фотоэдс
- QD:
-
Квантовая точка
- R L :
-
Сопротивление нагрузки
- si :
-
Полуизолирующие
- WL:
-
Смачивающий слой
Наноматериалы
- Проектирование и разработка устройств 5G:диапазоны производительности 5G
- Композиты с квантовыми точками на S, N-графене / TiO2 для эффективного фотокаталитического производства водород…
- Разработка процесса нанесения покрытия погружением и оптимизация производительности для электрохромных ус…
- Яркий однофотонный источник на 1,3 мкм на основе двухслойной квантовой точки InAs в Micropillar
- Обнаружение пространственно локализованного экситона в самоорганизованных сверхрешетках из квантовых точе…
- Эффективный и действенный дизайн нанопроволок InP для максимального сбора солнечной энергии
- Оценка структур графен / WO3 и графен / CeO x как электродов для применения в суперконденсаторах
- Устранение бимодального размера в квантовых точках InAs / GaAs для изготовления лазеров на квантовых точках 1,3 мк…
- Рекомендации по проектированию ВЧ и СВЧ
- Неудачи и решения при проектировании радиочастотных печатных плат



