Обнаружение пространственно локализованного экситона в самоорганизованных сверхрешетках из квантовых точек InAs / InGaAs:способ повышения фотоэлектрической эффективности
Аннотация
В данной статье сообщается об экспериментальных и теоретических исследованиях атипичных температурно-зависимых фотолюминесцентных свойств многослойных квантовых точек InAs в непосредственной близости от деформационного рельефа InGaAs, лежащего в основе квантовой ямы. Гетероструктура InAs / InGaAs / GaAs с квантовыми точками была выращена методом молекулярно-лучевой эпитаксии с твердотельным источником (SS-MBE) и исследована методами фотолюминесценции (PL), спектроскопической эллипсометрии (SE) и пикосекундной фотолюминесценции с временным разрешением. В спектрах ФЛ образца наблюдаются отчетливые пики двойного излучения. Согласно измерениям ФЛ, зависящим от мощности возбуждения и температуры, эти пики излучения связаны с переходом в основное состояние квантовых точек InAs с двумя различными населенностями. Измерения люминесценции проводились в зависимости от температуры в диапазоне 10–300 K методом ФЛ. Низкотемпературная ФЛ показала аномальное излучение, которое появилось на стороне низких энергий и объясняется рекомбинацией через глубокие уровни. Энергия пика ФЛ имеет аномальное поведение в результате процесса конкуренции между локализованными и делокализованными носителями. Мы предлагаем модель ансамбля локализованных состояний для объяснения обычного поведения фотолюминесценции. Количественное исследование показывает, что состояния континуума квантовой ямы действуют как транзитный канал для перераспределения термически активированных носителей. Определены глубина локализации и ее влияние на применение исследуемой гетероструктуры для фотоэлектрических элементов. Модель дает обзор возможного улучшения свойств СЭ квантовых точек InAs / InGaAs / GaAs на основе теоретических расчетов.
Фон
Самоорганизованные квантовые точки (КТ) широко исследуются для возможных приложений в оптоэлектронике из-за природы трехмерного ограничения носителей и δ-подобной плотности состояний. Недавно были предложены структуры с квантовыми точками для реализации солнечных элементов с промежуточной зоной (IBSC), которые вводят дополнительные фотоносители за счет поглощения валентных IB и IB-зон проводимости [1]. IBSC на основе GaAs с квантовыми точками, которые имеют меньшую ширину запрещенной зоны, чем GaAs, образуют тандемные структуры, которые способны поглощать фотоны при энергиях ниже, чем ширина запрещенной зоны GaAs, что приводит к более высокой эффективности преобразования энергии [2]. Для формирования промежуточной полосы квантовых точек необходима плотноупакованная многослойная структура квантовых точек высокой плотности [3,4]. Однако кристаллическое качество квантовых точек InAs ухудшается по мере увеличения количества слоев квантовых точек и уменьшения расстояния между слоями из-за нарастания внутренней деформации сжатия. Чрезмерная деформация вызовет дислокации и дефекты, которые выходят из квантовых точек к поверхности. Следовательно, производительность СЭ InAs / GaAs с квантовыми точками также ухудшается по мере увеличения количества слоев с квантовыми точками [5]. Чтобы преодолеть эти проблемы, была продемонстрирована методика роста компенсации деформации с использованием буферного слоя GaAsN, GaAsP и GaP для систем материалов InAs / GaAs [6,7,8]. Другой способ преодоления этих проблем - покрытие слоя квантовых точек InAs / GaAs тонким слоем пониженной деформации InGaAs. По сравнению с квантовыми точками InAs / GaAs этот слой вызывает красное смещение фотоотклика из-за наличия небольшого рассогласования решеток между InAs и InGaAs. Исследование температурно-зависимой фотолюминесценции дает полезную информацию о многослойных СЭ КТ InAs / GaAs, которая представляет значительный практический и теоретический интерес. Обычно ширина запрещенной зоны полупроводникового материала монотонно уменьшается с повышением температуры. Специальные материалы, такие как квантовые точки InAs / GaAs, показали аномалию в ФЛ при низких температурах из-за термически активированных механизмов переноса носителей заряда в ансамбле квантовых точек. Однако эти аномалии постепенно исчезают после послеростовых процессов перемешивания в гетероструктурах InAs / InGaAs / GaAs с квантовыми точками, как показано Ilahi et al. [9]. Гетероструктуры, подобные тем, что представлены в настоящем исследовании, были исследованы на предмет их эффективности в фотоэлектрических приложениях Sayari et al. [10]. За последние десятилетия было предложено много моделей, таких как Passler, Vina, Varshni. Для создания надежных устройств температурные характеристики гетероструктур InAs / InGaAs / GaAs с квантовыми точками такого типа должны быть хорошо изучены, и это делается с помощью модели, наиболее подходящей для этого. Мы используем классическую модель Пасслера с поправкой на коэффициент теплового перераспределения, чтобы лучше понять наблюдаемую S-образную температурную зависимость экситонной запрещенной зоны. Наше исследование дает самосогласованную точную картину локализации и переноса носителей в гетероструктуре InAs / InGaAs / GaAs с квантовыми точками, которая является чрезвычайно технологически важным энергетическим материалом для создания высокоэффективных фотоэлектрических устройств.
Подробные сведения об эксперименте
На рис. 1 представлена схематическая диаграмма гетероструктуры InAs / InGaAs / GaAs с квантовыми точками, исследованная в нашей работе. Гетероструктура состоит из пяти стопок InAs / In 0.11 Ga 0,89 Слои квантовых точек As / GaAs, зажатые внутренним слоем GaAs толщиной 80 нм. Эпитаксиальные слои выращивались на эпитаксиальном канале + . -GaAs (100) подложка с использованием молекулярно-лучевой эпитаксии с твердым источником (SS-MBE) с системой Riber MBE 32P. После десорбции оксида 250 нм n + буфер GaAs с плотностью легирования 2 × 10 18 см −3 был выращен при 520 ° C с последующим выращиванием базового слоя GaAs, легированного n-типа 1000 нм, с плотностью легирования 10 17 см −3 . Затем температура подложки понижается и стабилизируется на уровне 500 ° C для осаждения собственной области. Как показано на рис. 1, повторяющиеся слои состоят из 2,5 монослоев (МС) покрытия InAs, толщиной 5 нм In 0,11 Ga 0,89 As и GaAs толщиной 33 нм. Формирование квантовых точек контролировалось in situ путем мониторинга дифракционной картины высокоэнергетических электронов (ДБЭО). Назначение In 0.11 толщиной 5 нм Ga 0,89 As предназначен для красного смещения спектров излучения и поглощения, в то время как GaAs толщиной 33 нм действует как разделительный слой. Темпы роста InAs, In 0.11 Ga 0,89 Слои As и GaAs составляли 0,08 ML / s, 0,78 ML / s и 0,7 ML / s соответственно, измеренные с помощью колебаний зеркального пятна ДБЭО. В конце концов, эмиттерный слой GaAs с p-легированием толщиной 500 нм (2 × 10 17 см −3 ), за которым следует 100-нм GaAs p + -легированный контактный слой (5 × 10 18 см −3 ) были выращены поверх гетероструктуры. Кремний (Si) и бериллий (Be) использовались как легирующие примеси n- и p-типа соответственно. Во время выращивания температуру калибровали пирометром.
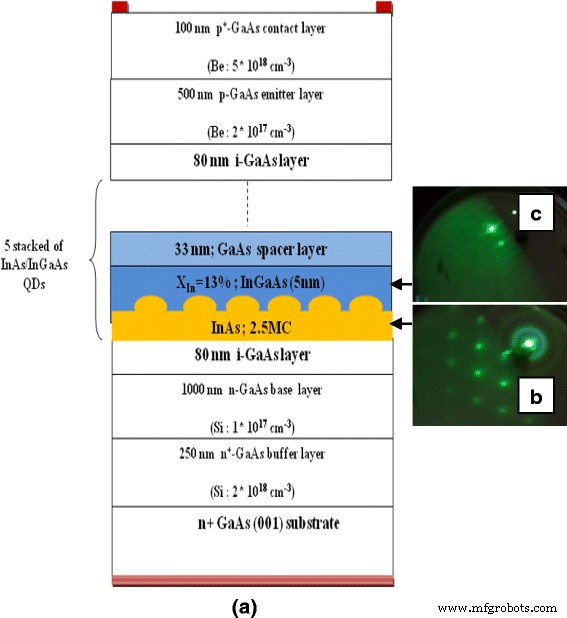
а Схематическая структура слоев пятислойной многослойной СК КТ InAs / InGaAs, выращенных на (001) n + -GaAs субстрат. б Рисунок ДБЭО сформирован после выращивания 2,5 мл InAs (трехмерный рост). c Узор ДБЭО во время роста 5 нм InGaAs (двумерный рост) [10]
Спектроскопическую эллипсометрию (SE) проводили при комнатной температуре от 1 до 6 эВ с использованием прибора J.A. Спектроскопический эллипсометр с переменным углом Вуллама (ВАСЕ) М-2000. Измерения SE проводились при углах падения от 45 ° до 60 °. При измерениях ФЛ ион аргона (Ar + ) лазер с длиной волны 514,5 нм использовался в качестве источника возбуждения для генерации электронно-дырочных пар. Свет люминесценции от образцов рассеивался спектрометром высокого разрешения и регистрировался термоэлектрическим охлаждаемым Ge-фотодетектором со встроенным усилителем. Для измерения зависимости ФЛ от мощности возбуждения и от температуры образцы помещались в гелиевый криостат замкнутого цикла с регулируемой температурой. Спектры ФЛ снимались в диапазоне номинальной выходной мощности 1,5–350 мВт и диапазоне температур 11–300 К. Измерения ФЛ с временным разрешением проводились в гелии замкнутого цикла с переменной температурой (10–240 К). криостат. Линия 514 нм использовалась в качестве длины волны возбуждения от титан-сапфирового пикосекундного импульсного лазера с синхронизацией мод с частотой повторения 80 МГц и шириной импульса 1,2 пс.
Результаты и обсуждения
На рис. 2 показаны измеренные действительная (а) и мнимая (б) части диэлектрической проницаемости гетероструктуры InAs / InGaAs / GaAs с квантовыми точками при 300 K в диапазоне энергий 1–6 эВ. Реальная и мнимая части следуют разным образцам. Изменение диэлектрической функции в зависимости от энергии фотона указывает на то, что некоторые взаимодействия между фотонами и электронами в пленках происходят в диапазоне энергий 1–6 эВ. Двумя основными спектральными характеристиками являются E 1 и E 2 структуры критических точек (КТ) при ~ 3 и ~ 4.5 эВ соответственно [11, 12]. Чтобы количественно определить энергетическое положение различных межзонных переходов, мы взяли пересечение нуля спектра второй производной мнимой части псевдодиэлектрической функции. Различные полученные энергии переходов сведены в Таблицу 1.
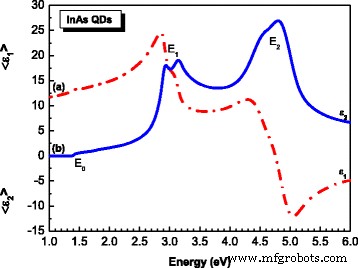
Реальный ( ϵ 1 ) ( красная пунктирная линия ) и мнимые ( ϵ 2 ) ( сплошная синяя линия ) части диэлектрических функций гетероструктуры InAs / InGaAs с квантовыми точками, полученные из измерений SE [10]
На рисунке 3 показан спектр второй производной энергии мнимой части псевдодиэлектрической функции, показанной на рисунке 2. Два пика при 2,9 и 3,1 эВ соответствуют, соответственно, E 1 и E 1 + Δ 1 , межзонные переходы в GaAs. Однако два близко расположенных пика при 4,4 и 4,7 эВ вызваны CP-переходами E 0 ’И E 2 соответственно в слоях квантовых точек InAs [12]. Отметим, что вклад E 1 + Δ 1 Энергия CP (2,74 эВ) [12] InAs на E 1 одну (2,91 эВ) [11] GaAs нельзя исключить из-за небольшой разницы между двумя значениями энергии. При низкой энергии запрещенная зона GaAs хорошо различима в ε спектр около 1,4 эВ. Кроме того, второй спектр производной энергии (рис. 3) показывает межзонный переход при 1,75 эВ, что соответствует E 0 + Δ 0 Энергия КП GaAs [11]. Известно, что ε 2 мера и мера качества материала; наибольшее значение подразумевает наиболее резкий интерфейс [13]. По данным литературы, ε 2 значения около 25, максимальное значение 26,8 в нашем случае, полученное в области E 2 ширина запрещенной зоны около 4,7 эВ указывает на высокое качество материалов, образующих гетероструктуру InAs / InGaAs / GaAs с квантовыми точками, выращенную методом SS-MBE.
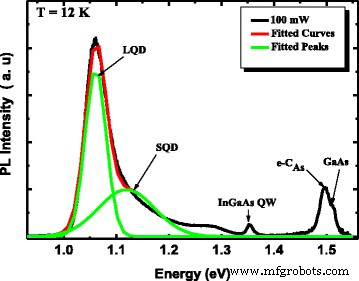
Спектр второй производной мнимой части ( ϵ 2 ) диэлектрической функции как функции энергии фотонов для гетероструктуры InAs / InGaAs с квантовыми точками. Указаны энергии переходов, возникающих из слоев квантовых точек InAs и слоев GaAs [10]
На рис. 4 показан спектр ФЛ активной области гетероструктуры InAs / InGaAs / GaAs с квантовыми точками с мощностью возбуждения 100 мВт при низкой температуре (12 K). Очевидно, что спектр имеет асимметричную форму, расположенную на стороне высоких энергий, и который может быть разложен на две поддиапазоны с помощью гауссовой аппроксимации [14]. Учитывая зависимость потенциалов размерного квантования от размера точки, наиболее интенсивный пик, расположенный при 1,06 эВ, приписывается излучению из основных состояний более крупных квантовых точек (LQD), в то время как пик с более высокой энергией при 1,11 эВ относится к излучению из основные состояния меньших квантовых точек (SQD) [15]. Таким образом, при очень низкой мощности возбуждения и низкой температуре мы заключаем, что асимметричная форма обусловлена люминесценцией, происходящей из бимодального распределения точек по размерам [16]. Кроме того, пики, происходящие от слоя квантовой ямы InGaAs, рекомбинации между электронами в зоне проводимости GaAs и дырками на уровне акцептора углерода (e-C As ) [17] и ширина запрещенной зоны GaAs составляют около 1,35, 1,49 и 1,51 эВ соответственно. Чтобы подтвердить эту принадлежность к асимметричной форме, мы провели измерения ФЛ при различной мощности лазера от 10 до 100 мВт. Мы также провели АСМ-измерения на незащищенной структуре, аналогичной исследуемой. Из рис. 5 видно, что гетероструктура имеет энергонезависимую форму ФЛ. За исключением самого высокого спектра возбуждения, интенсивность ФЛ и ширина линии пика высокоэнергетической ФЛ гетероструктуры существенно не меняются. Кроме того, энергетическое разделение между двумя пиками ФЛ (рис. 5) составляет около 50 мэВ. Как и ожидалось, изображение АСМ демонстрирует, что квантовые точки в пятом слое обладают бимодальным распределением размеров с полной плотностью квантовых точек 7 × 10 10 см ^ (- 2). Предполагая, что низкоэнергетические боковые пики гетероструктуры соответствуют основному состоянию больших квантовых точек (LQD), мы можем сказать, что высокоэнергетические пики при высокой мощности, по-видимому, являются результатом основных состояний относительно небольших квантовых точек (SQD ).
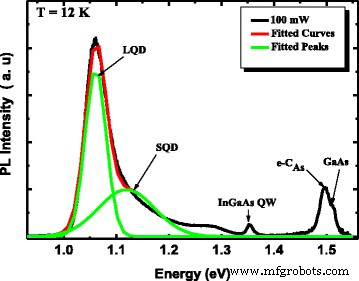
Спектр ФЛ, измеренный при низкой температуре (12 K) пятислойной многослойной гетероструктуры InAs / InGaAs с квантовыми точками. Анализ формы линий спектров доказывает, что сигнал КТ ФЛ представляет собой свертку двух пиков гауссовой формы, показанных сплошными линиями

Нормированные спектры ФЛ гетероструктуры InAs / InGaAs с квантовыми точками, зависящие от мощности возбуждения, измеренные при 12 К
Чтобы получить представление о механизмах рекомбинации фотолюминесценции, на гетероструктуре выполняются температурно-зависимые измерения фотолюминесценции в диапазоне от 10 до 300 К, показанные на рис. 6. На рис. 7 показано энергетическое положение основного пика, связанного с излучением ЖКД. Этот пик показывает аномальную температурную зависимость между 10 и 100 К по сравнению с другими тройными сплавами III – V, такими как обычный GaAlAs [18]. В этом температурном диапазоне (область (i)) наблюдается красное смещение около 12 мэВ. Этот сдвиг обусловлен рекомбинацией экситонов через локализованные состояния в ансамбле неоднородно распределенных LQD. По мере повышения температуры в этом диапазоне температур носители термически активируются и переносятся от меньших квантовых точек к более крупным внутри ансамбля, где они в конечном итоге рекомбинируют радиационно. Это делает наблюдаемые явления, вероятно, результатом большой дисперсии размеров точек в нашей структуре (см. Вставку АСМ). Характерная температура, при которой два процесса рекомбинации (локализованные и делокализованные носители) в равной степени участвуют в сигнале ФЛ, обозначается как T loc / deloc . Затем между 100 и 120 К (область (ii)) пиковая энергия увеличивается. Это связано с уходом носителей из более мелких состояний в более высокие. Характеристическая температура обозначается как T . escape . Даже при высокой температуре (область (iii)) экситоны полностью делокализованы, и межзонная рекомбинация восстанавливается.

Температурно-зависимые спектры ФЛ гетероструктуры InAs / InGaAs с квантовыми точками, измеренные при мощности возбуждения 100 мВт

Энергии пиков ФЛ LQD исследуемой гетероструктуры с квантовыми точками InAs / InGaAs, измеренные при различных температурах
Для дальнейшего понимания процесса рекомбинации в многослойных квантовых точках InAs / InGaAs / GaAs мы исследовали ФЛ с временным разрешением, используя методику фотоотсчета с временной корреляцией. Теоретически было предсказано, что время жизни экситонного распада КТ чувствительно к температуре [19]. Экспериментальные измерения показали, что времена жизни действительно являются постоянной температурой ниже критической [20]. Маркус и др. [21] сообщили о постоянном времени жизни около 950 пс в широком диапазоне температур в пределах экспериментальной ошибки.
На рисунке 8а представлен спектр затухания фотолюминесценции между 17 и 240 К для фиксированной энергии регистрации 1,06 эВ и энергии возбуждения ( λ exc =514 нм). Теоретически эти спектры хорошо аппроксимируются моноэкспоненциальной функцией с временем затухания ~ 1000 пс при более низких температурах. Это медленное время распада, по сравнению с тонкими пленками полупроводников AIIIBV [22], является признаком присутствия локализованных состояний [23], и рекомбинация носителей в пике LQD должна быть чисто излучательной. Действительно, при низкой температуре фотогенерированные электроны и дырки, прежде чем они рекомбинируют, требуется время для образования экситонов и релаксации своей энергии, чтобы быть захваченными мелкими локализованными состояниями. Эти явления приводят к замедлению времени распада. Влияние температуры на время затухания ФЛ было изучено и показывает наличие двух различных режимов, представленных на рис. 8б [24]. Отметим, что время затухания, связанное с более низкой энергией полосы ФЛ (LQD (1,06 эВ)), почти постоянно (1000 пс) до 140 K, а затем оно уменьшается с увеличением температуры.

а Время затухания пика LQD в зависимости от температуры образца для длины волны возбуждения 514 нм. б Типичная зависимость интенсивности затухания фотолюминесценции от температуры пика LQD, измеренная при длине волны возбуждения 514 нм
Теоретический подход
Чтобы понять аномальную температурную зависимость ФЛ, было исследовано положение пика ФЛ с использованием модели LSE, разработанной Ли и др. [25, 26]. Действительно, эта количественная модель удовлетворительно объясняет аномальные спектральные особенности люминесценции локализованного состояния, ранее наблюдавшиеся в нескольких материалах AIIIBV, таких как сплавы B (In) GaAs / GaAs [27, 28] на основе бора и InGaAs / GaAs. MQW [29, 30]. Модель предполагала, что локализованное состояние имеет распределение энергии гауссова типа для плотности состояний, заданной следующим образом:
$$ \ rho (E) ={\ rho} _o {e} ^ {- {\ left (\ frac {E- {E} _ {\ mathrm {ch}}} {2 {\ sigma} ^ 2} \ справа)} ^ 2} $$ (1)Где σ и E ч - параметр уширения для распределения локализованных состояний (глубина локализации) и уровень барьера, который носители должны преодолеть для перехода, соответственно. В квазистационарном режиме динамика локализованных экситонов может быть описана следующими скоростными уравнениями:
$$ \ frac {dN \ left (E, T \ right)} {dt} =G (E) + \ frac {\ gamma_c N \ hbox {'} \ left (E, T \ right) \ rho (E) } {\ Lambda} - \ frac {N \ left (E, T \ right)} {\ tau _ {\ mathrm {tr}}} {e} ^ {\ frac {E- {E} _a} {K_B T} } - \ frac {N \ left (E, T \ right)} {\ tau _ {\ mathrm {r}}} =0 $$ (2)Параметры τ r , τ tr , γ c , К B , Λ и N 'представляют собой, соответственно, время рекомбинации носителей (радиационное время жизни), время передачи носителей (безызлучательное время жизни), коэффициент повторного захвата, постоянную Больцмана, общее количество локализованных состояний и общее количество носителей, которые термически активируются вдали от локализованные состояния. G ( E ) представляет собой скорость генерации несущей. Количество \ (\ frac {\ gamma_c N \ hbox {'} \ left (E, T \ right) \ rho (E)} {\ Lambda} \) - это количество носителей, повторно захваченных локализованными состояниями на единицу время. Третий член справа дает скорость теплового выхода локализованных носителей. Последний представляет собой скорость удаления носителей из-за излучательной рекомбинации. Плотность населения локализованных носителей пропорциональна функции распределения и плотности состояний локализованных носителей. Фактически, решение уравнения. (2) можно описать уравнением. (3).
$$ N \ left (E, T \ right) =\ frac {\ rho_o {e} ^ {- {\ left (\ frac {E- {E} _0} {2 {\ sigma} ^ 2} \ right) } ^ 2}} {\ left [\ frac {\ tau _ {\ mathrm {tr}}} {\ tau _ {\ mathrm {r}}} + exp \ left (\ frac {\ left (E- {E} _ {\ mathrm {ch}} \ right)} {K _ {\ mathrm {B}} T} \ right) \ right]} $$ (3)где E 0 это центральная энергия. Математически температурная зависимость положения пика из-за теплового перераспределения носителей заряда в локализованных состояниях, определяемая из \ (\ frac {\ partial N \ left (E, T \ right)} {\ partial t} =0 \), определяется выражением :
$$ E (T) ={E} _0- x (T) {K} _B T $$ (4)Где x ( Т ) является численным решением нелинейного уравнения. (5):
$$ x {e} ^ x =\ left [{\ left (\ frac {\ sigma} {K_b T} \ right)} ^ 2- x \ right] \ left (\ frac {\ tau _ {\ mathrm {r }}} {\ tau _ {\ mathrm {tr}}} \ right) exp \ left [\ frac {\ left ({E} _0- {E} _ {\ mathrm {ch}} \ right)} {K_ { \ mathrm {B}} T} \ right] $$ (5)
Уравнение 5 имеет только одно решение для \ (0
Известно, что ширина запрещенной зоны идеализированного полупроводникового материала обычно описывается эмпирической формулой Пасслера [32]. С учетом поправки, обусловленной коэффициентом теплового перераспределения, изменение положения пика люминесценции с использованием модели LSE, описываемой уравнением. (7):
где θ - характеристический температурный параметр, который должен был быть сопоставим с температурой Дебая θ D . Для T >> θ , мы видим, что α представляет собой просто предел величины первой производной, \ ({\ frac {dEg (T)} {dT}} _ {T \ to \ infty} \). Показатель «p» связан с формой лежащей в основе электрон-фононной спектральной функции [33]. Модель хорошо согласуется с экспериментальной эволюцией, что подтверждается рис. 9. Подгоночные параметры приведены в таблице 2.
Температурно-зависимая эволюция фотолюминесценции пика LQD ( сплошные черные квадраты ), подобранный с использованием эмпирического закона Паслера ( синяя сплошная линия ) и модифицированной истинности отношения Пасслера к модели LSE ( красная сплошная линия )
Энергия пика ФЛ сильно зависит от теплового перераспределения, представленного на рис. 10. Последнее указывает на быстрое увеличение диапазона криогенных температур. Максимум теплового перераспределения соответствует максимуму красного смещения в эволюции энергии (~ 50–100 K). В области высоких температур ФЛ тепловое перераспределение экспоненциально уменьшается и имеет тенденцию к аннулированию, так как начиная со 150 K начинается процесс делокализации и возврат к межзонным переходам. Также мы можем наблюдать это, когда классическая и модифицированная кривые накладываются друг на друга (рис. 9). Показатель «p» указывает на то, что вклад продольных акустических (LA) фононов более значительный, чем вклад продольных оптических (LO ) фононы. Этот вклад оказывается доминирующим в области высоких температур ФЛ, где излучение поддерживается фононами. Процесс бимодального распределения открывает канал связи между квантовыми точками, который представлен делокализованными состояниями электрона и дырки, разделенными энергией E ch . Происхождение этого канала связи до сих пор остается предметом споров [34,35,36]. Однако канал связи можно рассматривать как промежуточные состояния, существующие между двумерным WL и нульмерными состояниями КТ [37]. Таким образом, можно представить, что носители в состояниях квантовых точек легче термически возбуждать в канале связи, чем WL, из-за меньшей необходимой энергии активации, а затем передаваться соседним квантовым точкам на конечном расстоянии. Это похоже на уровень Ферми-Дирака в распределении Ферми-Дирака. Эта энергия E ch меньше энергии активации E а извлеченный из диаграммы Аррениуса (рис. 11). Причина, по которой E а больше может быть объяснено тем фактом, что носителям требуется большая энергия для достижения смачивающего слоя (WL), как схематично показано на рис. 12. Кроме того, величина разности Δ E = E ch - E 0 играет более значительную роль в определении аномальной температурной зависимости люминесценции локализованных носителей. Следует отметить, что в двух случаях, E ch - E 0 > 0 и E ch - E 0 <0, существуют с физической точки зрения, но обычно ее принимают как «положительную» энергию тепловой активации. В нашем случае это означает, что E ch на 4 мэВ ниже E 0 в котором локализованные носители термически активируются в состояния (или узлы в реальном пространстве) с более высокими энергиями. Он уменьшается по сравнению с одним слоем квантовых точек InAs с In 0,15 Ga 0,85 Как уменьшение деформации подстилающего слоя [10]. Глубина потенциального колебания, присвоенная σ является результатом неоднородности распределения КТ по размерам. Потенциальная глубина составляет 19 мэВ. Уменьшается за счет увеличения количества стопок InAs / In 0.11 Ga 0,89 КТ As / GaAs. В результате мы можем сделать вывод, что уменьшение потенциальной глубины увеличивает эффективность структуры по сравнению с одним слоем квантовых точек InAs / InGaAs / GaAs, исследованным Илахи и др. и Helmi et al. [10, 36].
Температурно-зависимое тепловое перераспределение определено численно. Характерные температуры ( T loc / deloc и T escape ) указаны относительно процесса локализации-делокализации
Аррениусовская подгонка исследуемого образца. Нормализованная интегральная интенсивность ( черные кружки ) соответствует трем энергиям активации ( красная сплошная линия )
Схема распределения локализованных электронно-дырочных (экситонных) состояний в КТ ( WL смачивающий слой, CH канал передачи данных) 

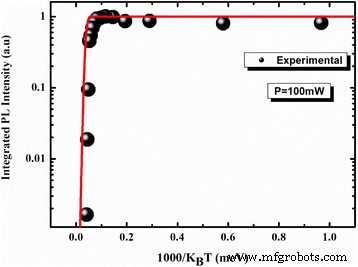
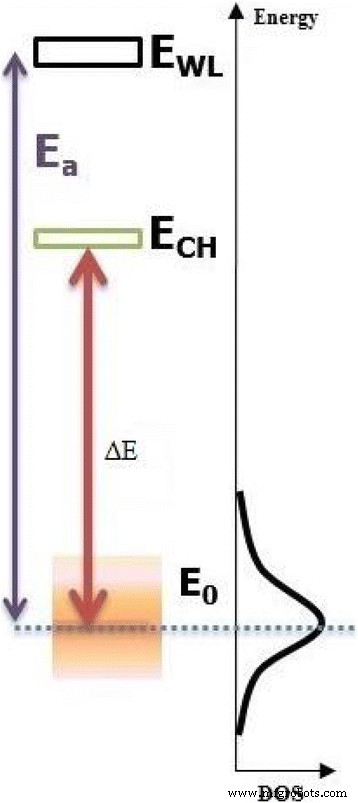
Заключение
В заключение, мы успешно изготовили СЭ на основе GaAs с многослойными квантовыми точками InAs путем перекрытия слоя InGaAs на квантовых точках и вставки разделительных слоев GaAs. Две основные спектральные особенности, наблюдаемые в спектрах диэлектрической проницаемости гетероструктуры InAs / InGaAs / GaAs с квантовыми точками при 3 и 4,5 эВ, приписываются E 1 и E 2 CP-структуры GaAs и InAs соответственно. Спектр ФЛ квантовых точек InAs в матрице GaAs интенсивный и имеет асимметричную форму, что свидетельствует о росте качественной многослойной структуры квантовых точек InAs. Также продемонстрирован вклад в спектр ФЛ квантовых точек большего и относительно меньшего размера. Измерения люминесценции были успешно смоделированы и переинтерпретированы с использованием разработанной модели LSE. Теоретическое исследование дало количественную интерпретацию наблюдаемых температурно-зависимых спектров и пролило свет на сложные механизмы спонтанного излучения в многослойных квантовых точках InAs / InGaAs / GaAs на основе подгоночных параметров. Это исследование предлагает способ повышения эффективности структур InAs / GaAs с квантовыми точками для их использования в фотоэлектрических приложениях. Эти результаты помогают лучше понять температурно-зависимую динамику носителей заряда в квантовых точках деформационного моделирования, чтобы повысить эффективность исследуемой структуры. В дополнение к этой работе мы будем изучать влияние ориентации, а также увеличение количества квантовых точек InAs / GaAs в многослойной структуре на глубину локализации.
Наноматериалы
- Использование углов для улучшения будущего электроники
- Обнаружение магнетизма ядра одиночного атома
- Пластиковые компоненты:на пути к повышению эффективности в автомобилестроении
- Яркий однофотонный источник на 1,3 мкм на основе двухслойной квантовой точки InAs в Micropillar
- Биполярные эффекты в фотоэдс метаморфных квантовых точечных гетероструктур InAs / InGaAs / GaAs:характеристика и кон…
- Обратимый электрохимический контроль фотовозбужденной люминесценции пленки CdSe / ZnS с квантовыми точками ядр…
- Фотоэлектрические характеристики солнечного элемента с гибридной матрицей на основе нанопроводов и квантов…
- Устранение бимодального размера в квантовых точках InAs / GaAs для изготовления лазеров на квантовых точках 1,3 мк…
- Глобальное потепление снизит эффективность солнечных батарей
- 5-осевое фрезерование с ЧПУ — путь к более эффективной обработке



