Резистивная память ZrO2 / ZrO2 - x / ZrO2 без соблюдения нормативных требований с управляемым межфазным режимом переключения между несколькими состояниями
Аннотация
Управляемое преобразование из межфазного режима в нитевидное переключение представлено на ZrO 2 / ZrO 2 - x / ZrO 2 трехслойная резистивная память. Два режима переключения исследуются с предложением возможных механизмов переключения и преобразования. Модуляция сопротивления ZrO 2 - x Предполагается, что слой отвечает за переключение межфазного режима переключения посредством впрыска / втягивания ионов кислорода. Переключение не требует согласования из-за внутреннего последовательного резистора нити, сформированной в ZrO 2 слои. Настроив СБРОС напряжения, управляемой и стабильной многопозиционной памяти, что ясно указывает на возможность разработки многопозиционной высокопроизводительной памяти следующего поколения.
Фон
Разработка более плотной, быстрой и менее энергоемкой энергонезависимой памяти имеет большое значение для инноваций в современных информационных технологиях [1, 2]. Хотя появилось много претендентов на звание запоминающего устройства следующего поколения, резистивная оперативная память (RRAM) на основе оксидов металлов является одним из наиболее многообещающих кандидатов благодаря своим преимуществам высокой скорости, высокой масштабируемости, низкому энергопотреблению и хорошей совместимости с CMOS процесс [3]. Хотя подробный механизм переключения резистивной памяти остается неясным, широко признано, что миграция кислородных вакансий под действием приложенного электрического поля играет ключевую роль в переключении [4]. В зависимости от механизма переключения резистивное переключение можно разделить на нитевидные и межфазные (однородные) режимы. Нитевой режим достигается за счет образования и разрыва кислородных вакансионных нитей между двумя электродами. С другой стороны, переключение сопротивления в межфазном режиме контролируется распределением кислородных вакансий вдоль границы раздела. Ток локализуется в проводящих нитях (нитях) в нитевидном режиме, а в межфазном режиме равномерно распределяется по площади устройства [5, 6]. Режим резистивной коммутации, характерный для запоминающего устройства, сильно зависит от его структуры. В целом проявление межфазной моды в системе на основе оксида металла основывается на существовании профиля градиента кислорода вдоль вертикальной оси [7, 8]. Недавно также сообщалось о сосуществовании обоих режимов в одной материальной системе [9,10,11]. Путем модуляции параметров измерения также может быть достигнуто преобразование между этими двумя режимами [12]. Однако переключение межфазного режима обычно связывают с изменением высоты барьера Шоттки, вызванным процессами накопления и истощения носителей через дефектные состояния на границе электрод / функциональный слой [7, 9,10,11,12,13, 14,15,16,17,18], а не эффект миграции кислородных вакансий на границах раздела оксид / оксид.
За последние несколько лет был достигнут огромный прогресс в увеличении плотности хранения RRAM. Помимо усилий по уменьшению физических размеров ячейки памяти, стало возможным использование состояний промежуточного сопротивления (IRS) между состоянием с высоким сопротивлением (HRS) и состоянием с низким сопротивлением (LRS) для реализации многоуровневого хранения в одной ячейке памяти. популярное альтернативное решение [19, 20]. Такое многоуровневое поведение памяти важно для запоминающих устройств с высокой плотностью и электронных синаптических устройств на основе оксидов [21,22,23]. Многоступенчатое хранение в режиме нитевидного переключения реализуется путем управления шириной и / или количеством проводящих нитей с различными параметрами RESET . напряжения или SET текущие соответствия. Различные оксиды металлов, включая TiO x , ZnO, SiO x и HfO 2 , продемонстрировали мультисостояния в устройствах RRAM [24,25,26,27]. Также сообщалось о многоуровневом хранении в режиме межфазного переключения, где было предложено регулировать ширину дефектных по кислороду областей, чтобы быть ответственными за это поведение [12, 28]. Однако для обоих режимов переключения требуется соответствие тока в SET процесс для защиты устройства от поломки и, в случае нити переключения, для достижения многократно более низкого сопротивления. Эти требования могут привести к сложности проектирования схем RRAM. Следовательно, резистивная память без соблюдения нормативных требований с управляемым режимом переключения с несколькими состояниями может быть выгодна, поскольку она минимизирует выбросы тока во время переключения и может значительно снизить стоимость изготовления [29, 30].
В последнее время использование ZrO 2 поскольку активный переключающий слой привлек внимание своей высокой термодинамической стабильностью, простым составом и совместимостью с полупроводниковыми процессами [31,32,33]. Кроме того, вставка инопланетного слоя в ZrO 2 Было доказано, что пленка для создания оксидной гетероструктуры является эффективным методом улучшения характеристик переключения в ZrO 2 устройства на основе [34, 35]. В этой работе мы демонстрируем ZrO 2 / ZrO 2 - x / ZrO 2 на основе резистивной памяти, в которой нестехиометрический ZrO 2 - x слой образуется внутри ZrO 2 слой, вставив слой Zr. Наблюдаются как межфазный, так и нитевидный режимы, и может быть реализовано контролируемое преобразование из межфазного в нитевидный. Исследуются характеристики переключения и производительность для обоих режимов. В то время как граница раздела оксид / электрод влияет на поведение переключения в нитевидном режиме, переключение в межфазном режиме сильно зависит от границ раздела оксид / оксид в трехслойных структурах. Что наиболее важно, резистивное переключение в межфазном режиме обладает встроенным свойством отсутствия соответствия, а также многоуровневым поведением хранилища при различных RESET напряжения.
Методы
ZrO 2 Тонкие пленки получали методом среднечастотного плазменного магнетронного распыления (Leybold Optics HELIOS Pro XL) при комнатной температуре. В этом процессе подложка вращалась со скоростью 180 об / мин для обеспечения равномерного осаждения. Во время каждого вращения сначала наносился тонкий слой Zr из металлических мишеней Zr (чистота 99,99%) с использованием мощности 2000 Вт в атмосфере Ar. Эта тонкая пленка была преобразована в оксидный слой, пропуская подложку под O 2 плазма источника ВЧ. О 2 скорость потока можно регулировать для получения ZrO x фильмы с разным составом. Композиционные свойства осажденных пленок были исследованы с помощью энергодисперсионного рентгеновского излучения (EDX) с использованием микроскопа Zeiss EVO LS 25, оснащенного рентгеновским детектором Oxford INCA. Пленки большой толщины 1 мкм наносились непосредственно на пластины Si, чтобы минимизировать влияние подложки. Картины дифракции рентгеновских лучей (XRD) были получены при скользящем падении ( θ =1 °) с помощью дифрактометра Rigaku Smartlab с Cu – K α мощностью 9 кВт источник. Данные рентгеновской фотоэлектронной спектроскопии (XPS) были получены с использованием системы ThermoScientific Theta Probe System с Al – K α излучения (энергия фотона =1486,6 эВ). Профиль глубины XPS был выполнен с использованием ионной пушки Ar при напряжении пучка 3 кВ на растровой области 2 × 2 мм. Образцы для просвечивающей электронной микроскопии (ПЭМ) были приготовлены с использованием обычной механической полировки с последующим ионным измельчением до электронной прозрачности с использованием Ar + при 6 кэВ. Заключительный этап низкоэнергетического измельчения выполняли при 500 эВ. Чтобы минимизировать повреждение поверхности, структура и морфология образцов были проанализированы с использованием ТЕМ JEOL 2100, оборудованного LaB 6 и JEOL ARM200F TEM / сканирующий TEM (STEM) с пистолетом Шоттки, оба работают при 200 кВ. Измерение кольцевого темного поля (ADF) STEM было выполнено в ARM200F, с датчиками и корректорами аберраций изображения CEOS. Изображения ADF-STEM были получены с использованием детектора кольцевого поля JEOL с током зонда приблизительно 23 пА, полууглом схождения ~ 25 мрад и внутренним углом 45-50 мрад. Oxford Instruments X-Max N Безоконный кремниевый дрейфовый детектор (SSD) 100TLE использовался для выполнения анализа STEM-EDX.
Поведение резистивного переключения трехслойного ZrO 2 / ZrO 2 - x / ZrO 2 фильм исследовался как память. Пленка TiN толщиной 200 нм была напылена реактивным способом (мишень Ti в N 2 атмосферу) на SiO 2 слой для формирования нижнего электрода. Затем последовало реактивное распыление второго SiO 2 слой (цель Si в O 2 атмосфера). Этот слой SiO 2 был сформирован узор для формирования активных областей устройства с помощью фотолитографии и реактивного ионного травления. Впоследствии ZrO 2 / ZrO 2 - x / ZrO 2 Были нанесены три слоя (20 нм / 5 нм / 20 нм), чтобы сформировать переключающий слой. Трехслойная структура была получена путем остановки кислородной плазмы во время ZrO 2 рост. ZrO 2 слой достигается под O 2 расход 20 куб. см, в то время как ZrO 2 - x слой получается отключением O 2 поток за 20 с. Идентичный ZrO 2 / ZrO 2 - x / ZrO 2 Трехслойный слой был также нанесен на подложку Si для определения характеристик XRD и XPS. Наконец, был напылен слой TiN толщиной 200 нм и нанесен узор на трехслойный слой, чтобы сформировать верхний электрод. Все электрические измерения проводились с помощью системы определения характеристик полупроводников Keithley 4200. Во время измерений на верхний электрод подавалось программирующее напряжение смещения, а нижний электрод оставался заземленным. Контакт зонда / точки с верхним и нижним электродами устройств был реализован через пару игл зонда Wentworth с использованием полуавтоматического зонда Wentworth Laboratories AVT 702. Измерения развертки постоянного напряжения проводились с постоянной скоростью 0,5 В / с.
Результаты и обсуждение
Свойства трехслойной структуры впервые были исследованы методом XRD. На рисунке 1 изображена рентгенограмма трех слоев после осаждения (красный цвет), на которой присутствуют два пика, расположенные под 28,2 ° и 29,8 °. Эти два пика можно отнести к пику −111 моноклинного ZrO 2 фаза и пик 101 от тетрагонального ZrO 2 фаза соответственно, что свидетельствует о наличии двух фаз. EDX- и XRD-характеристики, проведенные на одиночном ZrO x слои с разным составом (показаны в дополнительном файле 1:рис. S1 и S2) показывают, что стехиометрический ZrO 2 отображает моноклинную фазу (синий), в то время как тетрагональная фаза (зеленый) была обнаружена из дефицитного по кислороду ZrO 2 - x слой. Пики XRD металлического Zr (розового цвета) не наблюдались на трехслойной рентгенограмме. Это предполагает сосуществование стехиометрического ZrO 2 и кислородно-дефицитный ZrO 2 - x слой в трехслойной структуре и внедренный слой Zr был окислен.
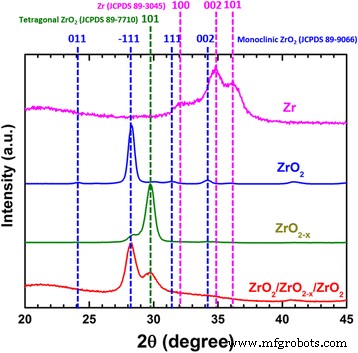
Рентгенограммы осажденного ZrO 2 / ZrO 2 - x / ZrO 2 трехслойная структура ( красный ), кислородно-дефицитный ZrO 2- x слой ( зеленый ), стехиометрический ZrO 2 слой ( синий ) и слой чистого металлического Zr ( розовый )
На рис. 2а, б представлены результаты РФЭС профилей пиков Zr 3d и O 1s при времени травления 800 с. Два пика, расположенные на уровне прибл. 182,3 и 184,5 эВ можно отнести к полностью окисленному Zr 4+ состояние [36, 37], которые доминируют в спектрах Zr вплоть до времени травления ок. 300 с. Явно усиленная интенсивность двух пиков, расположенных на уровне прибл. 178,3 и 180,5 эВ могут впоследствии наблюдаться между временем травления от 300 до 400 с; это также сопровождается уменьшением O 2− пиковая интенсивность прибл. 530.0 эВ. Было высказано предположение, что эти два пика Zr 3d связаны с металлическим или неокисленным Zr 0 состояние [36]. Это указывает на дефицит кислорода ZrO 2 - x слой лежит в середине этой трехслойной структуры. После 400 секунд травления Zr 4+ пики возобновляют свое доминирование, и интенсивность O 2− пик вернулся в норму. Концентрация атомов вдоль профиля глубины на рис. 2c дополнительно подтверждает окисление внедренного слоя Zr в нестехиометрический ZrO 2 - x . Также стоит отметить, что градиенты состава между ZrO 2 и ZrO 2 - x также наблюдались интерфейсы, которые, как предполагается, способствуют формированию поведения межфазного переключения [8]. Принимая во внимание результаты как XRD, так и XPS, разумно полагать, что моноклинная фаза, обнаруженная в XRD, происходит от двух стехиометрических ZrO 2 слои. Заполненный кислородно-дефицитный ZrO 2 - x слой, с другой стороны, способствует тетрагональной фазе, хотя нельзя исключать наличие некоторых следов аморфных областей.
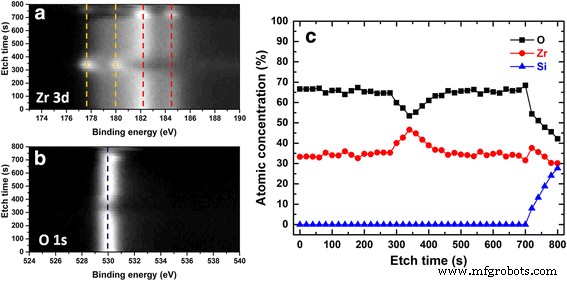
XPS-спектры a Zr 3d и b O 1s для ZrO 2 / ZrO 2 - x / ZrO 2 трехслойная структура при времени травления 700 с. c Профиль глубины XPS ZrO 2 / ZrO 2 - x / ZrO 2 трехслойная структура
Измерение ПЭМ дополнительно подтверждает трехслойную структуру с дефицитом кислорода ZrO 2 - x отчетливо наблюдается слой, как показано на рис. 3а. Кроме того, еще один межфазный слой между ZrO 2 также виден слой и нижний электрод из TiN. Соответствующий профиль EDX показан на рис. 3b, на котором взаимная диффузия атомов Ti, O, N и Zr очевидна в первых 10 нм. Более того, гораздо более высокое отношение O:Zr (незакрашенный квадрат) в первых 5 нм подтверждает существование TiO x N y межфазный слой между ZrO 2 и нижний электрод из TiN. Действительно, поскольку ZrO 2 распыляется сразу после TiN, O 2 плазма реагирует с поверхностью TiN с образованием TiO x N y слой, когда ZrO 2 слой все еще очень тонкий. Подобное образование межфазного TiO x N y также сообщалось о слое [38, 39].
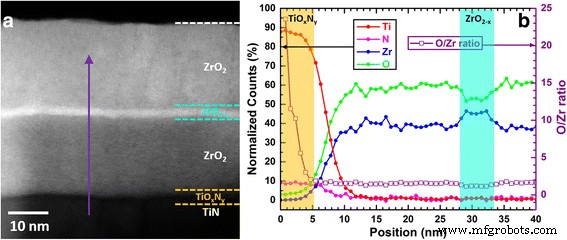
а Изображение ADF-STEM поперечного сечения образца и b Профили элементарных линий STEM-EDX для TiN / ZrO 2 / ZrO 2 - x / ZrO 2 структура
По результатам характеризации схема ZrO 2 / ZrO 2 - x / ZrO 2 Трехслойная память изображена на рис. 4а. Согласно измерениям, первоначальное устройство находится в состоянии с высоким сопротивлением, как показано на рис. 4b. Большое отрицательное формирующее напряжение ( I CC =1 мА) требуется, чтобы вызвать мягкий пробой диэлектрика и инициировать переключение. Совершенно необычно, что это связано с двухэтапным процессом формования, который предполагает последовательное образование двух нитей в двух ZrO 2 слои и устройство SET в состояние с низким сопротивлением. Затем на RESET было подано положительное напряжение. устройство в HRS, как показано на рис. 4c. Примечательно, что этот СБРОС Процесс характеризуется постепенным непрерывным уменьшением тока, типичным для межфазного резистивного переключения. НАБОР Процесс подачи отрицательного напряжения смещения также показывает аналогичное поведение, предполагая, что межфазное резистивное переключение является доминирующим режимом переключения. Поведение межфазного переключения дополнительно подтверждается областью зависимости тока как в HRS, так и в LRS (показано на рис. 4d). Оба тока увеличиваются с увеличением размера электрода, указывая на то, что токопроводимость не является нитевидной. Однако увеличение тока не полностью пропорционально площади. Это можно объяснить менее эффективной модуляцией удельного сопротивления при больших размерах ячеек во время межфазного переключения из-за большего количества границ зерен и тока утечки [12]. Об аналогичном поведении также сообщалось в других двухслойных резистивных устройствах переключения на границе раздела [8, 12]. НАБОР процесс демонстрирует самодостаточное поведение. Это выгодно для применения в резистивной памяти, поскольку минимизирует выбросы тока во время переключения и может значительно снизить стоимость изготовления [29, 30].
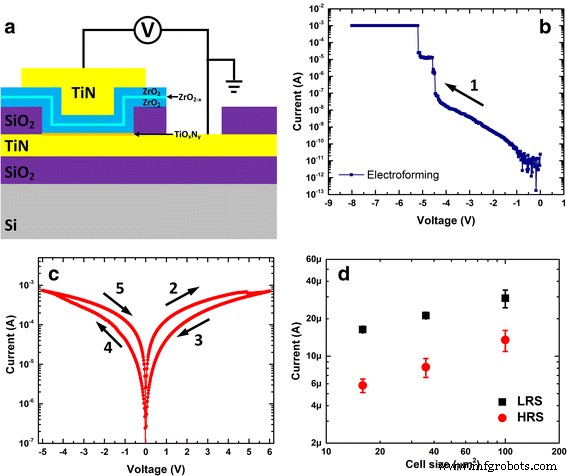
а Схема трехслойного TiN / ZrO 2 / ZrO 2 - x / ZrO 2 / TiN память. б I – V характеристики процесса гальванопластики для TiN / ZrO 2 / ZrO 2 - x / ZrO 2 / Устройство TiN. c I – V характеристики межфазного переключения после формования. г Ток как функция размера устройства для HRS / LRS в режиме межфазного переключения
Преобразование из режима межфазного переключения в режим нитевидного переключения может быть запущено вторым этапом формирования, как показано на фиг. 5a. На устройство было приложено более отрицательное смещение при HRS с током соответствия 20 мА. Это приводит к резкому увеличению тока прибл. −8 В, и устройство впоследствии остается в состоянии с гораздо более низким сопротивлением. После СБРОСА процесс с положительным смещением, режим переключения устройства полностью преобразован в нитевидный, характеризуемый резким SET (текущий элемент управления) и СБРОС переходы. На рисунке 5b показано кумулятивное распределение вероятностей LRS и HRS как для межфазного, так и для нитевидного режимов переключения, в котором можно наблюдать отличительные различия между этими двумя наборами состояний сопротивления, что указывает на то, что устройство было переключено в разных режимах. Чтобы пролить свет на механизм проводимости обоих режимов переключения, логарифмический I – V графики кривых и линейные аппроксимации SET представлены процессы. I – V кривая при HRS в межфазном режиме следует омическому поведению при низком напряжении с добавлением квадратичного члена при более высоком напряжении, т. е. I ∝ aV + bV 2 , что является типичной особенностью модели тока, ограниченного пространственным зарядом (SCLC), как показано на рис. 5c [40,41,42]. О подобных наблюдениях этого механизма SCLC сообщалось и на других устройствах межфазной резистивной памяти [8, 12]. С другой стороны, логарифмический I – V кривые SET Процесс в нитевидном переключении после преобразования показан на рис. 5г. Кривая предполагает, что ток регулируется моделью SCLC с ловушками [40,41,42]. Хотя аналогичная модель проводимости используется для объяснения межфазного и нитевидного переключения, эти две моды по-прежнему демонстрируют различные особенности, особенно в состоянии с низким сопротивлением. Токопроводимость для LRS в нитевидном режиме состоит из двух областей:омической области ( I ∝ V ) и области права ребенка ( I ∝ V 2 ), тогда как последнее не наблюдалось в LRS-проведении межфазного переключения. Это указывает на то, что нитевидное переключение опосредуется процессом захвата / удаления несущей [43]. Мы предполагаем, что в токопроводящих путях во время второго процесса формирования образуется значительное количество ловушек, что приводит к квадратичному члену тока в LRS нитевидного режима.

а Я - V характеристики процесса трансформации ( оранжевый ) от межфазного переключения ( красный ) на нитевидное переключение ( синий ). б График совокупной вероятности HRS и LRS для обоих межфазных ( V СБРОС =6 В) и нитевидные режимы переключения. НАБОР процесс I – V кривые c межфазный и d нитевидные режимы переключения на графике с двойным логарифмом
Однослойный ZrO 2 Память с толщиной пленки 40 нм также была изготовлена для сравнения со схемой, показанной на рис. 6а. Процесс гальванопластики ( I CC =1 мА) TiN / ZrO 2 Устройство / TiN имеет одну ступеньку с гораздо более высоким напряжением (рис. 6б). Впоследствии было обнаружено биполярное переключение (рис. 6c), аналогичное нитевидному режиму в трехслойном устройстве. Однако в этом однослойном устройстве режима межфазного переключения не наблюдалось. На рисунке 6d показаны логарифмические I – V кривые SET процессы для одноуровневых устройств, демонстрирующие хорошее согласие с моделью SCLC с ловушками. Это также подтверждает вывод о том, что зажатый ZrO 2 - x слой имеет решающее значение для межфазного переключения, которое происходит либо в ZrO 2 - x слой или около ZrO 2 - x / ZrO 2 интерфейс.
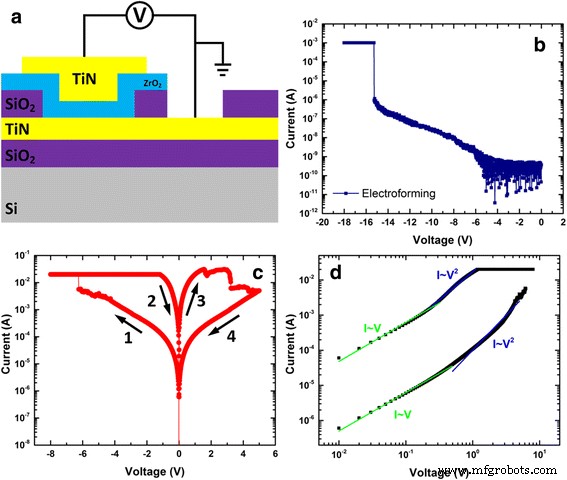
а Схема однослойного TiN / ZrO 2 / Устройство TiN. б I – V характеристики процесса гальванопластики для TiN / ZrO 2 / Устройство TiN. c I – V характеристики TiN / ZrO 2 / Устройство TiN после формовки. г I – V кривые SET процесс в двойном логарифмическом графике с линейной аппроксимацией
На основе результатов определения характеристик предлагается подробный механизм обоих режимов переключения и преобразования, как показано на рис. 7. При приложении отрицательного формирующего напряжения ионы кислорода выталкиваются вниз к нижнему электроду, в то время как вакансии кислорода перемещаются к верхнему. электрод и образуют токопроводящую нить. Межфазный TiO x N y слой играет решающую роль в биполярном поведении, поскольку он служит резервуаром кислорода [38, 44]. Две слабые нити образуются последовательно в нижнем и верхнем ZrO 2 слоев, характеризующихся двухэтапным процессом формирования (рис. 7б, в). Хотя некоторые ионы кислорода могли быть введены в середину ZrO 2 - x Уровень кислородных вакансий все еще достаточно высок, чтобы поддерживать слой в низкоомном состоянии. Следовательно, устройство переключилось на LRS (рис. 7c). При приложении положительного смещения ионы кислорода притягиваются к TiO x N y слой к ZrO 2 - x слой, в результате чего образуется богатый кислородом слой. Эта стехиометрическая модуляция ZrO 2 - x слой меняет память на HRS (рис. 7d). Еще одно отрицательное смещение требуется для SET устройство в LRS, выталкивая ионы кислорода из среднего слоя обратно в TiO x N y резервуар (рис. 7д). Отсутствие податливости устройства может происходить из-за низкой проводимости двух нитей накала, которые эффективно служат в качестве внутренних последовательных резисторов. Преобразование происходит при приложении очень большого смещения, которое вызывает образование гораздо более прочной и проводящей нити через всю трехслойную структуру (рис. 7f). Сопротивление устройства больше не зависит от ZrO 2 - x слой, а режим переключения трансформируется с межфазного в нитевидный. Затем устройство можно включить и ВЫКЛЮЧИТЬ . с использованием положительного и отрицательного смещения соответственно (рис. 7g, h).
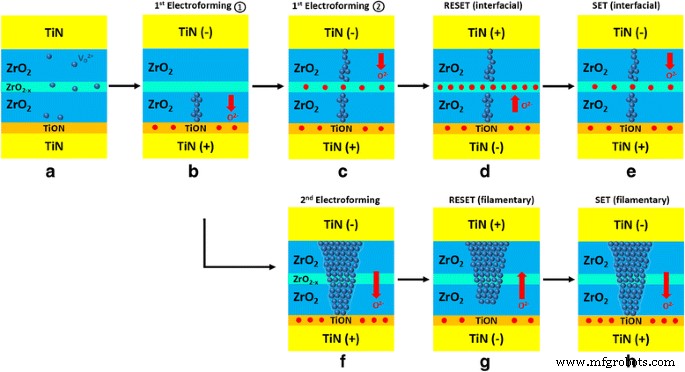
Схема механизма переключения на трехслойном TiN / ZrO 2 / ZrO 2 - x / ZrO 2 / TiN устройство для межфазного режима переключения ( a - е ). Преобразование из межфазного режима в нитевидный режим ( f ) и нитевидная мода ( g , ч )
Режим межфазной коммутации в этой работе предлагает потенциал для многоуровневого хранения. Поскольку сопротивление устройства в межфазном режиме определяется уровнем ионов кислорода в ZrO 2 - x слоя, состояния многократного сопротивления могут быть достигнуты путем управления количеством ионов кислорода в среднем слое с помощью различных RESET напряжения. На рисунке 8a показан I – V характеристики устройства с RESET напряжения 5,0, 5,5 и 6,0 В при постоянной SET напряжение −5 В. Следует отметить, что, поскольку миграция кислородных вакансий осуществляется под действием электрического поля, эти параметры масштабируются с толщиной слоя. Имея толстый функциональный слой около 50 нм, эта представленная работа все еще имеет хороший потенциал для уменьшения масштаба и значительного уменьшения как SET и СБРОС напряжения. На рисунке 8b показаны циклические характеристики этой многопозиционной операции с памятью, где обратимое и воспроизводимое свойство резистивной коммутации продемонстрировано примерно в течение примерно 30 минут. 100 циклов, что указывает на многообещающую долговечность этого устройства.
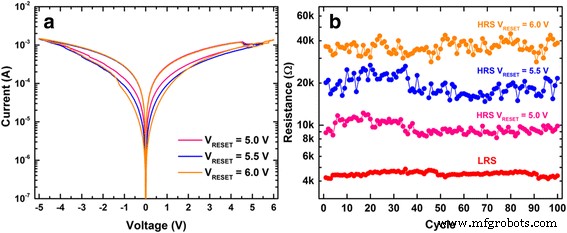
а I – V характеристики межфазного переключения для трехслойного TiN / ZrO 2 / ZrO 2 - x / ZrO 2 / TiN устройство с изменяющимся параметром RESET напряжения. б Испытание на выносливость 100 циклов на межфазное переключение с разными RESET напряжения
Выводы
В ZrO 2 наблюдалась контролируемая трансформация межфазного режима в межфазный режим нитевидного типа. / ZrO 2 - x / ZrO 2 трехслойная память. Предлагается возможный механизм переключения и трансформации. Встроенный ZrO 2 - x слой считается решающим слоем для межфазного режима переключения. Этот режим демонстрирует поведение без податливости, возможно, из-за внутреннего последовательного резистора, образованного двумя тонкими нитями, образованными в ZrO 2 слои. Управляя СБРОС напряжения, многоступенчатые сопротивления в HRS могут быть достигнуты. Такое поведение многоуровневого хранилища явно указывает на возможность разработки многоступенчатой высокопроизводительной памяти следующего поколения.
Сокращения
- ADF-STEM:
-
Сканирующая просвечивающая электронная микроскопия в кольцевом темном поле
- EDX:
-
Энергодисперсионная рентгеновская спектроскопия
- HRS:
-
Состояние высокого сопротивления
- IRS:
-
Состояние промежуточного сопротивления
- LRS:
-
Состояние низкого сопротивления
- RRAM:
-
Резистивная память с произвольным доступом
- SCLC:
-
Ограниченный ток пространственного заряда
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- XRD:
-
Рентгеновская дифракция
Наноматериалы
- Интегрированная RRAM 4T SRAM с самоторможением резистивной коммутационной нагрузки с помощью логического процес…
- Коллективное исследование моделирования и имитации резистивной оперативной памяти
- Преобразователь поляризации с управляемым двулучепреломлением на основе гибридной метаповерхности полност…
- Эффект сегнетоэлектрического поля, индуцированный асимметричным резистивным переключением, в эпитаксиальн…
- Исследование изменчивости контактной резистивной оперативной памяти с помощью стохастической модели вакан…
- Изготовление схем оптической коммутации из структурных цветных микроволокон
- Двойные функции устройства V / SiOx / AlOy / p ++ Si в качестве селектора и памяти
- Исследование энергетической полосы на гетеропереходах дисульфида молибдена и ZrO2
- Повышение диэлектрической проницаемости MIM-конденсаторов Al2O3 / ZrO2 / Al2O3 с атомным слоем за счет микроволнового…
- Высокомобильные Ge pMOSFET с диэлектриком ZrO2:последствия отжига после отжига



