Модель удержания TaO / HfO x и TaO / AlO x RRAM с характеристиками самовосстанавливающегося переключателя
Аннотация
Модель удерживающего поведения для самовосстановления TaO / HfO x - и TaO / AlO x предложена резистивная оперативная память (RRAM). RRAM захватывающего типа может иметь состояние с высоким сопротивлением (HRS) и состояние с низким сопротивлением (LRS); ухудшение в LRS обычно более серьезное, чем в HRS, потому что LRS во время процесса SET ограничивается слоем внутреннего резистора. Однако если TaO / AlO x элементы уложены слоями, удерживание LRS может быть улучшено. Время удерживания LRS, оцененное методом экстраполяции, составляет более 5 лет при комнатной температуре. Оба TaO / HfO x - и TaO / AlO x Структуры на основе RRAM имеют один и тот же закрывающий слой из TaO, а уровни энергии активации обоих типов структур составляют 0,38 эВ. Кроме того, дополнительный AlO x переключающий слой TaO / AlO x структура создает более высокий диффузионный барьер O, который может значительно улучшить удерживание, а TaO / AlO x структура также показывает довольно стабильную LRS в условиях смещения.
Фон
Поскольку технология флэш-памяти NAND сталкивается с ограничением масштабирования, конструкции с вертикальной резистивной памятью с произвольным доступом (VRRAM) с малым количеством пленок, высокой производительностью и отсутствием проблем перекрестной связи являются многообещающими кандидатами для приложений с памятью высокой плотности [1,2,3 ]. Архитектура 1TnR с трехмерной (3D) вертикальной структурой помогает реализовать сверхнизкую битовую стоимость для очень компактных плотных массивов [4,5,6]. Несколько исследователей предложили использовать RRAM при низких уровнях тока, изменив механизм переключения сопротивления с нитевидного типа на модель проводящего пути с захватом дефектов, модуляцией вакансий или интерфейсом [7,8,9]. Однако вопросы, лежащие в основе нарушений удержания и миграции кислородных вакансий, все еще остаются нерешенными [3, 10]. В некоторых исследованиях удерживания нитевидного типа было предложено множество различных моделей для объяснения потерь удерживания [11,12,13]. Изменение механизма переключения также указывает на другое направление, которое может улучшить удержание [11]. Наши предыдущие исследования показали, что TaO / HfO x устройства могут показывать благоприятные значения нелинейности около 40, значения выносливости, превышающие 1000 циклов, и сохранение данных при температуре 85 ° C [6, 7]. Тем не менее, добиться стабильного удержания на таком низком уровне операционного тока по-прежнему сложно. В этом письме предлагается модель удержания для реализации удерживающих потерь в двух различных устройствах с улавливанием дефектов с помощью метода Аррениуса. Извлеченная энергия активации неубедительно объясняет улучшение удерживания за счет AlO x слой. Несмотря на то, что оригинал был неоднозначным, наиболее вероятная интерпретация состоит в том, что плотное соединение способствует удержанию.
Методы
При изготовлении TaO / HfO x и TaO / AlO x В устройствах для настоящего исследования нижний электрод (BE) состоит из металлического TiN, нанесенного методом физического осаждения из паровой фазы (PVD) на 8-дюйм. термический оксид / Si подложки. На каждый BE был нанесен узор и травление с помощью обычного процесса литографии и травления. После того, как каждый TiN BE был протравлен газом на основе хлора, оставшийся фоторезист (PR) и остатки травления были удалены с помощью удаленной плазменной системы, на которую наносился O 2 и H 2 O при 180 ° C. В процессе удаления PR на поверхности каждого TiN BE образовывался тонкий окислительный слой TiON. Затем резистивные переключающие слои HfO x и AlO x были получены методом атомно-слоистого осаждения (ALD) с HfCl 4 -H 2 O и TMA-H 2 O предшественники соответственно. Два резистивных элемента HfO x и AlO x осаждались при 300 и 250 ° C. Затем поверх резистивных переключающих слоев был нанесен слой TaO с помощью PVD методом низкотемпературного плазменного окисления (LTPO) [14]. При таком производстве металлический Ta осаждается со сверхнизкой скоростью (0,2 Å / с). Стабильное плазменное окисление проводили смесью Ar и O 2 . газы. Этот слой TaO служил внутренним сопротивлением самодостаточности, которое было относительно негерметичным по сравнению с предыдущими резистивными переключающими пленками [7]. Верхний электрод также был изготовлен из PVD-TiN. Виды поперечного сечения и информация о толщине TaO / HfO x и TaO / AlO x запоминающие устройства показаны на рис. 1а, б соответственно. Толщина пленки TaO / HfO x проверяли с помощью просвечивающей электронной микроскопии (не показано). После формирования рисунка ячеек низкотемпературный оксид наносили для пассивации при 250 ° C. Наконец, был применен стандартный внутренний процесс для завершения изготовления конструкций контактов и металлических площадок.

Графики схемы ячеек с информацией о толщине для a TaO / HfO x устройства и б TaO / AlO x устройств. Оба графика описывают устройства, для которых PVD наносил слои TaO с помощью процессов LTPO, а нижние межфазные слои TiON были сформированы плазменным окислением во время удаления фоторезиста
Результаты и обсуждение
Электрические измерения проводились с помощью анализатора параметров полупроводников HP4156C. Установка и сброс плотности тока ( Дж ) от напряжения ( Дж - V ) кривые TaO / HfO x и TaO / AlO x устройства показаны на рис. 2а, б соответственно. Оба начальных состояния сопротивления ( R начальный ) TaO / HfO x и TaO / AlO x аппараты были HRS. Устройства чистой памяти были запрограммированы на LRS с положительным смещением и были возвращены обратно. Затем каждая ячейка была переключена с LRS на HRS подачей отрицательного напряжения. Оба J – V графики содержат ячейки трех размеров, а именно 0,1, 0,56 и 25 мкм 2 . В J – V На графиках все кривые для устройств с разными площадями похожи друг на друга, что указывает на TaO / HfO x и TaO / AlO x устройства имели (i) одинаковую плотность тока в исходном состоянии, (ii) аналогичные напряжения установки и сброса и (iii) одинаковую плотность тока в LRS и HRS. Кроме того, свойство постоянной плотности тока ясно иллюстрируется зависимостью сопротивления от площади ( R - А ) графики на рис. 2в, г. Сильная зависимость площади как в R начальный и LRS можно наблюдать, контролируя плотность тока. Независимо от масштаба площади ячейки и тока согласования, в обоих устройствах сохраняется одинаковое соотношение сопротивления включения / выключения. Эта характеристика переключателя постоянной плотности тока подразумевает, что ячейки памяти единообразно программируются или стираются электрическим полем. Считается, что эти устройства обладают переключающими свойствами ловушечного типа, которые сильно связаны с модуляцией вакансий [8]. В случае RRAM захватного типа резких скачков тока во время установки не наблюдалось, но резкие скачки тока обычно наблюдались для RRAM нитевидного типа. В настоящем исследовании наблюдались разные коммутационные напряжения для разных коммутирующих слоев с HfO x или AlO x . Установленный диапазон напряжения TaO / AlO x напряжение устройства составляет от 4 до 4,5 В, что больше, чем у TaO / HfO x устройство (от 3 до 4 В). Диапазон напряжения сброса TaO / AlO x напряжение устройства составляет от -1,5 до -2,5 В, что больше, чем у TaO / HfO x устройство (от −0,5 до −1,5 В). AlO x система потребляет больше энергии для завершения установки и сброса переключателей, чем HfO x система потребляет. Во время установки переключателей переключение слоев HfO x и AlO x добиться мягких пробоев при напряжениях примерно 3 и 3,5 В соответственно. В обоих типах устройств до образования нитей в переключающем слое ток ограничивается внутренним сопротивлением слоя TaO. В процессе самосогласования RRAM ловушечного типа внутри коммутирующего слоя генерируются избыточные кислородные вакансии [7]. Эти кислородные вакансии рекомбинируются во время процесса сброса отрицательного смещения. В отличие от RRAM нитевидного типа, HRS всегда ниже, чем состояние начального сопротивления (IRS) после операции сброса [15,16,17]. Подводя итог, можно сказать, что захват дефектов - это процесс, который модулирует вакансии посредством рекомбинации ион-вакансия кислорода для управления изменением сопротивления в переключающем слое. По сравнению с HfO x коммутирующий слой, захват дефектов вызывает более высокое напряжение и мощность в AlO x слой во время установки и сброса переключателя.
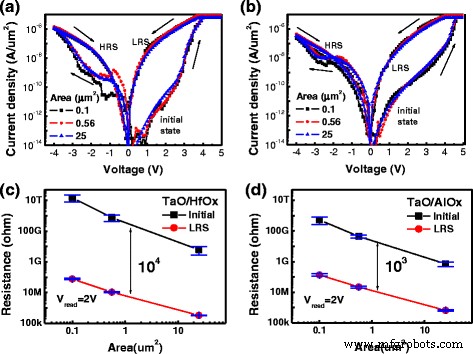
Плотность тока с графиком напряжения a TaO / HfO x устройства с разным размером ячеек. б TaO / AlO x устройства с разным размером ячеек. Сопротивление в зависимости от графика площади c a TaO / HfO x устройство и d a TaO / AlO x устройство. Оба графика содержат IRS и LRS с напряжением считывания =2 В. Каждая точка данных обеспечивает среднее значение 10 устройств и соответствующее стандартное отклонение
После того, как поведение переключения было исследовано, было исследовано поведение удерживания HRS и LRS блоков памяти захватывающего типа. Графики изменения сопротивления от времени при 85 ° C и 1 В для TaO / HfO x и TaO / AlO x устройства показаны на рис. 3а, б. На обоих графиках вариация LRS более выражена, чем вариация HRS. Стабильность сопротивления TaO / AlO x выше, чем у TaO / HfO x . Рисунки показывают, что HRS имели тенденцию смещаться в сторону IRS для обоих типов устройств; ИСО отмечены пунктирными линиями на рис. 3а, б. Тенденция возврата сопротивления к исходному состоянию устройства показана на рис. 3c для TaO / AlO x и на рис. 3d для TaO / HfO x . Чтобы реализовать это, оба типа устройств изначально были запрограммированы на LRS при комнатной температуре, как показано на I – V развертки (черная линия). Затем TaO / AlO x и TaO / HfO x устройства выпекали в печах при 150 ° C в течение 48 ч и при 120 ° C в течение 120 ч соответственно. В обоих случаях I – V развертка после запекания была аналогична начальной развертке. С помощью этой процедуры LRS устройств захватывающего типа были возвращены в исходное состояние через некоторое время в высокотемпературной среде. В отличие от устройств нитевидного типа, в которых наблюдается заметное движение атомов кислорода, устройства улавливающего типа имеют пары ионов кислорода и вакансий, разделенных небольшими расстояниями. Тенденция дрейфа сопротивления к исходному состоянию связана с его исходной кристалличностью, которая в основном контролируется температурой процесса ALD. В результате LRS в обоих типах устройств могут быть сброшены на HRS (или IRS) с помощью отрицательного смещения или тепловой энергии. Это свойство отличается от нитевидного RRAM.
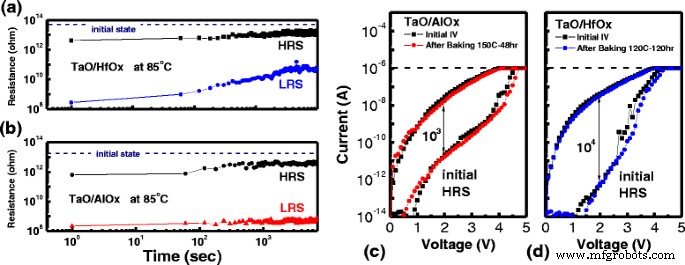
Графики изменения сопротивления в зависимости от времени для a TaO / HfO x и b TaO / AlO x устройств. Оба графика показывают изменение HRS и LRS при считывающем напряжении =1 В при 85 ° C. После I - V были установлены развертки каждого первичного устройства, устройство запекалось, а затем снова запрограммировано на LRS: c TaO / AlO x (150 ° С в течение 48 ч); г TaO / HfO x (120 ° C в течение 120 часов)
При стандартном тестировании на сохранение для энергонезависимой памяти сохранение данных проверяется как при комнатной температуре, так и при высокой температуре; устройства должны сохранять данные как при комнатной, так и при высокой температуре, чтобы их можно было использовать в реальных приложениях. Энергия активации ( E а ) извлечение методом Аррениуса на графике удерживания является распространенным методом оценки удерживания данных [18, 19]. Как видно на рис. 3а, вариация LRS более выражена, чем вариация HRS. Следовательно, коэффициент сопротивления ( R соотношение ) LRS в зависимости от времени выпекания при температурах от 30 до 150 ° C. Один пример извлечения времени удерживания из TaO / AlO x Устройство показано на рис. 4а. Скорость деградации сопротивления может быть рассчитана по наклону линейной аппроксимации в логарифме ( R соотношение ) -логарифмическая (временная) шкала. Учитывая максимальное отношение сопротивления включения / выключения примерно 10 3 для TaO / AlO x устройство, как показано на рис. 3c, время удерживания с 10 3 раз можно вычислить вариацию LRS. Расчетное сохранение данных LRS при температурах измерения от 30 до 150 ° C показано на рис. 4b. Каждая точка данных представляет информацию от более чем 18 устройств для обоих типов устройств. В TaO / AlO x устройство, срок хранения данных достигает 10 6 с при 150 ° C и 2 × 10 8 с (примерно 5 лет) при комнатной температуре; это время почти 10 1,5 раз дольше, чем у TaO / HfO x устройство. Самым интересным моментом является то, что как TaO / HfO x и TaO / AlO x устройства показывают одинаковый E а =0,38 эВ, как рассчитано из извлеченного наклона. Тот же E а означает, что оба типа устройств подвергаются сходным химическим реакциям в процессе деградации LRS. Это E а участвует во всех термически активируемых кинетических процессах, включая выделение ионов кислорода вблизи границ раздела TaO и процессы диффузии кислорода в AlO x и HfO x слои. Однако коэффициенты самодиффузии кислорода HfO x и AlO x слои разные при высоких температурах (> 1000 ° C); точные измерения можно найти в литературе [20, 21]. Коэффициент диффузии кислорода при низкой температуре (<200 ° C) также зависит от толщины HfO x диэлектрики [22]. Если процессы диффузии в переключающихся слоях доминируют над химической реакцией, то E а значения должны быть разными из-за разных коэффициентов диффузии в HfO x и AlO x слои. Оба типа устройств в этой работе демонстрируют одинаковые E а =0,38 эВ; это было связано с тем, что оба типа устройств имели один и тот же защитный слой из TaO поверх переключающих слоев. LRS-деградация - это процесс рекомбинации вакансий и ионов, что означает, что слой TaO контролирует эту химическую реакцию, и большинство вакансий скапливаются вблизи границы раздела между TaO и переключающим слоем. Эти вакансии предпочитают оставаться на интерфейсе TaO / коммутационный слой; это явление может быть подтверждено с точки зрения термодинамической стабильности, как сообщается Zhong et al. [23]. При моделировании TiN / Ta / HfO x / TiN, ионы кислорода предпочитали оставаться на Ta / HfO x интерфейс, потому что существует небольшая разница в энергии между Ta и HfO x [23]. В их моделировании, как и в настоящих экспериментах, резистивный слой TaO захватил большую часть ионов кислорода и доминировал в процессе рекомбинации вакансий. Деградация LRS схематически представлена на рис. 4c. Ионы кислорода возвращаются в предыдущее состояние теплового равновесия в процессе выпечки, что приводит к потере удерживания. Можно отметить различия между Ta / HfO x устройство, предложенное Zhong et al. и TaO / HfO x В данном исследовании используется устройство, но в обоих исследованиях слой TaO формировался в ходе нескольких циклов осаждения металла Ta и процессов LTPO [14]. Благодаря процессу LTPO богатый металлами TaO / HfO x интерфейс можно рассматривать как резервуар ионов кислорода. В процессе рекомбинации ионов кислорода и вакансий существенную роль играет плотность упаковки атомов. Превосходные удерживающие свойства LRS, полученные в AlO x переключающий слой можно объяснить высокой атомной плотностью AlO x слой. Хорошо известно, что длина связи Al – O меньше, чем у Hf – O [24, 25]. Короткая связь в AlO x снижает подвижность ионов кислорода из-за сильного кулоновского взаимодействия, что приводит к высокому диффузионному барьеру кислородных вакансий. Этот барьер увеличивает время удерживания в TaO / AlO x устройство, чем в TaO / HfO x один.
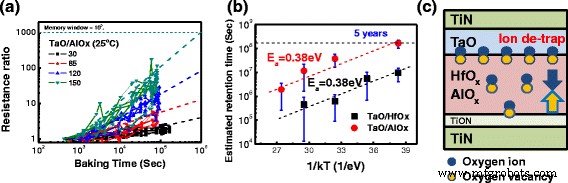
а Соотношение изменения сопротивления в зависимости от времени обжига для разных температур в TaO / AlO x устройств. Среднее начальное сопротивление составляло 179 МОм при напряжении считывания 2 В, а скорость деградации сопротивления LRS была рассчитана методом линейной аппроксимации в логарифмическом ( R соотношение ) –Log (T) масштаб. б Расчетное время удерживания (1000 ×) в зависимости от графика 1 / kT. Каждая точка содержит данные от 18 устройств, снятые при считывающем напряжении 2 В. Извлеченные энергии активации составили 0,38 эВ как для TaO / AlO x и TaO / HfO x устройств. c Схематическая диаграмма удерживания различных барьеров диффузии кислорода в HfO x или AlO x с закрывающим слоем TaO
Кроме того, модель удерживающей потери устройства нитевидного типа отличается от модели устройства улавливания дефектов. Удерживающее поведение для RRAM нитевидного типа связано с разрывом нити, а направление диффузии вакансий является латеральным [11, 19, 24]. В RRAM с захватом дефектов направление диффузии дефектов является продольным, которое параллельно внешнему электрическому полю. Следовательно, на поведение удерживания может влиять направление и величина смещения. На рис. 5a, b показано сохранение напряжения смещения за счет соотношения сопротивлений для двух устройств. Коэффициент сопротивления определяется как сопротивление стрессового устройства сопротивлению LRS. Положительное смещение может помочь поддерживать LRS, но отрицательное смещение ускоряет процесс деградации. Эти свойства смещения можно объяснить взаимодействием между локализованным полем пар ионов кислорода и вакансий и внешним электрическим полем. Если направление внешнего поля такое же, как заданное направление (положительное), это увеличивает время удерживания; если внешнее поле имеет направление сброса (отрицательное), это вызывает ухудшение характеристик. В слабом электрическом поле с ± 100 мВ ухудшение под напряжением такое же, как и без смещения в обоих типах устройств. Это смещение ± 100 мВ может быть покрыто смещениями полосы TiON-HfO x , TiON-AlO x , и переходы TiN-TaO. A TaO / AlO x устройство под высоким положительным смещением 500 мВ не обнаруживает явной деградации.
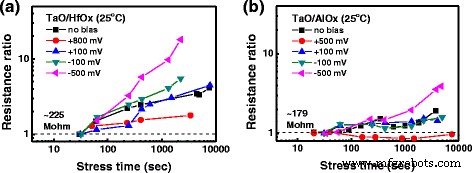
Отношение сопротивления смещению к времени нагрузки для a TaO / HfO x и b TaO / AlO x устройства при комнатной температуре
Выводы
Таким образом, мы сравнили два типа самокорректирующихся устройств RRAM по их характеристикам переключения и проанализировали их поведение при удержании. TaO / AlO x устройство показало более высокое коммутируемое напряжение и более устойчивую термическую стабильность LRS, чем TaO / HfO x устройство сделал. Преимущество надежного удержания от AlO x переключающий слой обусловлен высоким барьером диффузии кислорода, а не энергией активации. Энергия активации удерживаемых потерь связана с процессом захвата ионов в резистивном слое TaO. Высокая атомная плотность AlO x пленка может улучшить удержание LRS. Была предложена схематическая модель потери удерживания, и результаты смещенного удерживания подтвердили эту модель. Эта модель может быть полезна для разработки слаботочных, длительно сохраняемых, самовосстанавливающихся устройств RRAM для будущих приложений памяти с высокой плотностью записи.
Наноматериалы
- Характеристики и применение титана
- Схема с переключателем
- Настойчивость и настойчивость в руководстве
- switch… case в C (оператор Switch в C) с примерами
- Умный наноматериал и нанокомпозит с продвинутой агрохимической активностью
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Межфазные, электрические характеристики и характеристики совмещения полос стопок HfO2 / Ge с прослойкой SiO2, сфор…
- Оптические и электрические характеристики кремниевых нанопроволок, полученных методом химического травлен…
- Простой синтез окрашенного и проводящего композита CuSCN, покрытого наночастицами CuS
- Повышенная биосовместимость в массивах анодных TaO x нанотрубок



