Оптимизация омических контактов для p-GaAs нанопроводов
Аннотация
Характеристики омических контактов, применяемых к полупроводниковым нанопроволокам (НП), являются важным аспектом для их использования в электронных или оптоэлектронных устройствах. Из-за малых размеров и специфической ориентации поверхности ННК стандартная технология обработки, широко разработанная для плоских гетероструктур, не может быть применена напрямую. Здесь мы сообщаем о создании и оптимизации омических контактов Pt / Ti / Pt / Au для нанопроволок GaAs p-типа, выращенных методом молекулярно-лучевой эпитаксии. Приборы характеризовались вольт-амперными (ВА) измерениями. Линейность кривых ВАХ отдельных нанопроволок была оптимизирована путем корректировки расположения контактных металлических слоев, обработки поверхности перед испарением металла и термического отжига после обработки. Наши результаты показывают, что контактное сопротивление заметно уменьшается, когда слой Pt наносится на нанопроволоку GaAs до традиционной многослойной схемы Ti / Pt / Au, используемой для планарного GaAs p-типа. Эти результаты объясняются улучшенным качеством границы раздела металл-GaAs, о чем свидетельствуют измерения дифракции рентгеновских лучей при скользящем падении в аналогичных металлических тонких пленках, нанесенных на подложки GaAs (110). В частности, мы показываем, что Ti проявляет низкую степень кристалличности при нанесении на поверхность GaAs (110), что напрямую влияет на контактное сопротивление устройств NW. Осаждение тонкого слоя Pt на ННК перед нанесением Ti / Pt / Au приводит к 95% снижению общего электрического сопротивления ННК GaAs, легированного Be, что связано с более высокой степенью кристалличности Pt, чем Ti, при прямом осаждении. на GaAs (110).
Введение
Важным этапом в производстве полупроводниковых электронных и оптоэлектронных устройств является получение качественных и надежных омических контактов на границе раздела металл-полупроводник. С этой целью GaAs является важным и широко используемым материалом в технологических приложениях, таких как лазерные устройства, солнечные элементы и фотодетекторы. Поэтому изготовление омического контакта к легированным слоям GaAs p-типа и n-типа было целью большого количества исследований [1]. Вообще говоря, изготовление омических контактов с полупроводниковыми материалами включает четыре этапа:(1) удаление поверхностного естественного оксида, (2) пассивация поверхностных состояний на границе раздела полупроводник-металл, (3) нанесение металлических слоев, действующих как электрические контакты; 4) термический отжиг [2, 3]. Начиная с выбора металлов, которые обеспечивают низкое контактное сопротивление и превосходную термическую стабильность, сплавы на основе Au получили широкое распространение, особенно для GaAs p-типа в форме Au / Zn / Au [1, 3, 4] и Ti / Слои Pt / Au [1, 5]. С другой стороны, полупроводниковые нанопроволоки (ННК) AIIIBV возникли как новый класс многообещающих наноразмерных материалов для применения в качестве светодиодов [6, 7], солнечных элементов [8, 9] и фотоприемников [10], и они запустили конкретные разработки по обработке устройств.
Большинство описываемых в литературе технологий изготовления омических контактов было разработано для тонких пленок GaAs (100) и объемных структур, в то время как самокаталитический рост нанокристаллов GaAs дает ориентацию поверхности (110) на боковых стенках [11,12,13, 14,15]. Различные ориентации поверхности демонстрируют разные электронные состояния [16], которые влияют на свойства интерфейса и высоту барьера Шоттки [17,18,19]. Кроме того, ориентация поверхности может влиять на динамику кристаллизации осаждаемых металлических пленок. О хороших омических контактах с ННК p-GaAs сообщалось ранее [20,21,22,23,24,25,26,27,28] при использовании различных видов химической обработки для удаления естественного оксида, пассивации поверхности и различных металлических многослойных слоев. депонировано на NW. Затем было сообщено, что использование электрических контактов Pt / Ti / Pt / Au к тонким пленкам GaAs p-типа дает низкое сопротивление омического контакта даже при умеренных концентрациях легирующей примеси из-за малой высоты барьера Шоттки для Pt / GaAs [29]. Кроме того, было обнаружено, что Pt термически стабильна с небольшими скоростями реакции с GaAs при термообработке в диапазоне температур от 300 до 500 ° C [29,30,31]. Металлический мультислой Pt / Ti / Pt / Au является наиболее часто описываемым [20, 23, 25, 26, 28] омическим контактом с ННК p-GaAs. Однако более полное понимание свойств металла при формировании омического контакта является ключом к дальнейшему улучшению качества электрического контакта на устройствах нанометрового масштаба. Из-за большого количества методов выращивания ННК и концентраций примесей в ННК p-GaAs, о которых недавно сообщалось, было бы нецелесообразно проводить сравнение контактных сопротивлений, когда они доступны. Вместо этого было бы более подходящим всестороннее исследование различных маршрутов изготовления контактов на одном и том же наборе образцов NW, чтобы исключить влияние свойств NW.
Здесь мы обращаемся к влиянию различных электрических контактов на основе Pt и Ti и обработки поверхности перед испарением металла на общие вольт-амперные характеристики самокатализируемых ННК GaAs, легированных Be, выращенных на подложках Si [11, 32 ]. Анализ изменения общего сопротивления каналов ННК проведен на основе структурных исследований методом рентгеновской дифракции тонких пленок Ti, Pt и Pt / Ti, нанесенных на подложки GaAs (110). Мы показываем, что высокое контактное сопротивление связано с низкой степенью кристалличности Ti при нанесении непосредственно на GaAs (110), в то время как электрические контакты Pt / Ti / Pt / Au приводят к значительному снижению контактного сопротивления, которое объясняется улучшение качества металлического слоя, наблюдаемое в первых слоях Pt / Ti, нанесенных на поверхность GaAs (110).
Материалы и методы
Рост нанопроволоки
Самокатализируемые ННК GaAs, легированные Be, были выращены методом молекулярно-лучевой эпитаксии с твердым источником (МЛЭ) на безлитографических оксидных образцах, изготовленных на подложках p-Si (111) методами капельной эпитаксии и спонтанного окисления [32]. Температура роста ННК составляла 640 ° C, как определено пирометром, и использовался поток Ga, соответствующий планарной скорости роста 0,3 мкм / ч на GaAs (100). Смачивание Ga в течение 60 с предшествовало росту ННК, который был инициирован подачей As 2 с эквивалентным соотношением давлений пучка V / III, равным 9, и потоком Be, соответствующим 2,0 × 10 19 см −3 концентрация легирования p-типа; это было определено по выращиванию планарных калибровочных образцов GaAs (100), легированных Be, холловскими измерениями при комнатной температуре. Продолжительность роста 60 мин. Более подробную информацию о методологии выращивания и структурных свойствах нелегированных и легированных Be ННК можно найти в работах [1,96]. [11, 32, 33]. Короче говоря, ННК состоят из чистого GaAs с цинковой обманкой с образованием нескольких двойниковых плоскостей [33]. ННК имеют гексагональную форму с боковыми стенками, состоящими исключительно из граней с ориентацией (110), как это было ранее определено из структурного анализа ННК, легированных Be [33], и подтверждено в нелегированных ННК GaAs, выращенных в аналогичных условиях [12]. P>
Изготовление и описание контактов
ННК механически переносились на подложку p-GaAs (100), покрытую SiO 2 толщиной 200 нм. слой, который был предварительно сформирован с помощью фотолитографии и электронно-лучевого испарения площадок Ti / Au для определения характеристик переноса. Положение перенесенных проводов на подложке определяли с помощью сканирующей электронной микроскопии с малым увеличением (SEM). Положительный резист с электронным пучком наносили методом центрифугирования на подложку и экспонировали электронным пучком на областях электрического контакта. Резист был разработан в растворе MIBK:IPA после воздействия электронного луча и, возможно, с последующей обработкой кислородной плазмой для удаления остаточного сопротивления боковых стенок NW, как описано в таблице 1. Влияние обработки кислородной плазмой на характеристики устройства будет позже обсуждается в тексте. Перед испарением металла с контактных слоев образцы были химически обработаны для удаления естественного оксида и пассивирования открытых боковых стенок НП, как описано ниже в тексте. Отрыв осуществляли путем погружения образца в нагретый ацетон, промывки в IPA и сушки продувкой азотом.
Мы разработали пять различных процессов, сочетающих различную обработку поверхности открытых боковых стенок NW с различными металлическими слоями, используемыми в качестве электрических контактов. Это позволило нам определить индивидуальный вклад каждого параметра в результирующее сопротивление контакта при применении к GaAs ННК p-типа. Для удаления естественного оксида с поверхности мы использовали либо 2,8% NH 4 OH или 3,7% HCl, разбавленный H 2 O, за которым следует H 2 Ополаскивание. Для пассивации поверхности использовали 15% раствор (NH 4 ) 2 S x разбавлен H 2 O (нагретый до 45 ° C), а затем H 2 Ополаскивание. Металлический мультислой был нанесен с использованием испарения электронным пучком и состоял из Ti / Pt / Au (20/20/200 нм) или Pt / Ti / Pt / Au (5/10/10/200 нм). Для мультислоя Pt / Ti / Pt / Au использовали быстрый термический отжиг (RTA) при 400 ° C в течение 30 с. Процессы, используемые для каждого образца, указаны в таблице 1. Для каждого образца были изготовлены 4 равномерно расположенных электрических контакта вдоль оси NW. В данной работе мы ограничиваем ВАХ контактными парами, расположенными в центральной области СЗ. Данные IV были получены при комнатной температуре с использованием зондовой станции Keysight.
Структурное исследование с помощью дифракции рентгеновских лучей при падении
Чтобы исследовать структурные свойства электрических контактов на ННК, были измерены картины дифракции рентгеновских лучей при скользящем падении (GIXRD) на эталонных тонких пленках Ti, Pt и Pt / Ti, напыленных на нелегированные подложки GaAs (110). Мы приготовили образцы тонкой пленки, описанные в таблице 2, с использованием удаления естественного оксида с помощью HCl:H 2 O и пассивация поверхности (NH 4 ) 2 S x так же, как и для устройств NW. Малый угол падения рентгеновских лучей, используемых в GIXRD, позволяет нам анализировать металлические пленки той же толщины, что и в NW-контактах, из-за малой глубины проникновения. Диаграммы GIXRD были измерены с использованием излучения Cu Kα с длиной волны 1,54 Å и углом падения ω . =0,75 ° по отношению к поверхности образца. Положения дифракционных пиков индексируются в соответствии с файлами ICDD № 00-044-1294 и № 00-004-0802 для гексагонально-плотноупакованного (HCP) Ti и гранецентрированного кубического (FCC) Pt, соответственно, и корректируются с учетом эффект преломления рентгеновских лучей в экспериментах GIXRD, как описано в Ref. [34].
Результаты и обсуждение
На рис. 1а показаны ВАХ для образцов от P1 до P5, а на рис. 1b - СЭМ-изображение ННК GaAs, легированного Be, с электрическими контактами, использованными для определения транспортных характеристик. Почти симметричная нелинейная форма ВА для P1 – P4 на рис. 1a указывает на то, что контакты относятся к типу Шоттки с одинаковой высотой барьера для каждого контакта [35]. Нелинейность ВА для образца P1, очевидно, показывает, что стандартный процесс p-GaAs, как в P1, не дает омических контактов, как это имеет место в случае плоских тонких пленок GaAs. Обычно в легированных GaAs ННК используется удаление оксида HCl, возможно, за которым следует (NH 4 ) 2 S x пассивация поверхности перед испарением металла для образования омического контакта [20, 21, 36, 37] вместо NH 4 ОЙ. Кроме того, обработка кислородной плазмой обнаженной поверхности ННК ранее использовалась для удаления остаточного резиста с боковых стенок ННК [36, 38]. Однако, как побочный эффект, этот процесс может вызвать поверхностные дефекты в GaAs, такие как вакансии As, в результате чего образуются донорные ловушки, которые отвечают за компенсацию носителей заряда и, следовательно, увеличивают ширину обедненного слоя [5].
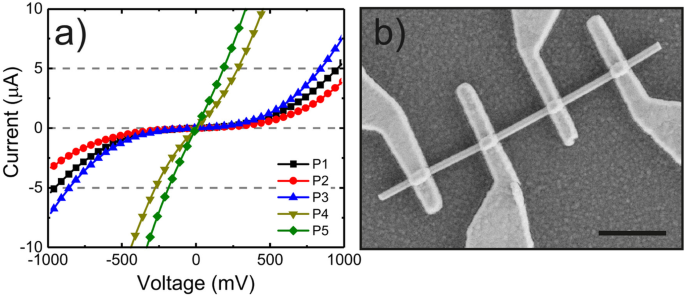
а IV из ННК GaAs, легированного Be, с электрическими контактами, изготовленными с использованием процессов P1 – P5, как описано в таблице 1. b СЭМ-изображение типичной ННК GaAs, легированной Be, с четырьмя равномерно расположенными электрическими контактами. Масштабная линейка составляет 1 мкм
Чтобы оценить влияние обработки кислородной плазмой на контактное сопротивление наночастиц p-GaAs, мы сравниваем IV образца с очисткой кислородной плазмой (P2) и без (P3) до обработки поверхности HCl и (NH 4 ) 2 S x на рис. 1а. P2 дает наихудшие характеристики ВА (определяемые как значение электрического тока при одинаковом приложенном напряжении) во всех образцах, но образец P3, в свою очередь, демонстрирует лучшие характеристики ВА, чем стандартный процесс P1 p-GaAs и P2, очищенный кислородной плазмой. Это подразумевает два важных результата:(i) воздействие кислородной плазменной обработки отрицательно сказывается на контактном сопротивлении, и (ii) P3 с удалением оксида HCl в сочетании с (NH 4 ) 2 S x Пассивирование поверхности приводит к более низкой высоте барьера Шоттки на границе раздела металл-полупроводник по сравнению с P1.
Характеристики ВАХ и омический характер (оцениваемые качественно по линейности ВАХ) были значительно улучшены в P4 по сравнению с P3 за счет добавления слоя Pt толщиной 5 нм под мультислой Ti / Pt / Au, как это видно из рис. 1a. Контактное сопротивление дополнительно снижается в P5 после RTA 30 с при 400 ° C, достигая линейных характеристик IV и улучшенных характеристик IV по сравнению с P4.
Для того, чтобы количественно оценить влияние параметров обработки на контактное сопротивление образцов P1 – P5 (химическая обработка, металлический многослойный материал), мы показываем на рис. 2a ВАХ от P1 – P5 с использованием меньшего диапазона смещения; в этом случае ВА проявляют линейное поведение и в основном определяются контактным сопротивлением [35]. Полное сопротивление канала (контакты + NW) в диапазоне 100 мВ на рис. 2a было рассчитано из линейной аппроксимации кривой ВАХ, и результаты показаны на рис. 2b. Поскольку диаметры всех исследованных ННК одинаковы, и существует лишь небольшое изменение концентрации легирующей примеси от проволоки к проволоке, как мы сообщали ранее [33], любые изменения общего сопротивления приписывались контактному сопротивлению. Более высокое сопротивление в P2 по сравнению с P1 и P3 подтверждает пагубный эффект обработки кислородной плазмой из качественного анализа IV на рис. 1a. Замечательным результатом является уменьшение общего сопротивления с 1400 кОм в P3 до 72 кОм в P4 и дальнейшее снижение до 40 кОм после RTA в P5, достигаемое за счет нанесения дополнительного слоя Pt перед многослойным слоем Ti / Pt / Au, используемым в образцы P1 – P3.
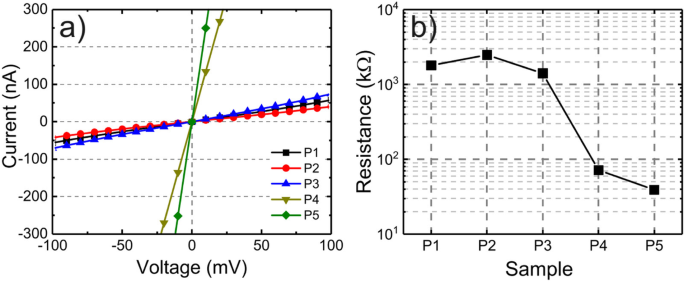
а IV от P1 до P5 в диапазоне приложенного напряжения 100 мВ. б Общее сопротивление канала P1 – P5, полученное в результате линейной подгонки IV в a
Более полное понимание микроструктуры границы раздела металл-полупроводник после изготовления контакта необходимо для установления корреляции изменений контактного сопротивления, наблюдаемых в образцах P1 – P5. Ранее сообщалось об использовании Ti и Pt для изготовления омических контактов с GaAs [39, 40], а также о структурных свойствах тонких пленок Ti и Pt, напыленных на поверхность GaAs (100) [41], и подложек из аморфного стекла [42, 43]. ] также были проанализированы. Однако для поверхности GaAs (110) столь подробные исследования не проводились. Ожидается, что различная ориентация поверхности повлияет на динамику кристаллизации тонких пленок Ti и Pt. Кроме того, химическая пассивация поверхности (NH 4 ) 2 S x может в дальнейшем повлиять на получаемые тонкие пленки. GIXRD исследовал степень кристаллизации тонких пленок Pt (5 нм), Ti (20 нм) и Pt / Ti (5/20 нм), осажденных на нелегированной подложке GaAs (110), с целью получения информации о структурных свойствах. первых металлических слоев, контактирующих с ННК в P1 – P5. Перед испарением металла подложки GaAs (110) подвергались удалению собственного оксида с помощью HCl:H 2 O и (NH 4 ) 2 S x ступени пассивации поверхности в образцах ННК П3 – П5. Подробности обработки поверхности и металлических тонких пленок, напыленных на подложку из GaAs (110), приведены в таблице 2.
Картины GIXRD для образцов S1 – S4 показаны в диапазоне углов дифракции от 30 до 60 ° на рис. 3a и в диапазоне от 60 до 90 ° на рис. 3b. Дифракционные картины на рис. 3 смещены по вертикали и разделены в двух диапазонах углов дифракции, чтобы обеспечить лучшее масштабирование для визуализации. Во-первых, мы сосредоточимся на эффекте (NH 4 ) 2 S x пассивация поверхности от степени кристалличности пленок Ti, напыленных на подложку GaAs (110), путем сравнения образцов S1 и S2. На рис. 3а мы наблюдаем перекрывающиеся низкоинтенсивные пики Ti (002) и Ti (101) с центрами при 38,4 и 40,2 °, соответственно, как для S1, так и для S2. Кроме того, для обоих образцов также наблюдается значительно более широкий пик Ti (102) с центром при 53,0 °, что свидетельствует об аморфном характере. Пик Ti (103) с центром при 70,6 ° на рис. 3b наблюдается только для S1, что является единственным значительным различием между образцами. В целом, низкие интенсивности и широкие пики S1 и S2 указывают на плохую кристалличность пленок Ti при осаждении на поверхность GaAs (110) после удаления оксида HCl и независимо от использования (NH 4 ) 2 S x пассивация. В случае S3, для которого Pt была нанесена на подложку GaAs (110) с той же обработкой поверхности, что и в S2, мы наблюдаем гораздо более выраженные Pt (111), Pt (200), Pt (220), Pt (311), и дифракционные пики Pt (222) с центрами при 39,8 °, 46,3 °, 67,5 °, 81,3 ° и 85,7 ° соответственно. Это указывает на то, что пленка Pt в S3 проявляет более высокую степень кристалличности по сравнению с образцами Ti. То же самое относится к S4, который показывает дифракционные сигнатуры Pt, аналогичные S3 на рис. 3a, b. Широкие и асимметричные пики между 35–45 °, 65–75 ° и 75–90 ° для S4 образуются из-за перекрытия Ti (002) -Ti (101) -Pt (111), Ti ( 103) -Pt (220) и Ti (004) -Pt (311) -Pt (222) пики дифракции соответственно. Качественное сравнение диаграмм GIXRD из S2, S3 и S4 подразумевает, что степень кристалличности Ti в S4 находится, по крайней мере, на том же уровне, что и в S1. Пик Ti (103) при 70,6 ° наблюдается как четкое плечо на пике Pt (220) на рис. 3b, а пик Ti (102) при 53,0 ° на рис. 3а присутствует с низкой интенсивностью, но с узкой шириной линии в S4. демонстрируя очень широкий аморфноподобный пик в S1 и S2. Этот результат предполагает улучшенную степень кристалличности Ti при нанесении на Pt вместо поверхности GaAs (110), что в дальнейшем будет напрямую коррелировать со свойствами электрических контактов, описанными на фиг. 1 и 2.
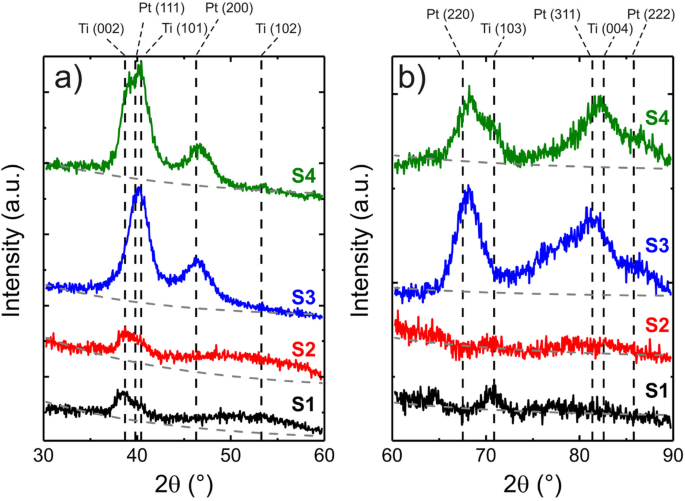
Шаблоны GIXRD из образцов S1 – S4 из a Диапазон углов дифракции от 30 до 60 ° и ( b ) Диапазон от 60 до 90 °. Пунктирные серые линии представляют собой базовые линии экспоненциального затухания, возникающие в результате диффузного рассеяния рентгеновских лучей. Вертикальные пунктирные черные линии соответствуют различным плоскостям дифракции Ti и Pt, обозначенным в верхней части a . и b
Анализ GIXRD металлических слоев в S1 – S4 позволяет коррелировать степень кристалличности Ti и Pt, нанесенных на подложку GaAs (110), и результаты полного сопротивления из P1 – P5 на рис. 2b. Важно подчеркнуть, что в этой работе мы основываем наши корреляции изменений общего сопротивления P1 – P5 в первую очередь на данных GIXRD, полученных из S1 – S4. Мы предполагаем, что другие факторы, такие как качество границы раздела металл-ННК из-за гексагональной геометрии боковых стенок ННК, имеют незначительный вклад в общие изменения сопротивления, наблюдаемые в P1 – P5. (NH 4 ) 2 S x пассивация поверхности оказывает положительное влияние на свойства границы раздела GaAs-металл, как видно из сравнения ВАХ и полного сопротивления образцов P1 и P3, но с низкой степенью кристалличности пленки Ti при осаждении непосредственно на поверхность GaAs (110). , как это наблюдается в S1 и S2. Это могло быть результатом реакции серы с заросшим Ti. Кроме того, сообщалось, что Ti обладает высокой реакционной способностью по отношению к остальным примесям в испарительной камере во время осаждения металла [41], образуя дополнительные слои между металлом / GaAs и, следовательно, увеличивая контактное сопротивление [5]. Как обсуждалось ранее, увеличение контактного сопротивления в P2 было приписано возможным поверхностным повреждениям, вызванным очисткой кислородной плазмой. Добавление тонкого слоя Pt между поверхностью Ti и GaAs (110), как в S4, приводит к более высокой степени кристалличности пленки Ti по сравнению с S1 и S2. Этот результат можно соотнести с уменьшением общего сопротивления канала с 1400 кОм в P3 до 72 кОм в P4, что связано с уменьшением контактного сопротивления. RTA дополнительно снижает общее сопротивление канала до 40 кОм в P5 в дополнение к увеличению омического характера IV, показанному на рис. 2a. Этот результат показывает, что не происходит никаких вредных реакций между поверхностью Pt и GaAs при используемых температуре и времени отжига [29,30,31].
Выводы
Влияние химической обработки поверхности перед испарением металла и формирование омических контактов с самокатализируемыми ННК GaAs, легированными Be, было исследовано путем сопоставления характеристик переноса одиночных ННК и структурного анализа тонких пленок Ti, Pt и Pt / Ti, осажденных на Подложки GaAs. Показано, что Ti проявляет низкую степень кристалличности при нанесении на поверхность GaAs (110), что напрямую влияет на контактное сопротивление устройств NW. Осаждение тонкого слоя Pt на ННК перед нанесением Ti / Pt / Au приводит к 95% снижению общего электрического сопротивления ННК GaAs, легированного Be, что связано с более высокой степенью кристалличности Pt, чем Ti, при прямом осаждении. на GaAs (110). Кроме того, мы показываем, что термический отжиг металлических слоев дополнительно снижает контактное сопротивление. Эти результаты имеют технологическое значение при разработке омических контактов к устройствам на основе GaAs ННК и показывают индивидуальный вклад каждого этапа обработки, описанного в таблице 1, в общее сопротивление и омический характер устройств с ННК. Для дальнейшего повышения производительности устройства потребуется систематическая оптимизация параметров каждого отдельного шага. В частности, мы показываем, что граница раздела металл-полупроводник на боковых стенках ННК играет важную роль в работе устройства и открывает путь для дальнейших исследований процесса кристаллизации металлических тонких пленок, осажденных на различных ориентациях поверхности полупроводниковых материалов AIIIBV.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этого исследования, включены в статью.
Сокращения
- FCC:
-
Гранецентрированный кубический
- GIXRD:
-
Дифракция рентгеновских лучей при скользящем падении
- HCP:
-
Гексагонально-закрытая упаковка
- IV:
-
Ток – напряжение
- NW:
-
Нанопроволока
- RTA:
-
Быстрый термический отжиг
- SEM:
-
Сканирующая электронная микроскопия
Наноматериалы
- Вольфрамовые контакты для электроприборов
- Дизайн контактов переключателя
- Связаться с «Bounce»
- Реле с выдержкой времени
- Цифровые логические функции
- Контактная линза
- Материаловеды учат нанопроволоки "танцевать"
- Оптимизация высокоотражающей тонкой пленки для полноугольных микро-светодиодов
- Многослойные полевые транзисторы SnSe Nanoflake с низкоомными Au-омическими контактами
- Матрицы нанополосов на основе GaAs с золотым покрытием, изготовленные методом химического травления с примене…



