Аналитическая модель максимальной температуры канала в полевых МОП-транзисторах с Ga2O3
Аннотация
В данной работе мы предложили точную аналитическую модель для оценки максимальной температуры канала Ga 2 О 3 МОП-транзисторы с естественной подложкой или подложкой с высокой теплопроводностью. Теплопроводность Ga 2 О 3 является анизотропным и значительно уменьшается с ростом температуры, что важно для теплового поведения Ga 2 О 3 Полевые МОП-транзисторы и поэтому рассматриваются в модели. Численное моделирование выполняется с помощью COMSOL Multiphysics для исследования зависимости максимальной температуры канала от плотности мощности путем изменения геометрических параметров устройства и температуры окружающей среды, что демонстрирует хорошее согласие с аналитической моделью, что обеспечивает ее применимость. Новая модель поучительна для эффективного управления температурой Ga 2 О 3 МОП-транзисторы.
Фон
Оксид галлия (Ga 2 О 3 Полевые транзисторы на основе металл-оксид-полупроводник (MOSFET) являются отличными кандидатами для силовой электроники следующего поколения, в которых используются два основных преимущества Ga 2 О 3 :значительно большая ширина запрещенной зоны (~ 4.8 эВ) и высококачественные объемные кристаллы, получаемые с низкими затратами [1]. Огромные усилия были направлены на улучшение его электрических свойств во всех аспектах, таких как плотность тока [2], напряжение пробоя [3] и добротность мощности [4]. С экспериментальным подтверждением его беспрецедентного потенциала для силовых электронных устройств [5,6,7,8,9], теперь чрезвычайно важно изучить производительность и надежность Ga 2 О 3 МОП-транзисторы, такие как проблема самонагрева и, следовательно, максимальная температура канала ( T макс ) из-за его относительно низкой теплопроводности ( κ , 0,11–0,27 Вт · см −1 К -1 при комнатной температуре) [1].
В последние годы появились различные методы оценки T макс Га 2 О 3 МОП-транзисторы были предложены теоретически и экспериментально [10,11,12,13]. Как правило, численное моделирование позволяет количественно оценить T макс определенного устройства. Однако это требует времени [14]. С другой стороны, извлечение T макс экспериментально всегда недооценивается [15]. Следовательно, необходимо создать аналитическую модель, чтобы адекватно моделировать T макс в Га 2 О 3 МОП-транзисторы, которые могут обеспечить достаточную точность с точки зрения эффективности времени и качественной оценки [14].
В этой статье мы предлагаем аналитическую модель T макс для Ga 2 О 3 МОП-транзисторы с использованием преобразования Кирхгофа с учетом зависимости κ от температуры и кристаллографических направлений для Ga 2 О 3 . Предлагаемая модель может быть применена для Ga 2 О 3 МОП-транзисторы с естественной подложкой или подложкой с высокой теплопроводностью. Достоверность и точность аналитической модели методически проверяются путем сравнения с численным моделированием в COMSOL Multiphysics.
Методы и разработка модели
Аналитическая модель для T макс в Га 2 О 3 Предлагаются полевые МОП-транзисторы на основе структуры, показанной на рис. 1. Основные параметры структуры перечислены в таблице 1. Фактически, было продемонстрировано, что джоулев нагрев сконцентрирован на краю стока затвора в Ga 2 О 3 МОП-транзисторы [13]. Чтобы упростить модель, предполагается, что эффект нагрева от затвора однороден [12] и может полностью проникнуть через оксид затвора из-за его незначительной толщины. Различные материалы подложки под Ga 2 О 3 канал рассматриваются в этой модели, например, объемный Ga 2 О 3 и высокий κ материалы, направленные на выполнимость и совместимость платы. Таким образом, устройство рассматривается как двухуровневая проблема. Подложка контактирует с идеальным радиатором, так что нижняя поверхность изотермична, а ее температура равна температуре окружающей среды ( T amb , По умолчанию 300 КБ). На другой поверхности конструкции были наложены адиабатические граничные условия. Эти граничные условия можно резюмировать как [14, 16]

Принципиальная схема Ga 2 О 3 МОП-транзистор
$$ {\ kappa} _ {y} {\ left. \ frac {\ partial T} {\ partial y} \ right |} _ {y ={t} _ {ch} + {t} _ {sub}} =\ left \ {\ begin {array} {c} \ frac {P} {{L} _ {g}} \ left | x \ right | \ le \ frac {{L} _ {g}} {2} \\ 0 \ left | x \ right |> \ frac {{L} _ {g}} {2} \ end {array} \ right., $$ (1) $$ {\ left.T \ right |} _ {y =0} ={T} _ {amb}, $$ (2) $$ {\ left. \ frac {\ partial T} {\ partial x} \ right |} _ {x =- \ frac { L} {2}} ={\ left. \ Frac {\ partial T} {\ partial x} \ right |} _ {x =\ frac {L} {2}} =0, $$ (3)где P , Т и κ y обозначают плотность рассеиваемой мощности, температуру и теплопроводность в направлении [010] для Ga 2 О 3 , соответственно. Следует подчеркнуть, что единица измерения P в этой статье - Вт / мм.
κ значение Ga 2 О 3 , один из ключевых параметров тепловых характеристик материала, играет важную роль в распространении теплового эффекта, а также в точности модели. То есть подробное описание κ значение требуется из-за его серьезной анизотропии и температурной зависимости [17]. В общем, зависимость κ Га 2 О 3 по температуре ( T ) вдоль двух различных ориентаций кристалла ([001] и [010]) определяется как
$$ {\ kappa} _ {\ left [001 \ right]} \ left (T \ right) =0,137 \ times {\ left (\ frac {T} {300} \ right)} ^ {- 1,12}, $ $ (4) $$ {\ kappa} _ {\ left [010 \ right]} \ left (T \ right) =0,234 \ times {\ left (\ frac {T} {300} \ right)} ^ {- 1.27}. $$ (5)Сравнительное исследование T макс при разных P был выполнен COMSOL Multiphysics с учетом постоянного и реалистичного κ , соответственно. Мы обнаружили, что при P 1 Вт / мм, Т макс получены значения 533 К и 622 К соответственно (не показаны). Следовательно, совершенно необходимо учитывать влияние T и кристаллографическое направление на κ Га 2 О 3 в модели.
Температурное поведение регулируется уравнением теплопроводности. Уравнение теплопроводности в установившемся режиме в Ga 2 О 3 домен
$$ \ frac {\ partial} {\ partial x} \ left ({\ kappa} _ {x} \ left (T \ right) \ frac {\ partial T} {\ partial x} \ right) + \ frac { \ partial} {\ partial y} \ left ({\ kappa} _ {y} \ left (T \ right) \ frac {\ partial T} {\ partial y} \ right) =0, $$ (6)где κ x обозначает теплопроводность направления [001] для Ga 2 О 3 . Уравнение нелинейной теплопроводности может быть решено с помощью преобразования Кирхгофа. Однако применение преобразования Кирхгофа может быть ограничено из-за сильно анизотропной κ в Га 2 О 3 , что справедливо, строго говоря, только для материалов с изотропными κ [14]. Учитывая указанное выше ограничение, не следует рассматривать κ x и κ y быть двумя независимыми переменными. На рисунке 2 показано соотношение между удельным тепловым сопротивлением, т. Е. 1 / κ , и T для направлений [001] и [010] на большом T диапазон соответственно. Видно, что 1 / κ y можно заменить на 1 / ( cκ x ) и c выбрано равным 1,64. Следовательно, уравнение. (6) можно преобразовать в следующее уравнение:

Связь между удельным тепловым сопротивлением и T для направлений [001] и [010]. Зеленые символы и красные линии обозначают фактические и подогнанные значения соответственно. Синяя линия представляет гипотезу 1 / κ y ≈ 1 / ( cκ x ), где c =1,64
$$ \ frac {\ partial} {\ partial \ mathrm {x}} \ left ({\ kappa} _ {x} \ left (T \ right) \ frac {\ partial T} {\ partial x} \ right) + \ frac {\ partial} {\ partial \ mathrm {y}} \ left ({c \ kappa} _ {x} \ left (T \ right) \ frac {\ partial T} {\ partial y} \ right) =0. $$ (7)На основе предыдущих приближений κ x и κ y преобразование Кирхгофа можно использовать без каких-либо ограничений. Кроме того, также видно, что величина, обратная κ ожидается, будет пропорционально T. Таким образом, чтобы уменьшить вычислительную сложность, выражение 1 / κ x можно упростить как 1 / κ x = АТ + b , как показано на рис. 2. Причина использования a , b и c просто удобство написания следующих уравнений.
Применяя преобразование Кирхгофа и метод разделения переменных, выражение T макс можно получить как
$$ \ begin {align} T _ {{max}} =&\\ &\, \ left ({T _ {{amb}} + \ frac {b} {a}} \ right) exp \ left ({\ frac {{AP \ left ({t _ {{ch}} + t _ {{sub}}} \ right)}} {{cL}} + \ frac {{aPSL}} {{\ sqrt c \ pi ^ {2} L_ {g}}}} \ right) - \ frac {b} {a}, \\ \ end {align} $$ (8)где
$$ S =\ sum_ {n =1} ^ {\ infty} \ frac {\ mathrm {sin} n \ pi \ frac {{L} _ {g}} {L}} {{n} ^ {2} } \ frac {\ mathrm {sinh} 2n \ pi \ frac {{t} _ {ch} + {t} _ {sub}} {\ sqrt {c} L}} {\ mathrm {cosh} 2n \ pi \ гидроразрыв {{t} _ {ch} + {t} _ {sub}} {\ sqrt {c} L}}. $$ (9)Следует отметить, что S представляет собой сходящийся бесконечный ряд, и его приблизительное значение, которое можно легко получить, используется в расчетах вместо его фактического значения.
В случае Ga 2 О 3 МОП-транзисторы с высоким κ субстратов, преобразование Кирхгофа не может быть применено непосредственно теоретически. Фактически, чтобы преобразование было действительным, граничные условия должны быть либо изотермическими (константа T поверхность), либо иметь фиксированную плотность теплового потока. Однако из-за различного κ Га 2 О 3 и материал подложки, оба эти граничных условия не полностью выполняются при Ga 2 О 3 / подложка. Учитывая, что κ Га 2 О 3 намного ниже высокого κ подложка, гипотеза, изотермическая граница раздела Ga 2 О 3 и субстрат вводится. Эта гипотеза помогает получить выражение T макс и его действительность будет проверена позже. В этом случае тепловое сопротивление ( R TH ) высокого κ подложка, соотношение разницы между T int и T amb и PW , т.е. R TH =( Т int - Т amb ) / ( PW ), можно рассчитать как R TH = LW / ( κt sub ), где W - ширина подложки [19]. Таким образом, выражение температуры Ga 2 О 3 / подложка ( T int ) является
$$ {T} _ {int} =\ frac {P {t} _ {sub}} {{\ kappa} _ {sub} L} + {T} _ {amb}, $$ (10)где κ sub - теплопроводность гетерогенной подложки, которая считается постоянной. Кроме того, следует отметить, что тепловое сопротивление границы между Ga 2 О 3 и гетерогенные субстраты не включены в модель. Таким образом, с помощью уравнения. (8) выражение T макс для Ga 2 О 3 МОП-транзисторы с гетерогенной подложкой могут быть получены как
$$ \ begin {align} T _ {{max}} =&\\ &\; \ left ({T _ {{int}} + \ frac {b} {a}} \ right) exp \ left ({\ frac {{aPt _ {{ch}}}} {{cL}} + \ frac {{aPSL}} {{\ sqrt c \ pi ^ {2} L_ {g}}}} \ right) - \ frac {b} {а}, \\ \ конец {выровнено} $$ (11)где
$$ S =\ sum_ {n =1} ^ {\ infty} \ frac {\ mathrm {sin} n \ pi \ frac {{L} _ {g}} {L}} {{n} ^ {2} } \ frac {\ mathrm {sinh} 2n \ pi \ frac {{t} _ {ch}} {\ sqrt {c} L}} {\ mathrm {cosh} 2n \ pi \ frac {{t} _ {ch }} {\ sqrt {c} L}}. $$ (12)Результаты и обсуждение
Обоснованность аналитической модели для T макс в Га 2 О 3 В этом разделе проводилась систематическая проверка полевых МОП-транзисторов с учетом как собственной подложки, так и аналога с более высокой теплопроводностью. Лучший способ проверить достоверность модели - сравнить ее с экспериментальными данными. Однако некоторые ключевые геометрические параметры не могут быть найдены в экспериментальной литературе, например t sub и L в исх. [12]. Поэтому моделирование методом конечных элементов, одно из наиболее точных средств, используется для проверки нашей модели. На рисунке 3 показана зависимость T макс по удельной мощности P получено из COMSOL Multiphysics и аналитической модели для Ga 2 О 3 MOSFET с родной подложкой. Учитываются различные ключевые параметры, в том числе длина устройства L , толщина подложки t sub , и температура окружающей среды T amb . Как показано на рис. 3a, T макс естественно увеличивается с увеличением плотности мощности, а скорость увеличения увеличивается с меньшим L . Это связано с тем, что устройство с большей L позволяет отвод тепла от активной области и, следовательно, его общая температура ниже, чем у меньшего L при том же P [11]. То есть его R TH , наклон кривых меньше, чем у последнего . Кроме того, поскольку κ Га 2 О 3 будет уменьшаться с увеличением общей температуры, его R TH также будет увеличиваться медленнее, чем при меньшем L следовательно, что очевидно на рис. 3а [19]. Аналогичным образом исследование зависимости T макс на t sub был выполнен, как показано на рис. 3b. Замечено, что тенденция T макс относительно P такое же, как на рис. 3а. Чем тоньше субстрат, тем меньше подъем T . макс по увеличенной плотности мощности, что понятно, что чем тоньше подложка, тем ниже общая температура, тем меньше R TH и скорость его увеличения, как и анализ на рис. 3а. На рисунке 3c сравнивается влияние T amb на T макс как P увеличивается. Видно, что разница между двумя кривыми медленно увеличивается, в отличие от кривых на рис. 3а, б. Обычно R TH преобладают геометрические параметры устройства и κ стоимость материала. Однако, учитывая, что в этом случае конструкция зафиксирована, увеличение R TH индуцируется только уменьшением κ Га 2 О 3 . С другой стороны, наблюдается высокий уровень согласия для предложенной модели, которая учитывает T - и зависимые от направления отношения для κ Га 2 О 3 , что подтверждает масштабируемость модели. В среднем разница между предложенной моделью и симуляцией составляет <1 К. Наблюдаемое в целом отличное согласие предполагает, что предложенная модель является высокоэффективной и точной.

Зависимость T макс на а длина устройства L , b толщина слоя подложки t sub , и c температура окружающей среды T amb на разной мощности P . Символы и линии обозначают результаты предложенной модели и моделирования соответственно
Аналогичным образом, как показано на рис. 4, аналогичные сравнения повторяются для Ga 2 О 3 МОП-транзисторы на высоком κ подложка, SiC. Здесь шаги для L и T amb которые мы выбираем, больше, чем на рис. 3, и варьируемая толщина канала t ch рассматривается вместо t sub в таком случае. В противном случае разница между двумя кривыми T макс относительно P на каждом рисунке будут неотличимы из-за эффективного рассеивания тепла подложкой SiC. κ SiC (3,7 Вт · см −1 К -1 ) применяется по умолчанию в программном обеспечении COMSOL Multiphysics. Благодаря высокому κ SiC, на всех рисунках хорошо видно, что увеличение T макс приблизительно линейна как P увеличивается, а это означает, что влияние температуры на R TH устройства незначительно. Следует отметить, что наша модель может успешно описать эту линейную зависимость. Однако очевидно, что T макс Расчетная по текущей модели ниже, чем прогнозируется с помощью моделирования, и эта разница более очевидна с увеличением энергопотребления. Чтобы показать этот механизм, смоделировал T int извлекаются с увеличением мощности и сравниваются с рассчитанным T int по формуле. (10), как показано на рис. 5. Было обнаружено, что джоулев нагрев становится более концентрированным в середине устройства как P увеличивается. Есть 0,5 К и 4 К Δ T между моделью и симуляцией в этом месте, когда P =0,25 и 1 Вт / мм соответственно. Это причина того, что наша модель не может точно предсказать T макс . Следовательно, более разумная гипотеза T int необходимо для получения более высокой точности в будущем. Тем не менее, T макс согласно прогнозам модели, будет всего на <4 К ниже, чем при моделировании, даже при плотности рассеиваемой мощности 1 Вт / мм. То есть, хотя гипотеза однородного T int не соответствует действительности, наша модель может дать оценку T макс с достаточной точностью.
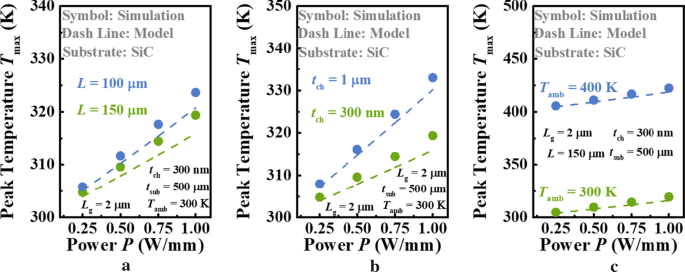
Зависимость T макс Га 2 О 3 МОП-транзисторы с подложкой SiC на a длина устройства L , b толщина Ga 2 О 3 слой t ch , и c температура окружающей среды T amb на разной мощности P . Символы и линии обозначают результаты предложенной модели и моделирования соответственно
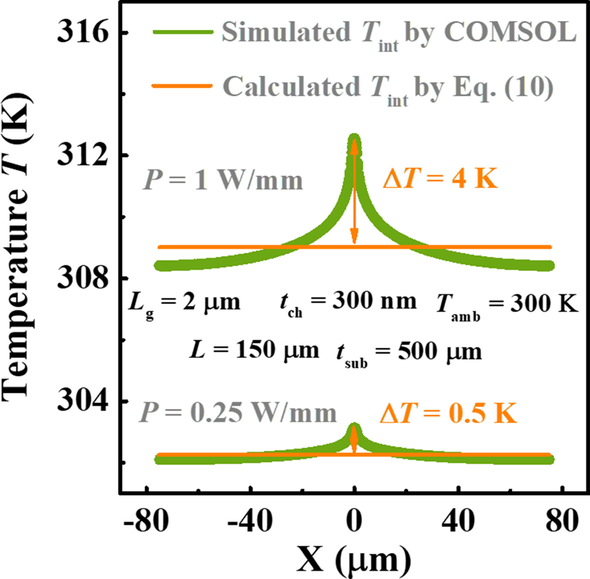
Сравнение T int между смоделированными и рассчитанными по формуле. (10) при разных P
Выводы
Точная аналитическая модель для оценки T макс Га 2 О 3 Представлены полевые МОП-транзисторы, в которых теплопроводность зависит от температуры и направления. Было получено простое выражение, основанное на геометрии устройства и параметрах материала. Было получено отличное согласие между моделью и численным моделированием COMSOL Multiphysics за счет варьирования различного энергопотребления. Предлагаемая модель для T макс имеет большое значение для эффективного управления тепловым режимом силовых устройств, особенно Ga 2 О 3 МОП-транзисторы.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью.
Сокращения
- Ga 2 О 3 :
-
Оксид галлия
- МОП-транзисторы:
-
Полевые транзисторы металл – оксид – полупроводник
- AlGaN:
-
Нитрид алюминия-галлия
- GaN:
-
Нитрид галлия
- SiC:
-
Карбид кремния
Наноматериалы
- Таксономия для IIoT
- Понимание науки о дисперсии пигментов для максимальной эффективности!
- Мониторинг температуры на Raspberry Pi
- Лучшие аксессуары для Raspberry Pi
- Зрение:для слепых
- Windows 10 IoT Core для Raspberry Pi 3, модель B +
- Ученые IBM изобрели термометр для наномасштаба
- Пандемия движет новой моделью принятия решений о цепочке поставок
- Задача метода 5S для индустрии 4.0
- Спасибо за воспоминания!



