Полевой транзистор ZrOx с отрицательной емкостью с подпороговым поведением качания ниже 60
Аннотация
Здесь мы сообщаем о ZrO x полевые транзисторы на основе отрицательной емкости (NC) с подпороговым размахом (SS) 45,06 мВ / декада ниже ± 1 В В GS диапазон, который может открыть новые возможности в будущих приложениях NCFET с масштабируемым напряжением. Сегнетоэлектрическое поведение Ge / ZrO x Конденсаторы / TaN предложено быть образованными на основе диполей кислородных вакансий. Эффект NC аморфного HfO 2 и ZrO x пленочные устройства могут быть подтверждены внезапным падением утечки затвора, явлением отрицательного дифференциального сопротивления (NDR), повышением I ДС и подпороги до 60 качели. 5 нм ZrO x NCFET-транзисторы обеспечивают гистерезис 0,24 В по часовой стрелке, менее 60 мВ / декада SS и 12% I Улучшение DS по сравнению с контрольным устройством без ZrO x . Подавленный NC-эффект Al 2 О 3 / HfO 2 NCFET по сравнению с ZrO x NCFET связан с частичным переключением диполей кислородных вакансий при прямой развертке из-за отрицательных межфазных диполей на Al 2 О 3 / HfO 2 интерфейс.
Фон
Поскольку дополнительные металлооксидные полупроводниковые (КМОП) устройства постоянно сокращаются, технология интегральных схем (ИС) вступила в эпоху «большей, чем эра Мура». Движущей силой индустрии и технологий ИС становится снижение энергопотребления вместо миниатюризации транзисторов [1, 2]. Однако тирания Больцмана в отношении полевых МОП-транзисторов, SS более 60 мВ / декада ограничила эффективность использования энергии / мощности [3]. В последние годы многие предложенные новые устройства обладают способностью достигать размаха порога ниже 60 мВ / декаду, включая полевые МОП-транзисторы с ударной ионизацией, туннельные полевые транзисторы и полевые транзисторы NCFET [4,5,6,7]. Благодаря простой конструкции, крутой SS и улучшенному току возбуждения, NCFET с сегнетоэлектрической (СЭ) пленкой были расценены как привлекательная альтернатива среди этих новых устройств [8,9,10]. Описанные эксперименты с NCFET в основном включают PbZrTiO 3 (PZT), P (VDF-TrFE) и HfZrO x (HZO) [11,12,13,14,15,16,17]. Однако высокая температура процесса и нежелательный ток утечки затвора по границам зерен поликристаллических сегнетоэлектрических материалов ограничили их развитие для узлов с современной технологией [18,19,20,21,22,23,24,25 , 26]. В последнее время сегнетоэлектричество в аморфном Al 2 О 3 и ZrO x пленки с модулированными по напряжению диполями кислородных вакансий были исследованы [27,28,29]. По сравнению с кристаллическими аналогами аморфные сегнетоэлектрические пленки обладают значительными преимуществами в снижении температуры процесса и тока утечки. Таким образом, проводятся массовые исследования FeFET с аморфным изолятором затвора для приложений энергонезависимой памяти и аналоговых синапсов [27, 30,31,32,33,34]. Однако систематическое исследование однотранзисторного ZrO x на базе NCFET не проводилось.
В этой работе Ge NCFET с 5 нм ZrO x сегнетоэлектрический диэлектрический слой и 5 нм Al 2 О 3 / HfO 2 были предложены сегнетоэлектрические диэлектрические слои. Мы экспериментально наблюдали крутой наклон менее 60 мВ / десятилетие в ZrO x (5 нм) NCFET, что можно отнести к NC-эффекту ZrO x сегнетоэлектрический слой. И мы проанализировали поляризацию P как функция приложенного напряжения В для Ge / ZrO x Конденсаторы TaN. Сегнетоэлектрическое поведение Ge / ZrO x Конденсаторы / TaN индуцируются диполями кислородных вакансий, индуцированными напряжением. Более того, мы отнесли улучшенный I DS и внезапное падение я G в Аль 2 О 3 / HfO 2 NCFET и ZrO x NCFET с эффектом NC. Мы также наблюдали явление NDR в Al 2 О 3 / HfO 2 NCFET и ZrO x NCFET. Кроме того, мы дополнительно проанализировали физический механизм индуцированного межфазными диполями эффекта пониженного NC в Al 2 О 3 / HfO 2 NCFET. ZrO x NCFET с крутым наклоном менее 60 мВ / декаду, улучшенным напряжением стока и низким рабочим напряжением будут подходить для проектирования NCFET с низким энергопотреблением в «эпоху больше, чем Мура».
Методы
Основные этапы процесса для NCFET с ZrO x и Al 2 О 3 / HfO 2 Изготовление показано на рис. 1а. Различные диэлектрические изоляторы затвора, в том числе Al 2 О 3 / аморфный HfO 2 (5 нм) пленки и аморфный ZrO x Пленки (4,2 нм) были выращены на подложках n-Ge (001) методом атомно-слоистого осаждения (ALD) при 300 ° C. TMA, TDMAHf, TDMAZr и H 2 Пары O использовались в качестве предшественников Al, Hf, Zr и O соответственно. Время импульса и время продувки прекурсоров Hf и Zr составляют 1,6 с и 8 с соответственно. Время импульса и время продувки предшественников Al составляют 0,2 с и 8 с соответственно. Затем верхний электрод затвора из TaN был нанесен на HfO 2 . или ZrO x поверхности реактивным напылением. Области истока / стока (S / D) определялись литографией и сухим травлением. После этого бор (B + ) и никель (Ni) был нанесен в области истока / стока (S / D). Наконец, быстрый термический отжиг (RTA) при 350 ° C в течение 30 с в течение 10 8 Па в атмосфере азота. На рис. 1b, d показаны схемы изготовленного Al 2 . О 3 / HfO 2 NCFET и ZrO x NCFET. Изображение, полученное с помощью просвечивающего электронного микроскопа высокого разрешения (HRTEM) на рис. 1c, показывает аморфный HfO 2 (5 нм) пленка на Ge (001) с Al 2 О 3 межфазный слой. Изображение HRTEM на рис. 1e показывает аморфный ZrO x (4.2 нм) на Ge (001). C – V-кривая ZrO x NCFET и рентгеновские фотоэлектронные спектры (XPS) TaN / ZrO x Конденсаторы (4,2 нм) / Ge были измерены в Дополнительном файле 1:Рис. S1.
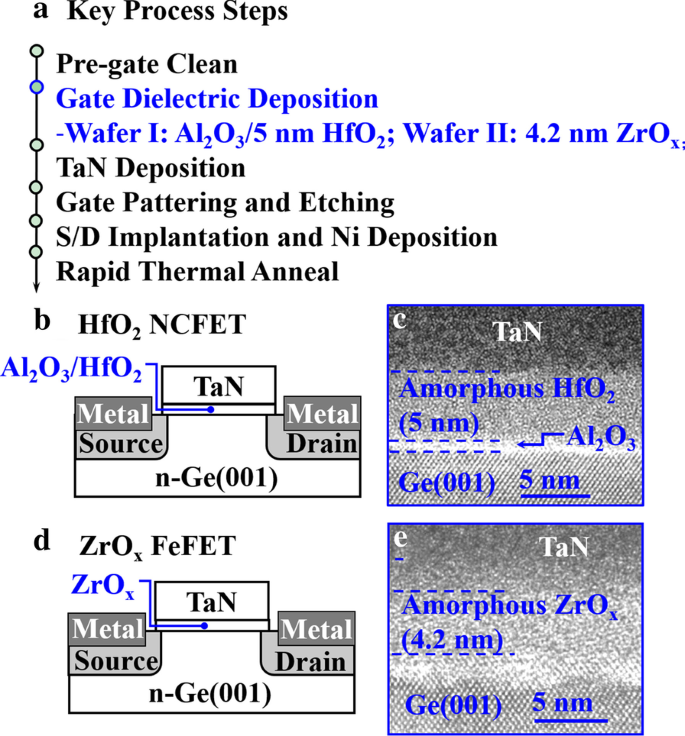
а Основные этапы процесса изготовления Al 2 О 3 / 5 нм HfO 2 NCFET и 4,2 нм ZrO x NCFET. б Схемы и c Изображения HRTEM изготовленного ZrO x NCFET. г Схемы и е Изображения HRTEM изготовленного Al 2 О 3 / HfO 2 NCFET
Результаты и обсуждение
На рисунке 2а показаны измеренные кривые поляризации P v.s. приложенное напряжение В характеристики для Ge / ZrO x / Конденсаторы TaN на 3,3 кГц. Длина ворот ( L G ) конденсаторов 8 мкм. Замечено, что остаточная поляризация P r Ge / ZrO x / Конденсаторы TaN могут быть улучшены за счет увеличения диапазона качания В . Сегнетоэлектрическое поведение аморфного ZrO x Предполагается, что пленка на рис. 2а образована диполями кислородных вакансий, управляемыми напряжением [35]. На рисунке 2b показаны измеренные значения P – V кривые для Ge / ZrO x / Конденсаторы TaN на разные частоты от 200 до 10 кГц. Мы видим, что сегнетоэлектрическое поведение аморфного ZrO x Пленка остается стабильной на всех частотах. Однако P r аморфного ZrO x пленка уменьшена с повышенными частотами. Это явление можно объяснить неполным переключением диполей при высоких частотах измерения [36, 37]. По мере увеличения частот измерения время изменения направления электрического поля в аморфном ZrO x пленка уменьшается. Таким образом, переключение диплоёв кислородных вакансий происходит не полностью, что снижает P r .

Измерено P по сравнению с V характеристики 4,2 нм ZrO x конденсаторы с a различные диапазоны развертки V и b разные частоты измерения
На рис. 3а показаны измеренные значения I DS - V GS кривые сегнетоэлектрика Al 2 О 3 / HfO 2 NCFET на V DS от - 0,05 В и - 0,5 В. На L G устройств составляет 3 мкм. Петли гистерезиса 0,14 В ( В DS =- 0,05 В, I ds =1 нА / мкм) и 0,08 В ( V DS =- 0,5 В, I ds =1 нА / мкм) соответственно. Петли гистерезиса по часовой стрелке объясняются миграцией кислородных вакансий и сопровождающими их отрицательными зарядами. Диполи кислородных вакансий накапливаются (истощаются) в Ge / Al 2 О 3 интерфейс под положительным (отрицательным) V GS . Следовательно, пороговое напряжение ( В TH ) увеличивается (уменьшается) при прямом (обратном) качании напряжений затвора. Как показано на рис. 3b, выходные характеристики Al 2 О 3 / HfO 2 NCFET и контрольный полевой транзистор сравниваются. Ток насыщения Al 2 О 3 / HfO 2 NCFET превышает 26 мкА / мкм, что на 23% больше, чем у контрольного полевого транзистора при | V GS - V TH | =| V DS | =0,8 В. Повышение тока вызвано увеличением интенсивности инверсионного заряда ( Q inv ) в электрическом поле обратной поляризации и усилении поверхностного потенциала [38, 39]. Помимо текущего улучшения, полученный очевидный NDR доказывает NC-эффект аморфного HfO 2 фильм. Эффект NDR вызван неполным переключением диполей кислородных вакансий из-за связи стока с каналом как V DS увеличивается [40, 41]. На рисунке 3c сравниваются измеренные утечки на затворе I G - V GS кривые для 5 нм Al 2 О 3 / HfO 2 NCFET на V DS от - 0,05 В до - 0,5 В. Резкие перепады I G только во время обратной развертки указывают на пониженное напряжение в аморфном HfO 2 пленка и усиление поверхностного потенциала [42]. Отсутствие NC-эффекта при прямой развертке вызвано частичным переключением диполей кислородных вакансий в аморфном HfO 2 фильм [43]. Различная способность содержать атомы кислорода между Al 2 О 3 и HfO 2 слой приводит к перераспределению кислорода и отрицательным межфазным диполям в Al 2 О 3 / HfO 2 интерфейс [44, 45]. Из-за наличия отрицательных межфазных диполей для аморфного HfO 2 трудно пленка для реализации полного переключения поляризации (NC-эффект) при прямой развертке (дополнительный файл 1).
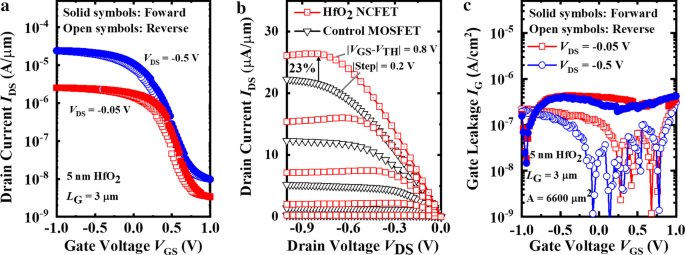
а Измерено I DS - V GS кривые 5 нм HfO 2 NCFET, когда V DS =- 0,5 В и В DS =- 0,05 В. b Измерено I DS - V DS кривые HfO 2 NCFET и управляющий полевой МОП-транзистор. c Измерено I G - V GS кривые 5 нм HfO 2 NCFET, когда V DS =- 0,5 В и В DS =- 0,05 В
На рисунке 4а показаны измеренные кривые передачи сегнетоэлектрика ZrO x . NCFET на V DS от - 0,05 В и - 0,5 В. На L G двух устройств - 4 мкм. Петли гистерезиса по часовой стрелке 0,24 В ( V DS =- 0,05 В, I ds =1 нА / мкм) и 0,14 В ( V DS =- 0,5 В, I DS =1 нА / мкм) соответственно. Как показано на рис. 4b, выходные характеристики ZrO x NCFET и контрольный полевой транзистор сравниваются. Ток насыщения ZrO x NCFET превышает 30 мкА / мкм, что на 12% больше, чем у контрольного полевого транзистора при | V GS - V TH | =| V DS | =1 В. Улучшенное усиление тока и более очевидный NDR указывают на усиленный NC-эффект аморфного ZrO x пленка (5 нм) контрастирует с 5 нм HfO 2 фильм. На рисунке 4c сравниваются измеренные утечки на затворе I G - V GS кривые для 5 нм ZrO x NCFET на V DS от - 0,05 В до - 0,5 В. По сравнению с внезапным I G капли Al 2 О 3 / HfO 2 NCFET только во время обратной развертки на рис. 3c, внезапные падения I G как прямая, так и обратная развертка на рис. 4c также доказывают усиленный эффект NC в аморфном ZrO x фильм.
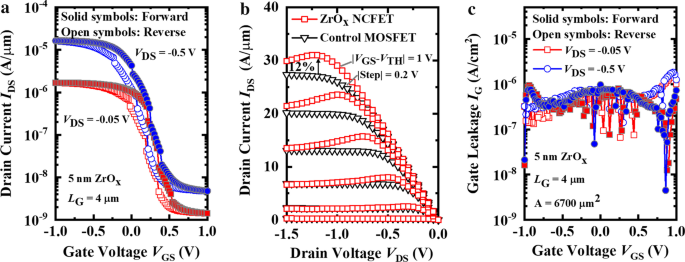
а Измерено I DS - V GS кривые 5 нм ZrO x NCFET, когда V DS =- 0,5 В и В DS =- 0,05 В. b Измерено I DS - V DS кривые ZrO x NCFET и управляющий MOSFET демонстрируют очевидный феномен NDR. c Измерено I G - V GS кривые 5 нм ZrO x NCFET, когда V DS =- 0,5 В и В DS =- 0,05 В
На рис. 5а, б показана точка SS как функция от I . DS для Al 2 О 3 / HfO 2 и ZrO x NCFET на V DS - 0,05 В и - 0,5 В. Как показано на рис. 5b, подпороговое колебание (SS) ниже 60 мВ / декада может быть достигнуто во время прямого или обратного качания V GS на V DS от - 0,05 В и - 0,5 В. Когда V DS составляет - 0,05 В, точечная прямая SS 45,1 мВ / дек и обратная точка 55,2 мВ / дек. Когда V DS составляет 0,5 В, точечная прямая SS 51,16 мВ / дек и обратная точка 46,52 мВ / дек. Из-за различной способности поглощать Al 2 О 3 / HfO 2 и ZrO x в слое, переключение частичных диполей происходит в Al 2 О 3 / HfO 2 NCFET. Следовательно, более очевидный NC-эффект с SS менее 60 мВ / декада достигается в 5 нм ZrO x NCFET.
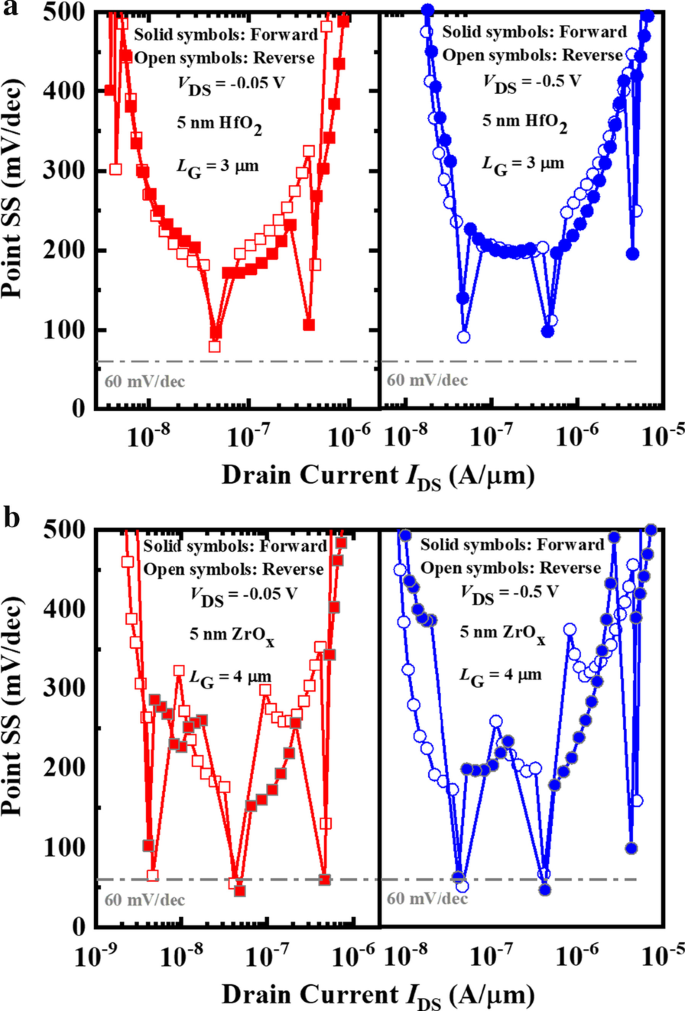
Точка SS как функция от I DS для а Аль 2 О 3 / 5 нм HfO 2 NCFET и b 5 нм ZrO x NCFET
Выводы
Сообщаем о демонстрации сегнетоэлектрика NC ZrO x pFET-транзисторы с SS менее 60 мВ / декада, низким рабочим напряжением 1 В и гистерезисом менее 60 мВ. Воздействие аморфного ZrO2 x Сегнетоэлектрическое поведение пленок объясняется диполями кислородных вакансий. Улучшенный I DS и явление NDR также получают в Al 2 О 3 / HfO 2 NCFET и ZrO x NCFET по сравнению с устройством управления. Подавленный NC-эффект Al 2 О 3 / HfO 2 NCFET можно отнести к частичному переключению диполей из-за межфазных диполей на Al 2 О 3 / HfO 2 интерфейс. ZrO x Полевые транзисторы NCFET с крутым наклоном менее 60 мВ / декаду, улучшенным напряжением стока и низким рабочим напряжением открывают новый путь для проектирования NCFET с низким энергопотреблением в будущем.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью.
Сокращения
- TaN:
-
Нитрид тантала
- ZrO x :
-
Диоксид циркония
- TDMAZr:
-
Тетракис (диметиламидо) цирконий
- P r :
-
Остаточная поляризация
- E c :
-
Коэрцитивное электрическое поле
- МОП-транзисторы:
-
Полевые транзисторы металл – оксид – полупроводник
- Ge:
-
Германий
- ALD:
-
Осаждение атомного слоя
- B + :
-
Ион бора
- Al 2 О 3 :
-
Оксид алюминия
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- Ни:
-
Никель
- RTA:
-
Оплаченный термический отжиг
- I DS :
-
Слить ток
- V GS :
-
Напряжение затвора
- V TH :
-
Пороговое напряжение
- NCFET:
-
Полевой транзистор с отрицательной емкостью
Наноматериалы
- Соединительный полевой транзистор (JFET) в качестве переключателя
- Материалы:пена EPP с улучшенными свойствами поверхности и оптимизированным поведением заполнения
- Многослойные полевые транзисторы SnSe Nanoflake с низкоомными Au-омическими контактами
- Поведение при спекании SiC, спеченного плазменной искрой, с композитными наночастицами Si-SiC, полученными метод…
- Графен / полианилиновый аэрогель со сверхэластичностью и высокой емкостью в качестве высокостойкого к сжати…
- Сегнетоэлектрические полевые транзисторы на основе одностенных углеродных нанотрубок с преобладанием микр…
- Аналоговые / ВЧ характеристики Т-образного затвора с двойным источником туннельного полевого транзистора
- Наноразмерный вакуумный канальный транзистор на основе графена
- Боковой транзистор металл-оксид-полупроводник со сверхнизким удельным сопротивлением в открытом состоянии …
- Высокопроизводительная токарная обработка при малой занимаемой площади



