Высокая плотность тока короткого замыкания, вызванная захватом света в солнечных элементах с гетеропереходом III-нитрида / Si (111)
Аннотация
Для массивов диодов p-GaN / i-InGaN / n-GaN, эпитаксиально выращенных на матрице диодов p-GaN / i-InGaN / n-GaN, была получена эффективная площадь фотоэлектрического КПД 1,27% при преобразовании мощности, исключая площадь контакта с металлической сеткой и при 1 солнце, в условиях AM 1.5G. (111) -Si. Плотность тока короткого замыкания составляет 14,96 мА / см 2 а напряжение холостого хода составляет 0,28 В. Считается, что улучшенное улавливание света за счет многократных отражений внутри структур массива наностержней из бездефектных и деформируемых нитридов III и коротковолновые отклики, усиленные широкозонными нитридными составляющими III, вносят свой вклад в наблюдается повышение производительности устройства.
Введение
Развитие зеленой энергетики становится все более важным, и производство светодиодов (LED), а также солнечных элементов развивается быстрыми темпами из-за постоянно усиливающегося энергетического кризиса. За последние несколько десятилетий полупроводники из III-нитрида успешно применялись в светодиодных устройствах [1,2,3], что дало существенные коммерческие выгоды. В настоящее время многие ученые стремятся использовать исследовательский потенциал III-нитридов для фотоэлектрических приложений [4, 5]. Нитридные материалы групп III-V имеют много преимуществ для фотоэлектрических систем, таких как прямая запрещенная зона с большим коэффициентом поглощения [4, 6], широкий диапазон запрещенной зоны, покрывающий большую часть солнечного спектра посредством зонной техники [4, 6, 7], высокая подвижность носителей [7] и превосходная радиационная стойкость [8]. На основе этих превосходных свойств моделируются конструкции нескольких устройств, таких как тандемные элементы InGaN / Si [9,10,11,12,13,14], солнечные элементы с горячими носителями [15], солнечные элементы на основе Шоттки [16, 17,18], одинарные [19,20,21,22,23,24] и множественные [25, 26] переходные солнечные элементы, а также влияние поляризации на характеристики солнечных элементов [9, 23, 27]. Моделирование предсказало, что гетероструктурные тандемные ячейки InGaN / Si могут иметь эффективность до 21–36% [10, 11, 13] на основе различных имитационных моделей. Эффективность преобразования энергии (КПЭ) гомоструктурного тандемного солнечного элемента InGaN с четырьмя различными составами In предлагается составлять 51% при облучении в 1 солнце и 58% в условиях концентрации 250 солнечных лучей [26]. Однако проблемы примесей и безызлучательной рекомбинации становятся все более значительными в условиях выращивания тонких пленок InGaN при низких температурах [28,29,30]. Значительные дефекты упаковки и плотности дислокаций из-за несоответствия решеток приводят к уменьшению длины диффузии носителей и ограничению PCE солнечных элементов [31,32,33,34]. Таким образом, остается множество проблем, связанных с реализацией потенциальных возможностей высокоэффективных фотоэлектрических устройств с нитридом III группы.
В последнее десятилетие многие актуальные темы исследований, такие как методы выращивания кристаллов InGaN с высоким содержанием In на отдельно стоящей подложке GaN [34], легирование InGaN p-типа [35], конструкции квантовых ям [36,37,38,39,40], электроды были изучены конструкции [41,42,43,44], фотоэлектрические концентраторы [37, 41, 45], солнечные элементы с промежуточной зоной [46] и структуры с уменьшенным отражением [47,48,49]. Кроме того, неполярные солнечные элементы на основе нитридов были исследованы на эффект поляризации [50, 51]. Dahal et al. продемонстрировали работу солнечных элементов с несколькими квантовыми ямами с содержанием InGaN более 30% на более длинных волнах (> 420 нм) [38] и проиллюстрировали эффективность 3,03% при увеличении интенсивности освещения до 30 солнц [37]. Mori et al. исследовали солнечные элементы на основе нитрида-концентратора [45] и обратились к самому высокому КПЭ, равному 4%, работающему при высокой интенсивности света до 300 солнц [41]. Несмотря на то, что несколько исследовательских групп разработали различные структурные или оптические конструкции и улучшили методы выращивания, ЭПЭ III-нитридных солнечных элементов не сильно продвинулись. С другой стороны, Reichertz et al. продемонстрировали, что тандемные солнечные элементы возможны путем эпитаксиального выращивания GaN p-n-перехода на подложке Si p-n-перехода [14]. Их результаты показали, что подложка Si вносит вклад в длинноволновую эффективность, а нитрид вносит вклад в коротковолновую эффективность. Кремниевые подложки обеспечивают не только дешевое решение, но также улучшают PCE и обеспечивают хорошую теплопроводность [52].
Обычно для выращивания солнечных элементов сплошные слои пленки выращивают друг над другом, что приводит к высокой плотности дислокаций. Однако, когда III-нитриды выращиваются в наноструктурах, нижняя поверхность, контактирующая с подложкой, мала, поэтому уменьшаются пронизывающие дислокации, а деформация также может быть минимальной. Тессарек и др. сообщили, что дислокации наностержней GaN исчезают при уменьшении диаметра до 200 нм [53]. Следовательно, в качестве альтернативы выращиванию пленки на кремниевых подложках было бы предпочтительным выбором для выращивания солнечных элементов на наностержнях из III-нитрида, чтобы снизить стоимость, улучшить качество кристаллов и повысить эффективность элементов. Кроме того, наностержень / нанопроволока имеет большую емкость для фотоэлектрических приложений, потому что фотогенерированные электроны могут собираться более эффективно, прежде чем они рекомбинируются с дырками из-за прямого пути к электродам, а наностержневые структуры могут улучшить захват света для увеличения поглощения фотонов [54, 55]. Несколько групп продемонстрировали фотоприемники [56, 57], нанолазеры [58, 59], нано-светодиоды [60, 61] и фотоэлектрохимическое расщепление воды [62] на основе наностержней III-нитрида [55]. Тем не менее недостатком солнечных элементов с наностержнями является то, что фотогенерированные электронно-дырочные пары рекомбинируют в многочисленных центрах захвата носителей из-за поверхностных дефектов. Более того, процессы изготовления солнечных элементов с наностержнями сложнее, чем у тонкопленочных устройств. Однако преодоление этих проблем, упомянутых выше, привело к почти трехкратному увеличению PCE, как показано Wallentin et al. где матрица наностержней InP имеет PCE 13,8% от оптимизации диаметра наностержня и длины верхнего n-сегмента [54, 63]. Krogstrup et al. указал, что высокая плотность тока короткого замыкания (J sc ) был получен в структурах GaAs с одинарной оболочкой из нанопроволоки за счет поглощения света более чем на один порядок величины, усиленного концентрацией света [64]. Wierer et al. [65], Cansizoglu et al. [66] и Nguyen et al. [31] продемонстрировали различные типы солнечных элементов с матрицами нитридных наностержней на GaN-шаблоне и Si-подложке. Сравнение последних исследований фотовольтаических наностержней / нанопроволок приведено в дополнительной информации:Таблица S1. Однако вклад фотоэлектрического преобразования различных фотоэлектрических устройств из ансамбля наностержней InGaN с различным содержанием In на недорогих подложках Si (111) до сих пор систематически не обсуждался.
В этом исследовании ансамбли наностержней нитрида Mg:GaN / InGaN / Si:GaN III с концентрацией индия 8% и 11% были выращены на подложках Si (111), легированных n-типа, методом плазменной молекулярно-лучевой эпитаксии (PA-MBE, Veeco EPI930). Структурные свойства и содержание индия оценивали с помощью измерений дифракции рентгеновских лучей с высоким разрешением (HR-XRD, Bede D1). Тонкую структуру наностержней анализировали с помощью просвечивающей электронной микроскопии высокого разрешения (HR-TEM, FEI E.O Tecnai F20 G2). Характеристики зависимости плотности тока от напряжения (JV) нитридных солнечных элементов обсуждались при освещении 1 солнцем, AM 1.5G (Newport 94023A). Для изучения спектрального отклика измеряли внешнюю квантовую эффективность (EQE, Enli Technology Co., Ltd., QE-R3018). Для объяснения переноса электронов и дырок были также исследованы выравнивания и моделирование зонной диаграммы.
Экспериментальный метод
Техника роста
Рост наностержней Si:GaN и Mg:GaN / InGaN / Si:GaN основан на методе плазменной молекулярно-лучевой эпитаксии (PA-MBE). Все образцы были выращены с помощью системы Veeco GEN930 PA-MBE, оснащенной источником азотной плазмы 6N (Veeco, UNI-Bulb). Подложка Si (111) n-типа с удельным сопротивлением 0,001–0,005 Ом · см очищалась ацетоном, изопропанолом и деионизированной водой в ультразвуковой ванне в течение 5 минут на каждом этапе для удаления остаточных органических загрязнений, а затем протравливалась в 48–51% HF:H 2 О =1:5 раствор в течение 5 мин для удаления естественного оксида. После процесса химической очистки / травления подложка Si была высушена газообразным азотом. Подложка Si вводилась в буферную камеру, а затем перемещалась в камеру для выращивания с помощью магнитно-связанного передаточного рычага. Перед выращиванием наностержней подложку подвергали термической очистке при 900 ° C в течение 30 мин для удаления остаточного естественного оксида для получения чистой и упорядоченной реконструированной поверхности Si размером 7 × 7. Активированные атомы азота генерировались плазменной пушкой, а их поток и чистота контролировались с помощью контроллера массового расхода с высоким разрешением (HORIBA STEC, SEC-7320 M) и очистителя азота (Entegris, CE35KFI4R). Источники Ga, In, Si и Mg высокой чистоты (6N или выше) обеспечивались эффузионными ячейками с твердым источником. Металл III группы и N 2 Эквивалентное давление пучка плазмы (ЭДП) измерялось с помощью измерителя потока пучка. Путем управления отношениями потока III / V к состоянию с высоким содержанием азота могут быть получены наностержни. Сначала были выращены самоорганизованные наностержни Si:GaN при 760 ° C в течение 82 мин. Десорбция InN имеет решающее значение при повышенных температурах, поскольку индий будет испаряться с поверхности образца. Для удержания индия в наностержнях использовалась методика металломодулированной эпитаксии (MME) [67, 68]. MME включает периодическое открытие и закрытие металлических заслонок, чтобы модулировать потоки металла, в то время как N 2 ставня остается открытой. Для настройки концентрации In, два различных времени цикла падения атомов In и Ga на подложку поочередно в течение 20 с / 30 с (образец B) и 30 с / 30 с (образец C) с 50 периодами при 550 ° C. Наконец, слой Mg:GaN был выращен при 600 ° C. Образцы были выращены под давлением 9,25 × 10 −6 активный азотный БЭП с мощностью плазмы 450 Вт, 2,42 × 10 −8 torr в BEP и 1,93 × 10 −8 torr Ga BEP. Кроме того, однослойные наностержни Si:GaN (образец A) также были приготовлены в качестве контролируемой группы при тех же условиях.
Изготовление устройства
После выращивания наностержня процесс изготовления устройства включал следующие этапы. (1) Площадь устройства 350 × 350 мкм 2 меза была определена травлением до Si n-типа тетрафторметаном (CF 4 ) на основе техники реактивного ионного травления (Advanced System Technology, Cirie-200) с использованием фоторезиста (Microchemicals GmbH, AZ1400) в качестве маски. (2) Ультразвуковая ванна с деионизированной водой использовалась для очистки устройства от незакрепленных наностержней, за исключением тех, которые находятся в области мезы. (3) Погрузите образец в (NH 4 ) 2 S при 60 ° C в течение 1 мин для пассивирования поверхности нитрида для подавления естественного оксида и уменьшения безызлучательной рекомбинации [69,70,71,72,73]. (4) Тонкая пленка оксида индия и олова (ITO) толщиной 100 нм была нанесена поверх наностержней в качестве омического прозрачного контакта Mg:GaN путем распыления (Advanced System Technology, Psur-100HB) в сопровождении фотолитографии (M&R Nano Technology , AG350-6B) и отрывной техники. (5) Многослойные сеточные металлические контакты Ti / Al / Ti / Au (20 нм / 300 нм / 20 нм / 50 нм) на пленке ITO и на подложках Si n-типа были изготовлены методом электронно-лучевого испарения (Advanced System Technology , Пева-600Э) методами фотолитографии и отрыва. (6) Все сеточные металлические контакты были отожжены в системе быстрого термического отжига (Advanced System Technology, FA04) в течение 30 с в азоте при 800 ° C для получения омических контактов.
Подготовка образца ТЕА
Для дальнейшего изучения кристаллической структуры отдельные наностержни образцов B и C были экстрагированы обработкой ультразвуком в этаноле. После 30 мин обработки ультразвуком несколько капель раствора этанола наносили на медную сетку (Ted Pella) и этанол выпаривали при комнатной температуре. Перед измерениями образец был запечен при 150 ° C для удаления свободных органических растворителей.
Результаты и обсуждение
Морфологические и структурные свойства
Виды сверху и поперечные сечения изображений, полученных с помощью сканирующей электронной микроскопии (SEM), показаны на рис. 1a – f, иллюстрируя морфологию выращенных наностержней. Слева направо на рис. 1 a – c показано изменение морфологии поверхности Si:GaN (образец A) и Mg:GaN / InGaN / Si:GaN с различным временем цикла падения атомов In / Ga, равным 20 с / 30. с (образец B) и 30 с / 30 с (образец C) во время 50-цикла роста InGaN, соответственно. Диаметр наностержней Si:GaN и Mg:GaN / InGaN / Si:GaN составляет 30–100 нм и 80–150 нм соответственно, а поверхностная плотность составляет ~ 7 × 10 9 см −2 . Изображения поперечного сечения наностержней показаны на рис. 1d – f и показывают, что длина наностержней составляет около 700 нм для образцов от A до C. Показана схематическая структура образцов Mg:GaN / InGaN / Si:GaN. на рис. 1ж.
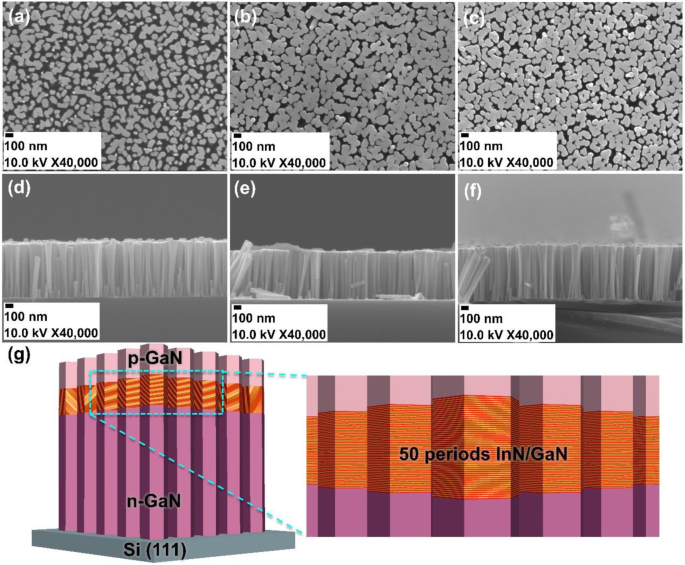
Просмотры a сверху на SEM n-GaN (образец A), p-GaN / InGaN / n-GaN с ударами атомов In и Ga время цикла b 20 с / 30 с (образец B) и c 30 с / 30 с (образец С). Поперечные сечения d на сканирующем электронном микроскопе образец A, e образец B и f образец C. g Принципиальная схема структуры наностержней p-GaN / InGaN / n-GaN
На рис. 2а записано измерение дифракции тета-2тета рентгеновских лучей с фокусировкой на различных образцах времени цикла падения источника. Самый сильный пик, расположенный при 28,44 °, исходит от подложки Si. Острый чистый пик при 34,56 ° соответствует дифракции GaN (0002) и указывает на хорошее ингибирование смешения фаз со слоем InGaN. Пик на нижней 2-тета-стороне пика GaN (0002) при 34,22 ° для образца B и при 34,13 ° для образца C представляет собой InGaN (0002). c постоянные решетки InN и GaN составляют 5,760 Å и 5,185 Å соответственно [74]. Следуя закону Брэгга, c постоянные решетки InGaN (0002) рассчитаны как 5,23 Å для образца B и 5,25 Å для образца C. Импорт c постоянная решетки InGaN (0002) согласно закону Вегарда, концентрация In может быть оценена как 8% для образца B и 11% для образца C без учета деформации. На рис. 2b показано ПЭМ-изображение с малым увеличением образца C и схематическая диаграмма его структуры. Область 1 и область 2 - это области n-GaN и InGaN соответственно. Картина дифракции электронов на селективной области (SAED), полученная в области 1, демонстрирует, что направление [0001] параллельно длинной оси наностержня и общему направлению роста нитридных наностержней. Более того, в кристалле не обнаружено никаких дислокаций. На рис. 2 c и d изображения ПЭМ с атомным разрешением дают c постоянные решетки GaN и InGaN равны 5,19 Å и 5,25 Å соответственно, что совпадает с результатами, рассчитанными по закону Брэгга с помощью тета-2-тета-сканирования XRD. Кроме того, c Постоянная решетки InGaN для образца B составляет 5,23 Å по данным ПЭМ-изображений с атомным разрешением, показанным в дополнительной информации:рисунок S1. Кроме того, в раздел «Дополнительная информация» включены изображения многоугольного кольцевого темного поля (HAADF) и линейное сканирование энергодисперсионной рентгеновской спектроскопии (EDS), показывающие распределение индия.
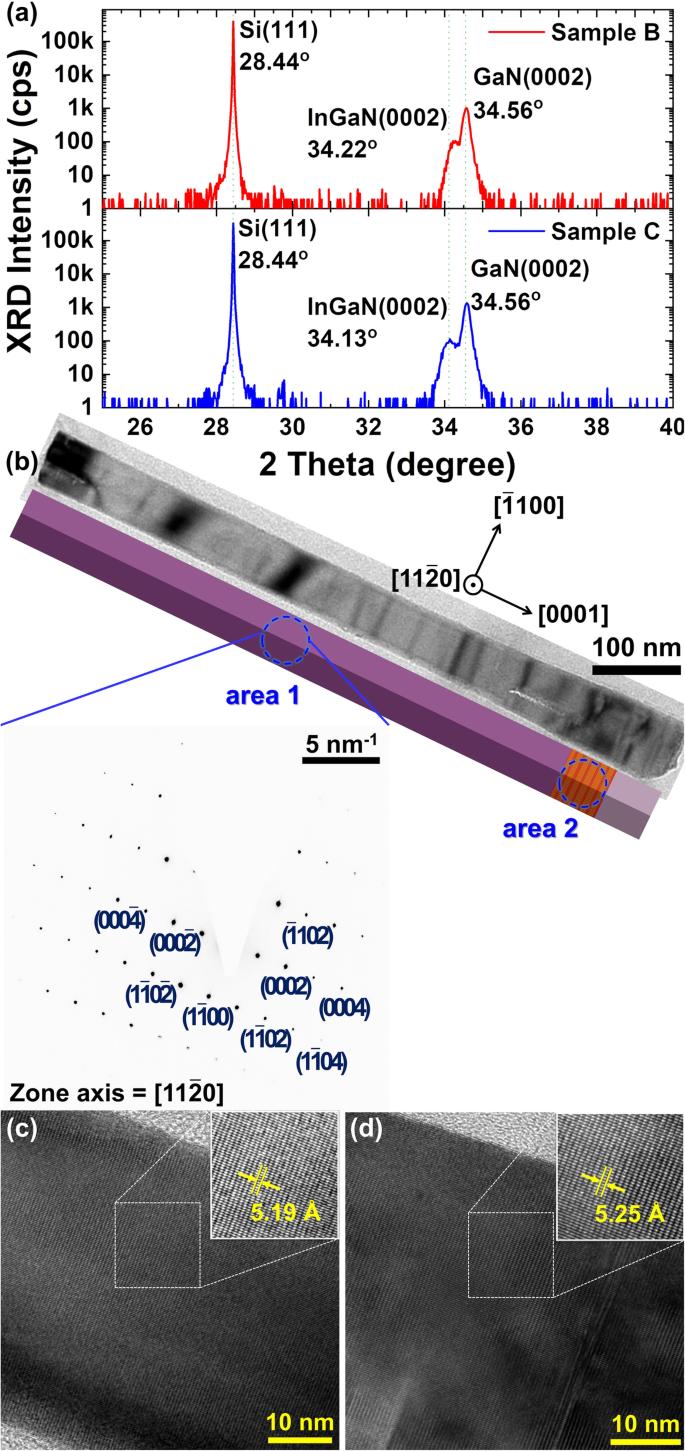
а HR-XRD-спектры тета-2-тета-сканирований. Содержание индия в материале InGaN было оценено как 8% для образца B (красная кривая) и 11% для образца C (синяя кривая) с использованием закона Вегарда. б ПЭМ-изображение бездислокационных нитридных наностержней и SAED-изображение области n-GaN. Схема одиночного наностержня под изображением соответствует структурному относительному масштабу. ПЭМ-изображения c с атомным разрешением n-GaN в области 1 и d InGaN в области 2 показывает отсутствие дислокаций и их c постоянные решетки
Анализ электрических и оптических характеристик
Измерения зависимости плотности тока от напряжения проводились с помощью измерителя источника Keithley 2400. На рисунке 3а показана принципиальная схема солнечного элемента в сборе с наностержнем. Общая площадь устройства 0,12 мм 2 а эффективная площадь под освещением без учета контактного металла - 0,0924 мм 2 . Для сбора генерируемых фотонами электронов на верхнюю часть p-GaN наносится прозрачная проводящая пленка ITO толщиной 100 нм для соединения наностержней и Ti / Al / Ti / Au (20 нм / 300 нм / 20 нм / 50 нм ) пальчиковый электрод. Анализ фотоэлектрических характеристик устройства также проводился с имитатором солнечного излучения под 1 солнцем, состояние AM 1.5G, как показано на рис. 3b – d. Последовательное сопротивление R s значения, определенные на рис. 3b – d, составляют 83 Ом, 250 Ом и 2,5 кОм, а сопротивление шунта R sh значения составляют 413 кОм, 550 кОм и 2 МОм для образцов A, B и C соответственно. Плотность фототока при нулевом напряжении, Дж sc , из In 0,08 Ga 0,92 N устройство (образец B) и In 0.11 Ga 0,89 Устройство N (образец C) составляет 7,77 мА / см 2 и 14,96 мА / см 2 соответственно. Увеличение фототока по сравнению с увеличением концентрации In было продемонстрировано с помощью J sc сравнение. Кроме того, Krogstrup et al. проиллюстрировал, что способность концентрировать свет в солнечных элементах с наностержнями может увеличивать поглощение света и обеспечивать высокий фототок [64]. Напряжение холостого хода (В oc ) и коэффициент заполнения (FF) образца C составляют 0,28 В и 30% соответственно. Несколько групп также продемонстрировали структуры наностержней с более низким V oc [72, 75, 76]. Чтобы выяснить реальные фотоэлектрические характеристики в фактически освещенной области, эффективная площадь PCE, PCE eff , устанавливает эффективность на основе эффективной площади, которая исключает площадь сеточного электрода, в то время как общая площадь PCE, PCE tot , учитывает всю площадь устройства. Примечательно, что PCE tot и PCE eff значения составляют 0,98% и 1,27%, что указывает на более высокий КПД солнечных элементов из нитридных наностержней, о которых когда-либо сообщалось. Основной вклад вносит высокий J sc , хотя V oc ниже, чем у других солнечных элементов с наностержнями III-нитрида [65, 77]. Есть две возможные причины низкого V oc , включая квазиуровень Ферми, ограниченный на p-n-переходе Si, что запрещенная зона Si составляет 1,12 эВ на основе зонной диаграммы, и ограниченный путь тока может быть создан из-за пиннинга уровня Ферми на поверхности [66]. В таблице 1 представлены J sc , V oc , FF и PCE сравнение трех образцов.
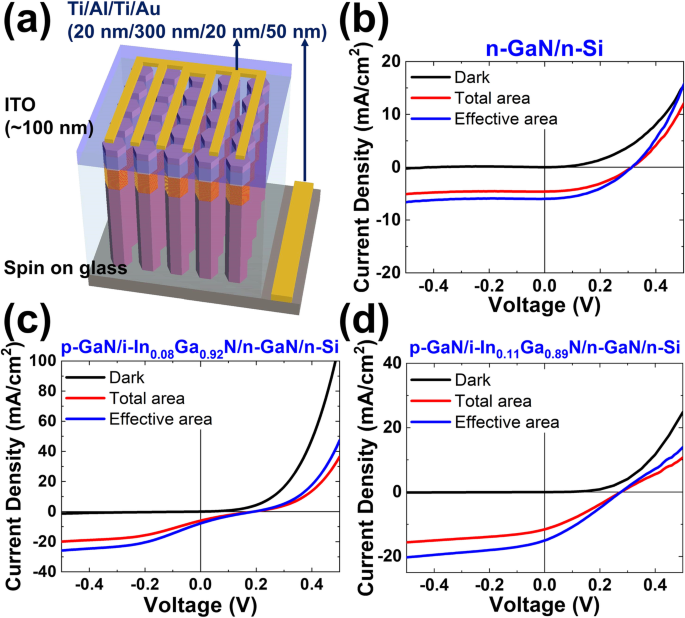
а Принципиальная схема сборки наностержня солнечного элемента. Кривые плотности тока-напряжения b n-GaN / n-Si, c p-GaN / In 0,08 Ga 0,92 N / n-GaN / n-Si и d p-GaN / In 0.11 Ga 0,89 Наностержень N / n-GaN / n-Si собирает солнечные элементы, измеренные под одним солнцем, имитатор солнечной энергии AM 1.5G
Чтобы понять физические и электрические свойства, диаграммы полос рассчитываются с использованием программы 1D-DDCC (One Dimension Poisson, Drift-Diffusion и Schrodinger Solver) [78]. Используемое сродство к электрону ITO, Si и GaN составляет 4,40 эВ, 4,05 эВ и 4,1 эВ соответственно. На рис. 4 a и b показаны зонная диаграмма ITO / n-GaN / n-Si без напряжения смещения и кривая J-V в темноте соответственно. Это показывает, что структура ITO / n-GaN / n-Si не обладает выпрямляющим эффектом и показывает линейный профиль J-V. Потенциальным барьером гетерограницы для переноса носителей можно пренебречь, поскольку ожидается, что смещение зоны проводимости между Si и GaN будет небольшим, равным 50 мэВ. Эта линейная J-V кривая, подобная резистору, противоречит экспериментальным результатам.

а Зонная диаграмма ITO / n-GaN / n-Si, b Кривая J-V для ITO / n-GaN / n-Si, c Зонная диаграмма ITO / n-GaN / p-Si / n-Si и d J-V кривые ITO / n-GaN / p-Si / n-Si, смоделированные с помощью программы 1D-DDCC
Возможное объяснение результатов кривой J-V заключается в том, что диффузия Ga индуцирует p-Si на границе GaN / Si и создает p-n-переход. Reichertz et al. [14] и Неплох и др. [76] подтвердили диффузию Al в кремниевую подложку во время роста нитридных слоев. Бор, Al и Ga являются элементами группы IIIB, которые могут быть легирующими добавками для образования слоя p-Si. Однако скорость диффузии Ga составляет 8 нм / сут при 700 ° C [79]. На рисунке 4c показана зонная диаграмма, которая включает очень тонкий (1 нм) слой p-Si между границей раздела n-GaN и n-Si. Небольшое встроенное электрическое поле создается в p-n-Si переходе, которое может направлять электроны к подложке n-Si, а дырки - к контактному слою ITO. Кривые J-V в зависимости от толщины демонстрируют, что напряжение включения диода уменьшается, когда толщина слоев p-Si становится меньше на рис. 4d. Ультратонкий p-Si будет ограничением для разделения квази-уровней Ферми и уменьшит V oc солнечной энергии. Смоделированные электрические свойства с включенным слоем p-Si ближе к этому результату исследования. Следовательно, зонная диаграмма структуры Mg:GaN / InGaN / Si:GaN / p-Si / n-Si может быть построена в качестве модели, как на рис. 5. Освещение AM 1.5G света сверху приводит к поглощению фотоны с энергией выше запрещенной зоны InGaN. Когда свет попадает на Si через стержни и промежуток между стержнями, фотоны с энергией, превышающей ширину запрещенной зоны Si, также могут поглощаться подложкой p-n Si, и возникает фототок. Одновременно электронно-дырочные пары, генерируемые коротковолновым светом в нитридных областях, разделяются встроенным электрическим полем p-i-n-перехода. В конце концов, фотогенерированные носители могут быть собраны через верхний контакт оксида индия и олова (ITO) с Mg:GaN и нижний Si n-контакт. На основе этой структурной модели и с учетом барьера Шоттки, создаваемого контактом ITO, симуляция кривой J-V показана на рис. 5b. Смоделированная кривая J-V показывает, что S-образная форма вызвана неомическим поведением p-контакта. Это возможная причина для объяснения существования S-образной формы для Mg:GaN / u-InGaN / Si:GaN (образцы B и C) на рис. 3 c и d. Следовательно, плотности тока при отрицательном смещении (J отрицательное смещение (- 0,5 В) ), где S-образная форма сплющена, указаны в таблице S2. J отрицательное смещение может быть контрольной точкой для дальнейшей оптимизации и целевого значения.
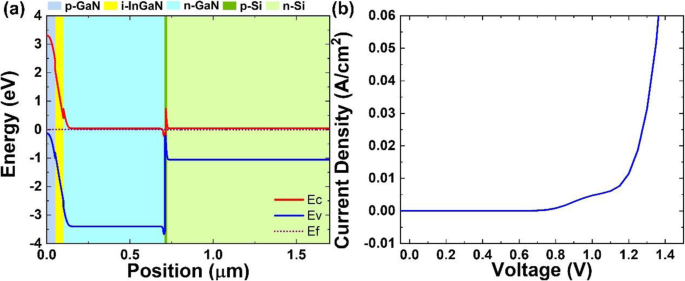
а Наностержень p-i-n-нитрида на диаграмме полосы солнечного элемента p-n-Si, смоделированной программой 1D-DDCC. б Моделирование кривой J-V наностержня p-i-n нитрида на солнечном элементе p-n Si
Результаты измерения EQE без смещения света (дополнительный немодулированный свет) показаны на рис. 6a, на котором сравниваются EQE для Si:GaN / n:Si (образец A), Mg:GaN / u-In 0,08 Ga 0,92 N / Si:GaN (образец B) и Mg:GaN / u-In 0,11 Ga 0,89 N / Si:GaN (образец С). Образец C имеет более высокую концентрацию In, что может быть причиной более высоких значений на короткой длине волны из-за поглощения в слое InGaN. Максимальные EQE в выборках A, B и C составляют 32%, 55% и 63% соответственно. По сравнению со спектрами отражения кремниевой пластины, образцы A, B и C, показанные на рис. 6b, колебания EQE и спектров отражения обусловлены интерференцией от разных слоев. Пластина Si без покрытия имеет самый высокий коэффициент отражения благодаря своей плоской поверхности. Образцы A, B и C имеют более низкий коэффициент отражения, поскольку наностержневые структуры обладают эффектом захвата света. Обнаружено, что образец C имеет самый высокий EQE на длинных волнах и самый низкий коэффициент отражения из-за самого высокого эффекта улавливания света. Этот результат может объяснить более высокий фототок, генерируемый в образце C. Спектры фотолюминесценции (PL) образца B и образца C при комнатной температуре (RT, 300 K) показаны на рис. 6c. Самый высокий пик, расположенный при 3,40 эВ, - это излучение GaN у края зоны (NBE). Пики, расположенные при 3,09 эВ и 3,03 эВ, связаны с In 0,08 Ga 0,92 N и In 0.11 Ga 0,89 N Эмиссия NBE. Результаты аналогичны значениям из расчета уравнения изгиба для 3,1 эВ и 3,0 эВ при RT [4]. Он также показывает такие же сильные колебания Фабри-Перо (отмечены звездочками), что и EQE и спектры отражения, представляющие гладкие границы раздела между каждым слоем / поверхностью.

а Спектры внешней квантовой эффективности трех образцов нитридных наностержней / Si. б Спектры отражения голой пластины Si и трех образцов нитридных наностержней / Si. c Спектры фотолюминесценции двух образцов InGaN при комнатной температуре
Заключение
Успешно продемонстрированы высококачественные наностержни Mg:GaN / InGaN / Si:GaN и Si:GaN, выращенные на n-Si с помощью плазменной молекулярно-лучевой эпитаксии. Фотоэлектрические измерения показывают PCE eff 1,27% и PCE tot 0,98% при 1 солнце, освещенность AM 1,5G для Mg:GaN / u-In 0,11 Ga 0,89 N / Si:GaN, который имеет более высокую концентрацию In и более сильный эффект захвата света, вызывающий высокий фототок. Хотя наностержни Si:GaN на устройстве n-Si могут не иметь заметного встроенного поля p-n-перехода, конструкция правильной структуры гетероперехода помогает направлять фотоносители к верхним и нижним контактам и повышает производительность ячейки.
Доступность данных и материалов
Авторы заявляют, что материалы и данные доступны читателям, и все выводы, сделанные в этой рукописи, основаны на данных, которые все представлены и показаны в этой статье.
Сокращения
- Светодиод:
-
Светодиод
- PCE:
-
Эффективность преобразования энергии
- J sc :
-
Плотность тока короткого замыкания
- PA-MBE:
-
Плазменная молекулярно-лучевая эпитаксия
- HR-XRD:
-
Дифракция рентгеновских лучей высокого разрешения
- HR-TEM:
-
Просвечивающая электронная микроскопия высокого разрешения
- EQE:
-
Внешняя квантовая эффективность
- BEP:
-
Эквивалентное давление пучка
- MME:
-
Эпитаксия с металлической модуляцией
- ITO:
-
Оксид индия и олова
- V oc :
-
Напряжение холостого хода
- RT:
-
Комнатная температура
- PL:
-
Фотолюминесценция
- NBE:
-
Ближний край полосы
Наноматериалы
- Солнечный элемент
- Нанодеревья для сенсибилизированных красителем солнечных элементов
- Высокоэффективные графеновые солнечные элементы
- Нано-гетеропереходы для солнечных элементов
- Фотоэлектрические характеристики устройств с гетеропереходом GaSe / MoSe2
- Плазмонно-усиленное поглощение света в (p-i-n) переходных GaAs-нанопроводных солнечных элементах:исследование ме…
- Краткий отчет о достижениях высокоэффективных перовскитных солнечных элементов
- Высокопроводящий слой PEDOT:PSS Transparent Hole Transport Layer с обработкой растворителем для высокоэффективных кремниевых /…
- Электроосаждение SnO2 на FTO и его применение в перовскитных солнечных элементах с планарным гетеропереходом в …
- Вольфрам



