Низковольтный рабочий 2D-сегнетоэлектрический транзистор памяти MoS2 со структурой затвора Hf1-xZrxO2
Аннотация
Сегнетоэлектрический полевой транзистор (FeFET) стал интересной технологией энергонезависимой памяти из-за его многообещающей скорости работы и долговечности. Однако для изменения поляризации требуется более высокое напряжение по сравнению с напряжением чтения, что снижает энергопотребление при записи ячейки. Здесь мы сообщаем о CMOS-совместимом элементе FeFET с низким рабочим напряжением. Проектируем сегнетоэлектрик Hf 1-x Zr x О 2 (HZO) тонкая пленка для формирования диэлектриков затвора с отрицательной емкостью (NC), которая генерирует петлю гистерезиса против часовой стрелки в области поляризации в многослойном дисульфиде молибдена (MoS 2 ) FeFET. Нестабилизированный отрицательный конденсатор по своей природе поддерживает субтермионную скорость качания и, таким образом, позволяет переключать сегнетоэлектрическую поляризацию с окном гистерезиса, намного меньшим, чем половина рабочего напряжения. FeFET показывает высокий коэффициент включения / выключения, превышающий 10 7 . и окно памяти (MW) против часовой стрелки на 0,1 В при минимальном напряжении программы (P) / стирания (E) 3 В. Надежная выносливость (10 3 циклов) и удержания (10 4 s) свойства также демонстрируются. Наши результаты показывают, что HZO / MoS 2 сегнетоэлектрический транзистор памяти может открыть новые возможности в приложениях энергонезависимой памяти с масштабируемым размером и напряжением.
Фон
Рынок встроенной памяти системы на кристалле (SoC) в настоящее время переживает эпоху стремительного роста, который требует, чтобы память была способна обеспечивать более быструю работу, меньший размер ячеек и меньшее энергопотребление [1,2,3,4,5,6 ]. Сегнетоэлектрическая память, один из наиболее многообещающих кандидатов, была пересмотрена в связи с открытием сегнетоэлектрического оксида гафния в 2011 году [7].
В последние десятилетия FeFET не показал хороших результатов во всех этих аспектах, включая требования к низкому напряжению для работы памяти, простоту этапа процесса и минимально комплементарный процесс интеграции металл-оксид-полупроводник (CMOS) и ограниченные проблемы загрязнения [8,9,10, 11]. Чтобы решить эту проблему, недавно было проведено огромное исследование энергонезависимой памяти (NVM) 2D FeFET на основе различных сегнетоэлектрических материалов, включая PbZrTiO 3 (PZT) и [P (VDF-TrFE)] полимер [12,13,14,15,16,17,18], что связано с многообещающими свойствами 2D-материала в «более чем эпоху Мура». В FeFET два стабильных состояния спонтанной поляризации сегнетоэлектрического материала, включенного в стопку затвора транзистора, используются для хранения данных через контролируемое пороговое напряжение, обеспечиваемое приложенными уменьшенными напряжениями затвора P / E. Сообщается, что воспроизводимое поведение гистерезиса, высокое отношение включения / выключения 10 4 , хорошие удерживающие свойства до 10 4 s, и стабильная работа переключения была достигнута в PZT / MoS 2 FeFET [19]. Примечательно, что максимальная подвижность 625 см 2 / В ∙ с, большой МВт 16 В для диапазона напряжения затвора ± 26 В и высокое соотношение включения / выключения 8 × 10 5 были также продемонстрированы полимером n-типа [P (VDF-TrFE)] / MoS 2 FeFET [15]. Однако существует так много фундаментальных проблем, которые могут помешать его практическому применению, например, совместимость с CMOS, возможность масштабирования и состояния интерфейса между Fe и 2D-материалом. Сегнетоэлектрический оксид гафния, разновидность нового сегнетоэлектрического материала, обладает отличной совместимостью с КМОП и возможностью масштабирования, что может послужить для усовершенствованного FeFET NVM на технологическом узле менее 5 нм в следующие 5-10 лет [20]. Соответственно, партия HfO 2 Диэлектрические стеки на основе диэлектриков были включены в 2D FeFET, которые предназначены для создания полевых транзисторов с отрицательной емкостью (NCFET) с крутым переключением ВКЛ / ВЫКЛ через наклон менее 60 мВ / декаду и характеристики без гистерезиса [21,22,23 , 24,25,26]. Хотя массовые эксперименты, основанные на диэлектрическом пакете NC с альтернативными материалами каналов 2D, привели к фантастическим выводам, они выдвинули на первый план требования к выбросам, чтобы различать NCFET и FeFET. По-прежнему отсутствуют систематические исследования, касающиеся физики и жизнеспособности технологии устройства на однотранзисторной сегнетоэлектрической памяти на основе MoS 2 . и сегнетоэлектрик HZO.
В этой работе FeFET с многослойным HZO MoS 2 транзистор был предложен. Он способен масштабировать напряжение P / E с помощью NC-эффекта, вызванного конструкцией стека затвора, при уменьшенном напряжении P / E. Мы экспериментально продемонстрировали, что в HZO MoS 2 была достигнута МВт против часовой стрелки, равная 0,1 В с наклоном менее 60 мВ / декада. FeFET, что можно объяснить модуляцией локальной плотности носителей в 2D-канале за счет быстрого переворота сегнетоэлектрического диполя. Мы объяснили пониженный гистерезис HZO / MoS 2 FeFET по мере увеличения напряжения стока до эффекта отрицательного снижения барьера, вызванного стоком (DIBL). Кроме того, систематически изучались характеристики удерживания, выносливости и зависимость порогового напряжения от напряжения стока HZO MoS 2 FeFET, открывающий реальный путь к разработке HZO MoS 2 FeFET NVM и его практическое применение.
Методы
6 нм Hf 1-x Zr x О 2 пленка и 2 нм Al 2 О 3 был депонирован на p + Подложка Si с использованием ALD при 300 ° C, с [(CH 3 ) 2 N] 4 Hf (TDMAHf), [(CH 3 ) 2 N] 4 Zr (TDMAZr) и H 2 Пары O в качестве прекурсора Hf, прекурсора Zr и прекурсора окислителя соответственно. Затем подложка прошла быстрый термический отжиг (RTA) при 450 ° C в течение 30 с в N 2 окружающий. После этого многослойный MoS 2 хлопья механически отслаивались и переносились на подложку. Диаметр p + Подложка Si, используемая для нанесения HZO (6 нм) / AI 2 О 3 (2 нм) составляет 6 дюймов. Мы использовали электронно-лучевую литографию (EBL) для создания рисунка контактных площадок из полиметилметакрилатного (PMMA) резиста A5. Параметры вращения, параметры выпечки и параметры визуализации:500 об / мин (9 с) + 4000 об / мин (40 с), 170 ° C (5 мин), MIBK:IPA =1:3 (15 с) соответственно. . Затем электроды истока / стока (Ti / Au, толщина 5/65 нм) были испарены с использованием системы электронно-лучевого испарения (EBE) и протравлены раствором ацетона. После отрыва устройство отжигали при 300 ° C в течение 2 ч для улучшения контакта. Мы провели определение электрических характеристик изготовленного нами MoS 2 / HZO Полевые транзисторы с использованием пробной станции с микроманипулятором. Напряжение заднего затвора ( В GS ) наносился на сильно легированную подложку Si p-типа. Система определения характеристик полупроводников (КПК) использовалась для измерения напряжения исток-сток ( В DS ), напряжение на заднем затворе ( В GS ), и ток исток-сток ( I DS ).
Результаты и обсуждение
Мы подготовили многослойный MoS 2 путем механического расслоения объемного кристалла и перенесенного MoS 2 нанофлейка на 2 нм Al 2 О 3 / 6 нм HZO / p + Подложка Si (подробнее см. В разделе «Экспериментальная часть»). На рисунках 1a и b показаны схематический трехмерный вид и поперечное сечение HZO / MoS 2 . Структура FeFET соответственно. Изображение HZO / MoS 2 , полученное с помощью сканирующей электронной микроскопии (СЭМ), вид сверху. FeFET показан на рис. 1c. Ширина и длина MoS 2 канал имеют размер 2 мкм и 12 мкм соответственно. Как показано на рис. 1d, толщина MoS 2 канал был подтвержден с помощью атомно-силовой микроскопии (АСМ). Измеренная толщина 1,57 нм указывает на наличие 4-х слоев MoS 2 . [26].
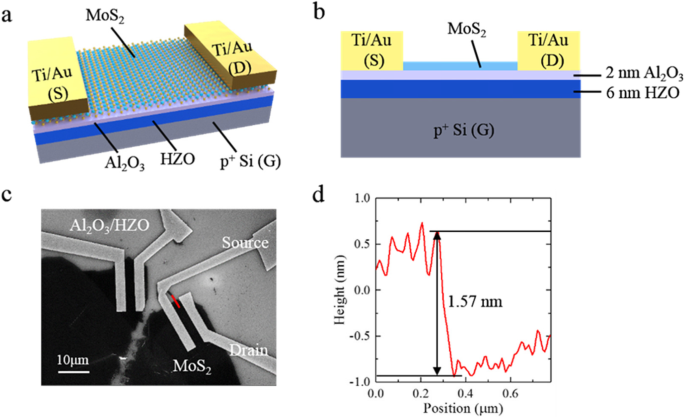
Структура устройства и основные свойства MoS 2 / HZO FeFET. а Трехмерное схематическое изображение MoS 2 / HZO FeFET. б Схематический разрез MoS 2 / HZO FeFET. c СЭМ изображение изготовленного MoS 2 , вид сверху / HZO FeFET с Ti / Au электродами истока / стока, сегнетоэлектрическими изоляторами затвора HZO и MoS 2 каналы. г Профиль по высоте с использованием АСМ в контактном режиме по красной линии на c , проверяя высоту MoS 2 канал.
Как показано на рис. S1c и d, элементный и связующий состав HZO исследовали с помощью рентгеновских фотоэлектронных (XPS) измерений. Пики составили 19,05 эВ, 17,6 эВ, 185,5 эВ и 183,2 эВ, что соответствует Hf 4f 5/2 , Hf 4f 7/2 , Zr 3d 3/2 , и Zr 3d 5/2 соответственно [27]. Концентрация атомов вдоль профиля глубины на рис. S1e дополнительно подтверждает распределение Al 2 О 3 / HZO / p + Трехслойная структура Si. Все вышеизложенное подтверждает, что пленка HZO, выращенная с помощью нашей системы атомно-слоистого осаждения (ALD), является высококристаллической.
Перед исследованием характеристик HZO / MoS 2 FeFET, сегнетоэлектрическое поведение Au / 2 нм Al 2 О 3 / 6 нм HZO / p + Пакет кремниевых затворов с использованием измерения поляризационного напряжения показан на рис. 2а. Очевидно, что наши изготовленные нами 6 нм HZO / 2 нм Al 2 О 3 конденсаторы демонстрируют петли гистерезиса поляризации-напряжения (измеренные при 1 кГц). Между тем, остаточная поляризация P r и коэрцитивное напряжение В c увеличиваются с увеличением максимального напряжения качания, подразумевая P-V Петли гистерезиса преобразуются из второстепенного цикла в главный. Когда максимальное напряжение качания увеличивается с 2 до 4 В, P r достигает 0,66 мкКл / см 2 , 0,86 мкКл / см 2 , и 1,1 мкКл / см 2 соответственно и V c достигает 1,12 В, 1,9 В и 2,04 В соответственно. Извлечено P r и V c в пределах 10 5 длительные циклы развертки постоянного тока показаны на рис. 2b и c. Очевидно, значительный эффект пробуждения и усталости в пределах 10 5 циклы наблюдаются в 6 нм HZO / 2 нм Al 2 О 3 конденсатор. Пробуждение и усталость можно объяснить диффузией и перераспределением кислородных вакансий под действием электрического поля. Эффект усталости обычно связан с захватом заряда на дефектах, связанных с кислородными вакансиями [28]. Поведение гистерезиса для фазы PR и петля в форме бабочки для PRampl с использованием силовой микроскопии пьезоотклика (PFM) показаны на рис. S1b и c, указывая на переключение поляризации как функцию напряжения смещения развертки. Учитывая различное контактное сопротивление между измерением напряжения поляризации и измерением напряжения пьезоотклика, измеренное V c на рис. S1b и c не очень согласуется со значениями, полученными на рис. 2a.

а Петли гистерезиса P-V для HZO (6 нм) / Al 2 О 3 (2 нм) конденсатор с различными диапазонами качания напряжения. Зависимость ( b ) P r и c V c при циклировании для HZO (6 нм) / Al 2 О 3 Конденсатор (2 нм) с циклическим изменением ± 4 В / 1 кГц
Кроме того, наблюдается увеличение MW, сопровождаемое повышенным диапазоном качающегося напряжения затвора ( V GS, диапазон ). Обычно поликристаллическая пленка HZO существует как многодоменная [29], и распределение коэрцитивного поля этих доменов удовлетворяет распределению Гаусса. Таким образом, должна быть повышенная зависимость от повышенного V GS, диапазон . Принудительное поле E C соответствует величине внешнего электрического поля, которое может уменьшить остаточную поляризацию до нуля. Следовательно, V GS , диапазон используется для переключения поляризации в пленке HZO, становится больше с более высоким соответствующим коэрцитивным напряжением V C . Это причина того, почему петли поляризационного напряжения пленки HZO удлиняются при увеличении V GS, диапазон , что продемонстрировано на рис. 2а. Другими словами, повышенная интенсивность поляризации и сегнетоэлектрическое переключение происходят при повышенном V GS, диапазон , что приводит к вышеупомянутому явлению расширенного против часовой стрелки MW, создаваемого увеличенным V GS, диапазон . В V GS, диапазон =(−2, 2 В), МВ почти исчезают и появляются почти безгистерезисные характеристики, что означает почти полную компенсацию между эффектами сегнетоэлектрического переключения и захвата / освобождения заряда.
Для дальнейшего изучения эффекта сегнетоэлектрического переключения, V GS, диапазон постоянно увеличивается до (−6, 6 В) и (−6,5, 6,5 В). Измеренный I DS - V GS кривые HZO MoS 2 FeFET при V GS, диапазон =(−6, 6 В) и (−6,5, 6,5 В) показаны на рис. 3а. Точно так же окно памяти против часовой стрелки увеличивается с расширенным V GS, диапазон . В V GS, диапазон =(−6,5, 6,5 В), MW против часовой стрелки выше 4 В, а коэффициент включения / выключения также увеличивается до 10 7 , что связано с усилением переключения поляризации при увеличении внешнего приложенного напряжения. Как правило, механизм, лежащий в основе поведения гистерезиса, показанный на I DS - V GS кривые во время двунаправленной развертки V GS это сдвиг порогового напряжения, который может быть изменен преобладающими эффектами переключения поляризации, то есть NC-эффектом [30,31,32], приводящим к гистерезису против часовой стрелки. Дальнейшее исследование улучшенных подпороговых характеристик было проведено на другом устройстве при уменьшенном V GS, диапазон . Измеренный I DS - V GS и извлеченная точка SS— I DS кривые другого устройства при V GS, диапазон =(−3, 3 В) показаны на рис. 3б. Показано, что при V GS, диапазон =(−3, 3 В), HZO / MoS 2 FeFET демонстрирует SS For =51,2 мВ / декада и СС Rev =66,5 мВ / декада соответственно. Другими словами, SS менее 60 мВ / декаду и МВт 0,48 В могут быть одновременно достигнуты в HZO / MoS 2 FeFET при комнатной температуре, что поможет отличить NCFET от FeFET.
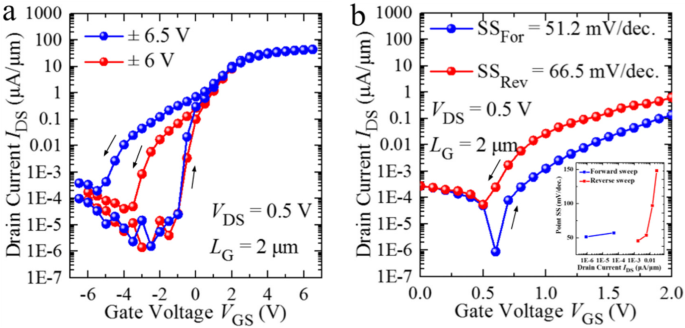
Испытание постоянным током HZO / MoS 2 FeFET при напряжении стока ( В DS ) составляет 0,5 В. a Сравнение передаточных кривых при максимальном напряжении на затворе 6 В и 6,5 В. б Увеличенный вид передаточных кривых при интервале от 0 до -2 В для V GS, диапазон =(−3, 3 В). Наклон подпороговой точки (SS) как функция тока стока ( I DS ) HZO / MoS 2 FeFET равен ( b ) вставка. Устройство выставляет СС Для =51,2 мВ / дек
Как известно, в NCFET SS может быть меньше 60 мВ / декаду при комнатной температуре из-за включения отрицательной диэлектрической емкости затвора ( C ins ), который можно получить через отрезок отрицательного наклона d P / d E <0, индуцированное сегнетоэлектрической пленкой, вносящее вклад в фактор стека затвора (m) <1. Механизм, лежащий в основе NC-эффекта [33], - это поле деполяризации, создаваемое сегнетоэлектрической пленкой [34,35,36,37,38]. Экспериментально сообщается, что из-за неполного экранирования на границе раздела сегнетоэлектрической пленки [39] остаточный поляризационный заряд может создавать внутреннее электрическое поле на сегнетоэлектрической пленке, которое имеет направление, противоположное приложенному извне напряжению, что приводит к повторному возникновению электрического поля. распределение напряжения между стеком затворов и усиленного поверхностного потенциала канала, названное «эффектом усиления напряжения» [40,41,42]. Усиление напряжения обычно можно разделить на две части:ускоренное изменение поверхностного потенциала канала и последующее повышенное значение, обеспечивающее резкое переключение ВКЛ / ВЫКЛ и улучшенное I ВКЛ / Я ВЫКЛ , соответственно. Однако для FeFET есть другая история. Согласно концепции согласования емкости сегнетоэлектрической емкости ( C FE ) и емкости металл-оксид-полупроводник ( C MOS ) [43,44,45], когда | C FE |> C MOS , теоретическая полная емкость ( C всего ) положительна, и система стабильна, что приводит к тому же поведению поляризации во время двунаправленной развертки V GS и стабильный NCFET без гистерезиса. Однако очень сложно добиться хорошего согласования, приводящего к улучшению SS и крутизны, поскольку оба C MOS и C FE являются очень нелинейными конденсаторами, зависящими от смещения. Кроме того, | C FE |> C MOS необходимо обеспечить для всего диапазона рабочего напряжения, чтобы избежать гистерезиса. Вместо этого один раз | C FE | < C MOS , теоретический C всего отрицательный, и система нестабильна, во время двойного переключения V должно происходить разделенное поляризационное поведение. GS чтобы сохранить C всего положительный, что может привести к гистерезису против часовой стрелки в FeFET для приложения NVM. Здесь упоминается, что гистерезисное поведение является последующим эффектом раздельного переключения поляризации, что означает, что ширину окна гистерезиса можно легко изменить на основе концепции согласования емкости, например, которой можно манипулировать путем изменения <я> V DS . При соответствующем согласовании емкости, даже при сильно уменьшенном V GS, диапазон =(−3, 3 В), HZO / MoS 2 FeFET по-прежнему демонстрирует очевидное окно гистерезиса и резкое переключение SS For =51,2 мВ / дек одновременно, что дополнительно свидетельствует о существовании NC-эффекта (эффекта сегнетоэлектрической поляризации) и в подпороговой области. Несмотря на то, что NCFET и FeFET отличаются, FeFET также можно использовать в качестве логических устройств с сопоставимой меньшей MW, поддерживающей глубину SS менее 60 мВ / дек и более высокое значение I . ВКЛ / Я ВЫКЛ соотношение также из-за эффекта NC.
Влияние V DS на ширину МВ был тщательно исследован. Я DS - V GS кривые в логарифмических масштабах при различных V DS охарактеризованы на рис. S3. Показано, что при фиксированном V GS, диапазон =(−2, 2 В), значения V GS извлечено в I DS =70 нА для двунаправленной развертки V GS все смещаются в отрицательную сторону. Между тем, также продемонстрировано, что изменение прямой стреловидности V GS намного более очевидна, чем обратная развертка, что указывает на значительные явления отрицательного DIBL. Следует отметить, что отрицательный эффект DIBL всегда возникает с эффектом NC [46, 47].
После вышеуказанного испытания постоянным током (DC) HZO / MoS 2 FeFET, мы дополнительно провели измерения MW для различных P / E V GS импульсы длительностью 10 мс на рис. 4а. MW определяется как максимальное изменение Δ V TH после P / E V GS импульсы. Во время импульсного V GS приложение, остальные терминалы были зафиксированы на V S = V D =0 В. Для операции чтения (R) V GS изменялся от -1 В до 1 В с V D =0,5 В и В S =0 В. Как показано на рис. 4a, извлеченные МВ становятся больше, чем P / E V GS импульсы увеличиваются. Когда наложенные P / E V GS импульс составляет ± 3 В, извлеченная МВ составляет 0,1 В. Когда заданное значение P / E V GS импульс составляет ± 5,5 В, извлеченная МВ составляет 0,275 В. По сравнению с МВ при 4 В и 0,48 В против часовой стрелки на рис. 3a и b, выделенные МВ после P / E V GS пульс сильно снижен. Возможно, это связано с более высокой плотностью состояний захвата, вызванной высокой влажностью воздуха [48]. Таким образом, механизм улавливания / снятия заряда усиливается, и петля гистерезиса против часовой стрелки в конечном итоге уменьшается. Кроме того, мы изучили выносливость при езде на велосипеде и сохранение данных HZO / MoS 2 FeFET под действием импульсов P / E с высотой ± 5,5 В на рис. 4b. Программа V GS импульс был шириной 10 мс с V S = V D =0 В. На рис. 4b показаны измеренные значения MW как функция длительности циклов. Цикл износостойкости формируется периодическими импульсами P / R / E / R напряжения на обратном затворе. Напряжения, приложенные к заднему затвору высотой P, E, R, составляли + 5,5 В, -5,5 В и 0 В соответственно. А ширина импульса P и E составляла 10 мс. Ясно, что МВт 0,3 В может поддерживаться без значительного ухудшения после 10 3 Циклы P / E. По мере увеличения количества циклов износостойкости MW увеличивается до 0,38 В после 10 циклов, а затем снова уменьшается до 0,28 В после 600 циклов. Первое увеличение MW называется эффектом пробуждения, а более позднее уменьшение MW называется эффектом усталости. Эффект пробуждения соответствует расщеплению доменных стенок, что приводит к увеличению переключаемых доменов поляризации пленки HZO [49]. Эффект усталости соответствует вновь введенным зарядам, которые прикрепляют к доменным стенкам после большого количества циклов P / E [50]. Сохранение данных при комнатной температуре показано на рис. 4c. Здесь снижение молекулярной массы незначительно после 10 4 с. Следовательно, согласно пунктирным линиям экстраполяции, можно ожидать, что МВт около 0,3 В будет устойчивым в течение 10 лет. Как показано на рис. 4d, устройство стабильно после 10 3 циклически под действием импульсов P / E с высотой ± 3 В. Стабильность HZO / MoS 2 FeFET открывает широкие возможности для применения в технологии энергонезависимой памяти.

Характеристики памяти HZO / MoS 2 FeFET при импульсах P / E. а Извлеченные МВ (МВ) при импульсах P / E с высотой ± 3 В, ± 4 В, ± 5 В, ± 5,5 В и ± 6 В. б Измерения выносливости в условиях импульса P / E. c Удерживающая характеристика HZO / MoS 2 FeFET. г Выносливость HZO / MoS 2 FeFET на 10 3 циклы под импульсами P / E с высотой ± 3 В
Сравнение добротности с устройствами на основе FeFET, сочетающими MoS 2 и сегнетоэлектрические диэлектрики затвора представлены в таблице 1. Здесь перечислены структура устройства, остаточная поляризация, коэрцитивное электрическое поле, направление петли гистерезиса, МВт, рабочее напряжение, циклы износостойкости и время удерживания. Очевидно, что изготовленное нами устройство демонстрирует самый тонкий сегнетоэлектрический слой толщиной 6 нм HZO и самое низкое рабочее напряжение по сравнению с другими работами [12,13,14,15,16,17,18], что важно для будущего 2 нм. или 3-нм технологический узел внутренней памяти (BEOL). Путем масштабирования толщины сегнетоэлектрического слоя была достигнута молекулярная масса около 0,1 В при низком рабочем напряжении ± 3 В. Такое низкое рабочее напряжение можно объяснить характеристиками, присущими слою HZO по сравнению с его аналогами, такими как P (VDF-TrFE) или HfO 2 , который имеет гораздо большую толщину. Кроме того, наше устройство имеет более низкую остаточную поляризацию P r 1,1 мкКл / см 2 по сравнению с другими описанными FeFET. Быстрое уменьшение удерживающих потерь в FeFET связано с наличием поля деполяризации E dep , что происходит из-за неполной компенсации заряда из-за существования Al 2 О 3 слой. Здесь E dep прямо пропорциональна остаточной поляризации P r [51]. Таким образом, высокий E c и низкий P r сделать соотношение E dep / E c в MoS 2 / HZO FeFET очень мал, что приводит к очень малым потерям удержания, связанным с эффектом поля деполяризации. Хотя показатели удержания MoS 2 FeFET на основе HZO и P (VDF-TrFE) имеют размер около 10 4 s, пленка P (VDF-TrFE) должна иметь толщину 150 нм [17].
Выводы
В заключение мы исследовали многослойный MoS 2 устройства на основе сегнетоэлектрических транзисторов памяти с использованием диэлектрика с задним затвором HZO. Изготовленные нами устройства демонстрируют гистерезис против часовой стрелки, вызванный сегнетоэлектрической поляризацией. Кроме того, наш HZO / MoS 2 сегнетоэлектрический транзистор памяти продемонстрировал отличные характеристики устройства:высокий коэффициент включения / выключения более 10 7 и против часовой стрелки MW 0,1 В при напряжении P / E 3 В, который имеет срок службы (10 3 циклов) и удержания (10 4 у) производительность. Таким образом, мы считаем, что результаты нашего MoS 2 Энергонезависимые сегнетоэлектрические транзисторы памяти на основе энергонезависимой памяти открывают многообещающие перспективы для будущих приложений маломощной энергонезависимой памяти 2D.
Доступность данных и материалов
Авторы заявляют, что материалы, данные и соответствующие протоколы доступны читателям, и все данные, использованные для анализа, включены в эту статью.
Наноматериалы
- Рейтинги и комплектации транзисторов (BJT)
- Некоторые примеры цепей переменного тока
- American Control Electronics:низковольтный привод постоянного тока с опцией программируемой платы с защелкой
- MoS2 с контролируемой толщиной для электрокаталитического выделения водорода
- Монодисперсные углеродные наносферы с иерархической пористой структурой в качестве материала электродов дл…
- Серебряный затворный электрод с УФ-отверждением для струйной печати с низким электрическим сопротивлением
- Улучшение частотной модуляции и поглощения ТГц микроболометра со структурой микромоста с помощью антенн спи…
- Морфология, структура и оптические свойства полупроводниковых пленок с наноостровками GeSiSn и напряженными сл…
- Сегнетоэлектрические полевые транзисторы на основе одностенных углеродных нанотрубок с преобладанием микр…
- Рост рынка управления низким напряжением



