Стратегия оптимизации 4H-SiC-разделенной поглощающей зарядки и умноженной лавинной фотодиодной структуры для высокой эффективности обнаружения ультрафиолета
Аннотация
В этой работе систематически проводятся параметрические исследования по оптимизации структуры для лавинного ультрафиолетового фотодиода (УФ-ЛФД) на основе 4H-SiC с разделенным поглощением и умножением (SACM). Согласно нашим результатам, на напряжение пробоя может сильно влиять толщина слоя умножения и концентрация легирования для слоя контроля заряда. Толщина омического контактного слоя n-типа, поглощающего слоя и слоя управления зарядом может заметно влиять на глубину проникновения света, что, соответственно, влияет на количество фотогенерируемых электронно-дырочных пар, и, следовательно, толщина вышеупомянутого слоя имеет Сильное влияние на отзывчивость для SACM APD. Для повышения чувствительности ЛФД нам требуется уменьшенная высота барьера энергетической полосы на границе слоя оптического поглощения и слоя управления зарядом, чтобы можно было способствовать ускоренному переносу носителей в слой умножения. Кроме того, мы исследуем положительные скошенные столбы с меньшими углами, чтобы уменьшить электрическое поле на краю мезы. Таким образом, темновой ток соответственно подавляется.
Введение
В качестве полупроводникового материала с широкой запрещенной зоной карбид кремния (SiC) и нитрид алюминия-галлия (AlGaN) демонстрируют превосходные характеристики материала, такие как высокое критическое электрическое поле, лучший антирадиационный эффект и хорошая теплопроводность, что делает его пригодным для ультрафиолетового (УФ) излучения. обнаружение [1,2,3]. Регулируемая ширина запрещенной зоны в диапазоне от 3,4 до 6,2 эВ для фотодетекторов на основе AlGaN обеспечивает регулируемую длину волны отсечки в диапазоне от 365 до 200 нм. Однако из-за сложности выращивания высококачественных соединений AlGaN с высоким содержанием алюминия темновой ток для фотоприемников на основе AlGaN выше, чем у аналогов на основе SiC [4]. Поэтому фотоприемники на основе SiC вызывают большой исследовательский интерес. На сегодняшний день твердотельные ультрафиолетовые детекторы на основе 4H-SiC включают диод с барьером Шоттки, фотодиод металл-полупроводник-металл (MSM), p-i-n фотодиод и лавинный фотодиод (APD) [5,6,7,8,9]. Благодаря высокому лавинному усилению, небольшому темновому току и низкому шуму, ультрафиолетовые ЛФД 4H-SiC имеют большие перспективы применения во многих передовых областях, где требуется обнаружение слабого ультрафиолетового сигнала, таких как предупреждение о пожаре, квантовая связь и обнаружение ракет [ 10,11,12]. Однако материал SiC имеет низкий коэффициент поглощения света, поэтому обычную структуру фотодиода с тонким умножающим слоем трудно достичь высокой квантовой эффективности. Проблема не будет решена до тех пор, пока не будет предложена структура APD с разделенной поглощающей способностью заряда и умножения (SACM). С одной стороны, УФ-свет может эффективно поглощаться поглощающим слоем, а с другой стороны, высокое внутреннее усиление может быть получено в слое умножения с сильным полем посредством процесса ударной ионизации. Процесс ударной ионизации в умножающем слое может быть остановлен слоем контроля заряда [13, 14]. Преимущество SACM-структуры возникает из-за пониженного шума, потому что только один тип фотогенерируемых носителей с большей скоростью ионизации может быть введен в слой умножения [15, 16]. Для получения высокой способности обнаружения слабого ультрафиолетового сигнала должны быть изготовлены SACM APD с большой активной областью обнаружения [17]. Однако увеличение размера устройства сопровождается значительным увеличением тока поверхностной и объемной утечки. Таким образом, это не только предъявляет строгие требования к качеству эпитаксиальной пластины SiC, но также отражает серьезную проблему для процесса изготовления устройства и конструкции устройства. В последние несколько десятилетий компания Cree значительно продвинула технологию эпитаксиального выращивания пленок SiC, что, таким образом, привело к постоянному улучшению качества кристаллов. Совсем недавно Zhou et al. предложили метод оплавления фоторезиста с переменной температурой для создания очень гладких боковых стенок для скошенной мезы 4H-SiC APD [18], которая обеспечивает высокий коэффициент умножения, превышающий 10 6 и низкий темновой ток ~ 0,2 нА / см 2 . Тем не менее, предыдущие исследования были в большей степени сосредоточены на улучшении качества материала и оптимизации технологии изготовления для SACM APD [19,20,21], в то время как влияние структурной конструкции на перенос фотогенерируемых носителей и обнаружение фототока до сих пор редко обсуждалось. . Поэтому в этом письме мы систематически исследуем оптоэлектронные характеристики ультрафиолетовых ЛФД большой площади на основе 4H-SiC SACM с различной конструкцией. Между тем, также предоставляются проницательные физические изображения и обсуждения. Мы считаем, что результаты этой работы будут полезны исследователям для оптимизации 4H-SiC APD с меньшими затратами.
Как известно, крупномасштабное умножение носителей происходит, когда имеет место ударная ионизация, на которую, тем не менее, сильно влияют толщина слоя умножения и концентрация легирования для слоя управления зарядом. В умножающем слое создается очень сильное электрическое поле, обеспечивающее ударную ионизацию. Электрическое поле может быть прекращено с помощью слоя управления зарядом из-за большей концентрации легирования в нем. Кроме того, мы также обнаружили, что, модулируя энергетическую полосу между слоем поглощения и слоем управления зарядом, мы можем регулировать спектральную чувствительность. Разумное применение положительной скошенной мезы может привести к значительному уменьшению электрического поля на поверхности боковой стенки, что помогает подавить темновой ток и краевой пробой. Подробный анализ и обсуждения будут проведены позже.
Методы исследования и физические модели
На рисунке 1а показан схематический вид в разрезе стандартного 4H-SiC SACM APD, используемого в данной работе, который имеет n + слой 4H-SiC в качестве подложки. Затем архитектурный стек состоит из p + толщиной 3 мкм. слой типа ( N а =1 × 10 19 см −3 ), служащего омическим контактным слоем p-типа, n - толщиной 0,5 мкм слой умножения типа ( N d =1 × 10 15 см −3 ) для умножения носителей, слой контроля заряда n-типа толщиной 0,2 мкм ( N d =5 × 10 18 см −3 ) для прекращения процесса ударной ионизации и n - толщиной 0,5 мкм. абсорбирующий слой типа ( N d =1 × 10 15 см −3 ) для поглощения входящих фотонов. Поверх конструкции устройства имеется n + толщиной 0,3 мкм. омический контактный слой типа ( N d =1 × 10 19 см −3 ). Положительный угол скоса ( θ =8 °) создается меза-структура для подавления краевого пробоя [22, 23]. Диаметр 4H-SiC SACM APD составляет 800 мкм. В наших расчетах как катодный, так и анодный контакты рассматриваются как идеальные омические контакты. Согласно рис. 1c и d, наши результаты показывают, что результаты расчетов для вышеупомянутой стандартной структуры 4H-SiC SACM APD показывают темновой ток 2,5 нА / см 2 , напряжение пробоя 161,6 В и пиковая чувствительность 0,11 А / Вт на длине волны 280 нм. Расчетные вольт-амперные характеристики и чувствительность для стандартных 4H-SiC SACM APD согласуются с экспериментальными данными. Это полностью доказывает, что ударная ионизация, коэффициент поглощения материала 4H-SiC, уравнение Пуассона, уравнение неразрывности тока и уравнения дрейфовой диффузии, используемые в этой работе, являются разумными. Здесь мы берем структуру, показанную на рис. 1a, в качестве эталона исследования, в то время как исследуемые переменные включают скошенный меза-угол, толщину и концентрацию легирования для каждого слоя.
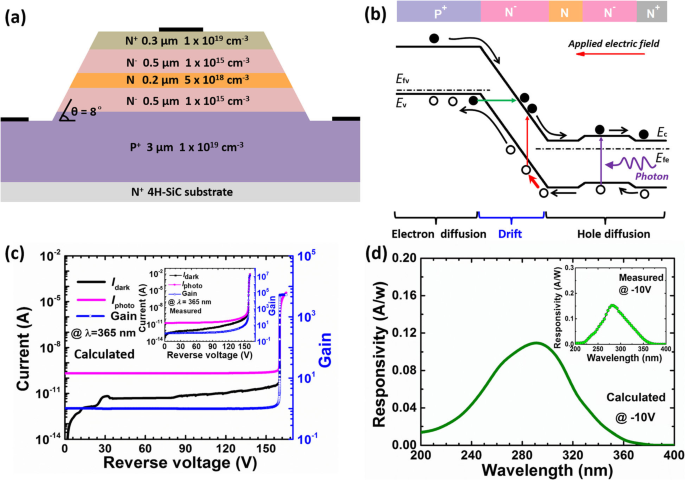
а Схематическое изображение конструкции в поперечном сечении (без масштаба), b схематическая диаграмма энергетических полос при обратном смещении для стандартных 4H-SiC SACM APD, c рассчитанные вольт-амперные характеристики и коэффициент умножения, и d рассчитаны спектральные характеристики отклика при обратном напряжении 10 В для стандартного 4H-SiC SACM APD. Рисунок на вставке в c показывает измеренные вольт-амперные характеристики и коэффициент умножения. Рисунок на вставке в d показывает измеренные характеристики спектрального отклика для стандартного 4H-SiC SACM APD со смещением - 10 В
Чтобы лучше понять влияние различных структурных переменных на фотоэлектрические свойства 4H-SiC SACM APD, на рис. 1b показана схематическая диаграмма энергетических зон при обратном смещении. Фотогенерация электронно-дырочных пар в поглощающем слое будет диффундировать в слой умножения через слой управления зарядом. После того, как фотогенерированные электронно-дырочные пары достигнут области размножения, они будут разделены обедненным электрическим полем. Затем отверстия будут подвергаться процессу умножения в слое умножения, что приводит к внутреннему усилению тока. Между тем, фотогенерированные электроны вернутся на катод и преобразуются в ток, не подвергаясь ударной ионизации. Важные факторы, влияющие на фототок, включают профили электрического поля в слое умножения, выравнивание энергетических зон в слое управления зарядом, слое поглощения и омическом контактном слое n-типа, в котором любой энергетический барьер может препятствовать переносу носителей. Также стоит отметить, что профили электрического поля в слое умножения могут определяться концентрациями легирования как для слоя умножения, так и для слоя контроля заряда. Между тем, скошенный меза-угол также в значительной степени связан с распределением электрического поля. Мы также будем обращать внимание на толщину каждого слоя, чтобы обеспечить высокую эффективность процесса диффузии носителей. Поэтому важно систематически изучать эти ключевые структурные параметры для оптимизации производительности устройства.
Численные исследования проводятся компанией APSYS, которая может решать текущие уравнения неразрывности, уравнения Пуассона и уравнения дрейфа-диффузии в соответствии с надлежащими граничными условиями. Процессы ударной ионизации и туннелирования Зинера были включены в уравнения дрейфовой диффузии. Рассеяние носителей-носителей для процесса переноса носителей также было включено в модель мобильности с низким полем. Время жизни рекомбинации Шокли-Рида-Холла (SRH) принято равным 1 мкс [24]. В частности, поле ( E ) зависимость коэффициентов ударной ионизации электронов ( α n ) и дырки ( β p ) для слоев на основе 4H-SiC можно выразить формулами Чиновета (1) и (2) следующим образом [25]:
$$ {\ alpha} _n =1.98 \ times {10} ^ 6 \ exp \ left [- {\ left (\ frac {9.46 \ times {10} ^ 6} {E} \ right)} ^ {1.42} \ right] {\ mathrm {cm}} ^ {- 1} $$ (1) $$ {\ beta} _p =4.38 \ times {10} ^ 6 \ exp \ left [- {\ left (\ frac {1.14 \ раз {10} ^ 7} {E} \ right)} ^ {1.06} \ right] {\ mathrm {cm}} ^ {- 1} $$ (2)Коэффициент поглощения (∂) с точки зрения различных длин волн (λ) для материала 4H-SiC рассчитывается по следующей формуле. (3) [26]:
$$ \ partial =-790.3 + 18.2 \ uplambda -0.17 {\ uplambda} ^ 2 + 8.57 \ times {10} ^ {- 4} {\ uplambda} ^ 3-2.39 \ times {10} ^ {- 6} { \ uplambda} ^ 4 + 3.53 \ times {10} ^ {- 9} {\ uplambda} ^ 5-2.16 \ times {10} ^ {- 12} {\ uplambda} ^ 6 $$ (3)Другие параметры материала, используемые в численных моделях, можно найти в [27]. Расчеты основаны на методе конечных элементов, который требует от пользователей правильной настройки распределений сетки для выполнения точных расчетов.
Результаты и обсуждения
Влияние структурных параметров омического контактного слоя n-типа на фотоэлектрические характеристики
Чтобы исследовать влияние толщины и концентрации легирования омического контактного слоя n-типа на фотоэлектрические характеристики, мы разработали эталонное устройство, устройства L1 – L4 и устройства A1 – A4, соответственно. Обратите внимание, что эталонное устройство является базовой структурой SACM APD, как показано на рис. 1a. Другие предлагаемые ЛФД идентичны эталонному устройству, за исключением омического контактного слоя SiC n-типа, подробная структурная информация для которого представлена в таблице 1.
Сначала мы покажем напряжение пробоя в терминах толщины омического контактного слоя SiC n-типа на рис. 2а, то есть устройств от L1 до L4. На вставке к рис. 2а выборочно показаны темновой ток, фототок при освещении 365 нм и коэффициент усиления для устройства L1. Для устройства L1 напряжение пробоя составляет ~ 161,6 В, а плотность темнового тока остается на уровне ~ 2,5 нА / см 2 . при смещении ниже 161,6 В. Обратите внимание, что напряжение пробоя получается при токе 10 −5 A. Темновой ток увеличивается, когда происходит процесс ударной ионизации. Уровень фототока становится высоким в линейной области, когда на устройство попадает 365 нм свет, и это показывает, что коэффициент умножения может быть более 10 3 для устройства L1 при обратном напряжении 161,6 В. Напряжение лавинного пробоя для пяти исследованных ЛФД представлено на рис. 2а. Из рис. 2а видно, что толщина омического контактного слоя n-типа незначительно влияет на напряжение пробоя. Чтобы выявить основной механизм наблюдений, мы рассчитываем и показываем вертикальное распределение электрического поля для эталонного устройства и устройств с L1 по L4 на рис. 2b, который показывает, что слой контроля заряда ограничивает границу области обеднения и электрического поля в слой умножения. Следовательно, мы можем предположить, что омический контактный слой n-типа не будет влиять на профили электрического поля в слое умножения, и это доказано на рис. 2b. Наблюдения на рис. 2b хорошо интерпретируют идентичное напряжение пробоя на рис. 2а для эталонного устройства и устройств от L1 до L4. Затем мы показываем фотогенерируемый ток для пяти устройств на рис. 2c. Для лучшего разрешения мы собираем фотогенерируемый ток при смещении 100 В, которые показаны на вставке к рис. 2c. Видно, что фотогенерируемый ток уменьшается с увеличением толщины омического контактного слоя n-типа. Слишком толстый омический контактный слой n-типа вызовет безызлучательную рекомбинацию фотогенерируемых носителей и, соответственно, снизит диффузионный ток. С помощью фотогенерируемого тока мы можем получить спектральную чувствительность для эталонного устройства и устройств с L1 по L4 при обратном напряжении 100 В на рис. 2d. Пиковая длина волны отклика для пяти исследованных устройств составляет 280 нм. Чувствительность уменьшается с увеличением толщины контактного слоя n-типа, что согласуется со вставкой на рис. 2в. Таким образом, мы резюмируем здесь, что толщина омического контактного слоя 4H-SiC n-типа должна быть достаточно тонкой, чтобы избежать повышенной безызлучательной рекомбинации и снижения диффузионного тока.

а Напряжение пробоя, b вертикальное распределение электрического поля SACM APD с напряжением - 160 В, c фототоковые характеристики при освещении 280 нм, и d спектральные характеристики отклика SACM APD со смещением - 100 В для эталонного устройства и устройств от L1 до L4 с разной толщиной омического контактного слоя n-типа соответственно. Рисунок на вставке в a показаны рассчитанные вольт-амперные характеристики и коэффициент умножения для устройства L1. Рисунок на вставке в c показывает фототок для эталонного устройства и устройств с L1 по L4 со смещением - 100 В
Затем мы исследуем напряжение пробоя как функцию концентрации легирования в омическом контактном слое n-типа, анализируя эталонное устройство и устройства A1 - A4 на рис. 3a. На вставке к рис. 3a показаны темновой ток, фотогенерационный ток и коэффициент усиления в виде приложенного смещения для устройства A1. Напряжение пробоя определяется, когда ток достигает 10 −5 A. Согласно рис. 3а, напряжение пробоя практически не зависит от концентрации легирования в омическом контактном слое 4H-SiC n-типа. Как было продемонстрировано ранее, слой управления зарядом может эффективно ограничивать область обеднения и электрическое поле в слое умножения. Следовательно, изменение концентрации легирования в омическом контактном слое n-типа не влияет на распределение электрического поля внутри устройства (см. Рис. 3b). Затем мы вычисляем и показываем фотогенерируемый ток с точки зрения приложенного смещения для эталонного устройства и устройств от A1 до A4 на рис. 3c. Из рис. 3в видно, что концентрация легирования омического контактного слоя n-типа незначительно влияет на смещенный фототок. Спектральная чувствительность на разных длинах волн для пяти исследованных устройств показана на рис. 3d. Данные рассчитаны при обратном напряжении 100 В. Длина волны с максимальной чувствительностью ~ 0,11 А / Вт составляет 280 нм. В соответствии с рис. 3в, чувствительность меньше зависит от концентрации легирования в омическом контактном слое n-типа. Таким образом, мы делаем вывод, что на чувствительность больше влияет толщина, чем концентрация легирования для омического контактного слоя n-типа для 4H-SiC SACM APD. Мы также предлагаем увеличить длину диффузии носителей с целью улучшения чувствительности.

а Напряжение пробоя, b вертикальное распределение электрического поля SACM APD с напряжением - 160 В, c фототоковые характеристики при освещении 280 нм, и d спектральные характеристики отклика SACM APD со смещением - 100 В для эталонного устройства и устройств от A1 до A4 с различной концентрацией легирования омического контактного слоя n-типа соответственно. Рисунок на вставке в a показаны рассчитанные вольт-амперные характеристики и коэффициент умножения для устройства A1. Рисунок на вставке в c показывает фототок для эталонного устройства и устройств от A1 до A4 со смещением - 100 В
Влияние структурных параметров абсорбирующего слоя на фотоэлектрические характеристики
В этом разделе исследуется влияние толщины и концентрации легирования для поглощающего слоя на фотоэлектрические характеристики ЛФД SACM на основе 4H-SiC. Подробная структурная информация абсорбирующего слоя для SACM APD суммирована и показана в таблице 2. Устройства с M1 по M4 и устройства с B1 по B4 конструктивно идентичны эталонному устройству, за исключением абсорбирующего слоя. Устройства с M1 по M4 имеют разную толщину, а устройства с B1 по B4 - с разной концентрацией легирования для абсорбирующего слоя.
При использовании эталонного устройства и устройств с M1 по M4 на рис. 4a показано напряжение пробоя в единицах различной толщины для абсорбирующего слоя. В целях демонстрации мы вычисляем и представляем темновой ток, фотогенерируемый ток и коэффициент усиления как функцию приложенного смещения для устройства M1 на вставке к рис. 4a. Напряжение пробоя собирается при токе 10 −5 . A. Видно, что напряжение пробоя практически не зависит от толщины поглощающего слоя. Известно, что напряжение пробоя сильно зависит от напряженности электрического поля в слаболегированном слое умножения, поэтому на рис. 4b показано вертикальное распределение электрического поля для пяти исследованных устройств при обратном смещении -160 В. Распределения поля для эталонного устройства и устройств с M1 по M4 точно такие же, что подтверждает вывод на рис. 4a. Затем мы демонстрируем фотогенерируемый ток и чувствительность на рис. 4в и г соответственно. Как фотогенерируемый ток (см. Вставку к рис. 4c), так и чувствительность показывают тенденцию к уменьшению с увеличением толщины поглощающего слоя. Для дальнейшего рассмотрения лежащего в основе механизма, мы также вычисляем и показываем распределение несущих в слое умножения на рис. 4e, когда обратное смещение составляет 100 В для пяти исследованных устройств. Видно, что уровни концентрации как электронов, так и дырок уменьшаются с увеличением толщины поглощающего слоя, что объясняется усилением безызлучательной рекомбинации, когда поглощающий слой становится толстым. Безызлучательная рекомбинация потребляет носители, подавляя тем самым диффузионный ток и чувствительность. Здесь, чтобы избежать потребления носителей из-за безызлучательной рекомбинации, мы предполагаем, что слой поглощения не может быть слишком толстым для получения 4H-SiC SACM APD с высокой детектирующей способностью.

а Напряжение пробоя, b вертикальное распределение электрического поля SACM APD с напряжением - 160 В, c фототоковые характеристики при освещении 280 нм, d спектральные характеристики отклика и е профили концентрации носителей в умножающем слое ЛФД SACM со смещением - 100 В для эталонного устройства и устройств с M1 по M4 с различной толщиной поглощающего слоя соответственно. Рисунок на вставке в a показаны рассчитанные вольт-амперные характеристики и коэффициент умножения для устройства M1. Рисунок на вставке в c показывает фототок для эталонного устройства и устройств с M1 по M4 со смещением - 100 В
Помимо толщины абсорбирующего слоя, концентрация легирования для абсорбирующего слоя также оказывает значительное влияние на характеристики устройства. Затем мы вычисляем и показываем напряжение пробоя для эталонного устройства и устройств с B1 по B4 на рис. 5a. Напряжение пробоя определяется при токе 10 −5 . A, как показано на вставке к рис. 5a. Из рис. 5а видно, что концентрация легирования для поглощающего слоя не оказывает существенного влияния на напряжение пробоя. Это может быть дополнительно доказано вертикальными одномерными распределениями электрического поля на рис. 5b, так что концентрация легирования для абсорбирующего слоя существенно не меняет профили электрического поля в умножающем слое. Мы также представляем фотогенерируемый ток на длине волны 280 нм для исследуемых устройств на рис. 5c, что указывает на улучшение фотогенерируемого тока при увеличении концентрации легирования в поглощающем слое. Хорошо согласуясь с рис. 5c, чувствительность, зависящая от длины волны на рис. 5d, также является предпочтительной, поскольку концентрация легирования для абсорбирующего слоя увеличивается, например, устройство B4.

а Напряжение пробоя, b вертикальное распределение электрического поля SACM APD с напряжением - 160 В, c фототоковые характеристики при освещении 280 нм, и d характеристики спектрального отклика SACM APD со смещением - 100 В для эталонного устройства и устройств от B1 до B4 с различной концентрацией легирования абсорбционного слоя, соответственно. Рисунок на вставке в a показаны рассчитанные вольт-амперные характеристики и коэффициент умножения для устройства B1. Рисунок на вставке в c показывает фототок для эталонного устройства и устройств с B1 по B4 со смещением - 100 В
Чтобы показать более глубокую причину повышенной чувствительности устройства B4, мы показываем профили энергетических зон для слоя контроля заряда, слоя поглощения и омического контактного слоя n-типа для устройств B1 и B4 на рис. 6а и б соответственно. Здесь стоит упомянуть, что концентрации легирования для слоя контроля заряда и омического контактного слоя n-типа составляют 5 × 10 18 см −3 и 1 × 10 19 см −3 , соответственно. Следовательно, более низкая концентрация легирования для поглощающего слоя может генерировать встроенное электрическое поле и создавать энергетические барьеры на границах раздела слой управления зарядом / поглощающий слой / омический контактный слой n-типа [28]. Энергетические барьеры могут замедлять диффузию фотогенерируемых носителей в слой умножения. Очень удобный способ уменьшить барьеры - увеличить концентрацию легирования в поглощающем слое. В результате эффективные значения барьера валентной зоны ψ v для слоя управления зарядом составляют 513 мэВ и 480 мэВ для устройств B1 и B4 соответственно. Видно, что повышенная концентрация легирования для абсорбирующего слоя способствует переносу фотогенерированных дырок (см. Рис. 6c). Ударная ионизация станет сильной, когда в область умножения можно будет ввести новые фотогенерируемые отверстия, что, соответственно, приведет к увеличению фотогенерируемого тока и чувствительности.
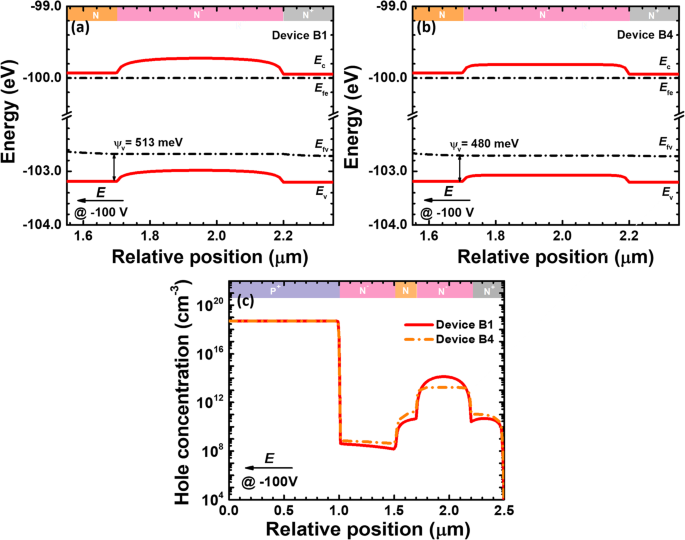
Диаграммы энергетических зон слоя контроля заряда, абсорбционного слоя и омического контактного слоя n-типа для a устройство B1 и b устройство B4, c профили концентрации дырок при освещении 280 нм для устройств B1 и B4. Данные рассчитаны при обратном напряжении 100 В
Влияние структурных параметров слоя контроля заряда на фотоэлектрические характеристики
Чтобы исследовать влияние толщины и концентрации легирования слоя управления зарядом на фотоэлектрические характеристики, мы установили различную архитектурную информацию для слоя управления зарядом, как показано в таблице 3. Устройства N1 – N4 и устройства C1 – C4 отличаются только от эталонного устройства. в слое управления зарядом. Для устройств от N1 до N4 и от C1 до C4 приняты разные концентрации легирования и толщина слоя.
Как упоминалось ранее, электрическое поле, обеспечивающее ударную ионизацию и лавинный пробой, в основном ограничивается слоем умножения. Напряжение пробоя в зависимости от толщины слоя управления зарядом на рис. 7a означает, что толщина слоя управления зарядом очень незначительно влияет на процесс умножения носителей. Это дополнительно подтверждается рисунком 7b. На рисунке 7c показан фотогенерируемый ток с точки зрения приложенного смещения для эталонного устройства и устройств с N1 по N4. Фотогенерируемый ток становится низким при увеличении толщины слоя управления зарядом, что также переводит меньшую чувствительность при увеличении толщины слоя управления зарядом. Мы также приписываем усиленную безызлучательную рекомбинацию, которая потребляет носители и подавляет диффузионный ток.

а Напряжение пробоя, b вертикальное распределение электрического поля SACM APD с напряжением - 160 В, c фототоковые характеристики при освещении 280 нм, и d спектральные характеристики отклика SACM APD со смещением - 100 В для эталонного устройства и устройств с N1 по N4 с разной толщиной слоя управления зарядом, соответственно. Рисунок на вставке в a показаны рассчитанные вольт-амперные характеристики и коэффициент умножения для устройства N1. Рисунок на вставке в c показывает фототок для эталонного устройства и устройств с N1 по N4 со смещением - 100 В
Роль слоя управления зарядом заключается в ограничении сильного электрического поля и процесса умножения носителей в слое умножения. Однако ширина обедненной области может быть дополнительно увеличена до тех пор, пока концентрация легирования в слое управления зарядом уменьшается. Тогда профили электрического поля могут существенно повлиять на напряжение пробоя, фотогенерируемый ток, коэффициент усиления и чувствительность. Поэтому мы проектируем устройства с C1 по C4 в таблице 3. Согласно рис. 8a, когда концентрация легирования уменьшается, напряжение пробоя сначала остается неизменным, а затем напряжение пробоя увеличивается, когда концентрация легирования для слоя управления зарядом ниже 2 × 10 18 см −3 . На вставке к рис. 8а показано, что напряжение пробоя составляет ~ 315 В для устройства C1, в то время как темновой ток также возрастает до 3,5 × 10 -11 . A по сравнению с устройством N1. Чтобы выявить причину наблюдений на рис. 8a, мы вычислим вертикальное распределение электрического поля на рис. 8b, которое демонстрирует, что электрическое поле в основном сосредоточено в слое умножения для эталонных устройств и устройств C3 и C4. Однако электрическое поле и обедненная область проникают в слой управления зарядом, когда концентрация легирования для слоя управления зарядом ниже 2 × 10 18 см −3 . Расширение области обеднения для устройств C1 и C2 помогает снизить напряженность электрического поля, и, таким образом, напряжение пробоя соответственно увеличивается для устройств C1 и C2. Увеличенная ширина обедненной области даст больший ток генерации пространственного заряда, что, таким образом, приведет к увеличению темнового тока, то есть 3,5 × 10 - 11 A и 5 × 10 - 11 A для устройств C1 и C2 соответственно. Затем мы показываем фотогенерируемый ток на длине волны 280 нм на рис. 8c. Кривые спектральной чувствительности со смещением 100 В на разных длинах волн для пяти исследованных устройств показаны на рис. 8d. Отличное согласие получено между рис. 8c и d, так что увеличенный фотогенерируемый ток вызывает повышенную чувствительность, то есть устройства C1 и C2. Other devices show similar photo-current level and the responsivity.

а Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices C1 to C4 with different doping concentration of charge control layer, respectively. Inset figure in a shows the calculated current-voltage characteristics and the multiplication gain for device C1. Inset figure in c shows photocurrent-voltage characteristics for reference device and devices C1 to C4
As has been interpreted previously, the energy band barrier height at the interface of multiplication layer/charge control layer can soundly affect the carrier diffusion. Due to the expansion of the depletion region for devices C1 and C2, the electric field in the depletion region will annihilate the energy barrier at the interface of multiplication layer/charge control layer [e.g., the inset for device C1 in Fig. 9a]. Meanwhile, we observe the valence band barrier at the interface of multiplication layer/charge control layer for device C4 according to the inset for Fig. 9b. The energy barrier will correspondingly retard the hole diffusion into the multiplication layer from the charge control layer. We also selectively compute and show the hole concentration profiles for device C1 and C4 in Fig. 9c. Because the interface of multiplication layer/charge control layer for device C1 no longer hinders the injection of photo-generated holes into the multiplication layer, more holes are limited in the charge control layer and the absorption layer for device C4. As a result, the hole concentration in the multiplication layer for device C1 is higher than that for device C4. Thus, the enhanced photo-generated current and the responsivity for device C1 are obtained when compared with device C4.
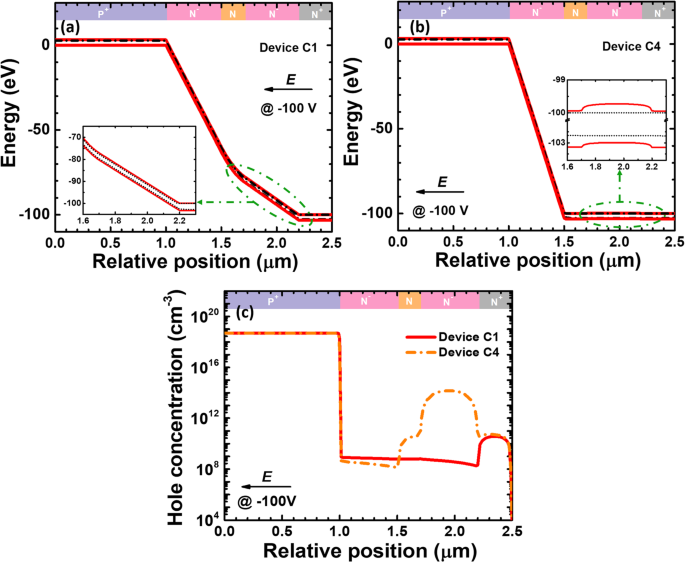
Energy band diagrams for a device C1 and b device C4, c hole concentration profiles for device C1 and C4. Data are calculated at the reverse voltage of 100 V. Insets for a и b show the local energy band diagrams for multiplication layer/charge control layer for devices C1 and C4, respectively
Impact of the Structural Parameters for the Multiplication Layer on the Photoelectric Performance
The impact ionization and the carrier multiplication process take place in the multiplication layer, making the design for the multiplication layer essentially vital for 4H-SiC SACM APDs. Therefore, we look into the impact of the thickness and doping concentration for the multiplication layer on the photoelectric performance for SACM APDs. The detailed structural information of the multiplication layer for different SACM APDs are summarized and presented in Table 4. The only difference for the devices in Table 4 lies on the multiplication layer.
As Fig. 10a presents, the breakdown voltage is enhanced from 110 to 210 V when the multiplication layer thickness is increased from 0.3 to 0.7 μm. For the purpose of demonstration, the inset of Fig. 10a demonstrates the current in terms of the voltage for reference device and devices P1 to P4. This indicates that a thick multiplication layer helps to reduce the electric field intensity [see Fig. 10b] and increase the breakdown voltage. We then show the photo-generated current for the five devices in Fig. 10c. The photo-generated current increases slightly with increasing the thickness of the multiplication layer for devices P2 to P4, except that device P1 has the highest photocurrent. The spectral responsivity characteristics for the five investigated devices at the reverse voltage of 100 V are provided in Fig. 10d. The peak responsivity for reference device and devices P2 to P4 improves slightly as the thickness of the multiplication layer increases, and this is because the number of carriers generated by impact ionization increases when the depletion region width increases. Note that device P1 with the thinnest multiplication layer owns the highest peak responsivity at the wavelength of 280 nm. This is because the − 100 V applied voltage is close to Geiger mode for device P1, and the avalanche gain is more likely to occur than that for other devices.

а Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent biased at − 100 V, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices P1 to P4 with different thicknesses of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices P1 to P4. Inset figure in c shows photocurrent-voltage characteristics under 280 nm illumination for reference device and devices P1 to P4
Then, we show the breakdown voltage in terms of the multiplication layer doping concentration for reference device and devices D1 to D4 in Fig. 11a. It seems that when the doping concentration for the multiplication layer is lower than 10 16 см −3 , the breakdown voltage is less affected. We believe the breakdown voltage can be significantly decreased if the doping concentration in the multiplication layer exceeds 10 18 см −3 . The dark current as a function of the applied bias for the five APDs are shown in the inset of Fig. 11a. The dark current increases with increasing doping concentration of the multiplication layer due to the enhanced space charge generation in the depletion region. Therefore, for the purpose of significantly decreasing the dark current and promoting the carrier multiplication process, we rarely have the multiplication layer heavily doped. Then, we calculate the vertical one-dimensional electric field profiles for the five studied devices, which are demonstrated in Fig. 11b. We can see that the electric field profiles of the five devices are mainly confined in the multiplication layer. In addition, Figs. 11c and d demonstrate the photo-generated current and the wavelength-dependent responsivity for the five devices. We can see that the photo-generated current for reference device and devices D1 and D2 are almost the same under the 280 nm illumination, while that the photon-generated current for the devices D3 and D4 is slightly increased. Therefore, the responsivity at the wavelength of 280 nm in Fig. 11d for devices D3 and D4 is slightly higher than the others.

а Breakdown voltage, b vertical electric field distribution of the SACM APDs biased at − 160 V, c photocurrent-voltage characteristics under 280 nm illumination, and d spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices D1 to D4 with different doping concentration of multiplication layer, respectively. Inset figure in a shows the calculated current-voltage characteristics for reference device and devices D1 to D4. Inset figure in c shows photocurrent for reference device and devices D1 to D4 biased at − 100 V
Impact of the Beveled Mesa Angle on the Photoelectric Performance
In order to eliminate premature breakdown and suppress leakage current that are caused by the junction termination, positive beveled mesas with a small inclination angle are usually adopted when fabricating 4H-SiC APDs [13,14,15,16, 18]. However, the angles of the positive beveled mesa adopted in previous reports are various. Thus, to get systematic insight into the influence of different mesa inclination angles on the electric field profiles for 4H-SiC SACM APDs, we design the devices that are shown in Table 5.
We firstly calculate and show the dark current-voltage characteristics for the six investigated devices with the various bevel angles in Fig. 12a. We can see that the dark current increases as the positive beveled angle becomes large [see Fig. 12a]. The breakdown voltages for the investigated devices are ~ 161.6 V except that device E5 is slightly less than 161.6 V. The premature breakdown is observed as the beveled mesa angle increase in the dark condition. Meanwhile, we calculate and show photo-generated current in terms of the applied bias for reference device and devices E1 to E5 in Fig. 12b. We also see that the photo-generated current also increases as the positive bevel increases according to the inset for Fig. 12b. The premature breakdown is also observed as the beveled mesa angle increase in Fig. 12b. Therefore, the responsivity of solar-blind waveband at − 100 V slightly enhances as the positive bevel angle increases according to Fig. 12c.
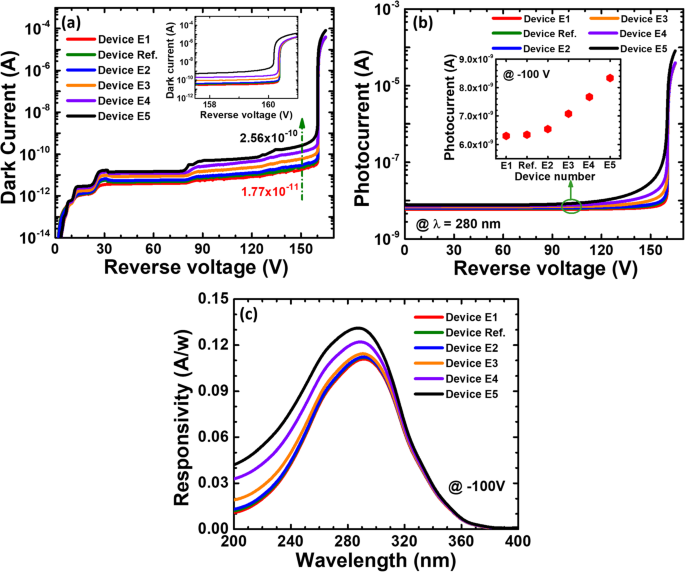
а Numerically calculated dark current-voltage characteristics, b photocurrent-voltage characteristics under 280 nm illumination, and c spectral response characteristics of the SACM APDs biased at − 100 V for reference device and devices E1 to E5, respectively
To reveal the origin for the observations in Figs. 12a and b, we calculate the lateral electric field distribution in the multiplication layer at the reverse bias of − 100 V in Fig. 13a, which demonstrates that, when the beveled mesas are utilized, the electric field decreases from the mesa center to the mesa edge. Moreover, the edge electric field intensity drops as the angle further decreases for the investigated devices. As has been mentioned, the junction termination will cause a large number of surface imperfections, which may cause the premature breakdown and the strongly leakage current, and the adopting of the beveled mesa shifts the premature breakdown from the mesa surface to the bulk [29]. Moreover, to get a full picture for the electric field profiles, the two-dimensional electric field distributions at the reverse bias of − 100 V for reference device and devices E1 to E5 are presented in Figs. 13b-g. We can see that the area of the high electric field in the entire multiplication layer gets narrowed, and this simultaneously causes the carriers that regenerated by impact ionization to decrease. As can be seen from Table 6, as the beveled mesa angle decreases, the surface electric field at the relative position of 700 μm decreases from 2.03 × 10 6 V/cm to 2.90 × 10 5 V/cm. As a result, the surface leakage and bulk leakage can be further suppressed as the beveled mesa angle get further decreased as shown in Fig. 12a. Although a small beveled mesa angle is preferred, this sacrifices the active detection area for APDs, and therefore, the responsivity is the lowest for device E1 according to Fig. 12c. Thus, one shall properly optimize beveled mesa angles depending on the crystalline quality for the 4H-SiC epitaxial layers and the surface conditions after junction termination. The suggested beveled angle in this works is in the range of 10–20°.
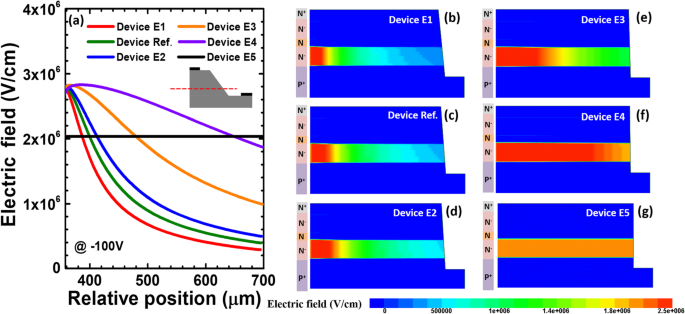
а Lateral electric field distribution of the multiplication layer at − 100 V, and numerically calculated two-dimensional electric field distribution at − 100 V for b device E1, c reference device, d device E2, e device E3, f device E4 and g device E5
Выводы
To summarize, we have numerically investigated and demonstrated the impact of the thickness and doping concentration of each layer on photoelectric performance for 4H-SiC SACM APDs. The obtained conclusions are as follows:(1) for n-type ohmic contact layer with a properly high doping concentration (N d ≈ 1 × 10 19 см −3 ) to enable ohmic contact, the thickness and doping concentration hardly affect the breakdown voltage. Nevertheless, the responsivity decreases as the thickness of the n-type ohmic contact layer increases. The thickness shall be controlled to about 0.2 μm; (2) the doping concentration for the absorption layer is vitally important, which can modulate the photo-generated carrier transport and affect the responsivity. The doping concentration is generally controlled at the intrinsic concentration (N d ≈ 1 × 10 15 см −3 ); (3) the doping concentration for the charge control layer regulates the electric field distribution and affects the depletion region width for 4H-SiC SACM APDs. The depletion region width increases as the doping concentration of the charge control layer decreases. According to our results, when the doping concentration is about 1 × 10 18 см −3 , the depletion region can be completely terminated by the charge control layer; (4) the breakdown voltage can be strongly affected by the thickness of multiplication layer which is the main support region of the electric field. The dark current is sensitive to the doping concentration of multiplication layer, and a low doping concentration for the multiplication layer is required, since the doping concentration therein influences the space charge generation current. Thus, the suggested doping concentration in this works is intrinsic concentration (N d ≈ 1 × 10 15 см −3 ); (5) we also point out the advantage of beveled mesa for 4H-SiC SACM APDs, and the optimized beveled mesa angles shall be a compromise among the active detection area, the surface conditions for the mesa, and the crystalline quality for 4H-SiC epitaxial films. This work indicates that the optimum beveled mesa angle is in the range of 10–20°. We strongly believe that this work provides the physical insight for the device physics and hence the findings in this work are very important for 4H-SiC-based SACM APDs.
Доступность данных и материалов
The data and the analysis in the current work are available from the corresponding authors on reasonable request.
Сокращения
- AlGaN:
-
Aluminum gallium nitride
- APSYS:
-
Расширенные физические модели полупроводниковых приборов
- MSM:
-
Metal-semiconductor-metal
- SACM:
-
Separated absorption charge and multiplication
- SiC:
-
Карбид кремния
- SRH:
-
Шокли-Рид-Холл
- UV APD:
-
Avalanche ultraviolet photodiode
Наноматериалы
- Исправление неработающей стратегии обслуживания:оптимизация PM и FMEA
- Демонстрация гибкого биосенсора на основе графена для чувствительного и быстрого обнаружения клеток рака яи…
- Усовершенствованные технологии осаждения атомного слоя для микро-светодиодов и VCSEL
- Разработка процесса нанесения покрытия погружением и оптимизация производительности для электрохромных ус…
- Диэлектрические метаповерхности высокого порядка для высокоэффективных поляризационных светоделителей и о…
- Улучшение частотной модуляции и поглощения ТГц микроболометра со структурой микромоста с помощью антенн спи…
- Ультрафиолетовые светодиоды на основе AlGaN с почти нулевым КПД и специально разработанным слоем блокировки эл…
- Кинетика управляющего заряда фотокатализаторов ниобата олова:ключевые роли фазовой структуры и электронной…
- Материалы и дизайн печатных плат для высокого напряжения
- VMC Machinery для производства и эффективности



