Высокомобильные Ge pMOSFET с диэлектриком ZrO2:последствия отжига после отжига
Аннотация
В данной статье исследуется влияние отжига после отжига металла (PMA) и отжига после осаждения (PDA) на электрические характеристики полевых транзисторов металл-оксид-полупроводник Ge p-типа (pMOSFET) с ZrO 2 диэлектрик. Для транзисторов без КПК ток в открытом состоянии ( I ВКЛ ), подпороговое колебание (SS) и характеристики эквивалентной толщины емкости (CET) улучшаются при повышении температуры PMA с 350 до 500 ° C. Кристаллизация ZrO 2 диэлектрик при более высокой температуре ПМА способствует увеличению диэлектрической проницаемости ZrO 2 и уменьшение плотности состояний интерфейса ( D это ), что приводит к снижению CET и высокой эффективной подвижности дырок ( μ eff ). Показано, что полевые МОП-транзисторы на основе Ge с обработкой PDA при 400 ° C имеют более низкий CET и более крутой SS, но более низкий μ eff по сравнению с устройствами без КПК.
Фон
Германий (Ge) считается одним из привлекательных материалов с p-каналом для усовершенствованных КМОП, поскольку он обеспечивает гораздо более высокую подвижность дырок, чем Si [1,2,3]. Высококачественный диэлектрик затвора и эффективная пассивация поверхности Ge являются ключами к реализации превосходной эффективной подвижности носителей ( μ eff ) и высокий ток возбуждения в Ge-транзисторе [4,5,6,7]. Несколько материалов с высоким κ, таких как HfO 2 [8], ZrO 2 [7, 9], Ла 2 О 3 [10], и Y 2 О 3 [11] изучались в качестве альтернативных диэлектриков затвора для полевых транзисторов металл-оксид-полупроводник Ge p-типа (pMOSFET) для достижения масштабируемости эквивалентной толщины емкости (CET) до уровня менее 1 нм. Среди них ZrO 2 Диэлектрик привлек наибольшее внимание из-за гораздо более высокого значения κ [12, 13] и лучшего качества поверхности раздела [14] по сравнению с диэлектриками на основе Hf. Широко сообщалось, что кристаллизация ZrO 2 может дополнительно улучшить электрические характеристики Ge pMOSFET, например, уменьшив CET и увеличив μ eff [15, 16]. Тем не менее, отсутствуют исследования влияния этапов процесса для ZrO 2 . кристаллизации на характеристиках устройств на германиевых транзисторах.
В этой статье мы исследуем влияние отжига металла после осаждения (PMA) и отжига после осаждения (PDA) на электрические характеристики Ge pMOSFET с ZrO 2 диэлектрик. Значительно улучшено μ eff и снижение CET может быть достигнуто в устройствах с более высокой температурой PMA.
Методы
Основные этапы процесса изготовления Ge pMOSFET с ZrO 2 диэлектрики показаны на рис. 1а. Ge pMOSFET были изготовлены на пластине Ge (001) n-типа с удельным сопротивлением 0,088–0,14 Ом ∙ см. После нескольких циклов химической очистки в разбавленном растворе HF (1:50) и ополаскивания деионизированной водой. Пластина Ge загружалась в камеру осаждения атомных слоев (ALD). Поверхность Ge была пассивирована постокислением озоном (OPO), то есть ультратонким Al 2 О 3 Слой наносили при 300 ° C, а затем проводили ППО in situ при 300 ° C в течение 15 мин. После этого ZrO 2 толщиной 5 нм осажден при 250 ° C в той же камере ALD с использованием TDMAZr и H 2 O как предшественники Zr и O соответственно. Во время осаждения Zr [N (CH 3 ) 2 ] 4 источник был нагрет до 85 ° C. Процесс PDA проводился на некотором образце при 400 ° C в течение 60 с с использованием быстрого термического отжига. Образцы с КПК и без него были обозначены как пластина II и I соответственно. Затем методом реактивного распыления наносился затворный электрод из TaN толщиной 100 нм. После формирования рисунка затвора и травления области истока / стока (S / D) были сформированы BF 2 + имплантация при энергии 30 кэВ и дозе 1 × 10 15 см −2 . Пятнадцать нанометровых никелевых S / D-контактов формировались методом отрыва. Наконец, для активации легирующей примеси и S / D металлизации был проведен PMA при 350, 400, 450 и 500 ° C в течение 30 с.
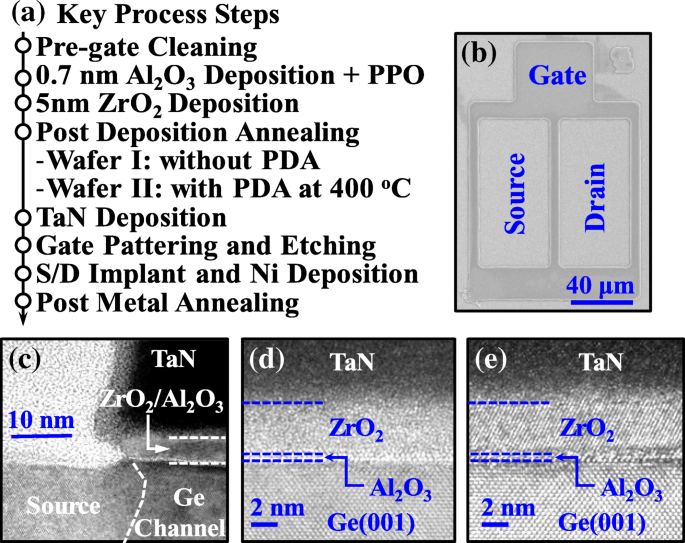
а Основные этапы процесса изготовления Ge pMOSFET с ZrO 2 диэлектрик. б СЭМ-изображение изготовленного транзистора. c XTEM-изображение Ge pMOSFET, показывающее области затвора и S / D. г , e Изображения HRTEM стопки затворов Ge pMOSFET на пластине I, отожженной при 400 ° C и 500 ° C, соответственно
На рис. 1b показано изображение, полученное с помощью сканирующего электронного микроскопа (СЭМ), изготовленного на основе Ge pMOSFET. На рисунке 1c показано изображение Ge pMOSFET, полученное с помощью просвечивающего электронного микроскопа (XTEM), на котором показаны область истока / стока, металлический затвор и ZrO 2 . диэлектрик. На рисунках 1d и e показаны изображения ПЭМ высокого разрешения (ПЭМВР) затворных стеков Ge pMOSFET с PMA при 400 и 500 ° C, соответственно, на пластине I. Наблюдается, что ZrO 2 диэлектрик полностью кристаллизовался и подвергался ФМА при 500 ° C. Толщина Al 2 О 3 межфазный слой составляет около 0,7 нм.
Результаты и обсуждение
Инверсионная емкость C inv по сравнению с V GS Кривые, измеренные на частоте 300 кГц для устройств на пластине I, показаны на рис. 2. Извлеченные значения CET составляют ∼ 1,95, 1,80, 1,67 и 1,52 нм для устройств с PMA на 350, 400, 450, и 500 ° С соответственно. Меньший CET достигается при более высокой температуре PMA из-за кристаллизации ZrO 2 . В общем, значения κ для аморфного и кристаллического ZrO 2 составляют около 20–23 и 28–30 соответственно. Кристаллический ZrO 2 толщиной 5 нм вносит EOT ~ 0,7 нм. Сдвиг C-V кривые с различной температурой ПМА связано с тем, что кристаллизация снижает плотность объемных ловушек в ZrO 2 диэлектрик.
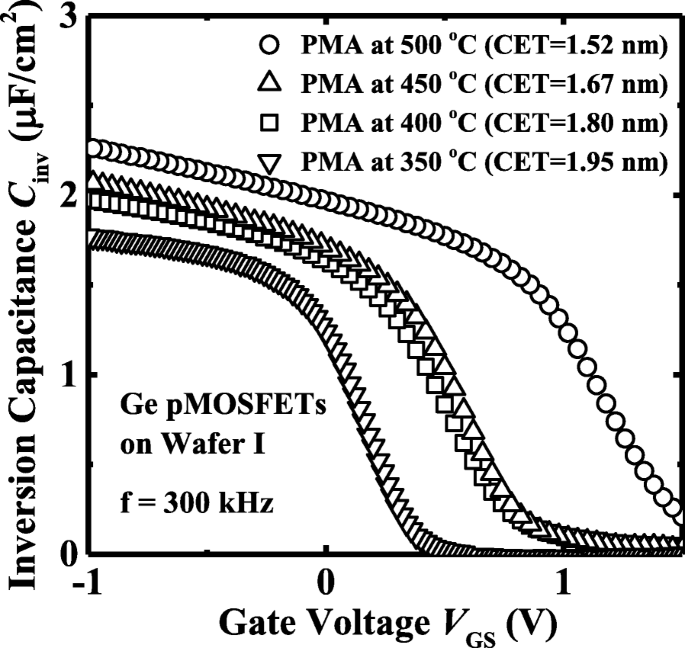
Инверсия C inv - V GS кривые для Ge pMOSFET на пластине I с PMA при 350 ° C, 400 ° C, 450 ° C и 500 ° C
На рис. 3а показаны измеренные передаточные характеристики и токи утечки затвора I . G полевых МОП-транзисторов Ge на пластине I с различными температурами PMA. Все устройства имеют длину затвора L G 4 мкм и шириной затвора W 100 мкм. Ge pMOSFET демонстрируют гораздо более низкое значение I G по сравнению с I DS для всех температур PMA. Я ВКЛ / Я ВЫКЛ соотношение выше 10 4 достигается для устройства с PMA при 500 ° C. Я DS - V DS кривые устройств, измеренные при разной перегрузке гейта | V GS - V TH | показаны на рис. 3б. Отмечается, что пороговое напряжение В TH определяется как V GS в I DS из 10 −7 А / мкм. Транзистор Ge с PMA при 500 ° C обеспечивает улучшение управляющего тока на ~ 47% и 118% по сравнению с устройствами, отожженными при 450 ° C и 350 ° C, соответственно, при V DS из - 1,0 В и | В GS - V TH | 0,8 В. На рис. 3с показан статистический график I ВКЛ при V DS от - 0,5 В и В GS - V TH - 1 В для Ge pMOSFET с различными температурами PMA. Все транзисторы на этом графике имеют обозначение L . G 4 мкм и W 100 мкм. Устройства с PMA при 500 ° C демонстрируют улучшенный I ВКЛ по сравнению с теми, у которых более низкие температуры PMA, что объясняется уменьшенным сопротивлением S / D, уменьшенным CET и более высоким μ eff , о чем будет сказано позже.

а Измерено I D , Я S , и Я G vs. V GS кривые Ge pMOSFET на пластине I с ПМА при 350, 400, 450 и 500 ° C. б Я DS - V DS кривые, измеренные при различных V GS - V TH для устройств. c Устройство, отожженное при 500 ° C, имеет более высокий ток в открытом состоянии I ВКЛ по сравнению с транзисторами с ПМА при более низких температурах
На рисунке 4 показаны статистические графики среднего промежутка D это , SS и V TH характеристики для устройств с различными температурами ПМА. Как показано на рис. 4a, на основе метода максимальной проводимости [17] средний зазор D это значения извлекаются как 1,3 × 10 13 , 9,5 × 10 12 , 9,2 × 10 12 , и 6,3 × 10 12 см −2 эВ −1 для устройств с PMA при 350, 400, 450 и 500 ° C соответственно. На рисунке 4b показано, что Ge pMOSFET, отожженные при 500 ° C, имеют улучшенные характеристики SS, чем транзисторы, отожженные при более низких температурах, из-за меньшей средней зазоры D это и CET. Значения D это и SS Ge pMOSFET с PMA по-прежнему выше, чем у наиболее известных Ge транзисторов. Его можно было бы уменьшить за счет оптимизации модуля пассивации OPO, например, Al 2 О 3 толщина, температура и продолжительность окисления озона. V TH смещается в положительную сторону V GS с повышением температуры PMA, что происходит из-за снижения CET и D это . Сделан вывод, что наилучшие электрические характеристики достигаются для полевых МОП-транзисторов на основе Ge с PMA при 500 ° C.
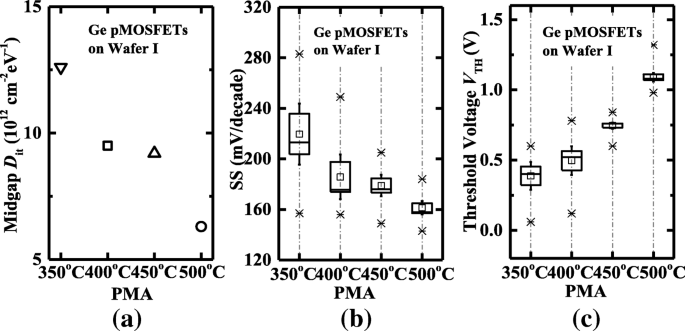
Сравнение а midgap D это , b SS и c V TH для Ge pMOSFET на пластине I с PMA при 350, 400, 450 и 500 ° C
μ eff , как решающий фактор, влияющий на ток возбуждения устройства и крутизну в Ge pMOSFET, был измерен с использованием Δ R малыш / Δ L G метод [18]. Большое количество устройств было измерено с помощью L G от 1,5 до 9 мкм. На рисунке 5а показано полное сопротивление R . малыш извлечено при | V GS - V TH | от - 1 В и В DS от - 0,05 В как функция от L G . R SD - значение, при котором подобранная линия пересекает точку y -ось. R SD оценочные значения составляют 7,85, 7,15, 6,10 и 4,35 кОм · мкм для устройств с PMA при 350, 400, 450 и 500 ° C соответственно. Это указывает на лучшую активацию легирующей примесью S / D при более высокой температуре PMA. μ eff может быть извлечен с помощью μ eff =1 / [ WQ inv (Δ R малыш / Δ L G )], где Q inv - инверсионная плотность заряда в канале Ge; Δ R малыш / Δ L G наклон R малыш по сравнению с L G как показано на рис. 5а. Чем меньше Δ R малыш / Δ L G для устройств с PMA при 500 ° C указывает на улучшение в μ eff по сравнению с транзисторами с ПМА при 450 ° С. На рисунке 5b показано μ . eff как функция от Q inv кривые, извлеченные с использованием разделения C - V метод. Пиковая подвижность дырок составляет 384 см 2 / В · с для устройств с PMA при 500 ° C, что на 31% выше, чем у устройств с PMA при 400 ° C. На высоком Q inv из 1 × 10 13 см −2 , Ge pMOSFET, подвергнутые PMA при 500 ° C, достигают большей мобильности по сравнению с устройствами, отожженными при 400 ° C. Ge-транзисторы с кристаллическим ZrO 2 имеют более низкую плотность объемного заряда ловушки, что приводит к меньшему удаленному кулоновскому рассеянию дырок по сравнению с устройствами с аморфным ZrO 2 . Благодаря гладкой границе раздела кристаллического ZrO 2 и устройства Ge, Ge, отожженные при 500 ° C, имеют более низкое рассеяние шероховатости поверхности и показывают сдвиг максимальной подвижности в сторону более высокого Q inv .
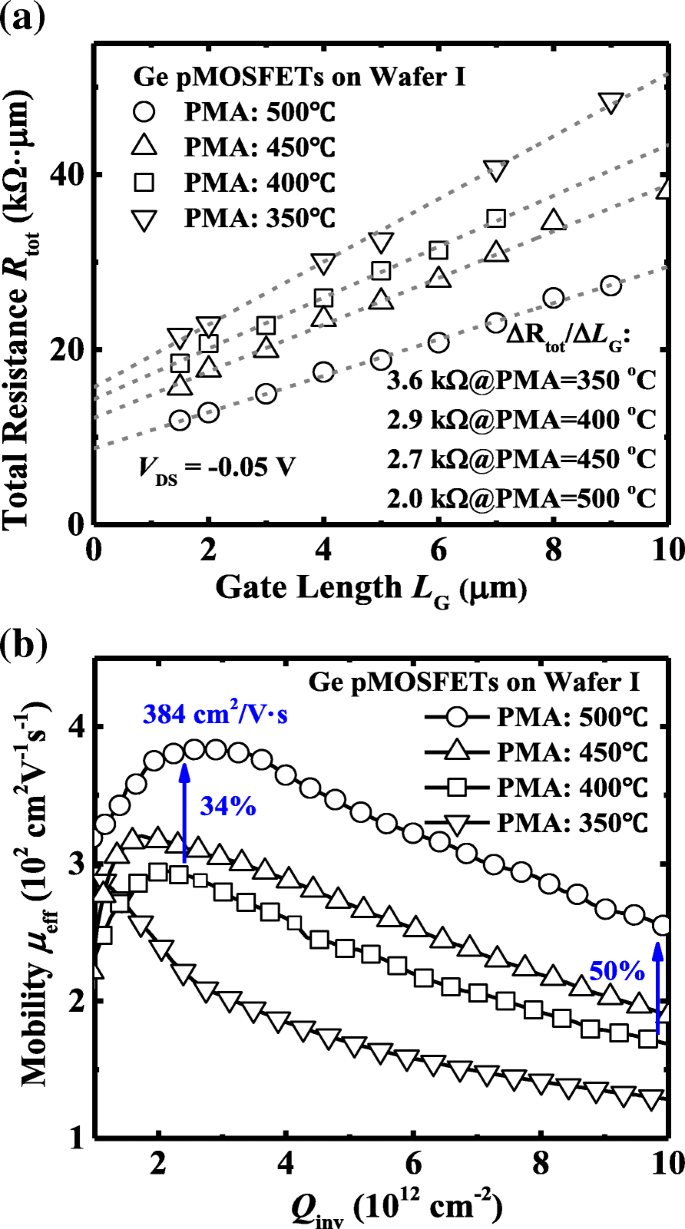
а R малыш как функция от L G при V GS - V TH от - 1 В и В DS - 0,05 В для устройств на пластине I с различными температурами ПМА. б μ eff vs. Q inv извлекается разделением C - V метод. Наибольшая мобильность достигается в устройствах с PMA при 500 ° C
Далее мы обсудим влияние КПК на электрические характеристики полевых МОП-транзисторов на основе Ge. На рисунке 6 показаны измеренные C inv по сравнению с V GS полевых МОП-транзисторов Ge на пластине I и пластине II с помощью PMA при 400 ° C. Устройство, которое подвергалось воздействию КПК при 400 ° C, имеет гораздо более низкое значение CET 1,29 нм по сравнению с устройством без КПК 1,80 нм. На рисунке 7a показан I D , Я S , и Я G - V GS характеристические кривые Ge pMOSFET на пластине I и пластине II, а также устройств, прошедших ФМА при 400 ° C. Для устройства с КПК получается больший ток утечки затвора по сравнению с транзистором без КПК, что связано с более низким CET. Соответствующий I DS - V DS кривые устройств, измеренные при разной перегрузке ворот V GS - V TH показаны на рис. 7б. Транзистор на основе Ge без КПК показывает увеличение тока возбуждения на ~ 24% по сравнению с транзистором с КПК при 400 ° C при том же перегрузке - 0,8 В в области насыщения.
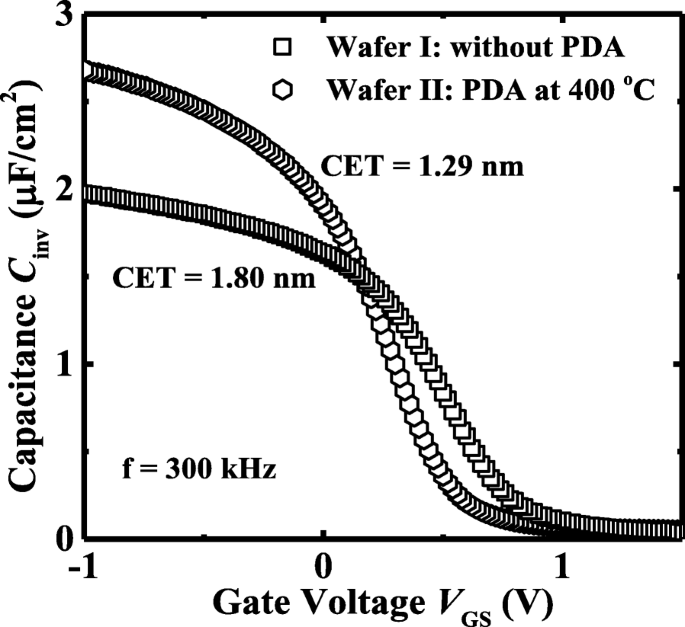
C inv -V GS графики для устройств на пластине I и II с PMA при 400 ° C
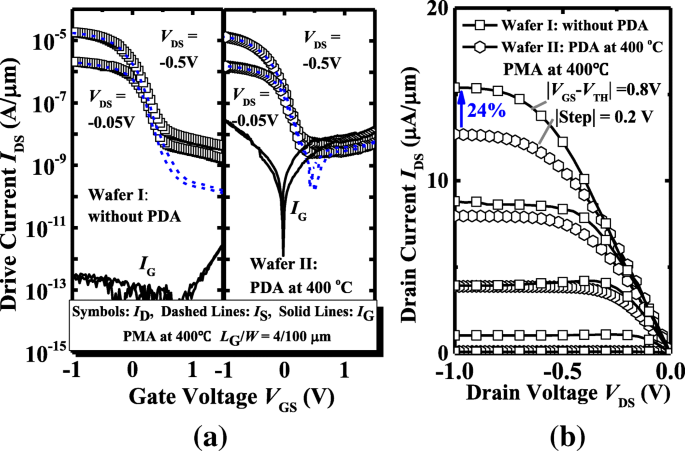
а Я D , Я S , и Я G vs. V GS кривые Ge pMOSFET на пластинах I и II с ФМА при 400 ° C. б Я DS - V DS кривые, измеренные при различных V GS - V TH для устройств
На рисунке 8 показаны статистические результаты среднего промежутка D это , SS и V TH полевых МОП-транзисторов Ge с КПК и без него. На рисунке 8a показано, что чем меньше D это достигается в Ge pMOSFET с КПК при 400 ° C по сравнению с устройствами без КПК. На рис. 8b нижнее значение среднего подпорогового размаха в 142 мВ / декаду достигается для устройств с КПК при 400 ° C, что соответствует нижнему CET и нижнему D . это . Это указывает на то, что устройства с КПК при 400 ° C имеют превосходный ZrO 2 / Ge интерфейс. На рисунке 8c показано, что устройства с КПК и без него имеют разные значения V . TH ; это может быть связано с плотностью ловушек в нижней половине запрещенной зоны, доминирующей в V TH .
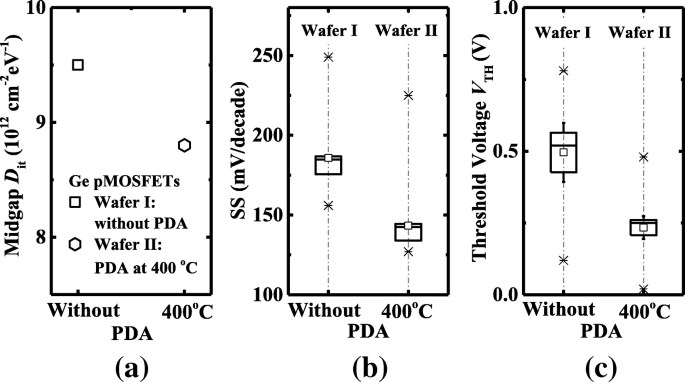
Сравнение а midgap D это , b SS и c V TH для Ge pMOSFET на пластинах I и II с PMA при 400 ° C
На рисунке 9a показан R малыш по сравнению с L G кривые при перегрузке гейта - 1 В и В DS - 0,05 В для устройств с ПМА при 400 ° C. R SD оценочные значения составляют 7,15 и 7,30 кОм · мкм для устройств без КПК и с КПК при 400 ° C соответственно. Как показано на рис. 9b, значительно более высокий пик μ eff достигается для Ge pMOSFET без КПК, что соответствует меньшему Δ R малыш / Δ L G на рис. 9а, в сравнении с устройствами с КПК. Устройства с КПК при 400 ° C показывают пик μ eff 211 см 2 /Против; более низкая подвижность дырок может быть в основном связана с сильным кулоновским рассеянием на удалении, вносимым фиксированным зарядом в ZrO 2 диэлектрик.
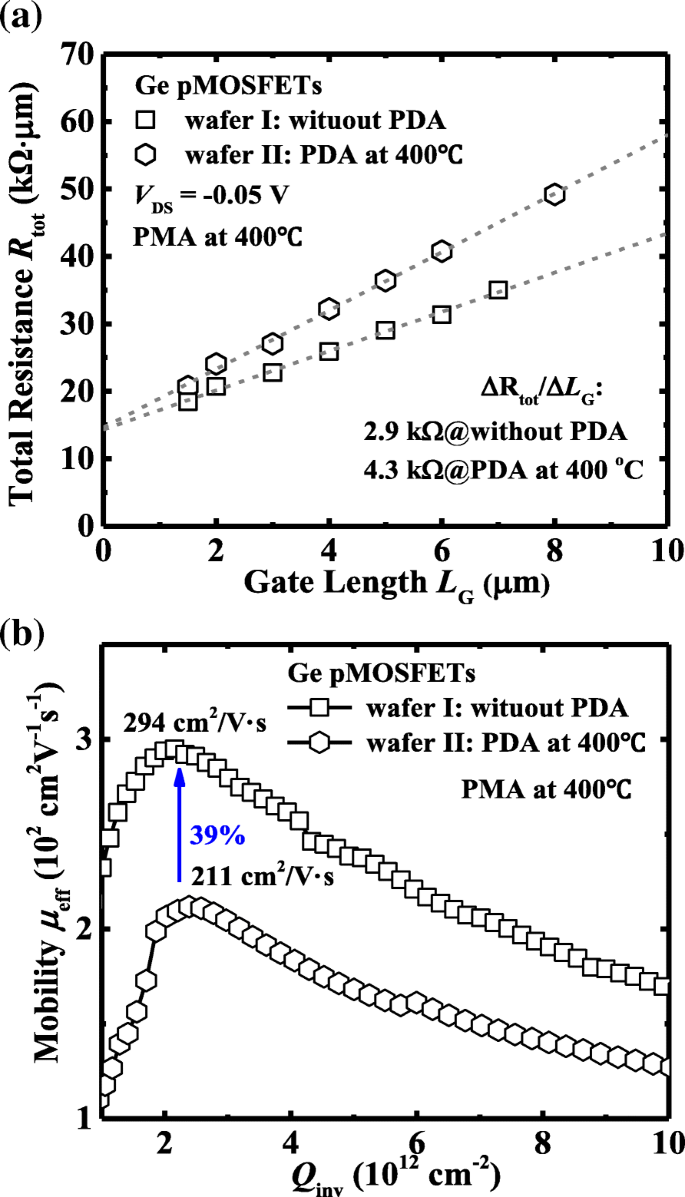
а R малыш по сравнению с L G кривые для устройств на пластине I и пластине II с ПМА при 400 ° C. б Подвижность дырок μ eff по сравнению с Q inv для устройств с КПК и без
Выводы
Таким образом, влияние PMA и PDA на Ge pMOSFET с ZrO 2 диэлектрик были широко исследованы. Кристаллизация ZrO 2 Диэлектрик затвора обеспечивает значительно повышенную подвижность отверстий и снижение CET по сравнению с устройствами с более низкой температурой PMA. Пиковая подвижность дырок 384 см 2 / В · с и повышенный ток возбуждения были достигнуты в устройствах с PMA при 500 ° C. Устройства с КПК при 400 ° C показали более низкий CET и меньший D это но плохая подвижность отверстий и больший ток утечки по сравнению с транзисторами без КПК.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью.
Сокращения
- ALD:
-
Осаждение атомного слоя
- BF 2 + :
-
Ион фторида бора
- CET:
-
Емкостная эффективная толщина
- Ge:
-
Германий
- HF:
-
Плавиковая кислота
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- IL:
-
Межфазный слой
- МОП-транзисторы:
-
Полевые транзисторы металл-оксид-полупроводник
- Ни:
-
Никель
- КПК:
-
Отжиг после осаждения
- PMA:
-
Последующий отжиг металла
- SS:
-
Подпороговое колебание
- TaN:
-
Нитрид тантала
- TDMAZr:
-
Тетракис (диметиламидо) гафний
- ZrO 2 :
-
Диоксид циркония
- μ eff :
-
Эффективная мобильность оператора связи
Наноматериалы
- KUHMUTE изменяет мобильность с помощью 3D-печати SLS
- Высокоскоростная 3D-печать с AFPM
- Высокоскоростная 3D-печать с AION500MK3
- Полный контроль терагерцовой поляризации с расширенной полосой пропускания через диэлектрические метапове…
- Резистивная память ZrO2 / ZrO2 - x / ZrO2 без соблюдения нормативных требований с управляемым межфазным режимом перек…
- Преобразователь поляризации с управляемым двулучепреломлением на основе гибридной метаповерхности полност…
- Высокоэффективный гибридный кремниевый элемент с органической наноструктурой и измененной структурой пове…
- Повышение диэлектрической проницаемости MIM-конденсаторов Al2O3 / ZrO2 / Al2O3 с атомным слоем за счет микроволнового…
- Безрезисторный источник опорного напряжения в наномасштабе с низким энергопотреблением и высоким PSRR
- Ge pMOSFET с высокой подвижностью и пассивированием аморфным Si:влияние ориентации поверхности



