Высокопроизводительные тонкопленочные транзисторы a-InGaZnO с чрезвычайно низким тепловым бюджетом за счет использования диэлектрика из Al2O3, богатого водородом
Аннотация
Электрические характеристики аморфных тонкопленочных транзисторов (TFT) на основе In-Ga-Zn-O (a-IGZO) сравниваются с использованием O 2 плазменное осаждение атомного слоя Al 2 О 3 диэлектрики при разных температурах. Высокопроизводительные тонкопленочные транзисторы a-IGZO успешно продемонстрированы с помощью Al 2 О 3 диэлектрик, осажденный при комнатной температуре, который демонстрирует высокую полевую подвижность 19,5 см 2 V - 1 s - 1 , небольшое подпороговое колебание 160 мВ / дек, низкое пороговое напряжение 0,1 В, большое отношение тока включения / выключения 4,5 × 10 8 и превосходная стабильность отрицательного и положительного смещения затвора. Это связано с богатым водородом Al 2 О 3 диэлектрик, осажденный при комнатной температуре по сравнению с более высокими температурами осаждения, таким образом эффективно пассивируя межфазные состояния a-IGZO / Al 2 О 3 и кислородные вакансии и улучшение проводимости канала a-IGZO за счет генерации дополнительных электронов из-за усиленного легирования водородом во время распыления IGZO. Такой чрезвычайно низкий тепловой баланс для высокопроизводительных тонкопленочных транзисторов a-IGZO очень привлекателен для гибкого электронного применения.
Фон
Тонкопленочные транзисторы (TFT) на основе аморфного In-Ga-Zn-O (a-IGZO) привлекли большое внимание в последнее десятилетие из-за их высокой мобильности, хорошей однородности, высокой прозрачности для видимого света и низкой температуры процесса [1, 2,3]. Эти достоинства делают его многообещающим кандидатом для применения в электронике следующего поколения, такой как прозрачный дисплей, гибкие устройства или носимая электроника. В частности, для приложений гибкой электроники TFT обычно изготавливаются на полимерных подложках с низкой термостойкостью. Таким образом, необходимо сократить тепловой бюджет изготовления a-IGZO TFT. С этой целью многие исследователи сосредоточили внимание на a-IGZO TFT с изоляторами затвора, изготовленными при комнатной температуре, такими как распыление [4,5,6], процесс растворения [7,8,9], испарение электронным пучком [10] и анодирование [11]. Однако эти диэлектрические пленки часто страдают от высокой плотности ловушек и сильного межфазного рассеяния диэлектрик / a-IGZO, что приводит к ограниченной подвижности полевого эффекта, большому подпороговому размаху и малому отношению тока включения / выключения [4,5,6 , 7,8,9,10,11].
С другой стороны, осаждение атомных слоев (ALD) является многообещающим методом, который может обеспечить получение высококачественных пленок, точный контроль толщины пленки, хорошую однородность на большой площади и низкую температуру процесса [12,13,14]. Zheng et al. [15] сообщили, что a-IGZO TFT с ALD SiO 2 диэлектрик показал отличные электрические характеристики без необходимости последующего отжига. Однако для ALD SiO 2 требуется высокая температура подложки 250 ° C. пленки [15], что выше температуры стеклования большинства гибких пластиковых подложек. Интересно, что сообщается, что ALD Al 2 О 3 пленки могут быть реализованы даже при комнатной температуре (RT) [16,17]; между тем, Аль 2 О 3 пленка, осажденная при КТ, содержит большое количество примесей водорода (H) [17]. Однако, насколько нам известно, вышеупомянутый H-богатый Al 2 О 3 Пленка никогда не использовалась в качестве изолятора затвора в a-IGZO TFT. Поэтому желательно изучить a-IGZO TFT с RT ALD Al 2 О 3 изолятор ворот.
В этом письме был успешно изготовлен высокопроизводительный a-IGZO TFT с нанесенным при комнатной температуре Al 2 О 3 затвор диэлектрик. Путем сравнения характеристик тонкопленочных транзисторов a-IGZO с различными Al 2 О 3 изоляторы затвора осаждались при разных температурах, был рассмотрен основной механизм.
Методы
Сильнолегированные кремниевые пластины p-типа (<0,0015 Ом · см) очищались стандартными процессами RCA и служили электродами затвора. Сорок нанометровый Al 2 О 3 пленки были нанесены в коммерческой системе ALD (Picsun Ltd.) с использованием триметилалюминия (ТМА) и O 2 плазма в качестве прекурсора и реагента соответственно. Один цикл роста состоял из импульса ТМА 0,1 с, 10 с N 2 продувка, 8 с O 2 плазменный импульс, и 10 с N 2 удалять. ТМА поддерживали при 18 ° C для стабильного давления пара и дозы, а O 2 скорость потока газа была зафиксирована на уровне 150 см3 / мин при мощности плазменного генератора 2500 Вт. Затем пленки a-IGZO толщиной 40 нм были нанесены методом высокочастотного распыления с использованием керамической мишени IGZO с атомным соотношением In:Ga:Zn:O =1. :1:1:4. Во время распыления рабочее давление и Ar и O 2 Расход газа был установлен на уровне 0,88 Па и 48 и 2 куб. м3 соответственно. Активная область формировалась методами фотолитографии и влажного травления. После этого были приготовлены электроды истока / стока из бислоев Ti 30 нм и Au 70 нм электронно-лучевым испарением и методом отрыва. Никаких дополнительных процессов отжига на этих устройствах не применялось.
Электрические свойства a-IGZO TFT были охарактеризованы с использованием анализатора полупроводниковых приборов (Agilent Tech B1500A) в темном боксе при комнатной температуре. Стабильность устройства измерялась при положительном и отрицательном смещении затвора соответственно. Глубинные профили элементов и химический состав были измерены с помощью масс-спектрометрии вторичных ионов (SIMS) и рентгеновской фотоэлектронной спектроскопии (XPS) соответственно.
Результаты и обсуждение
На рисунке 1а сравниваются диэлектрические проницаемости Al 2 . О 3 пленки, осажденные при различных температурах в зависимости от частоты (т. е. от 10 Гц до 10 5 Гц). При повышении температуры осаждения от 100 до 150 ° C диэлектрическая проницаемость пленки постепенно уменьшается. Подобная тенденция также отмечалась в предыдущей литературе при изменении температуры осаждения от RT до 150 ° C [18, 19]. Это потому, что RT Al 2 О 3 пленка содержит самую высокую концентрацию водорода (H) в виде групп ОН. Таким образом, соответствующая диэлектрическая проницаемость увеличивается за счет вращения большего количества групп ОН в электрическом поле [20]. Что касается частоты измерения 10 Гц, извлеченные диэлектрические постоянные для RT, 100 ° C и 150 ° C Al 2 О 3 пленки равны 8,6, 7,9 и 7,4 соответственно, которые используются для извлечения полевой подвижности ( μ FE ) и межфазной плотности ловушек ( D это ) изготовленного TFT-устройства. На рисунке 1b показаны характеристики тока утечки различных Al 2 . О 3 фильмы. Установлено, что RT Al 2 О 3 пленка имеет небольшую плотность тока утечки 2,38 × 10 - 8 А / см 2 при 2 МВ / см и электрическом поле пробоя 5,3 МВ / см. Кроме того, электрическое поле пробоя постепенно увеличивается с увеличением температуры осаждения от 100 до 150 ° C.
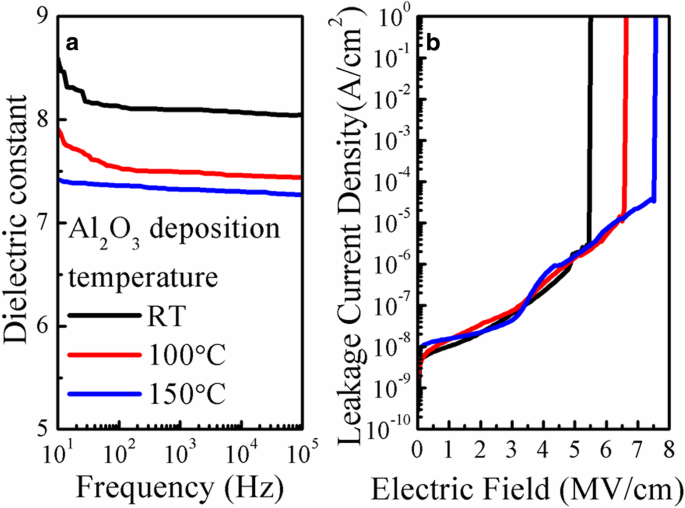
Электрические свойства Al 2 О 3 пленки, осажденные при разных температурах. а Диэлектрическая проницаемость в зависимости от частоты. б Плотность тока утечки в зависимости от электрического поля
На рисунке 2 показаны типичные переходные кривые для тонкопленочных транзисторов a-IGZO с различным содержанием Al 2 . О 3 изоляторы ворот. РТ Аль 2 О 3 TFT показывает лучшую производительность, например высокий μ FE 19,5 см 2 V - 1 s - 1 , малое подпороговое колебание (SS) 160 мВ / дек, небольшое пороговое напряжение ( В T ) 0,1 В и большой коэффициент включения / выключения ( I вкл / выкл ) 4,5 × 10 8 . Однако тонкопленочные транзисторы a-IGZO с Al 2 О 3 изоляторы затвора, осажденные как при 100, так и при 150 ° C, показывают гораздо худшие характеристики, т. е. меньшие токи включения (10 - 7 и 3 × 10 - 9 А) и деградированный СС. D это на интерфейсе Al 2 О 3 / a-IGZO можно рассчитать на основе следующего уравнения [21]:
$$ {D} _ {\ mathrm {it}} =\ left (\ frac {\ mathrm {SS} \ times \ lg e} {kT / q} -1 \ right) \ frac {C_ {ox}} { q ^ 2} $$ (1)где e , k , Т , и q представляют собой число Эйлера, постоянную Больцмана, абсолютную температуру и единичный заряд электрона соответственно. C бык - диэлектрическая емкость затвора на единицу площади. Для РТ Аль 2 О 3 TFT, D это равно 1,1 × 10 12 эВ - 1 см - 2 , что более чем в 1-2 раза ниже, чем у TFT с Al 2 О 3 изоляторы ворот наплавленные при 100 и 150 ° С.

Кривые передачи a-IGZO TFT с ALD Al 2 О 3 изоляторы затвора, наплавленные при разных температурах вместе с извлеченными параметрами устройства
Стабильность смещения затвора устройств была дополнительно измерена путем приложения отрицательного и положительного напряжения. На рисунке 3 показан V T сдвиг как функция времени напряжения смещения для различных TFT. Что касается отрицательного напряжения смещения затвора (NGBS), RT Al 2 О 3 TFT показывает незначительное V T сдвиг -0,04 В после напряжения -10 В в течение 40 мин. Однако более высокотемпературный Al 2 О 3 изоляторы ворот генерируют больше V T сдвигается особенно на 150 ° C. Такая высокая стабильность NGBS для RT Al 2 О 3 следует отнести к низкой концентрации кислородных вакансий ( V O ) в канале a-IGZO [22]. Что касается положительного напряжения смещения затвора (PGBS), RT Al 2 О 3 TFT показывает V T сдвиг 1,47 В, что намного меньше значений (8,8 В и 12,1 В) для Al 2 при 100 и 150 ° C О 3 TFT. Кроме того, было исследовано влияние времени хранения на характеристики устройства, как показано на рис. 4. Хотя задний канал не покрыт пассивирующим слоем, устройство по-прежнему сохраняет отличные характеристики после хранения в шкафу (относительная влажность 20%). 60 дней при 30 ° С; между тем, нет значительных изменений в μ FE и СС наблюдаются. Это указывает на RT Al 2 О 3 TFT без пассивирующего слоя обладают хорошей стабильностью в зависимости от времени хранения в текущих условиях.

V T сдвиг как функция времени напряжения смещения при NGBS =- 10 В и PGBS =10 В для TFT с Al 2 О 3 изоляторы нанесены при разных температурах

Стабильность RT Al 2 в зависимости от времени О 3 TFT после хранения в шкафу (относительная влажность 20%) при 30 ° C. а Кривые передачи. б Подвижность и подпороговые колебания
В таблице 1 сравниваются характеристики нашего RT Al 2 О 3 TFT с другими отчетами. Было обнаружено, что наше устройство показывает близкий к нулю V T , меньшая SS и большая I вкл / выкл в случае сопоставимой подвижности [4, 23]. Хотя используется Ta 2 О 5 изолятор затвора может получить более высокую подвижность 61,5 см 2 V - 1 s - 1 , как SS, так и I вкл / выкл значительно ухудшаются [10]. Одним словом, наш RT Al 2 О 3 TFT обладает превосходными характеристиками по сравнению с Al 2 при 100 и 150 ° C. О 3 TFT. Поскольку все этапы обработки идентичны, за исключением этапа нанесения Al 2 О 3 , такие значительные различия в электрических характеристиках должны происходить от Al 2 О 3 изоляторы ворот.
Чтобы понять основной механизм, глубинные профили элементов в a-IGZO / Al 2 О 3 сложенные пленки были проанализированы СМИС. На рис. 5а показана зависимость концентрации H от глубины в стопках IGZO / Al 2 . О 3 , где Al 2 О 3 Пленки осаждали при КТ и 150 ° C соответственно. Для сравнения также была проанализирована пленка IGZO, нанесенная на голую подложку Si. Пленка IGZO, нанесенная на чистый Si, содержит концентрацию H ~ 3 × 10 21 . см - 3 , который возникает из остаточного газа в системе распыления и абсорбированного H 2 / H 2 Молекулы O на поверхности Si. Обе пленки IGZO, нанесенные на Al 2 О 3 пленки содержат более высокие концентрации H, чем на голой подложке Si. Это указывает на то, что повышенные концентрации H должны происходить из-за высвобождения примесей H в нижележащем Al 2 О 3 пленки при напылении ИГЗО. Кроме того, наблюдается, что концентрация H в пленке IGZO поверх RT Al 2 О 3 пленка выше, чем на 150 ° C, в приграничной области, что может обеспечить более эффективную пассивацию межфазных состояний. Таким образом, улучшается стабильность SS и PGBS RT Al 2 О 3 TFT за счет уменьшения захвата межфазных носителей. Кроме того, O 1s XPS-спектры пленок a-IGZO вблизи границы раздела IGZO / Al 2 О 3 были проанализированы, как показано на рис. 5b. Соответствующие пики расположены при 530,2 ± 0,1 эВ, 530,9 ± 0,1 эВ и 531,6 ± 0,1 эВ, что соответствует O 2- ионы, связанные с металлом (O1), V O (O2) и OH-группы (O3) соответственно [13, 24]. Процент O2 составляет 26,3% в слое a-IGZO поверх чистого Si; однако она снижается до 12,3% и 6,8% для 150 ° C и RT Al 2 О 3 лежащие в основе пленки соответственно. Это означает, что больше V O в канале IGZO может быть эффективно пассивирован дополнительными примесями H, происходящими из нижележащего Al 2 О 3 пленки, специально для RT Al 2 О 3 пленка с более высокой концентрацией H. Сообщается, что когда V O и H оба присутствуют в пленке a-IGZO, они могут объединяться, чтобы сформировать стабильное состояние, в котором H удерживается на V O ( V O H), и полученный V O H - донор мелкого уровня [25,26,27]. Таким образом, усиленное легирование H в канал IGZO поверх RT Al 2 О 3 улучшает проводимость канала за счет дополнительных электронов. Кроме того, маленький V T сдвиг под НГБС по РТ Аль 2 О 3 TFT также можно отнести к эффективной H-пассивации V O [28]. Как сообщается в литературе, нестабильность TFT под NGBS происходит из-за ионизации нейтрального V O ( V O → V O 2+ + 2e - ) [17, 29]. Кроме того, процентное содержание O3 в пленке a-IGZO на RT Al 2 О 3 составляет 6,9%, что выше, чем у 150 ° C Al 2 О 3 (5,3%) и чистый Si (4,6%) соответственно. Группа ОН могла возникнуть в результате реакции O 2- + H → OH - + E - при нанесении пленок IGZO [30]. Таким образом, усиленное легирование H в канал IGZO поверх RT Al 2 О 3 пленка генерирует больше групп ОН, а также способствует улучшению проводимости канала.

а SIMS-профили концентрации водорода в Al 2 О 3 осажден при комнатной температуре и 150 ° C. б O1s XPS-спектры высокого разрешения канала IGZO, нанесенного на RT Al 2 О 3 , 150 ° С Al 2 О 3 , и голый Si
Выводы
Высокопроизводительный a-IGZO TFT был успешно изготовлен при чрезвычайно низком тепловом балансе RT с использованием H-богатого Al 2 О 3 диэлектрик затвора, изготовленный из O 2 ALD с плазменным усилением. Это объясняется тем, что Al 2 О 3 диэлектрик, осажденный при КТ, содержит больше примесей водорода, чем осажденный при более высоких температурах. Таким образом, высвободившиеся примеси H во время распыления IGZO генерировали больше электронов и эффективно пассивировали межфазные состояния a-IGZO / Al 2 О 3 и V O в канале a-IGZO.
Сокращения
- a-IGZO:
-
Аморфный In-Ga-Zn-O
- ALD:
-
Осаждение атомного слоя
- D это :
-
Плотность межфазной ловушки
- H:
-
Водород
- I вкл / выкл :
-
Коэффициент текущей / выключенной текущей ликвидности
- NGBS:
-
Отрицательное напряжение смещения затвора
- PGBS:
-
Положительное напряжение смещения затвора
- RT:
-
Комнатная температура
- SIMS:
-
Масс-спектрометрия вторичных ионов
- SS:
-
Подпороговое колебание
- TFT:
-
Тонкопленочный транзистор
- V O :
-
Кислородная вакансия
- V O H:
-
Водород, захваченный кислородной вакансией
- V T :
-
Пороговое напряжение
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- μ FE :
-
Полевая подвижность
Наноматериалы
- Оборудование для 3D-печати из высококачественных материалов
- Использование эпоксидной смолы для художественных работ
- Полный контроль терагерцовой поляризации с расширенной полосой пропускания через диэлектрические метапове…
- Многослойные полевые транзисторы SnSe Nanoflake с низкоомными Au-омическими контактами
- Значительное повышение теплопроводности силиконового композита с помощью сверхдлинных медных нанопроволок
- Изготовление упорядоченного наноразмерного рисунка с использованием триблочного сополимера ABC с солью в тол…
- Серебряный затворный электрод с УФ-отверждением для струйной печати с низким электрическим сопротивлением
- Совместно модифицированные ТИМы RGO и трехмерных графеновых сетей с высокой производительностью
- Атомное осаждение нанопленок оксида индия для тонкопленочных транзисторов
- Повышение производительности устройства a-IGZO TFT с использованием процесса чистого интерфейса через нано-слои…



