Германиевые полевые транзисторы с отрицательной емкостью:влияние состава Zr в Hf1-xZrxO2
Аннотация
Германиевые (Ge) полевые транзисторы с отрицательной емкостью (NCFET) с различным составом Zr в Hf 1− x Zr x О 2 ( x =0,33, 0,48 и 0,67) изготовлены и охарактеризованы. Для каждого состава Zr NCFET демонстрирует внезапное падение в некоторых точках подпорогового колебания (SS), которое вызвано NC-эффектом. Управляющий ток I DS увеличивается с повышением температуры отжига, что должно быть связано с уменьшением сопротивления истока / стока и улучшенной подвижностью носителей. Крутые точки SS воспроизводимы и стабильны благодаря многократным измерениям с качанием постоянного тока, что доказывает, что они вызваны эффектом NC. Значения напряжения затвора В GS соответствующие крутым СС последовательны и по часовой стрелке I DS - V GS поддерживаются в течение нескольких циклов постоянного тока. При фиксированной температуре отжига устройство ЧПУ с Hf 0,52 Zr 0,48 О 2 достигает более высокого я DS но больший гистерезис по сравнению с другими составами. NCFET с Hf 0,67 Zr 0,33 О 2 может получить отличные характеристики с кривыми без гистерезиса и высоким I DS .
Фон
Сегнетоэлектрический полевой транзистор с отрицательной емкостью (NCFET) с сегнетоэлектрической пленкой, вставленной в стопку затвора, является многообещающим кандидатом для приложений с малой мощностью рассеивания благодаря его способности преодолевать фундаментальные ограничения в подпороговом колебании (SS) для обычных металлических конструкций. оксидно-полупроводниковый полевой транзистор (MOSFET) [1]. Явление отрицательной емкости (NC) в NCFET широко изучалось в различных материалах каналов, включая кремний (Si) [2, 3], германий (Ge) [4], германий-олово (GeSn) [5], III – V [6], 2D материалы [7]. Кроме того, характеристики NC были продемонстрированы в NCFET с различными сегнетоэлектриками, такими как BiFeO 3 [8], PbZrTiO 3 (PZT) [9], PVDF [10] и Hf 1− x Zr x О 2 [11]. По сравнению с другими сегнетоэлектриками Hf 1− x Zr x О 2 имеет то преимущество, что он совместим с интеграцией CMOS. Экспериментальные исследования показали, что электрические характеристики NCFET можно оптимизировать, варьируя толщину и площадь Hf 1− x Zr x О 2 , который влияет на согласование емкости МОП ( C MOS ) и сегнетоэлектрической емкости ( C FE ) [12, 13]. Ожидается, что состав Zr в Hf 1− x Zr x О 2 также имеет большое влияние на характеристики NCFET, поскольку определяет сегнетоэлектрические свойства Hf 1− x Zr x О 2 . Однако до сих пор отсутствует подробное исследование влияния состава Zr на электрические характеристики полевых транзисторов с полевым транзистором.
В этой статье мы всесторонне изучаем влияние температуры отжига и состава Zr на характеристики Ge NCFET.
Методы
Основные этапы процесса изготовления Ge p-канальных NCFET с различным составом Zr в Hf 1− x Zr x О 2 показаны на рис. 1 (а). После предварительной очистки подложки n-Ge (001) загружали в камеру осаждения атомного слоя (ALD). Тонкий Al 2 О 3 (25 циклов) была нанесена пленка, за которой последовала O 3 пассивация. Тогда Hf 1- x Zr x О 2 пленки (x =0,33, 0,48 и 0,67) были осаждены в той же камере ALD с использованием [(CH 3 ) 2 N] 4 Hf (TDMAHf), [(CH 3 ) 2 N] 4 Zr (TDMAZr) и H 2 O в качестве предшественников Hf, Zr и O соответственно. После этого металлический затвор TaN был нанесен методом реактивного распыления. После формирования рисунка затвора и травления ионы бора (B + ) были имплантированы в области истока / стока (S / D) с энергией 20 кэВ и дозой 1 × 10 15 см −2 . Несамоцентрированные S / D-металлы были сформированы методом отрыва. Наконец, был проведен быстрый термический отжиг (RTA) при различных температурах для активации легирующей примеси, S / D металлизации и кристаллизации Hf 1− x Zr x О 2 фильм. Ge управляют полевыми МОП-транзисторами с Al 2 О 3 / HfO 2 стек также был изготовлен.

( а ) Ключевые этапы процесса изготовления Ge NCFET с различным составом Zr в Hf 1 −x Zr x О 2 сегнетоэлектрики. ( б ) Схема изготовленного NC-транзистора. ( c ) ПЭМ-изображение стека затвора устройства ЧПУ, иллюстрирующее 7 нм H 0,52 Zr 0,48 О 2 слой и 2 нм Al 2 О 3 слой
Рисунок 1 (b) показывает схему изготовленного NCFET. Изображение, полученное с помощью просвечивающего электронного микроскопа высокого разрешения (HRTEM) на рис. 1 (c), показывает стек затворов на канале Ge устройства с Hf 0,52 Zr 0,48 О 2 сегнетоэлектрик. Толщина Al 2 О 3 и Hf 0,52 Zr 0,48 О 2 слои составляют 2 нм и 7 нм соответственно.
Для подтверждения стехиометрии Hf 1− x Zr x О 2 , было выполнено измерение рентгеновской фотоэлектронной спектроскопии (XPS). На рис. 2 (а) и (б) показан Hf 4f и Zr 3d спектры остовного уровня фотоэлектронов соответственно для Hf 0.67 Zr 0,33 О 2 , Hf 0,52 Zr 0,48 О 2 , и Hf 0,33 Zr 0,67 О 2 фильмы. Состав материалов был рассчитан на основе отношения площадей пиков и соответствующих факторов чувствительности. Два пика Zr 3d 5/2 и Zr 3d 3/2 имеют спин-орбитальное расщепление 2,4 эВ, что подтверждается работами [5,11]. [14, 15]. С увеличением состава Zr в Hf 1− x Zr x О 2 , Zr 3d , и Hf 4f пики смещаются в сторону более низкой энергии.

( а ) Hf 4f и ( b ) Zr 3d спектры основного уровня для Hf 1− x Zr x О 2 образцы с различным составом Zr
Сегнетоэлектрические свойства Hf 1− x Zr x О 2 фильмы ( x =0,33, 0,48 и 0,66) характеризовались поляризацией P от напряжения привода В измерение петель гистерезиса. P - V петли записывались на первозданных приборах. На рисунке 3 показаны кривые P по сравнению с V для TaN / Hf 1− x Zr x О 2 (10 нм) / TaN в серии управляющих напряжений. При повышении температуры после отжига с 500 до 550 ° C P - V кривые Hf 1− x Zr x О 2 имеют тенденцию быть насыщенными в состоянии подпетля. По мере увеличения состава Zr остаточная поляризация пленки, очевидно, улучшается, и наблюдается утончение петли гистерезиса при нулевом смещении, что феноменологически лучше всего можно описать как наложение антисегнетоэлектрических характеристик [16,17].
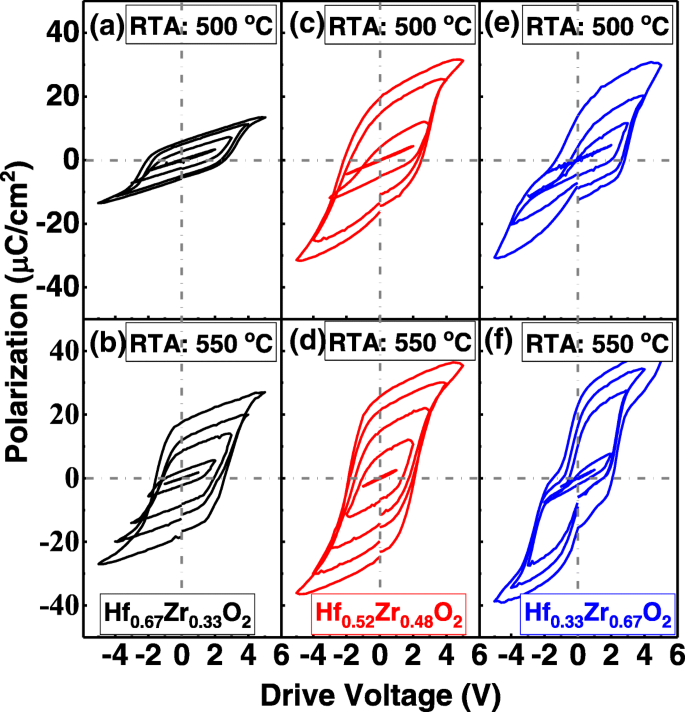
Измеренные кривые P-V Hf 1-x Пленки ZrxO2 с различным составом Zr, отожженные при 500 и 550 o С. ( а ) и ( b ) являются Hf 0,67 Zr 0,33 О 2 пленка отожженная при 500 и 550 o C соответственно. ( c ) и ( d ) являются Hf 0,52 Zr 0,48 О 2 пленка отожженная при 500 и 550 o C соответственно. ( е ) и ( f ) равны Hf 0,33 Zr 0,67 О 2 пленка отожженная при 500 и 550 o C соответственно. С постотжигом температура увеличивается с 500 до 550 o C, кривые P-V Hf 1-x Zr x О 2 имеют тенденцию быть насыщенными в состоянии подпетля. При увеличении состава Zr наблюдается эволюция сегнетоэлектрика к антисегнетоэлектрическому поведению
Результаты и обсуждение
На рисунке 4 (а) показаны измеренные передаточные характеристики Ge NCFET с Hf 0,52 . Zr 0,48 О 2 сегнетоэлектрики с разными температурами отжига и устройством контроля с Al 2 О 3 / HfO 2 стековый диэлектрик. Контрольное устройство отжигали при 500 ° C. Все устройства имеют длину затвора L G 2 мкм. Прямая и обратная развертки обозначены открытыми и сплошными символами соответственно. NCFET имеют гораздо более высокий ток возбуждения по сравнению с устройством управления. Видно, что при увеличении температуры отжига от 450 до 550 ° C пороговое напряжение V TH устройств ЧПУ смещаются на положительный V GS направление. NCFET демонстрируют небольшой гистерезис, которым можно пренебречь с увеличением температуры RTA. Эффект захвата также приводит к гистерезису, но это приводит к появлению против часовой стрелки I DS - V GS петле, противоположной результатам, вызванным сегнетоэлектрическим переключением [18]. Точка SS против I DS Кривые на рис. 4 (b) показывают, что NC-транзистор демонстрирует резкое падение в некоторых точках SS, соответствующее резкому изменению I DS индуцированный эффектом NC [19]. Замечено, что NCFET достигают улучшенных характеристик SS по сравнению с устройством управления. Мы обнаружили, что точки внезапного падения устройств совпадают при разных температурах отжига. Измеренный I DS - V DS кривые NCFET с Hf 0,52 Zr 0,48 О 2 сегнетоэлектрики, отожженные при различных температурах, показаны на рис. 4 (c). Я DS - V DS Кривые NC-транзистора демонстрируют очевидное явление NDR, которое является типичной характеристикой NC-транзисторов [20,21,22,23]. Рисунок 4 (d) - это графики I DS Ge NCFET с Hf 0,52 Zr 0,48 О 2 сегнетоэлектрический слой, отожженный при 450, 500 и 550 ° C, соответственно, при V DS =- 0,05 В и - 0,5 В, и | V GS - V TH | =1,0 В. Здесь V TH определяется как V GS в I DS из 10 −7 А / мкм. Я DS увеличивается с увеличением температуры RTA, что связано с уменьшением сопротивления истока / стока и улучшенной подвижностью носителей при более высокой температуре отжига.
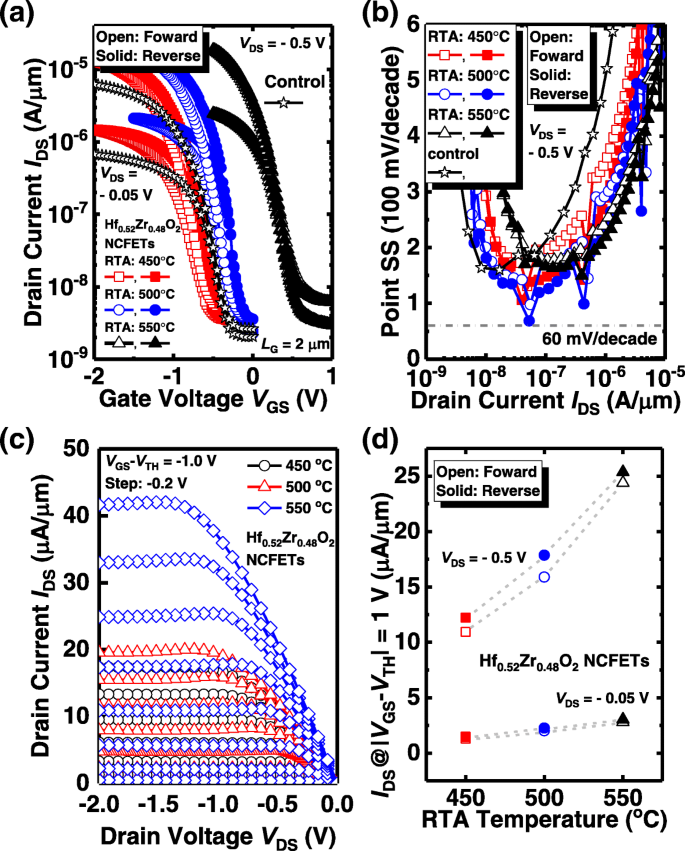
( а ) Измерено I DS - V GS кривые для NCFET с Hf 0,52 Zr 0,48 О 2 сегнетоэлектрик и устройство управления. ( б ) Точка SS против I DS кривые, показывающие, что у NCFET более крутая SS по сравнению с контрольным MOSFET. ( c ) Я DS - V DS кривые для NCFET, демонстрирующие типичные явления NDR. ( д ) Сравнение I DS для NCFET, отожженных при различных температурах с перегрузкой затвора 1 В
В дополнение к Hf 0,52 Zr 0,48 О 2 сегнетоэлектрических транзисторов, мы также исследуем электрические характеристики Ge NC-транзисторов с Hf 0,33 Zr 0,67 О 2 сегнетоэлектрик. На рисунке 5 (а) показан I DS - V GS характеристики устройств с ВЧ 0,33 Zr 0,67 О 2 с разными температурами отжига при V DS =- 0,05 В и - 0,5 В. По сравнению с Hf 0,52 Zr 0,48 О 2 У NC транзисторов получается еще меньший гистерезис. Аналогично Hf 0,52 Zr 0,48 О 2 Транзисторы с ЧПУ, при повышении температуры отжига с 450 до 550 ° C V TH увеличения устройства с -0,63 В до 0,51 В при прямой развертке при V DS =- 0,05 В. Точка SS как функция от I DS характеристики для Hf 0,33 Zr 0,67 О 2 сегнетоэлектрические NCFET изображены на рис. 5 (б). Кроме того, устройства с температурой отжига 450 ° C и 500 ° C получают более очевидное резкое падение SS по сравнению с отожженным транзистором на 550 ° C. Внезапные точки падения при разных температурах отжига происходят при одном и том же напряжении затвора. На рис. 5 (c) показаны прямые и обратные I DS Hf 0,33 Zr 0,67 О 2 NCFET в V DS =- 0,05 В и - 0,5 В, и | V GS - V TH | =1,0 В. Независимо от того, идет ли речь о прямой или обратной развертке, I DS увеличивается с ростом температуры отжига, что согласуется с характеристикой Hf 0,52 Zr 0,48 О 2 устройство.
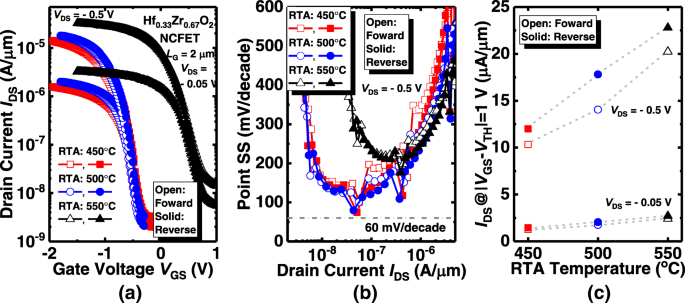
( а ) Измеренные передаточные характеристики Hf 0,33 Zr 0,67 О 2 NC Ge pFET отожжены от 450 до 550 ° C. ( б ) Точка SS как функция от I DS для Hf 0,33 Zr 0,67 О 2 устройств. ( c ) Я DS для сегнетоэлектрических NC-транзисторов с разными температурами отжига при перегрузке затвора 1 В
Мы также исследуем электрические характеристики Ge NCFET с меньшим составом Zr. Передаточные характеристики Hf 0.67 Zr 0,33 О 2 NCFET, отожженные при различных температурах отжига, представлены на рис. 6 (а). Явления гистерезиса не наблюдается. По сравнению с Hf 0,33 Zr 0,67 О 2 и Hf 0,52 Zr 0,48 О 2 устройства, V TH сдвиг, вызванный изменением температуры отжига, менее выражен в Hf 0,67 Zr 0,33 О 2 NCFET. Точка SS против I DS кривые на рис. 6 (б) показывают, что Hf 0,67 Zr 0,33 О 2 Транзистор NC показывает внезапное падение SS транзистора NC в некоторых точках при V DS =- 0,05 В. На рис. 6 (с) представлены значения I DS из Hf 0,67 Zr 0,33 О 2 Ge NCFET отожжены при 450 ° C, 500 ° C и 550 ° C, при V DS =- 0,05 В и - 0,5 В, и | V GS - V TH | =1,0 В. Аналогично, I DS усиливается при повышении температуры RTA.
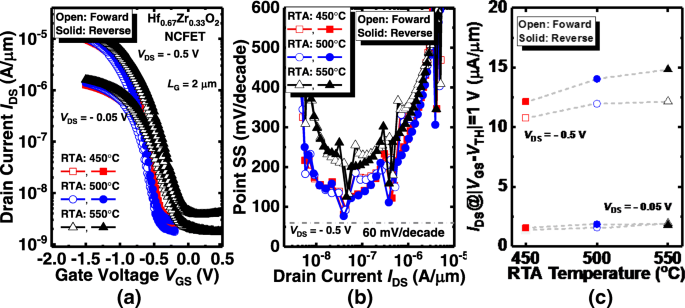
( а ) Измерено I DS - V GS Hf 0,67 Zr 0,33 О 2 NC Ge pFET отожжены при 450 ° C, 500 ° C и 550 ° C. ( б ) Точка SS против I DS характеристики устройств. ( c ) Я DS для сегнетоэлектрических NC-транзисторов с разными температурами отжига при перегрузке затвора 1 В
Устойчивость эффекта NC, индуцированного сегнетоэлектрическим слоем Hf 0,52 Zr 0,48 О 2 NCFET был подтвержден множественными измерениями постоянного тока. Измеренный I DS - V GS кривые за 100 циклов свипирования постоянного тока показаны на рис. 7 (а). Видно, что значения V GS соответствующие крутым СС согласуются. Кроме того, по часовой стрелке I-V петли поддерживаются через несколько циклов постоянного тока. Крутые точки SS воспроизводятся и стабильны при многократном сканировании по постоянному току, что еще раз доказывает, что они вызваны NC-эффектом. На рис. 7 (b) представлена лучшая точка SS и ток возбуждения по количеству циклов свипирования. На рисунке 7 (c) показаны характеристики гистерезиса как функция количества циклов качания постоянного тока. Стабильный I-V видно окно гистерезиса ~ 82 мВ.
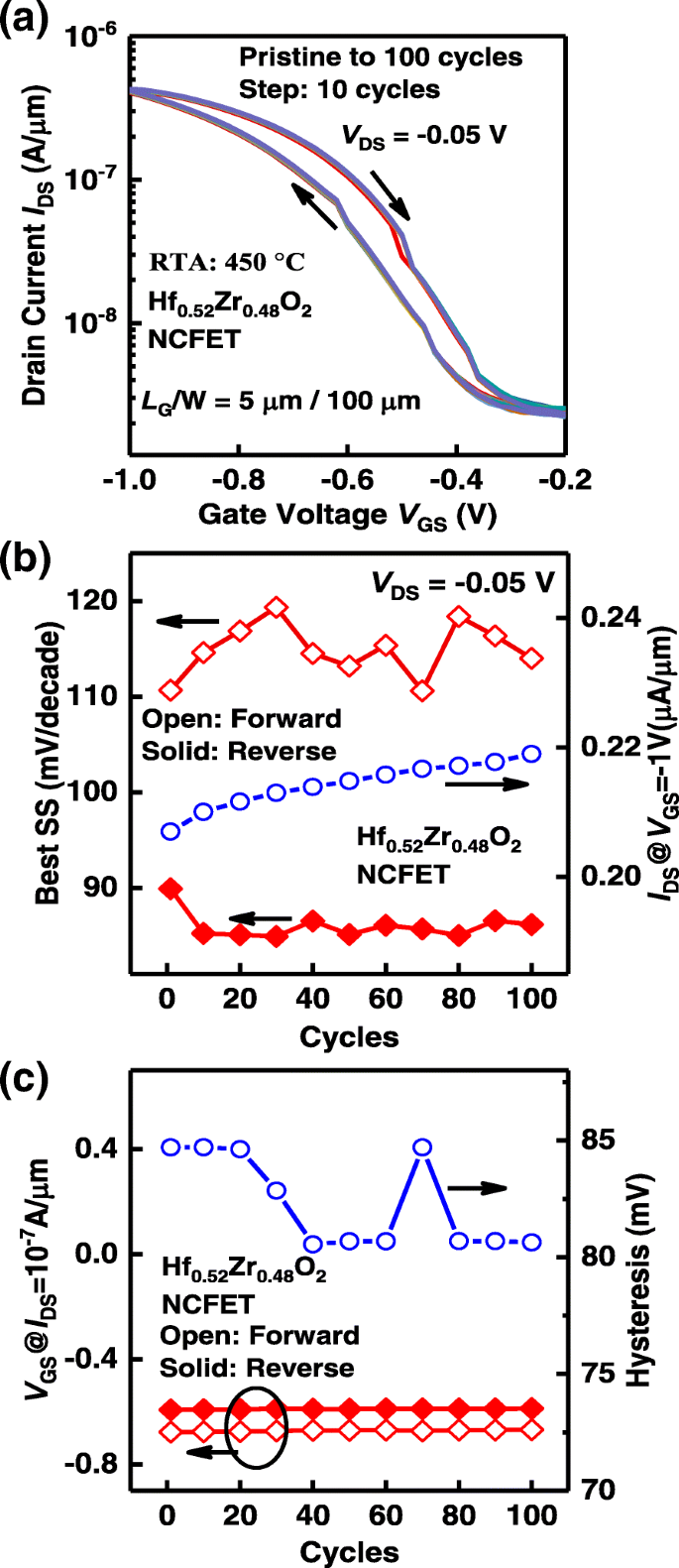
( а ) Измерено I DS - V GS кривые Hf 0,52 Zr 0,48 О 2 NC Ge pFET более 100 циклов свипирования по постоянному току. ( б ) Лучшая точка SS и I DS по сравнению с номером цикла. ( c ) Характеристики гистерезиса как функция количества циклов качания постоянного тока
Мы суммируем гистерезисные и управляющие токовые характеристики Ge NCFET с различным составом Zr в Hf 1− x Zr x О 2 на рис. 8. Как показано на рис. 8 (а), значения гистерезиса составляют 70, 148 и 106 мВ для устройств с x =0,33, 0,48 и 0,67 соответственно при V DS - 0,5 В. При увеличении состава от 0,33 до 0,48 гистерезис устройства ЧПУ значительно увеличивается. При дальнейшем увеличении состава Zr гистерезис быстро уменьшается. Я DS NCFET, отожженных при 450 ° C, показан на рис. 8 (b), при V DS =- 0 . 5 В и В GS - V TH =- 1 . 0 В. Незакрашенный и сплошной означает прямую и обратную развертку соответственно. Устройство ЧПУ с Hf 0,52 Zr 0,48 О 2 достигает наивысшего Я DS , но гистерезис у него серьезный. NCFET с Hf 0,67 Zr 0,33 О 2 может получить отличные характеристики с кривыми без гистерезиса и высоким I DS . По мере увеличения состава Zr сегнетоэлектрическая емкость C fe (=0,3849 * P r / ( E c * т fe ) [24]) увеличивается с увеличением P r , а между тем, емкость МОП ( C MOS ) также возрастает из-за роста диэлектрической проницаемости пленки HZO. Я DS и гистерезис определяются | C fe | и C MOS транзистора. При увеличении состава Zr с 0,33 до 0,48 увеличение | C fe | предполагается, что он медленнее, чем C MOS , что приводит к увеличению гистерезиса. Тем не менее, чем больше C MOS производит более высокое I DS . При дальнейшем увеличении состава Zr увеличение | C fe | быстрее, чем C MOS , который может предоставить | C fe | ≥ C MOS , уменьшая гистерезис NCFET.
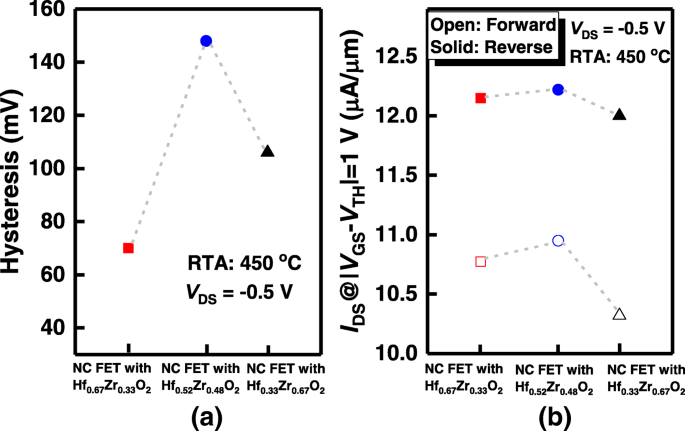
Статистические графики ( a ) гистерезис и ( b ) Я DS Ge NCFET с Hf 1− x Zr x О 2 ( x =0,33, 0,48 и 0,67)
Выводы
Влияние температуры отжига и состава Zr в Hf 1 −x Zr x О 2 на электрические характеристики Ge NCFETs экспериментально изучены. Стехиометрия и сегнетоэлектрические свойства Hf 1− x Zr x О 2 были подтверждены XPS и P-V измерения соответственно. NCFET демонстрируют крутую точку SS и улучшенный I DS по сравнению с устройством управления из-за NC-эффекта. V TH и я DS из Hf 1 −x Zr x О 2 NCFET сильно зависят от температуры отжига. Многократные измерения постоянного тока показывают, что стабильность NC-эффекта, вызванного сегнетоэлектрическим слоем, достигается в NCFET. Hf 0,67 Zr 0,33 О 2 NCFET может легче достичь безгистерезисных характеристик, чем устройства с более высоким содержанием Zr.
Сокращения
- Al 2 О 3 :
-
Оксид алюминия
- ALD:
-
Осаждение атомного слоя
- BF 2 + :
-
Ион фторида бора
- DC:
-
Постоянный ток
- Ge:
-
Германий
- GeO x :
-
Оксид германия
- HF:
-
Плавиковая кислота
- HfO 2 :
-
Диоксид гафния
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- МОП-транзисторы:
-
Полевые транзисторы металл-оксид-полупроводник
- NC:
-
Отрицательная емкость
- Ни:
-
Никель
- SS:
-
Подпороговое колебание
- TaN:
-
Нитрид тантала
- TDMAHf:
-
Тетракис (диметиламидо) гафний
- TDMAZr:
-
Тетракис (диметиламидо) цирконий
Наноматериалы
- Электрические поля и емкость
- Факторы, влияющие на емкость
- Цифровые (ВКЛ / ВЫКЛ) устройства на эффекте Холла:переключатели и защелки
- Определение положения с помощью эффекта Холла:линейность и наклон отклика для конфигураций Slide-By
- Воздушные прокладки для 10-нм чипов
- Скачок нанометров к триллионам транзисторов
- Влияние ультрафиолетового излучения на характеристики 4H-SiC PiN диодов
- Влияние отжига in situ на подвижность и морфологию органических полевых транзисторов на основе TIPS-пентацена
- Влияние полиэтиленгликоля на фотокатод NiO
- Теоретическое исследование двухосно-деформированных германиевых нанопроволок



