Оптимизация солнечных элементов с решеткой с нановолоконным GaAs с использованием гетеропереходов AlGaAs / GaAs
Аннотация
Мы оптимизировали производительность солнечных элементов с решеткой из GaAs нанопроволоки, введя гетеропереходы AlGaAs / GaAs. AlGaAs используется для верхнего сегмента p-типа для осевых переходов и внешней оболочки p-типа для радиальных переходов. AlGaAs не только служит пассивирующим слоем для нанопроволок GaAs, но также ограничивает оптическую генерацию в активных областях, уменьшая рекомбинационные потери в сильно легированных областях и рекомбинацию неосновных носителей заряда на верхнем контакте. Результаты показывают, что эффективность преобразования нанопроволок GaAs может быть значительно увеличена за счет использования AlGaAs для p-сегмента вместо GaAs. В этом исследовании было достигнуто максимальное повышение эффективности на 8,42%. А для аксиальной нанопроволоки, используя AlGaAs для верхнего p-сегмента, можно использовать относительно длинный верхний сегмент без ухудшения характеристик устройства, что могло бы облегчить изготовление солнечных элементов массива нанопроволок и установление контакта с ними. В то время как для радиальных нанопроволок нанопроволоки AlGaAs / GaAs демонстрируют лучшую устойчивость к толщине p-оболочки и состоянию поверхности.
Фон
Нанопроволоки (ННК) GaAs рассматриваются как потенциальные строительные блоки для высокоэффективных солнечных элементов [1,2,3]. При ширине запрещенной зоны 1,43 эВ GaAs более благоприятен, чем Si, для максимизации эффективности солнечных элементов [4]. Эффективность 15,3% была достигнута с помощью массива GaAs ННК с аксиальными pn-переходами [5]. Однако из-за того, что солнечные элементы GaAs NW всегда страдают от серьезной поверхностной рекомбинации, для достижения удовлетворительных характеристик необходима пассивация поверхности [6, 7]. Распространенным методом пассивации GaAs ННК является формирование оболочки AlGaAs вокруг ННК, которая создает большие барьеры как для электронов, так и для дырок по всей структуре, предотвращая рекомбинацию неосновных носителей заряда на поверхности [5, 8, 9].
За исключением пассивации поверхности, усиление поглощения света в активных областях также является эффективным методом повышения эффективности преобразования, что способствует разделению электронов и дырок. Для солнечных элементов NW с pn-переходами оптимизированная эффективность может быть достигнута путем размещения перехода рядом с местом, где генерируется наибольшее количество носителей [10,11,12], в то время как для солнечных элементов со штыревым переходом более высокая эффективность может быть достигнута, если больше носителей. могут быть сгенерированы во внутренних областях [13,14,15,16,17]. Более того, подавляя оптическую генерацию в областях вблизи контактов, можно уменьшить количество фотогенерированных неосновных носителей, диффундирующих в контакты [14,17]. Существует множество методов увеличения поглощения света в активных областях, таких как регулировка положения или длины переходов [13, 14], использование наклонных ННК [15], декорирование активной области металлическими частицами [16] или изготовление сильно легированных областей с материалы с большой шириной запрещенной зоны [17]. Для GaAs NW солнечных элементов широко сообщалось об использовании оболочек из AlGaAs в качестве пассивирующих слоев. Однако способности гетероструктур AlGaAs / GaAs удерживать фотогенерированные носители в активных областях уделялось меньше внимания.
В этой статье мы оптимизировали характеристики GaAs NW-матричных солнечных элементов с использованием гетеропереходов AlGaAs / GaAs. Были исследованы как осевые, так и радиальные стыки. В структурах штыревых гетеропереходов AlGaAs / GaAs AlGaAs используется для верхнего сегмента p-типа для осевых переходов и внешней оболочки p-типа для радиальных переходов. Из-за относительно низкого коэффициента поглощения AlGaAs меньше фотоносителей генерируется в p-областях. Следовательно, больше фотоносителей сосредоточено в i-областях. Следовательно, рекомбинационные потери, вызванные высокой концентрацией легирования, могут быть подавлены. Более того, слои AlGaAs с большой шириной запрещенной зоны могут эффективно отклонять неосновные носители от поверхностей или контактов ННК, чтобы уменьшить рекомбинацию неосновных носителей.
Солнечные элементы массива AlGaAs / GaAs с гетеропереходом были исследованы с помощью сопряженного трехмерного (3-D) оптоэлектронного моделирования, и их производительность сравнивалась с массивами GaAs ННК с такой же геометрической структурой. Результаты показывают, что, используя AlGaAs для p-сегмента вместо GaAs, эффективность солнечных элементов с осевым переходом может быть повышена даже с длинными верхними p-сегментами, в то время как для солнечных элементов с радиальным переходом эффективность может поддерживаться на относительно высоком уровне. с очень высокими скоростями поверхностной рекомбинации (SRV).
Методы
Схема солнечного элемента с решеткой на нановолокнах GaAs и его гетеропереходных аналогов AlGaAs / GaAs показана на рис. 1; каждый солнечный элемент содержит периодическую решетку NW, из которой показана только одна NW. Для изготовления гетеропереходов AlGaAs / GaAs Al 0,8 Ga 0,2 Используется для верхнего сегмента p-типа для осевых штыревых соединений и внешней оболочки p-типа для радиальных штифтовых соединений; остальные области ННК выполнены из GaAs. Концентрация легирования в областях p и n составляет 10 18 см - 3 . Диаметр и длина ННК составляют 180 нм и 1,2 мкм, период массива - 360 нм; эти геометрические параметры выбраны в соответствии с [18], где поглощение света массивами GaAs ННК было оптимизировано путем регулировки отношения D / P и диаметра ННК.
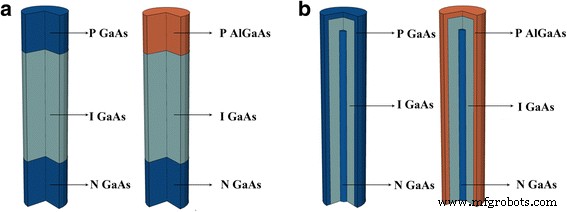
а Схематические изображения солнечного элемента с осевым штыревым переходом из GaAs-нанопроволоки и его гетероперехода AlGaAs / GaAs. б Схематические рисунки солнечного элемента с радиальным штыревым переходом на основе нанопроволоки GaAs и его гетероперехода AlGaAs / GaAs
Для оптического расчета мы используем программный пакет FDTD Solutions (Lumerical, Inc.) для расчета профиля поглощения в ННК. Установив периодические граничные условия, моделирование может быть выполнено с использованием одного NW для моделирования периодической структуры массива. Комплексный показатель преломления GaAs и Al 0,8 Ga 0,2 Используемые при моделировании взяты из [19]. Число поглощенных фотонов в каждой точке сетки вычисляется из вектора Пойнтинга S, предполагая, что каждый поглощенный фотон генерирует одну электронно-дырочную пару:
$$ {G} _ {ph} =\ frac {\ left | \ overrightarrow {\ nabla} \ cdot \ overrightarrow {S} \ right |} {2 \ mathrm {\ hslash} \ omega} =\ frac {\ varepsilon ^ {{\ prime \ prime}} {\ left | \ overrightarrow {E} \ right |} ^ 2} {2 \ mathrm {\ hslash}} $$ (1)где ℏ - приведенная постоянная Планка, ω угловая частота падающего света, E - напряженность электрического поля в каждой точке сетки, а ε ″ - мнимая часть диэлектрической проницаемости. Чтобы получить профиль скорости оптической генерации, используемый для электрического моделирования, G ph взвешивается по солнечному спектру AM 1.5G и интегрируется по спектру моделирования.
Для электрического моделирования профили оптической генерации включаются в конечно-элементную сетку NW с помощью Synopsys Sentaurus, который самосогласованно решает уравнения неразрывности носителей в сочетании с уравнением Пуассона. При электрическом моделировании устройства учитываются зависимая от легирования подвижность, излучательная, оже-рекомбинация и рекомбинация Шокли-Рида-Холла (SRH). Гетеропереход между AlGaAs и GaAs моделируется с помощью модели термоэлектронной эмиссии [20]. Электронный и дырочный токи ( Дж n и Дж p ) через гетероструктуру можно описать как:
$$ {J} _n ={a} _nq \ left [{v} _ {n, 2} {n} _2- \ frac {m_ {n, 2}} {m_ {n, 1}} {v} _ {n, 1} {n} _1 \ exp \ left (- \ frac {\ varDelta {E} _c} {k_BT} \ right) \ right] $$ (2) $$ {J} _p =- {a} _pq \ left [{v} _ {p, 2} {p} _2- \ frac {m_ {p, 2}} {m_ {p, 1}} {v} _ {p, 1} {p} _1 \ exp \ left (- \ frac {\ varDelta {E} _v} {k_BT} \ right) \ right] $$ (3)где a n ( а p ) - коэффициенты термоэмиссионного тока, q элементарный заряд, v n ( v p ) - скорость эмиссии электронов (дырок), которая может быть выражена следующим образом:
$$ {v} _n =\ sqrt {k_BT / 2 \ pi {m} _n} $$ (4) $$ {v} _p =\ sqrt {k_BT / 2 \ pi {m} _p} $$ (5)и н ( p ) - плотность электронов (дырок), а m n (м p ) - эффективная масса электронов (дырок). к B - постоянная Больцмана, а T - это комнатная температура при моделировании. Индексы 1 и 2 обозначают материалы с нижним и верхним краями зоны проводимости соответственно. Δ E c и Δ E v - смещения зоны проводимости и валентной зоны на границе GaAs / AlGaAs. Мы предполагаем, что граница раздела между AlGaAs и GaAs идеальна без каких-либо дополнительных центров рекомбинации. Обычно это справедливо для синхронизированной эпитаксии AlGaAs на GaAs [21]. Поверхностная рекомбинация учитывается только на границах раздела между воздухом и ННК. Параметры, используемые при моделировании устройства, перечислены в таблице 1. Коэффициенты Оже, коэффициенты излучательной рекомбинации и время жизни рекомбинации SRH для AlGaAs и GaAs установлены одинаковыми [11, 12].
Результаты и обсуждение
Поглощающие свойства ННК с гетеропереходом AlGaAs / GaAs и ННК GaAs показаны на рис. 2. Для ННК с осевым переходом длины верхней p-области и нижней n-области составляют 150 и 200 нм соответственно. Для ННК с радиальным переходом толщина оболочек p-типа составляет 20 нм, а радиус внутренних областей n равен 20 нм. Спектры поглощения ННК AlGaAs / GaAs и GaAs практически одинаковы, за исключением того, что поглощение ННК с радиальным гетеропереходом AlGaAs / GaAs падает на длинах волн, близких к запрещенной зоне GaAs. На длинах волн около 900 нм свет, распространяющийся в ННК, концентрируется вблизи боковой поверхности, в то время как для ННК с радиальным гетеропереходом AlGaAs / GaAs свет, распространяющийся в оболочке AlGaAs, не может эффективно поглощаться. На рис. 2б – г показаны поперечные сечения профилей генерации. Из-за более низкой поглощающей способности AlGaAs только небольшая часть носителей генерируется в области AlGaAs; поэтому ожидается, что рекомбинационные потери в сильно легированной области AlGaAs будут не очень серьезными. Для ННК AlGaAs / GaAs с аксиальными переходами большая часть оптической генерации концентрируется на границе раздела AlGaAs / GaAs. В то время как для ННК AlGaAs / GaAs с радиальными переходами большая часть фотоносителей ограничена сердцевиной GaAs и заблокирована от поверхности ННК; таким образом, ожидается, что потери на поверхностную рекомбинацию будут подавлены. Согласно нашей предыдущей работе [15], для NW солнечных элементов с штыревыми переходами фотогенерированные носители в i-области составляют большую часть эффективности; поэтому мы извлекаем оптическое поглощение в i-области и рассчитываем соответствующие спектры поглощения. Как для аксиальных, так и для радиальных ННК более высокое поглощение в i-области может быть достигнуто в ННК с гетеропереходом AlGaAs / GaAs благодаря неэффективному поглощению в областях AlGaAs p-типа.

а Спектры поглощения нанопроволоки GaAs и ее аналогов AlGaAs / GaAs с осевыми и радиальными гетероструктурами. Вертикальное сечение профилей оптической генерации в b Осевая гетероструктурная нанопроволока AlGaAs / GaAs, c Радиальная нанопроволока гетероструктуры AlGaAs / GaAs и d Нанопроволока GaAs. е Спектры поглощения собственных областей в солнечных элементах с осевым штифтом на основе GaAs и его аналогах из AlGaAs / GaAs. е Спектры поглощения собственных областей в солнечных элементах с радиальным штыревым переходом на основе нанопроволоки GaAs и их аналогов из AlGaAs / GaAs
Профили оптической генерации включены в электрический инструмент для исследования потенциального увеличения эффективности преобразования устройства, вызванного гетеропереходами AlGaAs / GaAs. Вольт-амперные характеристики рассматриваемых устройств рассчитаны и представлены на рис. 3. Два типичных СРВ, 10 3 и 10 7 см / с, при расчете учитываются соответствующие поверхности ННК с должной пассивацией и без нее [6, 8, 9]. Для ННК с осевым штыревым переходом с низкой поверхностной рекомбинацией при использовании AlGaAs для верхнего p-сегмента вместо GaAs эффективность преобразования увеличивается с 11,6 до 14,5%. Повышение эффективности в основном связано с фототоком, который увеличивается с 18,9 до 23,3 мА / см 2 . при нулевом смещении. Подобное явление наблюдается и в радиальных ННК; КПД увеличивается с 10,8 до 11,3% за счет использования гетеропереходов AlGaAs / GaAs, при этом ток короткого замыкания увеличивается с 22,6 до 23,8 мА / см 2 . При высоком SRV характеристики аксиальных ННК резко ухудшаются как для ННК AlGaAs / GaAs, так и для ННК GaAs из-за открытой поверхности i-областей. Однако увеличение тока короткого замыкания все еще существует в ННК AlGaAs / GaAs даже при высоком SRV 10 7 см / с, что происходит из-за подавленной рекомбинации в верхней p-области и верхнем контакте. Для радиальных ННК AlGaAs / GaAs на эффективность поверхностная рекомбинация лишь незначительно влияет на эффективность благодаря оболочке AlGaAs, которая ограничивает фотоносители в i-области и создает барьер, защищающий их от достижения поверхности ННК. В то время как для радиального NW GaAs эффективность снижается с 10,8 до 8,05% с увеличением SRV с 10 3 до 10 7 см / с, а ток короткого замыкания уменьшится с 22,6 до 17,1 мА / см 2 .
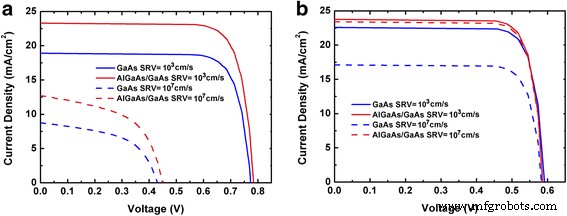
Вольт-амперные характеристики нанопроволоки GaAs и AlGaAs / GaAs a осевой и b солнечные элементы с радиальным штыревым переходом со скоростями поверхностной рекомбинации 10 3 и 10 7 см / с
Сообщалось, что объем сильно легированной области имеет большое влияние на эффективность преобразования, особенно для областей, где может иметь место сильная оптическая генерация. В данной работе исследуются характеристики ННК с различным объемом p-области. На рис. 4а представлены профили оптической генерации аксиальных ННК перехода AlGaAs / GaAs с разной длиной p-области. Поскольку длина p-области изменяется от 50 до 200 нм, горячая точка оптической генерации перемещается к нижней части NW, и большинство оптических генерируемых носителей ограничивается областью AlGaAs. Также рассчитываются соответствующие коэффициенты преобразования. Результаты показывают, что при низком SRV увеличение длины p-области не оказывает очевидного влияния на эффективность преобразования ННК AlGaAs / GaAs, хотя общее поглощение имеет тенденцию к уменьшению с увеличением объема AlGaAs. Более того, более длинная область AlGaAs удерживает большинство фотоносителей дальше от верхнего контакта, и меньшее количество неосновных носителей может быть рекомбинировано на контакте. Однако для GaAs NW эффективность преобразования линейно уменьшается с увеличением длины p-области из-за увеличения количества фотоносителей, генерируемых в верхней p-области. В случае высокого SRV эффективность преобразования ННК AlGaAs / GaAs даже увеличивается с увеличением длины p-области, поскольку оптическая генерация в AlGaAs сосредоточена в центре ННК и вдали от поверхностей, что приводит к меньшей поверхностной рекомбинации. по сравнению с GaAs-областями. Из приведенного выше обсуждения мы можем сделать вывод, что, используя AlGaAs для верхней p-области вместо GaAs, можно использовать относительно длинную верхнюю область без ухудшения характеристик устройства. А для NW с осевым переходом длинная верхняя область могла бы облегчить изготовление и подключение солнечных элементов массива NW.

а Вертикальное сечение профилей оптической генерации в солнечных элементах с осевым штыревым гетеропереходом с нанопроволокой AlGaAs / GaAs с разными p -длины области. б Эффективность преобразования осевых солнечных элементов с нанопроволокой GaAs и AlGaAs / GaAs в зависимости от длины p-области
Также были рассчитаны характеристики радиальных ННК с разной толщиной p-оболочки. На рис. 5а показаны профили оптической генерации радиальных ННК AlGaAs / GaAs. Как и в аксиальных ННК, большинство фотоносителей генерируется в GaAs. Эффективность преобразования как AlGaAs / GaAs, так и GaAs ННК уменьшается с увеличением толщины p-оболочки. В случае низкого SRV 10 3 см / с эффект поверхностной рекомбинации практически незначителен; таким образом, снижение эффективности в основном происходит из-за увеличения числа фотоносителей, генерируемых в p-оболочке. Однако ННК AlGaAs / GaAs демонстрируют лучшую устойчивость к толщине p-оболочки, поскольку большая часть оптической генерации может быть ограничена во внутренних областях GaAs. При увеличении SRV с 10 3 до 10 7 см / с, эффективность преобразования ННК AlGaAs / GaAs незначительно снижается, так как фотоносители защищены оболочками из AlGaAs с поверхности. А для ННК с более толстыми оболочками из AlGaAs, поскольку меньшее количество носителей может достигать и рекомбинировать на поверхности, характеристики устройства ухудшаются в меньшей степени. Напротив, характеристики GaAs ННК серьезно ухудшаются из-за высокой поверхностной рекомбинации, особенно в случаях толстых p-оболочек. Поскольку для радиальных ННК GaAs фотоносители, генерируемые в p-оболочке, могут быть легко рекомбинированы на поверхностях. При толщине p-оболочки 30 нм эффективность преобразования GaAs ННК составляет всего 1,98%, в то время как соответствующие ННК AlGaAs / GaAs показывают эффективность 10,4%, что на 8,42% выше, чем у GaAs ННК.
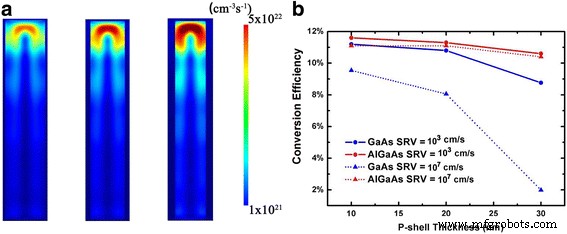
а Вертикальное сечение профилей оптической генерации в солнечных элементах с радиальным штыревым гетеропереходом с нанопроволокой AlGaAs / GaAs с разными p -толщина оболочки. б Эффективность преобразования радиальных солнечных элементов с нанопроволокой GaAs и AlGaAs / GaAs в зависимости от толщины p-оболочки
Выводы
В этой работе мы используем совместное трехмерное оптоэлектронное моделирование для исследования характеристик солнечных элементов с решетчатыми решетками с ННК на основе AlGaAs / GaAs и GaAs. По сравнению с GaAs ННК, ННК AlGaAs / GaAs могут ограничивать большую часть оптической генерации в активных областях, уменьшая рекомбинационные потери, существующие в сильно легированных областях, и создавать барьеры для неосновных носителей, защищая их от поверхностной или контактной рекомбинации. Для аксиальных ННК из AlGaAs / GaAs, используя AlGaAs для верхней p-области вместо GaAs, мы можем допустить относительно длинную верхнюю область без ухудшения характеристик устройства, что могло бы облегчить изготовление солнечных элементов с ННК и их подключение. А для радиальных ННК эффективность ННК AlGaAs / GaAs может поддерживаться на относительно высоком уровне с очень высокой поверхностной рекомбинацией. Из этого исследования мы можем сделать вывод, что использование гетеропереходов AlGaAs / GaAs является эффективным и практичным методом повышения производительности GaAs NW солнечных элементов.
Сокращения
- 3D:
-
Трехмерный
- NW:
-
Нанопроволока
- SRH:
-
Шокли-Рид-Холл
- SRV:
-
Скорость поверхностной рекомбинации
Наноматериалы
- Солнечный элемент
- Нанодеревья для сенсибилизированных красителем солнечных элементов
- Высокоэффективные графеновые солнечные элементы
- Нано-гетеропереходы для солнечных элементов
- Плазмонно-усиленное поглощение света в (p-i-n) переходных GaAs-нанопроводных солнечных элементах:исследование ме…
- Краткий отчет о достижениях высокоэффективных перовскитных солнечных элементов
- Матрицы нанополосов на основе GaAs с золотым покрытием, изготовленные методом химического травления с примене…
- Большой боковой фотоэлектрический эффект в гетеропереходе MoS2 / GaAs
- Синтез нанокристаллов ZnO и применение в инвертированных полимерных солнечных элементах
- Последовательно выращенный из пара гибридный перовскит для плоских солнечных элементов с гетеропереходом



