Повышение производительности устройства a-IGZO TFT с использованием процесса чистого интерфейса через нано-слои Etch-Stopper
Аннотация
Чтобы преодолеть технологические и экономические препятствия, связанные с объединительной панелью дисплея на основе аморфного индия-галлия-цинка (a-IGZO) для промышленного производства, разработан процесс чистого травления-стопора (CL-ES) для изготовления тонких панелей на основе a-IGZO. пленочный транзистор (TFT) с улучшенной однородностью и воспроизводимостью на стеклянных подложках 8,5 поколения (2200 мм × 2500 мм). По сравнению с TFT на основе a-IGZO со структурой с травлением по обратному каналу (BCE), недавно сформированный нанослой ES (~ 100 нм) и одновременное травление нанослоя a-IGZO (30 нм) и исток-сток электродный слой сначала вводится в устройство TFT на основе a-IGZO со структурой CL-ES, чтобы улучшить однородность и стабильность устройства для отображения на большой площади. Подвижность электронов насыщения 8,05 см 2 / V s и V th однородность 0,72 В реализована на TFT-устройстве на основе a-IGZO со структурой CL-ES. При испытании на надежность освещения при отрицательной температуре смещения и при положительном тепловом напряжении смещения при смещении ± 30 В в течение 3600 с измеренное значение V th сдвиг устройства со структурой CL-ES существенно снизился до -0,51 и + 1,94 В, что намного ниже, чем у устройства со структурой BCE (-3,88 В, + 5,58 В). Электрические характеристики устройства TFT на основе a-IGZO со структурой CL-ES подразумевают, что экономичный переход от процесса TFT на основе кремния к процессу изготовления ЖК-дисплеев на основе оксидов металлов и полупроводников весьма осуществим.
Фон
Объединительная плата на тонкопленочных транзисторах (TFT) с более высоким разрешением и большим размером панели очень востребована в индустрии плоских дисплеев. Полупроводниковый материал с высокой подвижностью электронов имеет решающее значение для улучшения характеристик объединительной платы TFT. В частности, объединительная плата TFT на основе оксидов металлов и полупроводников рассматривается как многообещающий кандидат для преодоления ограничений объединительной платы TFT на основе кремния с точки зрения механической гибкости и подвижности электронов [1,2,3,4]. Хотя объединительная плата TFT на основе оксидов металлов и полупроводников показывает многообещающие свойства, метод обработки с недорогим процессом как для крупномасштабного осаждения, так и для промышленного применения все еще необходим [5].
Аморфный оксид индия-галлия-цинка (a-IGZO) - превосходный металлооксидный полупроводник с высокой подвижностью электронов насыщения (~ 5–10 см 2 / В с) и низкий ток отключения (<10 пА) [6,7,8,9,10]. Распространенным промышленным методом производства объединительной платы TFT на основе a-Si:H является процесс травления с пятью масками и обратным каналом (BCE). Однако нанопленка a-IGZO имеет очень низкую химическую стойкость по сравнению с типичными травителями, которые в настоящее время используются в процессе BCE. В частности, нанопленки a-IGZO будут полностью вытравлены за несколько секунд, если они будут подвергнуты травлению Al, состоящим из фосфорной кислоты, азотной кислоты и уксусной кислоты [11,12,13]. Это бесконтрольно быстрое травление препятствует внедрению процесса BCE для объединительной платы TFT на основе a-IGZO. Для использования a-IGZO в объединительной плате со структурой BCE была разработана технология разводки Cu в качестве травителя, используемого в процессе разводки Cu, который основан на H 2 О 2 , намного мягче для нанопленок a-IGZO, чем те, которые используются в алюминиевых проводках [11, 13]. К сожалению, нанопленка a-IGZO все еще повреждается в процессе разводки Cu, даже если используется более мягкий травитель. Даже более мягкие травители вызывают повреждение поверхности нанопленки a-IGZO, которая образует задний канал TFT-устройств. Эти повреждения вызывают коллапс стехиометрического соотношения молекулярных составов у поверхности нанопленки a-IGZO, что приводит к ухудшению однородности дисплея с большой площадью и надежности устройства TFT. На сегодняшний день разработан традиционный процесс с шестью масками-травлением-стопором (CV-ES) для изготовления объединительной платы TFT на основе IGZO со структурой слоя травления-стопора (ESL) [14, 15]. Однако этот процесс с шестью масками ES может привести к отрицательной экономической целесообразности. Более того, это увеличенное количество тонкопленочных слоев увеличит площадь межслоевого перекрытия и приведет к увеличению паразитной емкости и уменьшению степени открытия [16,17,18]. Хотя недавно было сообщено о пятимасковом ES-процессе, который производит объединительную плату TFT с использованием технологии полутона и подъема, этот процесс недоступен для производства объединительной платы TFT на основе a-IGZO, поскольку поверхность их активного слоя все еще подвергается воздействию обрабатывают химикаты, такие как стриппер и фоторезист, на последнем этапе, которые могут вызвать значительное загрязнение a-IGZO, тем самым снижая качество устройства и выход продукции [19,20,21]. Поэтому метод промышленного производства объединительной платы TFT на основе a-IGZO с высокой однородностью и стабильностью остается сложной задачей.
В этой статье мы предлагаем чистый процесс ES с пятью масками (CL-ES) путем введения ESL для изготовления объединительной платы TFT на основе a-IGZO. Этот недавно разработанный процесс CL-ES полностью совместим с существующим процессом для устройства BCE. Этот процесс CL-ES спроектирован так, чтобы иметь те же маски, что и у процесса BCE, что обеспечивает незначительную потерю производительности существующей объединительной платы AM-LCD TFT FAB. Объединительная плата на основе a-IGZO, изготовленная с использованием процесса CL-ES, последовательно наносит изолятор затвора, нанослой IGZO и нанослой ES, а затем формирует новую маску ESL методом сухого травления. Это может предотвратить загрязнение нанослоя a-IGZO и их поверхности раздела травителем, стриппером и растворителем. Эта недавно сформированная наномаска помогает улучшить однородность и стабильность устройства TFT. По сравнению с обычным устройством со структурой BCE, устройство на основе a-IGZO со структурой CL-ES демонстрирует улучшенные электрические характеристики, а именно более высокую подвижность электронов насыщения, высокий коэффициент открытия и низкое энергопотребление.
Методы / экспериментальные
Изготовление объединительной платы TFT на основе a-IGZO
Объединительная плата TFT на основе a-IGZO со структурой ES, изготовленная с помощью процесса CL-ES, выглядела следующим образом (рис. 1).
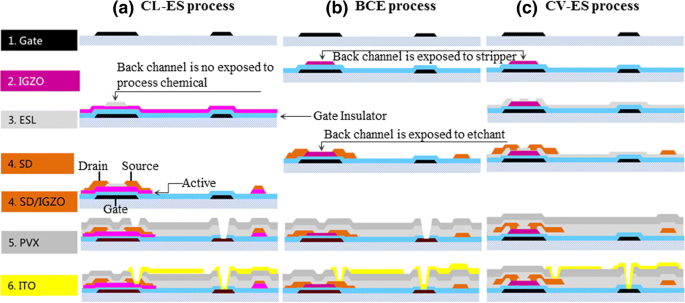
(Цветной онлайн) Схема a CL-ES, b До н.э. и c CV-ES процессы
Во-первых, для электрода затвора использовался двойной слой (Mo / Cu:30 нм / 250 нм), поскольку он имеет достаточно низкое удельное сопротивление. Затем изолятор затвора, нитрид кремния (SiNx) / оксид кремния (SiOx) (300 нм / 100 нм), был нанесен методом плазменного химического осаждения из паровой фазы (PECVD). Эта пленка SiNx предназначена для предотвращения окисления металлизации Cu и диффузии иона Cu в изолятор затвора. Затем была нанесена тонкая пленка SiOx. Условия осаждения пленки PECVD SiOx:мощность ВЧ 17 кВт, давление 1000 мторр, SiH 4 1:55. / N 2 Газовое соотношение O и температура 350 ° C. Затем нанопленка a-IGZO была осаждена до 30 нм с использованием вращающегося магнетронного распыления постоянного тока. Мишень имела диаметр 171 мм, а состав In 2 О 3 :Ga 2 О 3 :ZnO =1:1:1 мол.%. Параметры распыления для нанопленки a-IGZO:базовое давление системы 5 ~ 9 × 10 −7 Торр, ВЧ мощность распыления 10 кВт, давление распыления 5 мТорр Ar / O 2 газовая смесь (85% Ar-15% O 2 ). Температура наплавки - комнатная. Полученная пленка a-IGZO отжигается при 330 ° C в течение 1 ч в среде чистого сухого воздуха.
Во-вторых, нанослой ограничителя травления (ES) (SiOx) был нанесен методом PECVD. Нанослой ES наносится одновременно, чтобы предотвратить загрязнение в слое a-IGZO. Как и в процессе BCE, нет защитного слоя для нанопленки a-IGZO перед процессом формирования рисунка электродов S / D, поверхностное загрязнение и повреждение нанопленки a-IGZO травлением S / D при формировании канала TFT неизбежно. Нанослой ES в процессе CL-ES может эффективно защитить канал TFT от внешнего загрязнения и повреждения. Нанослой ES наносился до толщины 100 нм. Условия осаждения тонкой пленки SiOx:ВЧ-мощность 17 кВт, давление 1000 мторр, SiH 4 1:66. / N 2 Газовое соотношение O и температура 240 ° C. Полученная наномаска ES подвергалась травлению методом сухого травления и формирования рисунка. В процессе травления CF 4 и O 2 Подача газа составляла 2000 куб. м / 800 куб. м.
В-третьих, Mo / Cu / Mo также использовался в качестве S / D-электрода. При выборе S / D электрода для a-IGZO TFT, разница в работе выхода между металлом и a-IGZO учитывалась для образования омического контакта и материалов с низким удельным сопротивлением. Как описано в процессе остановки травления, во время формирования рисунка на ES-наномаске нанопленки a-IGZO, не защищенные стопорным слоем травления, уже подвергаются бомбардировке CF 4 плазма. Следовательно, омический контакт образуется естественным образом с Mo / Cu / Mo [22]. Слои S / D были нанесены толщиной 30 нм / 300 нм / 30 нм при тех же условиях распыления, что и электрод затвора. Кроме того, многослойные тонкопленочные слои Mo / Cu / Mo и a-IGZO подвергались периодическому травлению с использованием «H 2 О 2 травитель на основе меди, содержащий фторидную добавку »для завершения S / D-электрода. 30 нм Mo, добавленного поверх Cu, были сформированы для предотвращения окисления поверхности Cu пассивирующей пленкой (SiOx) в следующем процессе и для предотвращения плазменного повреждения поверхности Cu во время сухого травления для образования пассивирующих отверстий.
В-четвертых, пассивирующая пленка, разделенная на два вида тонких пленок, была нанесена методом PECVD. Первой пассивацией была тонкая пленка SiOx. Толщина тонкой пленки составляла 250 нм. Вторая пассивация состояла из тонкой пленки SiNx. Толщина тонкой пленки составляла 200 нм.
В-пятых, в качестве пиксельного электрода использовалась пленка из оксида индия и олова (ITO), которая чаще всего используется в индустрии дисплеев. Пленка ITO имела толщину 40 нм, для осаждения использовалось напыление на постоянном токе. Затем был проведен окончательный отжиг в среде чистого сухого воздуха при 230 ° C в течение 1 ч с использованием сушильного шкафа с горячим воздухом. Электрические характеристики изготовленных тонкопленочных транзисторов a-IGZO были измерены с помощью системы параметрических испытаний Keysight 4082A. Этот процесс позволит получить такое же количество масок (стандарт продукции TN:пять масок), что и процесс BCE, который широко используется в массовом производстве.
Для сравнения, объединительная плата TFT на основе a-IGZO со структурой BCE была изготовлена с помощью процесса BCE.
Характеристика
Измерение ВАХ TFT проводилось при комнатной температуре с использованием анализатора характеристик полупроводников. Условия анализа для оценки стабильности TFT при отрицательном температурном освещении смещения затвора (NBTIS) были следующими. V GS и V ds были зафиксированы соответственно на -30 и 15 В, а температура подложки поддерживалась на уровне 60 ° C. Яркость для NBITS была установлена на уровне 5000 кд / м 2 . . Продолжительность стресса для оценки составляла 3600 с [23]. Положительное тепловое напряжение смещения затвора (PBTS) было испытано при V GS 30 В и В ds 15 В, а температура подложки - 60 ° C. Продолжительность стресса для оценки продолжалась 3600 с [24].
Результаты и обсуждение
TFT на основе a-IGZO, изготовленный с помощью процесса CL-ES, показывает тот же номер маски, что и процесс BCE (рис. 1). По сравнению с TFT на основе a-IGZO со структурой BCE, TFT на основе a-IGZO со структурой CL-ES демонстрирует два преимущества:(1) объединительная плата на основе a-IGZO, произведенная с использованием процесса CL-ES, наносит изолятор затвора, a-IGZO nano -слой и нанослой ES последовательно, затем формируют нанослой ESL методом сухого травления. Эта недавно сформированная нано-маска ESL с длиной волны 100 нм может предотвратить воздействие на нанопленку a-IGZO травителя, стриппера или фоторезиста. Таким образом, эффективно предотвращается загрязнение межслойных поверхностей раздела [25]. (2) В то же время нанопленка a-IGZO не защищена слоем ES, а подвергается бомбардировке CF 4 Плазма во время формирования наномаски ЭСЛ становится проводником. Это, естественно, образует омический контакт между S / D электродом следующего процесса и полупроводником a-IGZO. С другой стороны, одновременное травление S / D и нанослоя a-IGZO может быть одним допуском наложения слоя ESL- (a-IGZO + S / D металлизации), что может уменьшить ошибку двух процессов наложения a- Слой металлизации IGZO-ESL и ES-S / D в традиционном процессе ESL (рис. 2). Количество наложения слоев a-IGZO, ES и S / D уменьшено, что привело к уменьшению размера устройства TFT, которое снизило паразитную емкость. Конечная планарная структура аналогична структуре BCE (рис. 3a, b).
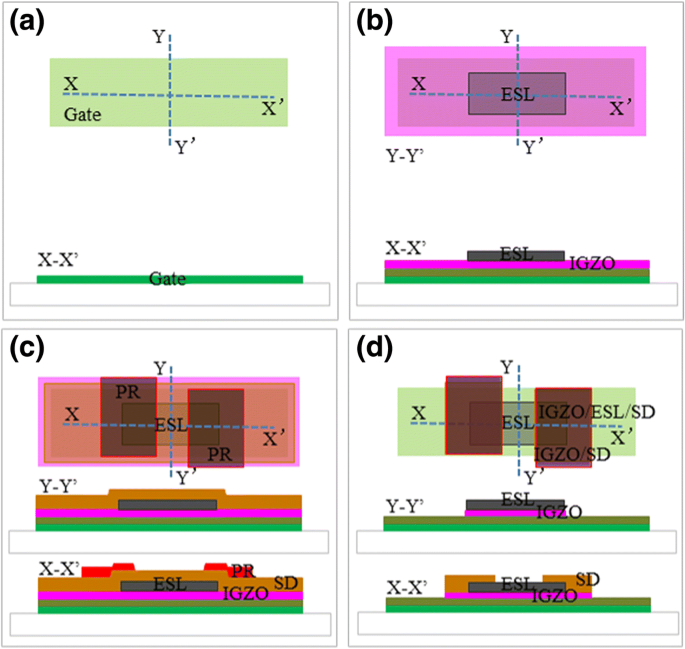
(Цветной онлайн) Схема метода одновременного формирования канала TFT и S / D электрода в процессе CL-ES. а Первый шаг, который формирует электрод затвора. б Второй этап формирования травильно-стопорного слоя. c Третий шаг, который формирует шаблон S / D фото. г Четвертый шаг, который формирует электрод S / D и активный узор
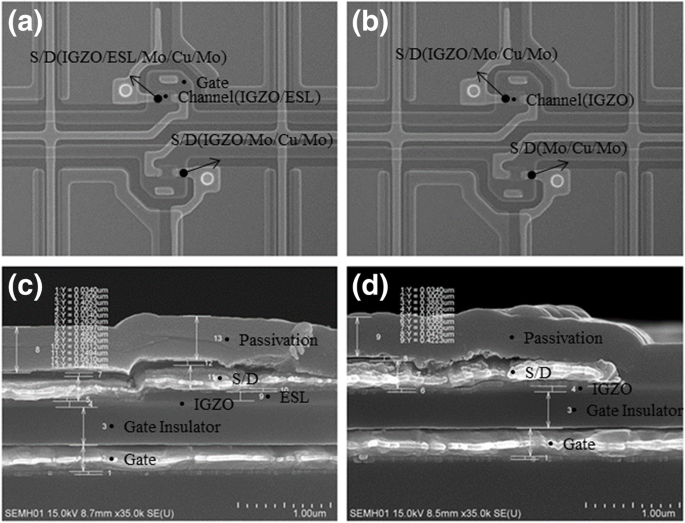
(Цветной онлайн) СЭМ-изображения a-IGZO TFT ( a , b вид сверху; c , d вид сбоку) со структурой CL-ES ( a , c ) и структура BCE ( b , d )
На рис. 3 показаны СЭМ-изображения TFT на основе a-IGZO со структурой CL-ES (рис. 3a, c) и структурой BCE (рис. 3b, d). При взгляде сверху сложно выделить различия между структурой CL-ES и структурой BCE (рис. 3а, б). При виде сбоку ES-нанослой можно найти между нанослоем a-IGZO и S / D-электродным слоем в структуре CL-ES (рис. 3c). Между тем, пассивирующий слой может быть обнаружен поверх нанослоя a-IGZO в структуре BCE (рис. 3d). В представленном процессе CL-ES наносится нанослой a-IGZO толщиной 30 нм. Причем повреждения при влажном травлении незначительны. Для процесса BCE наносится 70-нм нанослой a-IGZO, так как слой a-IGZO требует компенсации потерь при травлении. Разницу между толщиной нанослоев a-IGZO в структурах CL-ES и BCE можно наблюдать на изображениях SEM (рис. 3c, d).
Проведено сравнение ВАХ TFT на основе a-IGZO со структурой CL-ES и структурой BCE (рис. 4). Подвижность электронов насыщения, пороговое напряжение, значение подпорогового размаха напряжения (SS) и другие характеристические значения приведены в таблице 1. Обратите внимание, что значения, приведенные в таблице 1, являются средними числами, полученными от центра и края стеклянной подложки поколения 8.5. . TFT на основе a-IGZO со структурой CL-ES реализует V th - 0,8 В, значение SS 0,18 В / дек, подвижность электронов насыщения 8,05 см 2 /Против. В TFT на основе a-IGZO со структурой BCE соответствующие результаты равны V th + 0,5 В, значение SS 0,77 В / дек и подвижность электронов насыщения 6,03 см 2 /Против. По сравнению со структурой BCE, структура CL-ES показывает улучшенные характеристики устройства. Однако текущая характеристика устройства TFT на основе a-IGZO со структурой CL-ES ниже, чем у устройства со структурой BCE. Это связано с тем, что структуры каналов TFT различны в структурах CL-ES и BCE. Обычно длина канала TFT со структурой BCE - это расстояние между металлическими электродами S / D, а измеренная длина канала в этом исследовании составляет 5 мкм [21]. В структуре CL-ES электроды контактируют с нанопленкой a-IGZO, которая растягивается на стороне наномаски ESL. Следовательно, длина канала определяется расстоянием между a-IGZO, определенным на сторонах травильного ограничителя, но не определяется расстоянием между электродами. Длина канала нынешнего устройства CL-ES составляет 10 мкм.

(Цветной онлайн) Сравнение ВАХ тонкопленочных транзисторов a-IGZO со структурой CL-ES и BCE в центре ( a ) и ребро ( b ) стеклянной подложки поколения 8.5
Как показано в таблице 1, измеренные значения I на / Я выкл соотношение (~ 10 6 , см. Таблицу 1) примерно в 10 раз меньше типичного значения (> 10 7 ) TFT на основе a-IGZO. Это связано с тем, что измерительное оборудование, используемое здесь, предназначено для массового производства поколения 8.5. Для этих измерений необходимы длинные кабели, так как промышленное оборудование имеет большие размеры. Использование длинных кабелей привело к увеличению шума при измерениях. В следующем испытании надежности используется меньшее по размеру измерительное оборудование, а отдельные устройства TFT используются в качестве образца для измерения. Таким образом, измеренный I на / Я выкл все коэффициенты верхние 10 7 (см. ниже).
Процесс CL-ES тщательно разработан для предотвращения воздействия на слой канала a-IGZO травителя, фоторезиста или стриппера. Во время процесса, который производит процесс CL-ES, изолятор затвора, нанослой a-IGZO и нанослой ES, каждый межслойный интерфейс контактирует только с деионизированной водой для целей очистки. Следовательно, химическое загрязнение в слое изолятора и нанослое a-IGZO незначительно [25, 26]. Однако процесс BCE не только подвергает слой канала воздействию химикатов, но также включает загрязнение диффузией ионов Cu, поскольку канал a-IGZO напрямую подвергается воздействию металлической меди. Этого также избегают в устройстве со структурой CL-ES. Область канала нанопленки a-IGZO хорошо защищена наномаской ESL. Низкое химическое загрязнение в процессе CL-ES может привести к низкой плотности захвата носителей на границе раздела между нанослоем a-IGZO и слоем изолятора, что приведет к отличному значению SS. Это низкое химическое загрязнение TFT-устройства на основе a-IGZO с помощью процесса CL-ES также помогает улучшить однородность и воспроизводимость TFT a-IGZO, что очень важно в промышленном производстве [27, 28].
На рисунке 5 показаны измеренные ВАХ TFT со структурой CL-ES и структурой BCE, полученные из 42 точек измерения на подложке поколения 8.5. TFT на основе a-IGZO со структурой CL-ES имеет V th диапазон 0,72 В, а у устройства BCE - 2,14 В (таблица 1). Другими словами, структура CL-ES значительно улучшает единообразие производительности устройства.
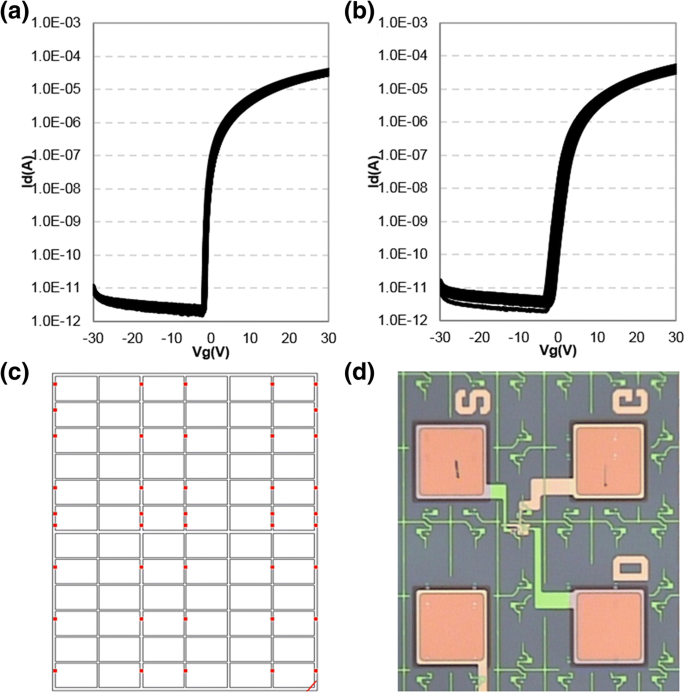
(Цветное онлайн) а Структура CL-ES. б I-V передаточная характеристика TFT структуры BCE. c 42 точки измерения. г фото TFT. Все измерения проводились на подложке поколения 8.5
На рис. 6а, б показан сдвиг ВАХ устройства со структурой CL-ES и устройства со структурой BCE, полученный при тестировании NBTIS, соответственно. Результаты тестирования NBTIS приведены в Таблице 2. В стрессовых условиях, описанных в Таблице 2, V th сдвиг устройства со структурой CL-ES и устройства со структурой BCE составляет - 0,51 и - 3,88 В соответственно. Кроме того, сдвиг при включении, выключении и отклонение значений SS устройства со структурой CL-ES ниже, чем у устройства со структурой BCE (Таблица 2); это связано с тем, что устройство на основе a-IGZO со структурой CL-ES может эффективно предотвращать загрязнение a-IGZO и более низкую плотность захвата несущих в канале a-IGZO TFT. В частности, если смотреть на результат первых 1000 с нагрузки, в устройстве со структурой CL-ES не наблюдается изменения значения SS. Это явление сравнимо с увеличением значения SS на 0,16 В / дек для устройства со структурой BCE, поскольку оно показывает, что участки дефектов, которые могут образовывать ловушки носителей на поверхности нанопленки a-IGZO, составляющей задний канал TFT CL-ES, дополнительно не создаются электрическими и световыми нагрузками. Эти результаты полностью доказывают, что устройство со структурой CL-ES намного более стабильно, чем устройство со структурой BCE. На рис. 6c, d показан сдвиг I-V кривой TFT со структурой CL-ES и BCE, полученный в результате тестирования PBTS. Подробные результаты тестирования PBTS приведены в таблице 3. И TFT со структурой CL-ES, и TFT со структурой BCE снизили ионный ток во время оценки PBTS. Это вызвано сдвигом V th в положительном направлении. Во время оценки PBTS отношение остаточного ионного тока [(последний ион / начальный ион) × 100] TFT со структурой CL-ES с относительно меньшим V th положительный сдвиг (+ 1,94 В) находится на уровне 88,2%. По сравнению с остаточным ионным током 41,3% TFT со структурой BCE, TFT со структурой CL-ES значительно превосходит. Это показывает важную разницу в емкости при проектировании схемы управления затвором на матрице (GOA). В отличие от NBTIS, значение SS для TFT со структурой CL-ES не имеет значительных изменений ((∆SS 0,06 В / дек) или, скорее, уменьшается (∆SS - 0,86), как в случае TFT со структурой BCE. Возможно, это связано с тем, что Носители накапливаются во внутреннем пространстве и на границе раздела между изолятором затвора и нанопленкой a-IGZO за счет положительного смещения затвора, заполняя место захвата носителей на ранней стадии, вызывая уменьшение явления захвата носителей. Более того, явление смещения порогового напряжения происходит из-за заряд носителей, захваченный вблизи границы раздела между изолятором затвора и нанопленкой a-IGZO. Небольшой сдвиг порогового напряжения TFT со структурой CL-ES означает, что интерфейс и внутреннее пространство a-IGZO удивительно чисты. В заключение, тестирование PBTS также предполагает, что структура и процесс CL-ES повышают надежность устройства.

(Цветной онлайн) Дрейф I-V передаточной характеристики CL-ES ( a , c ) и BCE ( b , d ) TFT, полученный от NBITS ( a , b ) и тестирование PBTS ( c , d )
Выводы
В заключение, недавно разработанный процесс CL-ES был успешно разработан для изготовления объединительной платы TFT на основе IGZO с пятью масками для расширенного отображения. Процесс CL-ES имеет преимущества структуры слоя травильного стопора при сохранении того же количества масок и аналогичных областей устройства, что и процесс BCE, который преодолевает проблему увеличения количества масок и занимаемой площади в обычных устройствах TFT с травильным стопором. . Вновь сформированная наномаска ESL и одновременное травление нанослоя a-IGZO и нанослоя S / D электрода обеспечивают высокую однородность и стабильность устройства для отображения на большой площади. Что касается электрических характеристик, воспроизводимость и надежность работы устройства TFT на основе a-IGZO со структурой CL-ES намного лучше, чем у устройства со структурой BCE. Устройство TFT на основе a-IGZO имеет V th распределение по 42 точкам измерения TFT на стеклянной подложке поколения 8.5, 0,72 В, подвижность электронов насыщения 8,05 см 2 / В с, и значение SS 0,18 В / дек. Согласно результатам оценки надежности, полученным от NBTIS и PBTS, V th отклонения до и после напряжения TFT на основе CL-ES a-IGZO составляют -0,51 и 1,94 В после 3600 с нагрузки, соответственно. Разброс значений SS составляет 0,33 и 0,06 В / дек. Таким образом, преодолевая технологические и экономические препятствия, представленная технология CL-ES проложит путь для продуктов следующего поколения с высоким разрешением и большими дисплеями.
Сокращения
- a-IGZO:
-
Аморфный оксид индия-галлия-цинка
- AM-LCD:
-
Жидкокристаллический дисплей с активной матрицей
- BCE:
-
Травление заднего канала
- ESL:
-
Слой протравливателя
- GOA:
-
Привод ворот на массиве
- NBTIS:
-
Напряжение освещения при отрицательной температуре смещения
- PBTS:
-
Температурное напряжение положительного смещения
- SiNx:
-
Нитрид кремния
- SiOx:
-
Оксид кремния
- SS:
-
Подпороговое колебание
- TFT:
-
Тонкопленочный транзистор
- ЖК-дисплей TN:
-
Скрученный нематический жидкокристаллический дисплей
Наноматериалы
- Использование безводных технологий в процессе окрашивания
- Переключатель выбора аппаратной загрузки с использованием Pico
- Использование общей эффективности оборудования
- Стратегии управления эффективностью активов
- Использование управления эффективностью активов для максимизации стоимости активов
- Разработка процесса нанесения покрытия погружением и оптимизация производительности для электрохромных ус…
- Гибридный композит на основе наноструктурированного диоксида кремния / золота и целлюлозы с амино-POSS, получе…
- Изготовление трехмерных периодических структур на основе наноболочек путем создания шаблонов с использован…
- Использование 3D-принтера для улучшения производственного процесса — видео
- Преимущества использования VIA в пэдах



