Структурный сдвиг GaN в сети Nanowall, наноколонке и компактной пленке, выращенной на Si (111) от MBE
Аннотация
Структурный сдвиг сетки наностенок GaN, наноколонки и компактной пленки был успешно получен на Si (111) с помощью плазменной молекулярно-лучевой эпитаксии (MBE). Как и ожидалось, рост наностолбиков GaN наблюдался в обогащенном азотом состоянии на голом Si, и рост сместился в сторону компактной пленки, когда поток Ga был улучшен. Интересно, что если предварительное осаждение алюминия (Al) в течение 40 с было выполнено до роста GaN, GaN растет в виде сетки наностен. Результаты показывают, что предварительно нанесенный Al выходит в виде капель с типичным диаметром и высотой ~ 80 и ~ 6,7 нм соответственно. Предложена модель роста сети наностен и обсуждается механизм роста. GaN растет в области без капель Al, в то время как рост над каплями Al затруднен, что приводит к образованию непрерывной сети наностенок GaN, которая устраняет препятствия при изготовлении наноустройств.
Фон
В качестве прямых широкозонных полупроводников GaN и родственные ему соединения достигли большого успеха в светодиодах [1,2,3], лазерных диодах [4] и транзисторах с высокой подвижностью электронов [5, 6]. Однако гетероэпитаксия пленки GaN на сапфире, карбиде кремния или монокристаллическом кремнии вызывает высокую плотность дислокаций. Считается, что их наноструктуры обладают превосходными характеристиками из-за отсутствия дислокаций, деформаций и большого отношения площади поверхности к объему [7, 8]. Исследования наноколонок и нанопроволок GaN ведутся интенсивно [9,10,11,12]. Нано-столбчатое зародышеобразование GaN происходит спонтанно по механизму роста Фольмера-Вебера [13], тогда как состояние с высоким содержанием азота (N) предотвращает слияние центров зародышеобразования. Большое внимание было уделено изготовлению электрического устройства на нанопроволоках GaN или на наноколонках. Нанопроволоки GaN были механически диспергированы на SiO 2 . Подложка / Si и омические контакты формируются с двух сторон индивидуальной нанопроволоки случайным образом [14]. В другом случае [15] одна сторона нанопроволоки была прикреплена к столику, соединенному с отрицательным электродом, а другая сторона была выровнена с положительным электродом с помощью сканирующего электронного микроскопа (SEM), образуя электрическое устройство для научных исследований.
В качестве альтернативы, особая наноструктура, а именно сетка наностенки GaN, которая является электропроводящей в плоскости, является многообещающей, поскольку для изготовления наноустройства не требуется сложного процесса. В 2007 году группа Кишино получила рост сетки наностенки GaN с использованием слоя Ti, сформированного с помощью электронно-лучевой литографии, в качестве маски [16]. Несколько лет назад рост сетки наностенки GaN без литографии был успешно осуществлен на сапфировых и кремниевых подложках [17,18,19]. Интенсивность излучения на краю полосы сетки наностенки GaN подобна наноколонкам GaN, и желтая люминесценция не очевидна, что указывает на высокое качество сетки наностенки GaN. В отличие от разделенной наноструктуры, такой как наноколонны, сетка наностенки является электропроводящей в плоскости [18, 20, 21], поэтому ее можно превратить в наноустройство так же просто, как пленку [22]. Следовательно, препятствие для изготовления устройств на разделенных наноколонках может быть устранено за счет плоской электропроводности сети наностен. Очень важно изучить механизм роста сети наностен. Спонтанное образование сетки наностен, вызванное дислокациями, рассматривается как механизм роста сетки наностен из GaN на голых c -плоскостной сапфир [23]. Поскольку образование сетки наностенок, вызванное дислокациями, плохо контролируется, рост сетки наностенок проводился на подложке Si (111) с буферным слоем Al [18]. Механизм роста наностенки на Si (111) существенно отличается от такового на голой сапфировой подложке; однако никаких исследований не проводится, хотя механизм роста на Si (111) является ключевым для роста сети наностен.
В данной работе систематически исследуется рост GaN в различных структурах, включая сетку наностенок, наноколонны и компактную пленку. Различные структуры GaN, упомянутые выше, были выращены на Si (111) с использованием плазменной молекулярно-лучевой эпитаксии (МБЭ). Результаты показывают, что сдвиг структуры при росте GaN может быть достигнут путем регулирования отношения Ga / N и добавления предварительно нанесенных капель Al. Морфология и фотолюминесценция сетки наностенки GaN были измерены с помощью автоэмиссионной сканирующей электронной микроскопии (FESEM) и анализатора спектра фотолюминесценции с He-Cd лазером (325 нм, 200 мВт) в качестве источника возбуждения. Атомно-силовой микроскоп (АСМ) был использован для характеристики предварительно нанесенного слоя Al. Предложен механизм роста сетки наностенок GaN на Si (111) с металлическими каплями Al.
Экспериментальный
Структуры GaN были выращены на подложках Si (111) с помощью системы МПЭ Riber 32, оснащенной N 2 ВЧ источник плазмы (Veeco, RFS-N / TH). Давление в камере роста было накачано до 3,0 × 10 - 10 Торр до роста. N 2 В эксперименте использовались газ, Ga и Al чистотой 99,9999%. Подложка Si (111) (без легирования, одна сторона отполирована для роста, 380 ± 20 мкм, предоставлена Sigma-Aldrich) с удельным сопротивлением> 5000 Ом · см была очищена стандартным процессом RCA с последующим погружением в HF:H 2. O =1:50 в течение нескольких секунд, чтобы удалить слой оксида кремния с поверхности Si-подложки, а также сформировать поверхность с концевыми водородными группами.
Для роста наноколонн GaN заслонки N 2 плазма и источник Ga были одновременно открыты, и голый Si (111) был нагрет до 973 К. Мощность и давление N 2 Источник плазмы, использованный во всех образцах в этой работе, был зафиксирован на 400 Вт и 4,2 × 10 - 5 Торр соответственно. Перед выращиванием сетки наностенки GaN капли Al диаметром около 80 нм осаждались на голый Si (111), нагретый до 973 К. Источник Al поддерживался при 1323 К. Предварительное осаждение капель алюминия привело к другому зарождению и росту GaN, что привело к росту сетки наностен. Поток Ga для роста сетки наностенок был таким же, как и для наноколонн ( φ Ga =1,2 × 10 - 7 Торр при 1169 К). Для роста пленки GaN поток Ga был увеличен до 5,3 × 10 - 7 Торр, в то время как поток азота поддерживался постоянным.
Результаты и обсуждение
Когда ставни N 2 плазма и Ga были открыты одновременно, GaN (S 1 ) выросли в виде наностолбиков на голом Si (111), как показано на рис. 1а. Поток Ga составил 1,2 × 10 - 7 . Торр и подложка Si (111) поддерживалась при 973 К, как показано в таблице 1. Наблюдается, что диаметр наноколонок GaN находится в диапазоне от 52 до 125 нм при длине ~ 460 нм. Плотность наностолбиков, рассчитанная по изображению на сканирующем электронном микроскопе, составляет ~ 10 7 мм - 2 . Очевидно, что большинство наноколонок, наблюдаемых на рис. 1б, не перпендикулярны подложке, а наклонены под углом ~ 30 °. Верхняя поверхность наноколонок гладкая, что согласуется с отчетом Бертнесса [9]. Считается, что наноколонки зарождаются спонтанно, а затем распространяются, потому что коэффициент прилипания на (0 0 01) c -плоскость выше, чем на {110 0} м -самолет. Длина диффузии L поглощенного атома Ga (Ga ab ) необходим для роста наноколонок. Как описано в формуле. (1) диффузионная длина L зависит от средней дистанции прыжка a , Ga ab энергия десорбции Q des , а энергия активации скачка поверхностной диффузии Q d [13] .
$$ L =\ sqrt {2} a \ \ exp \ left (\ frac {Q _ {\ mathrm {d} \ mathrm {es}} - {Q} _ {\ mathrm {d}}} {2 kT} \ справа) $$ (1)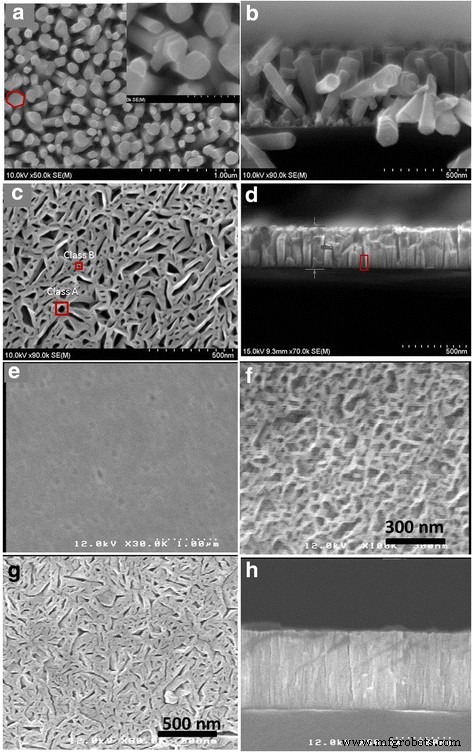
FESEM-изображения образцов, выращенных в различных условиях. а , b Соответствует наноколонкам GaN (образец S 1 ). c , d Соответствует сетке наностенки GaN (образец S 2 ), e Соответствует компактной пленке (образец S 3 ), f Соответствует сетке наностенки GaN (образец S 4 ) на начальной стадии роста. г , ч Соответствует сетке наностенок GaN, выращенной при более низкой температуре 900 К (образец S 5 )
Поскольку атомарно плоские боковые стенки наноколонки обеспечивают мало сайтов адсорбции, предполагается, что Ga ab длина диффузии L на м -плоскость боковин намного выше, чем на c -плоскость, приводящая к вертикальному росту GaN до наноколонн. Если бы это предположение было верным, сильная анизотропия скорости роста изменилась бы при улучшении отношения Ga / N. Действительно, GaN (S 3 ) структура изменилась с наноколонки на компактную пленку (рис. 1д), когда поток Ga был увеличен до 5,3 × 10 - 7 Торр. Следовательно, рост GaN в виде наноколонки или компактной пленки можно контролировать, регулируя соотношение Ø / V.
Хотя наноколонки GaN демонстрируют более высокие характеристики, чем пленка, изготовление электрического устройства представляет большие трудности, поскольку разделенные наноколонки необходимо выровнять перед изготовлением электрического контакта. Следовательно, предпочтение отдается плоской электропроводящей наноструктуре. Для роста образца S 2 Предварительное осаждение металлического Al проводилось в камере роста МЛЭ в течение 40 с. Затем N 2 плазма и источник Ga открывались одновременно. Поток Ga для S 2 рост представлен в Таблице 1, такой же, как у S 1 . На рис. 1c показано FESEM-изображение образца S 2 , вид сверху. Весьма интересно, что GaN растет в виде сетки наностенок на Al / Si (111). Наностены диаметром 50 ~ 100 нм перекрываются и переплетаются друг с другом, образуя непрерывную сеть в плоскости, а именно сеть наностен. Наблюдаются два класса отверстий, называемых классом A и классом B. Диаметр отверстий класса A и класса B обычно составляет 50 ~ 100 и 10 ~ 49 нм, соответственно. Непрерывная характеристика в плоскости делает сетку наностен в стекле электропроводящей [18], что в некоторой степени устраняет препятствия для изготовления наноприборов. Верхняя поверхность наностенок относительно плоская, в отличие от ограненной матрицы GaN, описанной в [5]. [13]. Видно, что отверстия, показанные на изображении вида сверху, доходят до подложки, как показано прямоугольником на рис. 1d.
Можно задаться вопросом, как образуются упомянутые выше дыры. Вырастили образец S 5 при более низкой температуре роста 900 К. Остальные параметры роста такие же, как у образца S 2 , как показано в таблице 1. Из рис. 1g мы видим, что образец S 5 также вырос в виде сети наностен с меньшими отверстиями. На рис. 1h показано поперечное сечение S 5 . , показывающий более компактный слой, чем S 2 Чтобы увидеть начало роста сети наностен из GaN, мы вырастили еще один образец S 4 за короткое время с предварительным осаждением Al. Все параметры роста S 4 такие же, как в образце S 2 кроме времени роста (20 против 120 мин). Толщина S 4 составляет около 50 нм, а его вид сверху показано на рис. 1f. Замечено, что на этой стадии образовались дырки, а GaN в исходном состоянии представляет собой непрерывную сетку в плоскости, а не нанопроволоки или островки GaN. Из исследования образцов S 1 , S 2 , S 4 , и S 5 очевидно, что предварительное осаждение слоя Al изменяет характер роста GaN вначале, от наноколонки к сплошной сетке наностенки в плоскости.
Обратите внимание, что все условия роста S 2 за исключением того, что предварительное осаждение Al такое же, как и для S 1 . Затем мы можем задаться вопросом, какова структура предварительно осажденного Al и как она влияет на последующий рост GaN. Чтобы найти эти ответы, предварительное осаждение Al в течение 40 с на голый Si (111) было исследовано методами FESEM и AFM. На рис. 2а показан вид сверху предварительно нанесенного алюминия. Обнаружено, что Al на подложке Si существует в форме капель (белых точек), отличных от пленки. Капли металлического Al плотностью ~ 4 × 10 7 мм - 2 распределяют относительно равномерно без значительного скопления. Недавно Li et al. Успешно выращивали капли алюминия с использованием метода МБЭ. для улучшения качества выращенного GaN, а также для снижения напряжения [24]. Для дальнейшего изучения морфологии капель Al с помощью АСМ измеряли их трехмерные изображения и связанные с ними параметры, как показано на рис. 2b, c. Капли имеют форму шара, как показано на рис. 2b, что согласуется с результатом SEM. Измеренные высота и диаметр капли Al составляют 6,7 и 80 нм соответственно. Поппиц и др. [25] исследовали рост сетки наностенки GaN на голом 6H-SiC (0001) с помощью МПЭ с использованием пучка железа. Их результаты показывают, что чрезвычайно богатые азотом условия роста в сочетании с высокой температурой подложки и энергичным облучением N-ионами во время роста являются основными причинами образования сетки наностен на чистом 6H-SiC (0001). Как первопроходец Кесария и др. [17] исследовали сетку наностенок GaN на голой сапфировой подложке с помощью PA-MBE. В их исследованиях считается, что наностенки GaN зарождаются на краях и на винтовых дислокациях и растут в богатой азотом атмосфере.
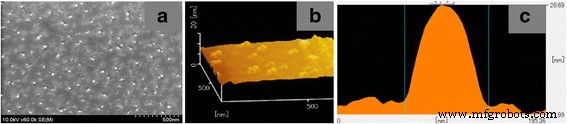
ФЕСЕМ ( а ) и AFM ( b ) изображения предварительно нанесенного Al на подложку Si. c Измерение параметров одной капли Al с помощью АСМ
В нашем случае механизм роста сетки наностенок GaN должен быть другим, поскольку наностены растут с требованием предварительного осаждения металлического Al. Конечно, насколько нам известно, все сети наностенок из GaN, включенные в наш эксперимент, выращены в атмосфере, богатой азотом. Обогащенный азотом необходим для уменьшения слипания наностенок. Теперь остановимся на роли капель Al в формировании сетки наностен. Подобно каплям Au, действующим как катализатор [26], если капли Al действуют как катализатор, GaN должен расти до наноколонн, а не до сетки наностен. Таким образом, роль капель алюминия не является катализатором в нашем исследовании. Температура плавления металлического Al составляет 933 К, в то время как температура подложки поддерживается на уровне 973 К во время роста. Таким образом, в начале роста GaN капли Al являются каплями жидкости. Согласно предыдущему отчету, в случае GaN на Si (111) с каплями Ga [13], капли Ga действуют как резервуары, снабжающие атомы Ga в непосредственной близости от них. Сами капли Ga, однако, препятствуют росту GaN на них, поскольку исходные места расположения капель Ga представляют собой полые круги. В нашем случае диаметр капель Al составляет ~ 80 нм, что аналогично размеру отверстий класса A на рис. 1а. Следовательно, капли Al могут препятствовать росту на них GaN, что приводит к образованию дырок класса A, наблюдаемых в сетке наностенок GaN. Из-за того же отношения Ш / В образцов S 1 и S 2 , диффузионная длина Ga L на Si для роста сетки наностенки, как ожидается, будет таким же, как и для наностолбиков. Типичный размер голой подложки Si (область без капель Al) составляет ~ 80 нм, что находится в пределах значения диаметра наноколонки на рис. 1а. Другими словами, диффузионная длина Ga L покрывает размер голой подложки Si, что приводит к непрерывному росту GaN в области без капель Al, то есть сетке наностенки GaN.
На основе вышеупомянутого анализа предложена модель роста сетки наностенки GaN, показанная на рис. 3. GaN зарождается на голой подложке Si, как показано на рис. 3а. Поскольку Ga ab длина диффузии L покрывает голую подложку Si, GaN растет по всей голой подложке Si, в то время как рост GaN над каплями Al затруднен (рис. 3b). Более того, в богатых азотом условиях GaN имеет тенденцию к вертикальному росту, как показано на рис. 3c. Поскольку голая подложка Si представляет собой непрерывную сетку в плоскости, рост GaN, описанный выше, также представляет собой непрерывную сеть, названную сеткой наностен, как показано на рис. 3d. Это предположение подтверждается изображением сверху образца S 4 на рис. 1е. Из-за богатства N для образца S 2 рост, боковой рост ограничен, что лунки способны резервировать при последующем росте. Обратите внимание, что как капли Al, так и состояние, богатое азотом, необходимы для роста сетки наностенки GaN.
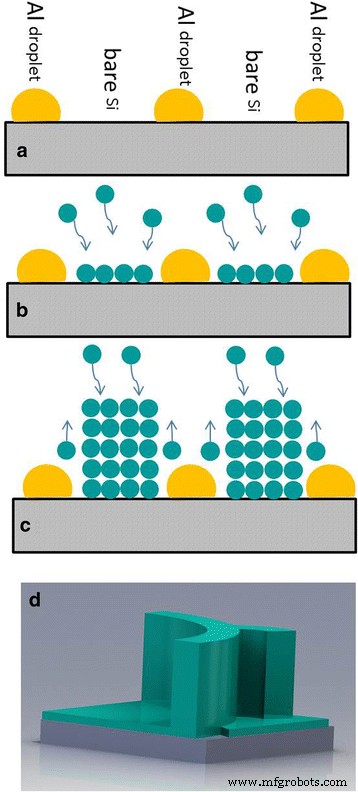
Модели роста сети наностенки GaN. а Предварительно нанесенные капли Al на подложку Si. б Зарождение сетки наностенок GaN на голом Si. c Поперечное сечение сети наностенки GaN, выращенной вертикально в состоянии с высоким содержанием азота. г Рисунок наклона сети наностенки GaN
Рентгеновская дифракция использовалась для характеристики кристаллической структуры сетки наностен GaN, как показано на рис. 4. Два дифракционных пика GaN (002) и GaN (004) наблюдаются вместе с пиком Si (111) от Подложка Si. Результат показывает, что сетка наностенки GaN является гексагональной и сильно ориентирована вдоль C . ось. В дополнение к рентгенограмме была также измерена кривая качания GaN (002) ω-сканирования, как показано на вставке к рис. 4. Полная ширина на полувысоте составляет 52,2 угл. Мин., Как и в предыдущем отчете, выращенном на сапфире. субстрат [27]. Электрические свойства были также измерены с использованием системы измерения Ван-дер-Пау-Холла (HL5500PC, Nanometrics) при 293 К. Электропроводность, холловская подвижность и концентрация электронов в сетке наностенки GaN составляют 10,2 См / см, 31 см 2 / Vs и 2,1 × 10 18 см - 3 , соответственно. Что касается пленки GaN, электропроводность увеличивается до 666,7 См / см из-за более высокой концентрации электронов 2,2 × 10 20 см - 3 . Высокая концентрация носителей в пленке, вероятно, объясняется высокой концентрацией собственных дефектов, вызванной неоптимизированным соотношением Ga / N. Что касается зальной подвижности пленки, то значение составляет 18,7 см 2 . / Против

Рентгенограмма сетки наностенок GaN (S 2 ). На вставке - кривая качания ω-развертки образца S 2 .
На рис. 5 показаны спектры фотолюминесценции сетки наностенок GaN с He-Cd-лазером в качестве источника возбуждения. Согласно отчету Кесария и др. [17], было проведено прямое сравнение катодолюминесценции между пленкой GaN, сеткой наностен и наноколонкой, выращенной на голой сапфировой подложке. Их результаты показывают, что эмиссия на краю полосы сетки наностен немного выше, чем у наноколонки, и намного выше, чем у пленки. Широкая эмиссия дефектов с центром от 520 до 620 наблюдается для сетки наностен, в то время как эмиссия дефектов не может наблюдаться для наноколонки. На рис. 5 наблюдается сильное излучение на краю полосы с центром на 363,7 нм с полной шириной на полувысоте 14,1 нм. В соответствии с отчетом Кесарии и др. [17], в диапазоне от 520 до 620 нм широкое зелено-желтое излучение, приписываемое точечным дефектам [28], обнаруживается, но очень слабо, что указывает на высокое качество наностенки GaN. сеть. Следовательно, люминесценция сетки наностенок GaN, выращенной на голой сапфировой подложке и на подложке Si с каплями Al, почти одинакова, хотя механизм роста различен.

Спектры фотолюминесценции (ФЛ) сетки наностенки GaN, измеренные при комнатной температуре
Выводы
В этой работе сдвиг структуры роста GaN между наноколонкой, сеткой наностен и компактной пленкой был успешно достигнут на подложке Si (111) с использованием МПЭ. Наноколонки GaN были выращены на голой подложке Si в условиях, богатых N, в то время как компактная пленка была выращена с улучшенным потоком Ga. При добавлении предварительно осажденного слоя Al рост GaN смещается от наноколонок к сплошной сетке наностенки в плоскости. Предварительно нанесенный слой Al существует в виде капель с типичной высотой и диаметром 6,7 и 80 нм соответственно. Рассмотрен механизм роста сети наностен. GaN непрерывно растет на голой подложке Si, в то время как рост GaN на каплях Al затруднен, что приводит к образованию сетки наностен. И капли алюминия, и условия, богатые азотом, важны для роста сети наностен.
Наноматериалы
- Побитовые операторы C# и операторы сдвига битов
- C Структура и функция
- Командная химия и индустрия 4.0
- 5G и GaN:переход от LDMOS к GaN
- 5G и GaN:будущие инновации
- Интернет вещей и блокчейн - изменение парадигмы
- Разница между структурой и объединением
- Раскрытие атомной и электронной структуры углеродных нановолокон с набором чашек
- Структура и электронные свойства наноглины каолинита, легированной переходным металлом
- Анализ инфракрасного отражения эпитаксиальных легированных слоев GaN n-типа, выращенных на сапфире



