Электронная томография нанопроволок GaN / (In, Ga) N ядро-оболочка в форме карандаша
Аннотация
Трехмерная структура нанопроволок ядро-оболочка GaN / (In, Ga) N с многогранным острием в форме карандаша проанализирована с помощью электронной томографии с использованием режима многоугольного кольцевого темного поля в сканирующем просвечивающем электронном микроскопе. Селективный рост площадей на шаблонах GaN-на-сапфире с использованием узорчатой маски выполняется методом молекулярно-лучевой эпитаксии для получения упорядоченных массивов однородных нанопроволок. Наши результаты томографической реконструкции позволяют детально определить сложную морфологию внутренней многогранной оболочечной структуры (In, Ga) N и ее отклонение от идеальной гексагональной симметрии. Томограмма однозначно определяет конфигурацию точки в проволоке на вершине нанопроволоки, включая точную форму и размер, а также пространственное распределение его химического состава.
Введение
Продолжающийся процесс миниатюризации оптоэлектронных устройств привел к разработке сложных трехмерных (3D) наноструктур. В этом отношении нанопроволоки (ННК) являются многообещающими кандидатами для реализации высококачественных структур с квантовыми ямами или квантовыми точками (КТ) из-за их большого отношения поверхности к объему, связанного с эффективной релаксацией деформации в осевых или радиальных гетероструктурах ННК [1, 2,3]. Недавние усовершенствования в области селективного роста площадей (SAG) с помощью молекулярно-лучевой эпитаксии (MBE) на шаблонах GaN-на-сапфире привели к изготовлению упорядоченных и однородных массивов GaN ННК с плоской или карандашной вершиной [4, 5]. Последний был использован для изготовления оболочечных структур (In, Ga) N / GaN, выращенных на многогранном острие ядра GaN, что является альтернативным решением для роста квантовых точек. Использование преимущества уменьшенного диаметра ННК и соответствующей возможности выращивания гетероструктур с короткими участками материала с малой шириной запрещенной зоны (In, Ga) N, вставленным в барьеры из GaN, приводит к образованию так называемой точки в проволоке (DIW ) конструкции. В зависимости от фактических размеров, эта конфигурация DIW позволяла излучать линейно поляризованные одиночные фотоны, используя основное преимущество, заключающееся в простом исследовании только одного одиночного NW вместо ансамбля NW [6,7,8]. Тем не менее, подробный микроструктурный анализ этих гетероструктур DIW необходим для понимания влияния морфологии ННК, толщины оболочки и локального химического состава на характеристики однофотонной эмиссии.
Просвечивающий электронный микроскоп (ПЭМ) - часто используемый и мощный инструмент для получения информации о структуре и химическом составе таких наноструктур на атомном уровне [9]. Однако более низкая симметрия этих трехмерных наноструктур по сравнению, например, с планарными системами, значительно затрудняет интерпретацию микрофотографий ПЭМ. Основной характеристикой является пропускание образца электронным лучом, так что структурная информация проецируется в двумерное изображение. Изменения структуры образца в направлении электронного луча и порядка толщины образца или ниже очень трудно или даже невозможно обнаружить напрямую. Электронная томография может обойти эту проблему. Вместо использования одной проекции образца записывается серия проекций с разными углами наклона к объекту для восстановления трехмерной информации образца. Это открывает новые и расширенные возможности для описания и анализа морфологии и химического состава сложных структур, таких как ядерно-оболочковые ННК. На данный момент опубликовано лишь несколько публикаций, касающихся электронной томографии структур ННК [9,10,11,12,13,14,15] или структур с внедренными КТ [16].
В данной работе описывается применение электронной томографии для структурной характеристики упорядоченных ННК GaN, содержащих встроенную оболочку (In, Ga) N. Подготовка образца объясняется здесь подробно из-за проблемы сделать одиночные ННК доступными для электронной томографии путем изоляции без внесения повреждений. Морфология поверхности и кристаллическая огранка ННК изучаются посредством анализа трехмерных представлений поверхности внешней оболочки GaN. Внутренняя структура ННК, т.е. морфология оболочки (In, Ga) N, а также пространственное распределение химического состава обсуждаются с помощью двумерных срезов реконструированного объема и дополнительных энергодисперсионных рентгеновская (EDX) спектроскопия.
Методы
Материал
ННК GaN / (In, Ga) N были выращены на коммерческом шаблоне GaN-на-сапфире (0001) (LUMILOG) с толщиной буферного слоя GaN 3,3 мкм методом плазменной молекулярно-лучевой эпитаксии (PAMBE). На первом этапе коллоидная литография была использована для создания маски с нанотверстиями из титана, образующей гексагональный узор. Последующая САГ произвела периодический массив ННК GaN с острием в виде карандаша. Ядра GaN NW зарастали тонким слоем (In, Ga) N при более низкой температуре роста, а затем дополняли тонким закрывающим слоем GaN без изменения температуры. Схема процесса выращивания представлена на рис. 1а. Подробности о процедуре формирования рисунка на подложке и процессе SAG MBE можно найти в других источниках [6, 7, 17]. На рисунке 1 представлены два изображения образца, полученные с помощью сканирующей электронной микроскопии (СЭМ), показывающие гексагональный массив ННК при виде сверху (b) и под углом 45 ° (c) при большем увеличении. Микрофотографии SEM показывают относительно однородное расположение с небольшими вариациями формы и длины. Средний диаметр НП составляет около 180 нм, а средняя высота - около 500 нм.
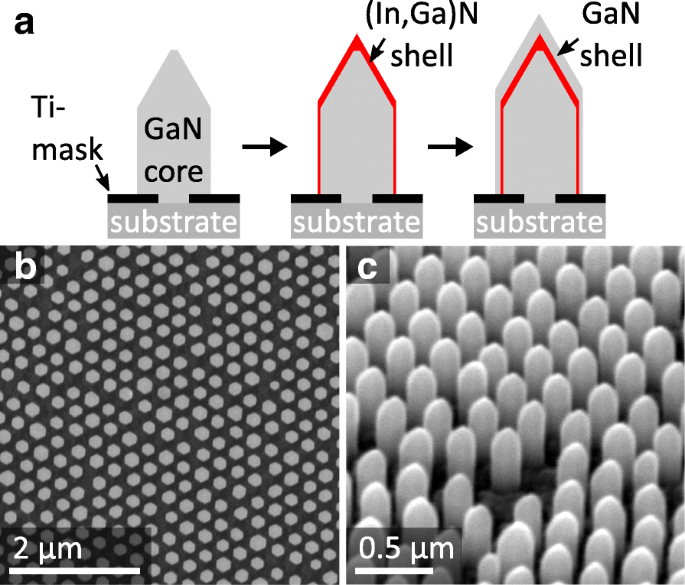
а Схема процесса выращивания NW. СЭМ-микрофотографии b массив GaN / (In, Ga) N NW сверху и c Угол обзора под углом 45 ° с большим увеличением
Подготовка иглы для томографии
Для получения игольчатого томографического образца, содержащего только одну единственную ННК, необходима сложная техника подготовки. Игла круглой формы допускает максимальный диапазон наклона 180 °, при этом толщина образца практически постоянна для всех углов наклона. Сфокусированный микроскоп с ионно-галлиевым пучком (FIB) позволяет проводить такую подготовку образцов в зависимости от места проведения эксперимента. Для этой работы использовалась система двухлучевого микроскопа (JEOL JIB-4501). Следующие этапы подготовки основаны на стандартной методике извлечения FIB с последующим утонением для получения образца игольчатой формы [18,19,20].
Различные этапы подготовки представлены на рис. 2. Первоначально выбирается интересующая область, которая идентифицируется ненарушенным и почти идеальным гексагональным расположением нескольких ННК (отмеченных белым прямоугольником на рис. 2а). Выбранный объем зонда должен быть заполнен углеродом для защиты NW во время процесса измельчения FIB [21]. Осаждение углерода проводилось в два этапа, чтобы уменьшить загрязнение Ga:(i) во-первых, осаждением углерода, индуцированным электронным пучком, чтобы заполнить объем между ННК (рис. 2b), и (ii) впоследствии, осаждением углерода индуцированный пучком галлия для создания ок. Защитный слой толщиной 1 мкм поверх выбранного участка (рис. 2в). Были изготовлены дополнительные угольные маркеры, чтобы упростить ориентацию на следующих этапах подготовки.
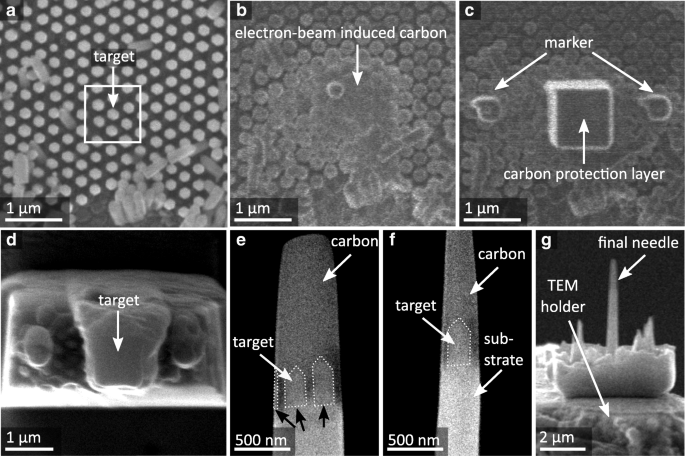
Микрофотографии SEM, показывающие a массив NW и выбранная область для препарирования иглы FIB (белое поле), b NW, встроенная в углерод, индуцированный электронным лучом, c углерод, индуцированный лучом галлия, в виде толстого слоя осаждения поверх выбранной области и два дополнительных маркера, d изолированная игла готова к извлечению, e , f истонченная томографическая игла (черные стрелки указывают северо-западные позиции) и g обзор иглы финальной томографии
После осаждения углерода было введено фрезерование FIB, чтобы изолировать защищенную зону (рис. 2d) и изготовить иглу прямоугольной формы, содержащую несколько ННК. Микроманипулятор (Kleindiek Nanotechnik GmbH) использовался для переноса иглы в держатель томографа. Таким образом, ось иглы должна быть тщательно отрегулирована параллельно оси вращения гониометра, чтобы такой же фокус был применим для большой площади образца. Кроме того, NW [0001] c - ось перпендикулярна подложке и, следовательно, параллельна оси иглы. Это соотношение использовалось для определения направлений кристаллов относительно оси томограммы. Картины дифракции на выбранной области (SAD), измеренные сзади, показали наклон северо-западного [0001] c - ось к оси вращения томограммы всего 2,2 °.
Дальнейшие этапы утонения были выполнены, чтобы изолировать одну единственную ННК, закруглить иглу и в конечном итоге получить электронную прозрачность (см. Рис. 2e, f). На Рисунке 2g показана последняя игла томографии.
Электронная томография
Томографический сбор данных и микроструктурный анализ выполнялись с помощью ТЕМ (JEOL JEM-2100F), работающего при 200 кВ. Микроскоп оборудован сканирующим блоком, включающим детектор светлого поля (BF) и многоугольного кольцевого темного поля (HAADF), а также 50-миллиметровый 2 Детектор рентгеновского излучения (JEOL EX-24065) для EDX-спектроскопии. Режим сканирующей просвечивающей электронной микроскопии (STEM) HAADF выбран из-за преимущественно химического контраста [22]. Монотонная зависимость интенсивности от массовой плотности и толщины объекта является предпосылкой для электронной томографии и известна как «требование проекции» [23].
Была записана серия из 89 микрофотографий HAADF с шагом 2 ° между каждым измерением. Эта серия наклона, охватывающая полный диапазон 180 °, стала возможной благодаря специальному держателю томографа (модель 2050 от E.A. Fischione Instruments Inc.), поддерживающему подготовленную геометрию иглы для образца. Каждая микрофотография STEM сделана с разрешением 2048 × 2048 пикселей; время задержки пикселя 30 мкс, то есть время полного сканирования 127 с на изображение; размер пятна 0,5 нм; и угол приема электронов от 70 до 180 мрад в соответствии с руководством производителя. Микрофотографии были объединены в интервалы (объединение 4 × 4 =окончательное разрешение 512 × 512) для улучшения отношения сигнал / шум, а также скорости вычислений при 3D-реконструкции. Все микрофотографии вручную выровнены относительно друг друга, так что ось иглы выбрана в качестве оси вращения для преобразования Радона. Томограмма рассчитывается и визуализируется с помощью пакета программ томографии (IMOD) [24]. Расширенный рендеринг трехмерных структур выполняется с помощью бесплатного программного обеспечения для компьютерной графики с открытым исходным кодом Blender (Blender Foundation).
В рамках этой работы для визуализации применяются два разных метода. Двумерные срезы извлекаются из восстановленного трехмерного объема. Такие срезы имеют конечную толщину, по которой интегрируются интенсивности вокселей (трехмерных пикселей) для улучшения отношения сигнал / шум. Идеальная ширина среза - это компромисс между уменьшением шума и размытием контраста из-за усреднения вариаций выборки перпендикулярно срезу. Другой метод визуализации - это представление изоповерхности. Используется в случае достаточного контраста между двумя соседними материалами. В общем, изоповерхность - это трехмерное представление поверхности вокселов с постоянной интенсивностью. Промежуточная интенсивность между двумя материалами выбирается для построения изоповерхности, воспроизводящей границу раздела соседних материалов.
Хотя микрофотографии HAADF используются в качестве основы для расчета томограммы, восстановленное распределение интенсивности определяется не только химическим составом образца. Кристаллические дефекты в образце [25] или, с другой стороны, несовпадение микрофотографий и искажения микрофотографий из-за дрейфа образца или возмущений магнитного поля влияют на восстановленные интенсивности и, таким образом, на окончательное разрешение. То же самое относится к внутренним ошибкам реконструкции, таким как артефакты купирования [26] или предел пространственного разрешения томограммы, обусловленный критерием Кроутера [27] (ограниченная выборка). Последнее следует особенно учитывать при использовании толстых игл для томографов в несколько сотен нанометров. Если размер реконструируемого объекта увеличивается, разрешение томограммы ухудшается, если количество микрофотографий фиксировано.
Результаты и обсуждение
Морфология поверхности и огранка кристаллов
На рис. 3 a и b показаны изоповерхностные представления всего NW и вершины NW в перспективе (в центре) и на различных видах в направлениях с низким показателем преломления с шагом 30 °. Рисунок показывает внешнюю форму кристалла и огранку поверхности соответственно. В нижней части реконструкции показан ожидаемый шестиугольный цилиндр СЗ с регулярным неполярным \ (\ left \ {1 \ overline {1} 00 \ right \} \) м грани поверхности. Грани и плоскости кристалла определяются на основе соответствующей картины дифракции электронов, снятой одновременно с изображениями HAADF. Пример такого шаблона SAD приведен для ориентации - 90 °, то есть вдоль оси зоны [\ (1 \ overline {1} 00 \ Big] \) (см. Рис. 3b). Верхняя часть СЗ отражает пирамидальную форму, состоящую из \ (\ left \ {1 \ overline {1} 01 \ right \} \) s -плоскость и \ (\ left \ {1 \ overline {1} 02 \ right \} \) r -плоские грани, которые, однако, не расположены идеально симметрично друг другу. Очень маленькая грань поверхности треугольной формы (отмечена зелеными стрелками на рис. 3b) расположена рядом с концом северо-западного направления, который, скорее всего, представляет собой \ (\ left \ {2 \ overline {2} 01 \ right \} \) -тип фасета. Такая небольшая асимметрия пирамидальной формы острия часто встречается на образце (см. Рис. 1). Причина этого отклонения связана с взаимодействием дефектов, как обсуждается в следующем абзаце.

Изоповерхностное представление a единый NW и b вершина СЗ с перспективным видом в центре и различными углами обзора вдоль направлений с низким показателем преломления GaN (ZA, ось зоны). Дополнительно несколько образцовых м -, s - и r -плоскости помечены (зеленые стрелки указывают фасет типа \ (\ left \ {2 \ overline {2} 01 \ right \} \))
Над пометкой r -плоскость и фасет \ (\ left \ {2 \ overline {2} 01 \ right \} \), на самом верху образуется неправильная «шляпа» СЗ. Измерения ПЭМ с высоким разрешением (ВР) на образце ПЭМ-пластинки, содержащем несколько ННК одной и той же пластины, демонстрируют наличие дефектов упаковки и изменение кристаллической решетки с гексагональной на кубическую в верхней области ННК (не показано здесь). Эти структурные изменения соответствуют нашим предыдущим наблюдениям, которые объясняются нестабильностью кристаллической фазы из-за значительно более низкой температуры роста, используемой для роста внешней оболочки GaN (около 625 ° C) по сравнению с ядром GaN (около 850 ° C) [5, 7].
Внутренняя структура оболочки (In, Ga) N
Томограмма ННК была использована для получения информации о внутренней структуре оболочки (In, Ga) N, ее химическом составе и пространственном распределении. Невозможно легко получить доступ к трехмерному изоповерхностному представлению структуры оболочки из-за низкого воксельного контраста между оболочкой (In, Ga) N и материалом матрицы GaN. Поэтому в качестве альтернативы внутренняя структура оболочки визуализируется путем извлечения тонких срезов, вырезанных из восстановленной трехмерной томограммы.
На рис. 4 в качестве примера показаны пять срезов кончика NW вдоль оси провода [0001]. Каждый срез имеет толщину около 7 нм. Ориентация срезов выбрана с учетом шестиугольной симметрии шестого порядка. Следовательно, срезы повернуты на 30 ° друг к другу - в соответствии с маркировкой, представленной на рис. 3b. Чтобы дополнительно проиллюстрировать эту точку зрения, трехмерное визуализированное изображение Северо-Западного края вместе с пространственным положением среза, наклоненного на -60 ° (т. Е. Срез, параллельный \ (\ left (\ overline {2} 110 \ right) \ ) плоскость решетки) дополнительно приведена на рисунке.
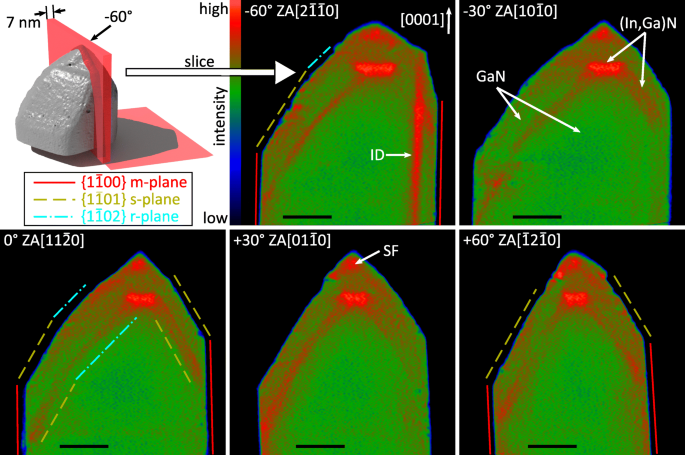
Поперечные срезы на томограмме. 3D визуализированное представление NW и среза (верхний левый угол) определяет пространственное положение среза с наклоном - 60 °. Все срезы вращаются вокруг оси, которая проходит через кончик ННК и параллельна оси роста [0001] ННК. Обозначены область инверсии (ID) и расположение дефектов упаковки (SF). Ориентация срезов соответствует маркировке на рис. 3. Длина черной шкалы соответствует 50 нм
Восстановленные воксели (In, Ga) N имеют несколько более высокую интенсивность по сравнению с таковыми из GaN. Следовательно, что касается цветового кода на фиг. 4, GaN представлен зеленым, тогда как In-содержащие слои для ясности выглядят красноватыми. Срезы в поперечном сечении демонстрируют структуру ядро-оболочка СЗ. Из-за снижения температуры роста для зарастания (In, Ga) N разумно предположить, что морфология ядра GaN остается неизменной и рост (In, Ga) N протекает конформным образом. Таким образом, внутренняя оболочка (In, Ga) N, а также внешняя оболочка из GaN примерно повторяют морфологию ядра GaN NW. В частности, слой (In, Ga) N образует полный m- плоская оболочка вокруг провода превращается в s - и r -плоские граненые пирамидальные оболочки на вершине СЗ. Кончик внутренней оболочки расширяется, образуя так называемую конфигурацию (In, Ga) N DIW, имеющую форму перевернутой усеченной пирамиды с гексагональным основанием, состоящим из c грани плоскости как верхняя и нижняя границы (см. следующий абзац).
Кроме того, рис. 4 дает обзор различных толщин слоя (In, Ga) N. м толщина оболочки составляет всего 1 нм (согласно микрофотографиям HAADF STEM вдоль направления \ (\ left \ langle 11 \ overline {2} 0 \ right \ rangle \), см. Дополнительный файл 1:Рисунок S1), тогда как <я> с - и r -плоскостные грани имеют толщину от 8 до 14 нм. Эта разница в толщине является следствием неоднородных скоростей роста [28, 29] различных граней и эффекта затенения, вызванного низкой диффузией индия во время роста MBE [30]. Кроме того, атомы индия не распределены однородно по структуре оболочки, поскольку скорость включения индия зависит от ориентации граней с наибольшим значением в c -плоскостные слои [31]. Вдобавок кажется, что в некоторых областях оболочки концентрация выше вблизи границ раздела. Следует отметить, что м Оболочка самолета при реконструкции решена плохо. Ось вращения преобразования Радона была выбрана таким образом, чтобы проникать через кончик СЗ для достижения наилучшего разрешения томографии в центре СЗ согласно критерию Кроутера.
Срез с ориентацией на 60 ° показывает полоску высокой интенсивности шириной 10 нм. Эта полоса также была видна как яркий контраст на изображениях HAADF серии наклона. Темное поле g 0002 измерения указывают на наличие границ инверсионных доменов, что соответствует наблюдениям Конга и др. за аналогичными структурами. [32]. Было обнаружено, что домен инверсии был индуцирован непреднамеренным атомным слоем титана (остатки маски), расположенным между подложкой и ННК. Электронная томография этой инверсионной области показывает форму эллиптического цилиндра, как это будет продемонстрировано ниже.
В дополнение к поперечным сечениям была сделана серия срезов на томограмме перпендикулярно оси NW, чтобы получить полное трехмерное представление структуры оболочки. Девять срезов на разной высоте показаны на фиг. 5 вместе с изображением пространственного положения первого среза вместе с поперечным сечением, представляющим различные положения по высоте. Все срезы на виде сверху имеют ширину 3,6 нм.
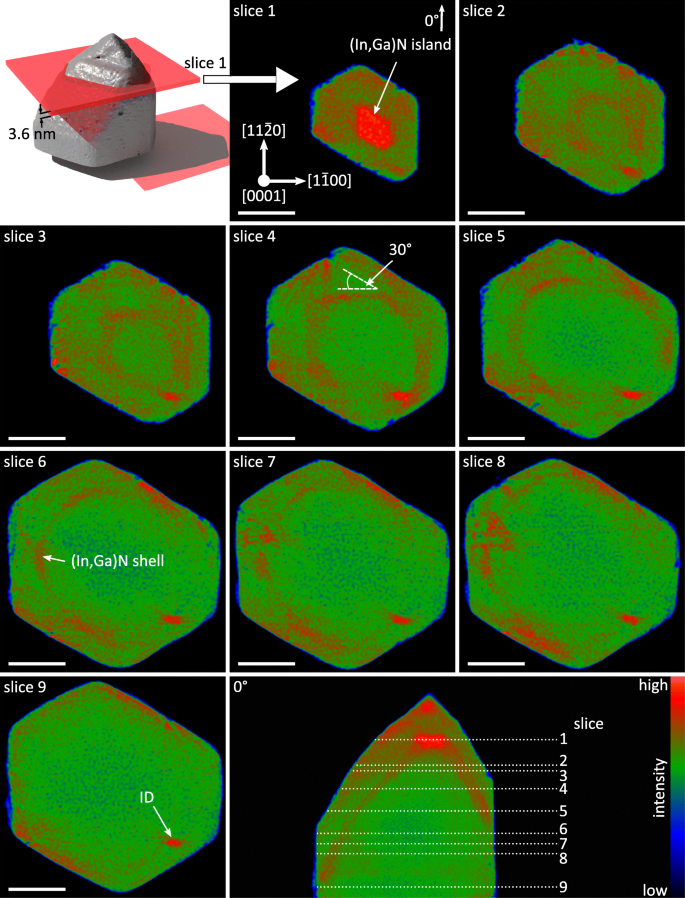
Вид сверху срезов на томограмме. Трехмерное визуализированное представление NW и среза (верхний левый угол) задает пространственное положение среза 1. Все срезы перпендикулярны направлению [0001], а различные положения срезов помечены в срезе поперечного сечения (нижний правый ). Срезы имеют ширину 3,6 нм. Длина белой шкалы соответствует 50 нм
Рассмотрение рис. 5 предлагает два новых взгляда на внутреннюю структуру ННК, которая была недоступна экспериментально без электронной томографии. Во-первых, прямо очевидно, что диаметр NW и, следовательно, площадь среза на виде сверху уменьшается снизу вверх, что является результатом карандашноподобной формы NW. Однако следует отметить, что боковая стенка, расположенная рядом с областью инверсии эллиптического цилиндра, остается на своем месте и меняет свои размеры медленнее, чем другие боковые стенки. Сравнение с изображением изоповерхности (см. Рис. 3) показывает, что эта боковая стенка соответствует внешней оболочке из GaN с очень вытянутой длиной m -плоскость, переходящая в треугольную, \ (\ left \ {2 \ overline {2} 01 \ right \} \) грань (зеленая стрелка на рис. 3). Таким образом, можно сделать вывод, что наличие инверсионного домена влияет на общую кинетику роста, приводя к закреплению ближайшей расположенной боковой стенки. Следовательно, центр острия NW смещен в сторону области инверсии, а противоположные грани должны поворачиваться на меньших высотах от m -плоскость до s - и r грани, образующие смещенный северо-западный конец.
Во-вторых, оболочка (In, Ga) N не всегда параллельна m -, г -, или s -плоскостная граненая боковина из GaN. В нижней части ННК оболочка (In, Ga) N однозначно воспроизводит форму ядра GaN с m грани, как и внешняя оболочка GaN. С другой стороны, у пирамидальной вершины ННК внутренняя оболочка (In, Ga) N отклоняется от гексагональной формы внешней оболочки GaN. Например, срез 4 на рис. 5 показывает, что внешняя грань GaN и оболочка (In, Ga) N имеют грани, которые повернуты на 30 ° в ожидаемую ориентацию по причинам симметрии. Эти фасеты соответствуют полуполярным фасетам \ (\ left \ {11 \ overline {2} l \ right \} \). Что касается срезов 1 и 2, оболочка (In, Ga) N возвращается к шестиугольной форме по направлению к кончику, причем две из шести граней выражены лишь незначительно. Это отклонение от гексагональной формы неожиданно и может быть обнаружено только с помощью электронной томографии. Примечательно, что внешняя оболочка из GaN не полностью повторяет форму внутренней оболочки (In, Ga) N, вместо этого форма НП изменяется на ожидаемую гексагональную симметрию НП из GaN.
Структура точки в проводе
Как ранее показано на фиг. 4 и 5, на вершине оболочки (In, Ga) N расположена вставка с повышенным содержанием индия. Более подробный вид этой структуры DIW изображен на рис. 6. На рисунке представлены увеличенные версии как вида сверху, так и срезов томографической реконструкции. Кроме того, он показывает изоповерхностное представление трехмерной формы точки, а также распределение индия, измеренное с помощью EDX. EDX-анализ выполняется на вершине аналогичного NW той же пластины.
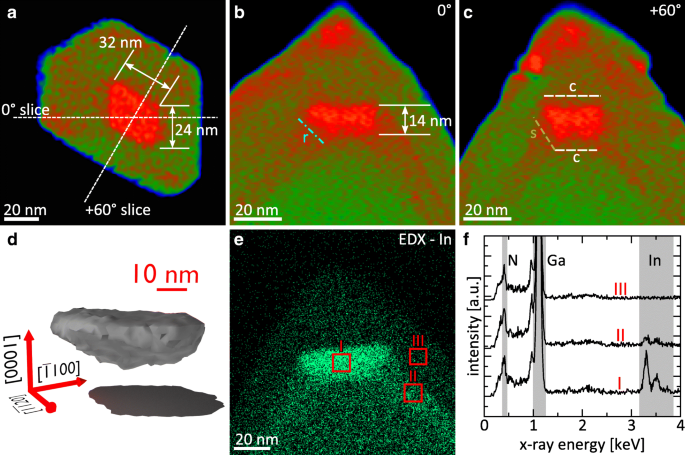
Увеличенный a вид сверху и б , c поперечные сечения томографических срезов рис. 4 и 5, демонстрирующие морфологию структуры «точка в проволоке». г Трехмерное изоповерхностное изображение точки (In, Ga) N. Измерения EDX на аналогичном наконечнике NW представлены в виде e карта EDX, показывающая пространственное распределение индия и f спектр EDX, извлеченный из карты в трех различных областях:(I) в точке (In, Ga) N, (II) в оболочке (In, Ga) N и (III) во внешней оболочке GaN
Три среза на рис. 6a – c показывают форму и размеры точки. На разрезе вида сверху на (а) точка почти отображает геометрию параллелограмма вместо шестиугольника с двумя менее выраженными боковыми стенками. Длина двух больших пар боковых стенок составляет 32 нм и 24 нм соответственно. Высота точки, определяемая двумя срезами в поперечном сечении на (b) и (c), составляет около 14 нм. Кроме того, на срезах поперечного сечения видно латеральное расширение точки к вершине, которое сопровождается образованием r - и s -плоские боковые грани, нижняя и верхняя части которых образуют c -плоскость граней. Тем самым точечная структура напоминает перевернутую усеченную пирамиду с искаженным шестиугольным основанием. Эта трехмерная форма наноточки дополнительно проиллюстрирована представлением изоповерхности на рис. 6d, которое подтверждает граненую форму точки и дополнительно демонстрирует, что нижний c Фаска плоскости имеет более высокую шероховатость.
На рисунках 6e и f показан результат измерения EDX с помощью карты индия в сочетании со спектрами, снятыми с позиций внутри точки (I) и оболочки (II) (In, Ga) N, а также на внешней оболочке GaN. (III). Нет интенсивности In- Lα 1 линия обнаружена в области GaN (III). С другой стороны, существует огромная разница в интенсивности линий между оболочкой и точкой, подтверждающая огромную разницу в концентрации индия [7]. По приблизительным оценкам, содержание индия в точке составляет (24 ± 6)% (более подробную информацию см. В Дополнительном файле 1:Рисунок S2). Таким образом, карта EDX обеспечивает четкое пространственное разделение между (In, Ga) N-оболочкой и точкой, одновременно подтверждая ее граненую форму. Кроме того, карта EDX демонстрирует, что воксели высокой интенсивности на томограмме очень близко к кончику ННК не возникают из-за включения индия. Это увеличение интенсивности может быть связано с контрастом HAADF, возникающим из-за дефектов упаковки в нарушенной области «шляпы» [25]. Кроме того, острие имеет гораздо меньшую толщину по сравнению с другими частями ННК, что приводит к завышению массовой плотности области острия [26].
Трехмерное изображение изоповерхности точки (In, Ga) N показывает значительную химическую шероховатость нижней границы раздела по сравнению с гладкой c -плоскостной интерфейс сверху (см. рис. 6г). Происхождение этой шероховатости может быть связано с механизмом зарождения (In, Ga) N на многогранной вершине ядра GaN ННК. В то время как рост (In, Ga) N на m -, г - и s -плоскости происходит в 2D-режиме из-за малой концентрации индия, гораздо более высокого содержания индия (In, Ga) N на c -плоскость приводит к росту напряженных трехмерных ядер. Эти ядра создают напряжение в окружающей среде, которое деформирует поверхность раздела и в конечном итоге приводит к измеренной шероховатости.
Выводы
ННК ядро-оболочка (In, Ga) N / GaN исследована методом электронной томографии. Изображение изоповерхности, а также томографические срезы позволили определить огранку внешней оболочки GaN и внутренней оболочки (In, Ga) N. Показано, что симметрия ННК нарушается наличием цилиндрической области инверсии. В частности, было выяснено отклонение ожидаемой гексагональной симметрии внутренней оболочки (In, Ga) N, которое могло быть разрешено только с помощью электронной томографии. Кроме того, были проанализированы различия в толщине оболочки (In, Ga) N и включение индия в различные грани. Кроме того, была подробно охарактеризована морфология структуры ДИВ (In, Ga) N. Было обнаружено, что точка огранена и содержит значительно более высокое содержание индия по сравнению с оболочкой. Дополнительная карта EDX использовалась для подтверждения интенсивности вокселей томограммы, на которую повлияли, например, дефекты упаковки, образующиеся на самом северо-западном конце, которые могут быть вызваны низкотемпературным ростом внешней оболочки GaN.
Томографический анализ дает полную картину сложной структуры ядро-оболочка исследуемой ННК. Сердечник из GaN имеет гексагональную форму, включая пирамидальный острие с небольшими отклонениями из-за влияния области инверсии, а оболочка (In, Ga) N однозначно повторяет форму сердечника. Неожиданно внешняя оболочка GaN не воспроизводит форму внутренней оболочки (In, Ga) N и ядра GaN; вместо этого он преобразуется в ожидаемую форму на основе гексагональной симметрии. Результаты показывают, что электронная томография позволяет понять эволюцию формирования структуры ядро-оболочка во время роста.
Дальнейшие исследования в этой области указывают на проблему стабильности сплава и потенциальных флуктуаций сплава в нанометровом масштабе и их пространственного распределения, поскольку они сильно влияют на характеристики излучения и оптические свойства. Поэтому наша попытка может заключаться в улучшении пространственного разрешения и химической чувствительности нашей трехмерной реконструкции структуры (In, Ga) N DIW, чтобы иметь возможность обнаруживать неоднородности и нанокластеры сплава индия.
Доступность данных и материалов
Наборы данных, использованные и проанализированные в ходе текущего исследования, доступны у соответствующего автора по разумному запросу.
Сокращения
- (S) ТЕМ:
-
(Сканирующий) просвечивающий электронный микроскоп
- BF:
-
Светлое поле
- DIW:
-
Точка в проводе
- EDX:
-
Энергодисперсионный рентгеновский снимок
- FIB:
-
Сфокусированный ионный пучок
- HAADF:
-
Кольцевое темное поле с большим углом
- Идентификатор:
-
Домен инверсии
- MBE:
-
Молекулярно-лучевая эпитаксия
- NW:
-
Нанопроволока
- PAMBE:
-
Плазменный MBE
- QD:
-
Квантовая точка
- SAD:
-
Дифракция в выбранной области
- SAG:
-
Селективный рост площади
- SEM:
-
Сканирующая электронная микроскопия
- SF:
-
Неисправности штабелирования
- ZA:
-
Zone axis
Наноматериалы
- Электронные трубки
- Введение в электронные лампы
- Материаловеды учат нанопроволоки "танцевать"
- Маскировка наноструктурированных электронов
- Дизайн эмиссионного слоя для электронных умножителей
- Исследование поляризации поверхности гетероструктуры GaN / AlGaN / GaN, закрытой Al2O3, методом рентгеновской фотоэле…
- Аморфные кремниевые нанопроволоки, выращенные на пленке оксида кремния путем отжига
- Нацеливание на эндотелиальные клетки с помощью многофункциональных наночастиц GaN / Fe
- Теоретическое исследование двухосно-деформированных германиевых нанопроволок
- Температурная зависимость спин-расщепленных пиков при поперечной фокусировке электронов



