Ge N-канальные МОП-транзисторы с диэлектриком ZrO2 для повышения мобильности
Аннотация
Высокомобильные Ge nMOSFET с ZrO 2 диэлектрик затвора демонстрируется и сравнивается с транзисторами с различными межфазными свойствами озона (O 3 ) лечение, O 3 после обработки и без O 3 лечение. Обнаружено, что при O 3 обработки, Ge nMOSFET с ZrO 2 диэлектрика, имеющего EOT 0,83 нм, получить максимальную эффективную подвижность электронов ( μ eff ) 682 см 2 / Vs, что выше, чем у универсальной подвижности Si при средней плотности заряда инверсии ( Q inv ). С другой стороны, O 3 постобработка Al 2 О 3 межфазный слой может обеспечить значительно улучшенное - μ eff , достигая около 50% μ eff улучшение по сравнению с универсальной мобильностью Si при среднем Q inv из 5 × 10 12 см −2 . Эти результаты указывают на потенциальное использование ZrO 2 диэлектрик в высокопроизводительных полевых МОП-транзисторах на основе Ge.
Фон
GERMANIUM (Ge) продемонстрировал преимущества более высокой подвижности носителей и более низкой температуры обработки по сравнению с Si-устройствами. Это делает Ge альтернативой для приложений сверхмасштабируемых логических устройств КМОП и тонкопленочных транзисторов (TFT) в качестве верхнего слоя в трехмерных интегральных схемах [1,2,3]. В последние несколько лет большие усилия были сосредоточены на пассивации поверхности, диэлектрике затвора и разработке каналов для полевых транзисторов металл-оксид-полупроводник (MOSFET) с р-каналом Ge p-типа, что способствовало значительному улучшению электрических характеристик р-канальные устройства.
Но для Ge n-канальных MOSFET низкая эффективная подвижность несущей ( μ eff ), вызванный плохим межфазным слоем стека затворов, сильно ограничивает производительность устройств. Различные методы пассивации поверхности, включая пассивацию Si [1], постокисление в плазме [4] и пассивацию InAlP [5], а также несколько диэлектриков с высоким κ, включая HfO 2 , ZrO 2 [6,7,8], Y 2 О 3 [9], и La 2 О 3 [10] были исследованы в Ge nMOSFET для усиления электронов μ eff . Было продемонстрировано, что ZrO 2 диэлектрик, интегрированный с каналом Ge, может обеспечить надежный интерфейс благодаря тому, что GeO 2 межфазный слой может реагировать и смешиваться с ZrO 2 слой [7]. Приличная дыра μ eff сообщалось о Ge p-канальных транзисторах [6,7,8], в то время как в электронных μ еще есть много возможностей для улучшения. eff для своих аналогов.
В этой работе Ge nMOSFET с ZrO 2 диэлектрик затвора изготовлен для достижения улучшенного μ eff над Si во всем диапазоне плотностей инверсионного заряда ( Q inv ). Транзисторы Ge обеспечивают улучшение электронного μ на 50%. eff по сравнению с универсальной мобильностью Si при среднем Q inv из 5,0 × 10 12 см −2 .
Экспериментальный
Основные этапы процесса изготовления Ge nMOSFET на 4-дюймовых пластинах p-Ge (001) с удельным сопротивлением 0,136–0,182 Ом · см показаны на рис. 1a. Области истока / стока (S / D) были имплантированы ионом фосфора в дозе 1 × 10 15 см −2 и энергия 30 кэВ с последующим активационным отжигом легирующей примеси при 600 ° C. После предварительной очистки затвора пластины Ge загружали в камеру осаждения атомных слоев для формирования диэлектрического слоя (слоев) затвора:Al 2 О 3 / O 3 окисление / ZrO 2 , ZrO 2 , или O 3 окисление / ZrO 2 для пластин A, B или C соответственно. Для пластины A, 0,9 нм Al 2 О 3 использовался для защиты поверхности канала в течение O 3 окисление. О 3 окисление проводилось при 300 ° C в течение 15 мин для обеих пластин A и C. Для всех пластин толщина ZrO 2 составляла ~ 3,3 нм. Впоследствии металлический затвор TiN (100 нм) был осажден посредством физического реактивного распыления, и для формирования электрода затвора использовались литографические рисунки и реактивное ионное травление. После этого в S / D областях наносился слой Ni толщиной 25 нм. Наконец, был проведен отжиг после металлизации (PMA) при 350 ° C в течение 30 с для образования германида Ni и улучшения качества поверхности раздела. Схематические и микроскопические изображения изготовленного транзистора показаны на рис. 1b, c соответственно.
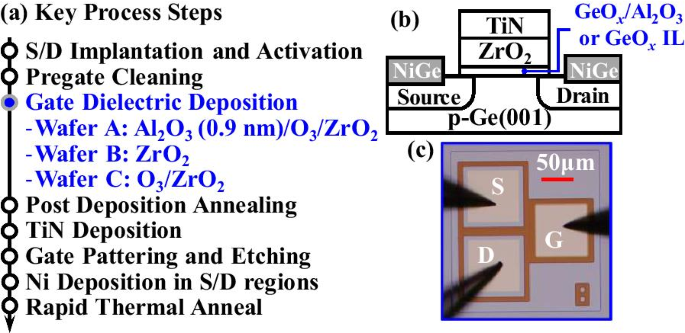
а Основные этапы процесса изготовления Ge nMOSFET. б Схема в разрезе и c изображение изготовленных устройств под микроскопом
На рис. 2а, б показаны изображения стопок затворов на пластинах A и B, полученные с помощью просвечивающего электронного микроскопа (HRTEM), соответственно. Единая толщина Al 2 О 3 / GeO x межфазный слой (IL) для пластины A составляет ~ 1,2 нм, что указывает на 0,2–0,3 нм GeO x . Для устройства на пластине B ультратонкий GeO x ИЛ была продемонстрирована экспериментально [7].
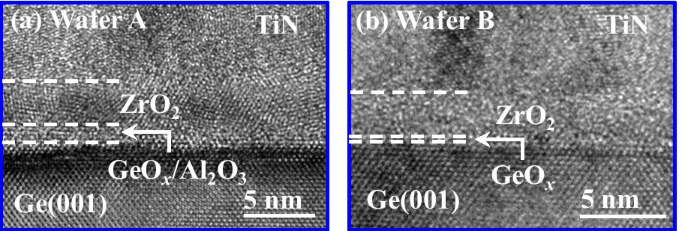
HRTEM изображения a TiN // ZrO 2 / Al 2 О 3 / GeO x / Ge, b TiN / ZrO 2 / GeO x / Ge стеки для устройств на пластинах A и B соответственно
Результаты и обсуждение
Измеренная емкость ( C ) и ток утечки ( Дж ) характеристики для Ge МОП-конденсаторов на пластинах A, B и C измерены и показаны на рис. 3a, b соответственно. Эквивалентная толщина оксида (EOT) устройств на пластинах A, B и C составляет 1,79, 0,59 и 0,83 нм соответственно. Предполагая, что GeO x IL обеспечивает дополнительный EOT ~ 0,25 нм для пластин A и C, сравнивая пластины B и C, 3,3 нм ZrO 2 вносит EOT ~ 0,6 нм со значением κ ~ 21,8, что согласуется с предыдущим сообщенным значением аморфного ZrO 2 [11]. Эти полученные результаты также подтверждают, что толщина GeO x IL на пластине B незначительно.

а Измерено C как функция напряжения В характеристики для конденсаторов Ge pMOS на пластинах A, B и C. b Дж по сравнению с V кривые для устройств. c Бенчмаркинг J (извлечено в V FB ± 1 В) конденсаторов Ge MOS в этой работе по сравнению с данными, полученными для аналогичных условий смещения из литературы
Гео x / Al 2 О 3 IL для пластины A и GeO x IL для пластины C дает EOT ~ 1,2 и ~ 0,25 нм соответственно. EOT устройств может быть дополнительно уменьшен за счет уменьшения толщины IL или улучшения качества интерфейса, а также увеличения диэлектрической проницаемости ZrO 2 с некоторой пассивацией поверхности, например, NH 3 / H 2 плазменная обработка [6]. На рис. 3c сравнивается J в сравнении с характеристиками EOT для Ge nMOSFET в этой работе со значениями для других опубликованных Ge устройств [5, 12, 13, 14, 15, 16, 17]. Также наблюдается, что результаты согласуются с заявленными Ge MOS с ультратонким EOT, следуя тем же тенденциям, указывая на то, что разница в токе утечки, показанная на рис. 3b, в основном объясняется разницей EOT.
На рисунке 4a показан измеренный ток стока ( I D ) и ток источника ( I S ) от напряжения затвора ( В G ) кривые Ge nMOSFET из пластин A, B и C. Все транзисторы имеют длину затвора L G 4 мкм и шириной затвора W 100 мкм. Точка подпорогового колебания (SS), определяемая как d V G / d (журнал I D ), как функция от I D Кривые для транзисторов на рис. 4а рассчитаны и показаны на рис. 4б. Уточняется, что транзистор на пластине A демонстрирует ухудшенный I D пол утечки и SS по сравнению с устройствами на пластинах B и C. Помимо увеличения EOT в устройствах на пластине A, это приведет к увеличению SS, это явление следует частично отнести к тому факту, что устройство с Al 2 О 3 вставленный слой имеет более высокую плотность ловушек интерфейса ( D это ) в запрещенной зоне канала Ge по сравнению с пластинами B и C.
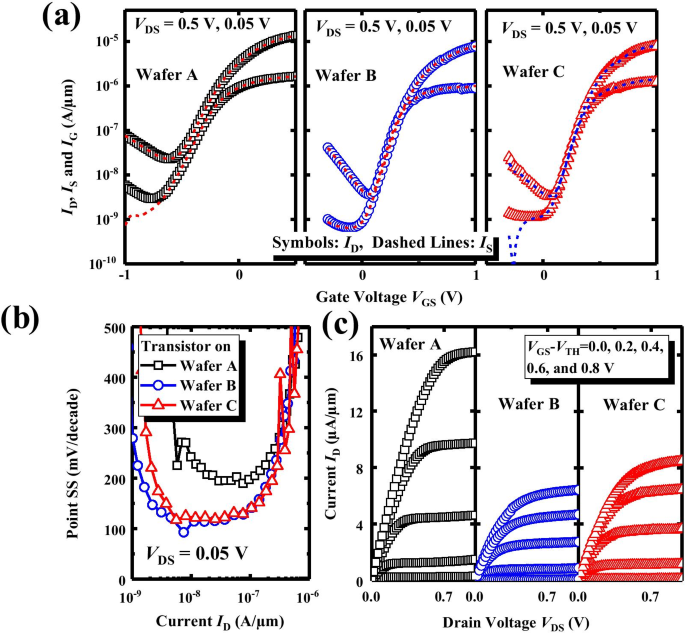
а Измерено I D и я S по сравнению с V GS кривые Ge nMOSFET на пластинах A, B и C. b Точка SS как функция от I D для транзисторов. c Я D - V D характеристики показывают, что Ge nMOSFET на пластине A имеет более высокий ток возбуждения по сравнению с устройствами на пластинах B и C
На рисунке 4c показаны измеренные выходные характеристики, т. Е. I D - V D кривые для различных значений перегрузки гейта | V G - V TH | устройств, демонстрирующих, что транзистор Ge на пластине A обеспечивает значительно улучшенный ток возбуждения по сравнению с устройствами на пластинах B и C. Здесь V TH определяется как V GS соответствующий I D из 10 −7 А / мкм. Учитывая идентичные условия формирования S / D, усиленный I DS для транзисторов на пластине A указывает более высокое значение μ eff [18,19,20,21]. Аль 2 О 3 слой не привел к деградации D это производительность вблизи зоны проводимости канала Ge.
На рисунке 5а показано полное сопротивление R малыш как функция от L G для Ge nMOSFET с ZrO 2 диэлектрик с L G от 2 до 10 мкм. Значения R малыш извлекаются при овердрайве затвора 0,6 В и V D 0,05 В. Сопротивление S / D R SD транзисторов получается ~ 13,5 кОм мкм, используя подогнанные линии, пересекающиеся в точке y -ось. Аналогичный R SD согласуется с идентичным процессом формирования PMA и S / D. Сопротивление канала R CH значения устройств получаются по наклону подобранных линий, то есть Δ R малыш / Δ L G , который можно использовать для вычисления μ eff характеристики Ge nMOSFET. Чтобы оценить качество интерфейса, используйте значения плотности прерывания интерфейса ( D это ) были извлечены по следующему уравнению по методу Хилла [17]:
$$ D _ {{{\ text {it}}}} =\ frac {{2G _ {{{\ text {m}} \ max}} / \ omega}} {{qA \ left [{\ left ({\ frac {{G _ {{{\ text {mmax}}}}}} {{\ omega C _ {{{\ text {ox}}}}}}} \ right) + \ left ({1 - C _ {{\ текст {m}}} / C _ {{{\ text {ox}}}}} \ right) ^ {2}} \ right]}} $$где q электронный заряд, А - площадь конденсатора, Г м, не более - максимальное значение измеренной проводимости с соответствующей ей емкостью C м , ω - угловая частота, а C бык - емкость оксида затвора. D это расчетные значения составляют 3,7, 3,2 и 2,3 × 10 12 эВ −1 см −2 для устройств на пластинах A, B и C соответственно.
Известно, что рассчитанные значения соответствуют середине промежутка D это . Устройство с Al 2 О 3 IL на пластине A имеет более высокий средний зазор D это по сравнению с устройствами на пластинах B и C. Это согласуется с результатами на рис. 3a и 4a, и более высокий средний промежуток D это вызывает большую дисперсию обедненной емкости в пластине A, вызывая более высокий ток утечки I DS по сравнению с двумя другими пластинами. Обратите внимание, что пластина A должна иметь нижний элемент D . это вблизи запрещенной зоны проводимости из-за ее более высокого μ eff поверх пластин B и C.
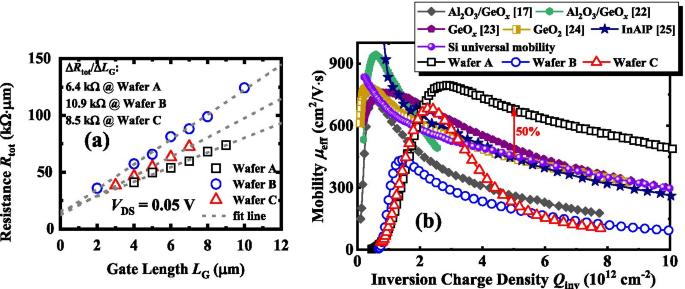
а R малыш по сравнению с L G кривые для Ge nMOSFET на пластинах A, B и C. Подгоняемая линия, пересекающаяся по оси y, и наклон линейных подгоночных линий используются для извлечения R SD и R CH , соответственно. б μ eff для Ge nMOSFET в этой работе по сравнению с ранее опубликованными результатами для ненапряженных Ge-транзисторов. Устройства на пластине A показывают улучшенный μ eff чем универсальная мобильность Si во всем диапазоне Q inv
Хорошо известно, что μ eff является узким местом для высокого тока возбуждения и крутизны в Ge nMOSFET. Здесь μ eff можно рассчитать как \ (\ mu _ {{{\ text {eff}}}} =1 / [WQ _ {{{\ text {inv}}}} (\ Delta R _ {{{\ text {tot}}}}} / \ Delta L _ {{\ text {G}}})] \), где Δ R малыш / Δ L G наклон R малыш по сравнению с L G как показано на рис. 5а. Q inv можно получить, интегрировав измеренные C inv - V G кривые. На рис. 5b мы сравниваем μ eff против Q inv полевых МОП-транзисторов Ge на пластинах A, B и C с описанными ранее в [18, 22,23,24,25]. Извлеченный пик μ eff Значения транзисторов на пластинах A и C составляют 795 и 682 см 2 / V s соответственно, а у Ge nMOSFET на пластине B - 433 см 2 /Против. Ge nMOSFET с Al 2 О 3 IL значительно улучшает μ eff по сравнению с транзисторами на пластине B или C, устройствами в [18, 22,23,24,25] в сильном поле и универсальной мобильностью Si во всем Q inv диапазон. На вопрос inv из 5 × 10 12 см −2 , 50% μ eff улучшение достигается в устройствах на пластине A по сравнению с универсальной мобильностью Si. Это демонстрирует, что, защищая поверхность канала от перемешивания ZrO 2 и GeO x используя Al 2 О 3 , высококачественный интерфейс между изолятором затвора и Ge реализован для повышения характеристик подвижности, о чем также сообщалось в предыдущих исследованиях полевых МОП-транзисторов на основе Ge с ультратонким EOT [26]. μ eff в транзисторах на пластине C выше, чем в универсальных Si на Q inv из 2,5 × 10 12 см −2 , хотя он быстро затухает с увеличением Q inv диапазон. Это означает, что использованный O 3 окисление перед ZrO 2 осаждение в некоторой степени улучшит качество поверхности раздела; однако это не приводит к достаточно плоской поверхности канала, чтобы эффективно подавить рассеяние шероховатости поверхности носителя при высоких Q inv из-за смешивания ZrO 2 и GeO x , поскольку сообщается, что образование кислородных вакансий во время перемешивания приведет к увеличению шероховатости ближнего порядка (SRO) [27]. Оптимизация O 3 процесс окисления или восстановления Al 2 О 3 Толщина IL может заставить транзистор Ge достичь пониженного EOT при сохранении более высокого μ eff на высоком Q inv .
Выводы
Исследовано влияние диэлектрической структуры и морфологии затвора на электрические характеристики Ge nMOSFET. Ан Аль 2 О 3 / ZrO 2 диэлектрик затвора обеспечивает значительно улучшенные μ eff по сравнению с универсальной мобильностью Si. μ eff можно улучшить, вставив Al 2 О 3 слой между ZrO 2 и канал Ge, что, однако, неизбежно приводит к увеличению EOT. Аль 2 О 3 -бесплатные Ge nMOSFET с O 3 окисление поверхности Ge до ZrO 2 осаждение достичь пика μ eff 682 см 2 / V s, что выше, чем у Si при аналогичном Q inv .
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью.
Сокращения
- Ge:
-
Германий
- ZrO 2 :
-
Диоксид циркония
- Al 2 О 3 :
-
Оксид алюминия
- O 3 :
-
Озон
- Si:
-
Кремний
- PMA:
-
Пост-металлический отжиг
- КПК:
-
Отжиг после осаждения
- IL:
-
Межфазный слой
- TiN:
-
Нитрид титана
- МОП-транзисторы:
-
Полевые транзисторы металл – оксид – полупроводник
- ALD:
-
Осаждение атомного слоя
- HF:
-
Плавиковая кислота
- µ eff :
-
Эффективная мобильность оператора связи
- PPO:
-
Постокисление плазмы
- SS:
-
Подпороговое колебание
- CET:
-
Толщина, эквивалентная емкости
- EOT:
-
Эквивалентная толщина оксида
- Qinv:
-
Плотность инверсионного заряда
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- Ни:
-
Никель
- GeO x :
-
Оксид германия
- I DS :
-
Слить ток
- V GS :
-
Напряжение затвора
- V TH :
-
Пороговое напряжение
Наноматериалы
- Достижение устойчивости с помощью красителей и пигментов
- KUHMUTE изменяет мобильность с помощью 3D-печати SLS
- Полный контроль терагерцовой поляризации с расширенной полосой пропускания через диэлектрические метапове…
- Резистивная память ZrO2 / ZrO2 - x / ZrO2 без соблюдения нормативных требований с управляемым межфазным режимом перек…
- Механизм проводимости и повышение выносливости в RRAM на основе HfO2 с лечением нитридом
- Повышение диэлектрической проницаемости MIM-конденсаторов Al2O3 / ZrO2 / Al2O3 с атомным слоем за счет микроволнового…
- Ge pMOSFET с высокой подвижностью и пассивированием аморфным Si:влияние ориентации поверхности
- 6 способов улучшить Protocase Designer в версии 4.6
- Достижение феноменальной отделки с помощью металлизации
- Улучшенная износостойкость с медными вольфрамовыми электродами



