Конструкция проводящего слоя AZO на микроканальной пластине
Аннотация
Когда удельное сопротивление проводящего слоя AZO находится в пределах требований к сопротивлению MCP, интервал содержания Zn очень узкий (70–73%) и его трудно контролировать. Ориентируясь на характеристики проводящего слоя AZO на микроканальной пластине, разработан алгоритм для регулировки соотношения проводящего материала ZnO и высокоомного материала Al2O3. Мы выдвигаем понятие рабочего сопротивления МКП (т. Е. Сопротивления во время лавины электронов в микроканале). Рабочее сопротивление AZO-ALD-MCP (микроканальная пластина для осаждения атомного слоя Al2O3 / ZnO) было впервые измерено с помощью системы тестирования сопротивления MCP. По сравнению с обычным MCP, мы обнаружили, что сопротивление AZO-ALD-MCP в рабочем и нерабочем состояниях сильно различается, и по мере увеличения напряжения рабочее сопротивление значительно уменьшается. Поэтому мы предложили набор аналитических методов для проводящего слоя. Мы также предложили отрегулировать соотношение проводящего материала проводящего слоя ALD-MCP к материалу с высоким сопротивлением в условиях рабочего сопротивления и успешно подготовили AZO-ALD-MCP с высоким коэффициентом усиления. Эта конструкция открывает путь к поиску лучших материалов для проводящего слоя ALD-MCP для улучшения характеристик MCP.
Введение
Микроканальная пластина (MCP) представляет собой электронный умножитель, состоящий из двумерных массивов пор путем интеграции формы тонкой стеклянной пластины, длиной 0,5–5 мм, диаметром 4–40 мкм и с углом смещения обычно 5–13 ° к нормали. поверхности пластины; коэффициент открытой площади пластины составляет до 60%, а высокое отношение длины к диаметру в каждой поре составляет примерно от 20:1 до 100:1 [1].
Как показано на рис. 1, падающие электроны, попадающие в микроканал, сталкиваются со стенками, вызывая генерацию вторичных электронов на поверхности стенок микроканала. Множественные столкновения со стенками микроканала приведут к увеличению количества вторичных электронов, что приведет к электронной лавине внутри микроканала и испусканию облака электронов на выходе микроканала. Электроны вторичных электронов будут дополнительно ускоряться по микроканалу под действием напряжения смещения. Прирост MCP составляет 10 3 –10 4 при рабочем напряжении 700–900 В [2,3,4,5,6,7,8,9].
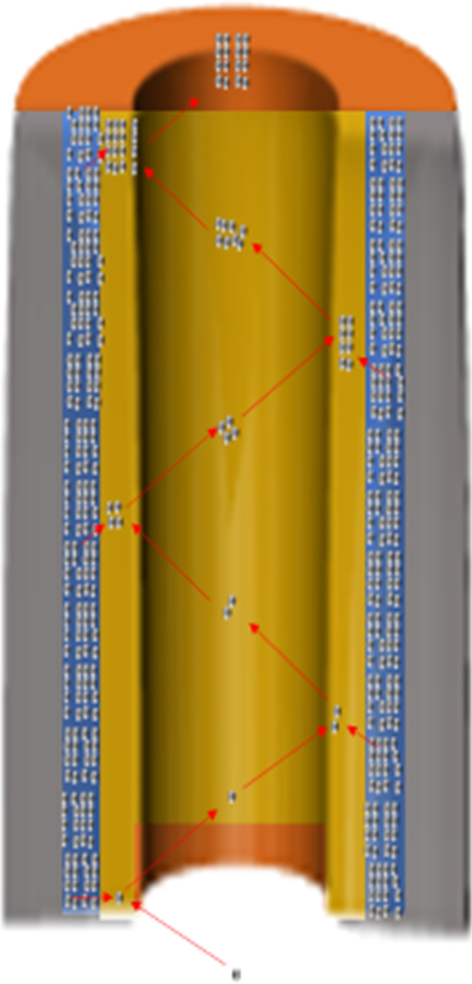
Диаграмма рабочего состояния МКП
Каждый микроканал выполняет функцию детектора и электронного умножителя. Благодаря тому, что миллионы микроканалов работают независимо, MCP обладает такими характеристиками, как высокое пространственное разрешение, высокое временное разрешение и широкий диапазон усиления, используемый для идентификации фотонов, электронов, нейтронов и ионов. MCP может интегрироваться в различные виды инструментов, включая фотоэлектрический детектор, фотоэлектронные умножители (ФЭУ), ультрафиолетовый спектрометр, электронно-лучевую трубку, сканирующий электронный микроскоп, автоэмиссионные дисплеи, анализатор остаточных газов, медицинскую визуализацию, времяпролетную масс-спектрометрию, ночную -зеркальные очки и др. [1, 4, 7,8,9]. Обжиг водорода в традиционном процессе делает микроканал подходящим по проводимости и коэффициенту вторичной электронной эмиссии.
Обычный процесс сжигания водорода при изготовлении микроканала имеет множество недостатков:во-первых, процесс сжигания водорода не может независимо регулировать проводящий слой и эмиссионный слой [10, 11]; во-вторых, элементы тяжелых металлов (Pb, Bi) приводят к загрязнению окружающей среды в процессе плавки свинцового стекла; в-третьих, большие площади МКП будут деформированы из-за высокой температуры [8]; в-четвертых, используемое свинцовое стекло в реакции восстановления водородом содержит K, Rb и другие радиоактивные элементы, которые создают фоновый шум [8]; наконец, водород, который остается в порах, становится ионами из-за напряжения смещения, и они летят в направлении, противоположном электрону, разрушая катод прибора [8, 12].
Ранние ученые предложили решение по выращиванию проводящего слоя и эмиссионного слоя на стенке микроканала, чтобы заменить процесс сжигания водорода [3]. Многие методы осаждения тонких пленок не позволяют вырастить однородную пленку в микроканале с высоким отношением длины к диаметру. Национальная лаборатория Аргонны предложила использовать осаждение атомных слоев (ALD) для выращивания проводящего слоя и эмиссионного слоя на МКП для получения неповрежденной и однородной пленки на стенках микроканалов [4, 13]. Кроме того, ALD-MCP устраняет вышеупомянутые недостатки. Многие исследовательские институты стремятся найти конкурентоспособные материалы, которые могут улучшить работу MCP.
Аргоннская национальная лаборатория выбирает материалы AZO для проводящего слоя ALD-MCP с учетом требований к сопротивлению MCP. Если сопротивление слишком велико, проводящий слой не может вовремя и непрерывно пополнять электроны в эмиссионном слое, МКП будет иметь низкий коэффициент усиления или даже не сможет работать. С другой стороны, если сопротивление слишком низкое, МКП перегреется, что в конечном итоге приведет к выходу из строя [4, 9, 14, 15]. Следовательно, конструкция проводящего слоя важна для ALD-MCP.
Как показано на рис. 2, когда удельное сопротивление проводящего слоя AZO находится в пределах требований к сопротивлению МКП, допустимое содержание Zn находится в очень узком диапазоне (70–73%) [16]. Следовательно, усиление MCP нестабильно, и MCP может легко выйти из строя. Альтернативные проводящие материалы, такие как W и Mo вместо Zn, были изучены [3, 4, 17,18,19]. Реакция взаимодействия \ ({\ text {WF}} _ {6} \) (\ ({\ text {MoF}} _ {6} \)) и \ ({\ text {H}} _ {2} {\ text {O}} \) используется для увеличения W (Mo) с помощью ALD. Однако использование \ ({\ text {WF}} _ {6} \) или \ ({\ text {MoF}} _ {6} \) имеет два серьезных недостатка:они очень агрессивны и содержат примеси, которые могут быть трудно удалить в процессе производства. По этим причинам ALD-MCP с этими материалами стоит дорого.

Содержание Zn, Zn / (Zn + A) * 100 (%), синяя область - область сопротивления MCP, зеленая область - область изменения AZO, красные области - область, требующая контроля
В нашем исследовании мы обнаружили, что разумные конструкции с ZnO и \ ({\ text {Al}} _ {2} {\ text {O}} _ {3} \) могут быть реализованы для проводящего слоя MCP без проблем. сталкивается, если используется W или Mo, и является более конкурентоспособным по цене. Здесь мы называем ALD-MCP с проводящим слоем AZO как AZO-ALD-MCP.
Мы предлагаем алгоритм регулировки соотношения проводящего материала ZnO и высокоомного материала \ ({\ text {Al}} _ {2} {\ text {O}} _ {3} \) для получения желаемых характеристик проводящего слоя AZO.
Мы выдвигаем понятие рабочего сопротивления МКП (т. Е. Сопротивления во время лавины электронов в микроканале). Мы проверили рабочее сопротивление AZO-ALD-MCP и обнаружили два различия между AZO-ALD-MCP и обычными MCP. Мы заметили, что рабочие и нерабочие сопротивления как AZO-ALD-MCP, так и обычных MCP значительно различаются. Кроме того, сопротивление AZO-ALD-MLP отрицательно коррелирует с напряжением. Наше предложение (ссылка на рабочее сопротивление) по регулировке соотношения проводящего материала и материала с высоким сопротивлением представляет собой руководство, которое поможет нам в поиске новых материалов, которые будут использоваться для проводящего слоя ALD-MCP для улучшения характеристик MCP в будущем.
Экспериментальные элементы и методы
Рост ZnO и \ ({\ text {Al}} _ {2} {\ text {O}} _ {3} \) атомная пленка
Осаждение атомного слоя (ALD) - это технология, при которой прекурсоры и химически активные газы чередуются на поверхности подложки для физической или химической адсорбции или реакции поверхностного насыщения с контролируемой скоростью. Материал нанесен на подложку в виде моноатомной поверхности пленки. ALD может производить непрерывную пленку без точечных отверстий, с отличным покрытием и может контролировать толщину и состав атомарной пленки [1, 2, 4, 11, 13, 19, 20].
Ниже приведены уравнения химической реакции использования ALD для выращивания Al 2 . О 3 :
$$ \ begin {align} &{\ text {A}}:{\ text {Substrate}} - {\ text {OH}} ^ {*} + {\ text {Al}} \ left ({{\ text {CH}} _ {3}} \ right) _ {3} \\ &\ quad \ to {\ text {Substrate}} - {\ text {O}} - {\ text {Al}} \ left ({ {\ text {CH}} _ {3}} \ right) _ {2} ^ {*} + {\ text {CH}} _ {4} \ uparrow \\ &{\ text {B}}:{\ text {Substrate}} - {\ text {O}} - {\ text {Al}} \ left ({{\ text {CH}} _ {3}} \ right) _ {2} ^ {*} + 2 {\ text {H}} _ {2} {\ text {O}} \\ &\ quad \ to {\ text {Substrate}} - {\ text {O}} - {\ text {Al}} \ left ({{\ text {OH}}} \ right) _ {2} ^ {*} + 2 {\ text {CH}} _ {4} \ uparrow \\ &{\ text {C}}:{\ text {Al}} - {\ text {OH}} ^ {*} + {\ text {Al}} \ left ({{\ text {CH}} _ {3}} \ right) _ {3} \\ { } &\ quad \ to {\ text {Al}} - {\ text {O}} - {\ text {Al}} \ left ({{\ text {CH}} _ {3}} \ right) _ { 2} ^ {*} + {\ text {CH}} _ {4} \ uparrow \\ &{\ text {D}}:{\ text {Al}} - {\ text {CH}} _ {3} ^ {*} + {\ text {H}} _ {2} {\ text {O}} \ to {\ text {Al}} - {\ text {OH}} ^ {*} + 2 {\ text { CH}} _ {4} \ uparrow \\ \ end {align} $$Температура реакции 60–150 ° C. Как показано на рис. 3, время и порядок выращивания слоя Al 2 О 3 атом:
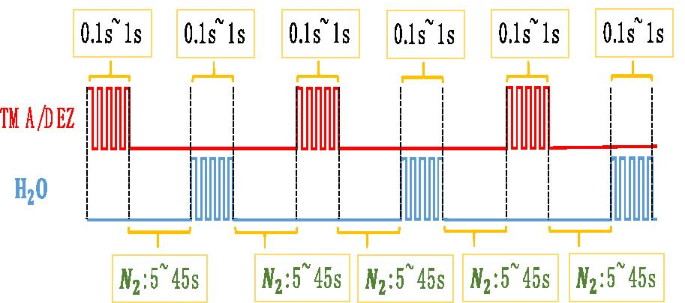
Выращивание Al 2 О 3 и диаграмма ZnO
\ ({\ text {TMA}} / {\ text {N}} _ {2} / {\ text {H}} _ {2} {\ text {O}} / {\ text {N}} _ { 2} =0,1 \ sim1 {\ text {s}} / 5 \ sim45 {\ text {s}} / 0,1 \ sim1 {\ text {s}} / 5 \ sim45 {\ text {s}} \).
Ниже приведены уравнения химической реакции для использования ALD для выращивания ZnO:
$$ \ begin {align} &{\ text {E}}:{\ text {Substrate}} - {\ text {OH}} ^ {*} + {\ text {Zn}} \ left ({{\ text {CH}} _ {2} {\ text {CH}} _ {3}} \ right) _ {2} \\ &\ quad \ to {\ text {Substrate}} - {\ text {O}} - {\ text {ZnCH}} _ {2} {\ text {CH}} _ {3} ^ {*} + {\ text {CH}} _ {3} {\ text {CH}} _ {3} \ вверх \\ &{\ text {F}}:{\ text {Substrate}} - {\ text {O}} - {\ text {ZnCH}} _ {2} {\ text {CH}} _ {3} ^ {*} + {\ text {H}} _ {2} {\ text {O}} \\ &\ quad \ to {\ text {Substrate}} - {\ text {O}} - {\ text { ZnOH}} ^ {*} + {\ text {CH}} _ {3} {\ text {CH}} _ {3} \ uparrow \\ &{\ text {G}}:{\ text {Zn}} - {\ text {OH}} ^ {*} + {\ text {Zn}} \ left ({{\ text {CH}} _ {2} {\ text {CH}} _ {3}} \ right) _ {2} \\ &\ quad \ to {\ text {Zn}} - {\ text {O}} - {\ text {ZnCH}} _ {2} {\ text {CH}} _ {3} ^ {*} + {\ text {CH}} _ {3} {\ text {CH}} _ {3} \ uparrow \\ &{\ text {H}}:{\ text {Zn}} - {\ text {CH}} _ {2} {\ text {CH}} _ {3} ^ {*} + {\ text {H}} _ {2} {\ text {O}} \ to {\ text {Zn} } - {\ text {OH}} ^ {*} + {\ text {CH}} _ {3} {\ text {CH}} _ {3} \ uparrow \\ \ end {align} $$Температура реакции 60–150 ° C. Как показано на рис. 3, время и порядок роста слоя атома ZnO следующие:
$$ {\ text {DEZ}} / {\ text {N}} _ {2} / {\ text {H}} _ {2} {\ text {O}} / {\ text {N}} _ { 2} =0,1 \ sim1 {\ text {s}} / 5 \ sim45 {\ text {s}} / 0,1 \ sim1 {\ text {s}} / 5 \ sim45 {\ text {s}} {.} $ $Дизайн проводящего слоя AZO
Толщина AZO обычно составляет от 300 до 1000 атомных слоев. Мы определяем новое математическое правило операции для расчета порядков атомных слоев Al2O3 и ZnO, чтобы регулировать соотношение проводящего материала ZnO и высокоомного материала Al2O3.
$$ \ left (\ begin {array} {* {20} c} {{\ text {mA}}} \\ {{\ text {mB}}} \\ \ vdots \\ \ end {array} \ right ) ={\ text {m}} \ left (\ begin {array} {* {20} c} {\ text {A}} \\ {\ text {B}} \\ \ vdots \\ \ end {массив } \ right) $$ (1) $$ \ begin {align} &{\ text {A}} \ left (\ begin {array} {* {20} c} {\ text {a}} \\ {\ текст {b}} \\ \ vdots \\ \ end {array} \ right) + {\ text {B}} \ left (\ begin {array} {* {20} c} {\ text {c}} \ \ {\ text {d}} \\ \ vdots \\ \ end {array} \ right) + {\ text {C}} \ left (\ begin {array} {* {20} c} {\ text {e }} \\ {\ text {f}} \\ \ vdots \\ \ end {array} \ right) \ ldots \\ &\ quad =\ left (\ begin {array} {* {20} c} {\ текст {A}} \\ {\ text {B}} \\ \ vdots \\ \ end {array} \ right) \ left [\ left (\ begin {array} {* {20} c} {\ text { a}} \\ {\ text {b}} \\ \ vdots \\ \ end {array} \ right) \ left (\ begin {array} {* {20} c} {\ text {c}} \\ {\ text {d}} \\ \ vdots \\ \ end {array} \ right) \ left (\ begin {array} {* {20} c} {\ text {e}} \\ {\ text {f }} \\ \ vdots \\ \ end {array} \ right) \ ldots \ right] =\ left (\ begin {array} {* {20} c} {{\ text {Aa}} + {\ text { Bc}} + {\ text {Ce}} + \ ldots} \\ {{\ text {Ab}} + {\ text {Bd}} + {\ text {Cf}} + \ ldots} \\ \ vdots \\ \ end {array} \ right) \\ \ end {align} $$ (2)Математическая операция получила название WYM-операции. Операция WYM имеет два свойства и формулу.
Свойство WYM 1:
$$ \ begin {align} &\ left ({\ begin {array} {* {20} c} {\ text {m}} \\ {\ text {n}} \\ \ end {array}} \ right ) \ left [{\ left ({\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {b}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {c}} \\ {\ text {d}} \\ \ end {array}} \ right)} \ right] \ left [{\ left ({\ begin {array} {* {20} c} {\ text {e}} \\ {\ text {f}} \\ \ end {array}} \ right) \ left ({\ begin {array } {* {20} c} {\ text {g}} \\ {\ text {h}} \\ \ end {array}} \ right)} \ right] \ left [{\ left ({\ begin { массив} {* {20} c} {\ text {i}} \\ {\ text {j}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {k}} \\ {\ text {l}} \\ \ end {array}} \ right)} \ right] \ ldots \\ &\ quad =\ left ({\ begin {array} {* {20} c} {\ text {m}} \\ {\ text {n}} \\ \ end {array}} \ right) \ left \ {{\ left ({\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {b}} \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c} {\ text {e}} \\ {\ text {f}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {g }} \\ {\ text {h}} \\ \ end {array}} \ right)} \ right], \ left ({\ begin в {массив} {* {20} c} {\ text {c}} \\ {\ text {d}} \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array } {* {20} c} {\ text {e}} \\ {\ text {f}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c } {\ text {g}} \\ {\ text {h}} \\ \ end {array}} \ right)} \ right]} \ right \} \ left [{\ left ({\ begin {array} {* {20} c} {\ text {i}} \\ {\ text {j}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {k}} \\ {\ text {l}} \\ \ end {array}} \ right)} \ right] \ ldots \\ &\ quad =\ left ({\ begin {array} {* {20} c} {\ text {m}} \\ {\ text {n}} \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {b}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {c }} \\ {\ text {d}} \\ \ end {array}} \ right)} \ right] \ left \ {{\ left ({\ begin {array} {* {20} c} {\ text {e}} \\ {\ text {f}} \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c} {\ text {i}) } \\ {\ text {j}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {k}} \\ {\ text { l}} \\ \ end {array}} \ right)} \ right], \ left ({\ begin {array} {* {20} c} {\ te xt {g}} \\ {\ text {h}} \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c} {\ text {i }} \\ {\ text {j}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {k}} \\ {\ text {l}} \\ \ end {array}} \ right)} \ right]} \ right \} \ ldots \\ \ end {align} $$Свойство WYM 2:
$$ \ begin {align} &{\ text {A}} \ left ({\ begin {array} {* {20} c} {\ text {m}} \\ {\ text {n}} \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {b}} \\ \ end {массив }} \ right) \ left ({\ begin {array} {* {20} c} {\ text {c}} \\ {\ text {d}} \\ \ end {array}} \ right)} \ right] \ left [{\ left ({\ begin {array} {* {20} c} {\ text {e}} \\ {\ text {f}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {g}} \\ {\ text {h}} \\ \ end {array}} \ right)} \ right] \ ldots \\ &\ quad =\ left ({\ begin {array} {* {20} c} {{\ text {Am}}} \\ {{\ text {An}}} \\ \ end {array}} \ right ) \ left [{\ left ({\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {b}} \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {c}} \\ {\ text {d}} \\ \ end {array}} \ right)} \ right] \ left [{\ left ({\ begin {array} {* {20} c} {\ text {e}} \\ {\ text {f}} \\ \ end {array}} \ right) \ left ({\ begin {array } {* {20} c} {\ text {g}} \\ {\ text {h}} \\ \ end {array}} \ right)} \ right] \ ldots \\ &\ quad =\ left ( {\ begin {array} {* {20} c} {\ text {m}} \\ {\ text {n}} \\ \ end {a rray}} \ right) \ left [{{\ text {A}} \ left ({\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {b}} \ \ \ end {array}} \ right), {\ text {A}} \ left ({\ begin {array} {* {20} c} {\ text {c}} \\ {\ text {d}} \\ \ end {array}} \ right)} \ right] \ left [{\ left ({\ begin {array} {* {20} c} {\ text {e}} \\ {\ text {f}) } \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {g}} \\ {\ text {h}} \\ \ end {array }} \ right)} \ right] \ ldots \\ &\ quad =\ left ({\ begin {array} {* {20} c} {\ text {m}} \\ {\ text {n}} \ \ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {b}} \\ \ end {массив}} \ right) \ left ({\ begin {array} {* {20} c} {\ text {c}} \\ {\ text {d}} \\ \ end {array}} \ right) } \ right] \ left [{{\ text {A}} \ left ({\ begin {array} {* {20} c} {\ text {e}} \\ {\ text {f}} \\ \ end {array}} \ right), {\ text {A}} \ left ({\ begin {array} {* {20} c} {\ text {g}} \\ {\ text {h}} \\ \ end {array}} \ right)} \ right] \ ldots \\ \ end {align} $$Формула WYM:
$$ \ begin {align} &\ left (\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {b}} \\ \ vdots \\ \ end {array} \ right) =\ left (\ begin {array} {* {20} c} {{\ text {A}} + \ frac {{\ text {X}}} {{\ text {Y}}}} \ \ {\ text {b}} \\ \ vdots \\ \ end {array} \ right) \ propto {\ text {Y}} \ left (\ begin {array} {* {20} c} {{\ text {A}} + \ frac {{\ text {X}}} {{\ text {Y}}}} \\ {\ text {b}} \\ \ vdots \\ \ end {array} \ right) =\ left ({\ begin {array} {* {20} c} {{\ text {Y}} - {\ text {X}}} \\ {\ text {X}} \\ \ end {array}} \ right) \ left [\ left (\ begin {array} {* {20} c} {\ text {A}} \\ {\ text {b}} \\ \ vdots \\ \ end {array} \ right ) \ left (\ begin {array} {* {20} c} {{\ text {A}} + 1} \\ {\ text {b}} \\ \ vdots \\ \ end {array} \ right) \ right] \\ &\ left (\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {b}} \\ \ vdots \\ \ end {array} \ right ) =\ left (\ begin {array} {* {20} c} {\ text {a}} \\ {{\ text {B}} + \ frac {{\ text {X}}} {{\ text {Y}}}} \\ \ vdots \\ \ end {array} \ right) \ propto {\ text {Y}} \ left (\ begin {array} {* {20} c} {\ text {a} } \\ {{\ text {B}} + \ frac {{\ text {X}}} {{\ text {Y}}}} \\ \ vdots \\ \ end {array} \ right) =\ left ({\ begin {array} {* {20} c} {{\ text {Y}} - {\ text {X}}} \\ {\ text {X}} \\ \ end {array}} \ right) \ left [\ left (\ begin {array} {* {20} c} {\ text {a}} \\ {\ text {B}} \\ \ vdots \\ \ end {array} \ right ) \ left (\ begin {array} {* {20} c} {\ text {a}} \\ {{\ text {B}} + 1} \\ \ vdots \\ \ end {array} \ right) \ right] \\ \ end {выровнено} $$Обратите внимание, что строчные буквы представляют собой действительные числа, а прописные - целые числа. В примерах 1 и 2 мы показываем выполнение операции.
Пример 1
$$ \ left ({\ begin {array} {* {20} c} {{\ text {ZnO}}} \\ {{\ text {Al}} _ {2} {\ text {O}} _ { 3}} \\ \ end {array}} \ right) =\ left ({\ begin {array} {* {20} c} {4 + \ frac {1} {2}} \\ 1 \\ \ end {массив}} \ right) \ propto \ left ({\ begin {array} {* {20} c} 1 \\ 1 \\ \ end {array}} \ right) \ left [{\ left ({\ begin {массив} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} 5 \\ 1 \\ \ end { массив}} \ right)} \ right] =\ left ({\ begin {array} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) + \ left ({\ begin { массив} {* {20} c} 5 \\ 1 \\ \ end {array}} \ right) $$Операция интерпретируется как имеющая две схемы:\ (\ left ({\ begin {array} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) \) и \ (\ left ( {\ begin {array} {* {20} c} 5 \\ 1 \\ \ end {array}} \ right) \). Для первой схемы увеличьте в 4 раза атомный слой ZnO и один атомный слой Al2O3. Для второй схемы вырастите в 5 раз атомный слой ZnO и один атомный слой Al2O3. Если повторить эти две схемы дважды, мы получим структуру, показанную на рис. 4.
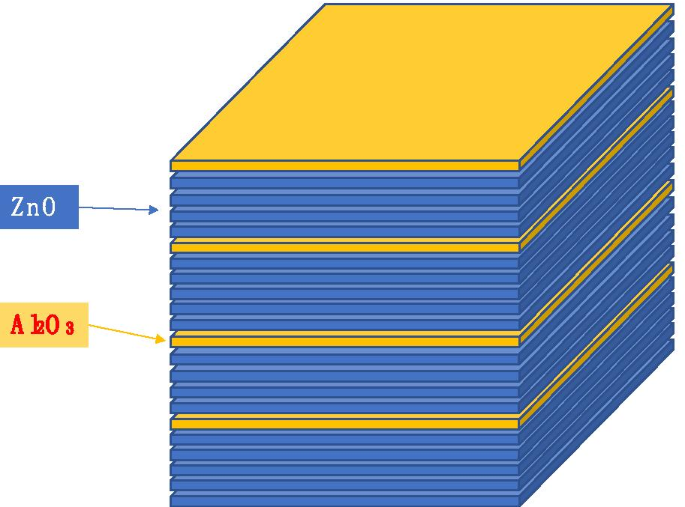
Принципиальная схема ZnO и Al 2 О 3 последовательность роста
Более сложное использование правил работы показано в примере 2, а именно:
$$ \ begin {align} &\ left ({\ begin {array} {* {20} c} {{\ text {ZnO}}} \\ {{\ text {Al}} _ {2} {\ text {O}} _ {3}} \\ \ end {array}} \ right) =\ left ({\ begin {array} {* {20} c} {4.71} \\ 1 \\ \ end {array} } \ right) =\ left ({\ begin {array} {* {20} c} {4 + 0.71} \\ 1 \\ \ end {array}} \ right) \\ &\ frac {2} {3 } =0,666 <0,71 <\ frac {3} {4} =0,75 \\ &\ left ({\ begin {array} {* {20} c} E \\ F \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c} {4 + \ frac {2} {3}} \\ 1 \\ \ end {array}} \ right) \ left ({ \ begin {array} {* {20} c} {4 + \ frac {3} {4}} \\ 1 \\ \ end {array}} \ right)} \ right] \\ &\ quad =E \ left ({\ begin {array} {* {20} c} {4 + \ frac {2} {3}} \\ 1 \\ \ end {array}} \ right) + F \ left ({\ begin { массив} {* {20} c} {4 + \ frac {3} {4}} \\ 1 \\ \ end {array}} \ right) =\ left ({\ begin {array} {* {20} c} {4E + 4F + \ frac {2} {3} E + \ frac {3} {4} F} \\ {E + F} \\ \ end {array}} \ right) \\ &\ quad =E + F \ left ({\ begin {array} {* {20} c} {4 + \ frac {{\ frac {2} {3} E + \ frac {3} {4} F}} {E + F}} \\ 1 \\ \ end {array}} \ right) \ propto \ left ({\ begin {array} {* {20} c} {4 + \ frac {{\ frac {2} {3} E + \ frac {3} {4} F}} {E + F}} \\ 1 \\ \ end {array}} \ right) =\ left ({\ begin {array} {* {20} c} {4.71} \\ 1 \\ \ end {array}} \ right) \\ &\ frac {{\ frac {2} { 3} E + \ frac {3} {4} F}} {E + F} =0,71 \ Rightarrow {\ text {E}} =12, {\ text {F}} =13 \\ &\ left ({ \ begin {array} {* {20} c} E \\ F \\ \ end {array}} \ right) =\ left ({\ begin {array} {* {20} c} {12} \\ { 13} \\ \ end {array}} \ right) =12 \ left ({\ begin {array} {* {20} c} 1 \\ {1 \ frac {1} {12}} \\ \ end { массив}} \ right) =\ left ({\ begin {array} {* {20} c} {11} \\ 1 \\ \ end {array}} \ right) \ left [{\ left ({\ begin {массив} {* {20} c} 1 \\ 1 \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} 1 \\ 2 \\ \ end { массив}} \ right)} \ right] \\ &\ left ({\ begin {array} {* {20} c} E \\ F \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c} {4 + \ frac {2} {3}} \\ 1 \\ \ end {array}} \ right), \ left ({\ begin {array} {* {20} c} {4 + \ frac {3} {4}} \\ 1 \\ \ end {array}} \ right)} \ right] \\ &\ quad =\ left ({\ begin { массив} {* {20} c} E \\ F \\ \ end {array}} \ right) \ left [{ \ left ({\ begin {array} {* {20} c} 1 \\ 2 \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c } 4 \\ 1 \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} 5 \\ 1 \\ \ end {array}} \ right)} \ right ], \ left ({\ begin {array} {* {20} c} 1 \\ 3 \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20 } c} 4 \\ 1 \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} 5 \\ 1 \\ \ end {array}} \ right)} \ right]} \ right] \\ &\ left ({\ begin {array} {* {20} c} {4.71} \\ 1 \\ \ end {array}} \ right) \ propto \ left ({\ begin {array} {* {20} c} {12} \\ {13} \\ \ end {array}} \ right) \ left [{\ left ({\ begin {array} {* {20} c}) 1 \\ 2 \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} 1 \\ 3 \\ \ end {array}} \ right)} \ right] \ left [{\ left ({\ begin {array} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c } 5 \\ 1 \\ \ end {array}} \ right)} \ right] =\ left ({\ begin {array} {* {20} c} {11} \\ 1 \\ \ end {array} } \ right) \ left [{\ left ({\ begin {array} {* {20} c} 1 \\ 1 \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} в } 1 \\ 2 \\ \ end {array}} \ right)} \ right] \ left [{\ left ({\ begin {array} {* {20} c} 1 \\ 2 \\ \ end {массив }} \ right) \ left ({\ begin {array} {* {20} c} 1 \\ 3 \\ \ end {array}} \ right)} \ right] \ left [{\ left ({\ begin {массив} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) \ left ({\ begin {array} {* {20} c} 5 \\ 1 \\ \ end { массив}} \ right)} \ right] \\ \ end {align} $$План 1 :\ (\ left ({\ begin {array} {* {20} c} {4.71} \\ 1 \\ \ end {array}} \ right) \ propto 12 \ left [{\ left ({\ begin { массив} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) + 2 \ left ({\ begin {array} {* {20} c} 5 \\ 1 \\ \ end {массив}} \ right)} \ right] + 13 \ left [{\ left ({\ begin {array} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) + 3 \ left ({\ begin {array} {* {20} c} 5 \\ 1 \\ \ end {array}} \ right)} \ right] \).
План 2 \ (\ left ({\ begin {array} {* {20} c} {4.71} \\ 1 \\ \ end {array}} \ right) \ propto 11 \ left [{\ left [{\ left ({ \ begin {array} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) + 2 \ left ({\ begin {array} {* {20} c} 5 \\ 1 \ \ \ end {array}} \ right)} \ right] + \ left [{\ left ({\ begin {array} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) + 3 \ left ({\ begin {array} {* {20} c} 5 \\ 1 \\ \ end {array}} \ right)} \ right]} \ right] + \ left [{\ left [{ \ left ({\ begin {array} {* {20} c} 4 \\ 1 \\ \ end {array}} \ right) + 2 \ left ({\ begin {array} {* {20} c} 5 \\ 1 \\ \ end {array}} \ right)} \ right] + 2 \ left [{\ left ({\ begin {array} {* {20} c} 4 \\ 1 \\ \ end {массив }} \ right) + 3 \ left ({\ begin {array} {* {20} c} 5 \\ 1 \\ \ end {array}} \ right)} \ right]} \ right] \).
В Примере 2 операцию из Плана 1 можно интерпретировать следующим образом:
Схема 1 ALD увеличивают в 4 раза процесс роста атомного слоя ZnO и один \ ({\ text {Al}} _ {2} {\ text {O}} _ {3} \) процесс роста атомного слоя; ALD увеличивают в 5 раз процесс роста атомного слоя ZnO и один \ ({\ text {Al}} _ {2} {\ text {O}} _ {3} \) процесс роста атомного слоя и повторяют дважды.
Схема 2 ALD увеличивают в 4 раза процесс роста атомного слоя ZnO и один \ ({\ text {Al}} _ {2} {\ text {O}} _ {3} \) процесс роста атомного слоя; ALD увеличивают в 5 раз процесс роста атомного слоя ZnO и один \ ({\ text {Al}} _ {2} {\ text {O}} _ {3} \) процесс роста атомного слоя и повторяют три раза.
Повторить схему 1 12 раз и схему 2 13 раз.
Интерпретация операции в плане 2 аналогична плану 1.
Тест на сопротивление микроканальных пластин
Как показано на рис. 5а, мы используем технологию осаждения атомного слоя для выращивания проводящего слоя AZO и эмиссионного слоя \ ({\ text {Al}} _ {2} {\ text {O}} _ {3} \) на стенки микроканалов двумерных массивов пор. Затем мы используем технологию термического испарения, чтобы вырастить электродный слой Ni – Cr с обеих сторон МКП [2, 4] и установить электродное кольцо с обеих сторон МКП. Готовясь к вышесказанному, мы непосредственно проверяем устойчивость ALD-MCP. В этом состоянии мы определяем соответствующее сопротивление MCP как нерабочее сопротивление MCP. Мы используем электрометр Keithley модели 6517B для измерения нерабочего сопротивления MCP в диапазоне 10 −3 –10 −5 Па [1, 4, 13].

Схема испытания сопротивления ALD – MCP
Как показано на рис. 5c, мы используем электронную пушку в качестве катода и люминофорный экран в качестве анода. Электронная пушка подает падающие электроны на MCP, а люминофорный экран принимает электроны, выводимые MCP. Кроме того, когда MCP работает, высоковольтный люминофорный экран будет излучать зеленый свет, чтобы определить однородность MCP [1, 21].
Как показано на рис. 1, мы используем электронную пушку, которая обеспечивает 100 пА в качестве входа MCP для измерения тока. Из-за увеличения количества вторичных электронов возникает состояние, при котором эмиссионный слой теряет большое количество зарядов, а проводящий слой непрерывно обеспечивает поток зарядов в эмиссионный слой. В этом состоянии мы определяем соответствующее сопротивление MCP как рабочее сопротивление MCP. Вакуумная среда рабочего сопротивления 10 −3 –10 −5 Па.
Результат и обсуждение
СЭМ-изображение в поперечном сечении образца AZO-ALD-MCP показано на рис. 6. Мы разработали серию проводящих слоев AZO, как показано в таблице 1, и их соответствующие рабочие и нерабочие сопротивления на рис. 7. На рис. На том же рисунке мы также показываем рабочее и нерабочее сопротивление обычного MCP. По сравнению с нерабочим сопротивлением AZO-ALD-MCP рабочее сопротивление AZO-ALD-MCP значительно снижено. Однако нет существенной разницы между рабочим сопротивлением и нерабочим сопротивлением обычного МКП. При увеличении напряжения рабочее сопротивление AZO-ALD-MCP значительно ниже, чем у обычного MCP. При одинаковом напряжении рабочее и нерабочее сопротивления AZO-ALD-MCP стабильны. Мы полагаем, что есть две основные причины вышеупомянутых характеристик.
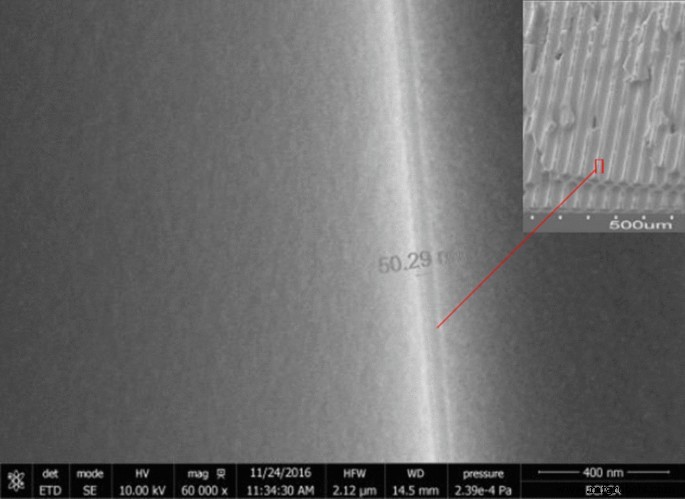
Поперечное сечение SEM-изображения AZO-ALD-MCP
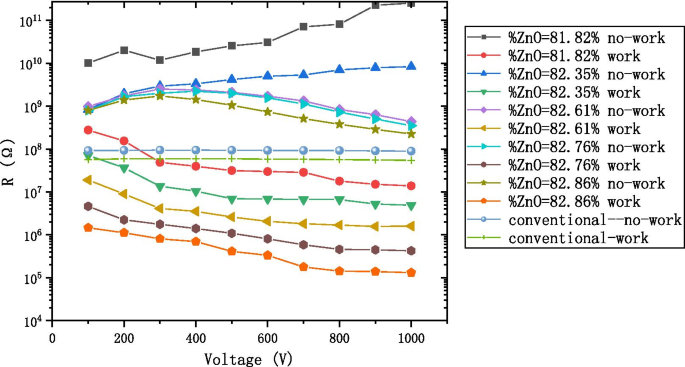
Рабочее сопротивление и сопротивление в нерабочем состоянии с диаграммой напряжения на AZO-ALD-MCP в различном соотношении и обычном-MCP
Согласно формуле [21],
$$ R _ {{{\ text {MCP}}}} =R_ {0} \ exp \ left [{- \ beta_ {T} \ left ({T _ {{{\ text {MCP}}}} - T_ { 0}} \ right)} \ right] $$по сравнению со свинцовым стеклом AZO - это материал с более высоким отрицательным температурным коэффициентом (NTC), поэтому сопротивление будет ниже при той же температуре и начальном сопротивлении. В процессе получения усиления AZO бомбардируется падающими электронами под высоким напряжением, тем самым генерируя больше электронно-дырочных пар, что приводит к увеличению тока.
Мы определяем отношение нерабочего сопротивления к рабочему сопротивлению, чтобы описать стабильность сопротивления материала:
$$ \ kappa_ {R} =\ frac {{R_ {n}}} {{R_ {w}}} $$На рисунке 8 показано, что \ (\ kappa_ {R} \) AZO-ALD-MCP составляет около 10 2 –10 3 раз, а \ (\ kappa_ {R} \) обычного МКП примерно в 2–3 раза. Это показывает, что изменение сопротивления AZO-ALD-MCP более очевидно; поэтому старую концепцию нерабочего сопротивления как определение сопротивления MCP следует заменить рабочим сопротивлением.
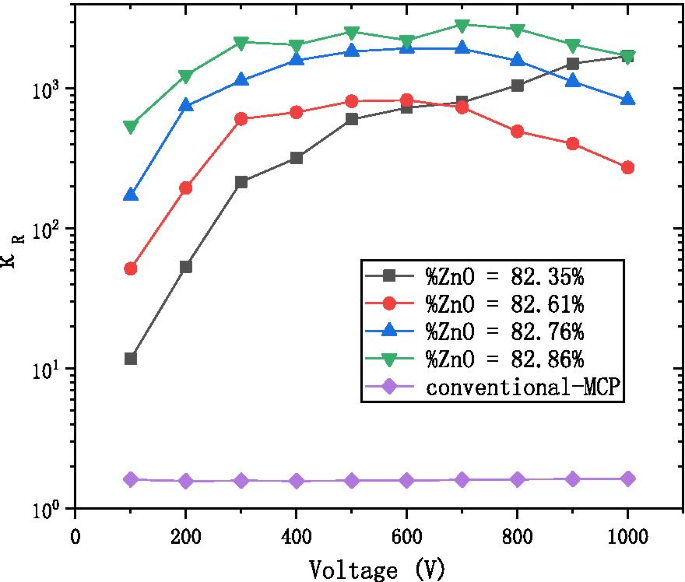
K R с диаграммой напряжения при различном соотношении AZO-ALD-MCP
На рисунке 9 показано отношение \ (L_ {R} \) сопротивления конструкции из «соседнего» материала по отношению к рабочему напряжению. Отношение \ (L_ {R} \) определяется как:
$$ L_ {R} =\ frac {{R \ left ({4 + \ frac {N - 1} {N}} \ right)}} {{R \ left ({4 + \ frac {N} {N + 1}} \right)}}$$
The resistance of the step length LR with the voltage diagram at the different ratio of the working resistance of neighbor formula
where
$$\left( {\begin{array}{*{20}c} {{\text{ZnO}}} \\ {{\text{Al}}_{2} {\text{O}}_{3} } \\ \end{array} } \right) =\left( {\begin{array}{*{20}c} {4 + \frac{N - 1}{N}} \\ 1 \\ \end{array} } \right) =\left( {\begin{array}{*{20}c} 1 \\ {N - 1} \\ \end{array} } \right)\left[ {\left( {\begin{array}{*{20}c} 4 \\ 1 \\ \end{array} } \right)\left( {\begin{array}{*{20}c} 5 \\ 1 \\ \end{array} } \right)} \right]$$и
$$\left( {\begin{array}{*{20}c} {{\text{ZnO}}} \\ {{\text{Al}}_{2} {\text{O}}_{3} } \\ \end{array} } \right) =\left( {\begin{array}{*{20}c} {4 + \frac{N}{N + 1}} \\ 1 \\ \end{array} } \right) =\left( {\begin{array}{*{20}c} 1 \\ N \\ \end{array} } \right)\left[ {\left( {\begin{array}{*{20}c} 4 \\ 1 \\ \end{array} } \right)\left( {\begin{array}{*{20}c} 5 \\ 1 \\ \end{array} } \right)} \right]$$As can be observed from Fig. 9, the LR value ranges from 2 to 4.5 to adjust ratio of conductive material ZnO and high resistance material \({\text{Al}}_{2} {\text{O}}_{3}\). And it proves the feasibility of WYM operation to design laminated materials.
Figure 10 shows the working resistance with respect to the percentage of ZnO cycles (%ZnO), where %ZnO is defined to be:
$${\text{\% ZnO}} =\frac{{{\text{ZnO}}}}{{{\text{ZnO}} + {\text{Al}}_{2} {\text{O}}_{3} }}{*}100\left( {\text{\% }} \right)$$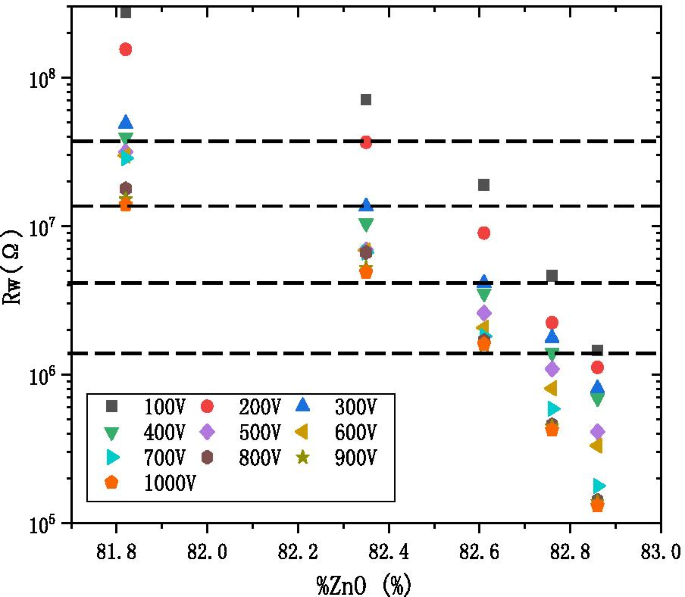
The working resistance with the percentage of ZnO cycles diagram at the different voltage
under various voltage conditions, ranging from 100 to 1000 V. It decreases that the working resistance under the same voltage with the increase in the percentage of ZnO cycles. It can be the same that the working resistance under different the percentage of ZnO cycles and under the different condition of voltage. Therefore, the AZO-ALD-MCP of different formulations works under its specific voltage to meet the MCP resistance index.
We define the ratio of the resistance difference under the different condition of voltage and the voltage difference to describe the effect of the voltage on the resistance of MCP:
$$r =\left| {\frac{{R_{U} - R_{V} }}{U - V}} \right| =\left| {\frac{{R_{1000v} - R_{100v} }}{1000 - 100}} \right|$$Figure 11 shows that the effect of the voltage on the resistance of AZO-ALD-MCP decreased and gradually stabilized with the increase in the percentage of ZnO cycles. Therefore, the preparation of AZO-ALD-MCP should try to choose a formula with a large percentage of ZnO cycles.

The r with the percentage of ZnO cycles diagram at the working state
Based on the above analysis, we have put forward the reference to the working resistance for the conductive layer of ALD-MCP. As shown in Fig. 5a, we design the AZO conductive layer of AZO-MCP by using the WYM operation and temperature adjustment based on the working resistance. We use atomic layer deposition technology to grow the \({\text{Al}}_{2} {\text{O}}_{3}\) emission layer on microchannel wall of the two-dimensional pore arrays [3, 11, 22]. In Fig. 12a, the gain from our AZO-ALD-MCP is compared to that of a conventional MCP under different voltages. As can be observed, our preparation method of the AZO-ALD-MCP provides a larger gain than that of a conventional MCP. Figure 12b shows the phosphor screen with uniform green light under high pressure, thus proving the uniformity of the material deposited on the wall of each microchannel and the uniformity of the AZO-ALD-MCP field of view.
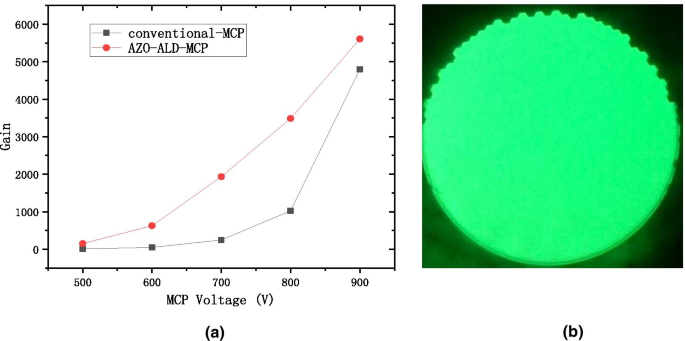
The gain with the voltage diagram at the AZO-ALD-MCP and conventional-MCP
Заключение
We defined the working and non-working resistance of the microchannel plate. Aiming at the required resistivity of the microchannel plate in the region with extremely narrow zinc content requirement (70–73%), an algorithm for growing the AZO conductive layer is proposed. Compared with the conventional MCP, we found a large difference between the working and non-working resistance and there is also a huge difference under different voltages. Therefore, we analyze the data by defining \(\kappa_{R} ,L_{R} ,\% {\text{ZnO}},r\). MCP should try to choose a formula with a large percentage of ZnO cycles. We recommend using the working resistance as an ALD-MCP resistance indicator in industrial production. Building on our results as described in this work, our studies will help to find even better materials as the conductive layer for the ALD-MCP.
История изменений
Наноматериалы
- Роль компьютерного дизайна (САПР) в 3D-печати
- Проблемы дизайна продукта
- Тетрод
- Что такое дизайн встроенной системы:этапы процесса проектирования
- Генеративный дизайн и 3D-печать:производство завтрашнего дня
- Промышленный дизайн в эпоху Интернета вещей
- Оптимизация RF-фидера при проектировании печатной платы
- Пакет проектирования печатной платы переносится в облако
- Преимущества прототипирования печатных плат
- Знайте значение спецификации в проектировании печатных плат



