Фотоэлектронные свойства нанопроволочного детектора InAsSb с концевыми связями в условиях слабого света
Аннотация
В этом исследовании продемонстрировано простое изготовление торцевых контактов InAsSb NW (нанопроволока) матричного детектора слабого света. Детектор изготовлен на основе массива ННК InAsSb, выращенного методом молекулярно-лучевой эпитаксии на подложке GaAs. Зазорные состояния, индуцированные металлом, индуцируются торцевым контактом, который подавляет темновой ток при различных температурах. Наличие диполя на границе раздела из-за состояний межфазной щели усиливает возбуждение света вокруг локального поля и, таким образом, улучшает светочувствительность и фотодетектируемость для слабого света. Интенсивность света инфракрасного источника света в этом отчете составляет 14 нВт / см 2 . что примерно на 3-4 порядка меньше, чем у лазерного источника. Чувствительность детектора достигла 28,57 А / Вт при комнатной температуре со световым (945 нм) излучением, а обнаруживающая способность - 4,81 × 10 11 см · Гц 1/2 W -1 . Аномальные характеристики, зависящие от температуры, проявляются в экспериментах с переменной температурой, и мы обсудили подробный механизм, лежащий в основе нелинейной зависимости между фотооткликом устройства и температурой. Кроме того, оптоэлектронные характеристики детектора прояснили, что эффект улавливания света и эффект фотостатирования ННК могут усилить фотоотклик на слабый свет в диапазоне от ультрафиолета до ближнего инфракрасного диапазона. Эти результаты подчеркивают возможность использования матричного детектора InAsSb NW для работы в слабом инфракрасном диапазоне без системы охлаждения.
Введение
Как важная ветвь узкозонных полупроводников AIIIBV, InAsSb обладает преимуществами, унаследованными от InAs, такими как малая эффективная масса электронов и высокая подвижность электронов [1, 2]. Когда элемент Sb вводится в InAs, характеристика длины волны отсечки тройного InAsSb может быть расширена до длинноволнового инфракрасного диапазона из-за эффекта изгиба запрещенной зоны [3]. Следовательно, InAsSb считается идеальным кандидатом в области инфракрасного обнаружения [4,5,6]. В области оптоэлектроники одномерные (1D) наноструктуры [7] обладают огромными уникальными свойствами, включая большую площадь поверхности с многочисленными состояниями ловушек, большую длину пути для поглощения фотонов и механически гибкую структуру из-за их огромных соотношений сторон [8]. Кроме того, в процессе разработки одномерные наноструктуры могут легко высвободить несоответствие кристаллической решетки подложкам и, в свою очередь, обеспечить высокое качество кристаллов [9]. При этом приложения для оптоэлектроники, такие как фотодетекторы [10], солнечные элементы [11] на основе одномерных наноструктур, привлекают огромный исследовательский интерес. Среди них специально разработанные структуры устройства [12] были созданы для достижения оптимального поглощения света и сбора широкополосного света, что сделало одномерные наноструктуры подходящими для различных сценариев применения и обеспечило совместимость компонентов с кремниевыми интегральными схемами. Недавно фотодетекторы на основе индивидуальных InAs ННК продемонстрировали свои возможности в инфракрасном детектировании [13]. С добавлением Sb тройной InAsSb может быть доступен в широком диапазоне спектра для обнаружения при комнатной температуре [14]. С пассивацией Al 2 О 3 детекторы на основе InAsSb ННК достигли неохлаждаемого детектирования в средневолновом инфракрасном спектре [15]. Однако обычные источники света, широко применяемые в этих исследованиях, представляют собой лазеры высокой интенсивности, и большинство из этих устройств не могут работать при комнатной температуре [16]. Кроме того, традиционная конструкция устройства на основе ННК не подходит для массового применения в совместимых интегральных схемах. Существует три основных типа традиционных детекторов на основе InAsSb NW, включая индивидуальное устройство NW [17], квантовые ямы, встроенные в InAs NW [3] и вертикальное устройство индивидуального NW [14]. Все они требуют дорогостоящих процессов нанопроизводства, таких как электронно-лучевая литография (EBL) и реактивное ионное травление (RIE). При этом нововведение в конструкции устройства актуально для применения ННК.
Интерфейс всегда играет жизненно важную роль в оптических и электрических характеристиках устройства, несмотря на ограниченный размер, что делает разработку контактов в устройствах на основе NW еще одним важным фактором [18]. Например, солнечный элемент с превосходными всенаправленными фотодетектирующими свойствами для слабого света был получен в гибридной структуре, использующей интерфейс между квантовыми точками графена и сульфонатом полистирола [19]. В этом исследовании мы модулируем оптоэлектрические характеристики устройства, используя полосную структуру на границе раздела между электродом и полупроводником. Перераспределение заряда происходит на границе раздела металл – полупроводник, а перенос заряда происходит между металлом и хвостами волновых функций металла в полупроводник. Это перераспределение называется MIGS, что может вызвать щелевые состояния и интерфейсный диполь на межфазных состояниях [20]. Однако результаты моделирования с использованием модели MIGS все еще имеют расхождения между экспериментами, которые считаются результатом дефектов интерфейса, искусственных наведенных дефектов и пиннинга уровня Ферми [21]. Пиннинг уровня Ферми неизбежен, особенно для InAsSb NW с богатыми поверхностными состояниями, так что индуцированные щелевые состояния будут фильтровать перенос заряда. Таким образом, темновой ток устройства может быть подавлен в приемлемом диапазоне. Кроме того, межфазный диполь может усилить возбуждение света в локальном поле, что важно для обнаружения слабого света. По материалам обсуждения Чу. и др., переходы с торцевыми связями с большей вероятностью достигают перекрытия состояний между металлом и полупроводником, чем переходы с плоскими связями [18]. Тем не менее, устройство с концевым соединением через индивидуальный NW сталкивается с препятствиями при изготовлении. Здесь мы предлагаем решение, используя массивы NW для достижения концевого контакта между NW и металлом. По сравнению с обычными фотодетекторами, устройства NW с многослойной структурой имеют преимущества, заключающиеся в простоте изготовления и высокой адаптируемости к окружающей среде [22, 23]. Наполнитель (AZ5214), который покрывается центрифугированием и обжигается вокруг ННК в процессе изготовления, делает устройство более стабильным и антиоксидантным для окружающей среды. Когда свет вводится в решетку NW, он многократно отражается и преломляется в разных направлениях, увеличивая поглощение света внутри [24, 25]. Удлиненный световой путь в решетке NW называется эффектом захвата света [26, 27], который широко используется в устройствах массива NW. И полосовая структура, и структура устройства дают устройству возможность обнаружения слабого света при комнатной температуре.
В данной работе мы изготовили устройство массива ННК на основе ННК InAsSb, выращенных методом МЛЭ (молекулярно-лучевой эпитаксии). Щелевые состояния и интерфейсный диполь, индуцированные контактом металл-полупроводник, могут подавлять темновой ток и усиливать обнаружение света по отдельности [28]. Эффект захвата света сэндвич-структурой массива ННК способствует обнаружению слабого света [29]. Подавление темнового тока при комнатной температуре значительно снижает шум обнаружения и позволяет обнаруживать при комнатной температуре [30]. Конструкция устройства для отверждения позволяет устройству работать в окружающей среде. Кроме того, фотоотклик устройства колеблется в зависимости от температуры, поскольку ожидаются сложные состояния интерфейса. При постоянной температуре значение фототока увеличивается линейно с интенсивностью падающего света, что демонстрирует потенциал для измерителя оптической мощности.
Методы / экспериментальные
ННК InAsSb были выращены на подложках GaAs {111} B с использованием системы МПЭ (Riber 32 R&D) с системой испарения золота in situ. Субстрат epi-ready был предварительно обработан для удаления загрязнения. Затем был нанесен буферный слой GaAs при 540 ° C в течение 15 мин, и наночастицы Au были сформированы в процессе испарения и отжига. Стебли InAs выращивали в течение 20 мин при постоянной температуре 380 ° C, после чего в камеру для выращивания на 60 мин вводили источник Sb. Во время роста NW In BEP (эквивалентное давление пучка) поддерживалось на уровне 2,7 × 10 –7 мбар, As BEP составлял 2,2 × 10 –6 мбар, а для Sb BEP - 7 × 10 –7 мбар, что приводит к соотношению потоков V / III ~ 11 и соотношению Sb / As ~ 0,3.
При изготовлении устройства в качестве расклинивающего агента использовался AZ5214 (фоторезист) для поддержания ориентации ННК. Затем массив ННК с подложкой подвергали центрифугированию с помощью AZ5214 при 3000 об / мин в течение 30 с и запекали в течение 2 минут при 120 ° C. Гель AZ5214 прозрачный, что сводит к минимуму потери света во время измерения. Чтобы обнажить кончики ННК, поверхность массива полировалась с помощью прецизионного измерителя сдвига (Logitech). Слои InAsSb, сформированные на поверхности подложки в процессе роста ННК по механизму VS (пар-твердое тело), могут выступать в качестве электрода стока. Согласно измерениям Холла эпислоев InAsSb (показано в Дополнительном файле 1:Рисунок S1), концентрация носителей при комнатной температуре составляет примерно 2 × 10 17 см −3 , а подвижность порядка 1,6 × 10 4 см 2 / (В · с) при комнатной температуре. После этого на выбранные участки наносилась пленка Au номинальной толщиной 8 нм, одна из которых находится на вершине массива, а другая - на эпислое. Небольшая толщина нанесенного золота обеспечивает фотопроницаемость электрода и приемлемые потери света во время измерений.
Морфологические, химические и структурные характеристики полученных InAsSb NW были исследованы с использованием SEM (FE-SEM, JEOL 7800F) и TEM [TEM, Philips Tecnai F20, оснащенного энергодисперсной спектроскопией (EDS) для композиционного анализа]. Индивидуальные ННК для ПЭМ-анализа были приготовлены путем обработки образцов ННК в этаноле с помощью ультразвука и диспергирования их на медных решетках, поддерживаемых углеродными пленками.
Измерения фотопроводимости проводились в гелиевом криостате замкнутого цикла, оборудованном светодиодами в качестве источников света. Температуру в этой системе можно непрерывно регулировать от 2 K до комнатной, а интенсивность света светодиодов можно легко регулировать с помощью входного тока. В этом исследовании использовались светодиоды с различными длинами волн, включая 260 нм, 620 нм и 945 нм. Интенсивность света светодиода зависит как от температуры, так и от входного тока. Интенсивность линейно увеличивается с током и уменьшается с температурой. Значения силы света при комнатной температуре в этом измерении составляют 4000 нВт / см 2 . для 260 нм, 558 нВт / см 2 для 620 нм и 14 нВт / см 2 для 945 нм. Соответствующую информацию об интенсивности света можно найти в работе. [30]. Постоянное напряжение V DS =100 мВ было приложено между истоком и стоком. Отклик фотопроводимости может быть получен путем настройки включения / выключения светодиодов.
Результаты и обсуждение
На рис. 1 показаны электронно-микроскопические исследования ННК InAsSb. На рис. 1а представлено СЭМ-изображение под наклоном, показывающее, что диаметры ННК находятся в диапазоне от 100 до 200 нм, а длина - от 6 до 8 мкм. На рисунке 1b показано ПЭМ-изображение в светлом поле (BF) типичного индивидуального NW, указывающее на классическую сужающуюся структуру. В осевом направлении состав СЗ демонстрирует умеренное постепенное изменение, а средняя концентрация сурьмы высока до 30% на основе нашего количественного анализа EDS (подробности доступны в Дополнительном файле 1:Рисунок S2). На рис. 1в показано изображение средней части НПВРЭМ, подтверждающее существование двойниковых плоскостей. Выбранная диаграмма электронной дифракции (SAED), показанная на рис. 1d, также подтверждает двойниковую структуру, и можно выделить два набора дифракций со структурой ZB (цинковая обманка). Элемент Sb может использоваться в качестве поверхностно-активного вещества и подавляет фазу WZ (вюрцит) в InAs NW [31], способствуя изменению фазы структуры с WZ на ZB. В нашем случае отношение V / III составляет ~ 11, что приводит к окружению с высоким содержанием V, которое способствует зарождению структуры ZB [32], но оставляет несколько двойниковых плоскостей. В исследовании двойниковой структуры в ННК InAsSb утверждалось, что смещение на границе вызовет неравномерное локальное распределение Sb [12], что способствует рассеянию электронов или захвату носителей заряда [33].
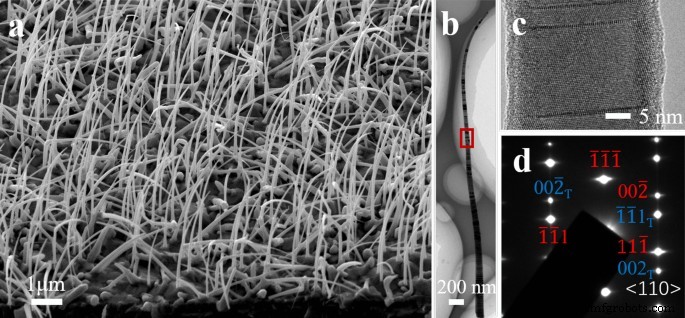
Расширенные электронно-микроскопические исследования ННК InAsSb. а СЭМ-изображение NW под наклоном. б Светлопольное (BF) ПЭМ изображение индивидуального НП. c Изображение ПЭМ высокого разрешения (ПЭМВР), полученное из середины северо-западного побережья из отмеченной области на b . г Соответствующая диаграмма SAED (электронограмма в выбранной области), взятая из c
Структура устройства проиллюстрирована на рис. 2а, на котором пленка Au покрывает верх и низ массива. СЭМ-изображение устройства показано в Дополнительном файле 1:Рисунок S3, где оставшаяся длина составляет около 3 мкм и почти все ННК интегрированы. Фоторезист используется для сохранения ориентации ННК и интеграции ННК в устройство для отверждения; Таким образом, устройство обладает большей антиокислительной способностью и подходит для применения. Коническая структура используется в устройстве массива ННК из аморфного кремния, демонстрируя усиление поглощения и нечувствительна к углу падения [34]. Рисунок 2b представляет собой схематическую карту интерфейса Au-InAsSb, определенного моделью MIGS. Рисунок 2c, d подтверждает почти постоянную проводимость, не зависящую от температуры, а значение проводимости составляет примерно 1 × 10 –7 . Ом −1 . ВАХ при 2 К и 300 К без падающего света показаны на рис. 2г. Отдельная нанопроволока имеет гораздо большее значение проводимости, показанное в Дополнительном файле 1:Рисунок S4. Матричное устройство эквивалентно параллельной цепи, к которой подключены тысячи отдельных NW, так что теоретическая проводимость должна быть гораздо более значительной. Кроме того, у нас есть два основных знания о проблемах, связанных с проводимостью:(1) проводимость отдельных NW сильно зависит от температуры; 2) матричные устройства из InAs ННК в нашем исследовании также имеют постоянную проводимость. Следовательно, мы заключаем, что контакт между металлом и полупроводником в этом устройстве имеет значительное сопротивление, определяющее общие выходные характеристики.

Структура и электрические свойства массива InAsSb NW. а Эскизная карта устройства с изображением SEM, показанным на вставке. б Энергетическая диаграмма состояний интерфейса Au-InAsSb. c Температурная проводимость устройства. г ВАХ при 2 К и 300 К без света соответственно
Когда Au присоединяется к InAsSb NW через концевой контакт, перенос заряда происходит на границе раздела через хвосты металлических электронных волновых функций, что называется континуумом MIGS [18]. Перераспределение заряда на границе раздела происходит, как только контактные формы вызывают развитие интерфейсных диполей [35]. Согласно модели MIGS высота межфазного барьера определяется \ ({\ Phi} _ {\ mathrm {Au}} \) (работа выхода металла), \ ({\ Phi} _ {\ mathrm {NW }} \) (сродство к электрону NW InAsSb) и \ ({\ Delta} _ {i} \) (падение напряжения из-за интерфейсного диполя, которое возникает при образовании интерфейса). \ ({\ Delta} _ {i} \) - это расстояние между состояниями щели, индуцированными металлом. Электронное состояние показано на рис. 2б. Интерфейсный диполь может создать дополнительный барьер для электронов [36], но эффект ограничен в области \ ({\ delta} _ {i} \). Прежде всего, внутренние свойства устройства модулируются большим паразитным контактным сопротивлением [37]. В нашем устройстве большое контактное сопротивление эффективно снижает темновой ток, в то время как его значение не зависит от температуры. Таким образом, концентрация носителей может быть ограничена в диапазоне, благоприятном для обнаружения света. Тем не менее, механизм контактного сопротивления из-за того, что интерфейсный диполь остается постоянным при различных температурах, остается более детальным исследованием.
На рис. 3а мы отображаем токи устройства от 2 до 120 К со световой подсветкой и без нее, а остальное отображается в Дополнительном файле 1:Рисунок S5. Состояния светодиода настраиваются по времени, при котором состояния «ВКЛ» и «ВЫКЛ» сохраняются в течение 60 с соответственно. Конкретные значения тока светодиода, показанные в состоянии «ВКЛ», составляют 10, 20, 50, 100, 200, 500, 1000, 2000 и 3000 мкА соответственно. Измерения проводились при различных температурах от 2 до 300 К. На вставке к рис. 3а показаны условия с тремя самыми слабыми световыми лучами (около 4–10 нВт / см 2 ), что указывает на аналогичную тенденцию с рис. 3а. Однако очевидное различное оптическое поведение можно констатировать при самом слабом свете, особенно из-за более медленной скорости отклика и немного постоянной фотопроводимости. На рис. 3б показано время отклика устройства при 20 К, при токе светодиода 2000 мкА. Стоит отметить, что рис. 3в получен в окружающей среде при комнатной температуре. Что еще более важно, источником света, который мы здесь использовали, являются все светодиоды, а значения интенсивности света составляют 4000 нВт / см 2 (260 нм), 558 нВт / см 2 (620 нм) и 14 нВт / см 2 (945 нм) соответственно. Помимо светочувствительности, исходя из скорости отклика при разных длинах волн света, мы можем сделать вывод, что ННК InAsSb лучше реагируют на инфракрасный свет.
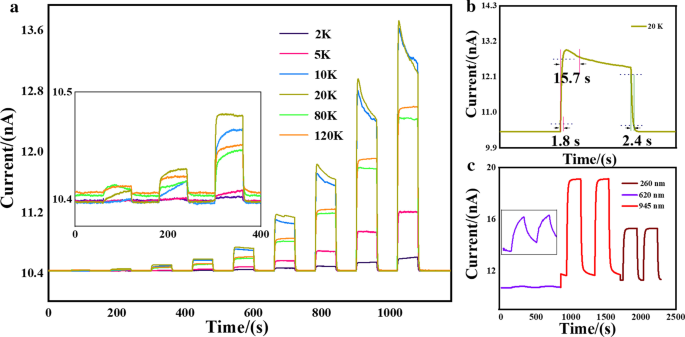
Зависимость проводимости исток-сток от времени при различных температурах. а Фотоотклик устройства при разных температурах до светодиода 620 нм с разным входным током. б Время отклика устройства - 20 К, а входной ток светодиода - 2000 мкА. c Зависимость фотоэлектрических характеристик прибора от длины волны при комнатной температуре с освещением 260 нм, 620 нм и 945 нм. На вставке показан увеличенный вариант фотоотклика на светодиода с длиной волны 260 нм
Рисунок 3а показывает, что наше устройство быстро и очевидно положительно реагирует на изменение состояния светодиода при разных температурах, а фотопроводимость увеличивается с увеличением тока светодиода. Без подсветки проводимость устройства составляет около 1,04 × 10 –7 . Ом −1 , что согласуется с выходным тестом, показанным на рис. 2в. При фиксированной температуре значение Δ G (определяемая как проводимость за вычетом проводимости в темноте) увеличивается почти линейно с током светодиода, представляющим интенсивность света. Когда источник света был заблокирован, ток устройства немедленно возвращается в исходное состояние. Максимальное значение Δ G на этом графике 3,2 × 10 –8 Ом −1 при 10 К. Следует отметить, что на этом графике можно выделить два вида фотоответа:
- 1.
для большинства температур токи быстро увеличиваются после включения светодиода, и токи остаются стабильными, пока светодиод включен;
- 2.
при 10 К и 20 К ток также быстро увеличивается со световым освещением. Тем не менее, при включении светодиода ток немного уменьшается, оставляя на графике хвост, которого нет при других температурах.
Чтобы прояснить внутренний механизм двух разных видов фотоответа, информация о скорости отклика при 20 К, когда ток светодиода составляет 2000 мкА, извлекается в качестве доказательства, а конкретные значения показаны на рис. 3b. Время отклика [38, 39] ( τ ris представляющий промежуток времени от пика тока 90% до пика тока 10%) определяется как 1,8 с, в то время как время восстановления ( τ rec определяется противоположным образом) составляет 2,4 с, что почти постоянно во всем диапазоне температур. Для 10 К и 20 К время задержки структуры «хвоста» составляет около 15,7 с, что на удивление отсутствует, когда ток свечения светодиода меньше 500 мкА. В сочетании с условиями слабого освещения на вставке к рис. 3а можно продемонстрировать три вида фотоотклика при 10 К и 20 К. При самом слабом свете (10–50 мкА) ток медленно увеличивается со временем. Когда ток светодиода увеличивается до 100–500 мкА, реакция становится быстрой. Когда ток превышает 1000 мкА, образуется хвост. Другими словами, только достаточная сила света может вызвать переходную структуру «хвоста». Подобные «хвостовые» структуры широко описаны в InAs NW [40, 41]. Источниками света в этих отчетах являются все лазеры с высокой интенсивностью света, что согласуется с нашим результатом, согласно которому структура «хвоста» появляется только в зонах высокой интенсивности света. Они утверждали, что «хвост» возникает из-за эффекта запаздывания, который соответствует захвату и освобождению носителей от захвата на поверхностных состояниях [42]. Для ННК InAsSb в нашем случае поверхностные состояния более неизбежны из-за сильного эффекта поверхностно-активного вещества, включенного в Sb [43]. Следовательно, мы ожидаем, что структура «хвоста» возникает из-за дефектных состояний двойниковой структуры, которые захватывают электроны только при определенных температурах с достаточно сильной световой помощью.
Для данного фотоприемника светочувствительность может быть выражена как [44]
$$ \ mathrm {R} =\ frac {{I} _ {\ mathrm {p}}} {PA} $$ (1)где \ ({I} _ {\ mathrm {p}} \) - фототок устройства, \ (P \) - мощность света на устройстве, а \ (A \) - эффективная площадь устройства. Для нашего устройства эффективная площадь устройства составляет 1 мм 2 что определяется маской, использованной при испарении электродов, а светопринимающая площадь фотометра составляет 0,9 см 2 . В этом случае светочувствительность устройства составляет 4,25 мА / Вт (260 нм), 1,27 А / Вт (620 нм) и 28,57 А / Вт (945 нм), соответственно, что дополнительно подтверждает потенциал InAsSb. Устройство NW с сэндвич-структурой для обнаружения инфракрасного излучения.
Фотодетектируемость устройства может быть представлена как [14]
$$ {D} ^ {*} =R {A} ^ \ frac {1} {2} / {(2e {I} _ {\ mathrm {dark}})} ^ \ frac {1} {2} $ $ (2)где R это светочувствительность устройства и e это электронный заряд. Я темный представляет темновой ток устройства, и значение составляет 10,8 нА. При подавлении темнового тока в многослойной структуре InAsSb NW значения \ ({D} ^ {*} \) фотоприемника достигают 7,28 × 10 7 (260 нм), 2 × 10 10 (620 нм) и 4,81 × 10 11 см · Гц 1/2 W -1 (945 нм) соответственно. Примечательно, что коэффициент заполнения NW в этой структуре массива меньше 50%, что делает фактическое значение R и \ ({D} ^ {*} \) больше, чем рассчитанный нами результат. Высокий R и \ ({D} ^ {*} \) не только связаны с эффектом захвата света матричным устройством, но также происходят из структуры интерфейса [2]. По сравнению с фотодетекторами на основе нанопроволоки, описанными в [5]. [45], рабочая температура 300 K для нашего устройства имеет превосходный потенциал применения в реальных декорациях [6]. Кроме того, в диапазоне комнатных температур светочувствительность нашего простого в изготовлении устройства массива InAsSb NW (28,57 A / W при 945 нм) может превосходить самые сложные устройства на основе NW (WSe 2 / Би 2 Te 3 :20 A / W при 980 нм [46], PtSe 2 / перовскит:0,12 A / Вт при 800 нм [47]). Несмотря на то, что интерфейсный диполь недоступен экспериментально, выходные характеристики на рис. 2 могут служить твердым доказательством его существования в нашем устройстве. Как предполагалось в предыдущем обсуждении, межфазный слой устройства может функционировать как оптическая дипольная решетка со световым освещением, что может способствовать большему коэффициенту усиления поля. Этот эффект упоминается как эффект усиления интерфейсных диполей (IDEE) в предыдущих исследованиях [48]. IDEE работает для более широкого диапазона длин волн, чем эффект усиления поверхностного плазмона, который существует только в пределах резонансного диапазона длин волн. Эффект улучшения межфазных состояний и эффект улавливания света матричным устройством работают вместе для обнаружения слабого света в нашем устройстве.
На рис. 4 показана зависимость фотоотклика устройства InAsSb NW от температуры (рис. 4а) и интенсивности света (рис. 4б). Значение \ ({I} _ {p} \) - это максимальное значение, которое фототок может получить при включенном свете. Фотоответ нормализуется точной интенсивностью света, чтобы скрыть его влияние на тенденцию. Поначалу можно сделать вывод о подобной тенденции при освещении разной интенсивности света. На всех графиках абсолютная фотопроводимость увеличивается от 2 до 20 К, а затем уменьшается до 80 К, оставляя первый пик около 20 К, а второй пик около 100–120 К. Температурный диапазон этого пика соответствует определенной температуре. область, в которой существует нестационарный «хвост» фототока. Другой пик составляет около 100–120 К, и его конкретное местоположение смещается в зону с более высокой температурой с увеличением интенсивности света.
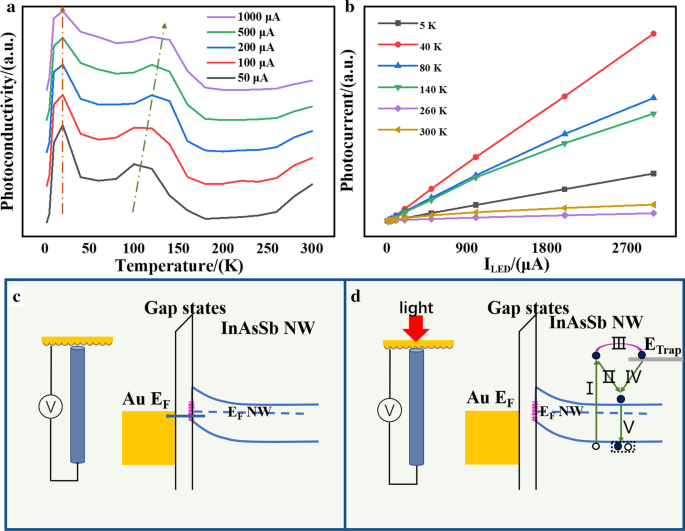
а Температурная зависимость Δ G измерены с разной интенсивностью света. б Степенная зависимость Δ G измеряется при разных температурах. c Зонная структура устройства с напряжением смещения. г Ленточная структура прибора со световой подсветкой
Фототок можно выразить как [28]
$$ {I} _ {p} =qg {V} _ {\ mathrm {NW}} [\ tau {\ mu} _ {d} / l] $$ (3)где \ (q \) - заряд элемента, \ (g \) - скорость генерации фотоносителя, \ ({V} _ {\ mathrm {NW}} \) - объем НВ, \ (\ tau \) - время жизни неосновных носителей заряда, а \ ({\ mu} _ {d} \) - дрейфовая подвижность, а \ (l \) - длина ННК. Это уравнение поясняет, что время жизни неосновных носителей заряда и дрейфовая подвижность являются двумя ключевыми параметрами фототока [43]. Оптоэлектрический процесс матричного устройства InAsSb показан на рис. 4c, d. До попадания света перенос электронов между ННК Au и InAsSb формирует темновой ток. Щелевые состояния из-за интерфейсного диполя достаточно короткие для передачи носителей с достаточным импульсом. В нашем устройстве интерфейсные состояния, индуцированные собственной структурой двойникования, и созданные дефекты могут действовать как состояния захвата. При включении света избыточные электроны с достаточной энергией и импульсом будут захвачены на интерфейсных состояниях, как показано в процессах I и III. Уменьшение концентрации электронов увеличивает подвижность в канале и увеличивает время жизни фотогенерированных электронов. С другой стороны, захваченные электроны в пограничном состоянии рассеивают электроны в канале и уменьшают подвижность. Освободившиеся электроны вернутся в зону проводимости через процесс IV и будут участвовать в токе. Электроны с более низкой энергией будут мотивированы на проводящую зону и участвовать в токе, как показано в процессе II. Через некоторое время электроны будут рекомбинированы с дырками, оставшимися в валентной зоне, как показано в процессе V. Мы можем сделать вывод о двух видах процессов рассеяния в устройстве:захватывающие центры рассеяния электронов и электрон-электронное рассеяние в канале [49] . Большее количество захватывающих электронов на интерфейсных состояниях уменьшило бы подвижность носителей и концентрацию носителей в канале. Впоследствии электрон-электронное рассеяние будет ослаблено и, в свою очередь, будет действовать на увеличение подвижности. В заключение, эти два процесса рассеяния будут взаимодействовать по току и получить экстремум около 10–20 К. Примечательной особенностью этого пика является структура «хвоста», стабильное место пика и постоянная фотопроводимость при сверхслабом освещении. При сверхслабом освещении индуцированного количества фотонов недостаточно, чтобы сразу достичь насыщенного фототока. Следовательно, прибор показывает стойкий фототок до насыщения. Когда интенсивность света увеличивается, фотовозбужденные носители увеличивают ток и достигают экстремального значения за короткое время отклика. Однако с большей интенсивностью света дело обстоит сложнее. Избыточные носители над насыщенными состояниями захватываются интерфейсными состояниями. Когда захваченные электроны попадают в зону проводимости, концентрация снова увеличивается. Увеличивающееся электрон-электронное рассеяние вызывает уменьшение тока, что называется эффектом запаздывания, и создает структуру «хвоста».
Для второго пика около 100–120 К аналогичный сдвиг пика был зарегистрирован в Bi 2 Te 3 фильм [50]. Наш анализ указывает на существование центров рекомбинации в этой области температур. Внутренний механизм аналогичен Bi 2 Te 3 оба связаны с балансом фототока (\ ({I} _ {\ mathrm {p}} \)) и темнового тока (\ ({I} _ {\ mathrm {d}} \)). В нашем случае \ ({I} _ {\ mathrm {d}} \) почти постоянно во всем диапазоне температур измерения. \ ({I} _ {\ mathrm {p}} \) определяется временем жизни неосновных носителей заряда и дрейфовой подвижностью. Отмечено, что эти два параметра ННК InAsSb имеют противоположную зависимость от температуры. Для времени жизни неосновных носителей термически возбужденные темные носители увеличиваются с температурой, а также скорость рекомбинации фотогенерированных носителей [51]. Таким образом, время жизни неосновных носителей обратно пропорционально температуре. Дрейфовая подвижность пропорциональна температуре, поскольку высокая температура вызывает эффект теплового возбуждения в ННК. Пик возникает, когда \ ({I} _ {\ mathrm {p}} \) и \ ({I} _ {\ mathrm {d}} \) достигают баланса при определенной температуре, которая составляет примерно 100–120 К. • При более высокой интенсивности света большее количество фотогенерированных носителей потребует большего количества термически возбужденных носителей при более высокой температуре, чтобы потребовался баланс. Следовательно, второй пик смещается в сторону более высокой температуры при увеличении интенсивности света. На рисунке 4b показана зависимость фотопроводимости от интенсивности света устройства InAsSb NW, где Δ G значения не нормализованы. Как видно, интенсивность света светодиода строго линейно увеличивается с входным током (см. Дополнительный файл 1:Рисунок S6). Hence, this result represents the relationship between the photoresponse and the light intensity, demonstrating the potential of the InAsSb NW array device in optical power meter.
Выводы
In summary, the sandwich-structured photodetector based on InAsSb NW array has achieved a splendid optical performance due to the MIGS induced by the end-bonded contact. Interface dipole and gap states suppress the dark current and enhance detection ability of the device. The native defects and the fabricated-induced defects in the device act as the interface states to modulate the optical properties. Even with the ultraweak light (4–20 nW/cm 2 ) illumination, the device shows obvious photoresponse at room temperature. The response to LEDs with different wavelengths indicated that the InAsSb NW array device has the strongest response to the infrared light (945 nm). The photoresponsivity and photodetectivity are 40 A/W and 7 × 10 11 cm Hz 1/2 W −1 , соответственно. These results confirmed that the sandwich structure in this study favors the repeatability and reliability of the NW devices, which paves a way for the fabrication of NW-based devices. Most importantly, the device may work in an ambient environment at room temperature, which is a great breakthrough for infrared detection.
Доступность данных и материалов
All data are fully available without restriction. Наборы данных, использованные и / или проанализированные в ходе текущего исследования, доступны у соответствующего автора по разумному запросу.
Сокращения
- MBE:
-
Молекулярно-лучевая эпитаксия
- 1D:
-
Одномерный
- NW:
-
Нанопроволока
- BEP:
-
Beam equivalent pressure
- VS:
-
Vapor–solid
- VLS:
-
Vapor–liquid–solid
- EBL:
-
Электронно-лучевая литография
- RIE:
-
Реактивное ионное травление
- WZ:
-
Вюрцит
- ZB:
-
Zinc blende
- BFTEM:
-
Bright-field scanning electron microscope
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- SAED:
-
Электронная дифракция в выбранной области
- EDS:
-
Энергодисперсная спектроскопия
- MIGS:
-
Metal-induced gap state
- IDEE:
-
Interface dipole enhancement effect
- Светодиод:
-
Light emitting diode
Наноматериалы
- Квантовый транспорт становится баллистическим
- Полупроводниковые наночастицы
- Нанокупы могут отклонять свет
- Плазмонно-усиленное поглощение света в (p-i-n) переходных GaAs-нанопроводных солнечных элементах:исследование ме…
- Фотоэлектрические характеристики солнечного элемента с гибридной матрицей на основе нанопроводов и квантов…
- Зависимости упругих свойств монокристаллов тантала от температуры и давления при растягивающем нагружении:…
- Оптимизация солнечных элементов с решеткой с нановолоконным GaAs с использованием гетеропереходов AlGaAs / GaAs
- Использование ИИ для управления свойствами света | Генерация суперконтинуума
- С# — Свойства
- Дальний инфракрасный микроволновый детектор кинетической индуктивности (FIR MKID) Массив



