Высокопроизводительные двухканальные HEMT AlGaN с улучшенной плотностью тока стока и высоким напряжением пробоя
Аннотация
В этой работе предложена и выращена двухканальная гетероструктура AlGaN методом химического осаждения из газовой фазы (MOCVD), а также изготовлены и исследованы высокоэффективные двухканальные транзисторы с высокой подвижностью электронов (HEMT) из AlGaN. Реализация функции двойного канала эффективно улучшает транспортные свойства канальных гетероструктур AlGaN. С одной стороны, общая плотность двумерного электронного газа (2DEG) повышается за счет двойных потенциальных ям в вертикальном направлении и улучшенного удержания носителей. С другой стороны, средняя плотность 2DEG в каждом канале снижается, а подвижность повышается в результате подавления эффекта рассеяния несущих-несущих. В результате максимальная плотность тока стока ( I макс ) двухканальных HEMT из AlGaN достигает 473 мА / мм при напряжении на затворе 0 В. Кроме того, продемонстрированы превосходные характеристики пробоя двухканальных HEMT из AlGaN. Эти результаты не только демонстрируют большой потенциал применения двухканальных HEMT из AlGaN в силовой микроволновой электронике, но и развивают новый подход к исследованиям электронных устройств на основе нитридов группы III.
Введение
Транзисторы с высокой подвижностью электронов (HEMT) на основе нитридов группы III были определены как наиболее многообещающие кандидаты для силовой СВЧ-электроники следующего поколения из-за их быстрой скорости переключения и низких потерь переключения [1,2,3,4,5] . В последнее время наиболее продвинутые нитридные HEMT достигли начальной стадии коммерциализации до 650 В. Однако с развитием технологии производства устройств становится все труднее увеличивать напряжение пробоя ( V b ) и повышение надежности устройства при высоких температурах. Следовательно, ввиду большей ширины запрещенной зоны и превосходной термической стабильности AlGaN по сравнению с GaN, канальные устройства AlGaN были предложены в качестве многообещающего кандидата для дальнейшего улучшения пределов рабочих характеристик нитридных HEMT в высоковольтных и высокотемпературных приложениях [6,7,8 , 9,10,11,12,13,14,15].
Nanjo et al. продемонстрировали заметное повышение напряжения пробоя HEMT канала AlGaN, и полученные максимальные напряжения пробоя составили 1650 В в Al 0,53 Ga 0,47 N / Al 0,38 Ga 0,62 N HEMT с расстоянием затвор-сток 10 мкм [6]. Впоследствии Nanjo et al. еще больше способствовало пробивному напряжению Al 0.40 Ga 0.60 N / Al 0,15 Ga 0,85 N HEMT до 1700 В [8]. Zhang et al. изготовили HEMT с каналом AlGaN с новым омическим контактом сток / гибрид Шоттки, и для HEMT с каналом AlGaN было получено рекордно высокое напряжение пробоя более 2200 В [11]. Xiao et al. предложены канальные гетероструктуры AlGaN с высокой подвижностью ДЭГ 807 см 2 / В · с, а также записи максимального тока стока и I on / I выкл соотношения были представлены для изготовленных HEMT с каналом AlGaN [14]. После этого Xiao et al. предложили нормально выключенные HEMT со сверхрешеточным канальным слоем AlGaN впервые, и изготовленные устройства показали напряжение пробоя более 2000 В, высокую плотность тока 768 мА / мм и пороговое напряжение ( V T ) 1,0 В [15]. Недавно Baca et al. оценили радиочастотные (RF) характеристики HEMT канала AlGaN с затвором длиной 80 нм. F T 28,4 ГГц и f MAX 18,5 ГГц были определены из измерений S-параметров слабого сигнала [12]. Эти результаты демонстрируют перспективность HEMT канала AlGaN для применения в ВЧ-системах.
Однако ограничения устройств канала AlGaN, о которых сообщалось ранее, также очевидны. С одной стороны, из-за эффекта неупорядоченного рассеяния тройного сплава подвижность двумерного электронного газа (ДЭГ) в канале AlGaN намного ниже, чем в канале GaN. В результате текущая пропускная способность устройств с каналом AlGaN намного ниже, чем у традиционных устройств с каналом GaN. С другой стороны, для того, чтобы индуцировать такое же количество 2DEG в канале AlGaN, компонент AlN в барьерном слое AlGaN должен быть выше, чем у традиционных гетероструктур с каналом GaN, что усложняет процесс роста материала. Эти противоречия серьезно препятствуют широкому применению канальных устройств AlGaN, и срочно необходима оптимизация компоновки гетероструктур.
Двухканальная технология представляет собой интересный подход к увеличению канальной плотности носителей в гетероструктурах на основе нитридов без какого-либо неблагоприятного воздействия на подвижность электронов, а токопроводимость устройств будет улучшена [16,17,18]. Однако до сих пор было немного сообщений о двухканальных гетероструктурах или электронных устройствах AlGaN. В этой работе впервые предложена и выращена двухканальная гетероструктура AlGaN для разрешения противоречий между способностью возбуждения тока и характеристиками пробоя электронного устройства на основе нитрида. Кроме того, изготавливаются и детально исследуются высокопроизводительные двухканальные HEMT из AlGaN на основе новой гетероструктуры.
Методы
Схема поперечного сечения двухканальной гетероструктуры AlGaN показана на рис. 1а, а процессы роста можно резюмировать следующим образом. Сначала на сапфировую подложку выращивали буферный слой GaN с размером 1600 нм. Затем был выращен градиентный буферный слой AlGaN размером 500 нм с увеличением состава AlN от 0 до 10%, что было полезно для подавления образования паразитного канала. После этого последовательно выращивали канал AlGaN на 100 нм ниже, прослойку AlN на 1 нм и барьер AlGaN на 23 нм ниже, и составы AlN в канальном и барьерном слоях составляли 10% и 31% соответственно. Наконец, были выращены 30 нм верхний канал AlGaN, 1 нм промежуточный слой AlN и 23 нм верхние барьерные слои AlGaN, состав которых был таким же, как и нижние слои. Диаграмма зоны проводимости двухканальной гетероструктуры AlGaN может быть рассчитана путем самосогласованного решения одномерного уравнения Пуассона-Шредингера, которое использует метод конечных разностей с неоднородным размером ячейки [19]. Диаграмма зоны проводимости и выделенное распределение электронной плотности двухканальной гетероструктуры AlGaN показаны на рис. 2а, а результаты для одноканальной гетероструктуры AlGaN также представлены на рис. 2b для состава. На границе прослоек AlN и Al 0,10 образуются две глубокие потенциальные ямы. Ga 0,90 N-канальные слои для двухканальной гетероструктуры AlGaN, соответствующие двойным каналам 2DEG. Кроме того, можно заметить, что плотность 2DEG в верхнем канале выше, чем в нижнем канале, что можно объяснить двумя аспектами. С одной стороны, нижний барьер AlGaN действует как задний барьер верхнего канала, что способствует ограничению 2DEG верхнего канала. С другой стороны, основным источником питания канала 2DEG в нитридных гетероструктурах являются донорно-подобные поверхностные состояния [20], которые более близки к верхнему каналу.
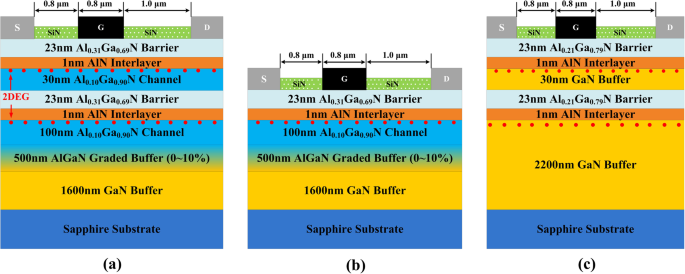
Вид в разрезе (без масштаба) a Двухканальный AlGaN, b Одноканальный AlGaN и c Двухканальные гетероструктуры (HEMT) на основе GaN
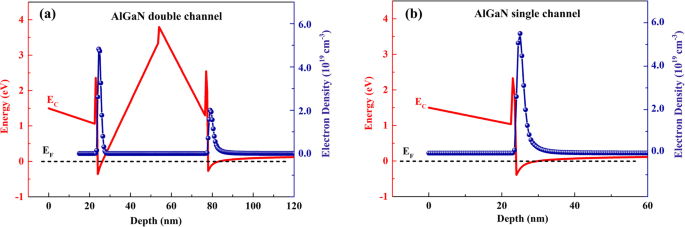
Диаграммы зон проводимости и распределения электронной плотности двухканальных и одноканальных гетероструктур AlGaN
Результаты и обсуждение
На рис. 3 показан результат сканирования ω-2θ с помощью дифракции рентгеновских лучей высокого разрешения (HRXRD) двухканальной гетероструктуры AlGaN от симметричного отражения (0004). Можно наблюдать интенсивность дифракции от зародышевого слоя AlN, буфера GaN, градиентного буфера AlGaN, канала AlGaN и барьерных слоев AlGaN. Кроме того, развертка спектра от 71,0 до 73,2 ° представлена на рис. 2b с увеличением для ясности, а функция Лоренца применяется для подгонки множественных пиков. Пики дифракции буфера GaN, канала AlGaN и барьера AlGaN располагаются при 71,6 °, 72,2 ° и 72,8 °, а градиентный буфер AlGaN дает платформу между пиками буфера GaN и канала AlGaN. Эти результаты указывают на отчетливую многослойную структуру и сложный контроль процесса роста, а также на возможность извлечения 10% и 31% состава AlN в канале и барьере AlGaN.

Сканирование ω-2θ плоскости HRXRD (0004) двухканальной гетероструктуры AlGaN
Измерение емкости-напряжения (C-V) с конфигурацией ртутного зонда было выполнено для исследования двухканальных характеристик гетероструктуры. Как показано на вставке к рис. 4, можно наблюдать две различные ступени емкости при примерно -2,5 В и -10 В с изменяемым приложенным напряжением от 0 до -15 В, что соответствует истощению 2DEG при AlN / Al
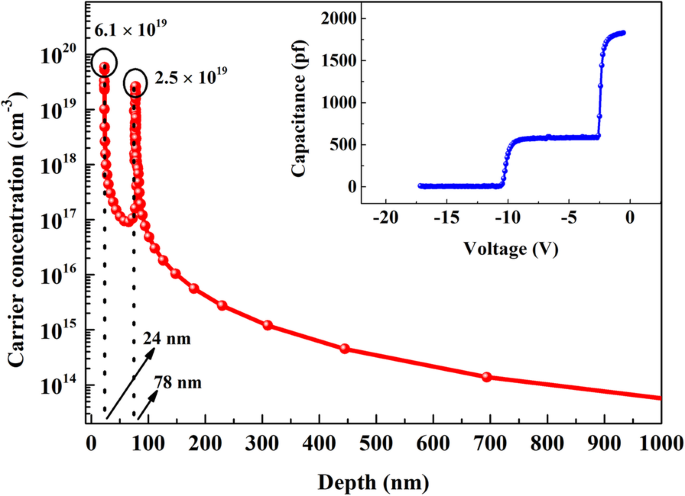
C-V характеристики и кривая электронного распределения двухканальной гетероструктуры AlGaN
Стандартный процесс изготовления HEMT проводился на двухканальной гетероструктуре AlGaN. Процесс изготовления устройства начался с омического контакта, образованного многослойной металлической стопкой Ti / Al / Ni / Au, нанесенной электронно-лучевым испарением, с последующим быстрым термическим отжигом при 850 ° C в течение 30 с в N 2 Атмосфера. Затем выделение мезы было выполнено с помощью Cl 2 / BCl 3 травление с индуктивно связанной плазмой на глубину 200 нм и пассивирующий слой SiN толщиной 100 нм были сформированы путем плазменного химического осаждения из газовой фазы. После этого участок ворот длиной ( L G ) 0,8 мкм было определено фотолитографией после травления верхнего SiN с помощью CF 4 плазмы, а затем осаждался электрод затвора Шоттки Ni / Au. Ворота-источник ( L GS ) и затвор-сток ( L GD ) расстояния равны 0,8 и 1 мкм соответственно. Для сравнения были также изготовлены два дополнительных образца HEMT на основе обычных одноканальных гетероструктур AlGaN и двухканальных GaN гетероструктур, и схемы поперечного сечения показаны на рис. 1b и c. Процесс устройства и характерные параметры дополнительных образцов HEMT точно такие же, как и у двухканальных HEMT из AlGaN. Выходные и передаточные характеристики устройств определялись с помощью анализатора параметров полупроводников Keithley 4200, а характеристики пробоя - с помощью системы высоковольтного полупроводникового анализатора Agilent B1505A.
Типичные выходные характеристики HEMT показаны на рис. 5, для которого V GS и V DS колебались от 0 ~ - 10 В до 0 ~ 10 В. Максимальная плотность тока стока ( I макс ) и дифференциальное сопротивление в открытом состоянии ( R на ) одноканального образца AlGaN составляют 265,3 мА / мм и 27,1 Ом ∙ мм соответственно. Эти результаты согласуются с предыдущими отчетами, предполагающими недостаток HEMT канала AlGaN в текущей емкости накопителя. Для двухканальных HEMT AlGaN, I макс резко возрастает до 473 мА / мм, что в 1,8 раза выше, чем у одноканальных HEMT AlGaN. Мы приписываем улучшение I макс превосходным транспортным свойствам двухканальной гетероструктуры AlGaN. С одной стороны, двухканальная структура обладает двумя потенциальными ямами в вертикальном направлении, и это способствует накоплению носителей в проводящем канале AlGaN. С другой стороны, хотя общая плотность носителей канала увеличивается, средняя концентрация электронов в каждом канале уменьшается. В результате подавляется эффект рассеяния носителей и повышается подвижность электронов в канале. Однако можно заметить, что R на двухканального HEMT из AlGaN составляет 12,5 Ом ∙ мм, что все еще больше, чем у двухканальных HEMT из GaN. Это явление связано с большой высотой контактного барьера барьерных слоев AlGaN, для которых состав AlN достигает 31%. Из-за эффекта самонагрева в результате высокой рассеиваемой мощности эффект отрицательного дифференциального сопротивления может наблюдаться для двухканальных HEMT из GaN, когда V GS > - 4 В и В DS > 6 В. Тем не менее, для HEMT с каналом AlGaN (как одноканального, так и двухканального) этот эффект отрицательного дифференциального сопротивления значительно подавлен, что свидетельствует о превосходных характеристиках HEMT с каналом AlGaN в условиях повышенных температур.

Выходные характеристики двухканальных AlGaN, одноканальных AlGaN и двухканальных GaN HEMT
На рисунке 6 показаны типичные свойства передачи HEMT с V DS 10 В. Одноканальные HEMT AlGaN демонстрируют пороговое напряжение ( В T ) - 3,8 В вместе с нижней пиковой внешней крутизной ( G м, не более ) 80,5 мСм / мм в районе V GS =- 1,5 В. Для двухканальных HEMT из AlGaN и двухканальных GaN напряжение V T заметно снижается до -9,2 и -11,2 В, что является результатом высокой плотности несущих каналов и относительно большого расстояния от электрода затвора до нижнего канала 2DEG. Высокий V T может привести к большим потерям мощности в устройствах в выключенном состоянии, и эту проблему можно решить путем дальнейшей оптимизации параметров роста двухканальных структур, например, надлежащего уменьшения толщины барьерного и верхнего слоев каналов. В частности, двугорбые характеристики можно наблюдать на кривых крутизны двухканального HEMT из AlGaN и двухканального GaN. Для двухканальных HEMT AlGaN два пика:97,9 и 42,5 мСм / мм могут быть извлечены при V G =- 1,0 и - 6,0 В. Подпиковое значение достигает 43% от G m, max , что указывает на приличную способность управления затвором и линейность двухканальных HEMT AlGaN. Более того, основываясь на нашем предыдущем исследовательском достижении [21], результаты могут быть дополнительно улучшены путем модуляции параметров структуры, таких как толщина и состав двойных каналов AlGaN, а эффект связи между двойными каналами и линейность устройства может быть увеличен. улучшено.

Передаточные характеристики двухканальных HEMT AlGaN, одноканальных AlGaN и двухканальных GaN
Характеристики пробоя в закрытом состоянии HEMT на основе различных гетероструктур измерены и показаны на рис. 7. V b определяется критериями тока утечки до 5 мкА / мм. Можно заметить, что все три образца демонстрируют жесткие характеристики пробоя, и характеристики пробоя HEMT с каналом AlGaN, очевидно, лучше, чем у HEMT с каналом GaN. V b двухканального HEMT из AlGaN составляет 143,5 В, что более чем в два раза выше, чем у двухканальных HEMT из GaN. Принимая L GD =1 мкм, то V b, стандартный (определяется V b / L GD ) достигает 143,5 В / мкм для двухканальных HEMT из AlGaN. Я макс и V b, стандартный Результаты двухканальных HEMT AlGaN в этой работе сравниваются с HEMT с каналом GaN и с каналом AlGaN, о которых сообщают другие группы на рис. 8, и различаются результаты устройств с режимом истощения (DM) и режимом улучшения (EM). Кроме того, основные показатели HEMT с каналом AlGaN (гетероструктуры) в предыдущих отчетах и этой работе суммированы в таблице 1. Как показано на рис. 8, очевидно, что характеристики пробоя HEMT с каналом AlGaN в целом лучше, чем у GaN. канальные HEMTs, сопровождающиеся ухудшением I макс . Примечательно, что I макс Двойной канал AlGaN в этой работе сопоставим с большинством результатов HEMT с каналом GaN. Кроме того, необходимо отметить, что I макс ценность в этой работе получена на V GS =0 В, что является консервативным и может быть улучшено путем приложения положительного напряжения затвора. Таким образом, эти результаты убедительно демонстрируют огромный потенциал двухканальных HEMT AlGaN в приложениях для силовых микроволновых устройств.

Пробивные характеристики двухканальных HEMT из AlGaN, одноканальных AlGaN и двухканальных GaN
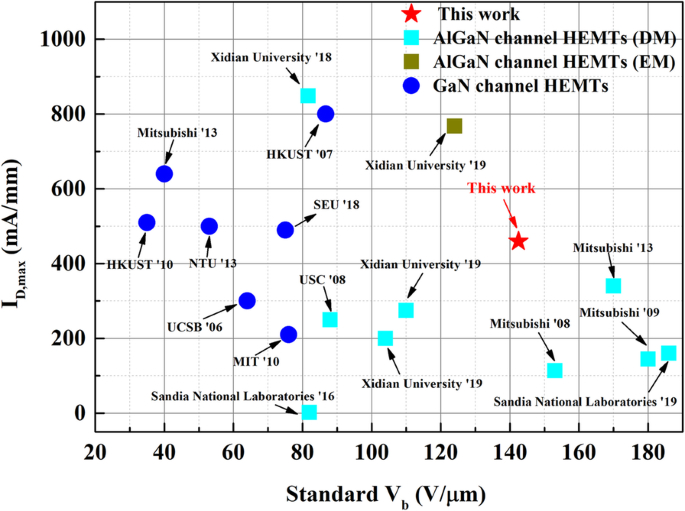
Контрольный показатель I макс и V b, стандартный для HEMT каналов AlGaN и GaN
Выводы
Таким образом, предлагается использовать двухканальную гетероструктуру AlGaN для изготовления HEMT с высокими рабочими характеристиками. Выявлены превосходные транспортные свойства двухканальной гетероструктуры AlGaN, что привело к улучшенной пропускной способности HEMT по току. Кроме того, продемонстрированы превосходные характеристики пробоя двухканальных HEMT AlGaN. Результаты, представленные в этой работе, показывают большой потенциал двухканальных устройств AlGaN в приложениях для использования в сверхвысоких частотах в будущем.
Доступность данных и материалов
Все данные, полученные или проанализированные в ходе этого исследования, включены в эту опубликованную статью и файлы с дополнительной информацией к ней.
Сокращения
- MOCVD:
-
Металлоорганическое химическое осаждение из паровой фазы
- HEMT:
-
Транзисторы с высокой подвижностью электронов
- 2DEG:
-
Двумерный электронный газ
- I макс :
-
Максимальная плотность тока стока
- V b :
-
Напряжение пробоя
- V T :
-
Пороговое напряжение
- RF:
-
Радиочастота
- HRXRD:
-
Дифракция рентгеновских лучей высокого разрешения
- C – V:
-
Емкость-напряжение
- L G :
-
Длина ворот
- L GS :
-
Расстояние от ворот до источника
- L GD :
-
Расстояние между воротами и стоками
- R на :
-
На сопротивление
- G м :
-
Крутизна
- DM:
-
Режим истощения
- EM:
-
Режим улучшения
Наноматериалы
- Напряжение и ток
- Напряжение и ток в практической цепи
- Напряжение пробоя изолятора
- Конденсаторы и вычисления
- Расчет напряжения и тока
- Комплексные вычисления напряжения и тока
- Взаимная индуктивность и основные операции
- Что такое аварийное обслуживание и как с ним бороться
- Влияние состояний поверхности и мольной доли алюминия на поверхностный потенциал и 2DEG в HEMT из AlGaN / GaN
- Материалы и дизайн печатных плат для высокого напряжения



