Сегнетоэлектрическое поведение, обусловленное диполями кислородных вакансий в аморфной пленке для энергонезависимой памяти
Аннотация
Традиционные сегнетоэлектрические устройства страдают недостаточной масштабируемостью. Допированный HfO 2 Тонкая пленка является многообещающей для решения проблемы масштабирования, но сталкивается с проблемой из-за высокого тока утечки и однородности из-за поликристаллической природы. Стабильное поведение, подобное сегнетоэлектрику, впервые продемонстрировано в аморфном Al 2 толщиной 3,6 нм. О 3 фильм. Аморфный Al 2 О 3 устройства обладают высокой масштабируемостью, что позволяет использовать энергонезависимый полевой транзистор с несколькими затворами (NVFET) с шагом ребер нанометрового масштаба. Он также обладает такими преимуществами, как низкая температура процесса, высокая частота (~ ГГц), широкое окно памяти и длительный срок службы, что свидетельствует о большом потенциале систем СБИС. Переключаемая поляризация ( P ), индуцированные диполями кислородных вакансий с модуляцией напряжения.
Фон
Сегнетоэлектрическая память с произвольным доступом (FeRAM), основанная на традиционных перовскитных сегнетоэлектриках (например, PZT), была одной из коммерческих энергонезависимых запоминающих устройств (NVM) [1], хотя ее нельзя масштабировать и она не совместима с CMOS. Сегнетоэлектричество широко наблюдалось в различных материалах, таких как стенки аорты свиньи [2], Sb 2 S 3 нанопроволоки [3], GaFeO 3 пленка [4], легированный поли-HfO 2 пленки [5], пленки нанокристаллического гидроксиапатита [6] и LaAlO 3 -SrTiO 3 фильм [7]. Среди этих материалов легированный HfO 2 Фильмы вызывают особый интерес в приложениях NVM из-за их совместимости с процессами CMOS. Но поликристаллическая структура неизбежно генерирует сегнетоэлектричество в легированном HfO 2 . , что создало следующие препятствия для применения устройства:1) оно несовместимо с обработкой до затвора в отношении теплового баланса 500 ° C, необходимого для образования фаз орторомбического кристалла [8]; 2) потребление энергии вызвано нежелательным током утечки по границам зерен, который экспоненциально увеличивается вместе с уменьшением толщины сегнетоэлектрика. Недавно в теоретическом исследовании было высказано предположение, что дополнительное сегнетоэлектричество в толстом поли-HfO 2 (> 5 нм) может быть результатом дальнодействующих корреляций в сборке электрических диполей, созданных кислородными вакансиями [9]. Механизм захвата / снятия дефектного заряда приводил к сегнетоэлектрическому поведению в аморфном Al 2 толщиной 5 нм. О 3 для многоуровневой памяти, которая, однако, страдает от очень низкой частоты захвата / удаления (например, ~ 500 Гц) [10].
В этой работе стабильное поведение, подобное сегнетоэлектрику, продемонстрировано в аморфном Al 2 толщиной 3,6 нм. О 3 пленка, где переключаемая поляризация ( P ) предполагается индуцировать модулированными по напряжению диполями кислородных вакансий. Аморфный Al 2 О 3 Пленка обладает преимуществами низкой температуры процесса и рабочей частоты до ~ ГГц, что позволяет использовать энергонезависимый полевой транзистор (NVFET) с несколькими затворами и шагом ребер нанометрового масштаба. Аль 2 О 3 Память NVFET с длительностью импульса программы / стирания (P / E) длительностью 100 нс и напряжением более 10 6 Продемонстрирована выносливость циклов P / E. Влияние электродов и толщины пленки на P в А1 2 О 3 конденсаторы также исследуются. Аморфные энергонезависимые устройства показывают многообещающее будущее СБИС-памяти.
Методы
Аморфный Al 2 О 3 Пленки выращивались на подложках Si (001), Ge (001) и TaN / Si методом атомно-слоистого осаждения (ALD). TMA и H 2 Пары O использовались в качестве прекурсоров Al и O соответственно. Во время напыления температура подложки поддерживалась на уровне 300 ° C. На Al 2 были нанесены различные верхние металлические электроды, включая TaN / Ti, TaN и W. О 3 поверхности реактивным напылением. Конденсаторы с разными электродами были изготовлены методом литографии и сухого травления. Был проведен быстрый термический отжиг (RTA) при 350 ° C в течение 30 с. NVFET с TaN / Al 2 О 3 Блок затворов был изготовлен на Ge (001). После формирования затвора области истока / стока (S / D) были имплантированы BF 2 + с дозой 1 × 10 15 см -2 и энергией 20 кэВ, и затем с помощью процесса отрыва были сформированы никелевые S / D металлические электроды толщиной 20 нм. На рис. 1а и б показаны схемы изготовленного Al 2 . О 3 конденсатор и р-канальный NVFET. Между электродом и Al 2 имеется межфазный слой (IL). О 3 фильм. На рис. 1c и d показаны изображения TaN / Al 2 , полученные с помощью просвечивающего электронного микроскопа (HRTEM). О 3 / Ge стопки с различным аморфным Al 2 О 3 толщина ( t AlO ) после RTA при 350 ° C.
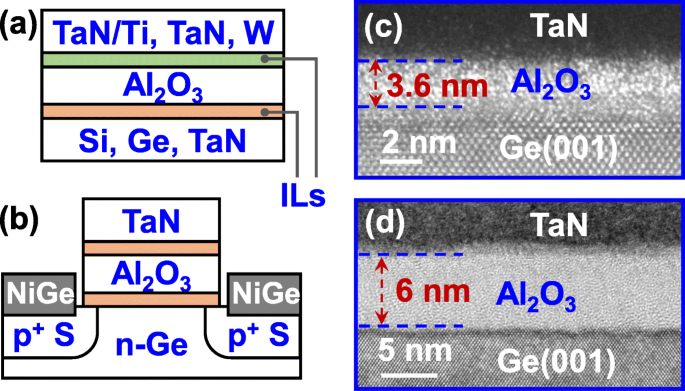
Схемы изготовленного а Аль 2 О 3 конденсаторы с различными электродами и б Аль 2 О 3 NVFET. c и d Изображения HRTEM изготовленного TaN / Al 2 О 3 / Ge стеки с разными t AlO , показывающий аморфный Al 2 О 3 пленки после RTA при 350 ° C
Результаты и обсуждение
На рисунке 2 показано измеренное значение P . vs . напряжение В характеристики аморфного Al 2 О 3 конденсаторы с разными t AlO и различные верхние и нижние электроды. Частота измерения 1 кГц. Как показано на рис. 2a – c, при фиксированном 3,6 нм t AlO , TaN / Al 2 О 3 Конденсатор / Ge обеспечивает более высокую насыщенность P ( P сб ) по сравнению с приборами с верхними электродами из TaN / Ti и W. Поведение, подобное сегнетоэлектрику, сильно коррелирует с интерфейсами, и предполагается, что образование TaAlO x IL между TaN и Al 2 О 3 производит больше кислородных вакансий, что способствует более сильному переключению P , по сравнению с TiAlO x и WALO x Ил. P-V кривые на рис. 2d показывают, что TaN / Al 2 О 3 / Конденсатор TaN имеет гораздо более высокое значение P сб по сравнению с TaN / Al 2 О 3 / Ge, что объясняется тем, что дуальный TaAlO x ИЖ обеспечивают более высокую концентрацию кислородных вакансий. Пока P сб значительно ниже, чем у нижнего Si-электрода (рис. 2д), по сравнению с Ge-электродом. Этот результат показывает, что Al 2 О 3 / Si качество интерфейса лучше, т.е. меньше кислородных вакансий, чем в устройстве на основе Ge. На рисунке 2f показан P-V кривые TaN / Al 2 О 3 (6 нм) / Ge конденсатор, демонстрирующий более высокое V c и почти идентичный P сб по сравнению с прибором с 3,6 нм Al 2 О 3 пленка на рис. 2б. Отмечается, что причина незакрытого P - V петли, потому что утечка действительно существует. Сообщалось, что большое смещение при нулевом электрическом поле всегда происходило с большим полем и всегда постепенно исчезало с меньшим диапазоном развертки V [11, 12].
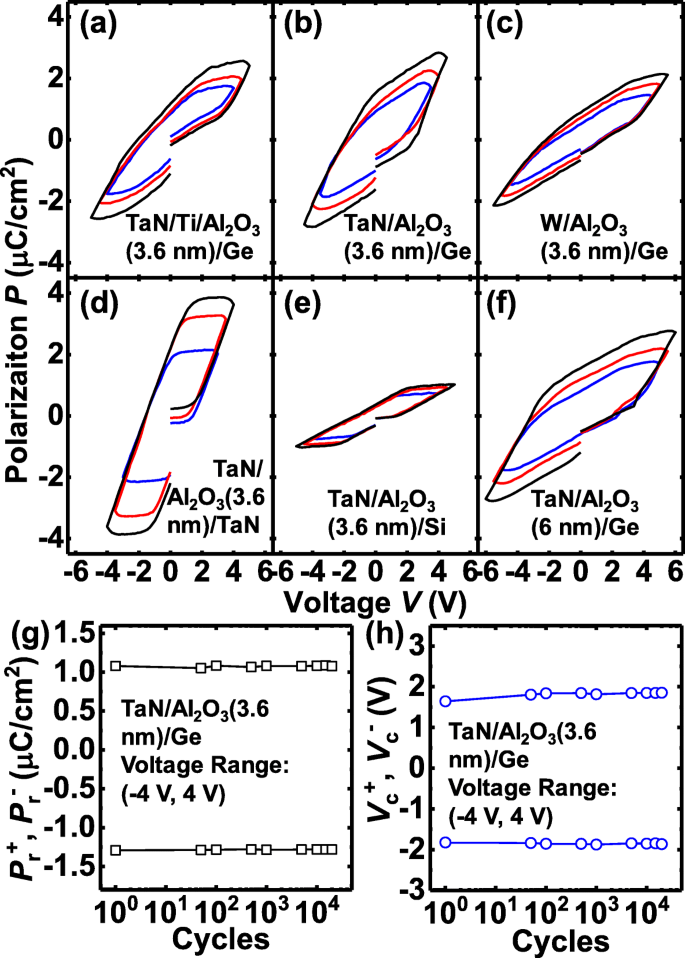
Измерено P по сравнению с V характеристики Al 2 О 3 конденсаторы с разными электродами. а , b , и c показывая P - V кривые TaN / Ti / Al 2 О 3 / Ge, TaN / Al 2 О 3 / Ge и W / Al 2 О 3 / Ge соответственно с длиной волны 3,6 нм t AlO . г и е показывая, что P сб улучшается (восстанавливается) за счет использования TaN (Si) в качестве нижнего электрода вместо Ge. е TaN / Al 2 О 3 (6 нм) / Ge конденсатор имеет более высокое V c и аналогичный P сб по сравнению с устройством толщиной 3,6 нм в b . г и h Измерения выносливости не показывают ухудшения P r и V c наблюдается через 10 4 циклы подметания для TaN / Al 2 О 3 (3,6 нм) / Ge конденсатор
На рис. 2g и h показана извлеченная эволюция положительного и отрицательного остатка P . ( P r ) и принудительного V ( V c ) значения соответственно более 10 4 циклы подметания для TaN / Al 2 О 3 / Ge конденсатор. Не наблюдается эффекта пробуждения, отпечатка или утомляемости. V c напряжения устройства составляет ~ 1,8 В, что говорит о том, что E в Аль 2 О 3 пленка составляет 4 ~ 6 МВ / см, а в ИЖ может превышать 8 МВ / см, что достаточно для движения кислородных вакансий [13, 14]. P сб диапазона устройств от 1 до 5 мкКл / см 2 , что соответствует разумной концентрации кислородных вакансий в диапазоне 3 ~ 15 × 10 12 см -2 при условии, что у них есть заряд плюс два.
Основной механизм сегнетоэлектрического поведения, связанный с кислородными вакансиями в Al 2 О 3 устройства обсуждается. Миграция кислородных вакансий, управляемых напряжением, была широко продемонстрирована в резистивных устройствах оперативной памяти [15, 16]. На рисунке 3 показана схема переключаемого P в TaN / Al 2 О 3 / Ge, который возникает в результате сегрегации модулированных напряжением кислородных вакансий и отрицательных зарядов с образованием электрических диполей. Разумно предположить, что подвижные кислородные вакансии в основном возникают в результате образования TaAlO x ИЛ и находятся в окрестности верхней границы раздела в исходном состоянии (рис. 3а). На рисунках 3b и c показано, как положительный и отрицательный P образуются соответственно при модуляции кислородной вакансии и диполей отрицательного заряда под действием приложенного напряжения. Рентгеновские фотоэлектронные спектры (РФЭС) Al 2 О 3 / Ge и (Ti, TaN и W) / Al 2 О 3 Образцы / Ge измерены и показаны на рис. 4). Для всего металла / Al 2 О 3 / Ge, между металлом и Al 2 образуется ИЖ оксида металла. О 3 , которые предполагается использовать в качестве резервуара для ионов кислорода и вакансий, что согласуется с [5]. [17].
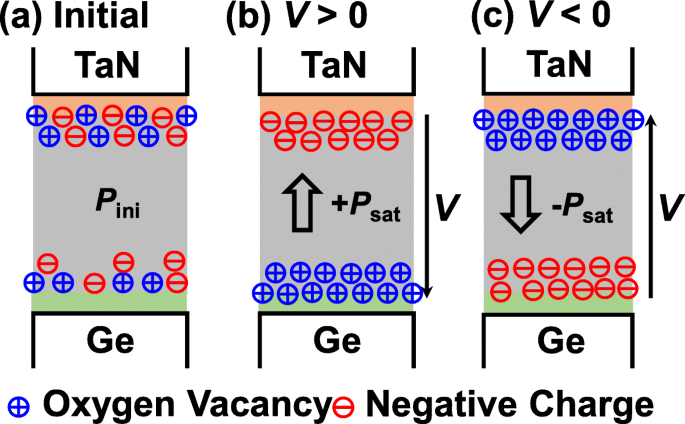
Схема механизма сегнетоэлектрического поведения в Al 2 О 3 конденсаторы. Переключаемый P происходит из-за миграции кислородных вакансий и отрицательных зарядов с образованием диполей

XPS-спектры основного уровня a Аль 2 О 3 / Ge, b TaN / Al 2 О 3 / Ge, c Ti / Al 2 О 3 / Ge и d W / Al 2 О 3 / Ge образцы
Для характеристики электрических характеристик Al 2 О 3 NVFET как NVM, операция программирования (стирания) достигается путем подачи положительных (отрицательных) импульсов напряжения на затвор для повышения (понижения) его порогового напряжения ( V TH ). На рисунке 5а показано, как передаточные характеристики в линейной области Al 2 О 3 Смещение NVFET относительно начального I DS - V GS кривая, измеренная при напряжении программы (стирания) ± 4 В с длительностью импульса 100 нс. Здесь V TH определяется как V GS при 100 нА⋅Вт / л, а МВт определяется как максимальное изменение V TH . Аль 2 О 3 NVFET имеет молекулярную массу 0,44 В, хотя аморфный Al 2 О 3 пленка имеет меньшее P r чем зарегистрированный допированный HfO 2 фильмы [5, 8]. Отмечено, что высокая рабочая частота до 10 МГц Al 2 О 3 Память NVFET, которая указывает на то, что переключаемый P в А1 2 О 3 возникает из-за миграции кислородных вакансий под действием напряжения с образованием диполей, а не из-за улавливания / снятия дефектов заряда. На Al 2 были поданы чередующиеся импульсы программы и стирания. О 3 устройства для дальнейшего изучения выносливости устройства. На рисунке 5b показаны графики V TH vs . Номер цикла P / E, предполагающий, что стабильный MW может поддерживаться без значительного ухудшения более 10 6 Циклы P / E для Al 2 толщиной 3,6 нм О 3 NVFET.
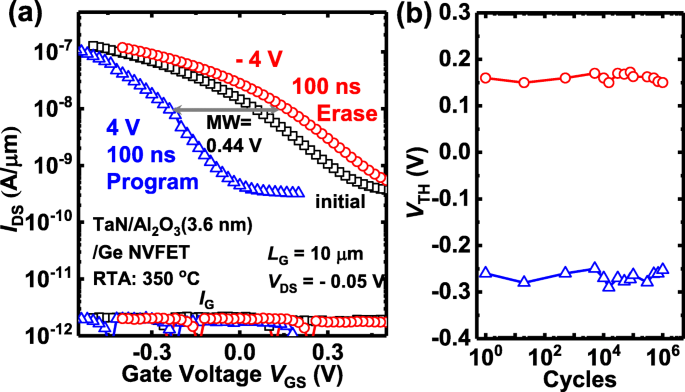
а Измерено I DS - V GS кривые Al 2 толщиной 3,6 нм О 3 NVFET для начального и двух состояний поляризации. Получается МВт 0,44 В. б Измерение долговечности показывает, что ухудшения молекулярной массы не наблюдается после 10 6 Циклы P / E
Примечательно, что поведение, подобное сегнетоэлектрику, наблюдаемое в аморфном Al 2 О 3 устройства могут быть расширены до универсальных аморфных оксидов, например оксида гафния (HfO 2 ) и оксид циркония (ZrO 2 ).
Выводы
Стабильное поведение, подобное сегнетоэлектрику, впервые реализовано в конденсаторах с тонким аморфным Al 2 О 3 изолятор. Переключаемый P в аморфном Al 2 О 3 конденсаторы демонстрирует P-V петли и тест NVFET. Предполагается, что причиной сегнетоэлектрического поведения являются кислородные вакансии на границе раздела фаз и ионные диполи. Al 2 толщиной 3,6 нм О 3 NVFET достигает МВт 0,44 В и более 10 6 продолжительность цикла при ± 4 В при условии P / E 100 нс. В целом, эта работа открыла новый мир для аморфно-оксидных сегнетоэлектрических устройств, которые являются многообещающими для многозатворных (ребристых, нанопроволочных или нанолистовых) полевых транзисторов NVFET с потенциально наноразмерным шагом ребер в системах СБИС.
Доступность данных и материалов
Наборы данных, подтверждающие выводы этой статьи, включены в статью.
Сокращения
- Al 2 О 3 :
-
Оксид алюминия
- ALD:
-
Осаждение атомного слоя
- BF 2 + :
-
Ион фторида бора
- E c :
-
Коэрцитивное электрическое поле
- Ge:
-
Германий
- GeO x :
-
Оксид германия
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- I DS :
-
Слить ток
- МОП-транзисторы:
-
Полевые транзисторы металл-оксид-полупроводник
- MW:
-
Окно памяти
- Ни:
-
Никель
- NVFET:
-
Энергонезависимый полевой транзистор
- P r :
-
Остаточная поляризация
- P сб :
-
Поляризация насыщенности
- RTA:
-
Оплаченный термический отжиг
- TaAlO x :
-
Оксид алюминия тантал
- t AlO :
-
Толщина оксида алюминия
- TaN:
-
Нитрид тантала
- V GS :
-
Напряжение затвора
- V TH :
-
Пороговое напряжение
- XPS:
-
Рентгеновские фотоэлектронные спектры
Наноматериалы
- Более умная память для устройств IoT
- Семейство энергонезависимой памяти увеличивает плотность
- Тестер выдержки для пленочных фотоаппаратов
- Противотуманная пленка для ПК для козырьков, линз и очков
- Диэлектрофорез с повышенным нагревом для выровненной однослойной пленки углеродных нанотрубок сверхвысоко…
- Аморфные кремниевые нанопроволоки, выращенные на пленке оксида кремния путем отжига
- Магнитные углеродные микросферы как многоразовый адсорбент для удаления сульфонамида из воды
- Пленка Solvay на эпоксидной основе для препрегов
- Сенсорная пленка для аэрокосмической отрасли
- Новый метод изготовления компьютерной памяти из оксида титана



