Характеристика резистивной коммутации с низким энергопотреблением в двухслойной резистивной памяти с произвольным доступом HfO2 / TiOx
Аннотация
Устройства резистивной оперативной памяти с осаждением атомного слоя HfO 2 и радиочастотное распыление TiO x поскольку резистивные коммутационные слои были успешно изготовлены. Характеристики малой мощности с установленной мощностью 1,52 мкВт (1 мкА при 1,52 В) и мощностью сброса 1,12 мкВт (1 мкА при 1,12 В) были получены в HfO 2 / TiO x устройства с резистивной оперативной памятью (RRAM), контролируя содержание кислорода в TiO x слой. Кроме того, влияние содержания кислорода во время TiO x Процесс распыления на свойства резистивного переключения будет обсуждаться подробно. Исследования показали, что «мягкий пробой» легко происходил в процессе электрического формования / отверждения в HfO 2 / TiO x Устройства RRAM с высоким содержанием кислорода TiO x слой, что приводит к высокой резистивной мощности переключения. Получена маломощная характеристика HfO 2 / TiO x Устройства RRAM с достаточно высокой плотностью кислородных вакансий TiO x слой, предполагая, что соответствующая плотность кислородных вакансий в TiO x слой может избежать «мягкого разрушения» диэлектрических слоев во время процесса формовки / отверждения, тем самым ограничивая ток, протекающий через устройство RRAM, и снижая потребляемую мощность при эксплуатации.
Введение
Резистивная память с произвольным доступом (RRAM) обеспечивает многообещающее решение для масштабирования по сравнению с традиционной памятью на основе заряда благодаря простой структуре ячеек, энергонезависимой памяти, высокоскоростной работе и высокому соотношению включения / выключения [1,2,3, 4,5,6,7,8,9,10]. В последнее время широко используется конструкция с одним транзистором и одним резистором (1T1R) для предотвращения неточных измерений сопротивления, вызванных током утечки в 1R матрице [11, 12]. Кроме того, развивающаяся память, особенно RRAM на основе оксидов, была предложена для пластиковых синаптических устройств из-за постепенной модуляции проводимости с количеством импульсов, которые могут имитировать биологическое синаптическое поведение для получения сигналов от пре- и постсинаптических нейронов [13,14,15 , 16,17]. Однако высокий резистивный ток переключения является основным ограничением для приложений с малой мощностью и высокой плотностью [18,19,20]. Массив 1T1R также сталкивается с проблемами масштабирования, если рабочий ток RRAM не может соответствующим образом масштабироваться. Например, когда технология CMOS уменьшается до 27 нм, ток возбуждения уменьшится до 40 мкА [21]. Следовательно, снижение рабочего тока устройства RRAM до 10 мкА за счет оптимизации структуры и материала необходимо для продолжения масштабирования 1T1R [22]. Кроме того, биологические синапсы потребляют около 1 ~ 10 фДж на событие в сложном человеческом мозгу, таким образом, снижение потребления энергии электрическими синаптическими устройствами так же мало, как биологические синапсы, важно для развития нейроморфных искусственных нейронных сетей (ИНС) [23, 24,25]. Следовательно, ограничение тока устройства и снижение энергопотребления принесет пользу практическому процессу хранения данных и приложениям для нейроморфных вычислений.
В этой работе Pt / HfO 2 / TiO x / Pt устройства с различным содержанием кислорода TiO x пленка и продемонстрирована маломощная характеристика при низком содержании кислорода. Устройство памяти достигло установленной мощности 1,52 мкВт и мощности сброса 1,12 мкВт за счет уменьшения содержания кислорода в TiO x пленка в процессе напыления. Проводящий механизм для характеристики малой мощности был дополнительно проанализирован, чтобы дать представление о конструкции оксидного RRAM.
Методы
Pt / HfO 2 / TiO x Структура устройства / Pt и процесс изготовления показаны на рис. 1а и б. Сначала на Si / SiO 2 / Ti подложка, нижний платиновый электрод (BE) с длиной волны 100 нм был приготовлен методом напыления на постоянном токе (DC) при комнатной температуре. Далее, 3 нм HfO 2 был нанесен методом атомно-слоистого осаждения (ALD) (Picosun R200) при 300 ° C с использованием TEMAH и H 2 О как предшественники. Впоследствии 30 нм TiO x был нанесен с различным содержанием кислорода методом радиочастотного распыления. Во время TiO x процесс напыления пленки, фиксирующий общий газовый поток аргона (Ar) и кислорода (O 2 ) как 20 sccm и изменяя парциальное давление кислорода на 9%, 11% и 13%, были получены три образца устройства (S1, S2 и S3) для исследования влияния содержания кислорода в TiO x фильм о резистивной коммутации. После этого с помощью распыления постоянным током был нанесен платиновый верхний электрод (ТЕ) с длиной волны 70 нм и нанесен узор с помощью литографии. Наконец, устройства квадратной формы 100 мкм × 100 мкм были сформированы реактивным ионным травлением (RIE). Напряжение смещения было приложено к TE, и BE было подключено к земле. Изображения с помощью просвечивающего электронного микроскопа высокого разрешения (HRTEM) поперечного сечения Pt / HfO 2 / TiO x / Pt показаны на рис. 2. Электрические характеристики устройств были измерены с помощью анализатора параметров полупроводников Agilent B1500A. Химические состояния атомов в TiO x Пленки исследовались методом рентгеновской фотоэлектронной спектроскопии (XPS, Axis Ultra).
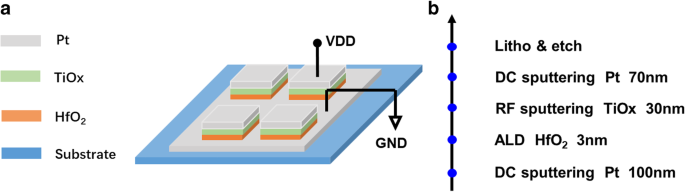
а Структура Pt / HfO2 / TiO x / Пт устройство. б Процесс изготовления
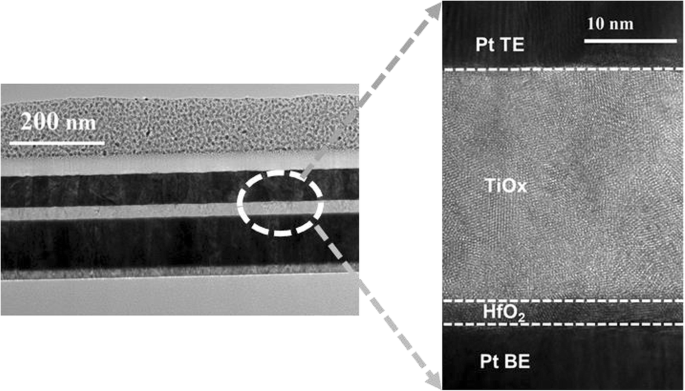
Поперечные сечения ПЭМ Pt / HfO 2 / TiO x / Pt устройство
Результаты и обсуждение
На рис. 3a, b и c показаны XPS O 1s-спектры TiO x на уровне ядра. фильмы. Чтобы прояснить химическую связь кислорода в пленках, асимметричные пики O 1s разделены на два пика, которые обычно приписываются O 2- связаны ионами металлов и O 2− в кислородно-дефицитной области [26]. Парциальное давление кислорода при TiO x Процесс напыления пленки был установлен на 9%, 11% и 13% соответственно, а соответствующее содержание дефицита кислорода в трех образцах составляет около 28,23%, 24,06% и 23,63%, что указывает на то, что содержание нерешетчатых ионов кислорода а количество кислородных вакансий уменьшается с увеличением парциального давления кислорода.

Спектры XPS сканирования O 1s TiO x фильмы в S1, S2 и S3. Парциальное давление кислорода было установлено как a 9%, b 11% и c 13% во время TiO x процесс напыления пленки
Для новых устройств исходное состояние находится в состоянии высокого сопротивления (HRS). Как показано на рис. 4, формирование тока (CF) применяется для инициирования формирования проводящей нити и изменения состояния устройства на состояние с низким сопротивлением (LRS) [27]. При подаче тока соответствия 1 мкА в S1 образуется токопроводящий путь, и в последующей операции может быть достигнут стабильный процесс установки / сброса. Для S2 и S3 операция сброса не выполняется из среднего состояния устройства во время процесса CF до тех пор, пока текущее соответствие не достигнет 20 мА.
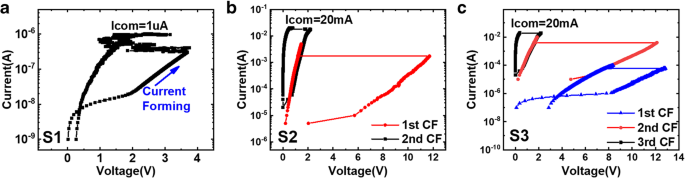
Текущий процесс формирования Pt / HfO2 / TiO x / Pt RRAM устройство в a S1, b S2 и c S3
Чтобы проверить электрические характеристики устройства RRAM, выполняются измерения постоянного тока при развертке напряжения. Положительное напряжение смещения в процессе формирования и установки прикладывается к TE, чтобы завершить проводящую нить накала, а отрицательное напряжение смещения в процессе сброса должно разорвать нить. Когда смещение колеблется взад и вперед, 100 циклов кривых биполярного переключения ток-напряжение (IV) для трех образцов показаны на рис. 5. Устройства S1 достигают стабильных характеристик резистивного переключения при соблюдении тока 10 мкА, но рабочий ток составляет до 10 мА для двух других образцов. Низкое энергопотребление S1 может быть связано с высоким содержанием кислородных вакансий в TiO x . пленка, которая эффективно ограничивает ток во время процесса формовки / схватывания.
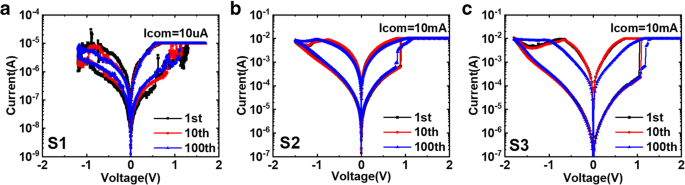
100 циклов стабильных двунаправленных кривых ВАХ в a S1, b S2 и c S3
На рисунках 6 и 7 показано изменение от цикла к циклу и от устройства к устройству (относительное стандартное отклонение, ( σ / μ )) трех образцов, а статистика суммирована в таблицах 1 и 2. Для S1 слабый прыжковый ток вызывает умеренное распределение сопротивления, а сильные проводящие нити, сформированные в S2 и S3, гарантируют относительно стабильное распределение сопротивления. Несмотря на то, что после десятков циклов S3 немного ухудшается, соотношение включения / выключения все еще превышает 100.

Изменение R LRS от цикла к циклу и R HRS на 100 циклов в a S1, b S2 и c S3

Вариант R LRS от устройства к устройству и R HRS для 20 устройств в a S1, b S2 и c S3
Как показано на рис. 8, установленная мощность (Pset) 1,52 мкВт и мощность сброса (Preset) 1,12 мкВт достигаются при низком токе согласования 1 мкА. Энергопотребление двух других образцов составляет десятки милливатт при рабочем токе 10 мА. Кроме того, состояния сопротивления S1 могут сохранять удерживающие характеристики более 10 4 с температурой ниже 85 ° C с соотношением включения / выключения примерно 100, что является стабильным для приложений хранения данных.
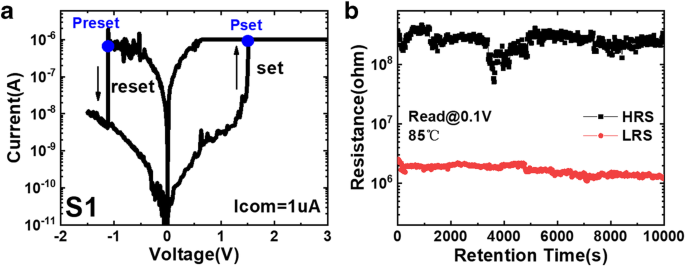
а Резистивное переключение при ограничении тока 1 мкА. б Удерживающая характеристика в S1 более 10 4 с ниже 85 ° C
Чтобы выяснить проводящий механизм маломощной характеристики, мы провели измерения температуры для S1 и S3 с разным рабочим током и исследовали соответствующий механизм, как показано на рис. 9 и 10. От 25 ° C до 125 ° C сопротивление S1 уменьшается с температурой, но сопротивление S3 почти не меняется. Экспериментальная проводимость и температура соответствуют модели прыжков с переменной длиной прыжка Мотта [28], как показано на рис. 11, который показывает, что основным проводящим механизмом S1 является прыжок электронов через локализованные дефекты кислородных вакансий в диэлектрическом оксиде [29]. При снижении парциального давления кислорода во время TiO x процесс распыления, как показано на S1, содержание вакансий кислорода в исходном TiO x слой увеличивается, а сопротивление пленки уменьшается [30]. Напряжение на TE подается в основном на HfO 2 . слой и масса кислородных вакансий мотивированы, чтобы сформировать проводящую нить. После этого в TiO x также появляются новые кислородные вакансии. слой, но связь между кислородными вакансиями слабая. Следовательно, прыжковая проводимость электронов в TiO x является доминирующим, что обеспечивает низкий резистивный коммутируемый ток 1 мкА.

а Сопротивление изменяется в зависимости от температуры в S1. б Соответствующая принципиальная схема токопроводящего механизма

а Сопротивление изменяется в зависимости от температуры в S3. б Соответствующая принципиальная схема токопроводящего механизма

Температурная зависимость проводимости S1 в a LRS и b HRS
Однако, как показано на рис. 10, после увеличения содержания кислорода во время TiO x В процессе распыления HRS и LRS практически не изменяются с температурой, что, скорее всего, связано с металлическим механизмом переноса, вызванным переносом электронов через проводящую нить, состоящую из концентрированных кислородных вакансий. По сравнению с устройством RRAM S1 меньше кислородных вакансий в исходном TiO x слоя S3 недостаточно для прыжковой проводимости электронов. Кроме того, из-за повышенного сопротивления TiO x пленка, напряжение смещения приложено к обоим HfO 2 слой и TiO x слой одновременно. Электрическая инициализация приводит к появлению большого количества кислородных вакансий, мотивированных HfO 2 и TiO x слои. Эти кислородные вакансии образуют прочную проводящую нить в обоих двух диэлектрических слоях, а многочисленные протяженные электроны проходят через две соседние кислородные вакансии, что вызывает высокий рабочий ток во время процесса резистивного переключения.
В принципе, можно тщательно контролировать содержание кислорода для достижения маломощных характеристик других резистивных запоминающих устройств на основе оксидов (OxRRAM), связанных с вакансиями кислорода. Требование к оксидному слою состоит в том, что в исходном состоянии должно быть достаточно кислородных вакансий для прыжковой электрической проводимости в случае выхода прибора из строя. Однако чрезмерное количество кислородных вакансий приведет к нестабильным характеристикам выносливости и ухудшит характеристики устройства. Следовательно, необходимы соответствующие кислородные вакансии для ограничения рабочего тока и снижения энергопотребления.
В таблице 3 сравниваются некоторые ключевые параметры Pt / HfO 2 / TiO x / Pt устройство с другими недавними отчетами. Устройство имеет важные достоинства:низкую резистивную коммутационную мощность 1,12 мкВт и соотношение между различными устройствами RRAM более 100 HRS / LRS.
Выводы
В этой работе резистивный коммутируемый ток 1 мкА был продемонстрирован в Pt / HfO 2 / TiO x / Устройство платиновой структуры. Для механизма проводимости прыжковая проводимость электронов является доминирующей при низком содержании кислорода в TiO x слой, ограничивающий рабочий ток и снижающий энергопотребление. Металлический транспорт преобладает при высоком содержании кислорода в TiO x слой, и «мягкий пробой» двух диэлектрических слоев вызывает высокий рабочий ток и высокое энергопотребление. Соответствующее содержание кислорода в TiO x пленка может ограничивать ток RRAM и способствовать характеристике низкого энергопотребления, что обеспечивает решение проблем с большим рабочим током и высокой мощностью и показывает перспективы для будущих встроенных энергонезависимых запоминающих устройств и приложений Интернета вещей (IoT).
Сокращения
- 1T1R:
-
Однотранзисторный однорезисторный
- ALD:
-
Осаждение атомного слоя
- ИНС:
-
Искусственные нейронные сети
- BE:
-
Нижний электрод
- CF:
-
Текущее формирование
- HRS:
-
Состояние высокого сопротивления
- HRTEM:
-
Просвечивающий электронный микроскоп высокого разрешения
- Интернет вещей:
-
Интернет вещей
- I-V:
-
Ток-напряжение
- LRS:
-
Состояние низкого сопротивления
- Соотношение включения / выключения:
-
HRS / LRS
- OxRRAM:
-
Оксидная резистивная память
- Предварительная установка:
-
Сбросить питание
- Pset:
-
Установить мощность
- RIE:
-
Реактивное ионное травление
- RRAM:
-
Резистивная память с произвольным доступом
- TE:
-
Верхний электрод
- XPS:
-
Рентгеновская фотоэлектронная спектроскопия
- σ / μ :
-
Относительное стандартное отклонение
Наноматериалы
- Кислород
- Нанографема, гибкая прозрачная память на основе кремния
- Характеристики биполярного резистивного переключения устройств RRAM с трехслойной структурой HfO2 / TiO2 / HfO2 на по…
- Резистивная память ZrO2 / ZrO2 - x / ZrO2 без соблюдения нормативных требований с управляемым межфазным режимом перек…
- Интегрированная RRAM 4T SRAM с самоторможением резистивной коммутационной нагрузки с помощью логического процес…
- Коллективное исследование моделирования и имитации резистивной оперативной памяти
- Эффект сегнетоэлектрического поля, индуцированный асимметричным резистивным переключением, в эпитаксиальн…
- Реакция восстановления кислорода на PtCo Нанокатализатор:отравление (Bi) сульфат-анионами
- Исследование изменчивости контактной резистивной оперативной памяти с помощью стохастической модели вакан…
- Новый метод изготовления компьютерной памяти из оксида титана



